InFO (Integrated-FanOut-Wafer-Level-Package)能夠提供多芯片垂直堆疊封裝的能力,它通過RDL層,將芯片的IO連接扇出擴展到Die的投影面積之外,增加了
2023-03-30 09:42:45 4560
4560 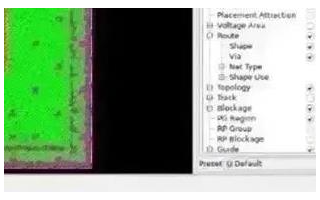
臺積公司宣布成功推出支援20奈米制程與CoWoS技術的設計參考流程,展現(xiàn)了該公司在開放創(chuàng)新平臺(OIP)架構中支援20奈米與CoWoS技術的設計環(huán)境已準備就緒。
2012-10-11 09:28:45 1410
1410 日前有媒體指稱,蘋果(Apple Inc.)、高通(Qualcomm Inc.)、海思(HiSilicon)及聯(lián)發(fā)科等 4 大廠商 2016 年第 1 季底將正式采用臺積電的“整合型扇出型封裝
2015-11-18 08:17:37 640
640 CoWoS 技術概念,簡單來說是先將半導體芯片(像是處理器、記憶體等),一同放在硅中介層上,再透過Chip on Wafer(CoW)的封裝制程連接至底層基板上。
2023-07-11 10:06:11 12293
12293 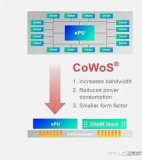
技術悄然崛起,向長期占據主導地位的臺積電CoWoS方案發(fā)起挑戰(zhàn),一場關乎AI產業(yè)成本與效率的技術博弈已然拉開序幕。 ? 在AI算力需求呈指數級增長的當下,先進封裝技術成為突破芯片性能瓶頸的關鍵。臺積電的CoWoS技術歷經十余年迭代,憑借成熟的工藝和出色
2025-12-16 09:38:28 1963
1963 決定提高在SiP制程上的研發(fā)力道,除了目前已開始小量生產的CoWoS技術之外,針對中低端處理器市場量身打造的InFO WLP封裝技術也可望在今年底開始生產,同時可支持Wide IO接口DRAM芯片的封裝
2014-05-07 15:30:16
我申請了lmv1012(DSBGA封裝)的樣片,但是按照datasheet我無法區(qū)分其引腳,因為我拿到的芯片正面沒有任何凸點或凹點,沒有任何標識,光溜溜的一片,而背面則是四個極小的金屬點引腳而已,請問我該如何區(qū)分?
謝謝!
2024-10-30 07:51:19
想做一個封裝信息整合,但是遇到困惑。比如同是BGA的封裝,它有各種引腳數的,引腳數相同的又有面積不同的,怎樣命名才會得以區(qū)分開呢?{:soso_e183:}
2012-02-22 09:24:06
怎樣去區(qū)分4412開發(fā)板的***封裝與POP封裝呢?怎樣去識別4412開發(fā)板呢?有何方式?
2021-12-27 07:28:57
CAM350 8.0 信息菜單(info)
1.
2007-01-25 11:29:30 1043
1043 臺積電不僅在晶圓代工技術持續(xù)領先,并將搭配最先進封裝技術,全力拉開與三星電子(Samsung Electronics)、英特爾(Intel)差距,臺積電日前揭露第四代CoWoS(Chip
2018-11-02 17:02:49 6045
6045 高效能運算領域的領導廠商arm與晶圓代工龍頭臺積電26日共同宣布,發(fā)布業(yè)界首款采用臺積電先進的CoWoS封裝解決方案,內建arm多核心處理器,并獲得硅晶驗證的7納米小芯片(Chiplet)系統(tǒng)。
2019-09-27 16:09:52 4116
4116 臺積電從原來的晶圓制造代工角色,逐步跨界至封測代工領域(InFO、CoWoS及SoIC等封裝技術),試圖完整實體半導體的制作流程。
2020-02-25 17:18:14 4256
4256 
3月3日消息,臺積電今日宣布,將與博通公司合作強化CoWoS平臺。
2020-03-03 11:52:26 2005
2005 DigiTimes消息,過去兩周CoWoS封裝產品的需求量有了顯著的增加。AMD、NVIDIA、海思、賽靈思和博通都對臺積電下了CoWoS的訂單,這些訂單包括高性能計算芯片、帶HBM的AI加速器和ASIC等,使得臺積電的CoWoS生產線滿負載運行。
2020-04-12 19:00:10 3152
3152 臺積電于2017年宣布了集成式FanOut技術(InFO)。它使用聚酰胺薄膜代替CoWoS中的硅中介層,從而降低了單位成本和封裝高度,這兩項都是移動應用的重要標準。臺積電已經出貨了數千萬個用于智能手機的InFO設計。
2020-06-11 10:59:01 2283
2283 重點 ● TSMC認證基于新思科技3DIC Compiler統(tǒng)一平臺的CoWoS和InFO設計流程 ● 3DIC Compiler可提高先進封裝設計生產率 ● 集成Ansys芯片封裝協(xié)同分析解決方案
2020-10-14 11:11:21 2814
2814 據媒體報道,作為全球一號代工廠,臺積電已經開始大規(guī)模量產第六代CoWoS晶圓級芯片封裝技術,集成度大大提高。 我們知道,如今的高端半導體芯片越來越復雜,傳統(tǒng)的封裝技術已經無法滿足,Intel、臺積電
2020-10-26 17:10:35 3147
3147 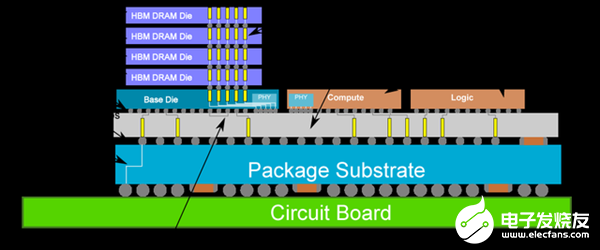
據媒體報道,作為全球一號代工廠,臺積電已經開始大規(guī)模量產第六代CoWoS晶圓級芯片封裝技術,集成度大大提高。
2020-10-27 14:37:30 4537
4537 
$IOBUS_INFO[] 具有有關總線驅動程序信息的結構 $IOBUS_INFO[Index ]=Information Index: 網絡號,序列號會自動分配給總線驅動程序
2021-05-08 11:26:26 2629
2629 
BGA封裝是球柵陣列封裝,是芯片的一種封裝形式,多見于多引腳的芯片,芯片的引腳位于芯片的底部,呈現(xiàn)球狀,所以還是比較容易區(qū)分的。
2021-06-21 17:53:19 12423
12423 根據外媒的消息報道稱,臺積電公司目前正在加大先進封裝投資力度,目前已將旗下CoWoS 封裝業(yè)務的部分流程外包分給了OSAT,此前臺積電還公布了最新強化版的CoWoS封裝工藝。
2021-11-25 17:38:58 2472
2472 一般來說完整的芯片器件型號都是由三部分組成的,分別是主體型號、前綴、后綴。那么電子元器件芯片的型號如何區(qū)分呢? 1、區(qū)分有鉛和無鉛。 2、可區(qū)分器件的封裝形式。 3、可以區(qū)分細節(jié)性能。 4、可區(qū)分
2022-01-02 15:39:00 13927
13927 Direct)、臺積電(InFO-OS、InFO-LSI、InFO-SOW、 InFO-SoIS、CoWoS-S、CoWoS-R、CoWoS-L、SoIC)、三星(FOSiP、X-Cube、I-Cube
2022-01-12 13:16:42 2983
2983 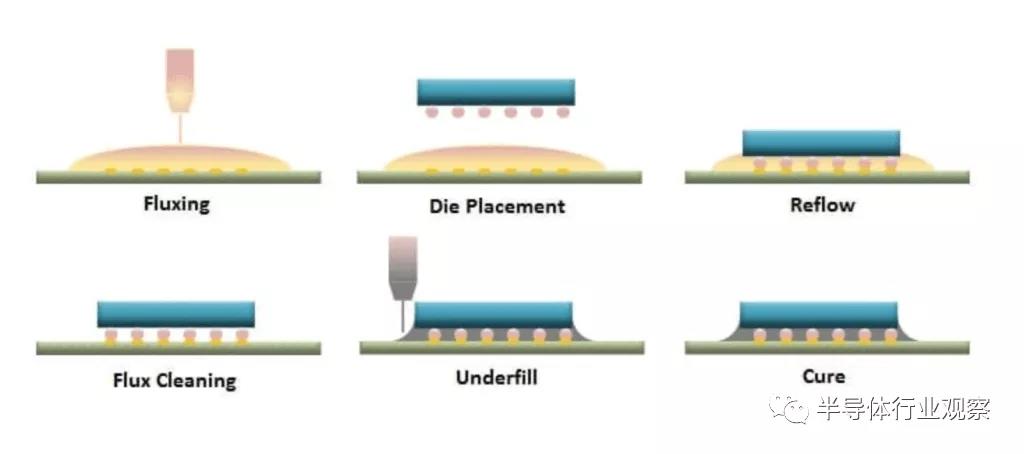
InFO和CoWoS產品已連續(xù)多年大批量生產。CoWoS開發(fā)中最近的創(chuàng)新涉及將最大硅插入器尺寸擴展到大于最大光罩尺寸,以容納更多模具(尤其是HBM堆棧),將RDL互連拼接在一起。
2022-06-30 10:52:35 2763
2763 臺積電InFO_PoP(package on package)技術實現(xiàn)商用已有10多年,包括iPhone AP的生產也已有多年。其2.5D IC CoWoS封裝技術得到包括Nvidia、AMD
2022-12-20 15:48:23 1249
1249 $PROG_INFO[]將某些系統(tǒng)狀態(tài)組合在一個結構中。 $PROG_INFO[ Interpreter ] = Information Interpreter 類型:INT ? 1:機器人翻譯
2023-05-23 10:15:18 2262
2262 在2022年底舉辦的TSMCOIP研討會上,Cadence資深半導體封裝管理總監(jiān)JohnPark先生展示了面向TSMCInFO技術的高級自動布線功能。InFO的全稱為“集成式扇出型封裝
2023-03-03 15:15:26 2179
2179 
Info封裝與CoWoS封裝是目前2.5D封裝的典型代表,同屬于TSMC開發(fā)的2.5D封裝,那么如何區(qū)分 Info封裝與CoWoS封裝呢?主要從以下方面進行闡述。
2023-06-20 11:51:35 11684
11684 
提及先進封裝,臺積電的CoWoS和InFO、三星的X-Cube以及英特爾的EMIB等晶圓級封裝是如今最為人所熟知的方案。在Chiplet熱潮的帶動下,這些晶圓級封裝技術扶持著逼近極限的摩爾定律繼續(xù)向前,巨大的市場機遇面前,傳統(tǒng)的封測廠商也開始鉆研晶圓級技術,意圖分一杯羹。
2023-07-11 16:19:09 1239
1239 報告臺積電的2023年cowos生產能力比2022年成倍增加,每年最少12萬個cowos晶片將具備生產能力,英偉達(nbiia)是第一位顧客,2023年第二、三大客戶分別博通、AMD,而2024年亞馬遜有望躋身第三大CoWoS客戶。
2023-07-17 09:49:38 1270
1270 CoWoS-R 技術的主要特點包括: 1)RDL interposer 由多達 6L 銅層組成,用于最小間距為 4um 間距(2um 線寬/間距)的布線。 2)RDL 互連提供良好的信號和電源完整性性能,路由線路的 RC 值較低,可實現(xiàn)高傳輸數據速率。
2023-07-26 11:27:45 20971
20971 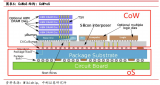
人工智能正在蓬勃發(fā)展。每個人都想要更多的人工智能加速器,而主要的限制因素是將 5nm ASIC 和 HBM 組合在一起的 CoWoS 先進封裝工藝,其產能容量不足導致 GPU 短缺,這種短缺將持續(xù)到明年第二季度。
2023-07-28 10:20:10 4517
4517 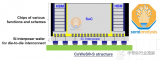
CoWos是最流行的 GPU 和 AI 加速器封裝技術。
2023-07-30 14:25:32 3940
3940 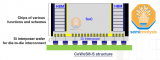
隨著chatGPT橫空出世,生成式AI紅遍全球,帶動AI芯片的需求強勁,英偉達(NVIDIA)的H100、A100全部由臺積電代工,并使用臺積電的CoWoS先進封裝技術,除了英偉達外,AMD MI300也導入CoWoS技術,造成CoWoS產能供不應求。
2023-07-31 12:49:24 5555
5555 AI芯片帶來的強勁需求下先進封裝景氣度正在反轉。有媒體日前消息稱,當前英偉達、博通、AMD均在爭搶臺積電CoWoS產能,公司AI芯片已現(xiàn)爆單,將于竹科銅鑼園區(qū)新建先進封裝晶圓廠。
2023-08-01 10:36:59 3305
3305 
據臺媒電子時報報道,數月前英偉達AI GPU需求急速導致臺積電CoWoS先進封裝產能嚴重不足,近日臺積電總裁魏哲家坦言,先前與客戶電話會議,要求擴大CoWoS產能。
2023-08-09 09:35:32 2175
2175 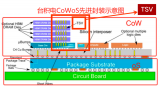
據傳,業(yè)界公認的臺積電獨吞蘋果訂單的關鍵利器就是CoWoS封裝技術。這幾年,先進封裝技術不斷涌現(xiàn),目前可以列出的估計有幾十種,讓人眼花繚亂。主流的封裝技術都有哪些?如何區(qū)分呢?下面就給大家盤點一下。
2023-08-10 09:23:26 4431
4431 
chiplet和cowos的關系 Chiplet和CoWoS是現(xiàn)代半導體工業(yè)中的兩種關鍵概念。兩者都具有很高的技術含量和經濟意義。本文將詳細介紹Chiplet和CoWoS的概念、優(yōu)點、應用以
2023-08-25 14:49:53 4513
4513 CoWoS,是Chip on Wafer on Substrate的簡稱。這一長串名詞可以分為CoW與WoS。CoW,將芯片(有源硅芯片)堆疊在中介層(無源硅片)上,WoS則是將中介層再堆疊在基板上,三層堆疊最終形成立體封裝形式。
2023-08-28 14:59:17 5726
5726 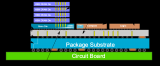
電子發(fā)燒友網站提供《采用InFO封裝的新型UltraScale+器件支持緊湊型工業(yè)相機.pdf》資料免費下載
2023-09-13 15:09:49 0
0 在展望明年cowos生產能力狀況時,法人預測臺積電明年cowos的年生產能力將增加100%,其中英偉達將占tsmc cowos生產能力的40%左右,amd將占8%左右。臺積電以外的供應鏈可以增加20%的設備。
2023-11-08 14:29:53 1176
1176 面向 TSMC InFO 技術的高級自動布線功能
2023-11-27 17:32:33 1521
1521 
為什么CoWoS技術采用了無源硅中介層作為通信層可以有效地減少信號干擾和噪聲? CoWoS(Chip-on-Wafer-on-Substrate)技術是一種在集成電路封裝中采用的先進技術,它采用
2023-12-07 10:53:38 961
961 為達成此目標,公司正加緊推進N2和N2P級別的2nm制造節(jié)點研究,并同步發(fā)展A14和A10級別的1.4nm加工工藝,預計到2030年可以實現(xiàn)。此外,臺積電預計封裝技術,如CoWoS、InFO、SoIC等會不斷優(yōu)化升級,使他們有望在2030年前后打造出超萬億晶體管的大規(guī)模封裝解決方案。
2023-12-28 15:20:10 1003
1003 臺積電預計封裝技術(CoWoS、InFO、SoIC 等)將取得進步,使其能夠在 2030 年左右構建封裝超過一萬億個晶體管的大規(guī)模多芯片解決方案。
2023-12-29 10:35:28 868
868 
據了解,臺積電公司(TSMC)的CoWoS產能已經飽和,且未來擴產計劃主要服務于英偉達,為滿足AMD需求新建生產線需耗時6—9個月。據此推測,AMD可能會尋找具有類似CoWoS 封裝技術的其他制造商合作,日月光、安靠(Amkor)、力成以及京元電或許是首選對象。
2024-01-03 14:07:58 1117
1117 晶圓廠設備制造商稱,臺積電的可用CoWoS產能仍不足以滿足需求。消息人士稱,盡管臺積電努力加快設備改造,但到2023年底,CoWoS的月產能僅為15000片晶圓。
2024-01-19 11:14:10 1720
1720 臺積電設定了提高推進先進封裝能力的目標,預計到2024年底,其CoWoS封裝產能將達到每月3.2萬片,而到2025年底將進一步增至每月4.4萬片。
2024-01-25 11:12:23 1456
1456 2.5/3D-IC封裝是一種用于半導體封裝的先進芯片堆疊技術,它能夠把邏輯、存儲、模擬、射頻和微機電系統(tǒng) (MEMS)集成到一起,是未來封裝的發(fā)展方向。
2024-03-06 13:59:41 7843
7843 
隨著全球半導體市場的持續(xù)繁榮和技術的不斷進步,臺積電作為全球領先的半導體制造企業(yè),近日傳出正在考慮在日本建立先進的封裝產能。這一舉措不僅可能改變日本半導體產業(yè)的格局,更可能標志著臺積電首次對外輸出其獨家的CoWoS封裝技術。
2024-03-18 13:43:11 1465
1465 今年年初,臺積電總裁魏哲家曾表示,公司計劃在今年將CoWoS的產量翻倍,并在2025年繼續(xù)擴大產能。日本已成為臺積電擴大產能的重要目標。
2024-03-18 15:31:42 1700
1700 CoWoS-L結合CoWoS-S和InFO技術優(yōu)點,成本介于CoWoS-S、CoWoS-R之間,中介層使用LSI(本地硅互聯(lián))芯片來實現(xiàn)密集的芯片與芯片連接。
2024-04-02 12:49:35 2336
2336 盡管英偉達計劃在下半年推出GB200和B100等新品,但由于需要采用更高精度的CoWoS-L技術進行封裝,且驗證測試過程相對繁瑣,因此集邦資訊預測這些產品可能會推遲到今年四季度或明年初才能實現(xiàn)大規(guī)模生產。
2024-04-17 10:23:16 908
908 基于 CoWoS-R 技術的 UCIe 協(xié)議與 IPD 的高速互連是小芯片集成和 HPC 應用的重要平臺。
2024-04-20 17:48:37 2940
2940 
據悉,臺積電近期發(fā)布的2023年報詳述其先進制程與先進封裝業(yè)務進展,包括N2、N3、N4、N5、N6e等工藝節(jié)點,以及SoIC CoW、CoWoS-R、InFO_S、InFO_M_PoP等封裝技術。
2024-04-25 15:54:58 1797
1797 在封裝技術的研發(fā)道路上,臺積電從未停止過前進的腳步。而除了CoWoS封裝技術的巨大進展,該公司還首次對外公布了其A16制程工藝。
2024-04-28 16:08:58 1591
1591 新版CoWoS技術使得臺積電能制造出面積超過光掩模(858平方毫米)約3.3倍的硅中介層。因此,邏輯電路、8個HBM3/HBM3E內存堆棧、I/O及其他小芯片最多可占據2831平方毫米的空間。
2024-04-29 16:21:54 1228
1228 英偉達占據全球AI GPU市場約80%的份額,根據集邦咨詢預測,到2024年,臺積電CoWoS月產能有望增至4萬片,并在明年底實現(xiàn)翻番。然而,隨著英偉達B100和B200芯片的問世,單片硅中介層面積增大,CoWoS產能依然吃緊。
2024-05-20 11:58:06 1082
1082 行業(yè)觀察者預測,英偉達即將推出的B系列產品,如GB200, B100, B200等,將對CoWoS封裝產能產生巨大壓力。據IT之家早前報道,臺積電已計劃在2024年提高CoWoS產能至每月近4萬片,較去年增長逾150%。
2024-05-20 14:39:06 1250
1250 共讀好書 芯片封裝由 2D 向 3D 發(fā)展的過程中,衍生出多種不同的封裝技術。其中,2.5D 封裝是一種先進的異構芯片封裝,可以實現(xiàn)從成本、性能到可靠性的完美平衡。 目前 CoWoS 封裝技術
2024-06-05 08:44:09 1792
1792 英偉達(NVIDIA)、AMD等大廠AI芯片熱銷,先進封裝產能供不應求,業(yè)界傳出,臺積電南科嘉義園區(qū)CoWoS新廠正進入環(huán)差審查階段,即開始采購設備,希望能加快先進封裝產能建置腳步,以滿足客戶需求
2024-06-14 10:10:57 969
969 近日,臺積電在中國臺灣嘉義科學園區(qū)規(guī)劃建設的兩座CoWoS先進封裝廠的建設工作遭遇波折。原計劃中,第一座CoWoS廠已于今年5月動工,進行地質勘探工作。然而,施工現(xiàn)場卻在6月初因發(fā)現(xiàn)疑似遺跡而暫停施工。
2024-06-19 14:45:12 1262
1262 來源:綜合 日月光投控6月26日召開股東會, 首席運營官(COO)吳田玉表示,到2025年AI先進封裝需求持續(xù)強勁,今年AI相關CoWoS先進封裝營收,會比原先預期增加2.5億美元以上 ,包括
2024-06-27 15:03:26 1002
1002 臺積電,作為全球領先的半導體制造巨頭,正加速推進其CoWoS(Chip On Wafer On Substrate)封裝技術的產能擴張計劃。據最新消息,臺積電已在臺灣地區(qū)云林縣虎尾園區(qū)選定了一塊建設用地,用于建設先進的封裝廠,以應對AI及高性能運算芯片市場日益增長的需求。
2024-07-03 09:20:40 2154
2154 近日,業(yè)界傳出重大消息,谷歌手機的自研芯片Tensor G5計劃轉投臺積電的3nm制程,并引入臺積電先進的InFO封裝技術。這一決策預示著谷歌將在智能手機領域進一步提升競爭力,尤其是針對高端人工智能(AI)手機市場。
2024-08-06 09:20:52 1232
1232 近日,據臺灣媒體報道,全球領先的半導體制造巨頭臺積電在先進封裝技術領域邁出了重要一步,首次將CoWoS封裝技術中的核心CoW(Chip on Wafer)步驟的代工訂單授予了矽品精密工業(yè)股份有限公司。這一決策標志著臺積電在提升CoWoS整體產能、應對市場供不應求挑戰(zhàn)方面邁出了關鍵性的一步。
2024-08-07 17:21:55 1382
1382 CoWoS(Chip-on-Wafer-on-Substrate)是一種先進的半導體封裝技術,它結合了芯片堆疊與基板連接的優(yōu)勢,實現(xiàn)了高度集成、高性能和低功耗的封裝解決方案。以下是對CoWoS封裝技術的詳細解析,包括其定義、工作原理、技術特點、應用領域以及未來發(fā)展趨勢等方面。
2024-08-08 11:40:58 9537
9537 8月16日,據聯(lián)合新聞網最新消息,臺積電位于嘉義科學園區(qū)的兩座CoWoS封裝工廠,在經歷因考古發(fā)現(xiàn)而暫停施工的波折后,現(xiàn)已正式獲得批準重啟建設進程。這一決定標志著臺積電在推動其先進封裝技術布局上的重要一步。
2024-08-16 15:56:48 1255
1255 據DIGITIMES研究中心最新發(fā)布的《AI芯片特別報告》顯示,在AI芯片需求激增的推動下,先進封裝技術的成長勢頭已超越先進制程,成為半導體行業(yè)的新焦點。特別是臺積電(TSMC)的CoWoS封裝技術
2024-08-21 16:31:33 1500
1500 先進封裝解決方案的激增需求,臺積電正全力加速擴充其CoWoS(Chip-on-Wafer-on-Substrate)封裝產能。
2024-09-06 17:20:10 1356
1356 臺灣電子材料領域的領軍企業(yè)華立(3010-TW)正積極搭乘全球CoWoS(Chip-on-Wafer-on-Substrate)封裝技術的擴產浪潮。張尊賢近日表示,華立的CoWoS封裝材料已成功打入
2024-09-06 17:34:21 1483
1483 據業(yè)內人士透露,臺積電正加速將一座工廠改造成先進的CoWoS封裝廠,以滿足英偉達對高端封裝技術的強勁需求。這一舉措顯示出臺積電在封裝技術領域的布局正在加速推進。
2024-10-14 16:12:38 1014
1014 CoWoS(Chip-on-Wafer-on-Substrate),指的是將多個裸片(die)集成在一個TSV轉換板(interposer)上,然后將這個interposer連接到一個基板上。CoWoS是一種先進的3D-IC封裝技術,用于高性能和高密度集成的系統(tǒng)級封裝。
2024-10-18 14:41:43 5219
5219 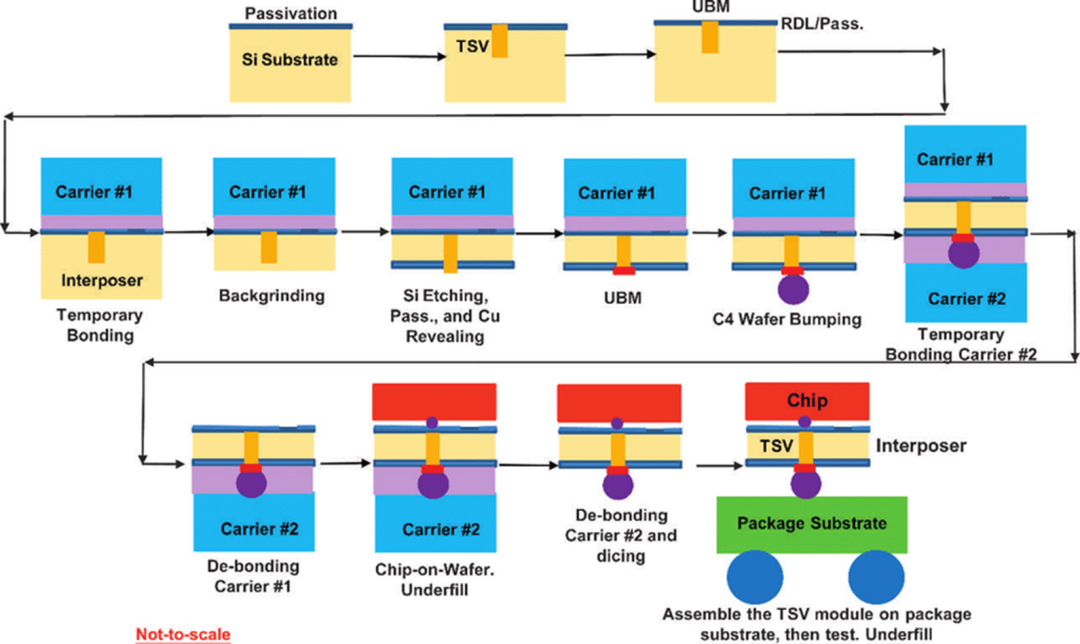
近日,潤欣科技發(fā)布公告稱,公司已與奇異摩爾正式簽署了《CoWoS-S異構集成封裝服務協(xié)議》。這一協(xié)議的簽署標志著雙方在CoWoS-S異構集成領域將展開深度的商業(yè)合作,共同推動技術創(chuàng)新與業(yè)務發(fā)展。
2024-10-30 16:44:56 3163
3163 據DIGITIMES Research的分析,由于云端AI加速器市場需求旺盛,預計到2025年,全球對CoWoS及其類似封裝技術的產能需求將激增113%。
為了應對這一需求增長,主要供應商
2024-10-31 13:54:55 1822
1822 來源:摘編自集微網 據研究機構DIGITIMES Research稱,受云端AI加速器需求旺盛推動,2025年全球對CoWoS及類似封裝產能的需求或將增長113%。 主要供應商臺積電、日月光科技控股
2024-11-14 17:54:34 916
916 在11月的歐洲開放創(chuàng)新平臺(OIP)論壇上,臺積電宣布了一項重要的技術進展。據透露,該公司有望在2027年推出超大版本的CoWoS(晶圓上芯片)封裝技術。
2024-12-02 10:20:14 870
870 隨著人工智能、高性能計算為代表的新需求的不斷發(fā)展,先進封裝技術應運而生,與傳統(tǒng)的后道封裝測試工藝不同,先進封裝的關鍵工藝需要在前道平臺上完成,是前道工序的延伸。CoWoS作為英偉達-這一新晉市值冠軍
2024-12-17 10:44:27 4456
4456 
封裝的未來變得模糊 – 扇出、ABF、有機中介層、嵌入式橋接 – 先進封裝第 4 部分 2.1D、2.3D 和 2.5D 先進封裝的模糊界限。在 IMAPS 2022 上,展示了該領域的許多
2024-12-21 15:33:52 4573
4573 
近日,臺積電宣布了其先進封裝技術的擴產計劃,其中CoWoS(Chip-on-Wafer-on-Substrate)制程將成為此次擴產的主力軍。隨著對群創(chuàng)舊廠的收購以及相關設備的進駐,以及臺中廠產能
2025-01-02 14:51:49 1173
1173 臺積電先進封裝大擴產,其中CoWoS制程是擴充主力。隨著群創(chuàng)舊廠購入后設備進機與臺中廠產能擴充,2025年臺積電CoWoS月產能將上看7.5萬片。 行業(yè)調研機構semiwiki分析稱,臺積電在
2025-01-07 17:25:20 860
860 前言 一、CoWoS 技術概述 定義與結構:CoWoS(Chip on Wafer on Substrate)是一種 2.5D 先進封裝技術,由 Chip on Wafer(CoW)和基板
2025-01-14 10:52:25 5403
5403 
近日,天風證券知名分析師郭明錤在其個人博文中,針對英偉達最新調整的Blackwell架構藍圖,提出了自己的見解。 郭明錤指出,根據英偉達的最新動向,該公司在未來一年內,將顯著降低對CoWoS-S封裝
2025-01-16 15:03:04 867
867 一、技術前沿探索:從微小到宏大的CoWoS封裝技術演進 在半導體技術的浩瀚星空中,每一次技術的革新都如同星辰般璀璨奪目。去年臺積電在歐洲開放創(chuàng)新平臺(OIP)論壇上透露的超大版本CoWoS(晶圓上
2025-01-17 12:23:54 1966
1966 英偉達(NVIDIA)執(zhí)行長黃仁勛于16日出席矽品潭科廠啟用揭牌典禮,贊嘆臺灣的合作伙伴快速建置大量CoWoS產能。他也強調,并沒有縮減對CoWoS產能需求的問題,而是增加產能,并轉換為有多一些對于
2025-01-21 13:09:51 680
680 近日,據最新業(yè)界消息,臺積電計劃在南科三期再建兩座CoWoS新廠,預計投資金額將超過2000億元新臺幣。這一舉措不僅彰顯了臺積電在先進封裝技術領域的持續(xù)投入,也對其近期CoWoS砍單傳聞做出了實際擴
2025-01-21 13:43:39 877
877 近期,半導體封裝巨頭日月光投控在先進封裝領域再次邁出重要一步,宣布將擴大其CoWoS(Chip-on-Wafer-on-Substrate)先進封裝產能,并與AI芯片巨頭英偉達的合作更加緊密。
2025-02-08 14:46:18 1207
1207 盡管全球政治經濟形勢充滿不確定性,半導體業(yè)內人士仍對臺積電未來五年的先進封裝擴張戰(zhàn)略保持樂觀態(tài)度,特別是其CoWoS(Chip-on-Wafer-on-Substrate)封裝技術的生產能力預計將保持穩(wěn)定增長。
2025-02-08 15:47:38 901
901 在先進封裝技術向超大型、晶圓級系統(tǒng)集成深化演進的過程中,InFO 系列(InFO-MS、InFO-3DMS)與 CoWoS-L、InFO_SoW 等技術持續(xù)突破創(chuàng)新。
2025-08-25 11:25:30 990
990 
InFO-R作為基礎架構,采用"芯片嵌入+RDL成型"的工藝路徑。芯片在晶圓級基板上完成精準定位后,通過光刻工藝直接在芯片表面構建多層銅重布線層(RDL),線寬/線距(L/S)可壓縮至2μm/2μm級別。
2025-09-01 16:10:58 2543
2543 
在半導體行業(yè)追逐更高算力、更低成本的賽道上,先進封裝技術成了關鍵突破口。過去幾年,臺積電的CoWoS(Chip-on-Wafer-on-Substrate)技術憑借對AI芯片需求的精準適配,成了先進
2025-09-03 13:59:35 2740
2740 
HBM通過使用3D堆疊技術,將多個DRAM(動態(tài)隨機存取存儲器)芯片堆疊在一起,并通過硅通孔(TSV,Through-Silicon Via)進行連接,從而實現(xiàn)高帶寬和低功耗的特點。HBM的應用中,CowoS(Chip on Wafer on Substrate)封裝技術是其中一個關鍵的實現(xiàn)手段。
2025-09-22 10:47:47 1618
1618 臺積電在先進封裝技術,特別是CoWoS(Chip on Wafer on Substrate)平臺上的微通道芯片液冷技術路線,是其應對高性能計算和AI芯片高熱流密度挑戰(zhàn)的關鍵策略。本報告將基于臺積電相關的研究成果和已發(fā)表文獻,深入探討其微通道芯片封裝液冷技術的演進路線。
2025-11-10 16:21:42 2390
2390 
隨著高性能計算(HPC)、人工智能(AI)和大數據分析的快速發(fā)展,諸如CoWoS(芯片-晶圓-基板)等先進封裝技術對于提升計算性能和效率的重要性日益凸顯。
2025-11-11 17:03:17 2358
2358 
燒錄、封裝后故障定位四大難題。解決方案包括設計 - 測試協(xié)同、多物理場仿真驗證、多協(xié)議協(xié)同燒錄、數據閉環(huán)智能診斷。CoWoS 大規(guī)模落地的關鍵,在于突破測試成本、標準及故障分析等瓶頸,構建適配微系統(tǒng)的智能認證體系。
2025-12-11 16:06:02 227
227 先進封裝競賽中,CoWoS 產能與封測低毛利的反差,凸顯檢測測試的關鍵地位。2.5D/3D 技術帶來三維缺陷風險,傳統(tǒng)檢測失效,面臨光學透視量化、電性隔離定位及效率成本博弈三大挑戰(zhàn)。解決方案在于構建
2025-12-18 11:34:40 198
198 摘要:由于半導體行業(yè)體系龐大,理論知識繁雜,我們將通過多個期次和專題進行全面整理講解。本專題主要從AI芯片發(fā)展關鍵痛點就是:CoWoS封裝散熱進行講解,讓大家更準確和全面的認識半導體地整個行業(yè)體系
2025-12-24 09:21:54 440
440 
摘要:由于半導體行業(yè)體系龐大,理論知識繁雜,我們將通過多個期次和專題進行全面整理講解。本專題主要從CoWoS封裝的中階層是關鍵——SiC材料進行講解,讓大家更準確和全面的認識半導體地整個行業(yè)體系
2025-12-29 06:32:07 485
485 


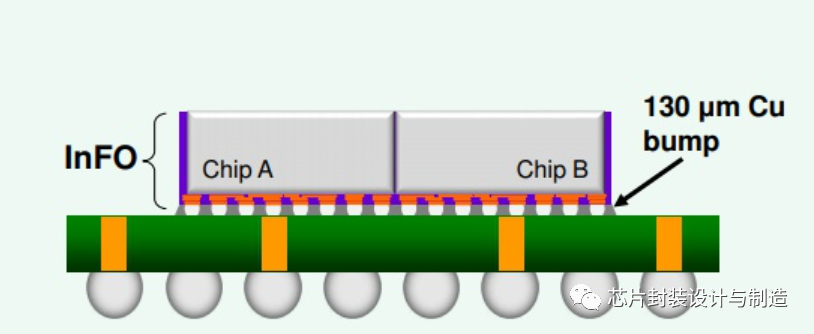

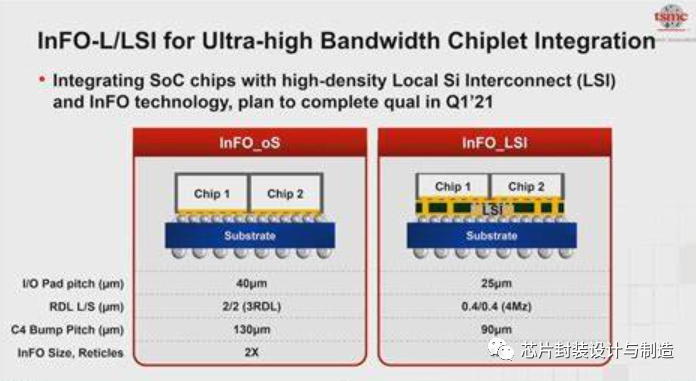
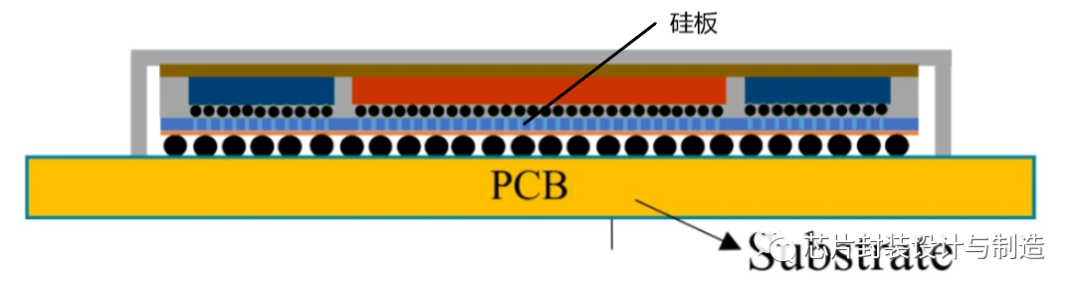
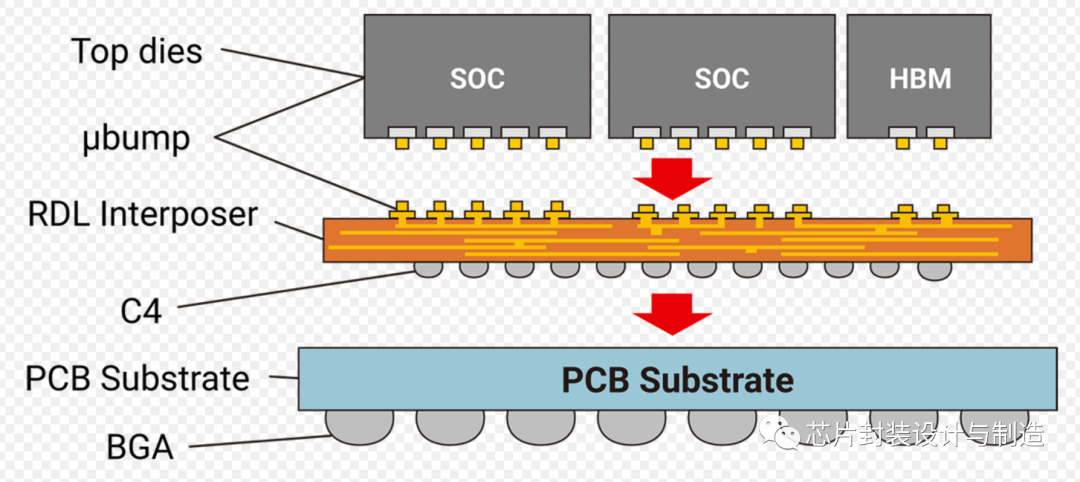
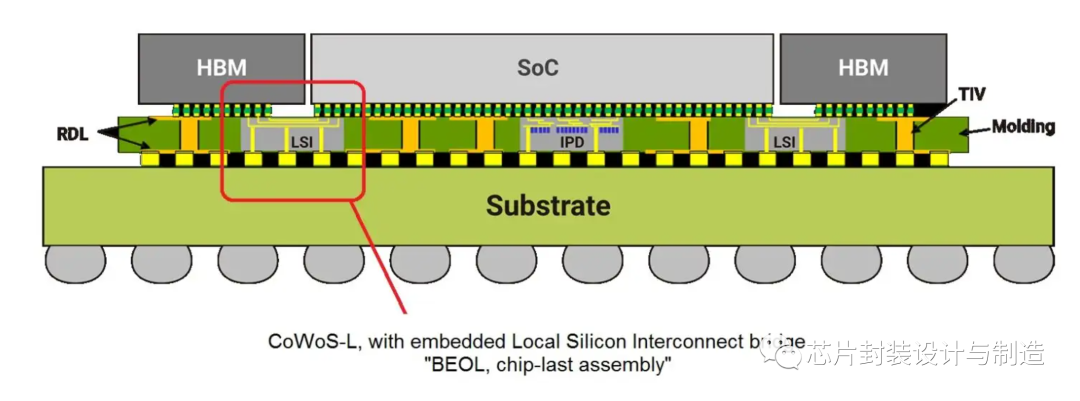
 電子發(fā)燒友App
電子發(fā)燒友App









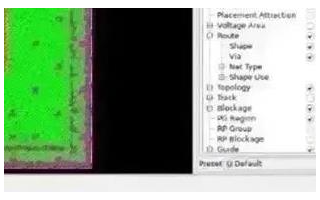
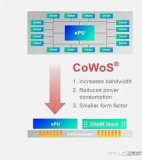

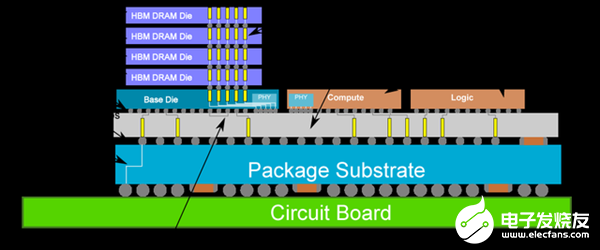


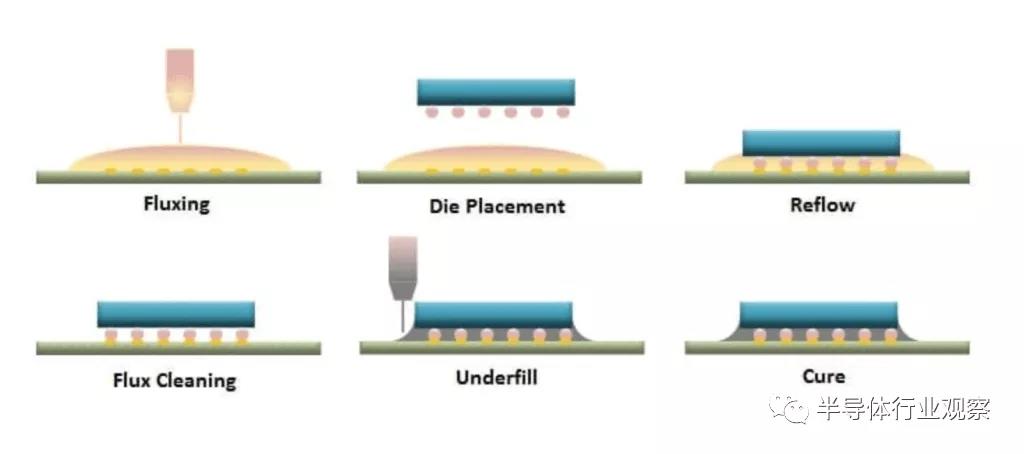


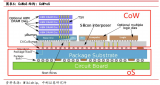
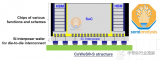
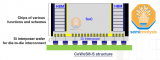

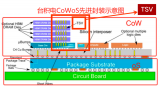

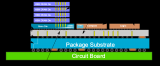





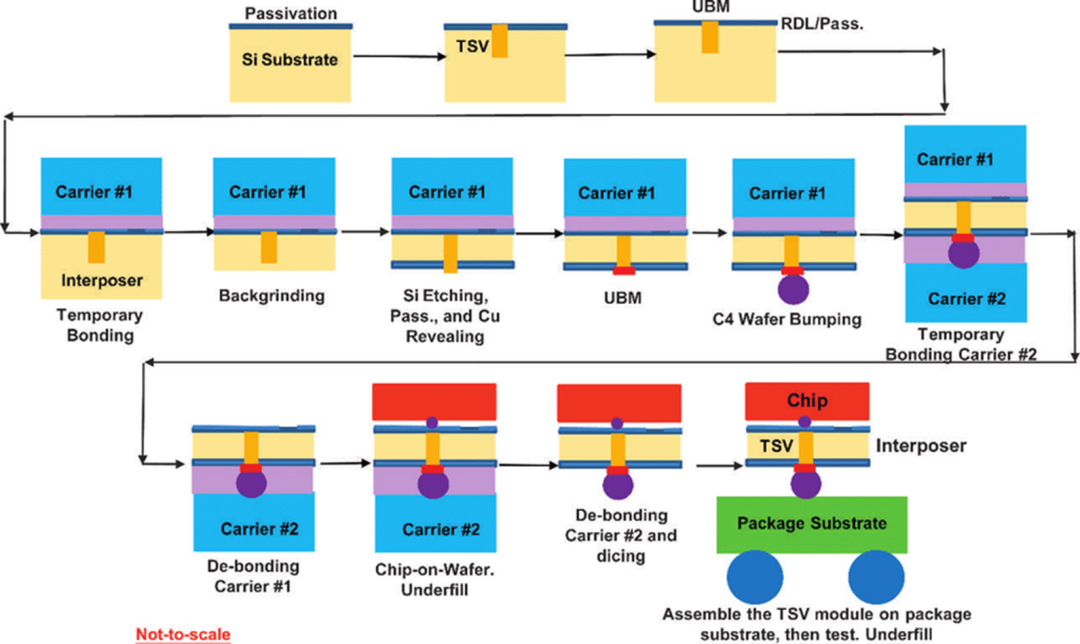












評論