據媒體報道,作為全球一號代工廠,臺積電已經開始大規模量產第六代CoWoS晶圓級芯片封裝技術,集成度大大提高。
我們知道,如今的高端半導體芯片越來越復雜,傳統的封裝技術已經無法滿足,Intel、臺積電、三星等紛紛研發了各種2.5D、3D封裝技術,將不同IP模塊以不同方式,整合封裝在一顆芯片內,從而減低制造難度和成本。
CoWoS的全稱為Chip-on-Wafer-on-Substrate,是一種將芯片、基底都封裝在一起的技術,并且是在晶圓層級上進行,目前只有臺積電掌握,技術細節屬于商業機密。
它屬于2.5D封裝技術,常用于HBM高帶寬內存的整合封裝,比如AMD Radeon VII游戲卡、NVIDIA V100計算卡都屬于此類。
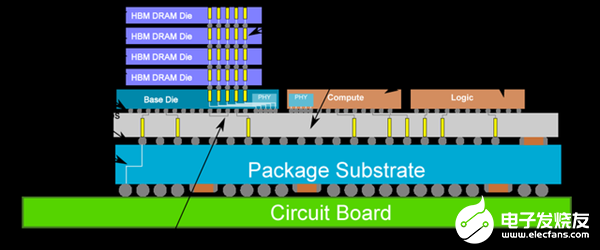
CoWoS封裝結構簡圖
臺積電當然也不會披露第六代CoWoS的細節,只是說可以在單個封裝內,集成多達12顆HBM內存。
最新的HBM2E已經可以做到單顆容量16GB,12顆封裝在一起那就是海量的192GB!
責任編輯:gt
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54010瀏覽量
466096 -
臺積電
+關注
關注
44文章
5803瀏覽量
176332 -
晶圓
+關注
關注
53文章
5410瀏覽量
132296 -
封裝
+關注
關注
128文章
9249瀏覽量
148628
發布評論請先 登錄
相關推薦
熱點推薦
HBM技術在CowoS封裝中的應用
HBM通過使用3D堆疊技術,將多個DRAM(動態隨機存取存儲器)芯片堆疊在一起,并通過硅通孔(TSV,Through-Silicon Via)進行連接,從而實現高帶寬和低功耗的特點。HBM的應用中,
什么是晶圓級扇入封裝技術
在微電子行業飛速發展的背景下,封裝技術已成為連接芯片創新與系統應用的核心紐帶。其核心價值不僅體現于物理防護與電氣/光學互聯等基礎功能,更在于應對多元化市場需求的適應性突破,本文著力介紹晶圓

臺積電最大先進封裝廠AP8進機
。改造完成后AP8 廠將是臺積電目前最大的先進封裝廠,面積約是此前 AP5 廠的四倍,無塵室面積達 10 萬平方米。 臺



 臺積電第六代CoWoS晶圓級芯片封裝量產,單封裝內集成多達12顆HBM內存
臺積電第六代CoWoS晶圓級芯片封裝量產,單封裝內集成多達12顆HBM內存















評論