摘要:由于半導體行業體系龐大,理論知識繁雜,我們將通過多個期次和專題進行全面整理講解。本專題主要從AI芯片發展關鍵痛點就是:CoWoS封裝散熱進行講解,讓大家更準確和全面的認識半導體地整個行業體系。我們分為半導體知識、半導體“芯”聞幾個模塊,歡迎各位大佬交流學習。
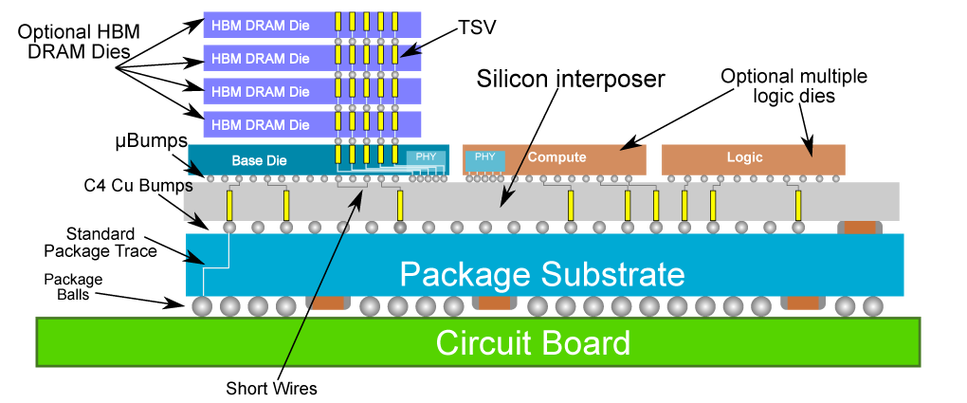
英偉達算力芯片功率持續上升,對散熱提出更高要求
根據Nvidia、KAIST、tomshardware,以單die維度,H100單位面積功率約0.86w/mm2,Rubin 約1.1w/mm2,下一代Feynman約 1.2w/mm2,未來的架構甚至將沖高至2w/mm2,將是H100的233%。 我們認為伴隨著多die和更多HBM的設計,熱傳導的壓力進一步加大,材料中的熱導率等性能變得更加關鍵。
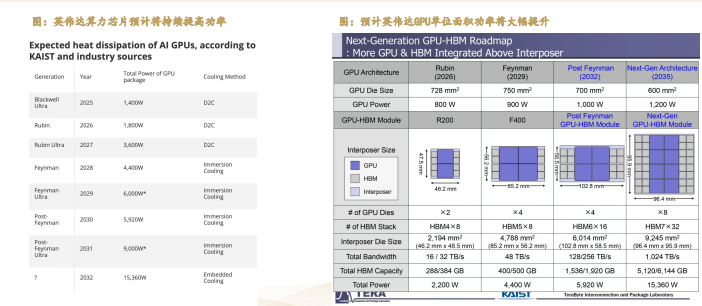
芯片發展遭遇“功耗墻”制約,散熱是核心制約之一
根據《高算力Chiplet的熱管理技術研究進展》,在微處理器40多年的發展中,晶體管數量呈指數級增加,但是典型的熱設計功耗 (TDP)在最近20年基本保持在100~200W,導致芯片性能提升緩慢,集成電路發展受到“功耗墻”的嚴重制約。相比于SoC,基 于異質集成先進封裝的Chiplet 可以實現更大面積、更多功能、更高密度的芯片集成,但也導致總熱功耗增加、熱分布不均、封裝中 的熱輸運困難,同時存在嚴重的多物理場耦合效應,給熱管理帶來了更加嚴峻的挑戰。根據Yole,英偉達和AMD在追求算力大幅提升的情況下,不得不繼續提高芯片功率。

AI芯片與HBM存儲緊密結合,熱量堆積可能產生更多問題根據
Nature,硅基器件中的熱傳輸基礎為了冷卻產生的熱點,熱量必須從產生點或局部最大值沿著系統中的熱梯度轉移。熱傳遞的 兩個最重要的材料屬性是熱容和熱導率。傳統層間介電材料提供的熱絕緣進一步阻礙了散熱,惡化了局部熱點問題。這些挑戰會導 致結溫升高、器件性能下降以及過早失效的可能性增大。 ? 根據三星電子相關論文,HBM 的溫度升高可歸因于環境溫升(32%)、HBM 自身熱阻(19%)、HBM 上方散熱環境(約 11%) 以及來自 ASIC 的熱耦合(38%)。
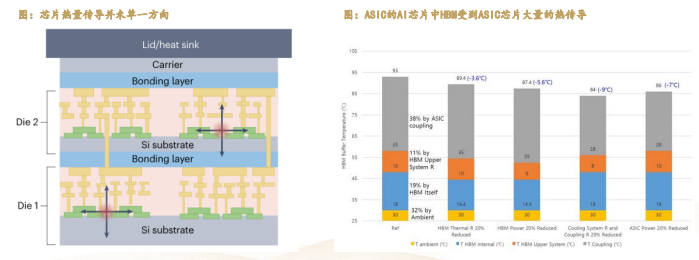
AI芯片因高速鏈接需求,基本上離不開CoWoS封裝
根據Semianalysis,HBM 和 CoWoS 是互補的。HBM 的高焊盤數量和短走線長度要求需要像 CoWoS 這樣的 2.5D 先進封裝技術來 實現在 PCB 甚至封裝基板上無法完成的如此密集、短的連接。CoWoS是主流的封裝技術,以合理的成本提供最高的互連密度和最 大的封裝尺寸。由于目前幾乎所有的 HBM 系統都封裝在 CoWoS 上,并且所有先進的 AI 加速器都使用 HBM,因此推論幾乎所有 領先的數據中心 GPU 都由臺積電封裝在 CoWoS 上。 ? 根據半導體產業縱橫,HBM(高帶寬內存)已是 AI 芯片的標配,但它不是隨便一個封裝就能適配。HBM 必須與處理器核心超近距 離、高帶寬連接,這需要極密的走線與超短的連接距離。CoWoS 通過中介層提供這樣的環境,讓 HBM 的帶寬(最高可 達 3.6TB/s)發揮到極致。
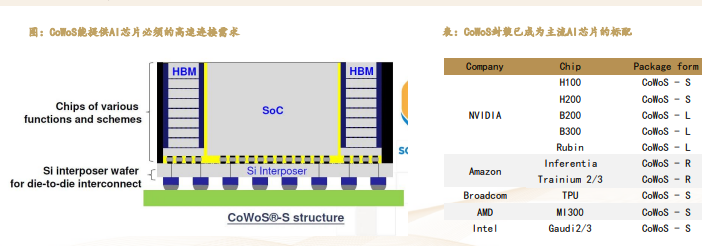
在高功率趨勢下,CoWoS中介層已面臨多項挑戰
根據Semianalysis 24年8月的報道,Blackwell 家族在實現大批量生產方面遇到了重大問題。由于臺積電的封裝問題和英偉達的設 計,原始Blackwell封裝的供應受到限制。Blackwell封裝是第一個采用臺積電CoWoS-L技術封裝的大批量設計。 ? 根據Semianalysis,CoWoS-L 是一項更復雜的技術,出現了各種各樣的問題。其中一種是與在中介層中嵌入多個Bump有關,在有 機中介層內會導致各模塊之間的熱膨脹系數 (CTE) 不匹配,從而導致翹曲。

結論梳理:解決CoWoS封裝散熱問題成為AI算力芯片發展重要課題
根據《大功率電力電子器件散熱研究綜述》,當前大功率電力電子器件正朝著高功率水平、高集成度的方向發展,因此散熱問題不 可避免的受到關注。已有研究表明,半導體芯片的溫度每升高10 ℃,芯片的可靠性就會降低一半,器件的工作溫度越高,器件的生 命周期越短。

-
CoWoS
+關注
關注
0文章
169瀏覽量
11505 -
封裝散熱
+關注
關注
0文章
2瀏覽量
7265 -
AI芯片
+關注
關注
17文章
2126瀏覽量
36766
發布評論請先 登錄
英偉達Rubin GPU采用鉆石銅散熱,解決芯片散熱難題
【深度報告】CoWoS封裝的中階層是關鍵——SiC材料

國內BLDC電機控制方案目前存在什么痛點
先進封裝市場迎來EMIB與CoWoS的格局之爭
CoWoS產能狂飆的背后:異質集成芯片的“最終測試”新范式
5G網絡通信有哪些技術痛點?
臺積電CoWoS平臺微通道芯片封裝液冷技術的演進路線

HBM技術在CowoS封裝中的應用
CoWoP能否挑戰CoWoS的霸主地位

國產AI芯片破局:國產TCB設備首次完成CoWoS封裝工藝測試
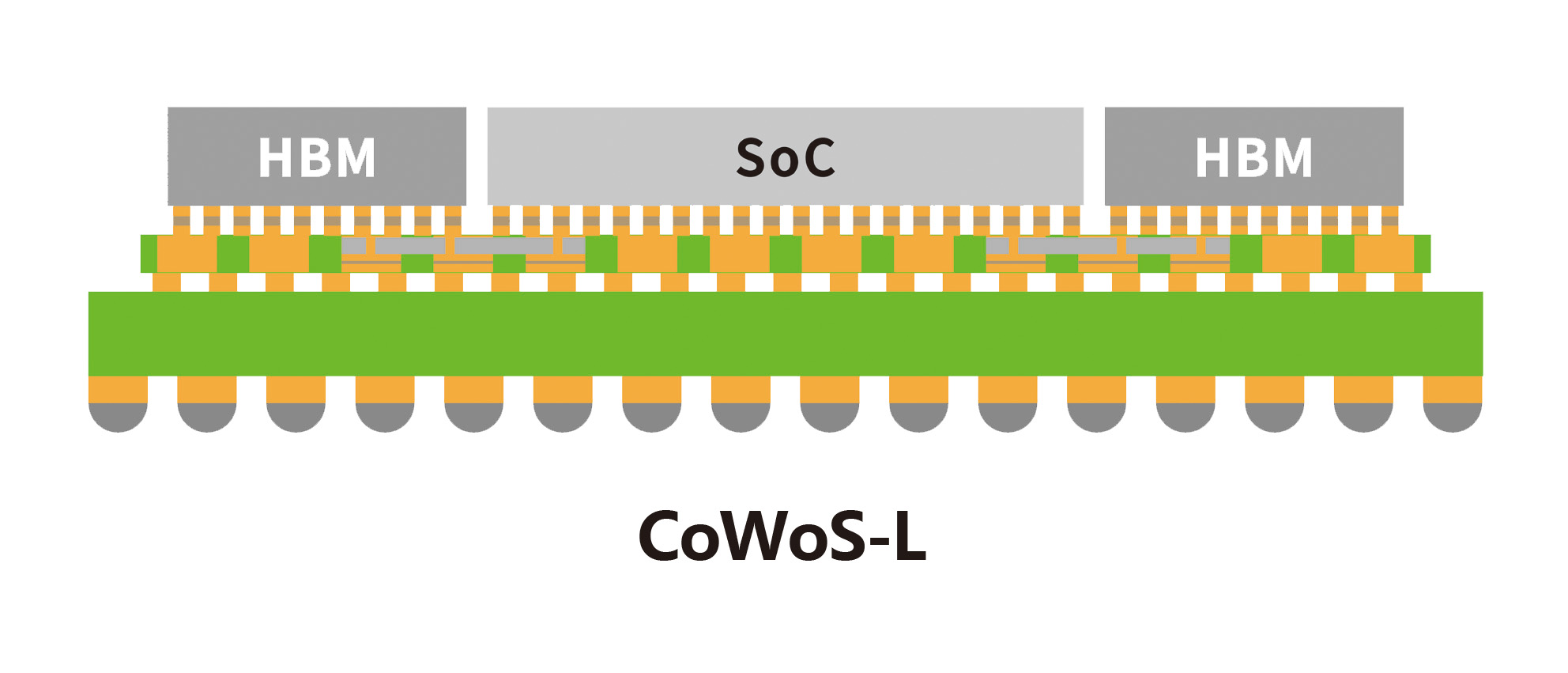



 AI芯片發展關鍵痛點就是:CoWoS封裝散熱
AI芯片發展關鍵痛點就是:CoWoS封裝散熱







評論