據工商業日報報道,AI芯片需求大幅增長,硅中間層面積擴大,間接影響了12寸晶圓的產量及CoWoS封裝供應量,供需矛盾日益突出。
不斷壯大的芯片
行業觀察者預測,英偉達即將推出的B系列產品,如GB200, B100, B200等,將對CoWoS封裝產能產生巨大壓力。據IT之家早前報道,臺積電已計劃在2024年提高CoWoS產能至每月近4萬片,較去年增長逾150%。
預計2025年總產能將再翻番。然而,英偉達新款B100與B200芯片的中間層面積增大,使得12寸晶圓切割出的芯片數量減少,CoWoS封裝產能難以滿足GPU需求。
HBM的挑戰
業界人士指出,HBM同樣面臨諸多問題。例如,SK海力士作為HBM市場占有率最高的企業,其EUV層數正逐漸增加。從1α階段的單層EUV,升級至1β階段,甚至有望將EUV使用量提升3~4倍。
此外,隨著HBM的多次迭代,DRAM數量亦隨之增加。HBM2中DRAM數量為4~8個,HBM3/3E則增至8~12個,而HBM4中DRAM數量將達到16個。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
CoWoS
+關注
關注
0文章
169瀏覽量
11506 -
HBM
+關注
關注
2文章
431瀏覽量
15836 -
AI芯片
+關注
關注
17文章
2128瀏覽量
36785
發布評論請先 登錄
相關推薦
熱點推薦
產能過剩還是供不應求?深度解析全球芯片代工市場現狀
芯片卻供不應求,先進封裝產能更是爭奪焦點。這一分化源于頭部代工廠戰略投資向先進制程和區域化成熟產能轉移,行業正處重置再平衡周期,中長期 AI、汽車電子等將成
IBM咨詢解析AI時代全球半導體發展趨勢
當 AI 成為驅動全球產業升級的核心引擎,半導體作為 “算力基石” 的價值被推至新高度。算力躍升為全球硬通貨,但由于全球生產和資源瓶頸,芯片供不應求。全球半導體產業正站在轉型
AI芯片發展關鍵痛點就是:CoWoS封裝散熱
摘要:由于半導體行業體系龐大,理論知識繁雜,我們將通過多個期次和專題進行全面整理講解。本專題主要從AI芯片發展關鍵痛點就是:CoWoS封裝散熱進行講解,讓大家更準確和全面的認識半導體地

AI存儲需求猛增,美光Q1業績飆升57%!2026年HBM3E產能告罄
12月17日,美國存儲大廠美光科技公布2026財年第一季度財報(截止11月27日的三個月),受惠于AI數據中心需求爆發,AI服務器對HBM和DDR5強勁

先進封裝市場迎來EMIB與CoWoS的格局之爭
技術悄然崛起,向長期占據主導地位的臺積電CoWoS方案發起挑戰,一場關乎AI產業成本與效率的技術博弈已然拉開序幕。 ? 在AI算力
HBM技術在CowoS封裝中的應用
HBM通過使用3D堆疊技術,將多個DRAM(動態隨機存取存儲器)芯片堆疊在一起,并通過硅通孔(TSV,Through-Silicon Via)進行連接,從而實現高帶寬和低功耗的特點。HBM
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+AI芯片的需求和挑戰
②Transformer引擎③NVLink Switch系統④機密計算⑤HBM
FPGA:
架構的主要特點:可重構邏輯和路由,可以快速實現各種不同形式的神經網絡加速。
ASIC:
介紹了幾種ASIC AI芯片
發表于 09-12 16:07
CoWoP能否挑戰CoWoS的霸主地位
在半導體行業追逐更高算力、更低成本的賽道上,先進封裝技術成了關鍵突破口。過去幾年,臺積電的CoWoS(Chip-on-Wafer-on-Substrate)技術憑借對

AI算力催熱光模塊,光芯片龍頭H1凈利潤翻17倍
,不僅推動了技術創新,還促進了產品迭代升級,以滿足全球市場尤其是800G乃至1.6T光模塊日益增長的需求。就在今年上半年,中際旭創、新易盛以及仕佳光子等企業實現了業績的增長。 ? 800G / 1.6T 光模塊

國產AI芯片破局:國產TCB設備首次完成CoWoS封裝工藝測試
,高端GPU的國產化制造成為中國AI產業發展的關鍵挑戰,尤其是CoWoS先進封裝制程的自主化尤為緊迫,目前中國大陸產能極少,且完全依賴進口設備,這一瓶頸嚴重制約著國產AI發展進程。在此
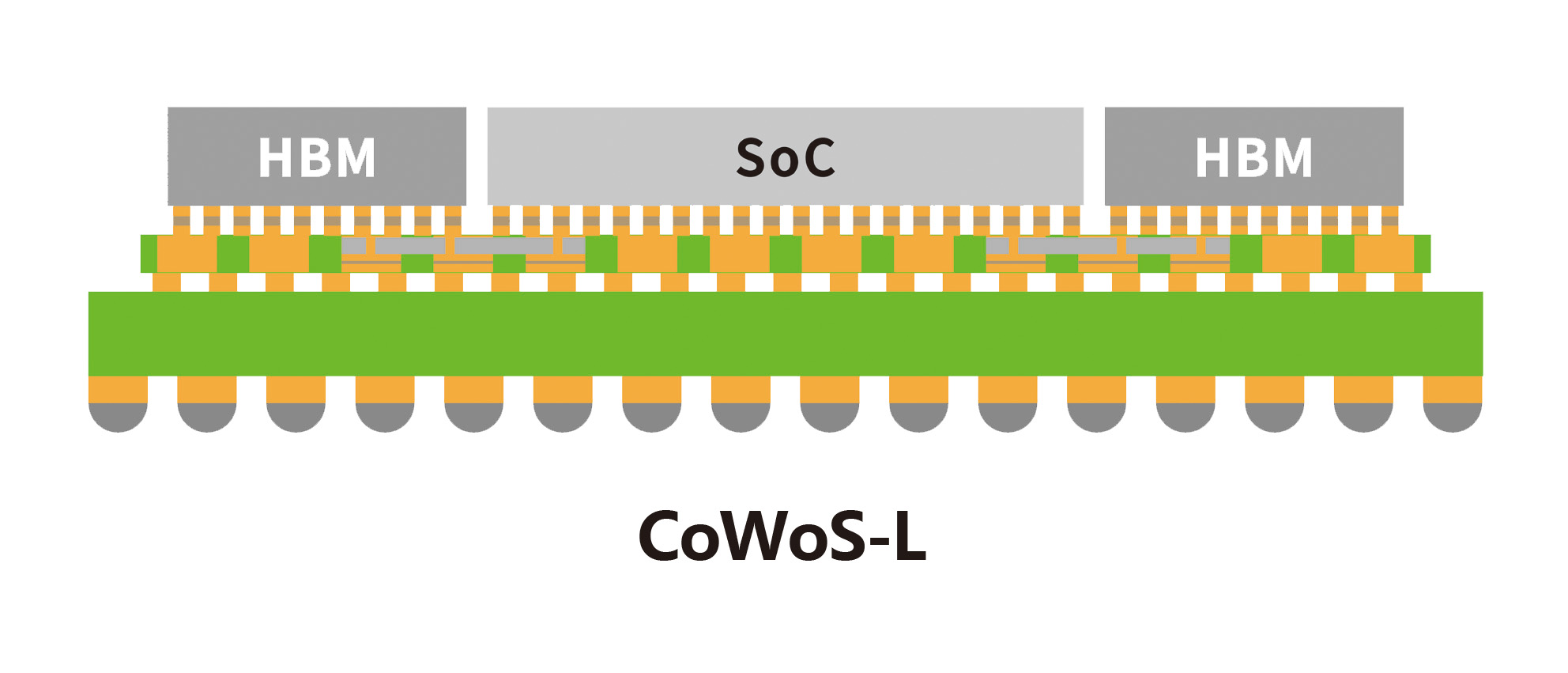
4月1日起漲價超10%,閃迪預計存儲供不應求
示,存儲芯片行業很快將過渡到供不應求狀態,再加上近期的關稅變化,將影響供應的可用性并增加Sandisk的業務成本。因此決定從4月1日起開始實施價格上漲,漲幅將超過10%,并適用于所有面向渠道和消費者客戶的產品。同時,還將繼續進行頻繁的定價審查,預計在接下來的季度會有額
發表于 03-10 09:10
?982次閱讀




 AI芯片需求猛增,CoWoS封裝供不應求,HBM技術難度升級
AI芯片需求猛增,CoWoS封裝供不應求,HBM技術難度升級








評論