2.5D及3D IC制程解決方案已經逐漸成熟,產業界目前面臨最大的挑戰是量產能力如何提升,業界預估明后年3D IC可望正式進入量產。
2013-07-23 11:24:32 1279
1279 裸眼3D顯示器被廣泛應用于廣告、傳媒、示范教學、展覽展示以及影視等各個不同領域。區別于傳統的雙目3D顯示技術,裸眼3D顯示由于擁有其裸眼的獨特特性,即不需要觀眾佩戴眼鏡或頭盔便可觀賞3D效果。
2016-01-27 13:45:27 61406
61406 · 新思科技Custom Design Platform為三星7LPP工藝技術提供經認證的工具、PDK、仿真模型、運行集(runsets)以及定制參考流程。
· 新思科技Custom
2018-07-18 11:46:35 8001
8001 先進封裝從MCM發展到2.5D/3D堆疊封裝,目前發展最快的制造商是TSMC。TSMC從Foundry端延伸入2.5D/3D先進封裝,稱為3D Fabric。近十年來TSMC的2.5D先進封裝技術
2022-10-26 10:21:37 5940
5940 隨著摩爾定律接近物理極限,半導體產業正在向2.5D和3D集成電路等新型技術方向發展。在2.5D集成技術中,多個Chiplet通過微凸點、硅通孔和重布線層放置在中介層上。這種架構在異構集成方面具有優勢,但同時在Chiplet布局優化和溫度管理方面帶來了挑戰[1]。
2025-02-12 16:00:06 2206
2206 
效果,那就需要應用到裸眼3D技術。 ? 裸眼3D顯示原理 ? 相比電影院中需要3D眼鏡參與才能看到3D圖像,裸眼3D顯示技術的最大優勢就是無需借助任何輔助設備即可觀看三維立體影像效果,而且還有120度的可視角度。并且對環境光線沒有任何要求,具有較高的亮
2023-07-17 00:01:00 3119
3119 、性能更高,也因此成了新的設計主流,席卷了AI、服務器與汽車芯片等市場。但新的設計方案除了需要新一代的die-to-die的接口IP、2.5D/3D的封裝技術外,也需要在EDA工具與工作流上做出創新。 ? 西門子3D IC設計流工具 ? 為了解決3DIC集成在設計工具上
2023-11-09 00:22:00 2672
2672 3DIC Compiler協同設計與分析解決方案結合新思科技IP,加速英特爾代工EMIB技術的異構集成 摘要: 新思科技人工智能(AI)驅動型多裸晶芯片(Multi-die)設計參考流程已擴展至
2024-07-09 13:42:31 1308
1308 景深和立體感上強過電影院的3D效果。 下面筆者就簡單介紹一下如何通過幀連續(Frame sequential)功能實現與3D藍光播放機的連接。一、準備工作三星3D顯示器SA9503D藍光播放機三星
2011-08-20 14:30:01
殼,防止手機的跌落及刮痕。這款三星note8手機殼會不會超級貴,質量可信嗎?提供這款三星Note 8手機殼的是一家韓國頂級科研公司,從2012年起一直致力于裸眼3D智能研發,并且一直與韓國三星這樣
2017-11-27 12:00:18
,3D封裝將產生巨大的影響。日前,AMD在其2020年財務分析師日發布了其新型的封裝技術——X3D封裝,據悉,該技術是將3D封裝和2.5D封裝相結合。AMD稱其X3D芯片封裝技術將把其MCM帶入三
2020-03-19 14:04:57
控制在立體顯示的視覺舒適區內,有助于管理DLP? 技術多視角顯示應用的VAC。圖1:自動立體顯示多視角解決方案 通過刺激人類視覺系統(HVS)中的雙目線索,3D顯示系統使用戶能夠以更強的三維感體驗內容
2022-11-07 07:32:53
! 那么今年China Joy MM們最關注的是什么呢?當然是核心話題“3D”啦,本次展會最大的顯示器贊助商三星提供了800多臺顯示器在整個展會,其中3D顯示器體驗區是最吸引China Joy MM們的地區,下面就來看一下三星3D顯示器與China Joy MM們的故事吧!
2011-08-03 15:20:00
:“BeSang創立于三年前,是家專門做3D IC技術的公司, BeSang即將實現單芯片3D IC工藝的商業化應用。通過在邏輯器件頂部使用低溫工藝和縱向存儲設備,每個晶圓可以制造更多的裸片,這就是裸片
2008-08-18 16:37:37
沒有讀者認識到發生在3DIC集成中的技術進步,他們認為該技術只是疊層和引線鍵合,是一種后端封裝技術。而我們該如何去拯救3DIC集成技術?
2021-04-07 06:23:51
半導體行業在超級集成的道路呈現的都是一路上升的趨勢,所以很多的人都從未想過3D IC設計與電源完整性之間會發生怎樣的糾葛。標準的做法是將新的功能塞進單個的裸片上,但是要將不同的功能集成在一個上就出
2017-09-25 10:14:10
三星啟動量產 3D電視決戰正式開火
在三星宣布正式開始量產40寸、46寸與55寸3D電視開始,全球3D電視的市場熱戰也正式引燃。由三星首
2010-01-30 10:02:58 1172
1172 主動快門式3D技術和偏光式3D技術應為看3D顯示設備還需要佩戴3D眼鏡,這讓不少用戶感覺到麻煩。裸眼3D讓用戶不用帶3D眼鏡即可看到3D畫面。
2012-02-28 09:45:17 7387
7387 
裸眼 3D 整體解決方案是一個全面的方案 , SuperD 公司在光學與材料研發 、 工藝研發 、 芯片和電子工程、圖像工程、 3D 視覺及 3D 應用等多方面都進行了深度的研發。該方案將被廣泛應
2012-08-17 13:57:55 0
0 裸眼3D:視覺盛宴何需眼鏡。裸眼3D技術是未來3D電視的發展趨勢...
2012-08-17 14:15:39 0
0 通過裸眼3D技術,你就能看到本來要借助特殊眼鏡才能觀看到的3D立體影像。很好奇吧,就讓《最新裸眼3D技術揭秘》技術專題帶你一起揭秘裸眼3D,一起了解裸眼3D技術、裸眼3D產品(含裸眼3D手機、裸眼3D顯示器、裸眼3D電視...)、裸眼3D技術特點、裸眼3D技術應用等知識吧!
2012-08-17 12:21:52

9月25日——全球電子設計創新領先企業Cadence設計系統公司(NASDAQ:CDNS)今天宣布,臺積電與Cadence合作開發出了3D-IC參考流程,該流程帶有創新的真正3D堆疊。該流程通過
2013-09-26 09:49:20 1717
1717 “裸眼3D”這一概念并不是第一次出現,早在2015年國產旗艦品牌“PPTV King 7S”手機采用6英寸2K分辨率2.5D曲面屏,裸眼3D”體驗主要包括3D影視以及3D游戲。10年前的,喬布斯在
2017-01-19 17:04:59 3517
3517 簡單來說,普通屏幕就是屏幕是一塊純平面,沒有任何弧形設計;2.5D 屏幕則為中間是平面的,但邊緣是弧形設計;而 3D 屏幕,無論是中間還是邊緣都采用弧形設計。 3D 曲面玻璃的特色符合 3
2017-09-30 09:32:34 22
22 d是three-dimensional的縮寫,就是三維圖形。裸眼3D技術是一種采用視差障壁技術、柱狀透鏡技術或者夠通過一定間隔重疊的兩塊液晶面板MLD(multi-layer display多層顯示
2017-11-10 15:22:52 6508
6508 為了緩解3D堆疊IC的挑戰,很多公司都在采用一種中間方式,即2.5D,用一種無源的硅中介層來連接各個片芯(圖2)。包括Mentor Graphics公司首席執行官Walden Rhinies在內
2018-07-20 08:47:00 13356
13356 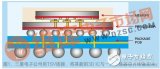
近日,三星電子面向中國市場發布了智能視覺技術的新一代產品——應用前沿裸眼3D解決方案的“瞳3D”筆記本電腦。目前,“瞳3D”筆記本電腦已經在國內線上電商平臺開售,價格為5599 元。
2017-12-13 16:05:07 5846
5846 西安3D V-NAND芯片廠是三星最大的海外投資項目之一,也是是三星第二座3D V-NAND芯片廠。今日報道,工業氣體供應商空氣產品公司將助力三星生產的3D V-NAND閃存芯片,宣布將為3D V-NAND芯片廠供氣。
2018-02-03 11:07:27 1538
1538 裸眼3D,顧名思義就是直接裸眼觀看,無需借助眼鏡等輔助工具就能產生3D視覺,這在3D潮流化的時代無疑是一大突破,把裸眼3D技術和LED超級電視結合起來更是錦上添花。
2018-03-19 11:07:12 12547
12547 裸眼3D電視采用在液晶面板前方配置雙凸透鏡的“全景圖像方式”顯示影像的內容,通過圖像處理可將已有的2D影像和3D影像(左眼和右眼的兩視差)轉換為9視差影像。從技術分類上來看,目前的裸眼3D主要分為光屏障式、柱狀透鏡、指向光源三種。
2018-03-19 11:27:54 4668
4668 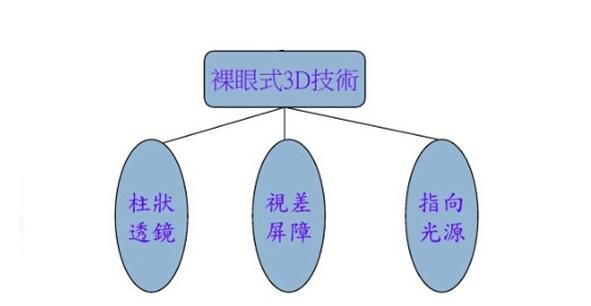
Platform支持與3D IC參考流程相結合,幫助用戶在移動計算、網絡通信、消費和汽車電子等應用中部署高性能、高連接性的多裸晶芯片技術。 新思科技Design Platform解決方案包括多裸晶芯片和中介
2018-10-27 22:14:01 828
828 記憶體的3D NAND flash大戰即將開打!目前3D NAND由三星電子獨家量產,但是先有東芝(Toshiba)殺入敵營,如今美光(Micron)也宣布研發出3D NAND,而且已經送樣,三星一家獨大的情況將劃下句點。
2018-12-13 15:07:47 1294
1294 對于目前的高端市場,市場上最流行的2.5D和3D集成技術為3D堆疊存儲TSV,以及異構堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術已經廣泛用于高性能計算
2019-02-15 10:42:19 8043
8043 
新思科技宣布新思科技設計平臺(Synopsys Design Platform)已通過臺積電最新系統整合芯片3D芯片堆棧(chip stacking)技術的認證,其全平臺的實現能力,輔以具備高彈性
2019-05-07 16:20:35 3668
3668 三星電子近日申請了Depth Vision Lens商標,據推測這或許將用于三星Galaxy Note 10 的3D ToF攝像頭。
2019-07-04 16:44:10 3519
3519 
根據臺積電在第二十四屆年度技術研討會中的說明,SoIC是一種創新的多芯片堆疊技術,是一種晶圓對晶圓(Wafer-on-wafer)的鍵合(Bonding)技術,這是一種3D IC制程技術,可以讓臺積電具備直接為客戶生產3D IC的能力。
2019-08-14 11:21:06 4993
4993 
從最初為圖像傳感器設計的硅2.5D集成技術,到復雜的高密度的高性能3D系統,硅3D集成是在同一芯片上集成所有功能的系統芯片(SoC)之外的另一種支持各種類型的應用的解決方案,可用于創建性價比更高的系統。
2020-04-10 17:38:49 3498
3498 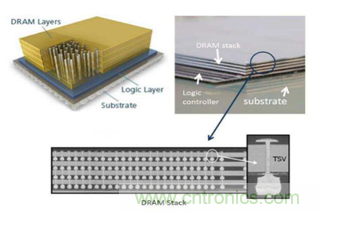
半導體業界,幾家公司正在競相開發基于各種下一代互連技術的新型2.5D和3D封裝。
2020-06-16 14:25:05 8484
8484 日前,三星電子宣布,由三星為業內最先進工藝節點專門研發的硅驗證3D IC封裝技術,eXtended-Cube,簡稱為X-cube,已經可以投入使用。
2020-08-14 17:24:39 3057
3057 三星晶圓代工市場策略的資深副總裁Moonsoo Kang表示,三星的新3D整合技術,確保TSV在先進的極紫外光(EUV)制程節點時,也能穩定聯通。
2020-08-17 17:58:41 1671
1671 新思科技的3DIC Compiler建立在一個IC設計數據模型的基礎上,通過更加現代化的3DIC結構,實現了容量和性能的可擴展性。該平臺提供了一個集規劃、架構探究、設計、實現、分析和signoff于一體的環境。
2020-08-28 15:43:55 3786
3786 三星計劃明年開始與臺積電在封裝先進芯片方面展開競爭,因而三星正在加速部署3D芯片封裝技術。
2020-09-20 12:09:16 3743
3743 在Intel、臺積電各自推出自家的3D芯片封裝技術之后,三星也宣布新一代3D芯片技術——X-Cube,基于TSV硅穿孔技術,可以將不同芯片搭積木一樣堆疊起來,目前已經可以用于7nm及5nm工藝。
2020-10-10 15:22:58 2004
2004 重點 ● TSMC認證基于新思科技3DIC Compiler統一平臺的CoWoS和InFO設計流程 ● 3DIC Compiler可提高先進封裝設計生產率 ● 集成Ansys芯片封裝協同分析解決方案
2020-10-14 11:11:21 2814
2814 隨著摩爾定律的逐漸失效,縮小芯片尺寸的挑戰日益艱巨。但隨著新工藝和技術接連涌現,芯片設計規模仍在持續拓展。其中一種方式就是采用3DIC,它將硅晶圓或裸晶垂直堆疊到同一個封裝器件中,從而帶來性能、功耗
2021-06-09 17:46:17 2972
2972 異構集成基礎:基于工業的2.5D/3D尋徑和協同設計方法
2021-07-05 10:13:36 12
12 2021年8月30日,中國上海訊——國產EDA行業的領軍企業芯和半導體發布了前所未有的“3DIC先進封裝設計分析全流程”EDA平臺。該平臺聯合了全球EDA排名第一的新思科技,是業界首個用于3DIC多
2021-08-30 13:32:23 2432
2432 隨著芯片制造工藝不斷接近物理極限,芯片的布局設計——異構集成的3DIC先進封裝(以下簡稱“3DIC”)已經成為延續摩爾定律的最佳途徑之一。
2021-08-30 14:12:17 1970
1970 3DIC架構并非新事物,但因其在性能、成本方面的優勢及其將異構技術和節點整合到單一封裝中的能力,這種架構越來越受歡迎。隨著開發者希望突破傳統二維平面IC架構的復雜度和密度限制,3D集成提供了引入更多
2021-09-03 10:17:53 7383
7383 新思科技3DIC Compiler是統一的多裸晶芯片設計實現平臺,無縫集成了基于臺積公司3DFabric技術的設計方法,提供完整的“探索到簽核”的設計平臺
2021-11-01 16:29:14 704
704 雙方拓展戰略合作,提供全面的3D系統集成功能,支持在單一封裝中集成數千億個晶體管 新思科技3DIC Compiler是統一的多裸晶芯片設計實現平臺,無縫集成了基于臺積公司3DFabric技術
2021-11-05 15:17:19 6382
6382 Integrity 3D-IC 是 Cadence 新一代多芯片設計解決方案,它將硅和封裝的規劃和實現,與系統分析和簽核結合起來,以實現系統級驅動的 PPA 優化。 原生 3D 分區流程可自動智能
2021-11-19 11:02:24 4231
4231 的發展做出更多的貢獻。
近年來,隨著“摩爾定律”的推進放緩,再加上追逐先進制程工藝所帶來的成本壓力越來越高,使得越來越多的芯片廠商開始選擇通過Chiplet、2.5D/3D先進封裝技術來進行異質集成
2022-02-08 12:47:41 18641
18641 2.5D/3D 芯片包含 Interposer/ 硅穿孔 (Through Silicon Via, TSV) 等復雜結構,通過多物理場
仿真可以提前對 2.5D/3D 芯片的設計進行信號完整性
2022-05-06 15:20:42 19
19 異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418 在 IC 設計的大部分歷史中,我們在一個封裝中使用了一個芯片,以及多芯片模塊 (MCM)。對于具有多個裸片的 2.5D 和 3D IC,您如何進行單個裸片測試,然后使它們適用于最終封裝?
2022-10-12 09:59:07 1972
1972 西門子數字化工業軟件近日推出 Tessent? Multi-die 軟件解決方案,旨在幫助客戶加快和簡化基于 2.5D 和 3D 架構的下一代集成電路 (IC) 關鍵可測試性設計 (DFT) 。
2022-10-17 17:13:38 1767
1767 
工藝技術的2D/2.5D/3D多裸晶芯片系統。基于與臺積公司在3DFabric?技術和3Dblox?標準中的合作,新思科技提供了一系列全面的、系統級的、經過產品驗證的解決方案,助力共同客戶能夠滿足復雜的多裸晶芯片系統對于功耗和性能的嚴苛要求。
2022-11-16 16:25:43 1653
1653 ? 芯和半導體2.5D/3D多芯片Chiplets解決方案
2022-11-24 16:54:08 1284
1284 簡介 3DIC Compiler具有強大的Bump Planning功能。它可在系統設計初期階段沒有bump library cells的情況下,通過定義pseudo bump region
2022-11-24 16:58:19 2112
2112 ? ? ?新思科技(Synopsys, Inc.)近日宣布,推出全面EDA和IP解決方案,面向采用了臺積公司先進N7、N5和N3工藝技術的2D/2.5D/3D多裸晶芯片系統。基于與臺積公司在
2022-12-01 14:10:19 991
991 隨著集成電路制程工藝逼近物理尺寸極限,2.5D/3D封裝,芯粒(Chiplet)、晶上系統(SoW)等先進封裝成為了提高芯片集成度的新方向,并推動EDA方法學創新。這也使得芯片設計不再是單芯片的問題,而逐漸演變成多芯片系統工程。
2023-01-29 09:31:01 1478
1478 創建真正的 3D 設計被證明比 2.5D 復雜和困難得多,需要在技術和工具方面進行重大創新。
2023-04-03 10:32:41 5318
5318 ? ? 原文標題:仿真分析:3DIC全流程解決方案的第一步 文章出處:【微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
2023-05-11 20:16:30 1097
1097 
地將多個裸片相鄰連接,而是通過硅晶圓或裸片的垂直堆疊來大幅提高性能和功耗表現,并讓尺寸變得更小。 為此,新思科技和力晶積成電子制造股份有限公司(簡稱“力積電”)攜手合作,共同推出新的晶圓堆棧晶圓(WoW)和晶圓堆棧芯片(CoW)
2023-06-27 17:35:01 2230
2230 熱點新聞 1、三星計劃為英偉達AI GPU提供HBM3和2.5D封裝服務 據報道,英偉達正在努力實現數據中心AI GPU中使用的HBM3和2.5D封裝的采購多元化。消息人士稱,這家美國芯片巨頭正在
2023-07-20 17:00:02 1360
1360 
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 1653
1653 2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 5284
5284 
新思科技經認證的多裸晶芯片系統設計參考流程和安全的Die-to-Die IP解決方案,加速了三星SF 5/4/3工藝和I-Cube及X-Cube技術的設計和流片成功。 新思科技3DIC
2023-09-14 09:38:28 1999
1999 Cadence員工MohamedNaeim博士曾在CadenceLIVE歐洲用戶大會上做過一場題為《2D/3D熱分析和三裸片堆疊設計實現》的演講,本文將詳細講述該演講內容。實驗:兩個裸片是否優于一個
2023-09-16 08:28:05 2057
2057 
作為全球領先的互聯產品和解決方案公司,奇異摩爾期待以自身 Chiplet 互聯芯粒、網絡加速芯粒產品及全鏈路解決方案,結合智原全面的先進封裝一站式服務,通力協作,深耕 2.5D interposer 與 3DIC 領域,攜手開啟 Chiplet 時代的新篇章。
2023-11-12 10:06:25 1901
1901 三星計劃在2024年先進3D芯片封裝技術SAINT(Samsung Advanced Interconnection Technology,三星高級互連技術),能以更小尺寸的封裝,將AI芯片等高性能芯片的內存和處理器集成。
2023-11-15 11:09:30 2499
2499 (Interposer)制造服務以連接小芯片(Chiplets),并與一流的晶圓代工廠和測試封裝供貨商緊密合作,確保產能、良率、質量、可靠性和生產進度,從而實現多源小芯片的無縫整合,進而保證項目的成功。 智原不僅專注于技術,更為每位客戶量身打造2.5D/3D先進封裝服務。作為一個中立的服務廠商,智原在包
2023-11-20 18:35:42 1107
1107 當芯片變身 3D 系統,3D 異構集成面臨哪些挑戰
2023-11-24 17:51:07 1969
1969 
TSV是2.5D和3D集成電路封裝技術中的關鍵實現技術。半導體行業一直在使用HBM技術將DRAM封裝在3DIC中。
2023-11-27 11:40:20 1762
1762 
據悉,三星很有可能將這些裝置作為2.5d包使用在nvidia ai gpu和hbm3芯片上。根據Shinkawa的訂單結構分析,如果英偉達的訂單增加,三星的設備訂單也會增加。
2023-12-07 15:37:16 1486
1486 2.5D 和 3D 半導體封裝技術對于電子設備性能至關重要。這兩種解決方案都不同程度地增強了性能、減小了尺寸并提高了能效。2.5D 封裝有利于組合各種組件并減少占地面積。它適合高性能計算和人工智能加速器中的應用。3D 封裝提供無與倫比的集成度、高效散熱并縮短互連長度,使其成為高性能應用的理想選擇。
2024-01-07 09:42:10 4507
4507 
此款顯示器運用置于屏幕頂部的雙攝像頭制造3D立體效果,可實時追蹤使用者的頭部與眼球運動,輕松地將二維視頻轉化為3D效果。試驗中,三星在顯示器運行的游戲《匹諾曹的謊言》3D環節展示了驚人的視覺效果
2024-01-08 14:38:16 1390
1390 在2024年的國際消費電子展(CES 2024)上,三星展示了一款令人驚艷的裸眼3D游戲顯示器。這款顯示器獨特之處在于,用戶無需佩戴任何可穿戴設備,就能享受到沉浸式的3D/VR體驗。
2024-01-09 15:36:54 1482
1482 隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 5268
5268 
隨著科技的發展,現在3D視角已經不是新鮮事。而現在,裸眼3D應用則也在頻頻“出圈”。特別是在5G的助力下,裸眼3D技術應用更是成為科技圈一個熱點。
2024-03-11 17:33:09 1664
1664 2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個中介層通常是一塊具有高密度布線的硅片,可以實現芯片之間的短距離、高速通信
2024-04-18 13:35:13 1709
1709 西門子數字化工業軟件近日推出Innovator3D IC軟件,可為采用全球先進半導體封裝2.5D/3D技術和基板的ASIC和Chiplet規劃和異構集成實現快速的可預測路徑。 Innovator3D
2024-06-28 14:58:31 1274
1274 隨著消費者對視覺體驗需求的不斷提升,能讓用戶無需輔助設備即可感受立體影像的裸眼3D創新技術正逐漸成為市場的新寵,其市場前景備受關注。據第三方研究機構預測,預計到2027年,全球裸眼3D產品出貨量將達
2024-07-15 16:00:38 1575
1575 提供了一個統一的協同設計與分析解決方案,通過新思科技3DIC Compiler加速從芯片到系統的各個階段的多裸晶芯片設計的探索和開發。此外,新思科技3DSO.ai與新思科技3DIC Compiler原生集成,實現了信號、電源和熱完整性的優化,極大程度地提高了生產力并優化系統性能。
2024-07-16 09:42:16 1291
1291 隨著科技的不斷進步,裸眼3D技術已經不再是科幻電影中的幻想。如今,英倫科技裸眼3D筆記本電腦將這一前沿科技帶到了我們的日常生活中。無論你是專業的3D模型設計師,還是希望在視頻播放和模型展示中體驗逼真
2024-07-16 10:04:02 1593
1593 深視智能3D相機2.5D模式高度差測量SOP流程
2024-07-27 08:41:36 2002
2002 
2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個中介層通常是一塊具有高密度布線的硅片,可以實現芯片之間的短距離、高速通信
2024-07-30 10:54:23 1792
1792 新思科技宣布推出面向英特爾代工EMIB先進封裝技術的可量產多裸晶芯片設計參考流程,該流程采用了Synopsys.ai EDA全面解決方案和新思科技IP。此外,新思科技3DSO.ai與新思科技3DIC
2024-08-12 09:50:30 1133
1133 隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。
2024-11-11 11:21:51 5379
5379 
本文要點在提升電子設備性能方面,2.5D和3D半導體封裝技術至關重要。這兩種解決方案都在不同程度提高了性能、減小了尺寸并提高了能效。2.5D封裝有利于組合各種器件并減小占用空間,適合高性能計算和AI
2024-12-07 01:05:05 2506
2506 
整合更多功能和提高性能是推動先進封裝技術的驅動,如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統的flip-chip要求每個IC單獨封裝,并通過傳統PCB技術與其他IC集成
2025-01-14 10:41:33 2904
2904 
英倫科技裸眼3D便攜屏采用了領先的光場裸眼3D技術,無需佩戴3D眼鏡即可觀看,給用戶帶來裸眼看3D視頻的體驗,為用戶帶來更加便捷和自由的視覺享受。
2025-02-06 14:20:41 879
879 
高密度先進封裝 (HDAP) 在各種最終用戶應用中的采用率持續攀升。使用中介層(硅或有機)的 2.5D 集成電路 (IC) 設計通常針對高端應用,如軍事、航空航天和高性能計算,而類似臺積電集成扇出
2025-02-20 11:36:56 1272
1272 
面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。2.5D/3D 集成技術正快速發展,集成方案與集成技術日新月異。
2025-06-16 15:58:31 1508
1508 
摘要半導體行業向復雜的2.5D和3DIC封裝快速發展,帶來了極嚴峻的熱管理挑戰,這需要從裸片層級到系統層級分析的復雜解決方案。西門子通過一套集成工具和方法來應對這些多方面的挑戰,這些工具和方法結合了
2025-07-03 10:33:10 1051
1051 
隨著“后摩爾時代”的到來,芯粒(Chiplet)與 2.5D/3D 先進封裝技術正成為突破晶體管微縮瓶頸的關鍵路徑。通過異構集成將不同的芯片模塊化組合,依托2.5D/3D封裝實現高帶寬互連與低功耗
2025-08-07 15:42:25 4113
4113 
Socionext Inc.(以下簡稱“Socionext”)宣布,其3DIC設計現已支持面向消費電子、人工智能(AI)和高性能計算(HPC)數據中心等多種應用。通過結合涵蓋Chiplet、2.5D
2025-09-24 11:09:54 2350
2350 
2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能和集成度,還能有效降低功耗,為AI和高性能計算等領域提供強有力的
2024-07-11 01:12:00 8591
8591
 電子發燒友App
電子發燒友App













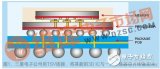
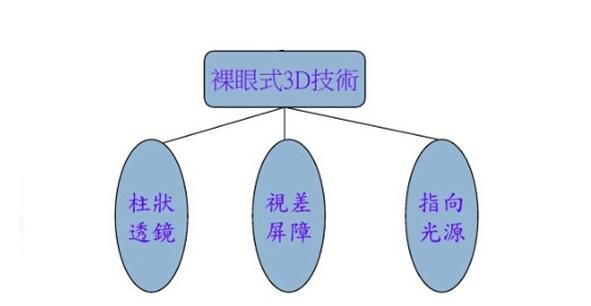



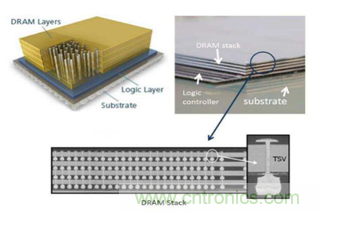





















評論