深視智能3D相機系列2.5D模式高度差測量SOP操作指南旨在協助用戶更加全面地了解我們的傳感器設備。
以塔臺標定板為例:01
圖 | 塔臺標定板
在軟件中進行參數調整:02 圖 |2.5D模式高度差測量SOP在公共設定中將3D模式改為2.5D模式:03
圖 |2.5D模式高度差測量SOP在公共設定中將3D模式改為2.5D模式:03 圖 |2.5D模式高度差測量SOP激活測量設定:04
圖 |2.5D模式高度差測量SOP激活測量設定:04
圖 |2.5D模式高度差測量SOP
在注冊主控中選擇注冊:05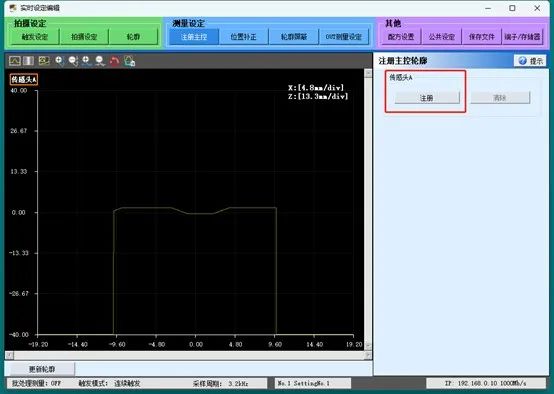
圖 |2.5D模式高度差測量SOP
在位置補正中進行補正:06

圖 |2.5D模式高度差測量SOP
點擊設定進入模式選擇,選擇需要的測量項(如檢測高度差信息):07
圖 |2.5D模式高度差測量SOP
返回主頁面,點擊開始測量:08
圖 |2.5D模式高度差測量SOP
點擊測量值,即可監控數值:09
圖 |2.5D模式高度差測量SOP
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
測量
+關注
關注
10文章
5671瀏覽量
116852 -
SOP
+關注
關注
0文章
99瀏覽量
28726 -
3D相機
+關注
關注
0文章
144瀏覽量
9049
發布評論請先 登錄
相關推薦
熱點推薦

3D曲面玻璃的特點與2.5D玻璃屏幕的作用介紹及其之間的區別
C 產品設計需求。3C 產品設計如智能手機、智能手表、平板計算機、可穿戴式智能產品、儀表板等陸續出現 3D 產品,已經明確引導
發表于 09-30 09:32
?22次下載
2.5D/3D芯片-封裝-系統協同仿真技術研究
2.5D/3D 芯片包含 Interposer/ 硅穿孔 (Through Silicon Via, TSV) 等復雜結構,通過多物理場
仿真可以提前對 2.5D/3D 芯片的設計進
發表于 05-06 15:20
?19次下載
智原推出2.5D/3D先進封裝服務, 無縫整合小芯片
來源:《半導體芯科技》雜志 ASIC設計服務暨IP研發銷售廠商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先進封裝服務。通過獨家的芯片中介層
2.5D和3D封裝的差異和應用
2.5D 和 3D 半導體封裝技術對于電子設備性能至關重要。這兩種解決方案都不同程度地增強了性能、減小了尺寸并提高了能效。2.5D 封裝有利于組合各種組件并減少占地面積。它適合高性能計算和人工

探秘2.5D與3D封裝技術:未來電子系統的新篇章!
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和

2.5D/3D封裝技術升級,拉高AI芯片性能天花板
2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能
技術資訊 | 2.5D 與 3D 封裝
本文要點在提升電子設備性能方面,2.5D和3D半導體封裝技術至關重要。這兩種解決方案都在不同程度提高了性能、減小了尺寸并提高了能效。2.5D封裝有利于組合各種器件并減小占用空間,適合高性能計算和AI

2.5D和3D封裝技術介紹
整合更多功能和提高性能是推動先進封裝技術的驅動,如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統的flip-chip要求每個IC單獨封裝,并通過傳統PCB技術與其他IC

多芯粒2.5D/3D集成技術研究現狀
面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。




 深視智能3D相機2.5D模式高度差測量SOP流程
深視智能3D相機2.5D模式高度差測量SOP流程





評論