目前在全球半導體產業領域,有業界人士認為2.5D先進封裝技術的芯片產品成本,未來可望隨著相關產品量產而愈來愈低,但這樣的假設可能忽略技術本身及制造商營運管理面的諸多問題與困境,可能并非如此容易預測新興封裝技術產品的未來價格走勢。
2016-03-24 08:23:56 4152
4152 主要的技術路徑。2.5D/3D封裝正在加速3D互連密度的技術突破,TSV及TGV的技術作為2.5D/3D封裝的核心技術,越來越受到重視。
2023-05-23 12:29:11 5750
5750 
Info封裝與CoWoS封裝是目前2.5D封裝的典型代表,同屬于TSMC開發的2.5D封裝,那么如何區分 Info封裝與CoWoS封裝呢?主要從以下方面進行闡述。
2023-06-20 11:50:20 4873
4873 
2.5D封裝工藝是一種先進的半導體封裝技術,它通過中介層(Interposer)將多個功能芯片在垂直方向上連接起來,從而減小封裝尺寸面積,減少芯片縱向間互連的距離,并提高芯片的電氣性能指標。這種工藝
2025-02-08 11:40:35 6652
6652 
隨著摩爾定律接近物理極限,半導體產業正在向2.5D和3D集成電路等新型技術方向發展。在2.5D集成技術中,多個Chiplet通過微凸點、硅通孔和重布線層放置在中介層上。這種架構在異構集成方面具有優勢,但同時在Chiplet布局優化和溫度管理方面帶來了挑戰[1]。
2025-02-12 16:00:06 2206
2206 
Eyes具備先進且經濟實惠的2.5D視覺,可為所有領先機器人手臂增加深度感知和零件識別功能,提供無縫集成、單圖校準、直觀編程,同時避免了現有視覺系統的復雜性。
2020-04-18 12:03:53 3138
3138 電子發燒友網報道(文/吳子鵬)先進封裝包括倒裝焊、2.5D封裝、3D封裝、晶圓級封裝、Chiplet等,過去幾年我國先進封裝產業發展迅猛。根據中國半導體協會的統計數據,2023年我國先進封裝市場規模
2024-07-16 01:20:00 4618
4618 
電子發燒友網報道(文/莫婷婷)近日,芯原宣布與開源圖形庫LVGL達成戰略合作,在LVGL庫中支持芯原的低功耗3D和VGLite 2.5D GPU技術,芯原將助力進一步提升LVGL圖形庫的3D圖形渲染
2024-12-06 00:07:00 5391
5391 就是在2.5 / 3D EM求解器中開始優化會話,讓我的電腦在周末出汗。這似乎不可行。我已經看到一些使用Momentum描述優化的Web內容,但那是幾個版本之前。據我所知(現在),我無法以參數化方式將過
2018-09-26 15:17:48
我們一直在拼命地通過經紀人找到一批 KINETIS ARM Cortex M4,確切代碼 MK20DX256VLL10。官方經銷商缺貨。由于解封裝測試存在問題,測試實驗室向我們發送了一份結果為“失敗
2023-03-15 07:23:59
對于測量精度高的零件,中圖儀器2.5d自動影像測量儀相當于一臺小的三座標測量儀,即為復合式影像測量儀,全行程采用立柱式、龍門橋式的穩定結構,單軸的超高測量精度可達(1.8+L/200)um,在需要
2022-08-02 15:43:00
中圖儀器CH系列2.5d影像儀品牌6.5X電動變倍高分辨率鏡頭和大視野鏡頭組合測量,表面光、透射光、同軸光分段編程控制,鑄就強大的毛邊、弱邊抓取功能,清晰呈現工件真實邊緣,實現準確測量。儀器測量手段
2022-11-04 11:43:57
Novator系列2.5d全自動影像儀將傳統影像測量與激光測量掃描技術相結合,充分發揮了光學電動變倍鏡頭的高精度優勢,多種測量新特性、新功能的創新支持,可實現2.5D和3D復合測量。還支持頻閃照明
2023-03-06 09:29:01
Novator系列2.5D影像測量儀是一種全自動影像測量儀。它將傳統影像測量與激光測量掃描技術相結合,充分發揮了光學電動變倍鏡頭的高精度優勢,支持點激光輪廓掃描測量、線激光3D掃描成像,可進行高度
2023-06-07 11:19:54
線掃描功能,可輸出斷面高度、距離等二維尺寸做分析。Novator全自動高精度2.5D影像測量儀還支持頻閃照明和飛拍功能,可進行高速測量,大幅提升測量效率;具有可獨
2024-11-14 13:49:02
中圖儀器Novator系列2.5D光學全自動影像測量儀具備多種測量功能,包括表面尺寸、輪廓、角度與位置、形位公差、3D空間形貌與尺寸結構等的精密測量。其線激光3D掃描功能,可實現3D掃描成像和空間
2024-11-19 17:54:02
前言2.5d影像測量儀是一種用于測量產品在靜態下外形尺寸(也叫形位公差二維分析)的儀器。它能夠在20°左右的情況下,對電子電工、汽車摩托、航空航天、橡膠、塑膠、金屬、船舶兵器、高等院校
2024-12-03 13:41:29
產品的零部件及材料進行測量檢測。一、產品描述2.5d影像測量儀是一種用于測量產品在靜態下外形尺寸(也叫形位公差二維分析)的儀器。它能夠在20°左右的情況下,對電子
2024-12-27 11:30:45
Novator中圖光學2.5D影像測量儀將傳統影像測量與激光測量掃描技術相結合,實現2.5D和3D復合測量。儀器具備多種測量功能,包括表面尺寸、輪廓、角度與位置、形位公差、3D空間形貌與尺寸結構等
2025-06-26 11:45:04
Novator系列高精度2.5D影像儀智能化和自動化程度高,使測量變得簡單。它具備多種測量功能,包括表面尺寸、輪廓、角度與位置、形位公差、3D空間形貌與尺寸結構等的精密測量。Novatorr支持頻閃
2025-07-11 11:30:05
Novator精密2.5D影像測量儀智能化和自動化程度高,使測量變得簡單。它具備多種測量功能,包括表面尺寸、輪廓、角度與位置、形位公差、3D空間形貌與尺寸結構等的精密測量。Novatorr支持頻閃
2025-08-14 14:46:45
電子發燒友網訊:【編譯/Triquinne 】為打破通訊系統內存帶寬限制,華為和Altera將合力研發以2.5D封裝形式集成FPGA和內存單元。華為一位資深科學家表示,這項技術雖然棘手,但是在網絡
2012-11-15 16:40:03 1682
1682 一位華為的資深科學家表示,華為和Altera將推出集成了FPGA和有眾多I/O接口的內存的2.5D硅基封裝芯片,旨在突破通信設備中的內存帶寬的極限。這項技術雖然面臨巨大的挑戰,但該技術
2012-11-16 11:03:22 2404
2404 目前大部分中高端機型都采用了2.5D屏幕玻璃,“溫潤晶瑩”且“柔美舒適”,廠商愛這么描述2.5D玻璃,那你對它又了解多少呢?
2017-01-23 09:47:25 7273
7273 MacRumors網站從早前日經英文站點Nikkei Asian News有關iPhone 8曲面屏幕的傳聞推斷,iPhone 8采用的2.5D曲面屏幕,弧度遠比Galaxy S7 edge那些3D
2017-03-17 09:42:54 859
859 加利福尼亞,圣克拉拉(2017年8月9日)——格芯今日宣布推出2.5D封裝解決方案,展示了其針對高性能14納米FinFET FX-14?ASIC集成電路設計系統的功能。
2017-08-14 17:46:54 1075
1075 產品設計需求。3C 產品設計如智能手機、智能手表、平板計算機、可穿戴式智能產品、儀表板等陸續出現 3D 產品,已經明確引導 3D 曲面玻璃發展方向。而 2.5D 玻璃屏幕是在玻璃的中心有一個平面的區域,然后在平面玻璃的基礎上對邊緣進行了弧度處理。因為應用
2017-09-30 09:32:34 22
22 對于數據密集型應用,大量能量和延時消耗在計算和存儲單元之間的數據傳輸上,造成馮諾依曼瓶頸。在采用2.5D封裝集成的系統中,這一問題依然存在。為此,提出一種新型的硬件加速方案。引入存儲型計算到2.5D
2018-02-26 11:47:46 1
1 5G即將到來,說起手機外殼材料大家首先會想到玻璃,陶瓷,但是2018年這款PC/PMMA塑膠復合材料在仿2.5D/3D玻璃的道路上火得一塌糊涂!!包括住友,科思創,sabic,四川龍華等企業都有涉及
2018-06-01 15:05:57 64384
64384 對于目前的高端市場,市場上最流行的2.5D和3D集成技術為3D堆疊存儲TSV,以及異構堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術已經廣泛用于高性能計算
2019-02-15 10:42:19 8043
8043 
Eyes具備先進且經濟實惠的2.5D視覺,可為所有領先機器人手臂增加深度感知和零件。在自動化工業生產中,需要機器人手臂經常執行拾取位置、形狀、大小不同物品的任務。
2020-04-17 10:44:02 1068
1068 協作機器人夾爪制造商OnRobot推出最新2.5D視覺系統Eyes,適用于各家先進機器手臂,提供外加的深度感知和零件辨識功能。
2020-05-31 10:14:43 1409
1409 半導體業界,幾家公司正在競相開發基于各種下一代互連技術的新型2.5D和3D封裝。
2020-06-16 14:25:05 8484
8484 代工廠、設備供應商、研發機構等都在研發一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項技術正在推動下一代2.5D和3D封裝技術。
2020-10-10 15:24:32 7955
7955 
再就是2.5D/3D先進封裝集成,新興的2.5D和3D技術有望擴展到倒裝(FC)芯片和晶圓級封裝(WLP)工藝中。通過使用內插器(interposers)和硅通孔(TSV)技術,可以將多個芯片進行垂直堆疊。據報道,與傳統包裝相比,使用3D技術可以實現40~50倍的尺寸和重量減少。
2020-10-10 16:09:18 4448
4448 異構集成基礎:基于工業的2.5D/3D尋徑和協同設計方法
2021-07-05 10:13:36 12
12 今天,三星推出了全新2.5D封裝解決方案H-Cube(Hybrid Substrate Cube,混合基板封裝),專用于需要高性能和大面積封裝技術的高性能計算(HPC)、人工智能(AI)、數據中心和網絡產品等領域。
2021-11-12 15:52:17 3438
3438 的發展做出更多的貢獻。
近年來,隨著“摩爾定律”的推進放緩,再加上追逐先進制程工藝所帶來的成本壓力越來越高,使得越來越多的芯片廠商開始選擇通過Chiplet、2.5D/3D先進封裝技術來進行異質集成
2022-02-08 12:47:41 18640
18640 電子行業正在經歷半導體封裝技術的再興。越來越多的創新性的3D封裝方法已經發展,是電子工廠能夠去最大化他們的產品功能。通過整合多個芯片到一個封裝模組中,產品板可以明顯的比它們的前輩更小,并且更短的內部
2022-04-29 17:17:43 8
8 開始呈現疲軟的狀態,先進
制成工藝也無法帶來成本上的縮減。如何超越摩爾定律(More than Moore’s
law),讓行業繼續高速發展,成為業界苦苦尋思的問題。而目前來看,2.5D/3D
先進封裝技術將會是行業一個重要的突破口,是超越摩爾定律的必經之路
2022-04-29 17:20:01 8
8 2.5D/3D 芯片包含 Interposer/ 硅穿孔 (Through Silicon Via, TSV) 等復雜結構,通過多物理場
仿真可以提前對 2.5D/3D 芯片的設計進行信號完整性
2022-05-06 15:20:42 19
19 在閱讀文章之前,大家可以思考下 2.5D 設計屬于哪種界定?
2022-06-06 10:17:22 2382
2382 為了更有效辨別 2D 與 2.5D 之間的區別,圖撲軟件選用 2D 空調裝配生產線與 2.5D 化工廠安全流程作比較。通過自主研發的 HT 產品,采用 B/S 架構快速搭建零代碼拖拽式 Web 組態可視化場景,以真實的場景化、圖形化、動態化的效果,反映二者運行狀態、工藝流程、動態效果之間的不同。
2022-06-07 10:10:45 1817
1817 異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418 在 IC 設計的大部分歷史中,我們在一個封裝中使用了一個芯片,以及多芯片模塊 (MCM)。對于具有多個裸片的 2.5D 和 3D IC,您如何進行單個裸片測試,然后使它們適用于最終封裝?
2022-10-12 09:59:07 1972
1972 西門子數字化工業軟件近日推出 Tessent? Multi-die 軟件解決方案,旨在幫助客戶加快和簡化基于 2.5D 和 3D 架構的下一代集成電路 (IC) 關鍵可測試性設計 (DFT) 。
2022-10-17 17:13:38 1767
1767 
2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-10-26 09:34:04 1504
1504 2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-11-14 10:14:53 2151
2151 2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-11-15 09:35:36 3421
3421 先進的2.5D異質整合結構芯片封裝技術來扮演這個角色。但是為什么需要采用2.5D封裝技術,以目前來說,2.5D封裝是一種高階的IC芯片封裝技術,可實現各種IC芯片的高速整合。
2022-12-05 16:25:39 1276
1276 
2.5D封裝技術可以將兩種或更多類型的芯片放入單個封裝,同時讓信號橫向傳送,這樣可以提升封裝的尺寸和性能。
2023-01-30 15:38:28 1367
1367 SiP是一個非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術,但就最先進SiP封裝技術而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構Chiplet封裝技術。
2023-03-20 09:51:54 2006
2006 
創建真正的 3D 設計被證明比 2.5D 復雜和困難得多,需要在技術和工具方面進行重大創新。
2023-04-03 10:32:41 5313
5313 裸芯通過微凸點組裝到Interposer上,如上圖所示。其Interposer上堆疊了三顆裸芯。Interposer包括兩種類型的互聯:①由微凸點和Interposer頂部的RDL組成的水平互連,它連接各種裸芯②由微凸點、TSV簇和C4凸點組成的垂直互聯,它將裸芯連接至封裝。
2023-04-10 11:28:50 14212
14212 就收入而言,倒裝芯片BGA、倒裝芯片CSP和2.5D/3D是主要的封裝平臺,其中2.5D/3D技術的增長率最高。2.5D/3D 市場預計將從 2022 年的 92 億美元增長到 2028 年的 258 億美元,實現 19% 的復合年增長率。
2023-04-24 10:09:52 1622
1622 
電子發燒友網站提供《用焊接在一起的PCB重建2.5D凸輪.zip》資料免費下載
2023-06-08 11:05:24 0
0 據2022年2月7日消息,上海微電子裝備(集團)股份有限公司(SMEE)舉行首臺2.5D/3D先進封裝光刻機發運儀式,向客戶正式交付先進封裝光刻機。需要指出的是,上海微電子此次交付的是用于IC后道
2022-02-11 09:37:04 15455
15455 
Info封裝與CoWoS封裝是目前2.5D封裝的典型代表,同屬于TSMC開發的2.5D封裝,那么如何區分 Info封裝與CoWoS封裝呢?主要從以下方面進行闡述。
2023-06-20 11:51:35 11684
11684 
nvidia的a100、h100和其他ai gpu目前使用控制臺來制造晶片和2.5包的前端工程。nvidia ai gpu使用的hbm芯片由sk海力士獨家提供。但是tsmc沒有能力處理2.5d包裝所需的所有工作。
2023-07-20 10:45:23 2330
2330 與包括三星在內的潛在供應商進行交易談判。 目前,英偉達的A100、H100和其他AI GPU均使用臺積電進行晶圓制造和2.5封裝工作的前端工藝。英偉達AI GPU使用的HBM(高帶寬內存)芯片由SK海力士獨家提供。然而,臺積電沒有能力處理這些芯片所需的2.5D封裝的所有工作量。消息人士稱,英
2023-07-20 17:00:02 1359
1359 
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 1652
1652 2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 5284
5284 
本文通過測試、仿真分析了影響2.5D CoWoS翹曲、應力、可靠性的因素:real/dummyHBM、interposer 厚度、C4 bump高度。對2.5D package的設計非常有指導意義。
2023-09-07 12:22:40 4745
4745 
先進封裝技術以SiP、WLP、2.5D/3D為三大發展重點。先進封裝核心技術包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術的組合各廠商發展出了滿足多樣化需求的封裝解決方案,SiP系統級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發展重點。
2023-09-28 15:29:37 4970
4970 
不同的連接技術把它們拼裝在一起,以實現更高效和更高性能的芯片設計。本文將會詳盡、詳實、細致地介紹Chiplet主流的封裝技術。 1. 面向異構集成的2.5D/3D技術 2.5D/3D技術是Chiplet主流封裝技術中最為流行和成熟的一種,通過把不同的芯片堆疊在一起,可以將它
2023-09-28 16:41:00 2931
2931 作為全球領先的互聯產品和解決方案公司,奇異摩爾期待以自身 Chiplet 互聯芯粒、網絡加速芯粒產品及全鏈路解決方案,結合智原全面的先進封裝一站式服務,通力協作,深耕 2.5D interposer 與 3DIC 領域,攜手開啟 Chiplet 時代的新篇章。
2023-11-12 10:06:25 1900
1900 來源:《半導體芯科技》雜志 ASIC設計服務暨IP研發銷售廠商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先進封裝服務。通過獨家的芯片中介層
2023-11-20 18:35:42 1107
1107 當 2.5D 和 3D 封裝最初被構想出來時,普遍的共識是只有最大的半導體公司才能負擔得起,但開發成本很快就得到了控制。在某些情況下,這些先進的封裝實際上可能是成本最低的選擇。
2023-12-05 11:10:57 1364
1364 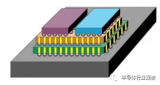
據悉,三星很有可能將這些裝置作為2.5d包使用在nvidia ai gpu和hbm3芯片上。根據Shinkawa的訂單結構分析,如果英偉達的訂單增加,三星的設備訂單也會增加。
2023-12-07 15:37:16 1486
1486 半導體芯片封裝的重要性、傳統和先進技術以及該領域的未來趨勢。
2024-01-02 11:09:17 2174
2174 
2.5D 和 3D 半導體封裝技術對于電子設備性能至關重要。這兩種解決方案都不同程度地增強了性能、減小了尺寸并提高了能效。2.5D 封裝有利于組合各種組件并減少占地面積。它適合高性能計算和人工智能加速器中的應用。3D 封裝提供無與倫比的集成度、高效散熱并縮短互連長度,使其成為高性能應用的理想選擇。
2024-01-07 09:42:10 4503
4503 
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 5268
5268 
自去年以來,隨著英偉達AI芯片需求的迅猛增長,作為其制造及封裝合作伙伴的臺積電(TSMC)在先進封裝技術方面面臨了前所未有的產能壓力。為了應對這一挑戰,臺積電正積極擴大其2.5D封裝產能,以確保能夠滿足持續增長的產能需求。
2024-02-06 16:47:14 6631
6631 隨著人工智能的興起,2.5D中介層轉接板作為先進封裝集成的關鍵技術,近年來得到迅猛發展。
2024-03-06 09:44:19 2572
2572 
了解到,2.5D封裝技術能夠有效地將CPU、GPU、I/O接口、HBM芯片等多種芯片以橫向方式置于中間層之上。如臺積電所采取的CoWoS技術以及三星的I-Cube便是此類技術。
2024-04-08 11:03:17 3041
3041 2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個中介層通常是一塊具有高密度布線的硅片,可以實現芯片之間的短距離、高速通信
2024-04-18 13:35:13 1709
1709 ? ATS3085S和ATS3089系列中采用了芯原低功耗且功能豐富的2.5D圖形處理器(GPU)IP。 炬芯科技的智能手表SoC ATS3085S和ATS3089系列擁有卓越的圖形顯示性能,采用2D+2.5D雙
2024-05-15 11:39:26 1337
1337 近日,芯原股份與低功耗AIoT芯片設計廠商炬芯科技股份有限公司(炬芯科技)達成合作。炬芯科技在其高集成度的雙模藍牙智能手表SoC ATS3085S和ATS3089系列中,成功采用了芯原提供的低功耗且功能豐富的2.5D圖形處理器(GPU)IP。
2024-05-16 14:58:42 3423
3423 。 典型封裝技術包括:1)倒片封裝(Flip-Chip):芯片倒置,舍棄金屬引線,利用凸塊連接;2)扇入型/扇出型封裝(Fan-In/Fan-Out):在晶圓上進行整體封裝,成本更低,關鍵工藝為重新布線(RDL);3)2.5D/3D封裝:2.5D封裝中芯片位于硅中介層上,3D封裝舍
2024-07-03 08:44:54 6868
6868 
7月17日,韓國財經媒體Money Today披露,半導體巨頭SK海力士正就硅中介層(Si Interposer)技術合作事宜,與業界領先的半導體封裝與測試外包服務(OSAT)企業Amkor進行深入探討。此次合作旨在共同推動高性能HBM(高帶寬內存)與2.5D封裝技術的融合應用。
2024-07-17 16:59:18 1689
1689 深視智能3D相機2.5D模式高度差測量SOP流程
2024-07-27 08:41:36 2002
2002 
2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個中介層通常是一塊具有高密度布線的硅片,可以實現芯片之間的短距離、高速通信
2024-07-30 10:54:23 1792
1792 近日,ASIC設計服務暨IP研發銷售廠商智原科技(Faraday Technology Corporation)與AI網絡全棧式互聯產品及解決方案提供商奇異摩爾宣布,雙方共同合作的2.5D封裝平臺已成功邁入量產階段。
2024-10-14 16:43:25 1193
1193 半導體行業不斷發展,不斷推動芯片設計和制造的邊界。隨著逐漸接近傳統平面縮放的極限,先進封裝技術正成為持續提升性能的關鍵推動力。在這些技術中,3.5D封裝作為當前2.5D解決方案和完全3D集成之間的折中方案,正在獲得廣泛關注。本文將探討3.5D封裝的概念、優勢、挑戰以及對半導體設計未來的潛在影響。
2024-10-28 09:47:45 1804
1804 
隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。
2024-11-11 11:21:51 5379
5379 
?? 隨著制程技術的不斷逼近極限,進一步提升晶體管密度和性能變得愈發艱難,成本也日益高昂。在此背景下,先進封裝技術,特別是2.5D封裝,成為了半導體領域的重要突破口。2.5D封裝技術作為半導體領域
2024-11-22 09:12:02 4311
4311 
? 本文是篇綜述,回顧了學術界、工業界在解決2.5D封裝熱力問題上的努力。研究內容包含對翹曲應變、BGA疲勞壽命的仿真測試評估,討論了材料物性、結構參數的影響。 根據JEDEC,封裝失效機理可分為
2024-11-24 09:52:48 3092
3092 
本文要點在提升電子設備性能方面,2.5D和3D半導體封裝技術至關重要。這兩種解決方案都在不同程度提高了性能、減小了尺寸并提高了能效。2.5D封裝有利于組合各種器件并減小占用空間,適合高性能計算和AI
2024-12-07 01:05:05 2506
2506 
近日,據韓媒報道,SK海力士在先進封裝技術開發領域取得了顯著進展,并正在考慮將其技術實力拓展至對外提供2.5D后端工藝服務。 若SK海力士正式進軍以2.5D工藝為代表的先進OSAT(外包半導體組裝
2024-12-25 14:24:56 926
926 2.5D封裝技術是一種先進的異構芯片封裝技術,它巧妙地利用中介層(Interposer)作為多個芯片之間的橋梁,實現高密度線路連接,并最終集成為一個封裝體。
2024-12-25 18:34:16 6798
6798 整合更多功能和提高性能是推動先進封裝技術的驅動,如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統的flip-chip要求每個IC單獨封裝,并通過傳統PCB技術與其他IC集成
2025-01-14 10:41:33 2903
2903 
高密度先進封裝 (HDAP) 在各種最終用戶應用中的采用率持續攀升。使用中介層(硅或有機)的 2.5D 集成電路 (IC) 設計通常針對高端應用,如軍事、航空航天和高性能計算,而類似臺積電集成扇出
2025-02-20 11:36:56 1272
1272 
?多年來,封裝技術并未受到大眾的廣泛關注。但是現在,尤其是在AI芯片的發展過程中,封裝技術發揮著至關重要的作用。2.5D封裝以其高帶寬、低功耗和高集成度的優勢,成為了AI芯片的理想封裝方案。 在
2025-03-27 18:12:46 711
711 
芯原股份(芯原,股票代碼:688521.SH)今日宣布推出全新超低功耗的圖形處理器(GPU)IP——GCNano3DVG。該IP具備3D與2.5D圖形渲染功能,在視覺效果與功耗效率之間實現了卓越平衡
2025-04-17 10:15:32 618
618 面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。2.5D/3D 集成技術正快速發展,集成方案與集成技術日新月異。
2025-06-16 15:58:31 1507
1507 
隨著“后摩爾時代”的到來,芯粒(Chiplet)與 2.5D/3D 先進封裝技術正成為突破晶體管微縮瓶頸的關鍵路徑。通過異構集成將不同的芯片模塊化組合,依托2.5D/3D封裝實現高帶寬互連與低功耗
2025-08-07 15:42:25 4111
4111 
集成電路封裝技術從2D到3D的演進,是一場從平面鋪開到垂直堆疊、從延遲到高效、從低密度到超高集成的革命。以下是這三者的詳細分析:
2025-12-03 09:13:15 440
440 2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能和集成度,還能有效降低功耗,為AI和高性能計算等領域提供強有力的
2024-07-11 01:12:00 8591
8591
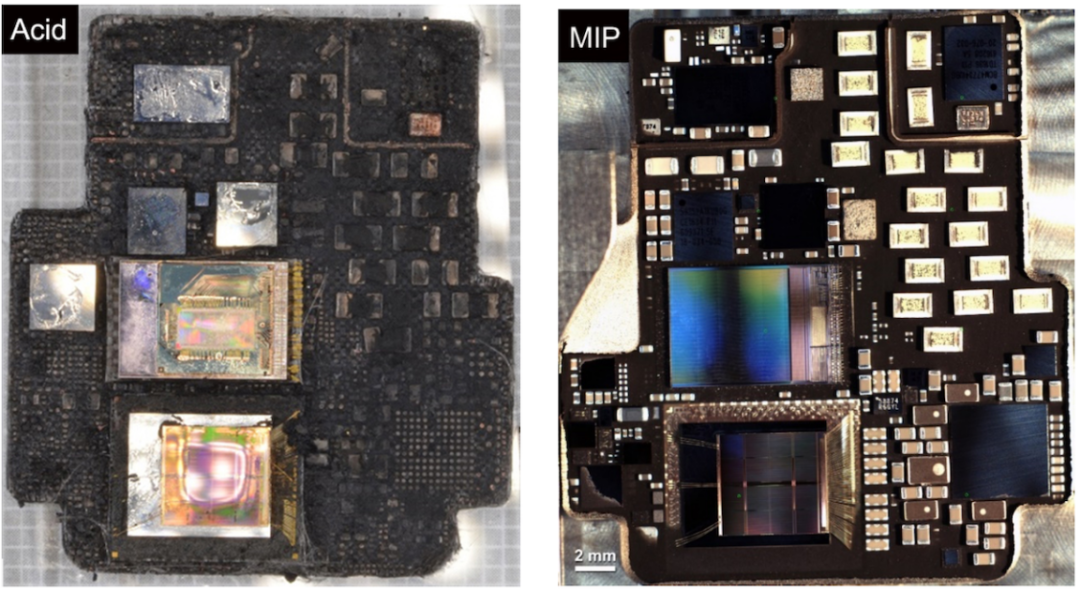
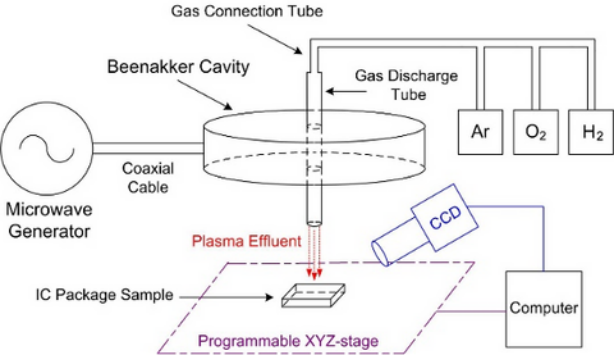
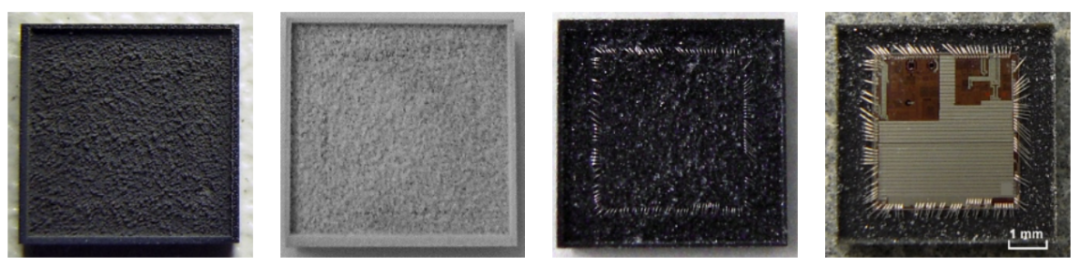


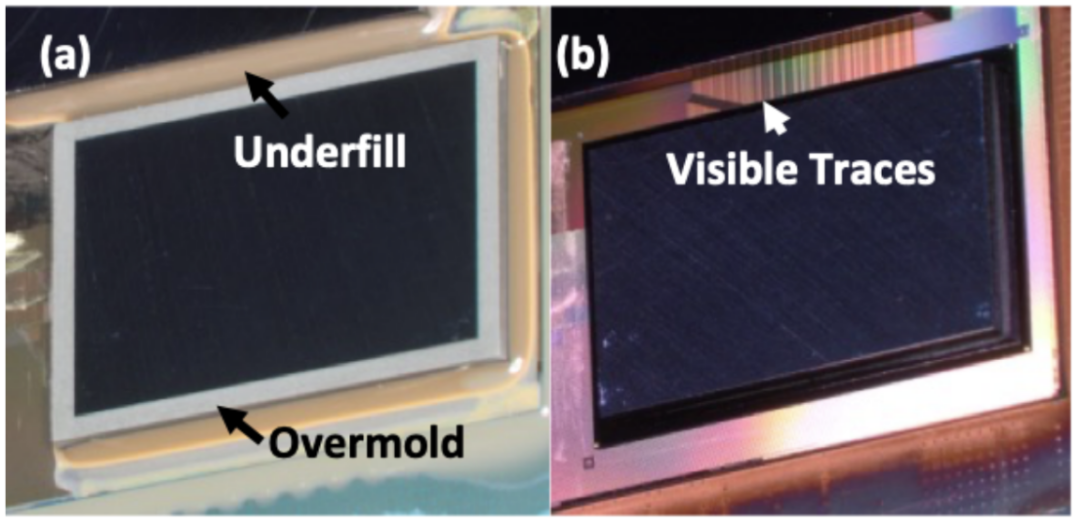
 電子發燒友App
電子發燒友App





























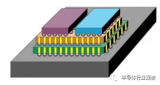



















評論