云天半導體突破2.5D高密度玻璃中介層技術
隨著人工智能的興起,2.5D中介層轉接板作為先進封裝集成的關鍵技術,近年來得到迅猛發展。與硅基相比,玻璃基(TGV)具有優良的高頻電學、力學性能、工藝流程簡化和成本低等優勢,并能實現光電合封,是理想的芯粒三維集成解決方案。
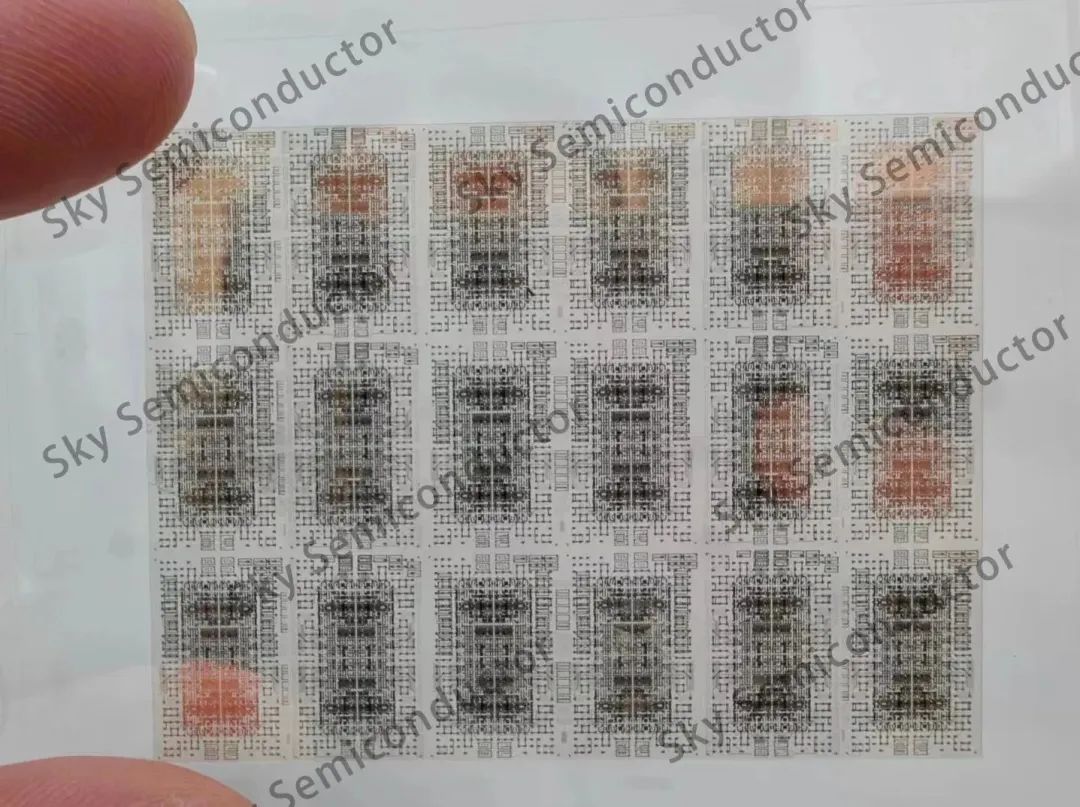 ?
?
圖1 封裝面積為2700mm2的TGV轉接板
近年來,廈門云天半導體科技有限公司致力于研發玻璃通孔及其集成技術,開發了高精度、高深寬比玻璃孔制備技術、高性能玻璃基IPD技術,并實現了規模化量產。面向高性能芯粒集成需求,云天半導體成功研發了高密度玻璃轉接板技術。大尺寸TGV轉接板樣品如圖1所示,該玻璃轉接板面積為2700mm2(60mm×45mm),厚度為80μm,TGV開口直徑25μm,實現8:1高深寬比的TGV盲孔無孔洞填充。金屬布線采用無機薄膜介質材料,實現3層RDL堆疊,通過調試干法刻蝕參數、優化CMP拋光能力實現細間距RDL,其中最小L/S可達1.5/1.5μm(如圖2)。并通過多場reticle拼接技術可滿足大尺寸轉接板制備,其中拼接精度可控在100nm以內(如圖3)。電性測試結果表明基于玻璃基的無機RDL結構較有機RDL損耗降低10%。
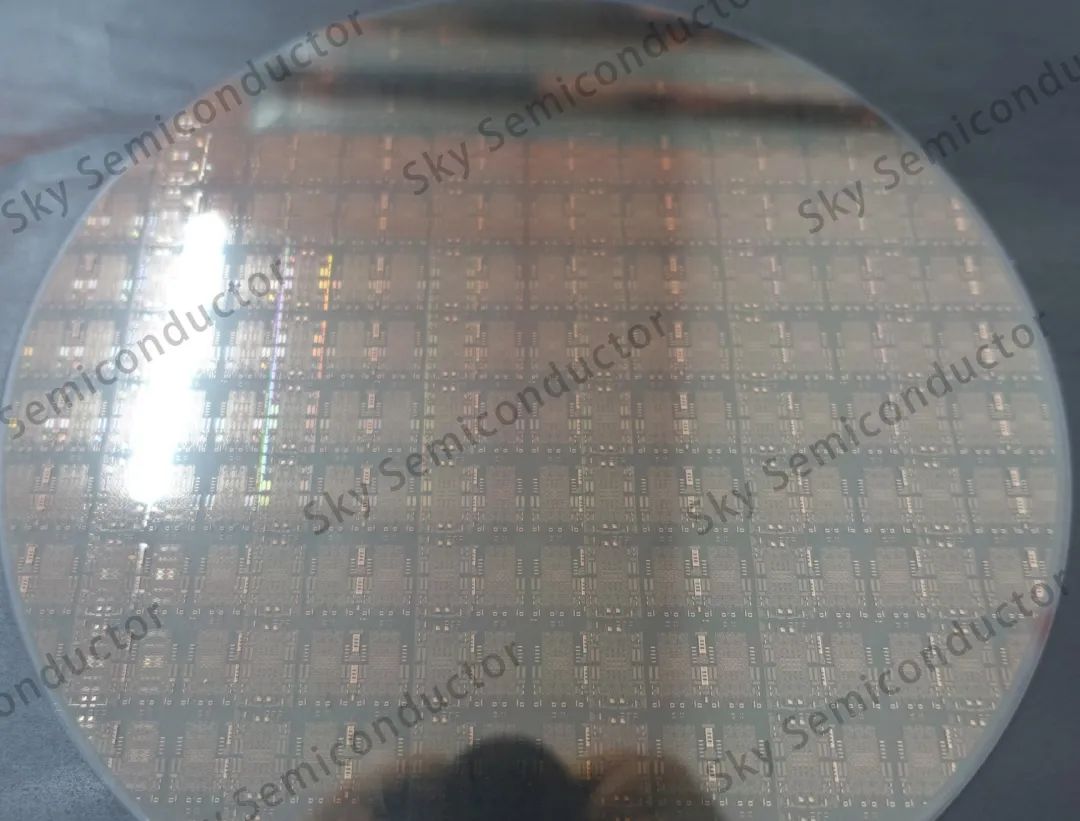 ?
?
圖2 多層RDL堆疊晶圓

圖3 細長RDL拼接
基于玻璃基板的綜合性能以及近期Intel發布的未來發展規劃,業界高度重視玻璃基板技術發展和產品應用。云天半導體的高密度玻璃中介層技術未來將助力AI等應用的CPU、GPU產品的先進封裝。
云天半導體
-
半導體
+關注
關注
339文章
30725瀏覽量
264054 -
人工智能
+關注
關注
1817文章
50094瀏覽量
265299 -
CMP
+關注
關注
7文章
160瀏覽量
27755
原文標題:云天半導體突破2.5D高密度玻璃中介層技術
文章出處:【微信號:today_semicon,微信公眾號:今日半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
2D、2.5D與3D封裝技術的區別與應用解析

Kioxia研發核心技術,助力高密度低功耗3D DRAM的實際應用
EMI濾波高密度D-Sub連接器技術解析與應用指南
哪種工藝更適合高密度PCB?
TGV產業發展:玻璃通孔技術如何突破力學瓶頸?
華大九天推出芯粒(Chiplet)與2.5D/3D先進封裝版圖設計解決方案Empyrean Storm

多芯粒2.5D/3D集成技術研究現狀

Analog Devices Inc. ADGS2414D高密度開關數據手冊
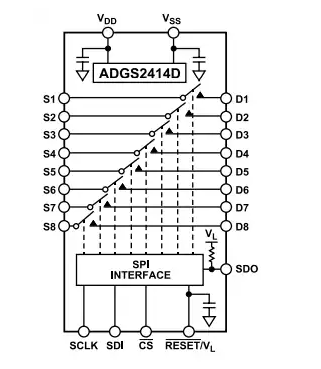
高密度配線架和中密度的區別
基于疊層組裝和雙腔體結構的高密度集成技術




 云天半導體突破2.5D高密度玻璃中介層技術
云天半導體突破2.5D高密度玻璃中介層技術


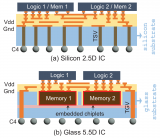



評論