在最近舉辦的GSA存儲大會上,芯片制造業(yè)的四大聯(lián)盟組織-IMEC, ITRI, Sematech以及SEMI都展示了他們各自在基于TSV的3D芯片技術(shù)方面的最新進(jìn)展
2011-04-14 18:38:31 7492
7492 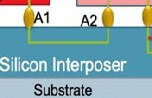
本文研究主要考慮基于CuSn金屬互化物的微凸點(diǎn)(μbump)作為芯片堆疊的手段。系統(tǒng)研究了形成金屬互化物凸點(diǎn)連接的兩種方法。
2012-03-08 16:29:24 6956
6956 
據(jù)IC Insights發(fā)布的最新2020 McClean報告顯示,半導(dǎo)體行業(yè)研發(fā)的投入將在2024年出現(xiàn)明顯成效包括轉(zhuǎn)向EUV光刻,低于3納米制程技術(shù),3D芯片堆疊技術(shù)和先進(jìn)封裝在內(nèi)的技術(shù)挑戰(zhàn)有望
2020-01-31 09:20:34 7042
7042 3D堆疊、多芯片封裝大家想必都不陌生了,這年頭制造工藝已經(jīng)沒有太多噱頭,有時甚至性能提升也有限,廠商只好從架構(gòu)上入手。像蘋果的Ultra?Fusion拼接、Graphcore的3D WoW,都是在
2022-04-13 01:06:00 7527
7527 視為堆疊邏輯與內(nèi)存、3D NAND,甚至可能在高帶寬存儲(HBM)中的多層DRAM堆疊的關(guān)鍵技術(shù)。垂直堆疊使得芯片制造商能夠?qū)?b class="flag-6" style="color: red">互連間距從35μm的銅微凸點(diǎn)提升到10μm甚至更小。
2025-05-22 11:24:18 1405
1405 
半導(dǎo)體協(xié)會理事長盧超群指出,未來半導(dǎo)體將要做3D垂直堆疊,全球半導(dǎo)體產(chǎn)業(yè)未來會朝向類摩爾定律成長。
2016-06-10 00:14:00 2696
2696 三星作為全球首家量產(chǎn)3D NAND Flash的廠商的風(fēng)光并沒有太久,日前東芝也研究出64層3D Flash,這樣的追趕速度讓人驚嘆。有消息顯示,英特可能暫緩擴(kuò)建大連廠,而是通過直接收購美光科技擴(kuò)大芯片領(lǐng)域?qū)嵙ΑK髂酨layStation VR國行版來襲,紅米Pro三個版本還有什么發(fā)布會沒說的細(xì)節(jié)?
2016-07-28 09:44:26 1235
1235 據(jù)外媒報道,東芝今天宣布正式出貨BiCS FLASH 3D閃存,采用64層堆疊,單晶粒容量512Gb(64GB,TLC),相對于上一代48層256Gb,容量密度提升了65%,這樣封裝閃存芯片的最高容量將達(dá)到960GB。
2017-02-23 08:33:40 1752
1752 臺積電(中國)有限公司技術(shù)總監(jiān)陳敏表示,TSMC 3D Fabric先進(jìn)封裝技術(shù)涵蓋 2.5D 和垂直芯片堆疊產(chǎn),是臺積電過去10年以來對于3D IC的不斷完善和開發(fā)。客戶采用臺積3D Fabric所生產(chǎn)的產(chǎn)品取得的整個系統(tǒng)效能的提升,都有非常良好的表現(xiàn)。
2022-09-20 10:35:47 2930
2930 
先進(jìn)封裝從MCM發(fā)展到2.5D/3D堆疊封裝,目前發(fā)展最快的制造商是TSMC。TSMC從Foundry端延伸入2.5D/3D先進(jìn)封裝,稱為3D Fabric。近十年來TSMC的2.5D先進(jìn)封裝技術(shù)
2022-10-26 10:21:37 5940
5940 對于自動駕駛應(yīng)用來說,3D 場景感知至關(guān)重要。3D點(diǎn)云數(shù)據(jù)就是具有3D特征的數(shù)據(jù)。一方面,3D 點(diǎn)云可以直接用來獲取障礙物的距離和大小,以及場景的語義信息。
2023-12-28 16:35:22 2712
2712 
背景部分介紹了3D點(diǎn)云應(yīng)用領(lǐng)域中公開可訪問的數(shù)據(jù)集的重要性,這些數(shù)據(jù)集對于分析和比較各種模型至關(guān)重要。研究人員專門設(shè)計了各種數(shù)據(jù)集,包括用于3D形狀分類、3D物體檢測和3D點(diǎn)云分割等任務(wù)的數(shù)據(jù)集。
2024-02-22 16:16:47 2454
2454 
3D堆疊像素探測器芯片技術(shù)詳解
2024-11-01 11:08:07 4435
4435 
3D堆疊將不斷發(fā)展,以實現(xiàn)更復(fù)雜和集成的設(shè)備——從平面到立方體
2024-09-19 18:27:41 2348
2348 
3D 集成電路的優(yōu)勢有目共睹,因此現(xiàn)代芯片中也使用了 3D 結(jié)構(gòu),以提供現(xiàn)代高速計算設(shè)備所需的特征密度和互連密度。隨著越來越多的設(shè)計集成了廣泛的功能,并需要一系列不同的特征,3D 集成將與異構(gòu)集成
2024-12-03 16:39:31 2918
2918 
動力。 ? 據(jù)資料顯示,這項技術(shù)通過將銅金屬鍵合與介電層鍵合工藝結(jié)合,實現(xiàn)了亞微米級的垂直互連,使芯片堆疊密度提升兩個數(shù)量級,為突破摩爾定律物理極限提供了可行路徑。 ? 二十年來,錫基焊料凸點(diǎn)(Micro Bump)一直是芯片堆疊的標(biāo)準(zhǔn)導(dǎo)線。但當(dāng)
2025-06-29 22:05:13 1519
1519 什么是3D圖形芯片?3D圖像生成算法的原理是什么?
2021-06-04 06:29:06
成微型的往往會導(dǎo)致很差的效果。比如建筑模型,在打印這種模型時尺寸非常關(guān)鍵,因為包含的細(xì)節(jié)非常之多,你將尺寸調(diào)的越小,3D 打印模型能展現(xiàn)出來的細(xì)節(jié)就越少。Sculpteo建議大家在打印精細(xì)的模型
2016-05-05 14:31:56
我公司專業(yè)從事3D全息風(fēng)扇研發(fā)生產(chǎn),主要生產(chǎn)供應(yīng)3D全息風(fēng)扇PCBA,也可出售整機(jī),其他配件可免費(fèi)提供供應(yīng)商信息或者代購,歡迎咨詢 劉先生:*** 微信同號3d全息風(fēng)扇燈條3d全息風(fēng)扇PCBA3D全息風(fēng)扇方案本廣告長期有效
2019-08-02 09:50:26
芯片封裝鍵合技術(shù)各種微互連方式簡介微互連技術(shù)簡介定義:將芯片凸點(diǎn)電極與載帶的引線連接,經(jīng)過切斷、沖壓等工藝封裝而成。載帶:即帶狀載體,是指帶狀絕緣薄膜上載有由覆 銅箔經(jīng)蝕刻而形成的引線框架,而且芯片
2012-01-13 14:58:34
正在從二維走向三維世界——芯片設(shè)計、芯片封裝等環(huán)節(jié)都在向3D結(jié)構(gòu)靠攏。晶體管架構(gòu)發(fā)生了改變當(dāng)先進(jìn)工藝從28nm向22nm發(fā)展的過程中,晶體管的結(jié)構(gòu)發(fā)生了變化——傳統(tǒng)的平面型晶體管技術(shù)(包括體硅技術(shù)
2020-03-19 14:04:57
無線通信(CCWC),可以解決傳統(tǒng)芯片內(nèi)采用金屬互連線、硅通孔燈通信的瓶頸,提高芯片的性能和能效,同時大大縮小面積。
CCWC面臨的挑戰(zhàn):
2、3D堆疊
1)3D堆疊技術(shù)的發(fā)展
3D堆疊技術(shù)最早應(yīng)用于
2025-09-15 14:50:58
世界首款3D芯片工藝即將由無晶圓半導(dǎo)體公司BeSang授權(quán)。 BeSang制造了一個示范芯片,在邏輯控制方面包含1.28億個縱向晶體管的記憶存儲單元。該芯片由韓國國家Nanofab和斯坦福
2008-08-18 16:37:37
如何同時獲取2d圖像序列和相應(yīng)的3d點(diǎn)云?以上來自于谷歌翻譯以下為原文How to obtain the sequence of 2d image and corresponding 3d point cloud at the same time?
2018-11-13 11:25:01
`華爾街日報發(fā)布文章稱,科技產(chǎn)品下一個重大突破將在芯片堆疊領(lǐng)域出現(xiàn)。Apple Watch采用了先進(jìn)的的3D芯片堆疊封裝技術(shù)作為幾乎所有日常電子產(chǎn)品最基礎(chǔ)的一個組件,微芯片正出現(xiàn)一種很有意思的現(xiàn)象
2017-11-23 08:51:12
大家好, 在Ultrascale FPGA中,使用單片和下一代堆疊硅互連(SSI)技術(shù)編寫。 “單片和下一代堆疊硅互連(SSI)技術(shù)”是什么意思?謝謝娜文G K.
2020-04-27 09:29:55
3D 點(diǎn)云。高度差異化 3D 機(jī)器視覺系統(tǒng)利用 DLP?(...)主要特色 集成型 API 和針對 DLP 芯片組的驅(qū)動程序支持,可實現(xiàn)快速以及可編程圖形針對同步捕捉的集成型攝像機(jī)支持投影儀和攝像機(jī)校準(zhǔn)例程用于生成視差圖、景深圖和點(diǎn)云的結(jié)構(gòu)光算法API 文檔應(yīng)用和源代碼的完全訪問權(quán)限
2018-10-12 15:33:03
構(gòu)建精細(xì)的 3D 點(diǎn)云。作為緊湊或手持解決方案的理想之選,此高分辨率 3D 掃描儀系統(tǒng)利用 DLP?(...)主要特色針對 DLP 芯片組的集成型 API 和驅(qū)動程序支持,可實現(xiàn)快速以及可編程圖形集成型攝像頭支持,實現(xiàn)同步捕捉投影儀和攝像頭校準(zhǔn)例程用于生成視差圖、景深圖和點(diǎn)云的結(jié)構(gòu)化照明算法
2018-09-18 08:38:28
3D 點(diǎn)云。高度差異化 3D 機(jī)器視覺系統(tǒng)利用 DLP? LightCrafter? 4500 估模塊 (EVM)(采用 DLP? 0.45 英寸 WXGA 芯片組),能夠靈活控制工業(yè)、醫(yī)療和安全
2022-09-22 10:20:04
被稱之為“堆疊硅片互聯(lián)技術(shù)”的3D封裝方法采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術(shù),實現(xiàn)了多芯
2010-10-29 17:54:25 1168
1168 單片型3D技術(shù)實現(xiàn)的關(guān)鍵在于如何將各層功能單元轉(zhuǎn)換到單片3D堆疊結(jié)構(gòu)之中去,其采用的方法非常類似于Soitec在制作SOI晶圓時所采用的SMARTCUT技術(shù)
2011-05-04 11:27:21 2198
2198 
據(jù)臺灣對外貿(mào)易發(fā)展協(xié)會(TAITRA)透露,芯片代工巨頭臺積電(TSMC)有望超過intel,在2011年底推出業(yè)內(nèi)首款采用3-D芯片堆疊技術(shù)的半導(dǎo)體芯片產(chǎn)品。
2011-07-07 09:19:07 1168
1168 賽靈思采用了稱之為“堆疊硅片互聯(lián)技術(shù)”的 3D 封裝方法,該技術(shù)采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術(shù),實現(xiàn)了多芯片可編程平臺
2011-10-26 14:35:26 3936
3936 2012年4月27日訊 - GLOBALFOUNDRIES今天宣布,在為新一代移動和消費(fèi)電子應(yīng)用實現(xiàn)3D芯片堆疊的道路上,公司達(dá)到了一個重要的里程碑。在其位于美國紐約薩拉托加郡的Fab 8,GLOBALFOUNDRIES已開始
2012-04-28 09:15:03 1772
1772 9月25日——全球電子設(shè)計創(chuàng)新領(lǐng)先企業(yè)Cadence設(shè)計系統(tǒng)公司(NASDAQ:CDNS)今天宣布,臺積電與Cadence合作開發(fā)出了3D-IC參考流程,該流程帶有創(chuàng)新的真正3D堆疊。該流程通過
2013-09-26 09:49:20 1717
1717 光固化3D打印技術(shù)憑借成型表面質(zhì)量好、尺寸精度高以及能夠?qū)崿F(xiàn)比較精細(xì)的細(xì)微之處等特點(diǎn),在3D打印圈小有名氣,也得到了廣泛的應(yīng)用。今天咱們不談技術(shù),聊聊光固化3D打印技術(shù)的核心——光敏樹脂材料
2017-06-27 17:48:57 10848
10848 ;x>nkedIn上發(fā)表了一篇跟澳大利亞科技公司優(yōu)立(Euclideon)所使用的點(diǎn)云數(shù)據(jù)有關(guān)的文章,并在業(yè)內(nèi)引起了一番討論。 1. 點(diǎn)云的問題 點(diǎn)云是由3D掃描硬件收集的數(shù)據(jù),如FARO的Focus 3D激光掃描儀和Shining 3D的Einscan Pro。捕獲3D對象的基本原理是3D掃描儀反饋光
2017-09-15 09:28:05 20
20 。即便是掃描最小的對象,系統(tǒng)都會創(chuàng)建上百萬這樣的點(diǎn),所以要管理這樣的海量數(shù)據(jù)并不容易。CAD軟件可以連接各個點(diǎn),但這一過程需要大量的計算資源,完善成品模型往往是一個艱苦的過程。 從點(diǎn)云(右)到完成的3D模型(左和中心) 優(yōu)立的無限細(xì)節(jié)算法集成到SOLIDSCAN軟件中后能夠?qū)崟r渲染點(diǎn)
2017-09-27 15:27:25 17
17 芯片晶粒在未來搭載愈來愈多晶體管可望成為趨勢,讓芯片運(yùn)算能力達(dá)到人腦水平也可望有朝一日達(dá)成,對于這類新技術(shù)的發(fā)展,在芯片上以及在多層堆疊芯片之間打造先進(jìn)3D結(jié)構(gòu)成為一大主要驅(qū)動力,在2017年
2017-12-20 08:45:50 5710
5710 這款工業(yè)級3D相機(jī)使用動態(tài)結(jié)構(gòu)光方案實現(xiàn)高精度三維點(diǎn)云輸出,采用知微傳感自有的MEMS微振鏡技術(shù),實現(xiàn)了3D相機(jī)的小型化、低成本和高精度。
2018-09-14 10:59:48 5470
5470 被稱之為“堆疊硅片互聯(lián)技術(shù)”的3D封裝方法采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術(shù),實現(xiàn)了多芯片可編程平臺。
2019-01-03 13:20:59 3796
3796 在近日舉行的英特爾“架構(gòu)日”活動中,英特爾不僅展示了基于10納米的PC、數(shù)據(jù)中心和網(wǎng)絡(luò)系統(tǒng),支持人工智能和加密加速功能的下一代“Sunny Cove”架構(gòu),還推出了業(yè)界首創(chuàng)的3D邏輯芯片封裝技術(shù)——Foveros。這一全新的3D封裝技術(shù)首次引入了3D堆疊的優(yōu)勢,可實現(xiàn)在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 8854
8854 英特爾近日向業(yè)界推出了首款3D邏輯芯片封裝技術(shù)“Foveros”,據(jù)悉這是在原來的3D封裝技術(shù)第一次利用3D堆疊的優(yōu)點(diǎn)在邏輯芯片上進(jìn)行邏輯芯片堆疊。也是繼多芯片互連橋接2D封裝技術(shù)之后的又一個顛覆技術(shù)。
2018-12-14 16:16:45 3316
3316 近日,武漢新芯研發(fā)成功的三片晶圓堆疊技術(shù)備受關(guān)注。有人說,該技術(shù)在國際上都處于先進(jìn)水平,還有人說能夠“延續(xù)”摩爾定律。既然3D芯片堆疊技術(shù)有如此大的作用,那今天芯師爺就跟大家一起揭開它的面紗。
2018-12-31 09:14:00 34067
34067 對于目前的高端市場,市場上最流行的2.5D和3D集成技術(shù)為3D堆疊存儲TSV,以及異構(gòu)堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術(shù)已經(jīng)廣泛用于高性能計算
2019-02-15 10:42:19 8043
8043 
從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來。
2019-07-08 11:47:33 5835
5835 對于3D封裝技術(shù),英特爾去年宣布了其對3D芯片堆疊的研究,AMD也談到了在其芯片上疊加3D DRAM和SRAM的方案。
2019-08-13 10:27:53 3414
3414 困于10nm的Intel也在這方面尋找新的機(jī)會,其在去年年底的“架構(gòu)日”活動中,推出其業(yè)界首創(chuàng)的3D邏輯芯片封裝技術(shù)——Foveros,F(xiàn)overos首次引入3D堆疊的優(yōu)勢,可實現(xiàn)在邏輯芯片上堆疊
2020-01-28 16:10:00 4118
4118 德國3D打印機(jī)制造商EOS展示了其超精細(xì)細(xì)節(jié)分辨率(FDR,F(xiàn)INE DETAIL RESOLUTION)3D打印技術(shù)。
2020-05-18 14:51:35 3339
3339 SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內(nèi)系統(tǒng)集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強(qiáng)調(diào)封裝內(nèi)包含了某種系統(tǒng)的功能封裝,3D封裝僅強(qiáng)調(diào)在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 7076
7076 與傳統(tǒng)的大面積SoC相比,3D IC具有許多優(yōu)勢,其中大部分是由于縮短了互連。與2D SoC中的長線相反,功能塊彼此堆疊并通過TSV連接,因此3D IC能夠顯著縮短互連長度。
2020-09-14 16:52:22 2925
2925 三星計劃明年開始與臺積電在封裝先進(jìn)芯片方面展開競爭,因而三星正在加速部署3D芯片封裝技術(shù)。
2020-09-20 12:09:16 3743
3743 在Intel、臺積電各自推出自家的3D芯片封裝技術(shù)之后,三星也宣布新一代3D芯片技術(shù)——X-Cube,基于TSV硅穿孔技術(shù),可以將不同芯片搭積木一樣堆疊起來,目前已經(jīng)可以用于7nm及5nm工藝。
2020-10-10 15:22:58 2004
2004 測量表面法向量估計 幾何測量平面提取 3D重建從離散點(diǎn)云得到光滑曲面 3D重建ICP點(diǎn)云配準(zhǔn) 3D重建SDF表面重建 應(yīng)用例子:從稀疏的點(diǎn)云中,構(gòu)造出可以3D打印的模型 3D物體分割、識別與測量 應(yīng)用算法流程3D物體分割、識別與測量 應(yīng)用算法流程靜態(tài)手勢識別 應(yīng)用算
2020-10-23 09:40:46 4061
4061 
電子發(fā)燒友網(wǎng)為你提供3D堆疊技術(shù)的誘因資料下載的電子資料下載,更有其他相關(guān)的電路圖、源代碼、課件教程、中文資料、英文資料、參考設(shè)計、用戶指南、解決方案等資料,希望可以幫助到廣大的電子工程師們。
2021-03-31 08:50:58 12
12 倒裝芯片技術(shù)正得到廣泛應(yīng)用 ,凸點(diǎn)形成是其工藝過程的關(guān)鍵。介紹了現(xiàn)有的凸點(diǎn)制作方法 ,包括蒸發(fā)沉積、印刷、電鍍、微球法、黏點(diǎn)轉(zhuǎn)移法、SB2 - Jet 法、金屬液滴噴射法等。每種方法都各有其優(yōu)缺點(diǎn) ,適用于不同的工藝要求。可以看到要使倒裝芯片技術(shù)得到更廣泛的應(yīng)用 ,選擇合適的凸點(diǎn)制作方法是極為重要的。
2021-04-08 15:35:47 26
26 堆疊技術(shù)也可以叫做3D堆疊技術(shù),是利用堆疊技術(shù)或通過互連和其他微加工技術(shù)在芯片或結(jié)構(gòu)的Z軸方向上形成三維集成,信號連接以及晶圓級,芯片級和硅蓋封裝具有不同的功能,針對包裝和可靠性技術(shù)的三維堆疊處理技術(shù)。
2022-05-10 15:58:13 4946
4946 
融合標(biāo)注使用的3D標(biāo)注工具仍以3D立體框為主,但在3D點(diǎn)云數(shù)據(jù)以外,還需要使用2D標(biāo)注工具在點(diǎn)云數(shù)據(jù)相對應(yīng)的2D圖像中進(jìn)行標(biāo)注,3D點(diǎn)云數(shù)據(jù)中的標(biāo)注對象與2D圖像中的標(biāo)注對象一一對應(yīng),具體形式如下:
2022-07-21 15:52:36 10125
10125 異質(zhì)整合需要通過先進(jìn)封裝提升系統(tǒng)性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418 目前有多種基于 3D 堆疊方法, 主要包括: 芯片與芯片的堆疊( D2D) 、芯片與圓片的堆疊( D2W ) 以及圓片與圓片的堆疊( W2W) 。
2022-11-01 09:52:51 2488
2488 當(dāng)裸片尺寸無法繼續(xù)擴(kuò)大時,開發(fā)者開始考慮投入對 3D 堆疊裸片方法的研究。考慮用于 3D 封裝的高端器件已經(jīng)將當(dāng)前的可測試性設(shè)計 (DFT) 解決方案推向了極限。
2023-02-28 11:39:26 2362
2362 我們之前見過的閃存多屬于Planar NAND平面閃存,也叫有2D NAND或者直接不提2D的,而3D 閃存,顧名思義,就是它是立體堆疊的,Intel之前用蓋樓為例介紹了3D NAND,普通NAND是平房,那么3D NAND就是高樓大廈,建筑面積一下子就多起來了,理論上可以無線堆疊。
2023-03-30 14:02:39 4227
4227 裸芯通過微凸點(diǎn)組裝到Interposer上,如上圖所示。其Interposer上堆疊了三顆裸芯。Interposer包括兩種類型的互聯(lián):①由微凸點(diǎn)和Interposer頂部的RDL組成的水平互連,它連接各種裸芯②由微凸點(diǎn)、TSV簇和C4凸點(diǎn)組成的垂直互聯(lián),它將裸芯連接至封裝。
2023-04-10 11:28:50 14215
14215 在Hybrid Bonding前,2D,2.5D及3D封裝都是采用焊錫球凸點(diǎn)(solder bump)或微凸點(diǎn)(Micro bump)來實現(xiàn)芯片與基板
2023-04-20 09:40:16 21819
21819 隨著計算機(jī)視覺技術(shù)的不斷發(fā)展,3D 數(shù)字化技術(shù)已經(jīng)成為了當(dāng)今工業(yè)制造領(lǐng)域和三維醫(yī)學(xué)影像領(lǐng)域的關(guān)鍵技術(shù)。然而,構(gòu)建高精度、高分辨率的 3D 點(diǎn)云數(shù)據(jù)集對于實現(xiàn)這一技術(shù)至關(guān)重要。在這篇文章中,我們將深入探討 3D 點(diǎn)云數(shù)據(jù)集的構(gòu)建、應(yīng)用以及其在 3D 數(shù)字化技術(shù)中的重要性。
2023-05-06 16:46:17 2219
2219 凸塊制造技術(shù)(Bumping)是在芯片上制作凸塊,通過在芯片表面制作金屬凸塊提供芯片電氣互連的“點(diǎn)”接口,廣泛應(yīng)用于 FC、WLP、CSP、3D 等先進(jìn)封裝。
2023-05-15 16:42:19 7001
7001 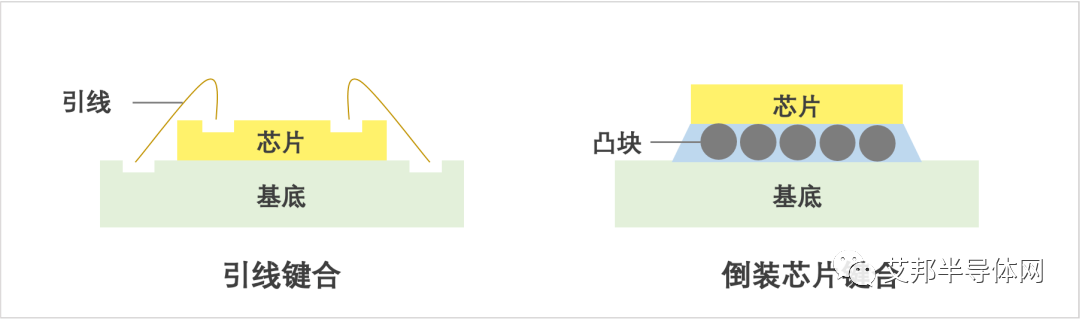
3D NAND閃存是一種把內(nèi)存顆粒堆疊在一起解決2D或平面NAND閃存限制的技術(shù)。這種技術(shù)垂直堆疊了多層數(shù)據(jù)存儲單元,具備卓越的精度,可支持在更小的空間內(nèi),容納更高的存儲容量,從而有效節(jié)約成本、降低能耗,以及大幅度地提升性能。
2023-06-15 09:37:56 3209
3209 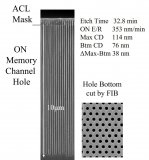
隨著異構(gòu)集成模塊功能和特征尺寸的不斷增加,三維集成技術(shù)應(yīng)運(yùn)而生。凸點(diǎn)之間的互連 是實現(xiàn)芯片三維疊層的關(guān)鍵,制備出高可靠性的微凸點(diǎn)對微電子封裝技術(shù)的進(jìn)一步發(fā)展具有重要意 義。整理歸納了先進(jìn)封裝中的凸點(diǎn)
2023-07-06 09:56:16 5076
5076 
相對于傳統(tǒng)平面型的金絲鍵合焊接的MMIC應(yīng)用,三維(3D)多芯片互連封裝MMIC以其高集成度、低損耗、高可靠性等性能優(yōu)勢,正逐步在先進(jìn)電路與系統(tǒng)中得到應(yīng)用。而3D封裝引入的復(fù)雜電磁耦合效應(yīng),在傳統(tǒng)
2023-08-30 10:02:07 5731
5731 
隨著摩爾定律接近物理界限,在3納米以下的先進(jìn)工藝中,能夠負(fù)擔(dān)較高費(fèi)用的顧客受到限制,晶片sip和邏輯芯片的3D堆疊概念正在成為重要的新一代趨勢。
2023-09-11 11:09:58 2010
2010 長期以來,個人計算機(jī)都可以選擇增加內(nèi)存,以便提高處理超大應(yīng)用和大數(shù)據(jù)量工作的速度。由于3D芯片堆疊的出現(xiàn),CPU芯粒也有了這個選擇,但如果你想打造一臺更具魅力的計算機(jī),那么訂購一款有超大緩存的處理器可能是正確的選擇。
2023-10-15 10:24:23 2733
2733 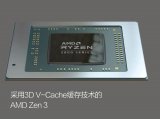
多個垂直堆疊的活動層(模具)較短的垂直互連:功耗、延遲、帶寬..分離的和小的模具:異構(gòu)集成,產(chǎn)量,成本,尺寸山復(fù)雜設(shè)計、設(shè)計自動化和制造過程
2023-10-17 12:25:50 1388
1388 
VT6000系列共聚焦顯微鏡擅長微納級粗糙輪廓的檢測,配備了真彩相機(jī)并提供還原的3D真彩圖像,具有很強(qiáng)的縱向深度的分辨能力,所展示的圖像形態(tài)細(xì)節(jié)更清晰更微細(xì),橫向分辨率更高。為國內(nèi)3D顯微檢測的應(yīng)用場景提供更全的解決方案。
2023-02-03 10:31:49 3
3 3D實例分割(3DIS)是3D領(lǐng)域深度學(xué)習(xí)的核心問題。給定由點(diǎn)云表示的 3D 場景,我們尋求為每個點(diǎn)分配語義類和唯一的實例標(biāo)簽。 3DIS 是一項重要的 3D 感知任務(wù),在自動駕駛、增強(qiáng)現(xiàn)實和機(jī)器人導(dǎo)航等領(lǐng)域有著廣泛的應(yīng)用,其中可以利用點(diǎn)云數(shù)據(jù)來補(bǔ)充 2D 圖像提供的信息。
2023-11-13 10:34:27 3744
3744 
三星計劃在2024年先進(jìn)3D芯片封裝技術(shù)SAINT(Samsung Advanced Interconnection Technology,三星高級互連技術(shù)),能以更小尺寸的封裝,將AI芯片等高性能芯片的內(nèi)存和處理器集成。
2023-11-15 11:09:30 2499
2499 來源:《半導(dǎo)體芯科技》雜志 ASIC設(shè)計服務(wù)暨IP研發(fā)銷售廠商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先進(jìn)封裝服務(wù)。通過獨(dú)家的芯片中介層
2023-11-20 18:35:42 1107
1107 當(dāng)芯片變身 3D 系統(tǒng),3D 異構(gòu)集成面臨哪些挑戰(zhàn)
2023-11-24 17:51:07 1969
1969 
在3D實現(xiàn)方面,存儲器比邏輯更早進(jìn)入實用階段。NAND閃存率先邁向3D 。隨著目前量產(chǎn)的20-15nm工藝,所有公司都放棄了小型化,轉(zhuǎn)而轉(zhuǎn)向存儲單元的三維堆疊,以提高每芯片面積的位密度。它被稱為“ 3D(三維)NAND ” 。
2023-12-02 16:38:40 2967
2967 
中得到了廣泛的應(yīng)用。隨著3D封裝技術(shù)的發(fā)展,凸點(diǎn)鍵合技術(shù)也被應(yīng)用于芯片-芯片、芯片-圓片鍵合及封裝體的3D疊層封裝。
2023-12-05 09:40:00 3259
3259 
隨著I/O數(shù)量的增加,對具有更高性能的微小電子設(shè)備的高需求使得集成電路 (IC) 更加復(fù)雜,封裝技術(shù)也更迎來變革。隨著元件尺寸的減小,IC芯片與焊盤或印刷電路板的互連結(jié)構(gòu)需要用到焊料凸點(diǎn)陣列,從而
2024-01-22 10:04:37 1063
1063 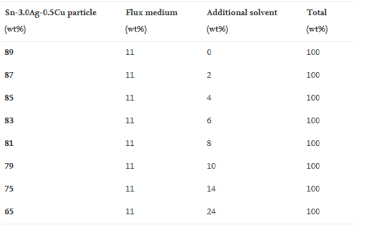
三星將在IEEE國際固態(tài)電路研討會上展示其GDDR7產(chǎn)品以及280層堆疊的3D QLC NAND技術(shù)。
2024-02-01 10:35:31 1299
1299 日月光半導(dǎo)體宣布VIPack? 平臺先進(jìn)互連技術(shù)最新進(jìn)展,透過微凸塊(microbump)技術(shù)將芯片與晶圓互連間距制程能力從 40um提升到 20um,可以滿足人工智能 (AI)應(yīng)用于多樣化小芯片(chiplet)整合日益增長的需求。
2024-03-22 14:15:08 1191
1191 上的先進(jìn)封裝技術(shù)應(yīng)運(yùn)而生。微凸點(diǎn)作為實現(xiàn)芯片到圓片異構(gòu)集成的關(guān)鍵結(jié)構(gòu),可有效縮短信號傳輸距離,提升芯片性能。利用電沉積法在 Si基板上以 Cu作支撐層、Ni作阻擋層淀積微米級別的 Au/Sn凸點(diǎn),所制得的多層凸點(diǎn)直徑約 60 μm、高度約 54 μm,其高
2024-03-23 08:42:10 1560
1560 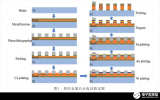
先進(jìn)封裝技術(shù)持續(xù)朝著連接密集化、堆疊多樣化和功能系統(tǒng)化的方向發(fā)展,探索了扇出型封裝、2.5D/3D、系統(tǒng)級封 裝等多種封裝工藝。晶圓微凸點(diǎn)技術(shù)已被廣泛應(yīng)用于各種先進(jìn)封裝工藝技術(shù)中,是最重要的基礎(chǔ)技術(shù)
2024-10-16 11:41:37 2939
2939 
市場對于產(chǎn)品小型化需求增長,讓SiP(系統(tǒng)級封裝)和 PoP(疊成封裝)奠定了先進(jìn)封裝的初始階段。此后,倒裝芯片(Flip-Chip)、晶圓級封裝(WLP)和3D IC封裝技術(shù)出現(xiàn), 不斷縮短芯片之間的互連距離。近年來,先進(jìn)封裝的發(fā)展非常快,臺積電
2024-11-21 10:14:40 4681
4681 
引言 Cu-Cu混合鍵合(Cu-Cu Hybrid Bonding) 技術(shù)正在成為先進(jìn)3D集成的重要技術(shù),可實現(xiàn)細(xì)間距互連和高密度芯片堆疊。本文概述了Cu-Cu混合鍵合的原理、工藝、主要挑戰(zhàn)和主要
2024-11-24 12:47:06 3760
3760 
隨著集成電路技術(shù)的飛速發(fā)展,芯片封裝技術(shù)也在不斷進(jìn)步,以適應(yīng)日益增長的微型化、多功能化和高集成化的需求。其中,球柵陣列封裝(BGA)作為一種先進(jìn)的封裝技術(shù),憑借其硅片利用率高、互連路徑短、信號傳輸
2024-11-28 13:11:04 3498
3498 
晶圓微凸點(diǎn)封裝,更常見的表述是晶圓微凸點(diǎn)技術(shù)或晶圓級凸點(diǎn)技術(shù)(Wafer Bumping),是一種先進(jìn)的半導(dǎo)體封裝技術(shù)。以下是對晶圓微凸點(diǎn)封裝的詳細(xì)解釋:
2024-12-11 13:21:23 1416
1416 在半導(dǎo)體行業(yè)的快速發(fā)展歷程中,芯片封裝技術(shù)始終扮演著至關(guān)重要的角色。隨著集成電路設(shè)計復(fù)雜度的不斷提升和終端應(yīng)用對性能、功耗、尺寸等多方面要求的日益嚴(yán)苛,傳統(tǒng)的2D封裝技術(shù)已經(jīng)難以滿足市場的需求。在此背景下,芯片3D堆疊封裝技術(shù)應(yīng)運(yùn)而生,成為半導(dǎo)體技術(shù)發(fā)展的新里程碑。
2025-02-11 10:53:45 2820
2820 
隨著電子設(shè)備向小型化、高性能化發(fā)展,芯片封裝技術(shù)也在不斷演進(jìn)。高密度芯片封裝是滿足現(xiàn)代電子產(chǎn)品需求的關(guān)鍵技術(shù)之一,而芯片互連技術(shù)作為封裝的核心環(huán)節(jié),經(jīng)歷了從焊球到銅柱再到微凸點(diǎn)的技術(shù)革新。本文將從
2025-02-20 10:06:00 3303
3303 
在摩爾定律逼近物理極限的當(dāng)下,先進(jìn)封裝技術(shù)正成為半導(dǎo)體行業(yè)突破性能瓶頸的關(guān)鍵路徑。以系統(tǒng)級封裝(SiP)、晶圓級封裝(WLP)、3D堆疊、Chiplet異構(gòu)集成為代表的顛覆性方案,正重新定義芯片性能
2025-04-10 14:36:31 1189
1189 
隨著臺積電在 2011年推出第一版 2.5D 封裝平臺 CoWoS、海力士在 2014 年與 AMD 聯(lián)合發(fā)布了首個使用 3D 堆疊的高帶寬存儲(HBM)芯片,先進(jìn)封裝技術(shù)帶來的片上互連拓?fù)浣Y(jié)構(gòu)的改變和帶來的集成能力的提升,成為當(dāng)前片上互連技術(shù)發(fā)展的主要驅(qū)動因素。
2025-05-22 10:17:51 975
975 
先進(jìn)封裝中,凸點(diǎn)作為芯片互連的 “微型橋梁”,材料選擇需匹配場景:錫基焊料(SAC系列、SnBi)性價比高,適用于消費(fèi)電子;銅基凸點(diǎn)適合高頻場景;金錫合金、金屬間化合物則用于特殊領(lǐng)域。其性能需滿足低
2025-07-05 10:43:03 1652
1652 
凸點(diǎn)(Bump)是倒裝芯片的“神經(jīng)末梢”,其從金凸點(diǎn)到Cu-Cu鍵合的演變,推動了芯片從平面互連向3D集成的跨越。未來,隨著間距縮小至亞微米級、材料與工藝的深度創(chuàng)新,凸點(diǎn)將成為支撐異構(gòu)集成、高帶寬芯片的核心技術(shù),在AI、5G、汽車電子等領(lǐng)域發(fā)揮關(guān)鍵作用。
2025-08-12 09:17:55 3767
3767 
、3D及5.5D的先進(jìn)封裝技術(shù)組合與強(qiáng)大的SoC設(shè)計能力,Socionext將提供高性能、高品質(zhì)的解決方案,助力客戶實現(xiàn)創(chuàng)新并推動其業(yè)務(wù)增長。
2025-09-24 11:09:54 2350
2350 
3D封裝架構(gòu)主要分為芯片對芯片集成、封裝對封裝集成和異構(gòu)集成三大類,分別采用TSV、TCB和混合鍵合等先進(jìn)工藝實現(xiàn)高密度互連。
2025-10-16 16:23:32 1553
1553 
在晶圓級封裝(WLP)中,Bump 凸點(diǎn)是芯片與基板互連的關(guān)鍵,主流實現(xiàn)方式有電鍍法、焊料印刷法、蒸發(fā) / 濺射法、球放置法四類,差異顯著。選型需結(jié)合凸點(diǎn)密度、成本預(yù)算與應(yīng)用特性,平衡性能與經(jīng)濟(jì)性。
2025-10-23 14:49:14 1709
1709 
?在芯片成品制造的環(huán)節(jié)中,堆疊封裝(StackedPackaging)是一種將多個芯片垂直堆疊在一起,通過微型互連方式(如TSV硅通孔、RDL重布線層、微凸點(diǎn)等)
2025-10-27 16:40:34 428
428 
堅固的 IP67 防護(hù)等級,即便在強(qiáng)光直射下也能提供穩(wěn)定的深度信息。無論是用于精細(xì)結(jié)構(gòu)掃描,還是高性價比的 3D 采集,對于既需要高細(xì)節(jié)度又要求可靠深度數(shù)據(jù)的應(yīng)用而言,Nion 都是理想之選。 二
2025-12-15 14:59:41 171
171 
燒結(jié)銀:3D封裝中高功率密度和高密度互連的核心材料
2025-12-29 11:16:01 119
119


 電子發(fā)燒友App
電子發(fā)燒友App









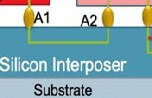













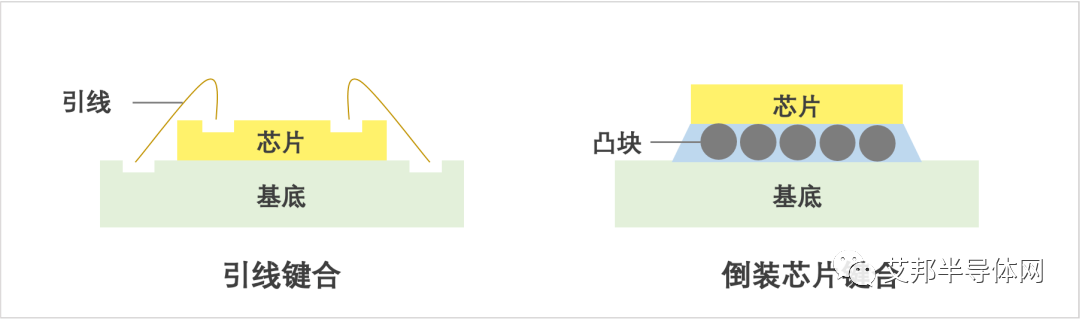
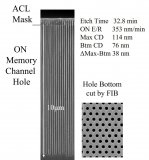


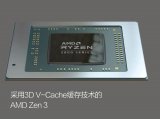





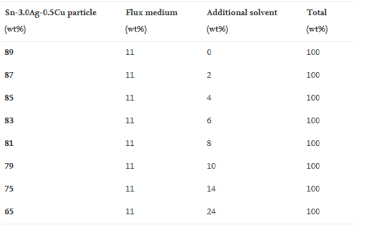
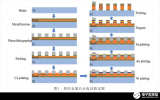


















評論