視為堆疊邏輯與內存、3D NAND,甚至可能在高帶寬存儲(HBM)中的多層DRAM堆疊的關鍵技術。垂直堆疊使得芯片制造商能夠將互連間距從35μm的銅微凸點提升到10μm甚至更小。
2025-05-22 11:24:18 1405
1405 
3D堆疊像素探測器芯片技術詳解
2024-11-01 11:08:07 4435
4435 
芯片堆疊封裝技術實用教程
2024-11-01 11:08:07 4273
4273 
三維集成電路制造中,對準技術是確保多層芯片鍵合精度、實現高密度TSV與金屬凸點正確互聯的核心技術,直接影響芯片性能與集成密度,其高精度可避免互連失效或錯誤,并支持更小尺寸的TSV與凸點以節約面積。
2025-08-01 09:16:51 3050
3050 
11 BGA封裝激光重熔釬料凸點制作技術 11.1 激光重熔釬料合金凸點的特點 BGA/CSP封裝,Flip chip封裝時需要在基板或者芯片上制作釬料合金凸點,釬料合金凸點的制作方法有:釬料濺射
2018-11-23 16:57:28
展會時間:2013年11月7日-9日展會地點:上海世博展覽館指導單位:中華人民共和國工業和信息化部、上海市科學技術委員會主辦單位:中國電子學會承辦單位:深圳物聯傳媒有限公司一、展會介紹:2013中國
2013-05-08 10:42:01
,這些技術使得5G網絡能夠滿足未來物聯網、智能制造、自動駕駛等領域對高速、低時延、高可靠性的通信需求。
5G網絡通信有哪些技術痛點?
5G網絡通信經過多年的高速發展,仍有一些技術痛點未能解決,其技術痛
2025-12-02 06:05:13
覆蓋膜,在關鍵位增加墊層介質,再疊層壓合,而后采用凸點模具沖壓電路板,形成電路板凸點,電鍍鎳金,修整達到凸點平整、高度均勻,凸點金面光亮耐磨,不易下塌等效果。此工藝的常見產品應用:打印機觸控排線柔性
2008-11-15 11:18:43
Business2.0雜志將其評價為“改變未來的七種技術之一”,科研機構和企業對其表現了濃厚的興趣,微流控芯片可應用在生物、化學、化工、機械、環境、材料等領域。深入到微流控芯片研究和產業化的先決條件
2018-06-22 15:59:44
據處理與準備、大數據交易共享等);信息安全;云計算;人工智能(計算機視覺、語音和自然語言、智能機器人技術、深度學習等)。2、物聯網傳感器與芯片物聯網核心元器件(面向物聯網應用的傳感器、芯片、微系統、模組等
2020-06-09 10:02:45
物聯網被業內認為是繼計算機、互聯網之后世界產業技術第三次革命,其市場規模達到萬億級,前景可謂無限光明。根據 IDC 測算,到2021年將會有250 億臺設備聯網,而物聯網芯片作為萬物互聯的關鍵,目前
2019-11-21 16:48:03
物聯網基礎知識點什么是物聯網?特征關鍵技術射頻識別技術傳感網M2M系統框架云計算應用挑戰技術標準的統一與協調管理平臺問題成本問題安全性問題什么是物聯網?物聯網(The Internet
2021-09-16 06:39:30
物聯網基本概念:物聯網是新一代信息技術的重要組成部分,也是“信息化”時代的重要發展階段。從字面意思來看,物聯網就是物物相連的互聯網,物聯網是互聯網的應用拓展,從本質來看,物聯網更偏重于業務和相關
2016-01-21 16:11:25
芯片堆疊技術在SiP中應用的非常普遍,通過芯片堆疊可以有效降低SiP基板的面積,縮小封裝體積。 芯片堆疊的主要形式有四種: 金字塔型堆疊 懸臂型堆疊 并排型堆疊 硅通孔TSV型堆疊
2020-11-27 16:39:05
芯片封裝鍵合技術各種微互連方式簡介微互連技術簡介定義:將芯片凸點電極與載帶的引線連接,經過切斷、沖壓等工藝封裝而成。載帶:即帶狀載體,是指帶狀絕緣薄膜上載有由覆 銅箔經蝕刻而形成的引線框架,而且芯片
2012-01-13 14:58:34
芯片上除焊盤周圍開口之外的所有區域。該開口上噴涂有或鍍有一層凸點下金屬(UBM)。UBM由不同的金屬層疊加而成,充當擴散層、阻擋層、浸潤層和抗氧化層。將焊球滴落(這是其稱為落球的原因)在UBM上,并經
2018-10-17 10:53:16
SnAgCu無鉛焊料中Sn的含量較高,焊接溫度也比較高,導致了焊點中Cu的溶解速度和界面金屬間化合物的生長速度遠高于SnPb系焊料。相關研究表明,焊點與金屬接點間的金屬間化合物的形態和長大對焊點
2020-02-25 16:02:25
POCT市場規模約占體外診斷市場的10%以上,增速超過20%。POCT技術的發展經歷了從定性、半自動定量、到半定量產品,再到全自動定量產品四個發展時代,精密度與自動化程度逐漸提升。而微流控技術的興起
2023-03-22 14:31:23
。使用軟焊可以消除應力,卻要以熱疲勞和低強度為代價,而硬焊具有高強度卻無法消除應力。瞬態液相鍵合技術要求使用一個擴散勢壘,以防止Si3N4襯底上的銅金屬化層與用來鍵合SiC芯片的Au層之間的互擴散
2018-09-11 16:12:04
運行的設備,點進即可進行控制。6 示例效果7 注意事項1)如果出現:”該設備當前不可用“,首先檢查是否按照官方教程進行操作,如果是,則重新配置網絡(微信),重試關注微信公眾號【口袋物聯】,微信號為koudaiwulian,分享更多物聯網知識。
2015-11-21 20:26:53
需求者能夠敏捷開發出專業的物聯網應用系統。 從技術層面來說:公司的核心技術定位于“萬物互聯技術”,自主協議、自主芯片、自主平臺和自主生態,獨家推出了SDWSN軟件定義傳感器網絡技術、CWSN無線云
2018-05-21 16:52:09
(TSV)的形成與金屬化、晶圓減薄與調整粘接技術? 光學芯片-芯片互連無源元件(電阻、電容和電感等)的集成就是一個實例。與采用CMOS工藝將這些器件集成起來的方法相比,三維集成是一種很好的替代方法,它可
2011-12-02 11:55:33
(主要是Al2O3和AlN)鍵合銅箔的一種金屬化方法,它是隨著板上芯片(COB)封裝技術的興起而發展出來的一種新型工藝。其基本原理是在Cu與陶瓷之間引進氧元素,然后在1065~1083℃時形成Cu/O
2021-03-10 12:00:17
研究的互響應思想有效地解決了當今獨立的二維電子地圖和三維虛擬場景各自不足之處,做到了兩者間的優勢互補。文章還對二維電子地圖和三維虛擬場景中的可視化以及互響應后的可視化問題進行了探討。最后在VC++平臺
2010-04-24 09:56:22
焊料球的基底,UBM與圓片上的金屬化層有著非常好的粘附特性,與焊料球之間也有著良好的潤濕特性。UBM在焊料球與IC金屬焊盤之間作為焊料的擴散層,同時UBM作為氧化阻擋層還起著保護芯片的作用。芯片凸點
2018-11-26 16:13:59
); (6)下填充。 4.倒裝芯片焊接的關鍵技術 芯片上制作凸點和芯片倒裝焊工藝是推廣倒裝芯片焊接的技術關鍵。 (1)凸點制作 凸點制作工藝很多,如蒸發/濺射法、焊膏印刷-回流法、化鍍法、電鍍法
2020-07-06 17:53:32
)一般用半導體前端工藝的光刻及蒸發、電鍍或絲網印刷的方式生成[1]。為了防止焊球金屬(多為鉛錫合金)對芯片電路的擴散,需要在產生凸點前在芯片表面制作球下金屬層(UBM)進行隔離。圖4顯示了倒裝芯片凸點
2018-11-23 17:03:35
關于物聯網互操作平臺和動態網絡協議的介紹
2021-05-24 06:21:12
單芯片互補式金屬氧化物半導體(CMOS)傳感器有哪幾種?它們分別有什么應用以及特點?
2021-06-17 08:54:54
。基于“不要破壞現狀”的理念,電網演化的一個關鍵挑戰是如何實現互操作性。如何在繼續向最新以太網技術過渡以及采用Sub-1 GHz、Bluetooth?和Wi-Fi?等無線技術的同時,結合采用RS-232
2022-11-09 06:22:46
斯利通陶瓷電路板分析4種陶瓷電路板制造技術中,激光活化金屬化將成主流工藝
2021-01-06 07:03:36
間的數據傳輸,飛睿科技代理樂鑫方案,提供ESP32 WiFi芯片模塊技術和方案,針對有特殊功能需求的客戶,可提供定制服務。ESP32系列模組具備高性能和豐富的外設,集Wi-Fi、傳統藍牙、低功耗藍牙為一體,提供集成Wi-Fi和藍牙連接的MCU整體解決方案,廣泛適用于各物聯網應用。
2021-08-06 14:13:51
晶圓凸點模板技術和應用效果評價詳細介紹了晶圓凸點目前的技術現狀,應用效果,通過這篇文章可以快速全面了解晶圓凸點模板技術晶圓凸點模板技術和應用效果評價[hide][/hide]
2011-12-02 12:44:29
IC尺寸微縮仍面臨挑戰。為了使芯片微縮,總是利用光刻技術來推動。然而近期Sematech在一次演講中列舉了可維持摩爾定律的其他一些技術。1. 零低k界面:在目前Intel的45nm設計中,采用硅襯底
2014-01-04 09:52:44
大神,能解釋以下為什么在通孔位置金屬化會出現空洞或者較金屬化缺嗎?
2016-10-30 14:06:51
在電力物聯網大發展時代下,芯片成為保障電力物聯網系統與全鏈條高效運轉的核心動力,也對電力物聯網各環節高效配合起到至關重要的作用。在電力行業,瑞芯微的工規芯片已被廣泛用于各類電網的數據采集分析
2022-07-25 15:48:24
作用稱為沾錫,它在各個部分之間構成分子間鍵,生成一種金屬合金共化物。1. 沾錫作用當熱的液態焊錫溶解并滲透到被焊接的金屬表面時,就稱為金屬的沾錫或金屬被沾錫。焊錫與銅的混合物的分子形成一種新的部分是銅
2018-02-07 11:57:23
`華爾街日報發布文章稱,科技產品下一個重大突破將在芯片堆疊領域出現。Apple Watch采用了先進的的3D芯片堆疊封裝技術作為幾乎所有日常電子產品最基礎的一個組件,微芯片正出現一種很有意思的現象
2017-11-23 08:51:12
門外漢一個。膠體金屬顆粒很容易做到10nm以下,能否用于制作芯片?別笑!
2018-04-18 19:02:07
請問物聯網引爆點是什么?
2021-06-15 08:30:13
大家好, 在Ultrascale FPGA中,使用單片和下一代堆疊硅互連(SSI)技術編寫。 “單片和下一代堆疊硅互連(SSI)技術”是什么意思?謝謝娜文G K.
2020-04-27 09:29:55
點焊機交流焊機 氣動中頻電阻焊接機 金屬點凸焊機廠家批發點焊是一種形成結合的金屬連接,在焊接時焊件通過焊接電流局部發熱,并在焊件的接觸加熱處施加壓力,形成一個焊點。點焊目前被廣泛的應用于各個工件部門
2021-11-27 16:03:09
鐵絲長臂氣動電焊機 臺式金屬平臺點凸焊機 網片排焊機電阻焊機焊接方法主要有即點焊、縫焊、凸焊、對焊。排焊機隸屬于其中的點焊,分為C型單頭排焊機,C型多頭排焊機及龍門式多頭排焊機。由于焊接電極為方塊
2021-12-22 11:44:38
本文提出一種基于凸包的齒痕點的快速定位方法。在詳細討論了如何將圖形學中的經典凸包算法應用于數字化中醫舌診的齒痕定位中后,通過相關舌圖做實驗,證明了該方法在快
2009-08-10 10:09:46 6
6 什么是堆疊交換機
堆疊技術擴展
堆疊技術是目前在以太網交換機上擴展端口使用較多的另一類技術,是一種非標準化技術。各個廠商之間不支持混
2008-10-20 09:26:28 3332
3332 
Numonyx與Intel 開發堆疊式交叉點相變化內存技術
Numonyx B.V. 與 Intel Corporation 宣布相變化內存 (PCM) 研究的關鍵性突破
2009-11-13 15:04:44 1174
1174 引言
線路板在機加工之后的微、通孔板,孔壁裸露的電介質必須經過金屬化和鍍銅導電處理,毫無疑問,其目的是為了確保良好的導
2010-10-22 16:53:22 2724
2724 被稱之為“堆疊硅片互聯技術”的3D封裝方法采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術,實現了多芯
2010-10-29 17:54:25 1168
1168 賽靈思采用了稱之為“堆疊硅片互聯技術”的 3D 封裝方法,該技術采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術,實現了多芯片可編程平臺
2011-10-26 14:35:26 3932
3932 賽靈思打造了堆疊硅片互聯(SSI)技術。該技術在無源硅中介層上并排連接著幾個硅切片(有源切片),該切片再由穿過該中介層的金屬連接,與印制電路板上不同 IC 通過金屬互聯通信的方式
2011-10-26 14:26:53 4317
4317 ST-Ericsson計劃2012年將銅柱凸塊納入技術藍圖,隨著芯片制程逐漸微縮到28納米,同時成本降低壓力依舊存在,各家手機芯片大廠相繼采用,預料將掀起銅柱凸塊風潮,成為繼銅打線封裝制
2011-11-30 09:14:45 3381
3381 芯片堆疊封裝是提高存儲卡類產品存儲容量的主流技術之一,采用不同的芯片堆疊方案,可能會產生不同的堆疊效果。針對三種芯片堆疊的初始設計方案進行了分析,指出了堆疊方案失
2012-01-09 16:14:14 42
42 本文研究主要考慮基于CuSn金屬互化物的微凸點(bump)作為芯片堆疊的手段。系統研究了形成金屬互化物凸點連接的兩種方法。一:瞬時液相(TLP)鍵合,在此過程中,全部Sn焊料熔化,隨后
2012-05-04 16:26:11 4180
4180 
被稱之為“堆疊硅片互聯技術”的3D封裝方法采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術,實現了多芯片可編程平臺。
2019-01-03 13:20:59 3796
3796 在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 8854
8854 近日,武漢新芯研發成功的三片晶圓堆疊技術備受關注。有人說,該技術在國際上都處于先進水平,還有人說能夠“延續”摩爾定律。既然3D芯片堆疊技術有如此大的作用,那今天芯師爺就跟大家一起揭開它的面紗。
2018-12-31 09:14:00 34067
34067 微流控芯片技術在水環境污染分析中的研究尚處于起步階段,因此多集中于優先污染物的相關報道,主要包括重金屬、營養元素、有機污染物和微生物等。
2019-01-29 14:40:16 4262
4262 對全新芯片堆疊技術的全面支持確保實現最高性能的3D-IC解決方案
2019-05-18 11:28:01 4231
4231 裸芯片封裝技術之一,在LSI 芯片的電極區制作好金屬凸點,然后把金屬凸點與印刷基板上的電極區進行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術中體積最小、最薄的一種。
2019-08-12 11:28:43 9444
9444 從英特爾所揭露的技術資料可看出,Foveros本身就是一種3D IC技術,透過硅穿孔(Through-Silicon Via, TSV)技術與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來。
2019-08-14 11:18:42 4607
4607 
倒裝芯片技術正得到廣泛應用 ,凸點形成是其工藝過程的關鍵。介紹了現有的凸點制作方法 ,包括蒸發沉積、印刷、電鍍、微球法、黏點轉移法、SB2 - Jet 法、金屬液滴噴射法等。每種方法都各有其優缺點 ,適用于不同的工藝要求。可以看到要使倒裝芯片技術得到更廣泛的應用 ,選擇合適的凸點制作方法是極為重要的。
2021-04-08 15:35:47 26
26 ,華為這次公布的芯片堆疊專利是2019年10月3日申請的,涉及電子技術領域,用于解決如何將多個副芯片堆疊單元可靠的鍵合在同一主芯片堆疊單元上的問題。 在美國將華為列入芯片制裁名單后,華為的芯片技術遭到了前所未有的限制,許多全球知名的半導體企
2022-05-07 15:59:43 101144
101144 電子發燒友網報道(文/黃山明)近日,華為密集公布了多項技術專利,其中引人注意的是華為再次公布了兩項與芯片堆疊有關的專利。為何說再次,因為就在一個月前,華為同樣公開了“一種芯片堆疊封裝及終端設備”的專利。多項與芯片堆疊相關專利的公開,或許也揭露了華為未來在芯片技術上的一個發展方向。
2022-05-09 09:50:20 6384
6384 堆疊技術也可以叫做3D堆疊技術,是利用堆疊技術或通過互連和其他微加工技術在芯片或結構的Z軸方向上形成三維集成,信號連接以及晶圓級,芯片級和硅蓋封裝具有不同的功能,針對包裝和可靠性技術的三維堆疊處理技術。
2022-05-10 15:58:13 4946
4946 
7月27日至29日,點成生物科技(虹科旗下生物科技公司)受邀參加第五屆微流控技術應用創新論壇,布展展示微流控芯片、壓力泵、循環泵等高端產品,并進行微流控前沿技術分享演講。
2022-08-01 10:35:26 2805
2805 
“芯片堆疊”技術近段時間經常聽到,在前段時間蘋果舉行線上發布會時,推出了號稱“史上最強”的Apple M1 ultra,這就是一種采用堆疊思路設計的芯片。
2022-08-11 15:39:02 10366
10366 
微流控技術將化學和生物等領域中涉及的各種基本操作單元集成到一塊非常小的芯片上,由微通道形成網絡,以可控流體貫穿整個系統,實現不同實驗室的各種功能,本文將主要介紹點成Microfluidic微流控集成系統的應用原理和領域。
2022-11-16 11:06:54 1652
1652 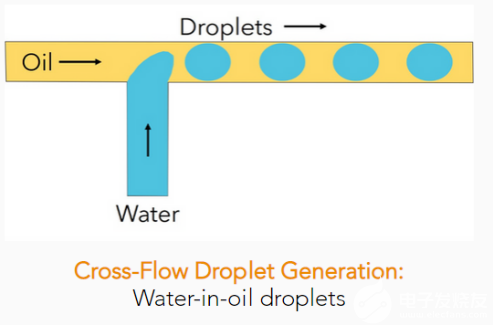
在TAB和FCB中也存在WB中的部分失效問題,同時也有它們自身的特殊問題,如由于芯片凸點的高度-致性差,群焊時凸點形變不一-致,從面造成各焊點的
鍵合強度有高有低;由于凸點過低,使集中于焊點周圍的熱應力過大,而易造成鈍化層開裂;
2022-12-02 11:12:05 1211
1211 為什么芯片可以進行堆疊呢?這里面我們講的主要是未經過封裝的裸芯片。曾經有用戶問我,封裝好的芯片可不可以進行堆疊呢?一般來說是不可以的,因為封裝好的芯片引腳在下表面直接焊接到基板上,而裸芯片的引腳一般在芯片上表面,通過鍵合的方式連接到基板。
2023-02-11 09:44:18 2847
2847 GRANDMICRO有容微:閑聊物聯網射頻芯片(代理商KOYUELEC光與電子提供技術交流支持)
2023-03-02 10:59:52 1383
1383 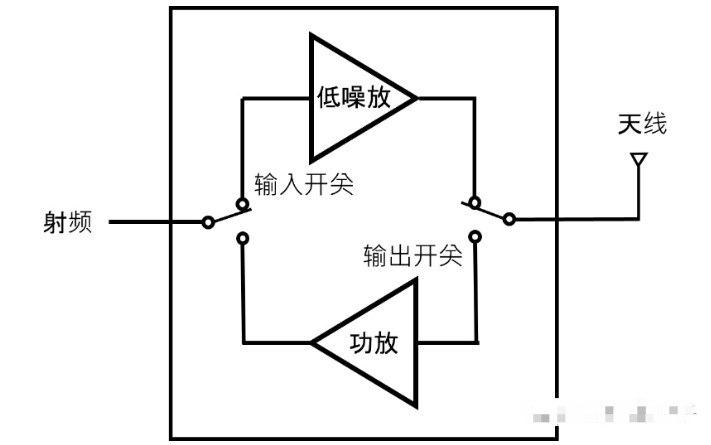
裸芯通過微凸點組裝到Interposer上,如上圖所示。其Interposer上堆疊了三顆裸芯。Interposer包括兩種類型的互聯:①由微凸點和Interposer頂部的RDL組成的水平互連,它連接各種裸芯②由微凸點、TSV簇和C4凸點組成的垂直互聯,它將裸芯連接至封裝。
2023-04-10 11:28:50 14212
14212 凸塊是指按設計的要求,定向生長于芯片表面,與芯片焊盤直接或間接相連的具有金屬導電特性的凸起物。
2023-04-27 09:48:06 8971
8971 
圓片級芯片尺寸封裝(WLCSP)是指在圓片狀態下完成再布線,凸點下金屬和焊錫球的制備,以及圓片級的探針測試,然后再將圓片進行背面研磨減薄
2023-05-06 09:06:41 4461
4461 
凸塊制造技術(Bumping)是在芯片上制作凸塊,通過在芯片表面制作金屬凸塊提供芯片電氣互連的“點”接口,廣泛應用于 FC、WLP、CSP、3D 等先進封裝。
2023-05-15 16:42:19 7001
7001 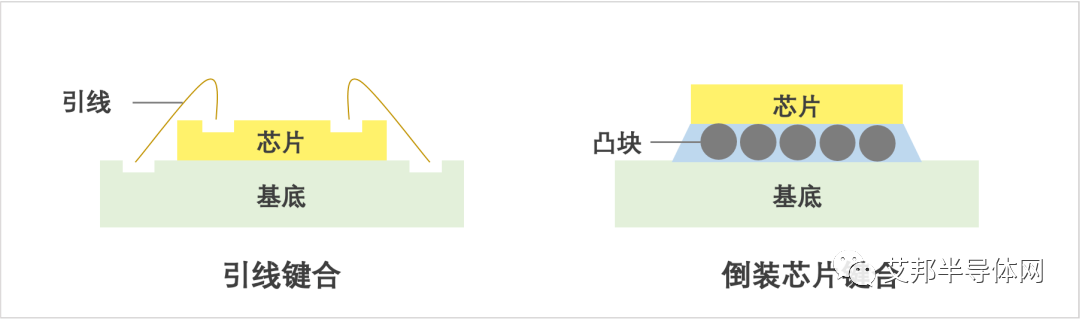
微凸天線結構端莊、高姿、美觀、優雅。圖1示意了我們在微帶天線的矩形(方形)金屬貼片上增加微型長方(立方)金屬體,在微帶天線的圓形金屬貼片上增加微型圓柱金屬體,在微帶天線的圓形金屬貼片上增加微型圓球金屬體所形成的微凸天線。
2023-06-19 10:21:04 6185
6185 
近日,中科億海微與龍芯中科完成了產品兼容互認證明。經過龍芯中科技術股份有限公司(簡稱“龍芯中科”)和中科億海微電子科技(蘇州)有限公司(簡稱“中科億海微”)的聯合嚴格測試,現得出以下結論:中科億海微
2022-01-12 10:01:47 1647
1647 
電阻焊機氣動點凸焊機鋼筋網片焊接點焊機點焊是焊件在接頭處接觸面的個別點上被焊接起來,點焊要求金屬要有較好的塑性。焊接時,先把焊件表面清理干凈,再把被焊的板料搭接裝配好,壓在兩柱狀銅電極之間,施加壓力
2021-11-26 18:11:32 2362
2362 
BEOnChip是西班牙的一家專注于微流控技術領域的公司,主要生產或定制微流控芯片。2021年7月,點成生物與BEOnChip正式達成戰略合作協議,成為BEOnChip芯片的官方授權代理商。本文總結
2022-09-15 10:19:26 1450
1450 
物聯網智能化硬件模塊芯片一級封裝膠底部填充膠點膠應用由漢思新材料提供客戶是一家:專注于物聯網全方位相關技術的公司,專注于互聯網技術、物聯網技術物聯網智能化硬件模塊、電子專業設備的研發,計算機軟件
2023-06-14 15:51:49 1277
1277 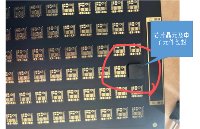
隨著異構集成模塊功能和特征尺寸的不斷增加,三維集成技術應運而生。凸點之間的互連 是實現芯片三維疊層的關鍵,制備出高可靠性的微凸點對微電子封裝技術的進一步發展具有重要意 義。整理歸納了先進封裝中的凸點
2023-07-06 09:56:16 5076
5076 
芯片技術領域的應用概要,用于簡化芯片堆疊結構及其形成方法、芯片封裝結構、電子設備、芯片堆棧結構的制造技術。該芯片的堆疊結構至少包括兩個堆疊的芯片,每一個芯片包括電線層,電線層設有電具組。
2023-08-09 10:13:42 2753
2753 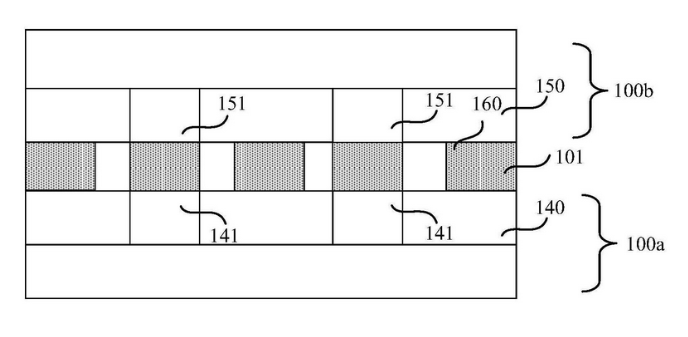
多個垂直堆疊的活動層(模具)較短的垂直互連:功耗、延遲、帶寬..分離的和小的模具:異構集成,產量,成本,尺寸山復雜設計、設計自動化和制造過程
2023-10-17 12:25:50 1388
1388 
自從IBM于20世紀60年代開發出可控塌陷芯片連接(Controlled Collapse Chip Connect,C4)技術,或稱倒裝芯片技術,凸點鍵合在微電子封裝領域特別是芯片與封裝基板的鍵合
2023-12-05 09:40:00 3259
3259 
隨著I/O數量的增加,對具有更高性能的微小電子設備的高需求使得集成電路 (IC) 更加復雜,封裝技術也更迎來變革。隨著元件尺寸的減小,IC芯片與焊盤或印刷電路板的互連結構需要用到焊料凸點陣列,從而
2024-01-22 10:04:37 1063
1063 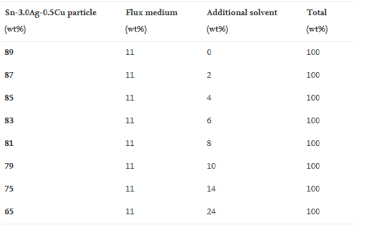
這項技術采用新型金屬疊層于微凸塊之上,達成20μm(2*10-5米)芯片與晶圓之間的極致間距,較從前方案減少了一半。此舉大幅度增強了硅-硅互連能力,對其它開發過程大有裨益。
2024-03-22 13:59:55 1350
1350 上的先進封裝技術應運而生。微凸點作為實現芯片到圓片異構集成的關鍵結構,可有效縮短信號傳輸距離,提升芯片性能。利用電沉積法在 Si基板上以 Cu作支撐層、Ni作阻擋層淀積微米級別的 Au/Sn凸點,所制得的多層凸點直徑約 60 μm、高度約 54 μm,其高
2024-03-23 08:42:10 1560
1560 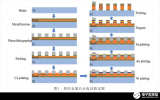
最近,我們收到了一位來自半導體行業的客戶的咨詢,他們有一個關于倒裝芯片封裝凸點剪切力測試的需求,希望能夠獲得合適的測試設備。為了解決客戶的測試需求,科準測控為其定制了一套技術方案,包括相應的檢測儀
2024-04-08 14:05:52 1530
1530 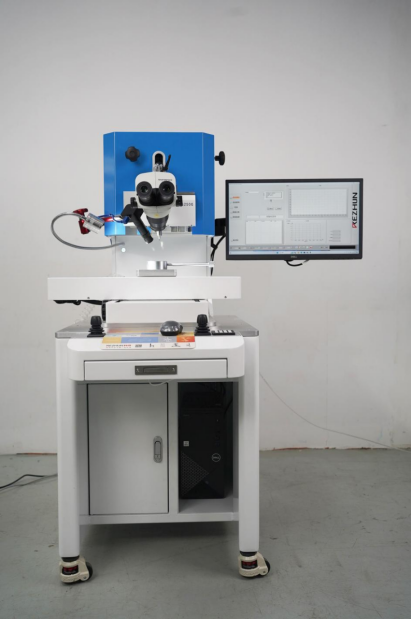
凸點金屬化是為了將半導體中P-N結的性能引出,其中熱壓倒裝芯片連接最合適的凸點材料是金,凸點可以通過傳統的電解鍍金方法生成,或者采用釘頭凸點方法,后者就是引線鍵合技術中常用的凸點形成工藝。
2024-04-19 11:46:10 2724
2724 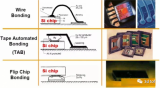
無鉛共晶焊料在厚Cu凸點下金屬化層上的潤濕反應涉及多個方面,以下是對這一過程的詳細分析:
我們對4種不同的共晶焊料(SnPb、SnAg、SnAgCu 和 SnCu)在電鍍制備的厚Cu(15 μm)UBM層上的反應進行比較分析。
2024-08-12 13:08:41 1059
1059 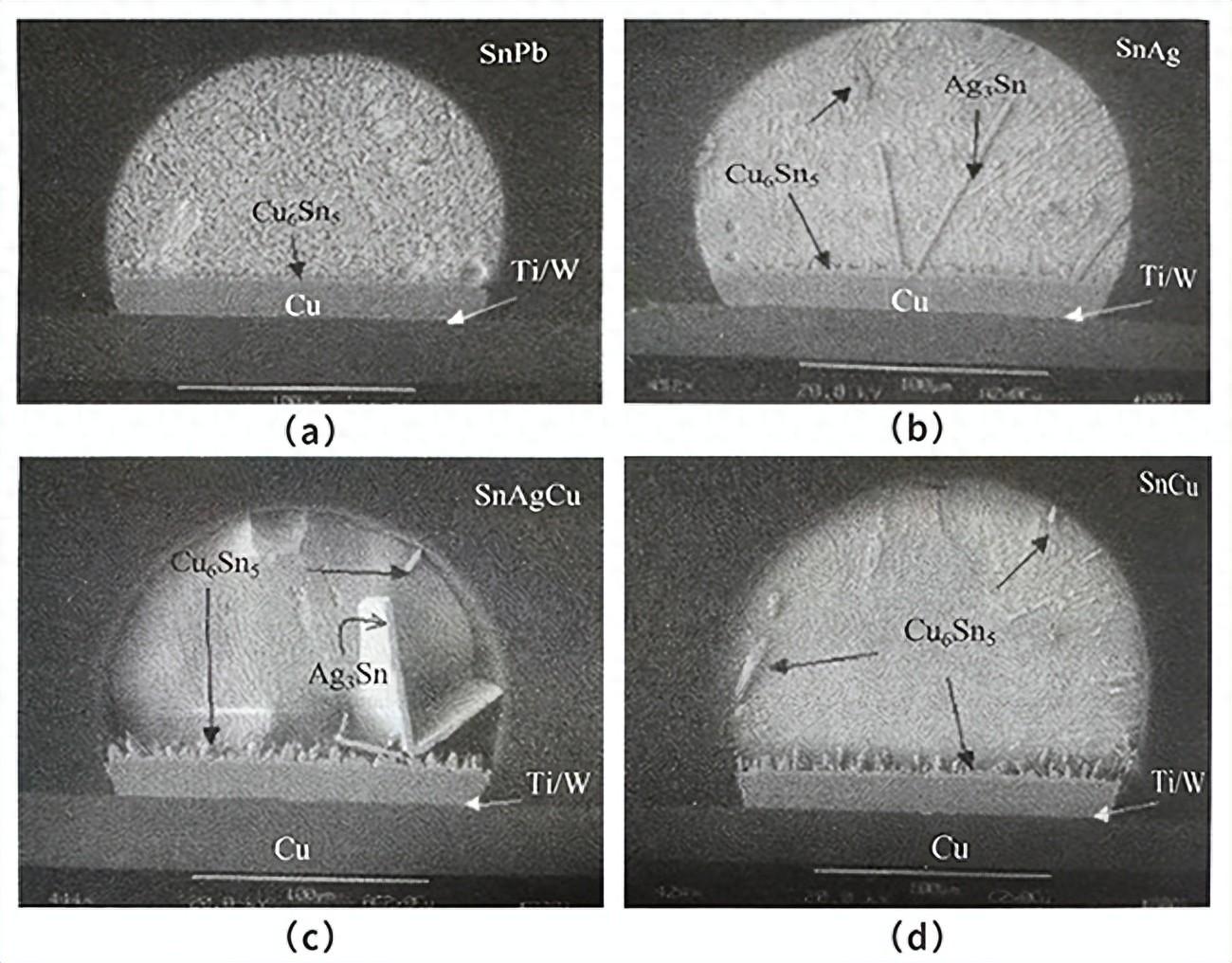
先進封裝技術持續朝著連接密集化、堆疊多樣化和功能系統化的方向發展,探索了扇出型封裝、2.5D/3D、系統級封 裝等多種封裝工藝。晶圓微凸點技術已被廣泛應用于各種先進封裝工藝技術中,是最重要的基礎技術
2024-10-16 11:41:37 2939
2939 
在半導體制造領域,晶圓級凸點制作是一項關鍵技術,對于提高集成電路的集成度和性能具有重要意義。其中,甲酸回流工藝作為一種重要的凸點制作方法,因其具有工藝簡單、成本低廉、易于控制等優點而被廣泛應用。本文
2024-11-07 10:41:44 2641
2641 
隨著集成電路技術的飛速發展,芯片封裝技術也在不斷進步,以適應日益增長的微型化、多功能化和高集成化的需求。其中,球柵陣列封裝(BGA)作為一種先進的封裝技術,憑借其硅片利用率高、互連路徑短、信號傳輸
2024-11-28 13:11:04 3498
3498 
晶圓微凸點封裝,更常見的表述是晶圓微凸點技術或晶圓級凸點技術(Wafer Bumping),是一種先進的半導體封裝技術。以下是對晶圓微凸點封裝的詳細解釋:
2024-12-11 13:21:23 1416
1416 隨著電子設備向小型化、高性能化發展,芯片封裝技術也在不斷演進。高密度芯片封裝是滿足現代電子產品需求的關鍵技術之一,而芯片互連技術作為封裝的核心環節,經歷了從焊球到銅柱再到微凸點的技術革新。本文將從
2025-02-20 10:06:00 3303
3303 
多芯片堆疊技術的出現,順應了器件朝著小型化、集成化方向發展的趨勢。該技術與先進封裝領域中的系統級封裝(SIP)存在一定差異。
2025-04-12 14:22:05 2567
2567 
先進封裝中,凸點作為芯片互連的 “微型橋梁”,材料選擇需匹配場景:錫基焊料(SAC系列、SnBi)性價比高,適用于消費電子;銅基凸點適合高頻場景;金錫合金、金屬間化合物則用于特殊領域。其性能需滿足低
2025-07-05 10:43:03 1652
1652 
凸點(Bump)是倒裝芯片的“神經末梢”,其從金凸點到Cu-Cu鍵合的演變,推動了芯片從平面互連向3D集成的跨越。未來,隨著間距縮小至亞微米級、材料與工藝的深度創新,凸點將成為支撐異構集成、高帶寬芯片的核心技術,在AI、5G、汽車電子等領域發揮關鍵作用。
2025-08-12 09:17:55 3756
3756 
在晶圓級封裝(WLP)中,Bump 凸點是芯片與基板互連的關鍵,主流實現方式有電鍍法、焊料印刷法、蒸發 / 濺射法、球放置法四類,差異顯著。選型需結合凸點密度、成本預算與應用特性,平衡性能與經濟性。
2025-10-23 14:49:14 1704
1704 
?在芯片成品制造的環節中,堆疊封裝(StackedPackaging)是一種將多個芯片垂直堆疊在一起,通過微型互連方式(如TSV硅通孔、RDL重布線層、微凸點等)
2025-10-27 16:40:34 428
428 





 電子發燒友App
電子發燒友App




















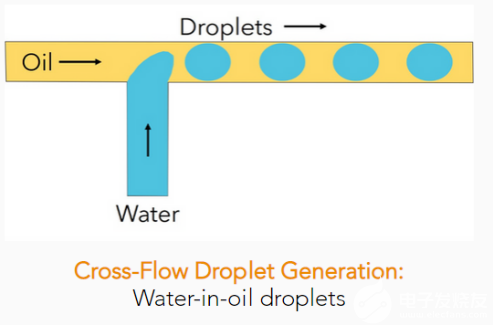
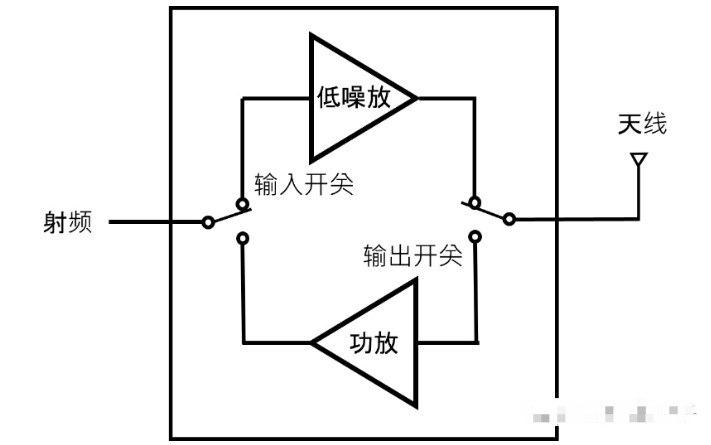


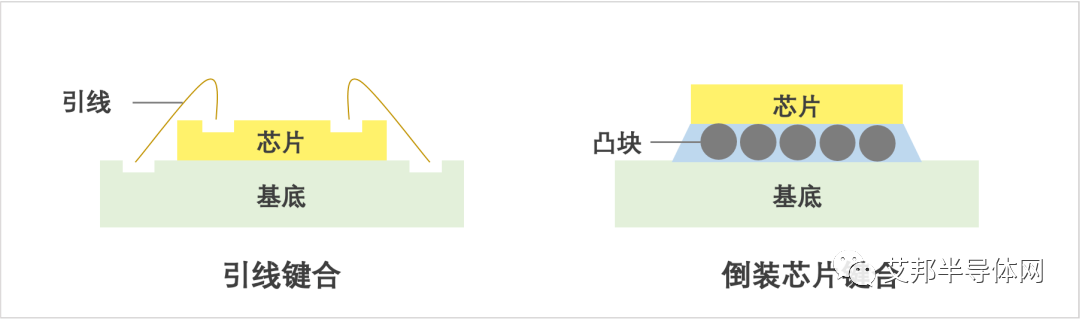




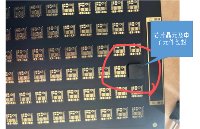

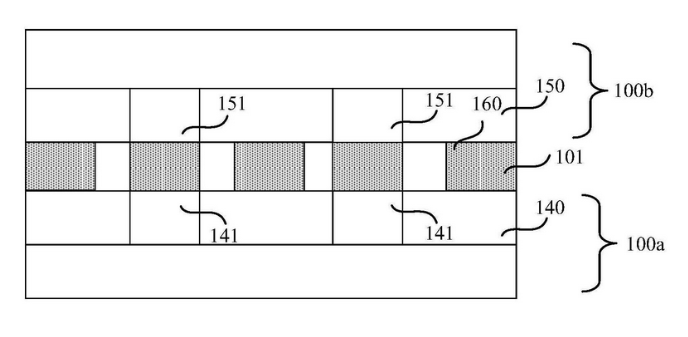


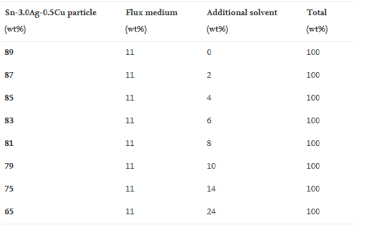
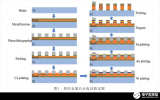
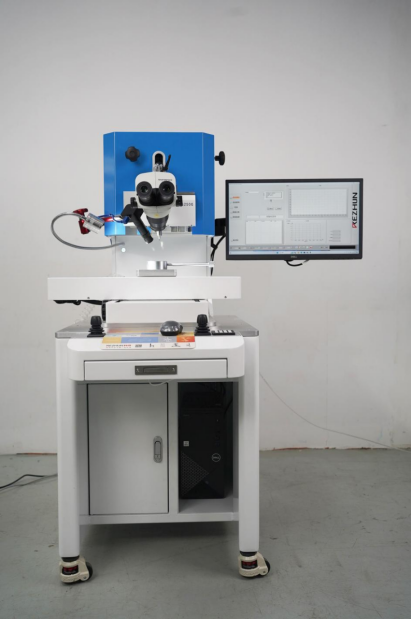
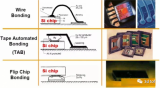
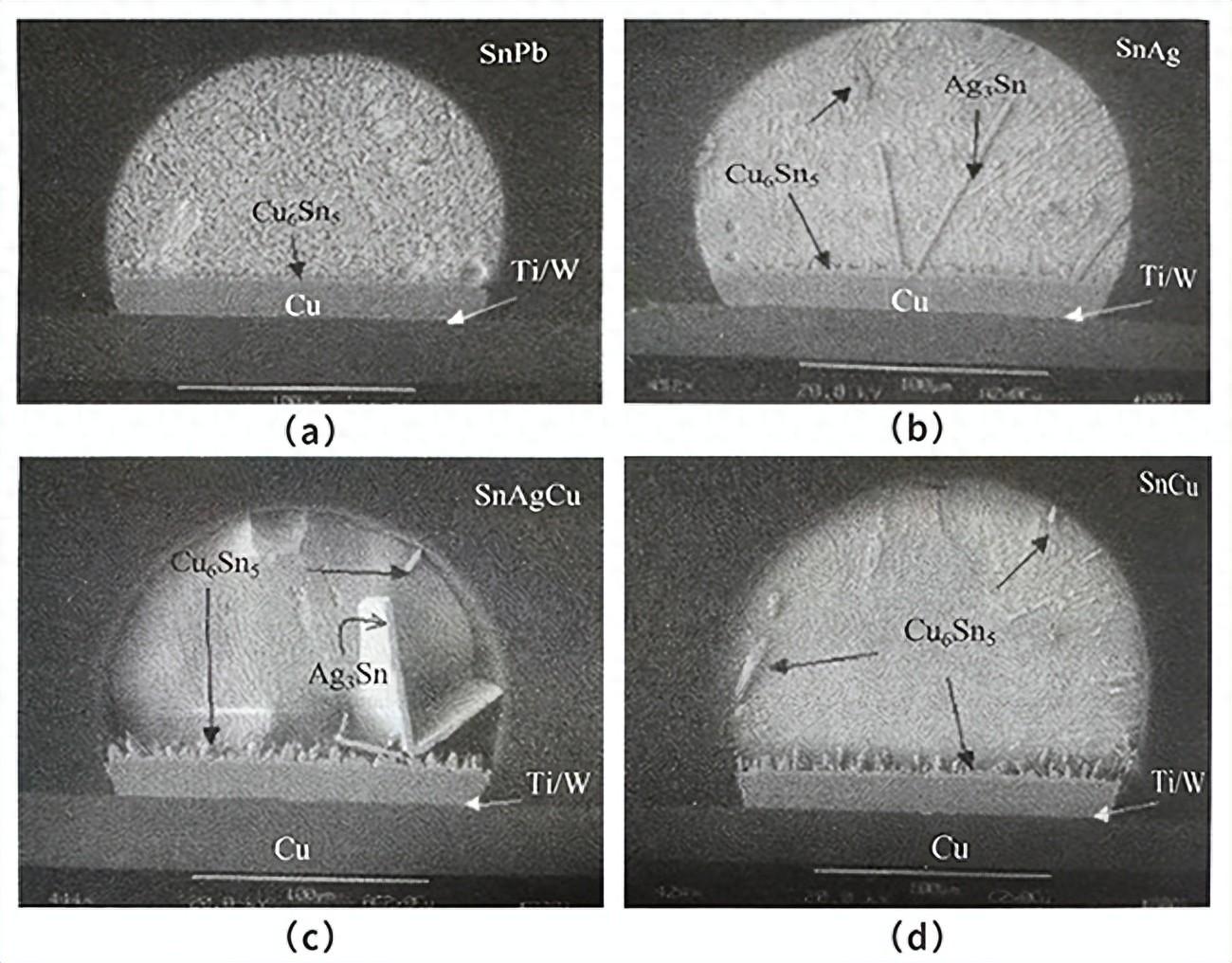












評論