引言
Cu-Cu混合鍵合(Cu-Cu Hybrid Bonding) 技術正在成為先進3D集成的重要技術,可實現細間距互連和高密度芯片堆疊。本文概述了Cu-Cu混合鍵合的原理、工藝、主要挑戰和主要行業參與者的最新進展[1]。
Cu-Cu混合鍵合技術簡介
Cu-Cu混合鍵合是芯片堆疊技術,結合了Cu-Cu金屬鍵合和介電-介電鍵合,通常是氧化物-氧化物鍵合。工藝通常包括以下關鍵步驟:
對Cu焊盤和介電表面進行化學機械拋光(CMP)
表面活化,通常使用等離子體處理
介電表面在室溫下鍵合
退火以促進Cu-Cu互擴散并形成強金屬鍵
與使用焊料凸點的傳統倒裝芯片鍵合相比,Cu-Cu混合鍵合具有以下優勢:
更細的間距(亞微米)互連
更好的散熱性能
更薄的封裝厚度
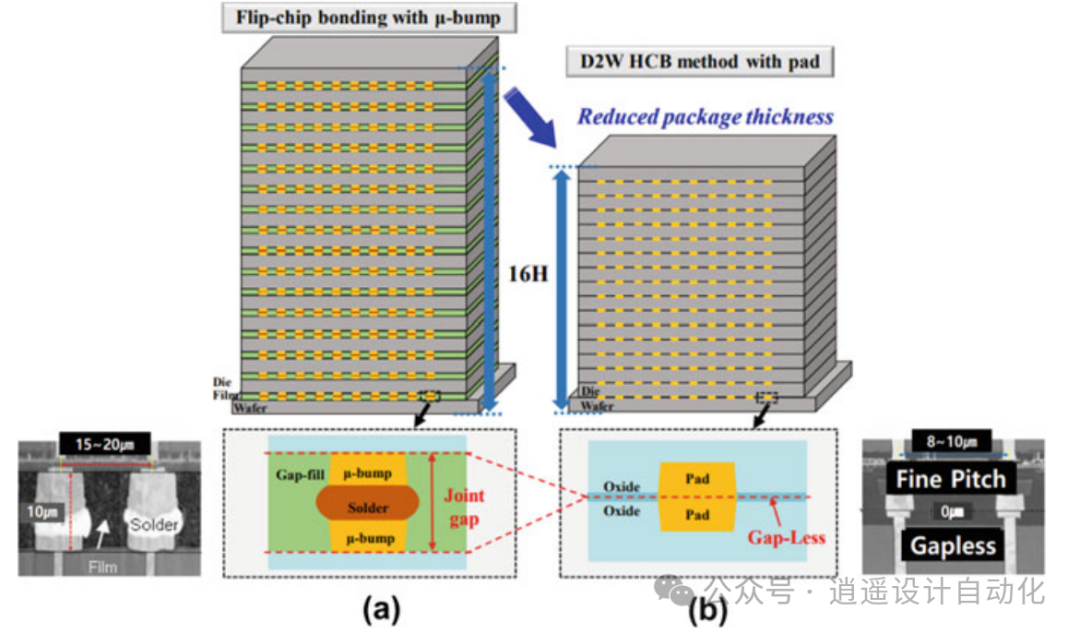
圖1:(a)倒裝芯片焊料回流和(b)Cu-Cu混合鍵合的16H HBM結構對比。混合鍵合方法實現了更薄的封裝,芯片之間無間隙連接。
關鍵工藝步驟和挑戰
表面準備
獲得超平滑和清潔的鍵合表面對成功實現混合鍵合很重要。化學機械拋光(CMP)用于使Cu焊盤和介電表面平坦化。精確控制Cu凹陷(凹陷)很重要 - 通常只允許幾納米的凹陷。
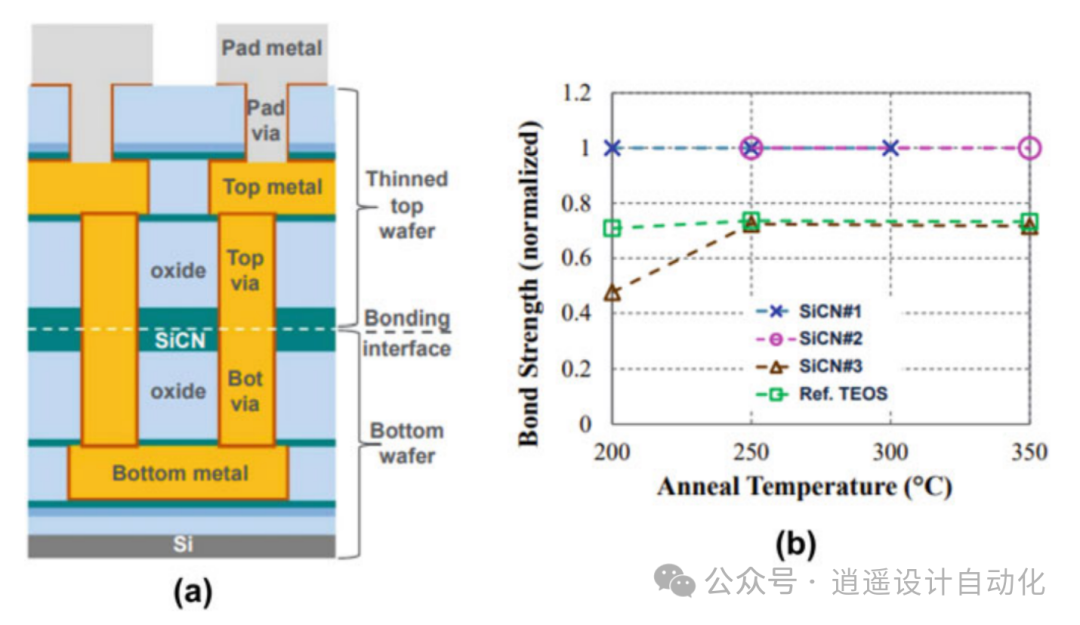
圖2:使用SiCN作為鍵合層的晶圓對晶圓混合鍵合集成流程。CMP用于在鍵合前使表面平坦化。
表面活化
等離子體處理通常用于在鍵合前活化介電表面。這在表面上創建反應性羥基(OH)基團,以實現室溫鍵合。需要優化等離子體條件以獲得高鍵合強度。
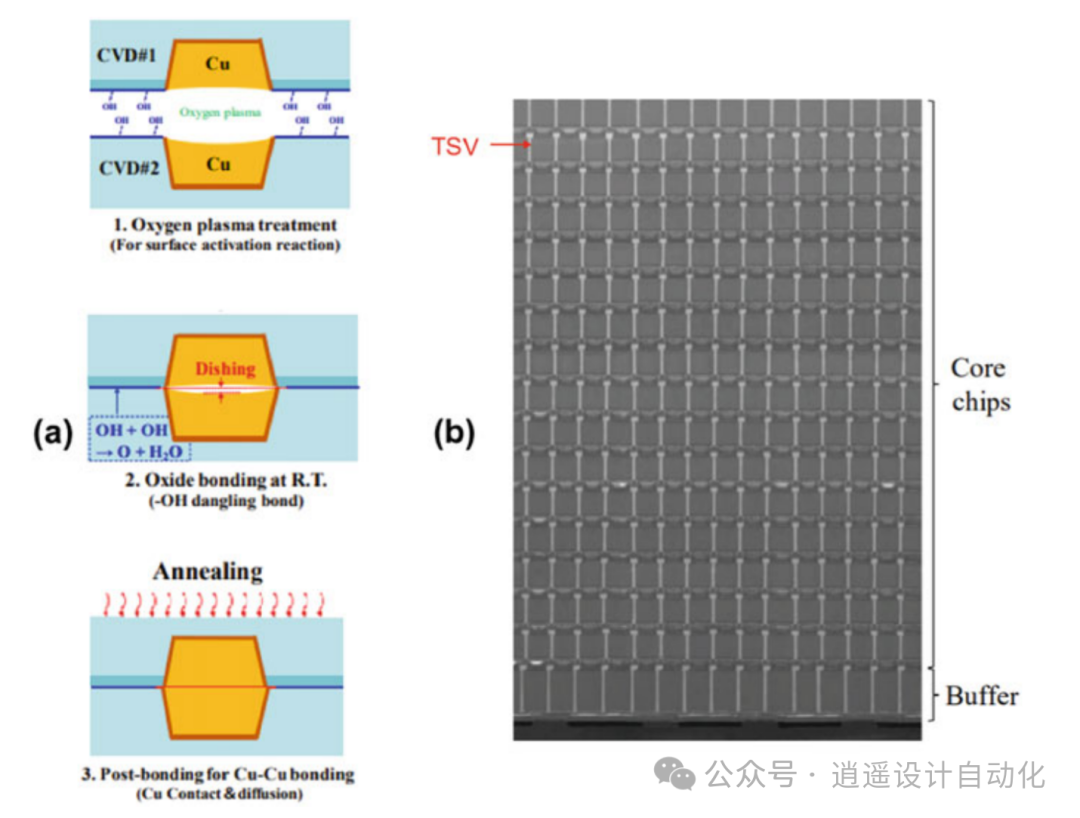
圖3:關鍵的混合鍵合工藝步驟,包括通過等離子體處理進行表面活化,以創建羥基基團實現室溫鍵合。
室溫鍵合
將活化的晶圓或芯片在室溫下接觸,使介電表面形成初始鍵合。精確對準對細間距互連尤為關鍵。
退火
鍵合后退火,通常在200-400°C下進行,使Cu原子能夠跨鍵合界面擴散,形成強金屬-金屬鍵。需要優化退火條件,以實現良好的Cu鍵合,同時避免空洞形成等問題。
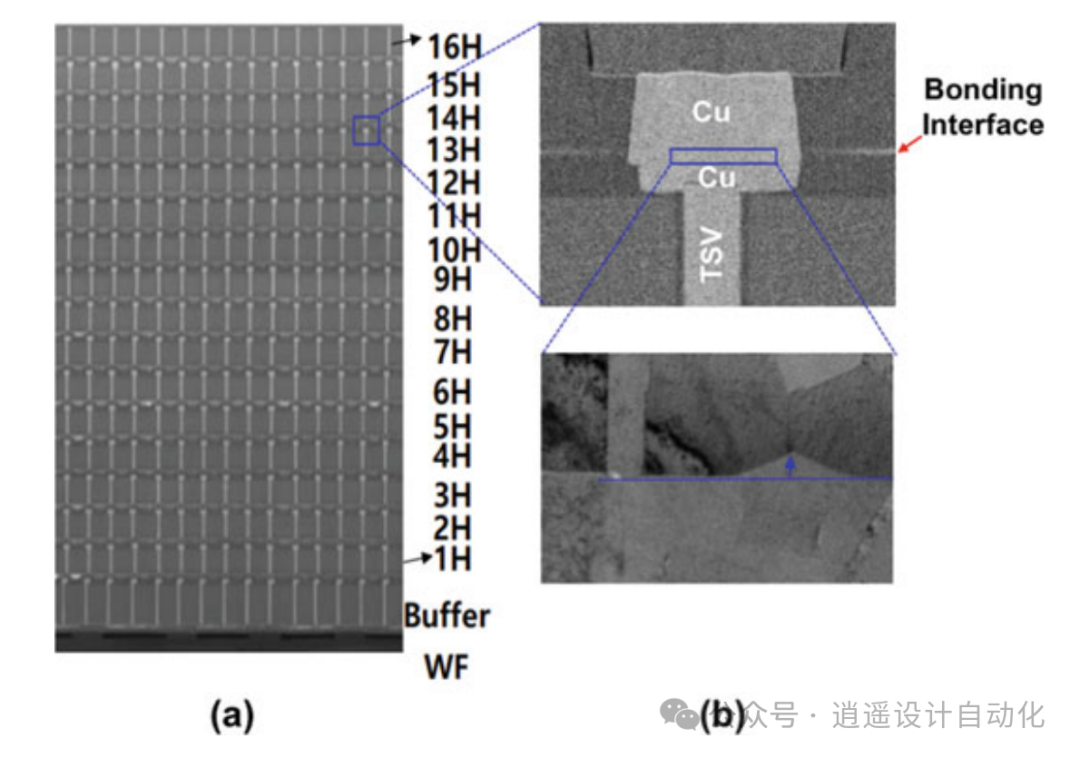
圖4:(a)16H HBM整體結構和(b)退火后Cu-Cu界面的橫截面SEM圖像,顯示跨鍵合界面的重結晶Cu晶粒。
主要挑戰
Cu-Cu混合鍵合的主要挑戰包括:
實現并維持超清潔的鍵合表面
精確控制Cu凹陷/凹陷
優化等離子體活化以獲得高鍵合強度
精確對準,特別是對于細間距
鍵合界面處的空洞/缺陷控制
某些應用的熱預算限制
主要參與者的最新進展
三星一直在積極開發用于高帶寬內存(HBM)應用的混合鍵合技術。已經展示了使用混合鍵合的16H HBM堆疊。
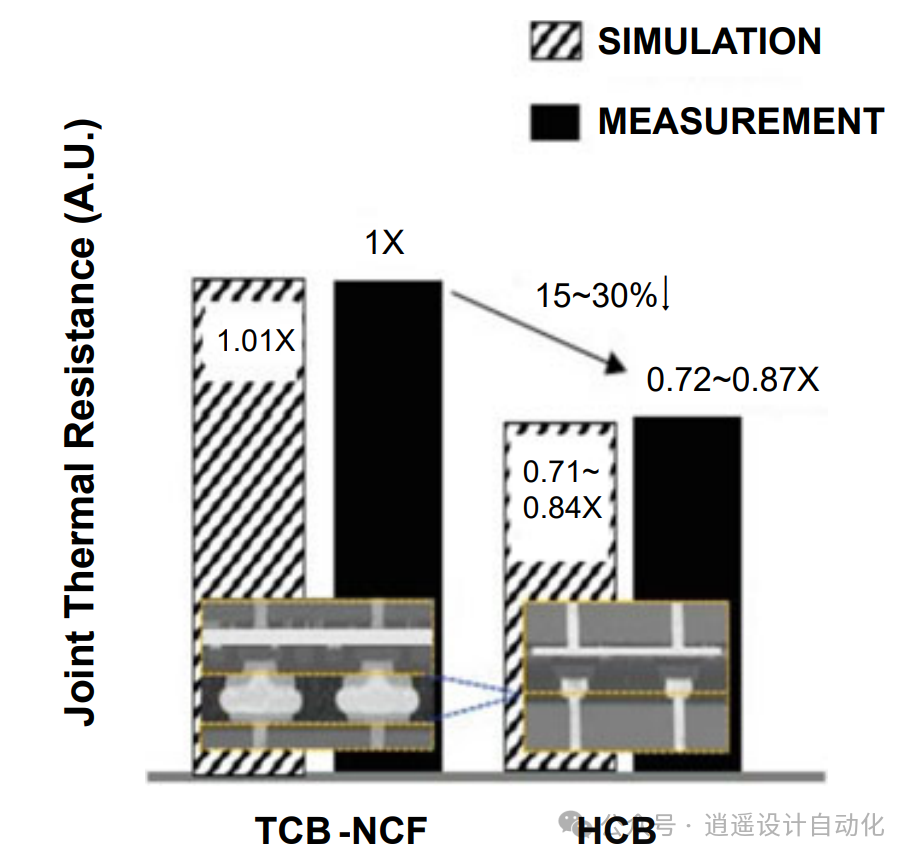
圖5:使用TCB-NCF和混合鍵合方法的16H HBM堆疊熱阻對比。混合鍵合方法顯示出15-30%較低的熱阻。
三星還提出了新型結構,如鍵合界面處的Cu-Cu布線,以進一步改善電氣和熱性能。
SK海力士
SK海力士也在追求用于HBM的混合鍵合。已經展示了使用芯片對晶圓(C2W)混合鍵合的8Hi HBM堆疊。
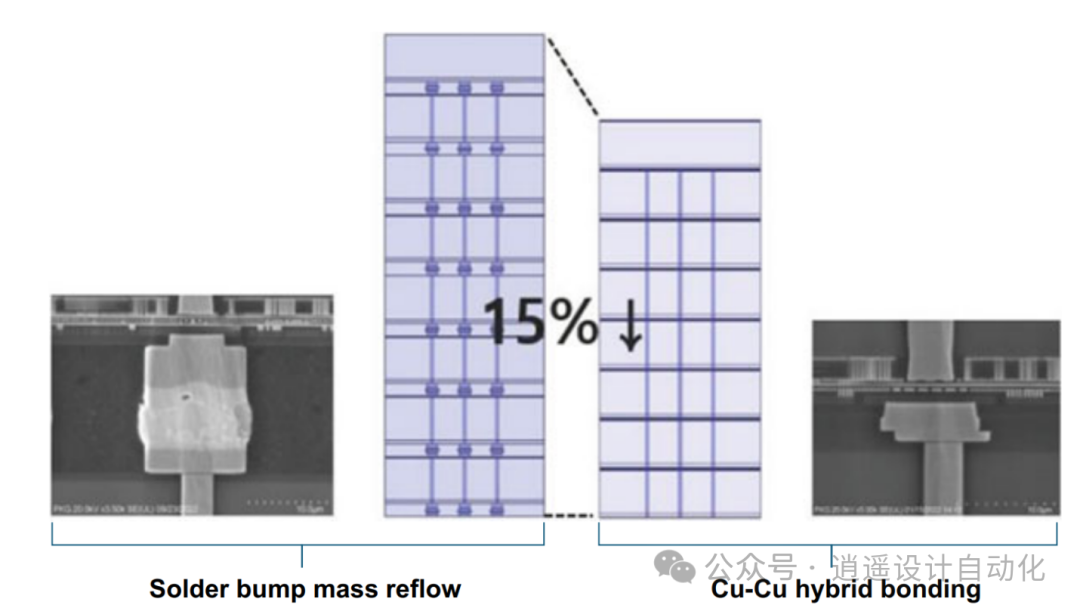
圖6:8Hi HBM的焊料凸點倒裝芯片和混合鍵合互連結構對比,顯示使用混合鍵合可減少15%的厚度。
SK海力士的工作集中在優化等離子體處理和鍵合條件,以實現高鍵合強度和低空洞密度。
美光
美光正在開發用于HBM和潛在3D DRAM應用的混合鍵合。他們強調了幾個關鍵挑戰,包括:
晶圓切割后的顆粒控制
傳統晶圓支撐系統的限制
需要更高溫度的退火
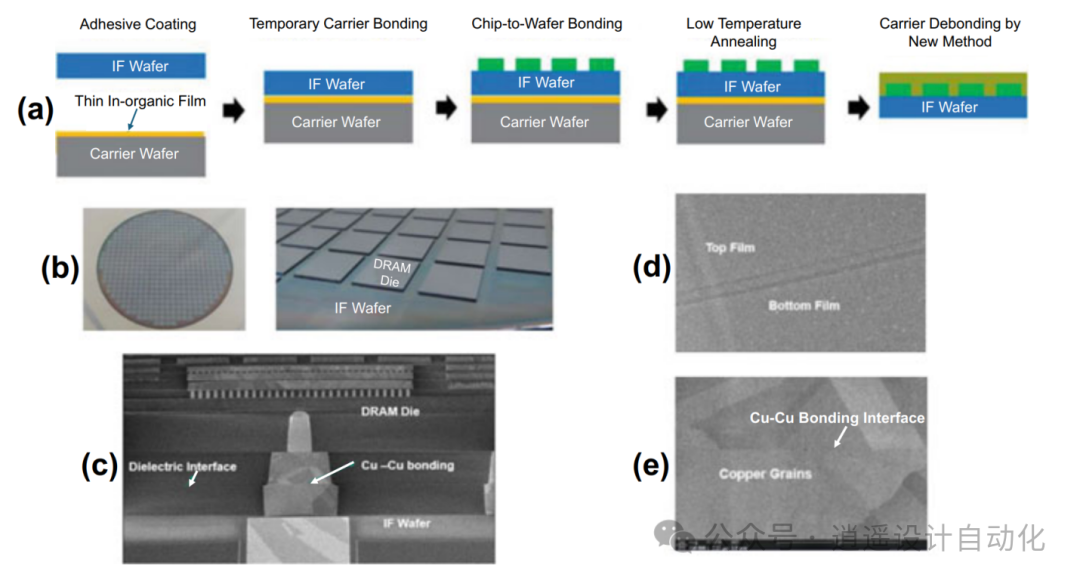
圖7:美光的新晶圓支撐系統(WSS)工藝,可實現更高溫度退火,提高混合鍵合質量。
索尼
作為CMOS圖像傳感器混合鍵合的早期采用者,索尼繼續推進該技術。最近的工作集中在:
大尺寸(>400 mm2)芯片對晶圓鍵合
細間距(6 μm)互連
新型結構,如界面處的Cu-Cu布線

圖8:索尼在鍵合界面處的新型Cu-Cu布線結構,除了電氣接觸外,還可將Cu圖案用作互連。
應用材料
作為主要設備供應商,應用材料正在開發先進節點的混合鍵合工藝和工具。最近的工作展示了:
0.5 μm間距的晶圓對晶圓鍵合
使用SiCN作為鍵合介電材料
Cu凹陷控制在<2-3 nm

圖9:應用材料公司展示的各種特征尺寸和間距(小至0.5 μm)的混合鍵合結果TEM圖像。
英特爾正在研究混合鍵合作為其先進封裝路線圖的一部分。最近的工作集中在:
用于鍵合介電的低溫SiCN薄膜
表面活化效果的表征
鍵合強度優化
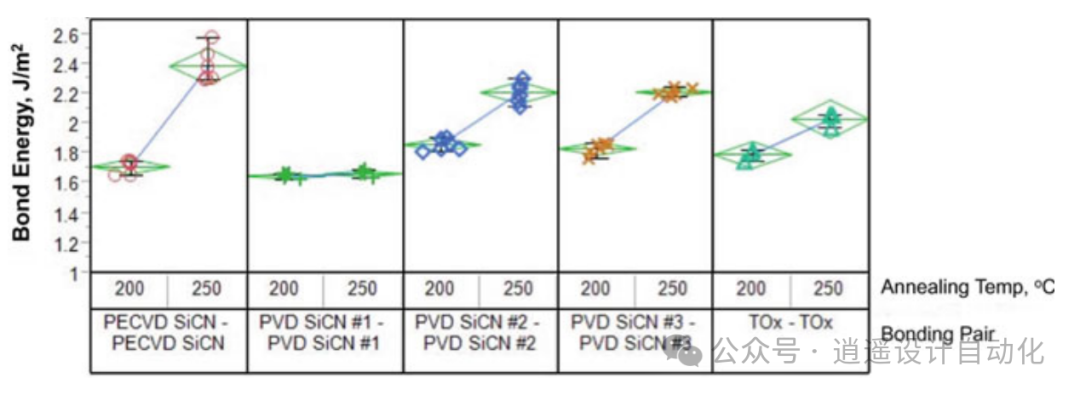
圖10:英特爾研究中各種SiCN-SiCN鍵合界面和退火溫度的鍵合能量(強度)結果。
臺積電
臺積電正在其SoIC(集成芯片系統)平臺下開發混合鍵合。正在推進芯片對晶圓(SoIC-X)和晶圓對晶圓(SoIC-CoWoS)方法。
最近的工作集中在:
熱管理優化
TSV與鍵合焊盤直接連接
超薄鍵合膜
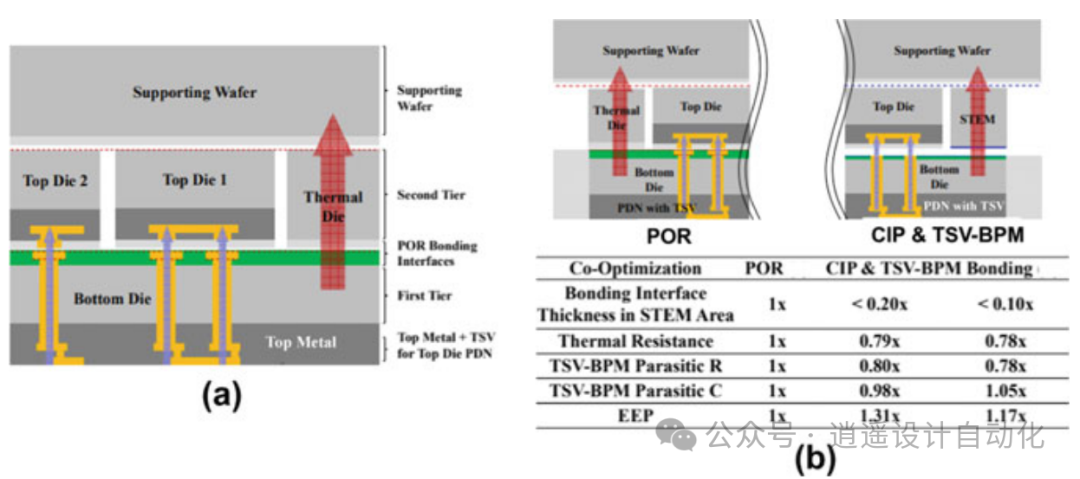
圖11:臺積電SoIC平臺中背面鍵合界面電氣-熱協同優化方法。
新興研究方向
正在追求幾個有趣的研究方向,以進一步推進混合鍵合技術:
1. 新型鍵合材料
雖然SiO2和SiCN是常見的鍵合介電材料,但也在研究其他材料。例如,Resonac提出使用環氧模塑料(EMC)和光敏性介電材料(PID)等有機材料進行混合鍵合。
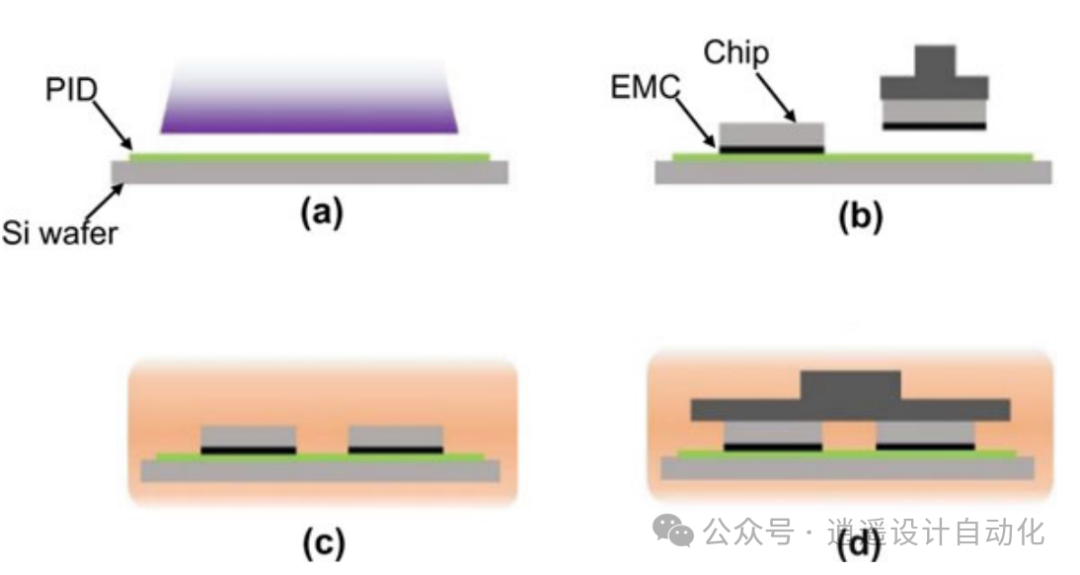
圖12:Resonac使用EMC芯片和PID晶圓進行混合鍵合的熱鍵合工藝。
2. 金屬間化合物形成
一些研究人員正在探索在鍵合界面處控制形成金屬間化合物。例如,德累斯頓工業大學的工作研究了用于混合鍵合的超薄Cu-Sn雙層。

圖13:不同退火溫度下超薄Cu-Sn雙層的金屬間化合物生長研究。
3. 新鍵合機制
IMEC報告了一種"Cu鼓包"機制,可實現亞微米間距的混合鍵合。這涉及在退火過程中控制Cu擴散以填充界面處的小間隙。
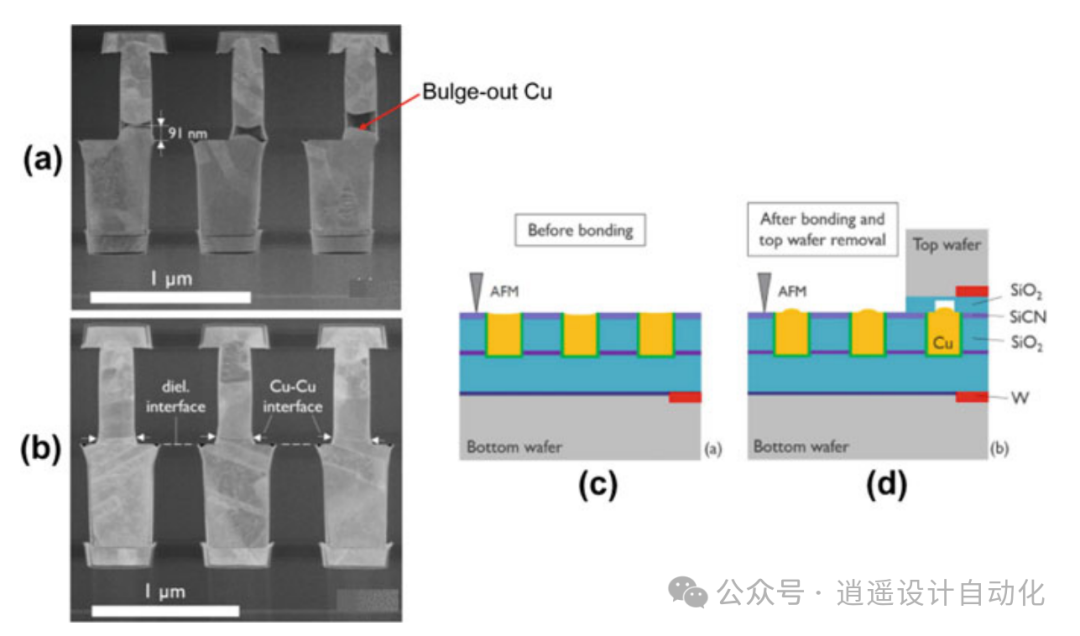
圖14:IMEC的Cu"鼓包"機制支持亞微米混合鍵合的TEM橫截面圖。
4. 替代鍵合方法
雖然大多數混合鍵合工作集中在室溫下的氧化物對氧化物鍵合,然后退火,但也在探索一些替代方法。例如,加州大學洛杉磯分校提出了一種兩階段熱壓縮鍵合(TCB)方法,簡化了工藝。
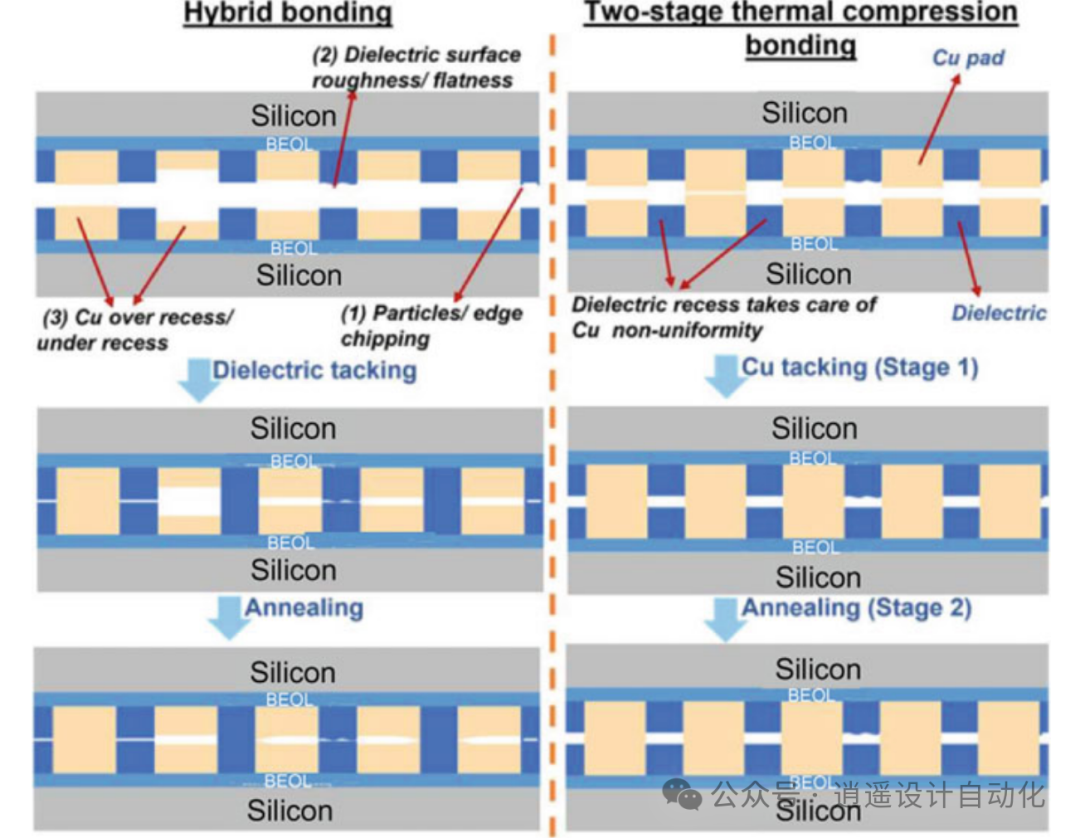
圖15:傳統混合鍵合與加州大學洛杉磯分校提出的兩階段Cu-Cu TCB方法的比較。
結論
Cu-Cu混合鍵合正在迅速發展成為下一代3D集成的關鍵技術。主要的存儲器和邏輯制造商,以及設備和材料供應商,正在積極開發和優化混合鍵合工藝。主要關注領域包括更細間距擴展、更大尺寸晶圓/芯片鍵合、新型材料系統以及與先進節點器件的集成。
取得了重大進展,但仍然存在幾個挑戰,特別是在表面準備、對準精度和缺陷控制方面。需要在材料、工藝和設備方面繼續創新,以實現混合鍵合在廣泛應用中的大規模制造。
隨著半導體行業不斷推動更高水平的集成和性能,Cu-Cu混合鍵合將在實現先進3D和異構集成方案中發揮關鍵作用。未來幾年可能會看到混合鍵合在需要超高密度互連的存儲器、處理器、傳感器和其他應用中得到更廣泛的應用。
參考文獻
[1] J. H. Lau, "Cu-Cu Hybrid Bonding," in Flip Chip, Hybrid Bonding, Fan-In, and Fan-Out Technology. Singapore: Springer Nature Singapore Pte Ltd., 2024, ch. 2, pp. 103-157.
-
3D
+關注
關注
9文章
3011瀏覽量
115056 -
工藝
+關注
關注
4文章
713瀏覽量
30313 -
先進封裝
+關注
關注
2文章
533瀏覽量
1027
原文標題:Cu-Cu Hybrid Bonding技術在先進3D集成中的應用
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
2D、2.5D與3D封裝技術的區別與應用解析

FT32F030F6CU7輝芒微單片機32位M0系列MCU
【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估

iTOF技術,多樣化的3D視覺應用
聊聊倒裝芯片凸點(Bump)制作的發展史




 Cu-Cu Hybrid Bonding技術在先進3D集成中的應用
Cu-Cu Hybrid Bonding技術在先進3D集成中的應用








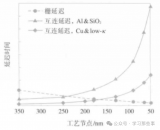



評論