文章來源:Tom聊芯片智造
原文作者:芯片智造
本文介紹了3D封裝架構的分類、定義、實現和挑戰。
3D封裝架構主要分為芯片對芯片集成、封裝對封裝集成和異構集成三大類,分別采用TSV、TCB和混合鍵合等先進工藝實現高密度互連。
3D封裝架構分類
3D封裝架構主要分三大類:芯片對芯片的3D集成、封裝對封裝的3D集成,還有把封裝和芯片堆疊混在一起用的3D異構集成。
芯片對芯片的3D集成
1. 基本概念
芯片對芯片的3D集成,簡單來說就是把幾顆芯片"堆疊"在一起,并用硅通孔(TSV)和微凸點把它們牢牢連起來。
2. 具體實現
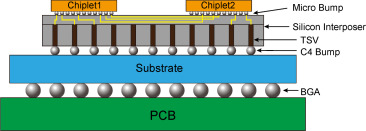
比如:兩顆存儲芯片先通過TSV和微凸點堆疊在一顆邏輯芯片上;邏輯芯片再通過一級焊點連到基板上;最后用二級焊點把整個3D封裝連到印刷電路板(PCB)上。
3. 工藝挑戰
傳統的2D封裝里,用的是"焊料回流"——先涂助焊劑,再貼芯片,然后放到爐子里回流焊接。但到了3D封裝時代,這種方法就不太好使了:
3D封裝里的芯片和基板都更薄
互連更小更密
一加熱就容易翹曲、錯位、傾斜、焊接不良、焊料橋連
所以,3D封裝需要更先進的工藝來代替傳統回流焊。
4. 先進工藝方案
TCB(熱壓鍵合)就是最常用的替代方案,它專門用來把3D封裝里的微凸點精確焊接到位,避免翹曲和焊接不良。
再往前一步,混合鍵合(Hybrid Bonding)等新工藝,甚至可以處理小于5微米間距的超密互連,組裝溫度還低,更適合下一代3D封裝的發展。
封裝對封裝的3D集成
1. 典型配置
系統級封裝(SIP)和封裝堆疊封裝(POP)是封裝對封裝3D集成的典型配置,通過引線鍵合或倒裝鍵合把封裝堆疊起來。
2. 技術優勢
跟芯片堆疊比,封裝堆疊技術開發周期短,能更快地把產品推向市場,價格也便宜。
3. 結構描述
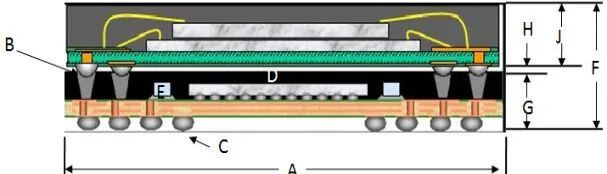
如圖所示,一個引線鍵合封裝通過倒裝鍵合堆疊在另一個引線鍵合封裝上面,然后這兩個封裝再堆到一個倒裝封裝上,形成POP。
異構3D集成
1. 定義與特點
異構3D集成,是指將不同功能、不同工藝節點的芯片堆疊整合在同一個緊湊封裝中的封裝方式。
2. 應用優勢
相比傳統的單片芯片(所有功能做在一個Die上),異構3D封裝的優勢非常明顯:
可以讓每個小芯片用最合適的制程工藝(比如CPU用先進工藝,模擬部分用成熟工藝)
小芯片面積小,良率更高、成本更低
可以用現成的芯片快速組合出新產品,大大縮短開發周期
整體封裝更緊湊,系統級性能更強
3. 實現案例
比如,下面這種異構3D結構
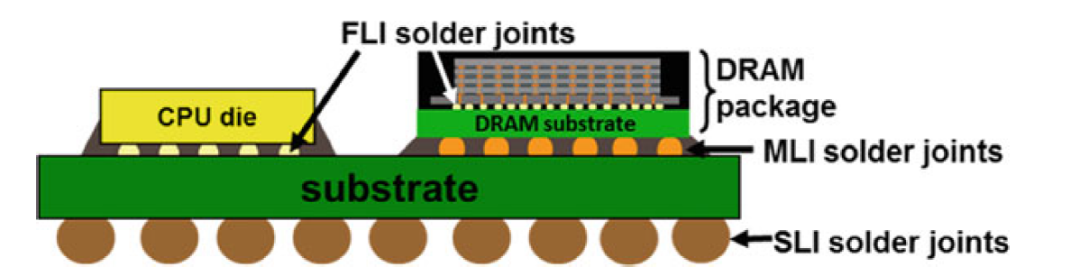
一顆DRAM封裝(里面是4顆通過TSV+微凸點堆疊的存儲芯片) 再跟一顆倒裝的CPU芯片并排組合在一個封裝中 封裝與封裝之間通過多級互連,再通過封裝內的一級互連、基板連接,實現整個系統級的高速通信
這樣的"芯片堆+封裝堆"組合,既高效又靈活。
-
芯片
+關注
關注
463文章
54148瀏覽量
467581 -
TSV
+關注
關注
4文章
137瀏覽量
82711 -
3D封裝
+關注
關注
9文章
149瀏覽量
28340
原文標題:3D封裝架構是怎么分類的?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 3D封裝架構的分類和定義
3D封裝架構的分類和定義





評論