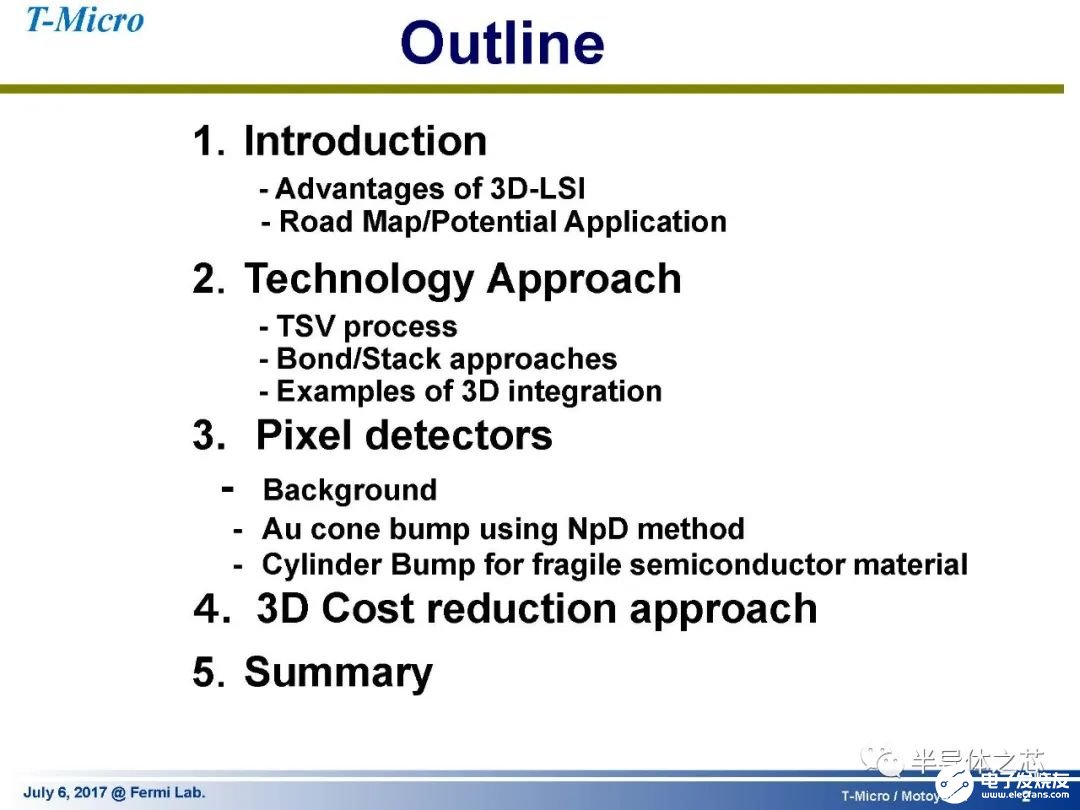


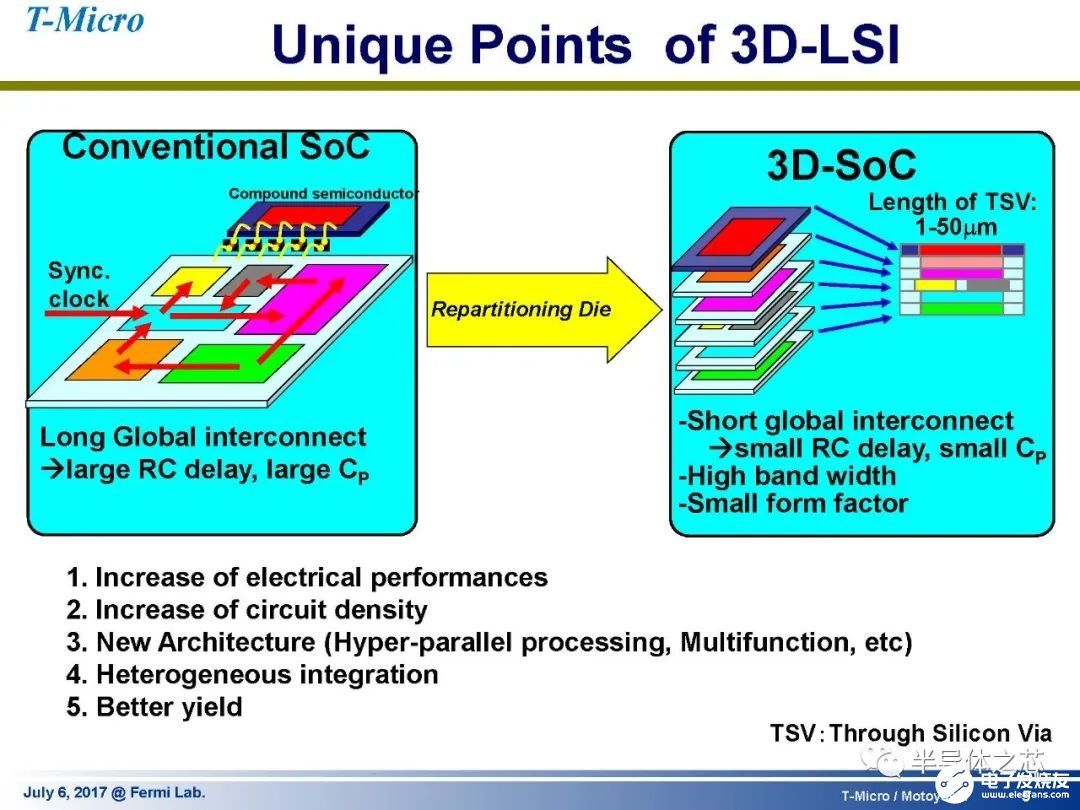
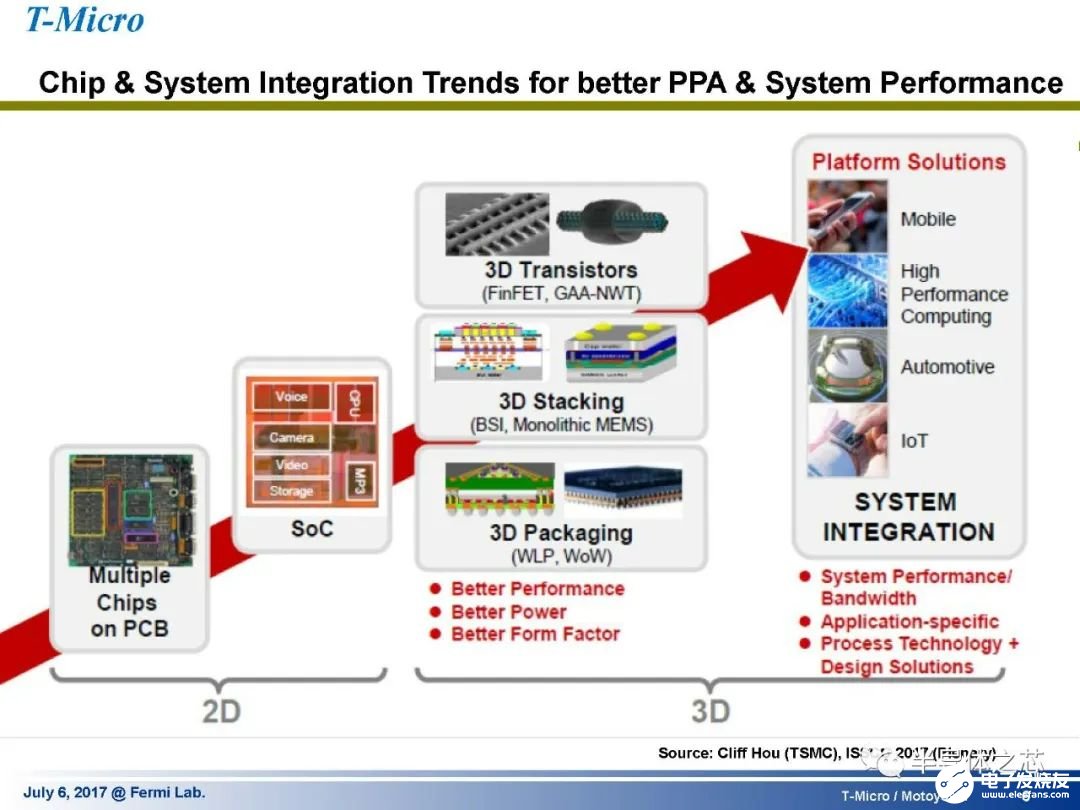
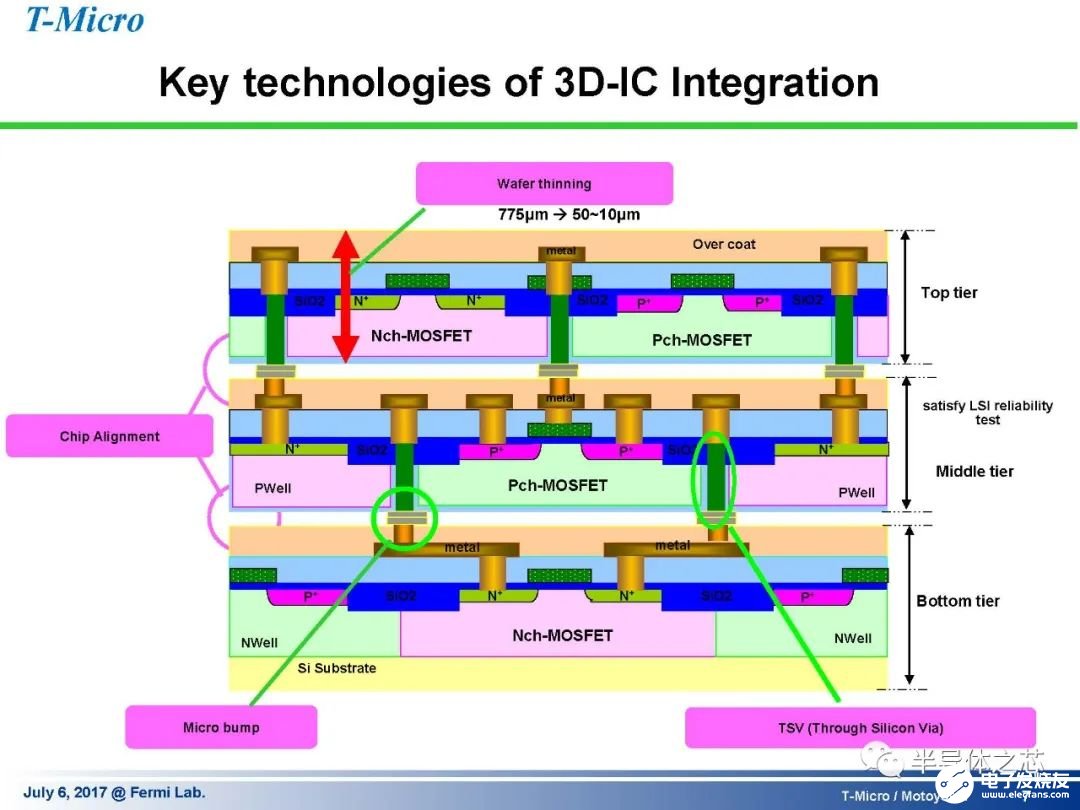
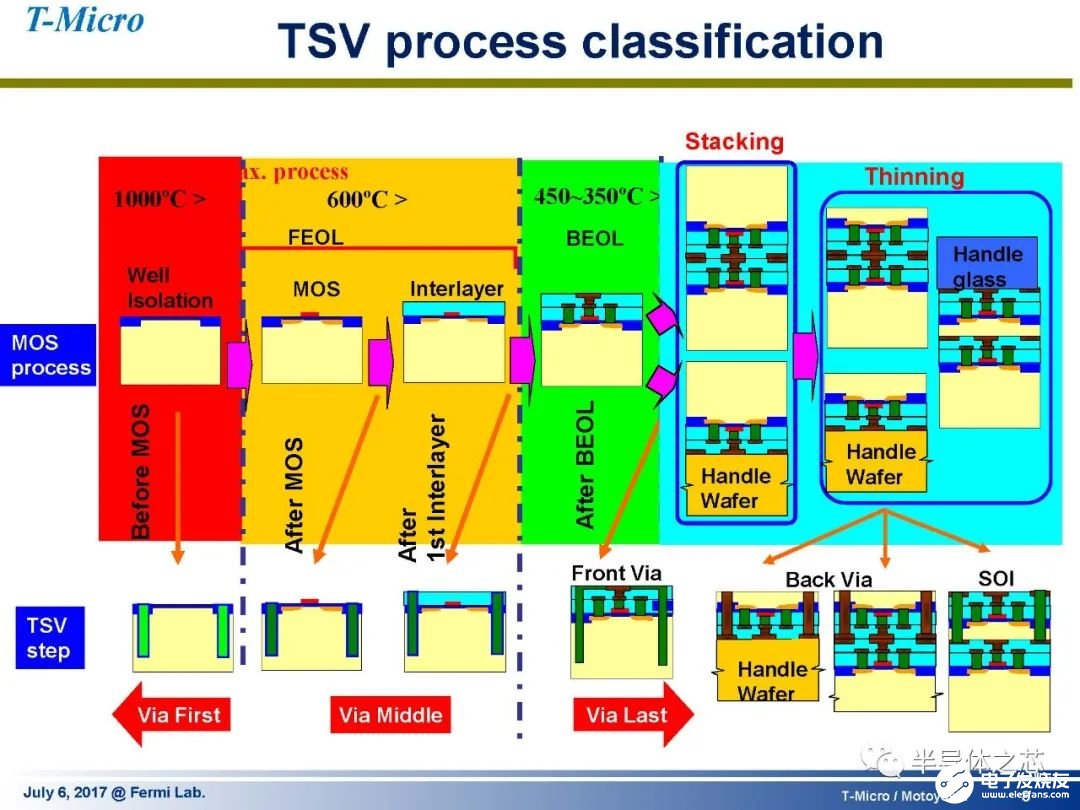
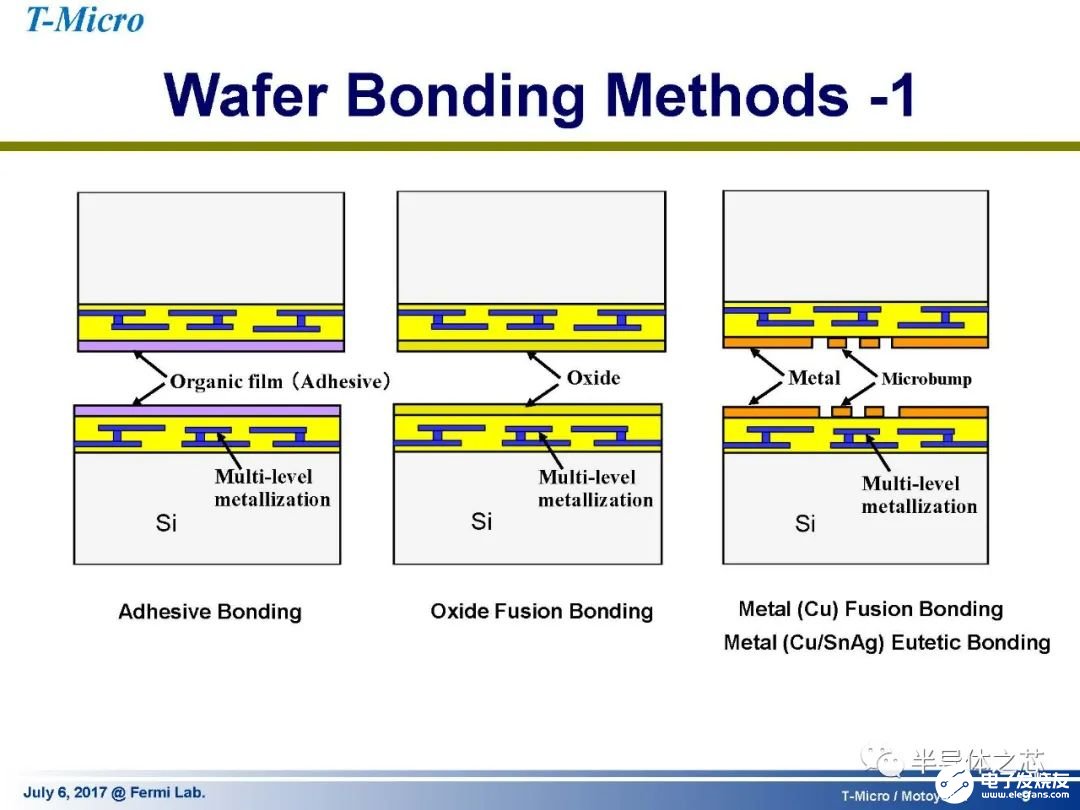
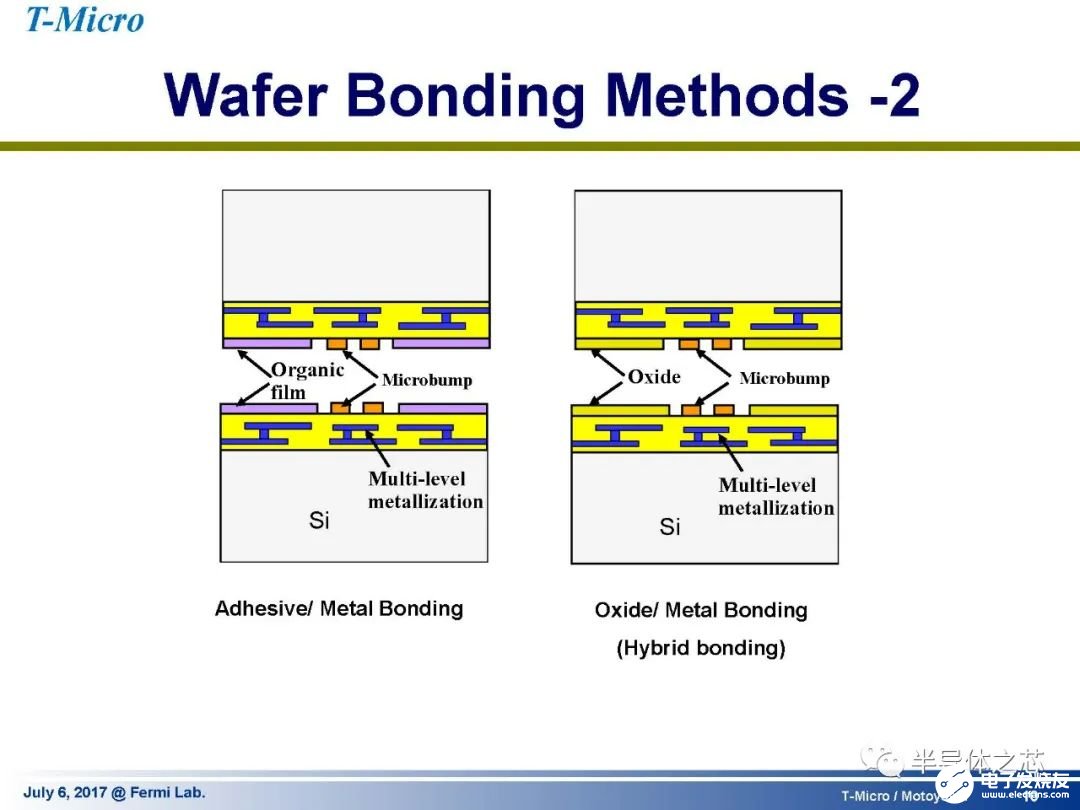
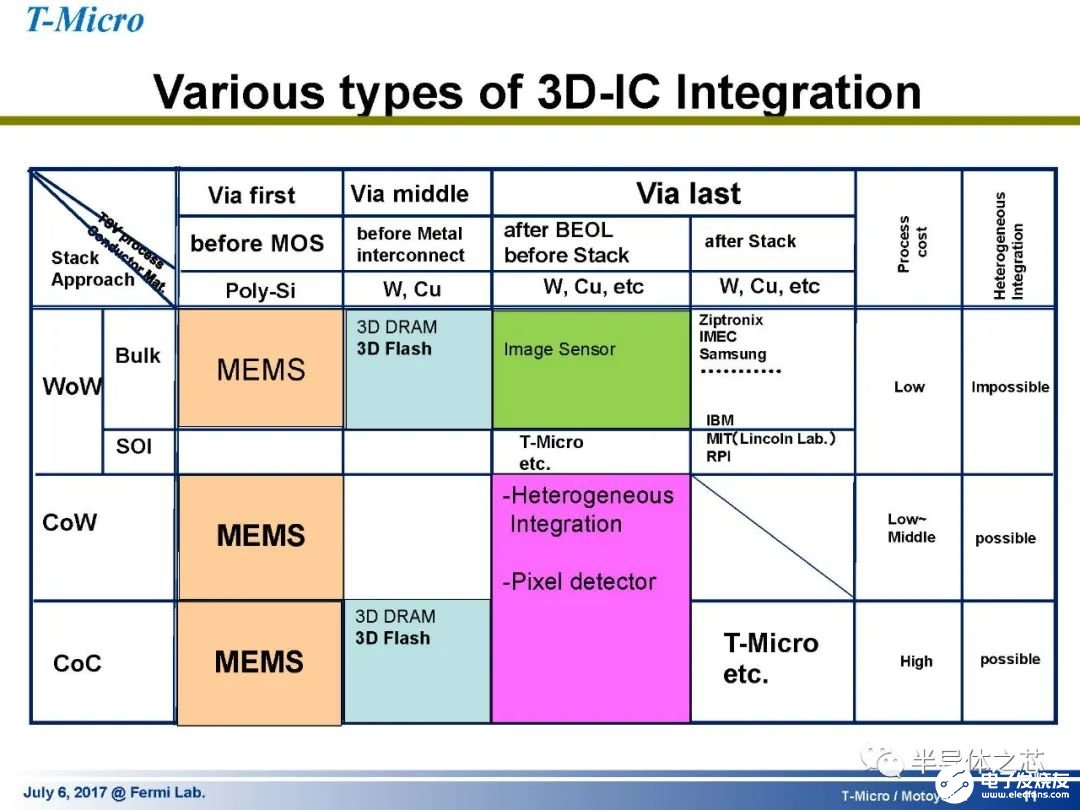
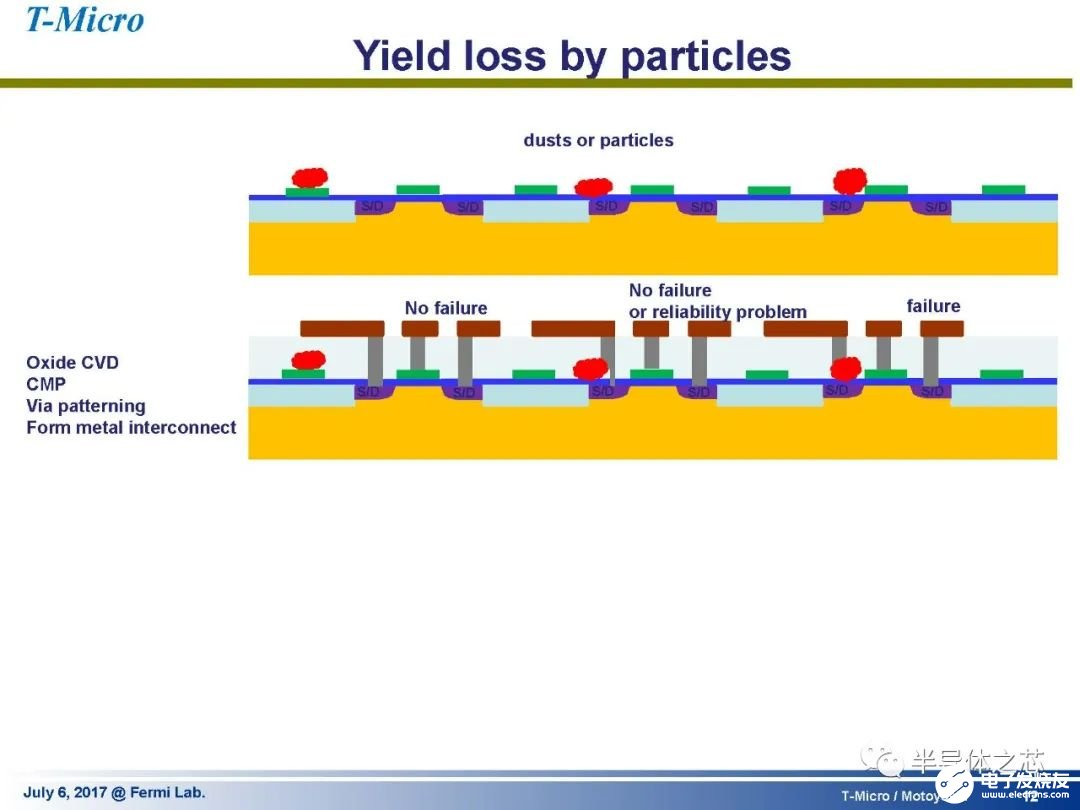
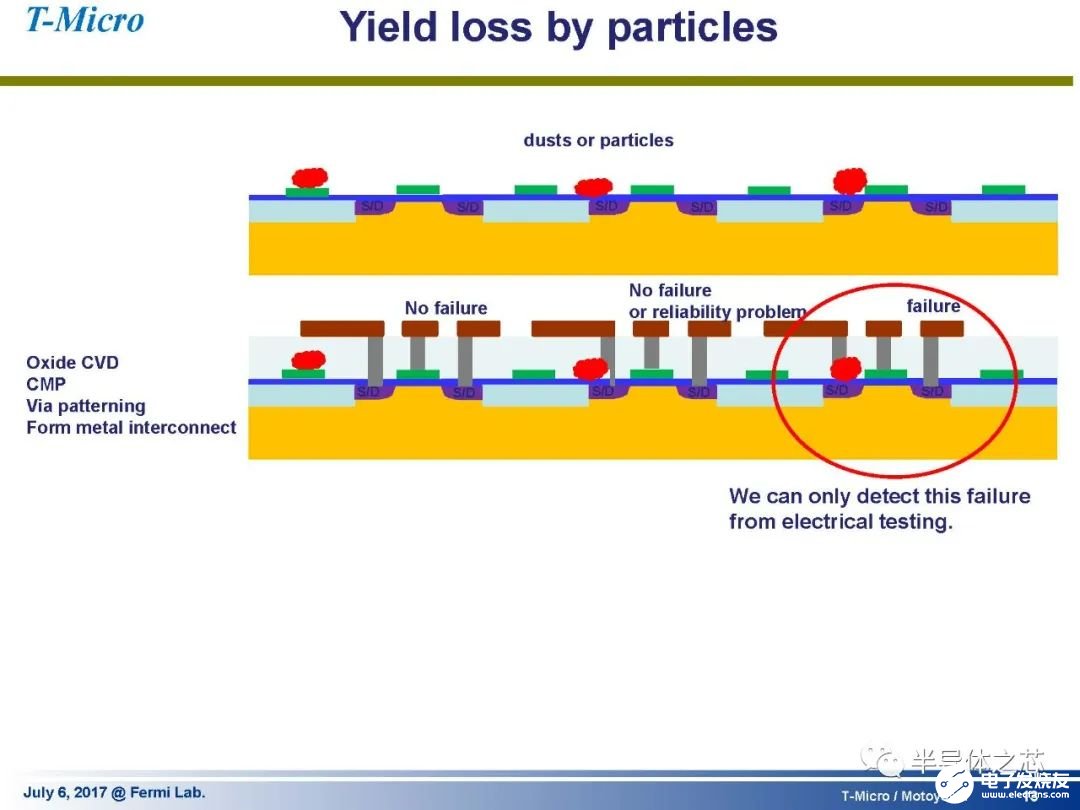
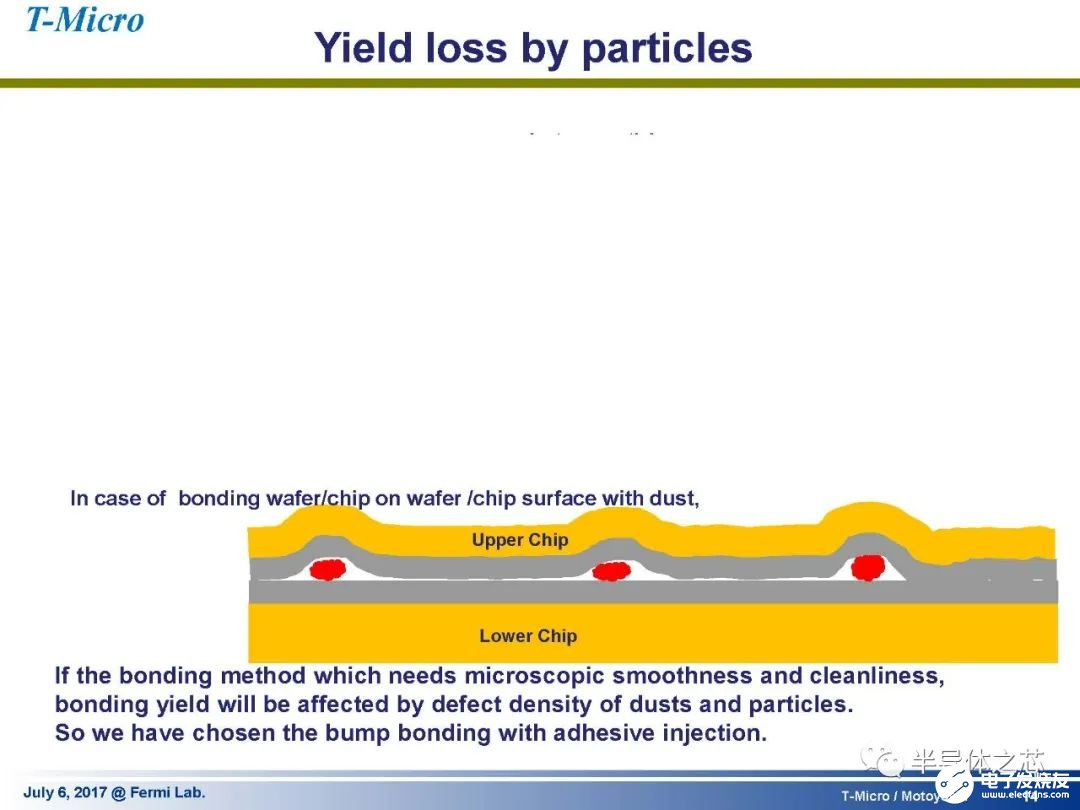
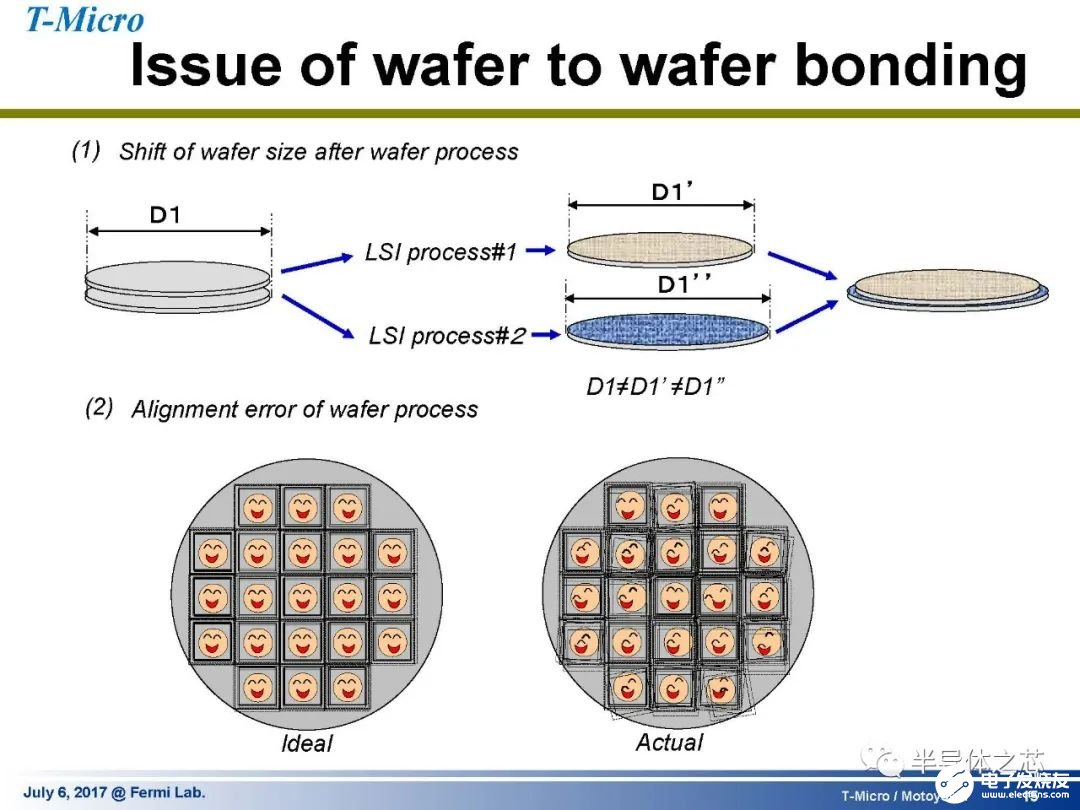

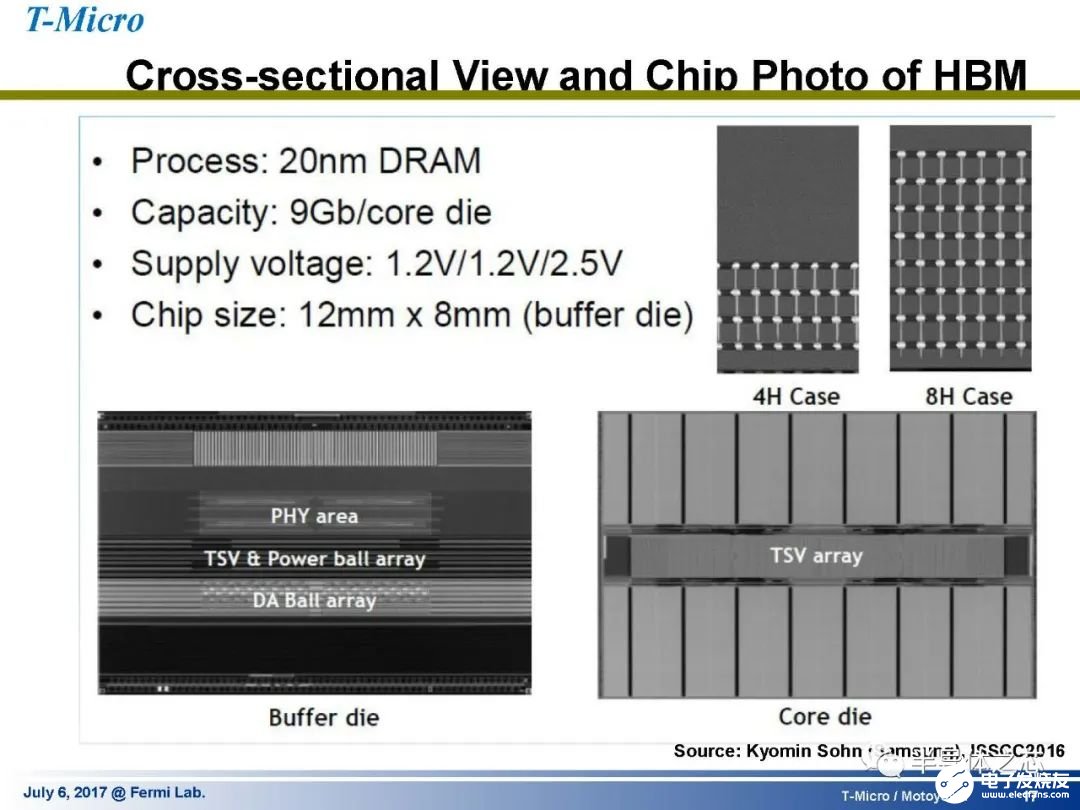
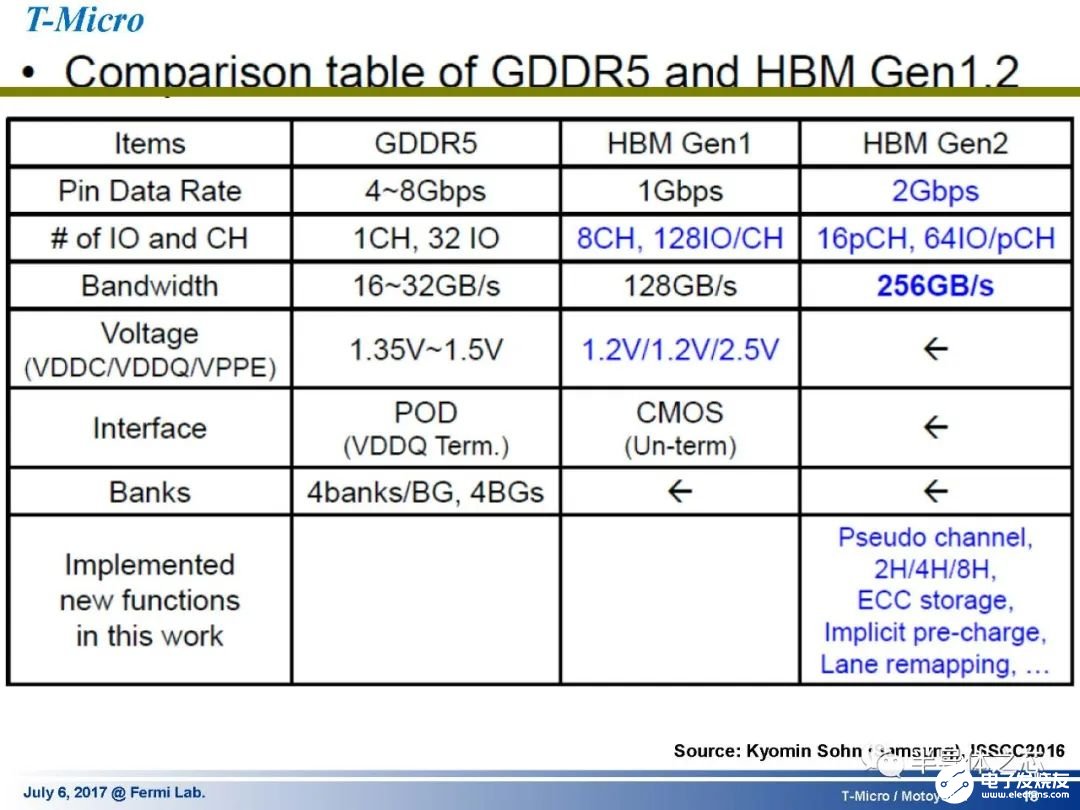

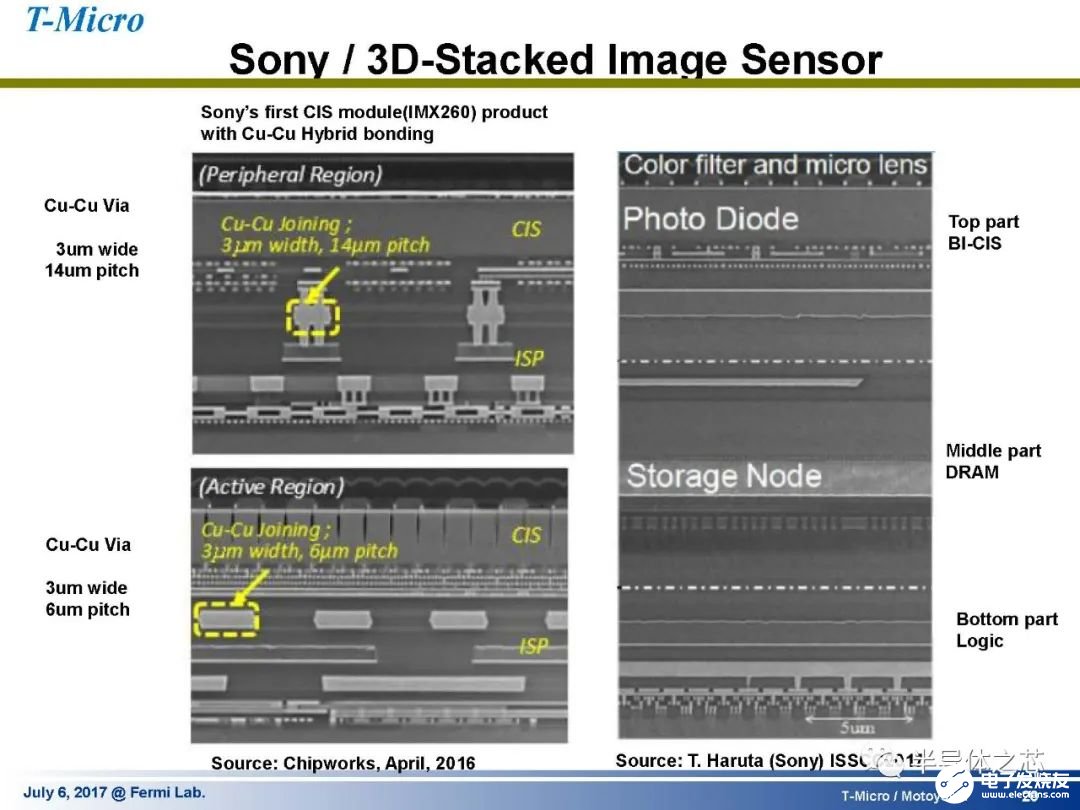
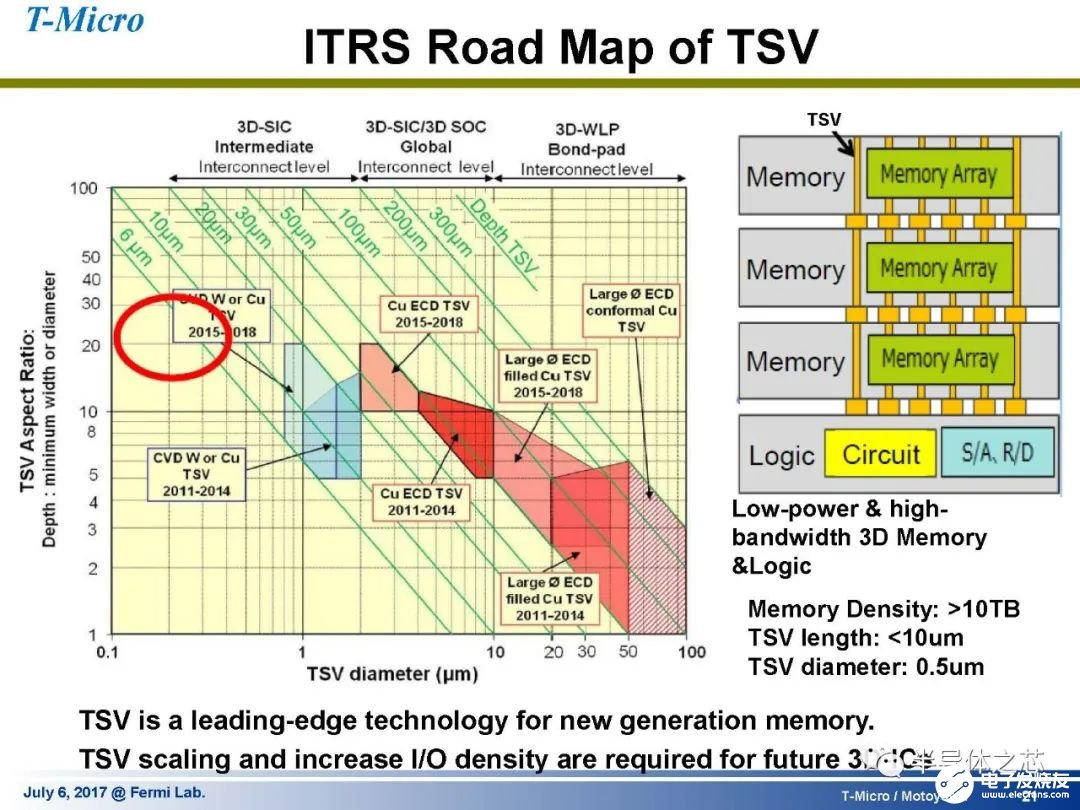
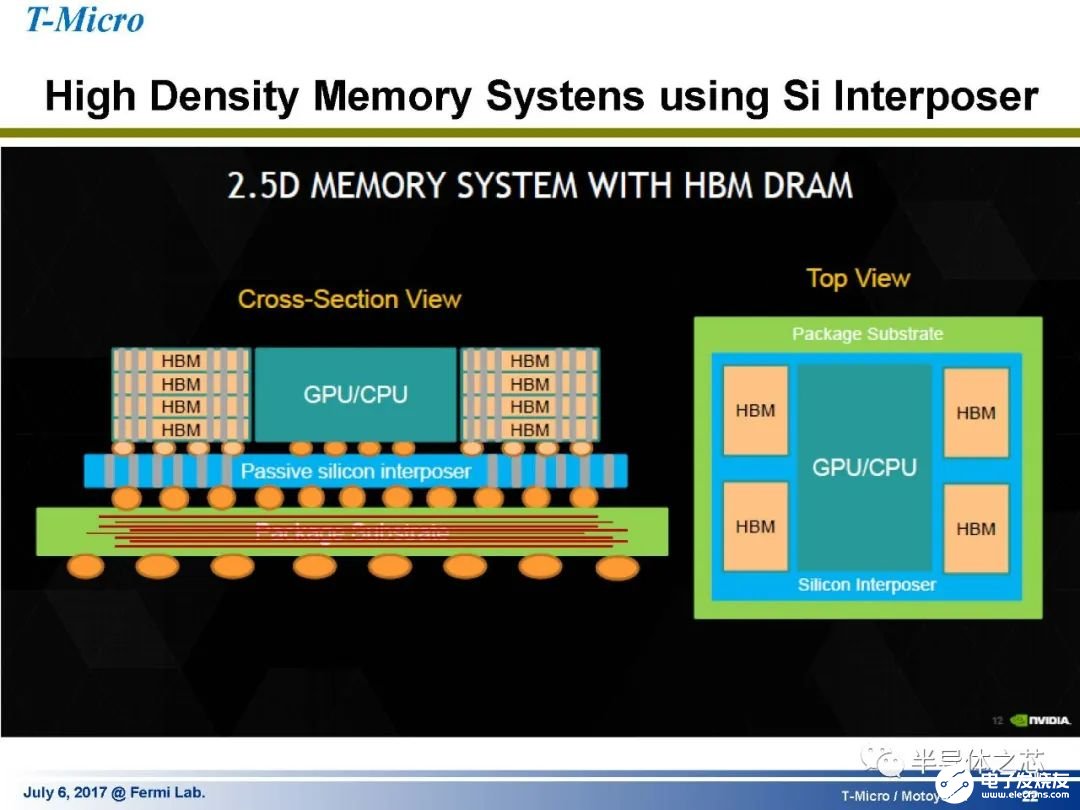
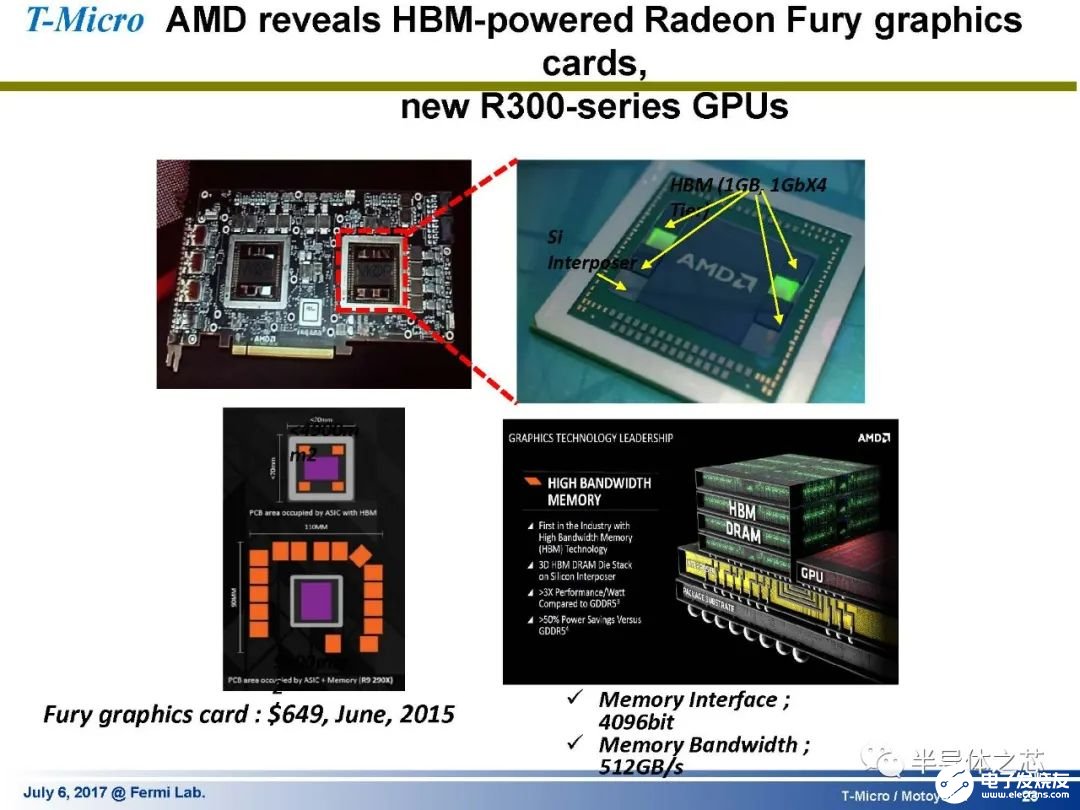
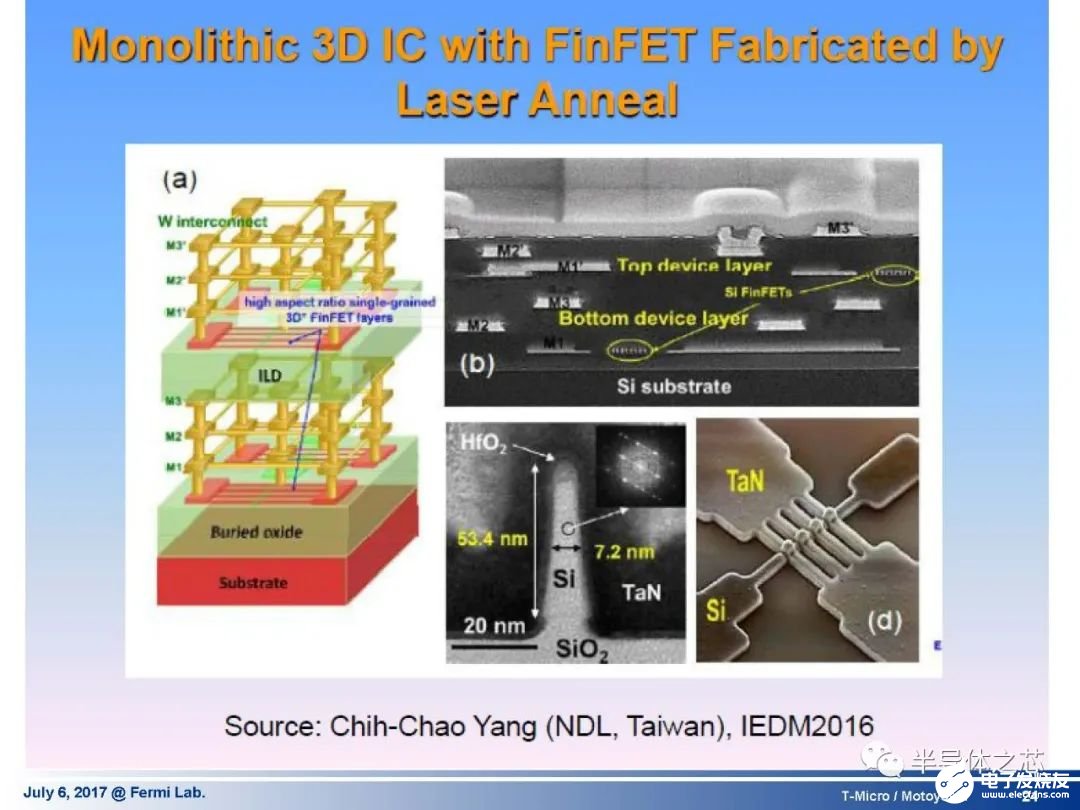
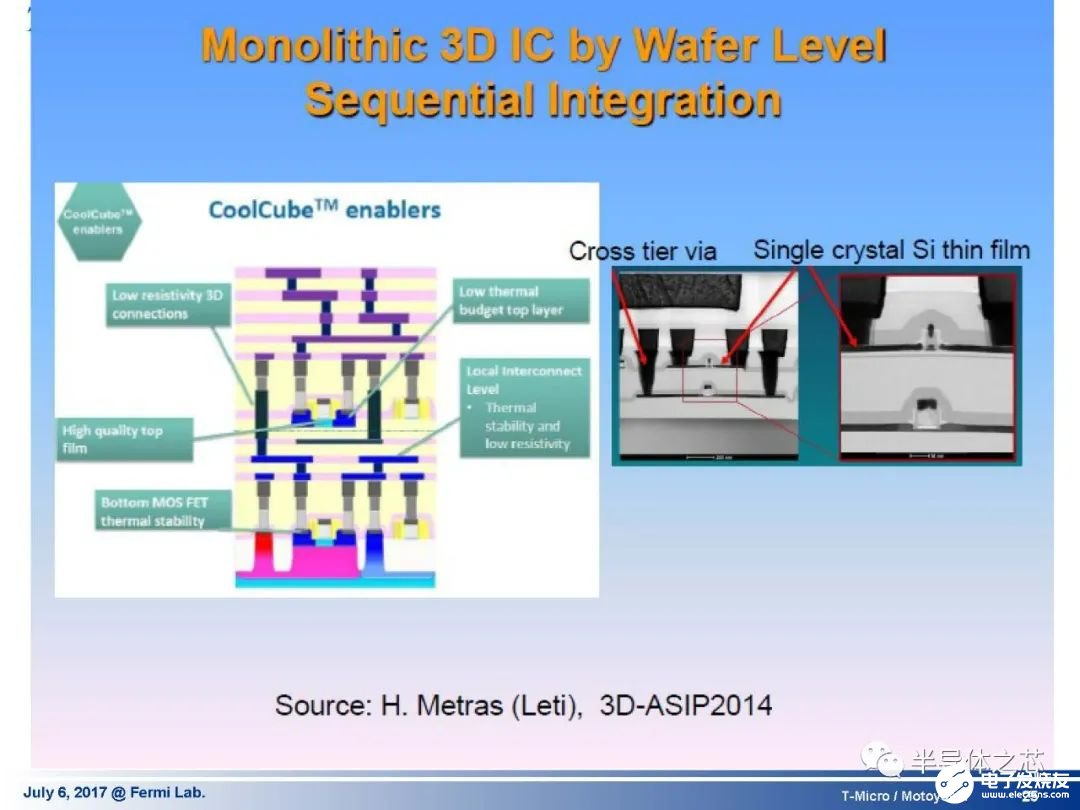


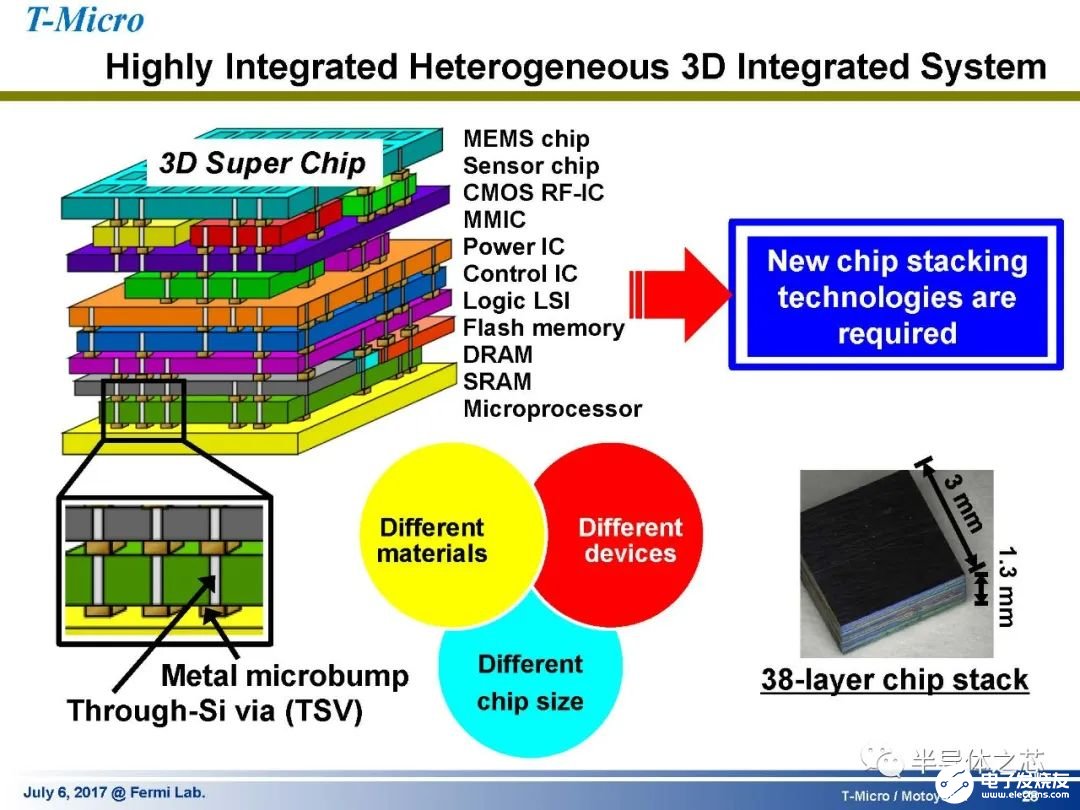

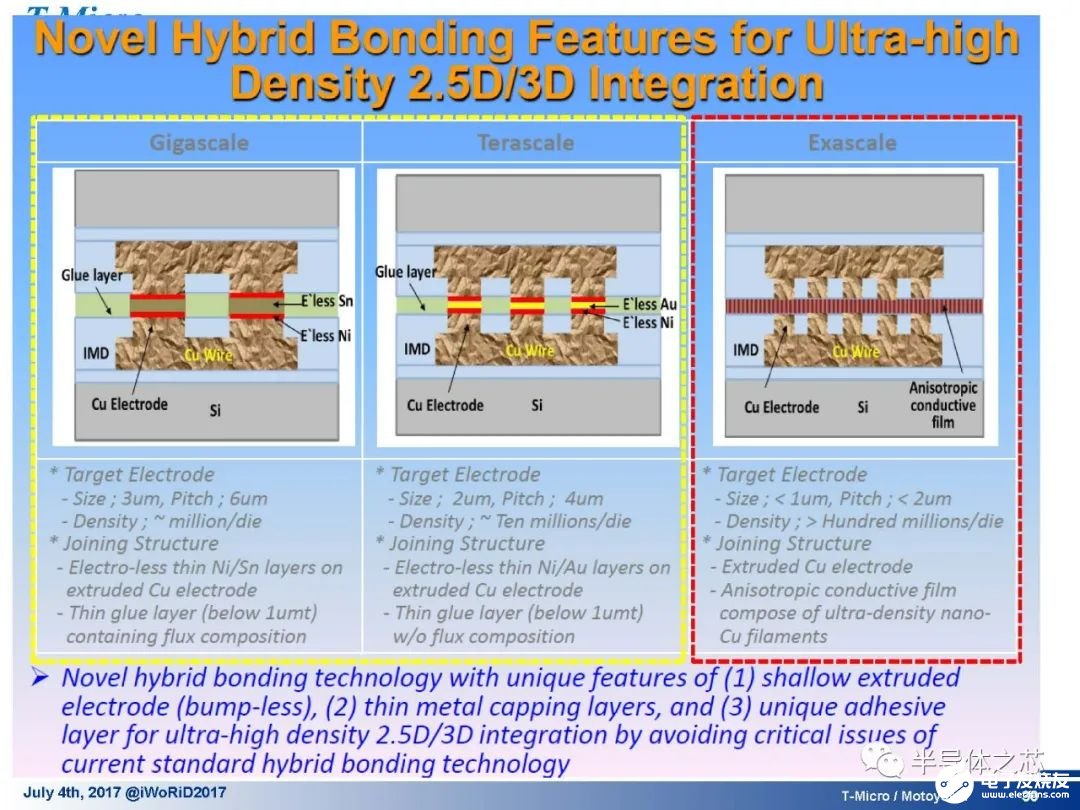
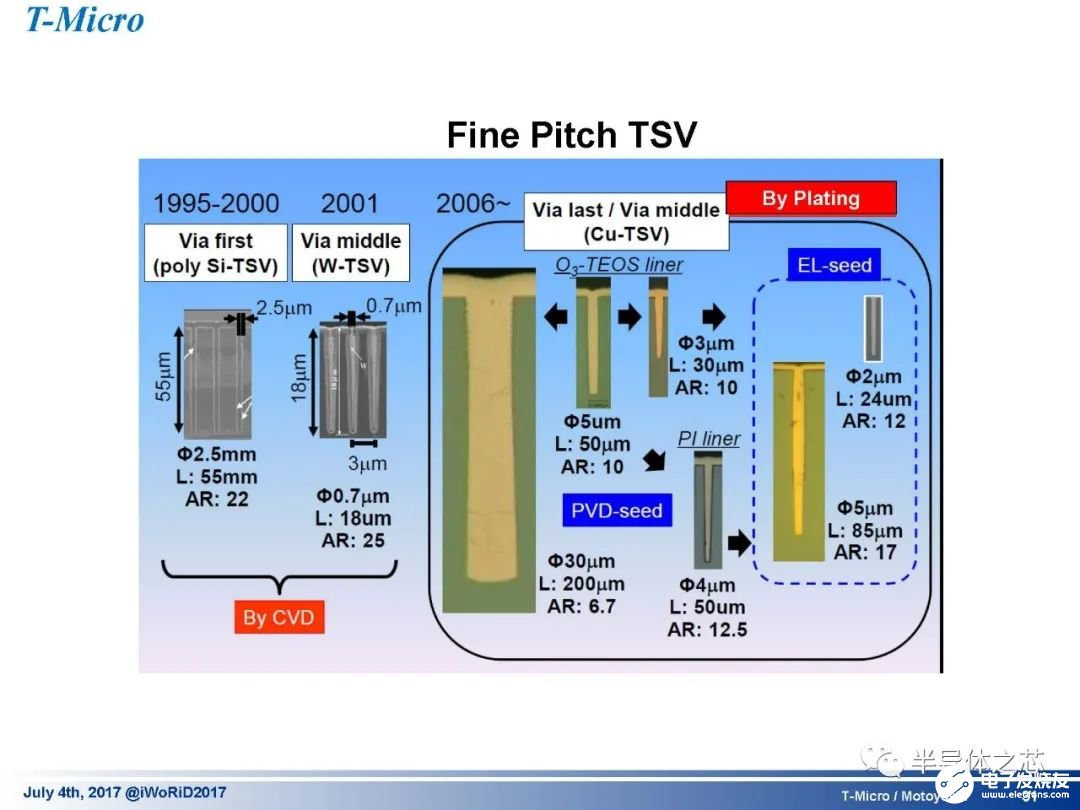
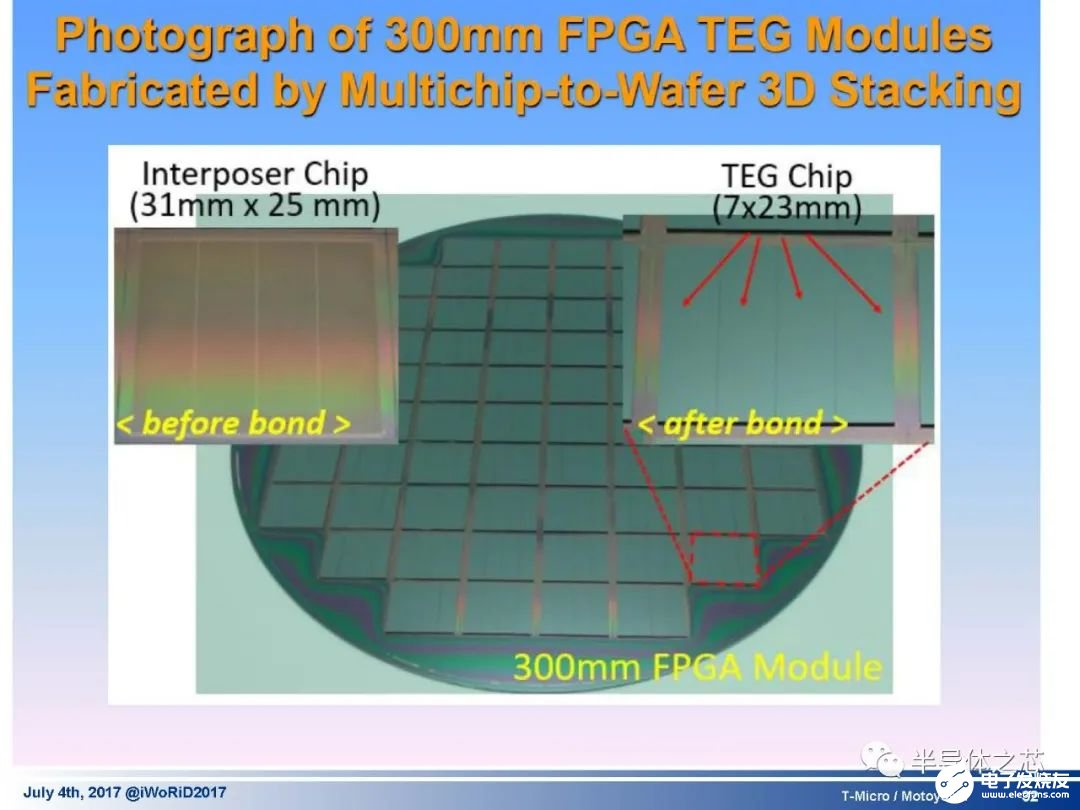

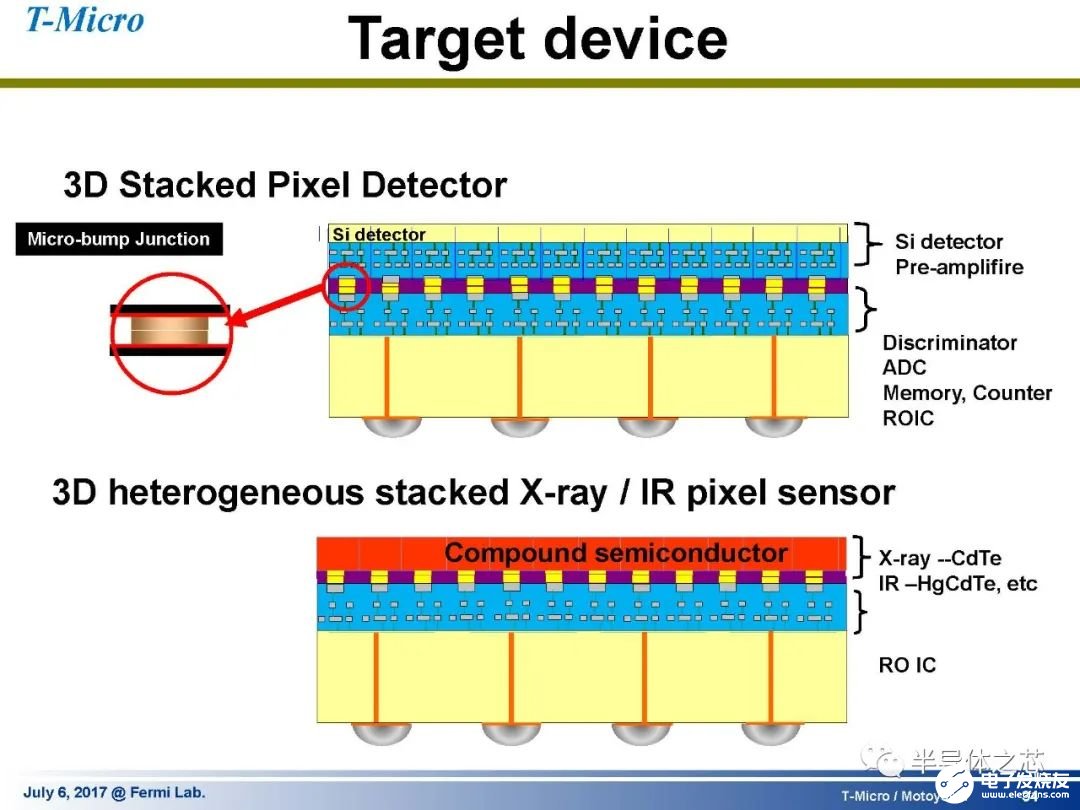
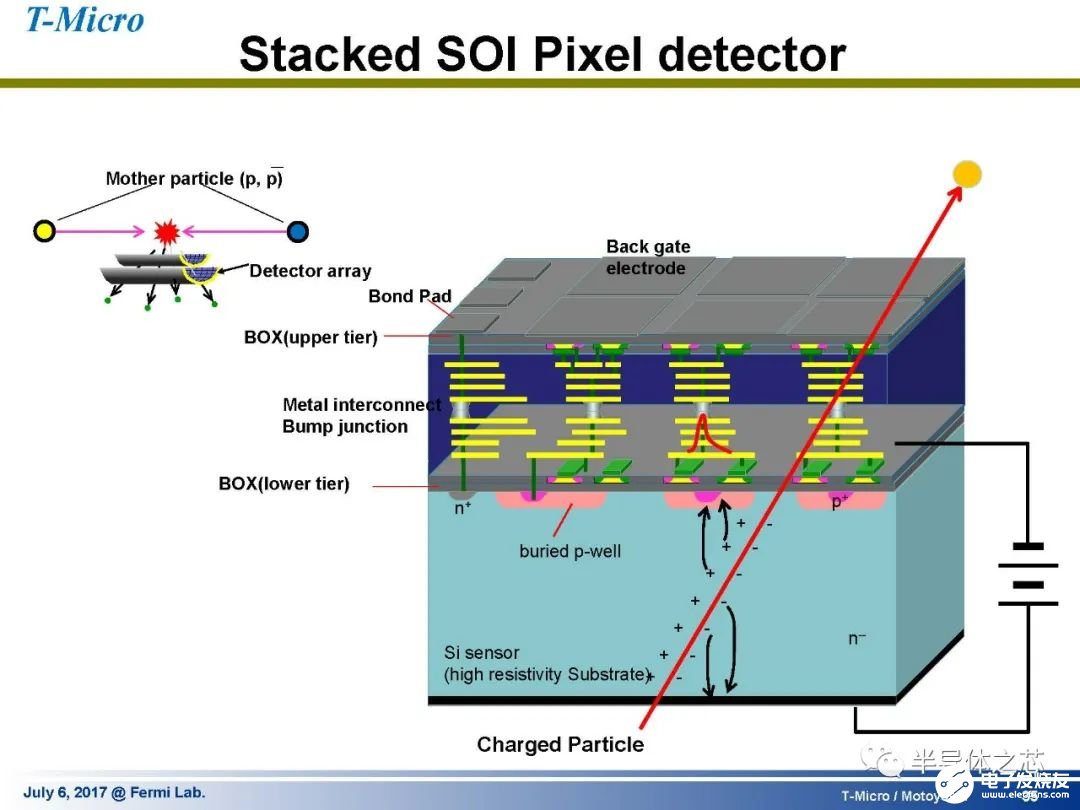
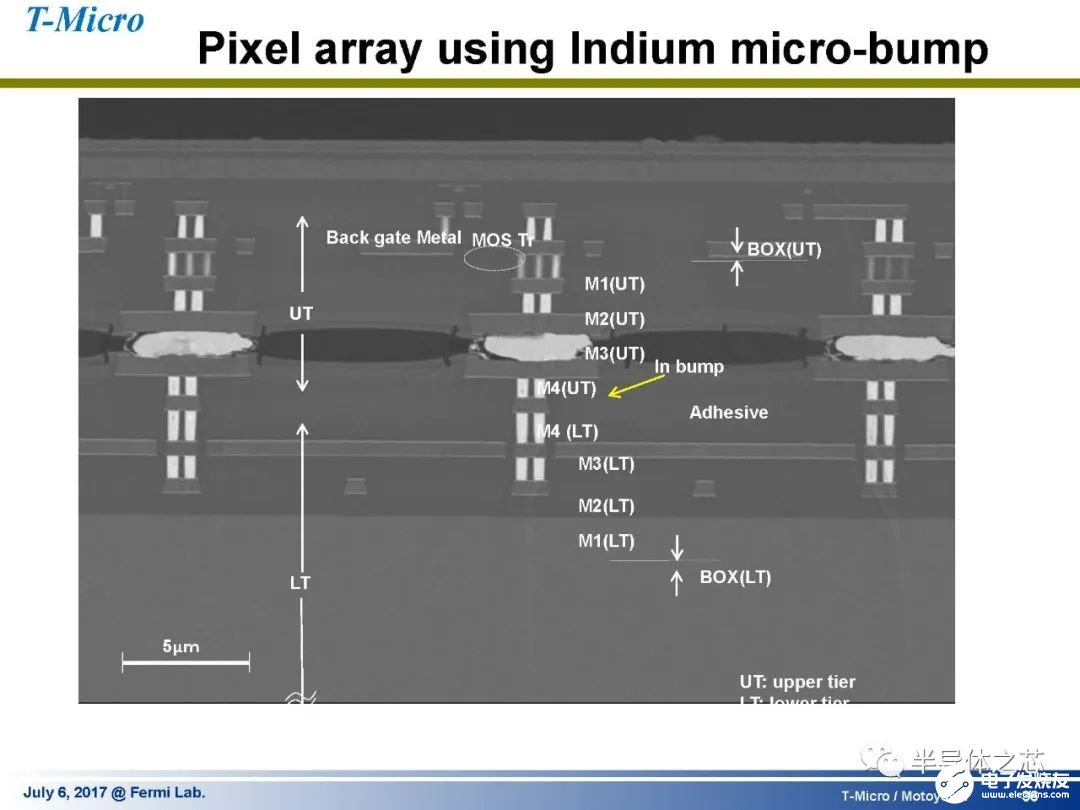

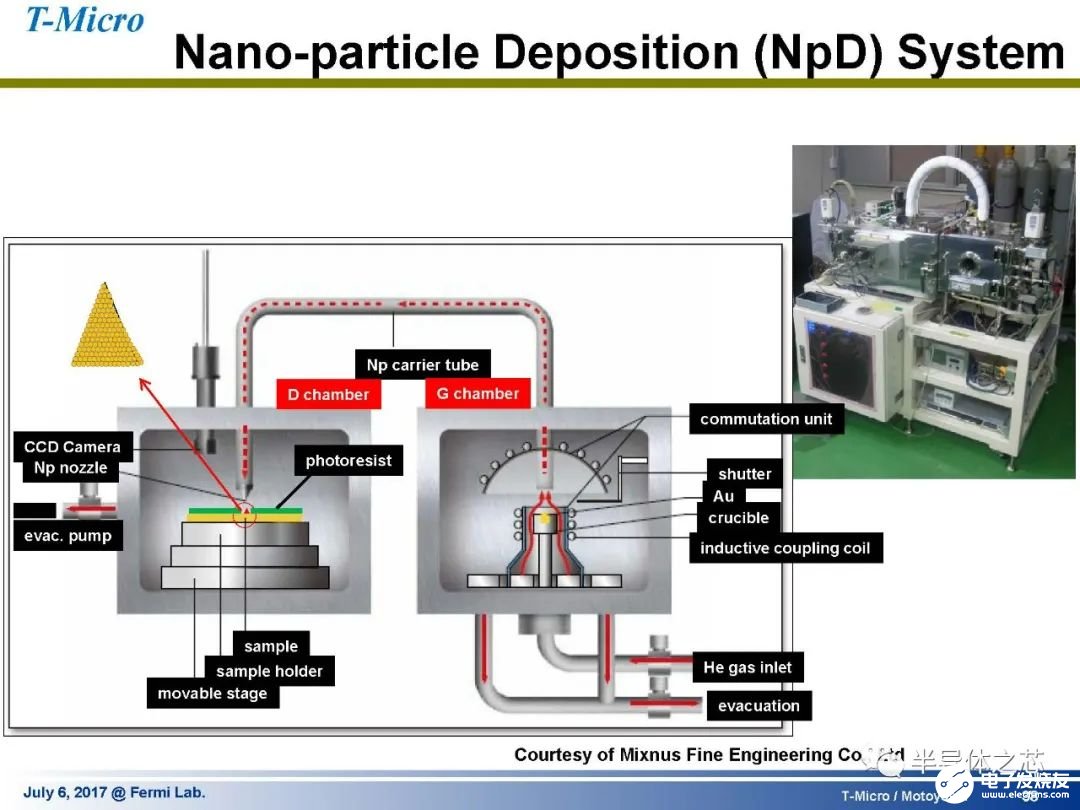
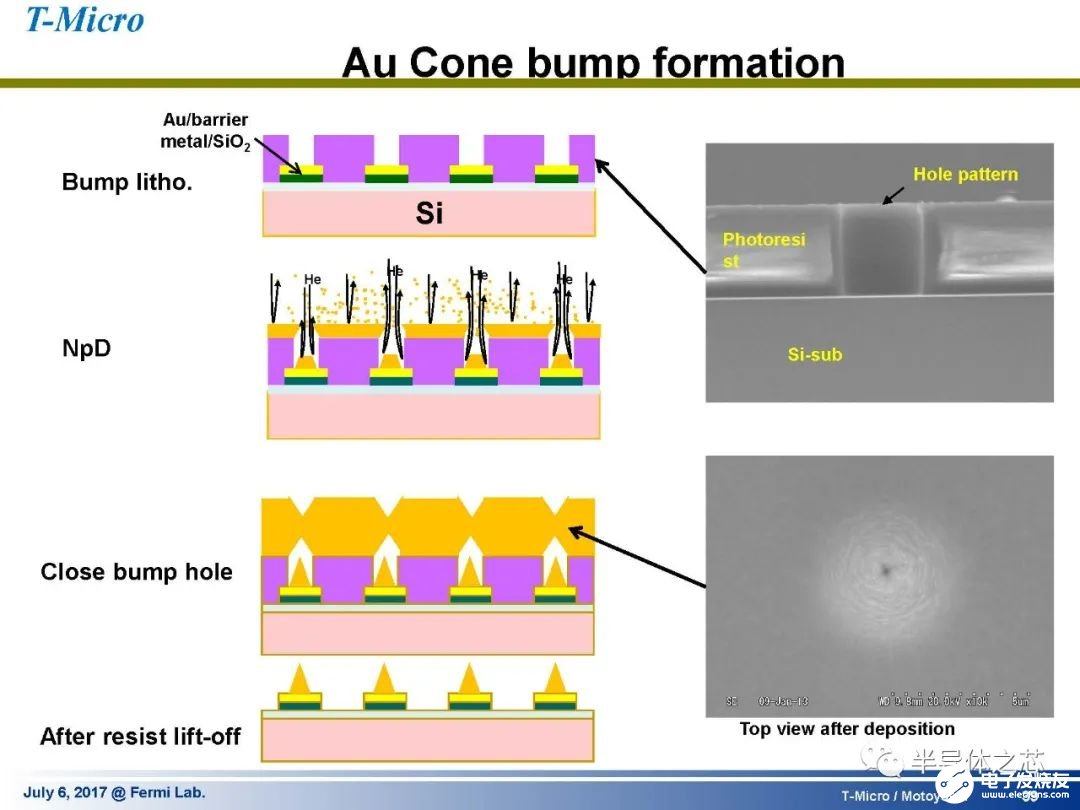

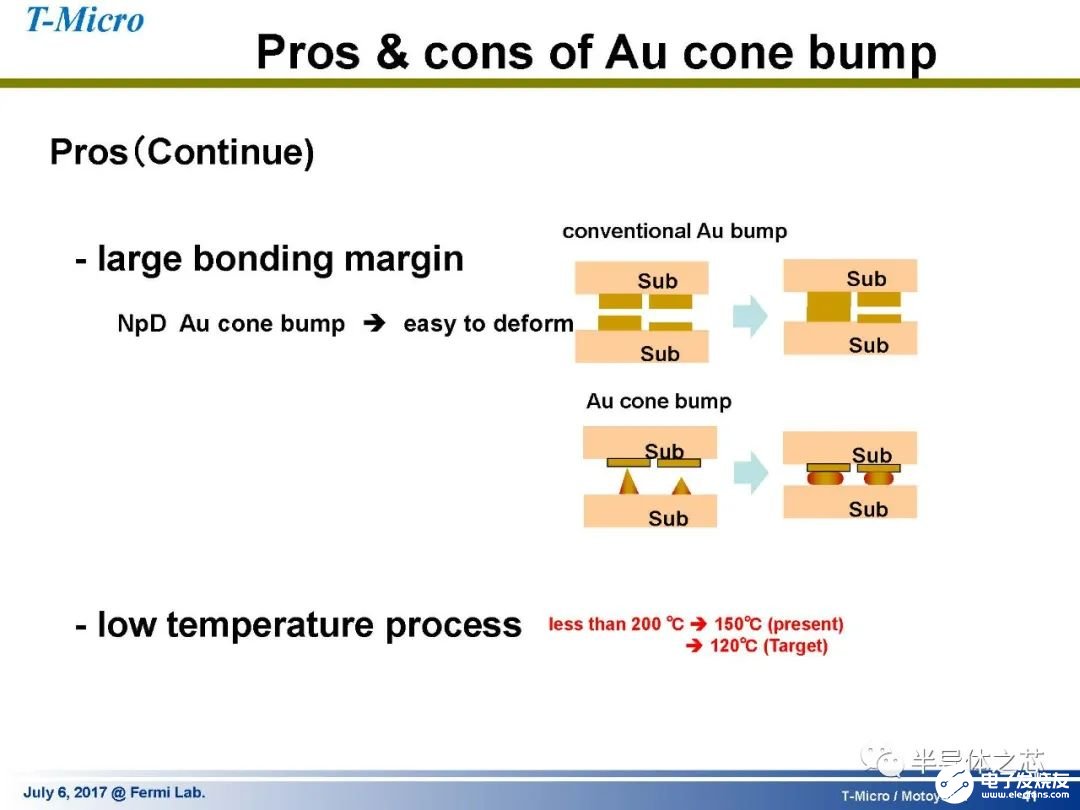
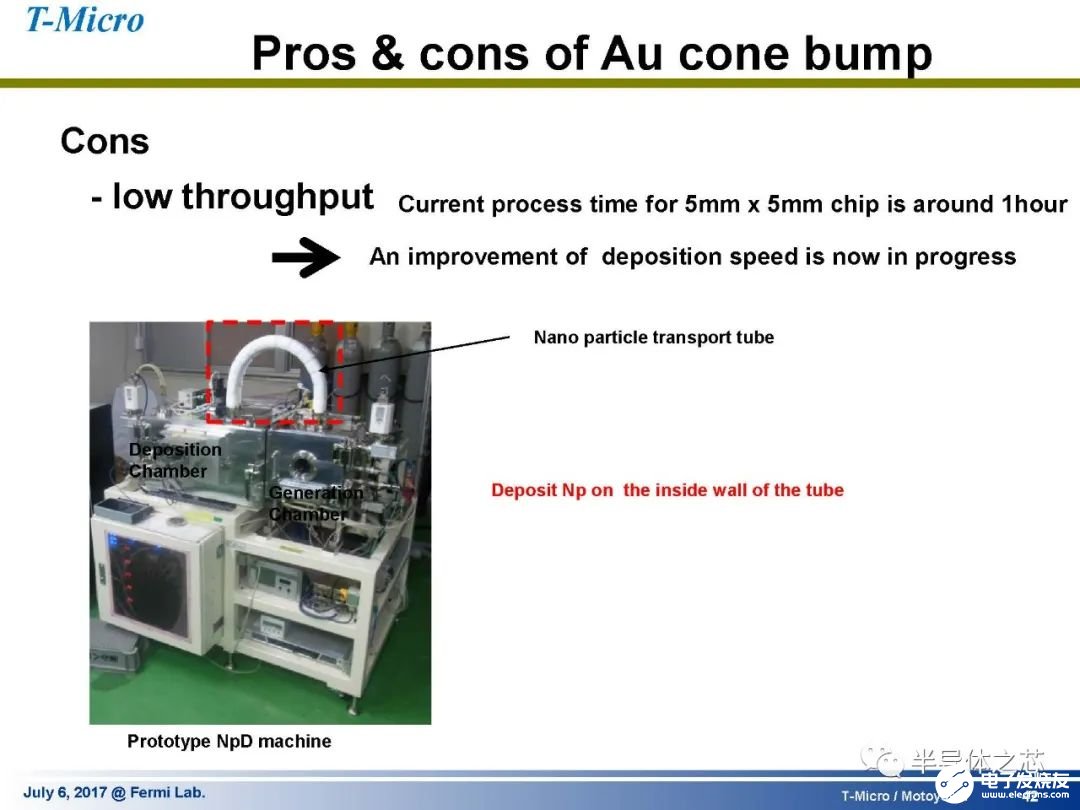
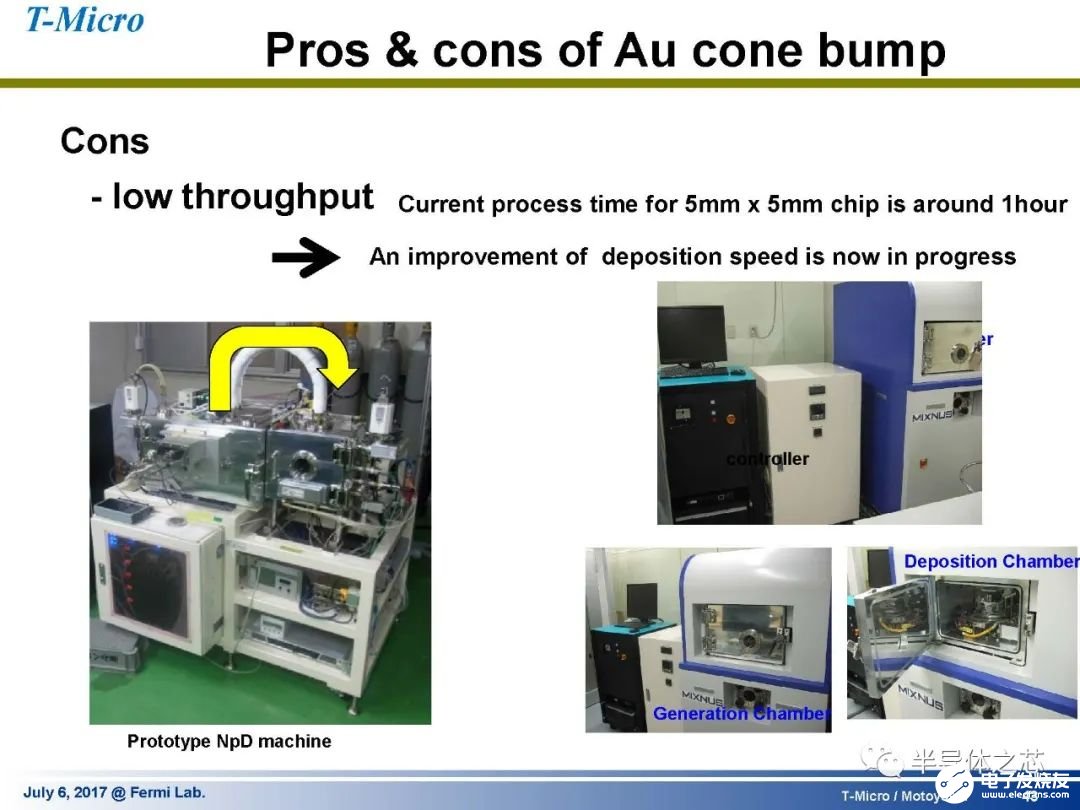
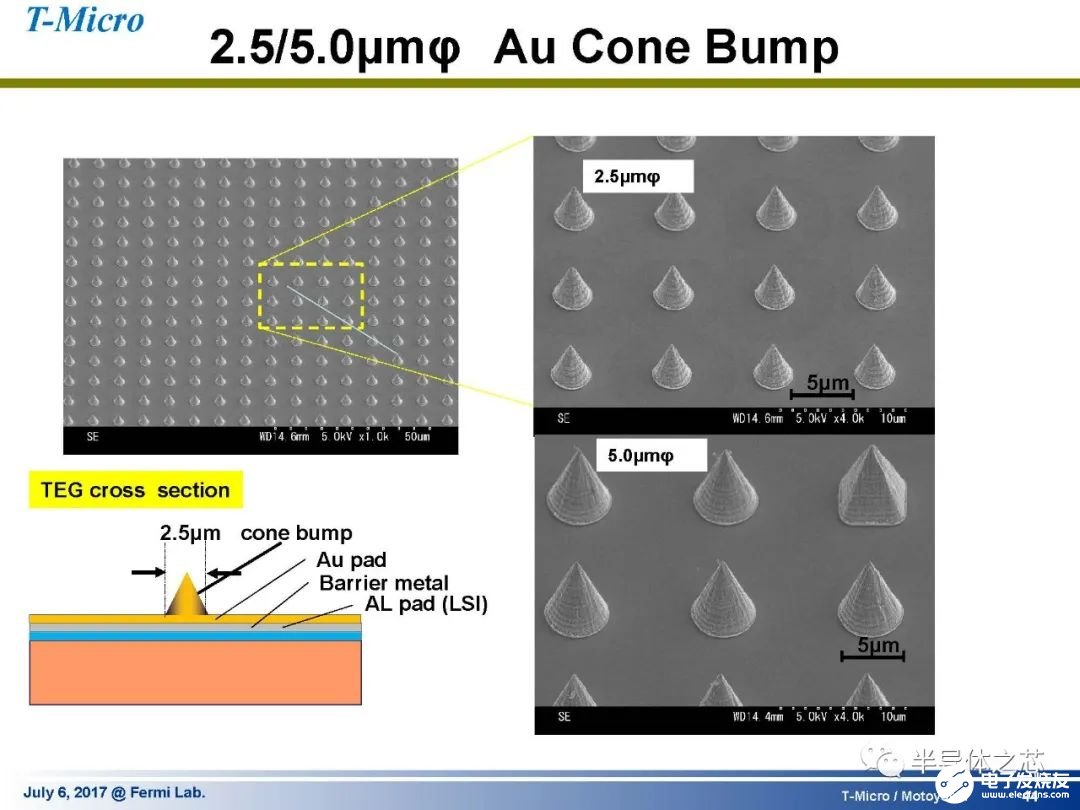
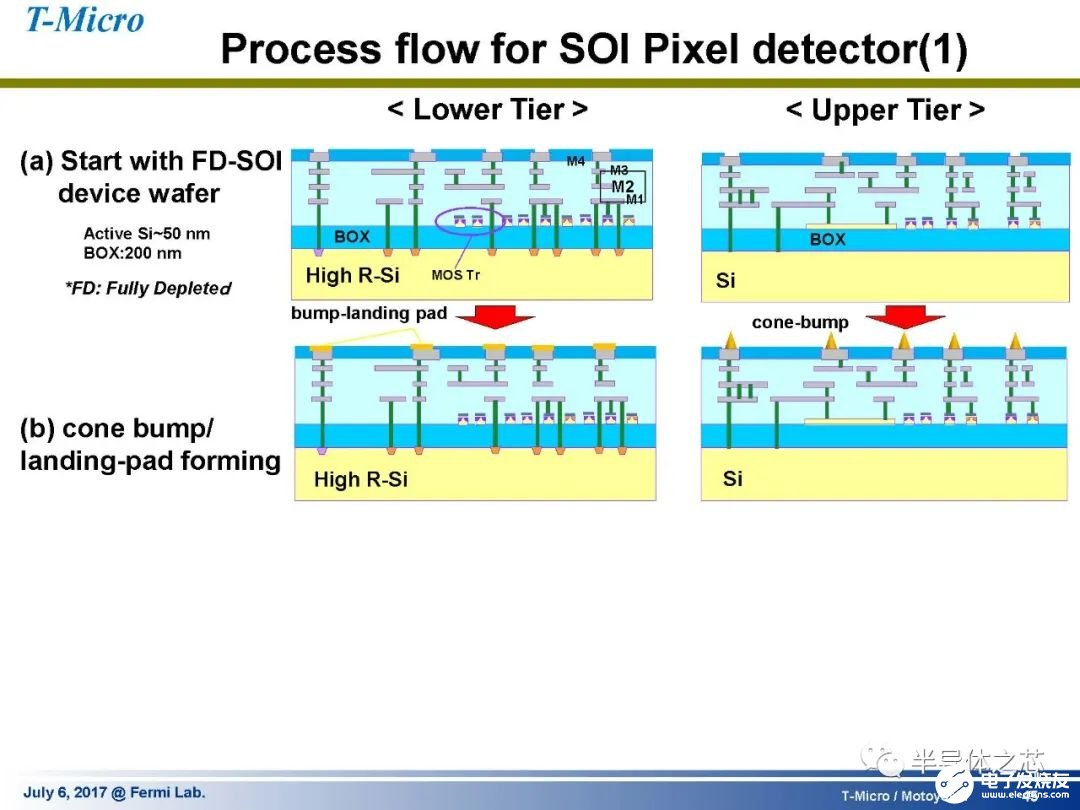

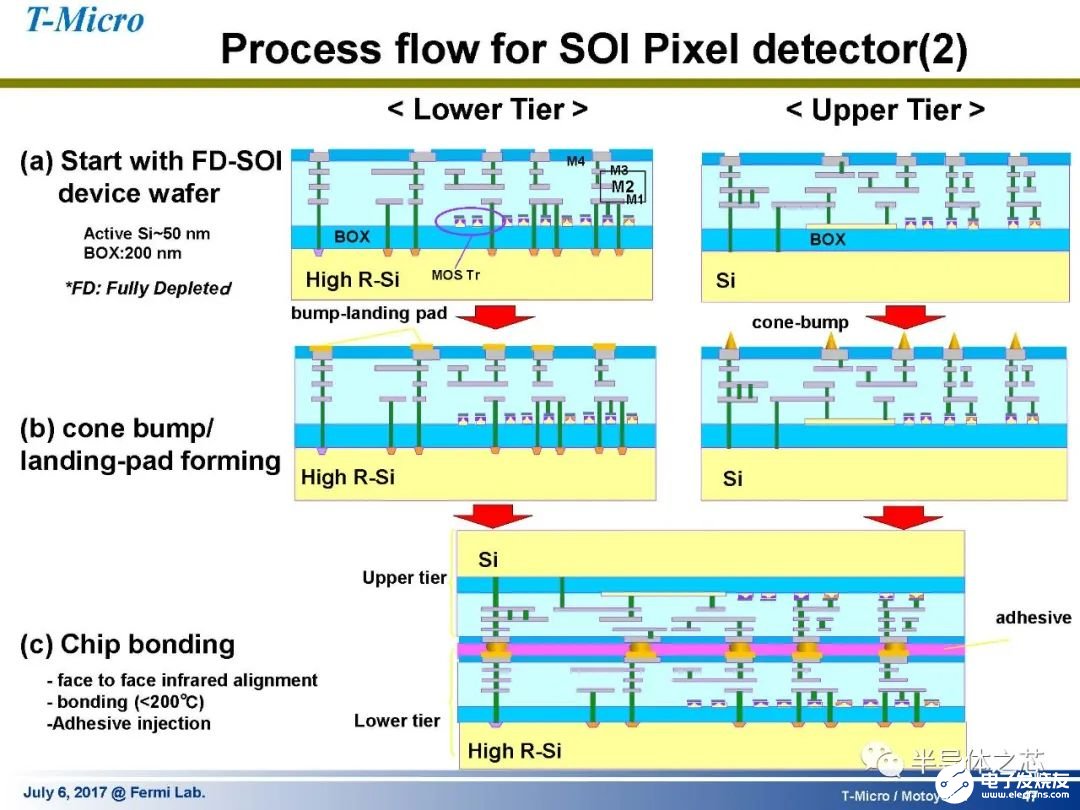
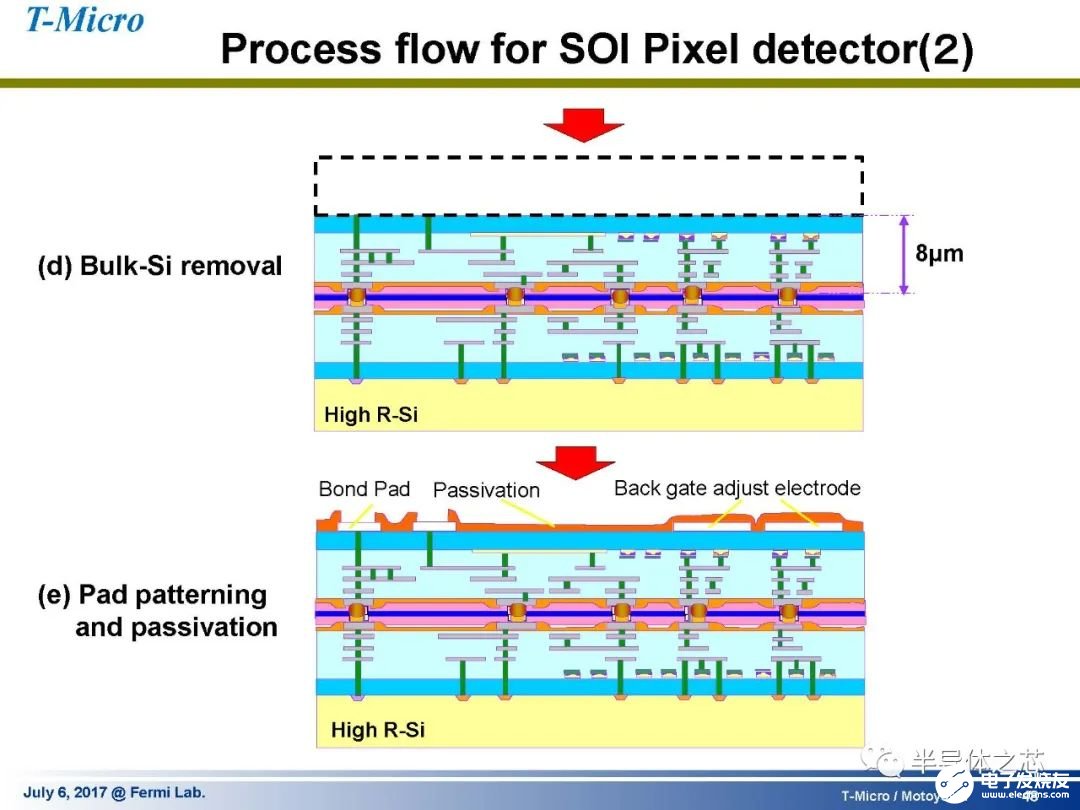

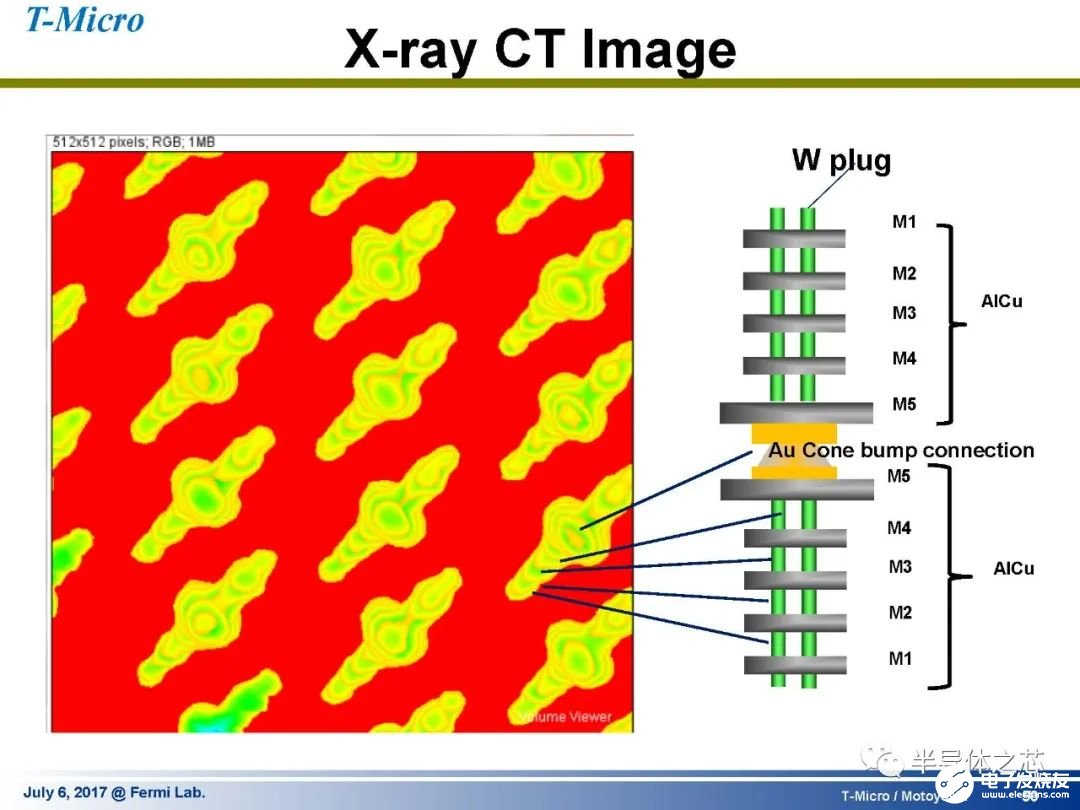


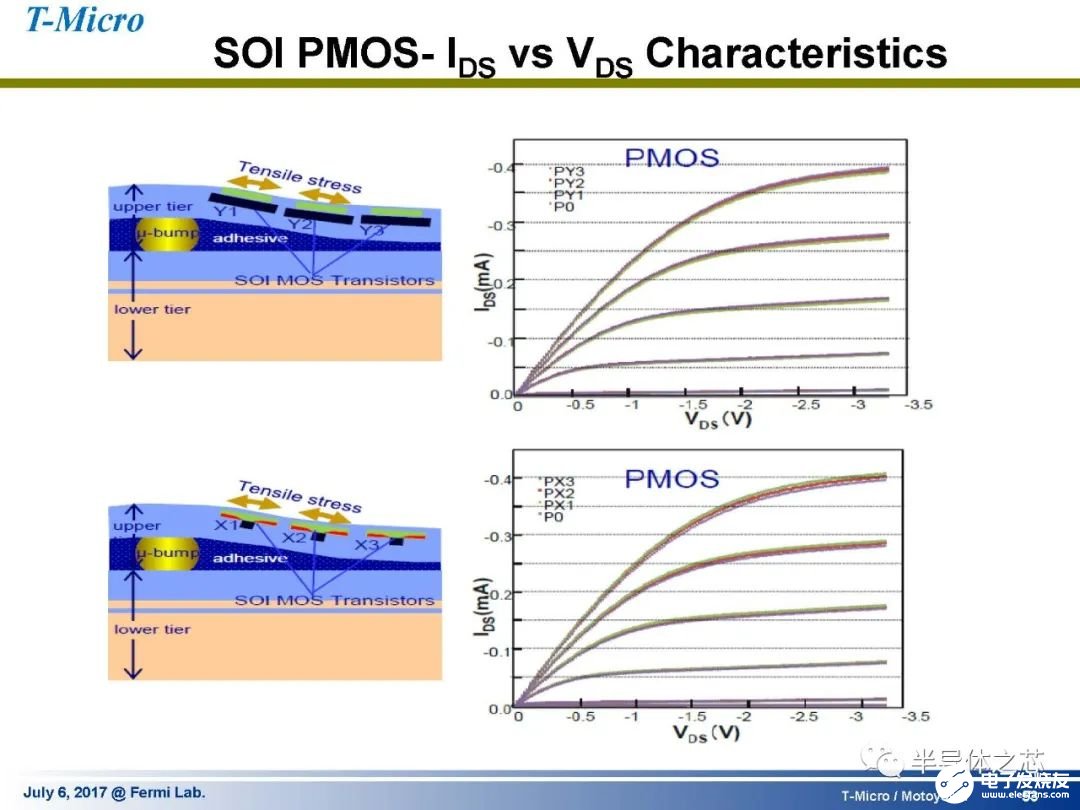
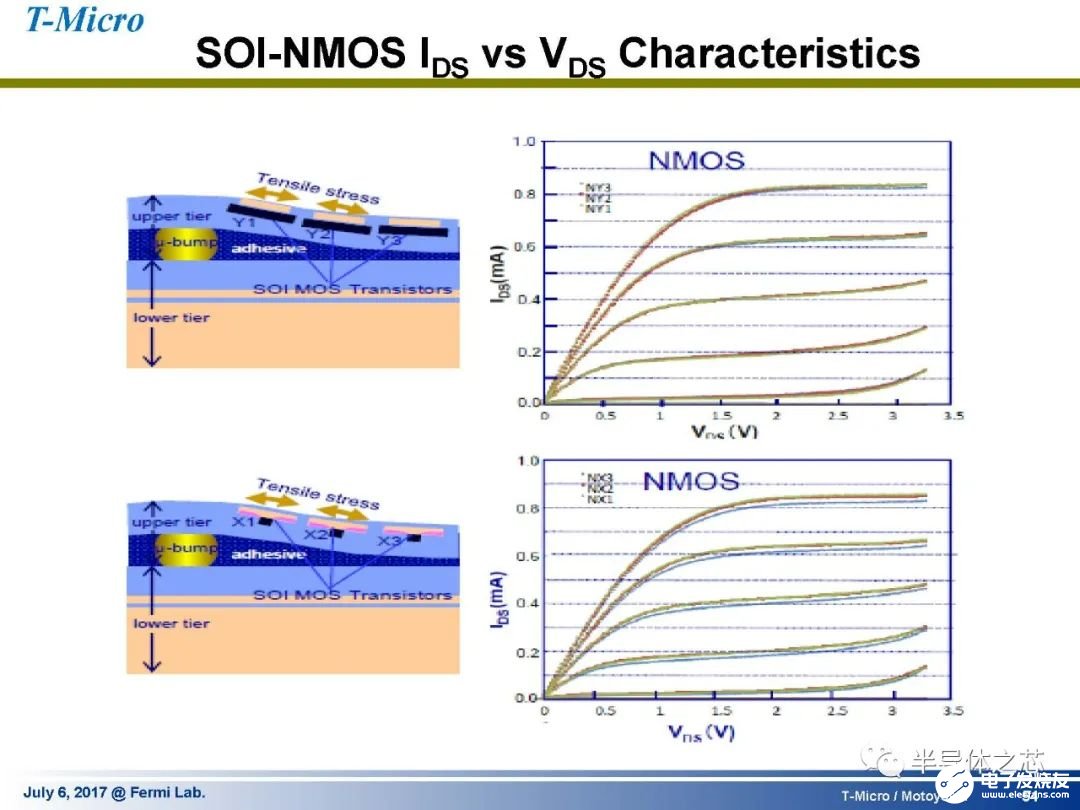
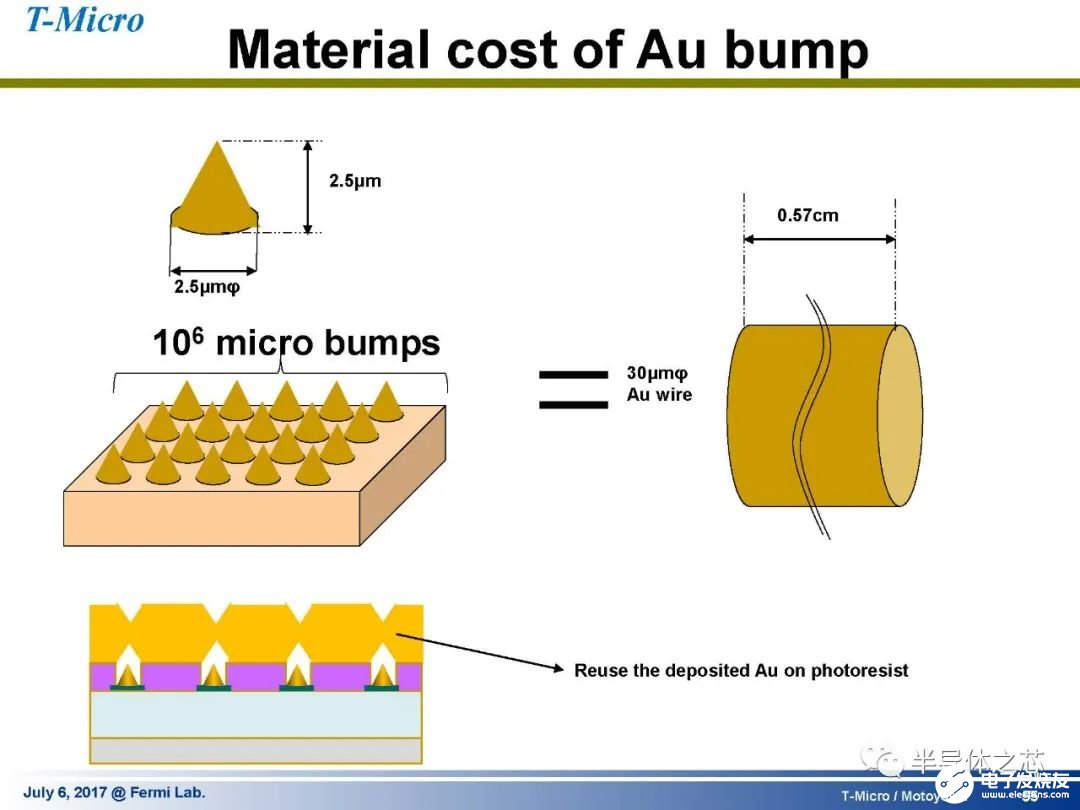

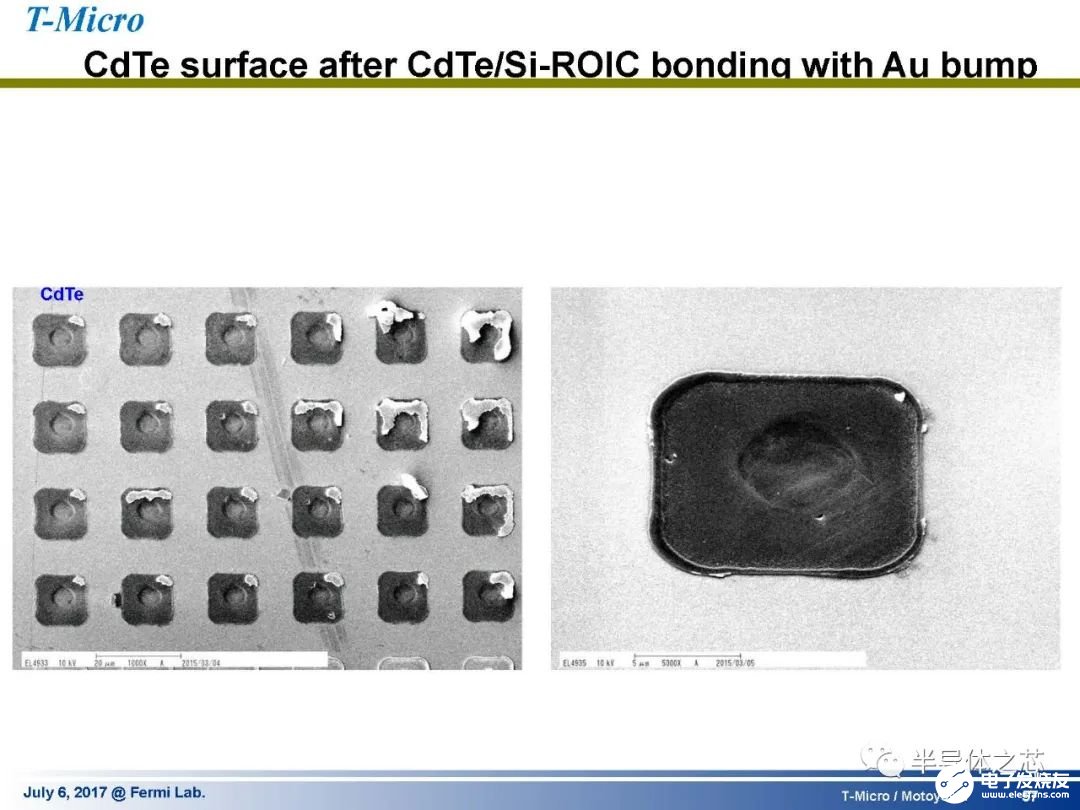
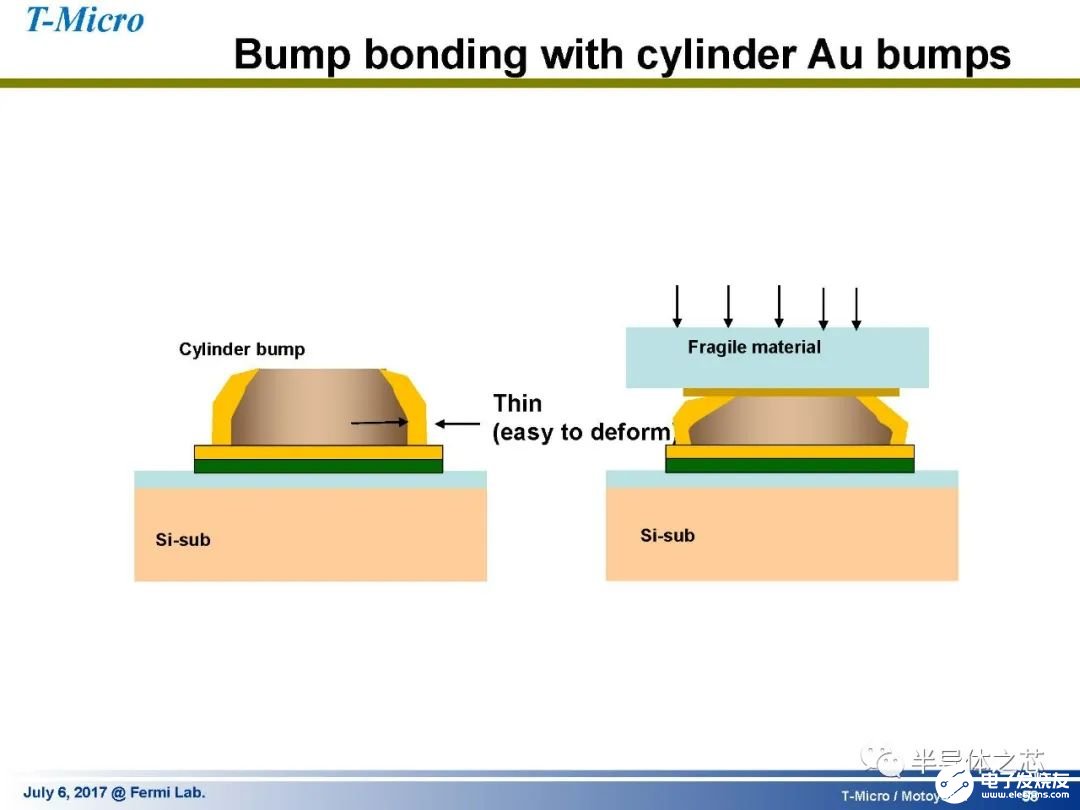
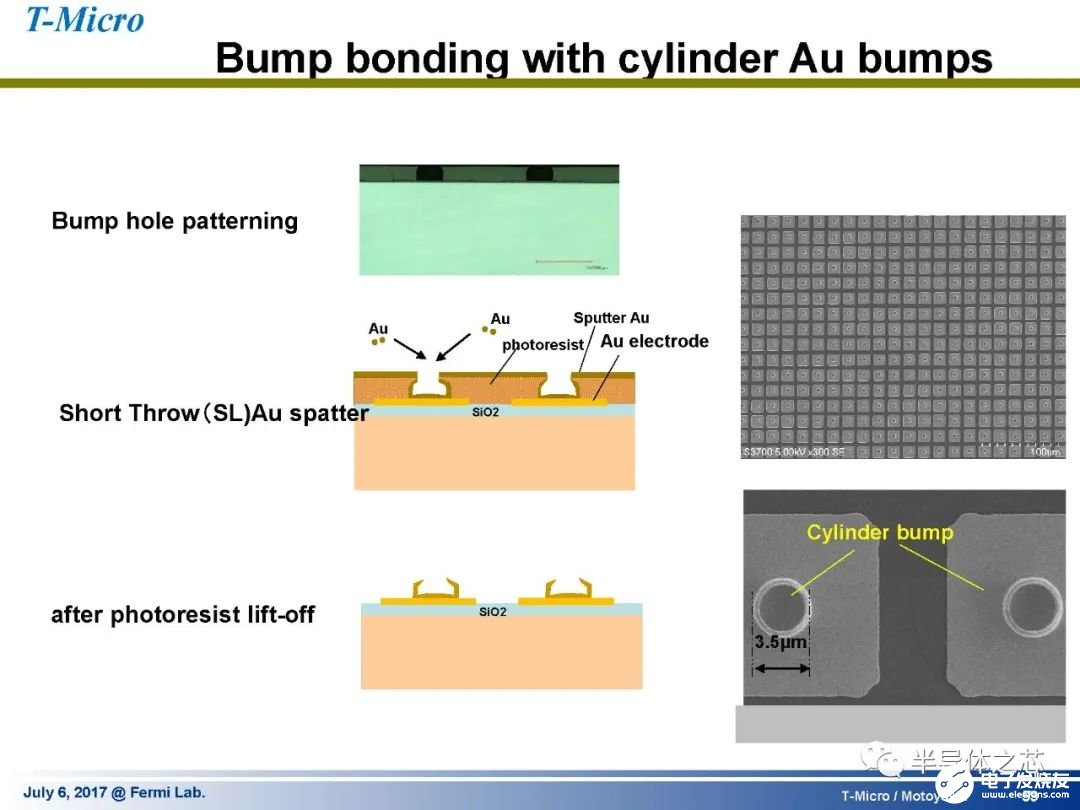


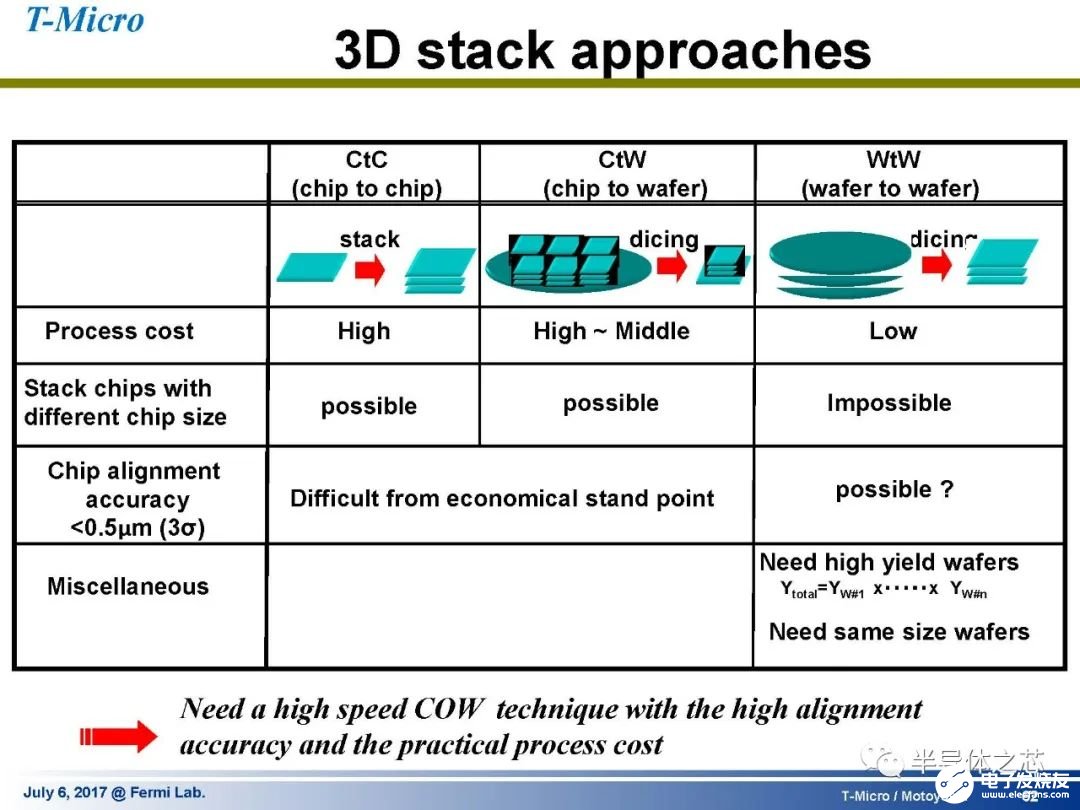
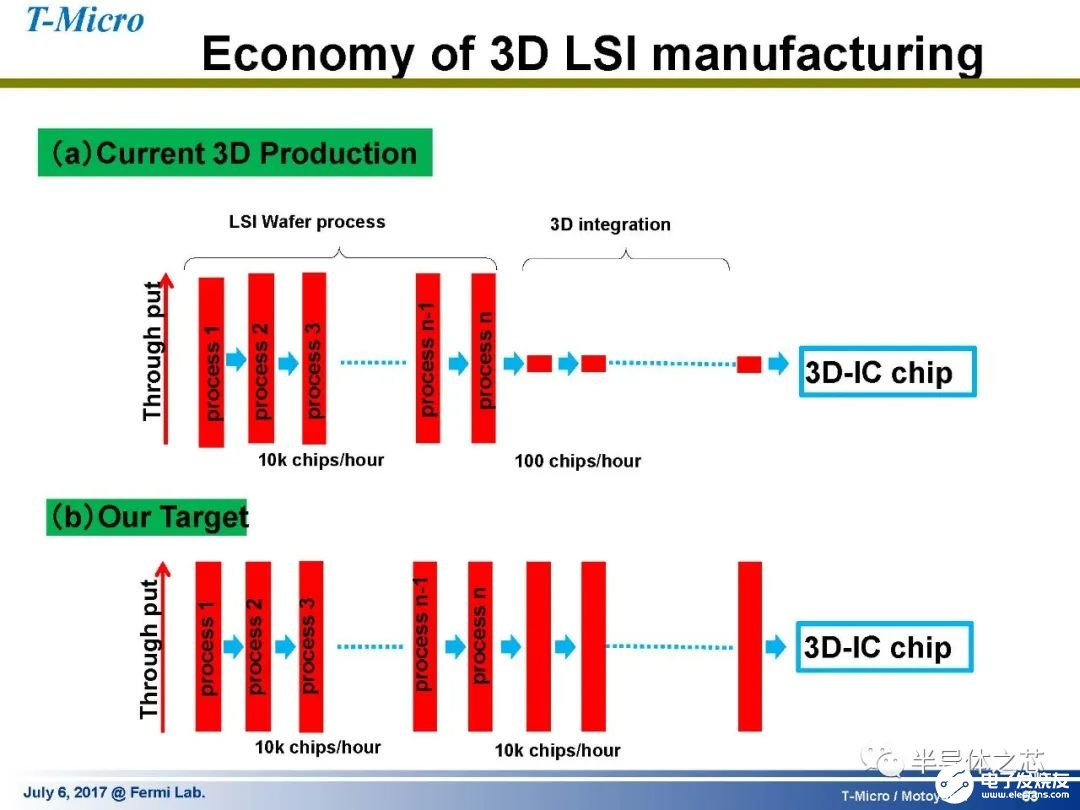

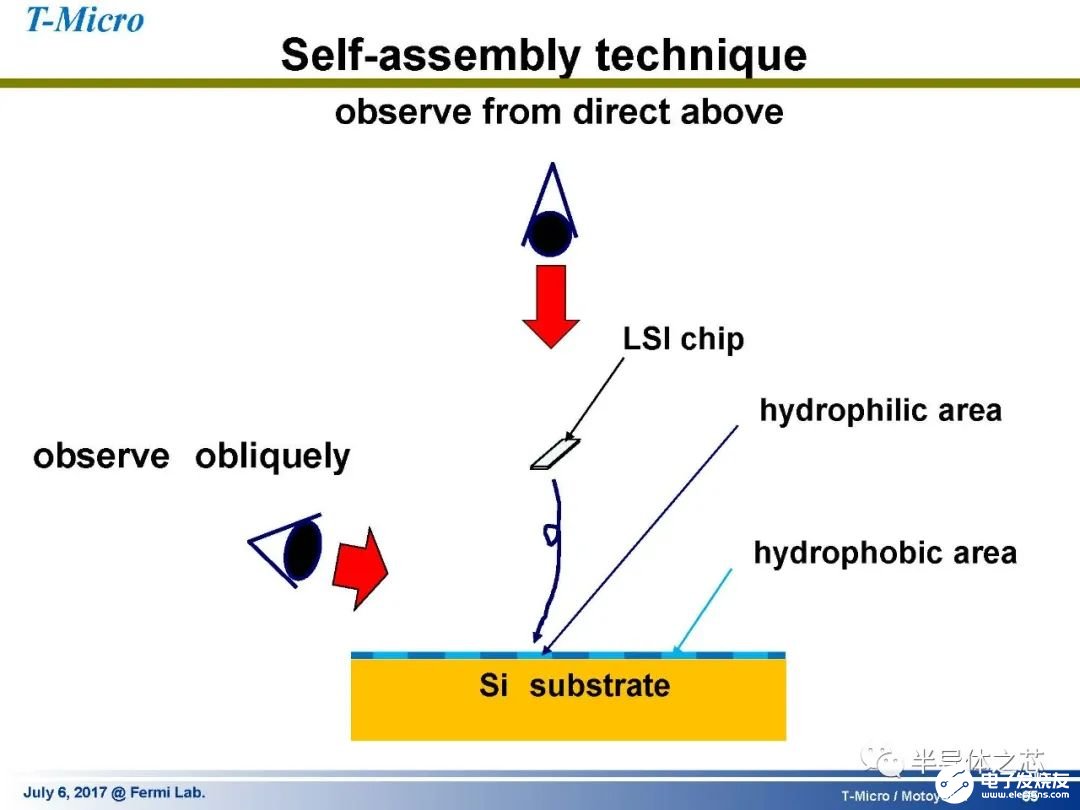


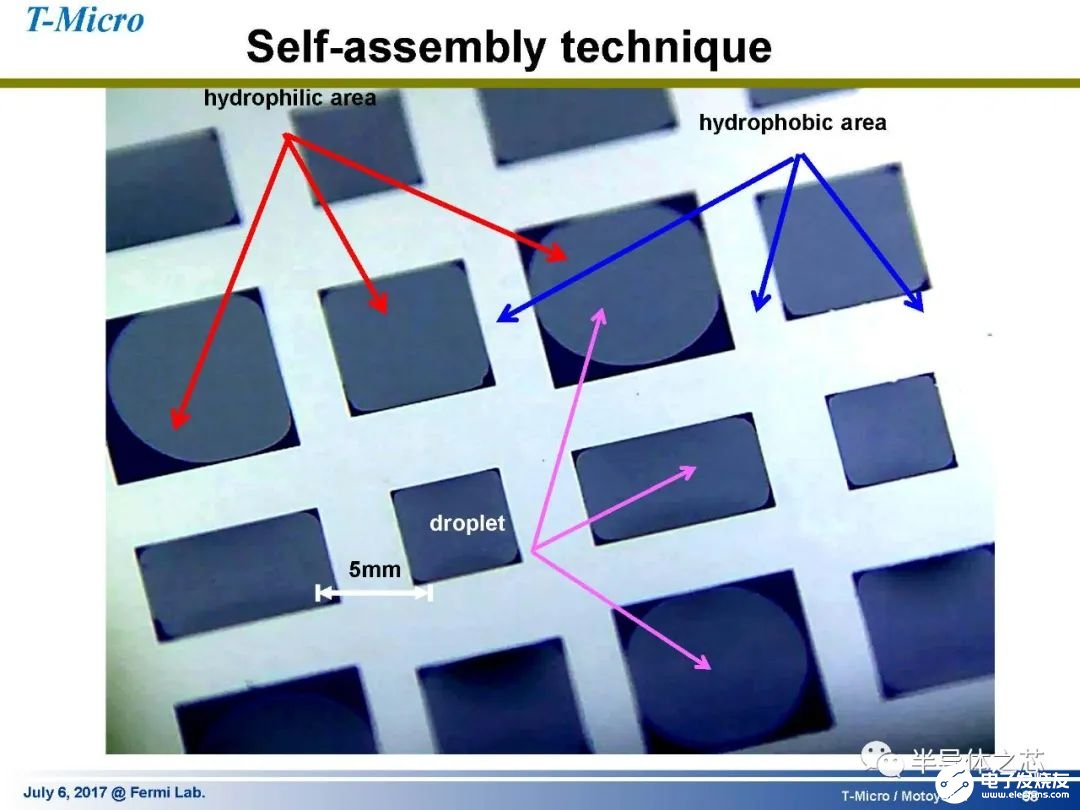
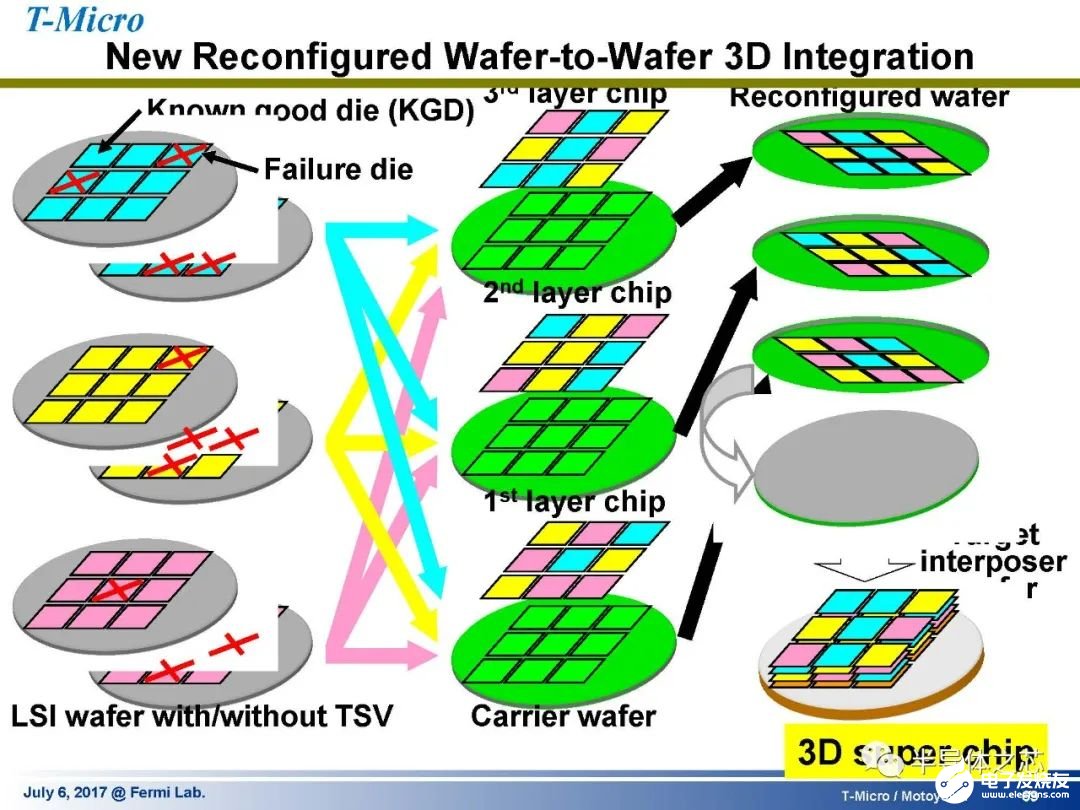
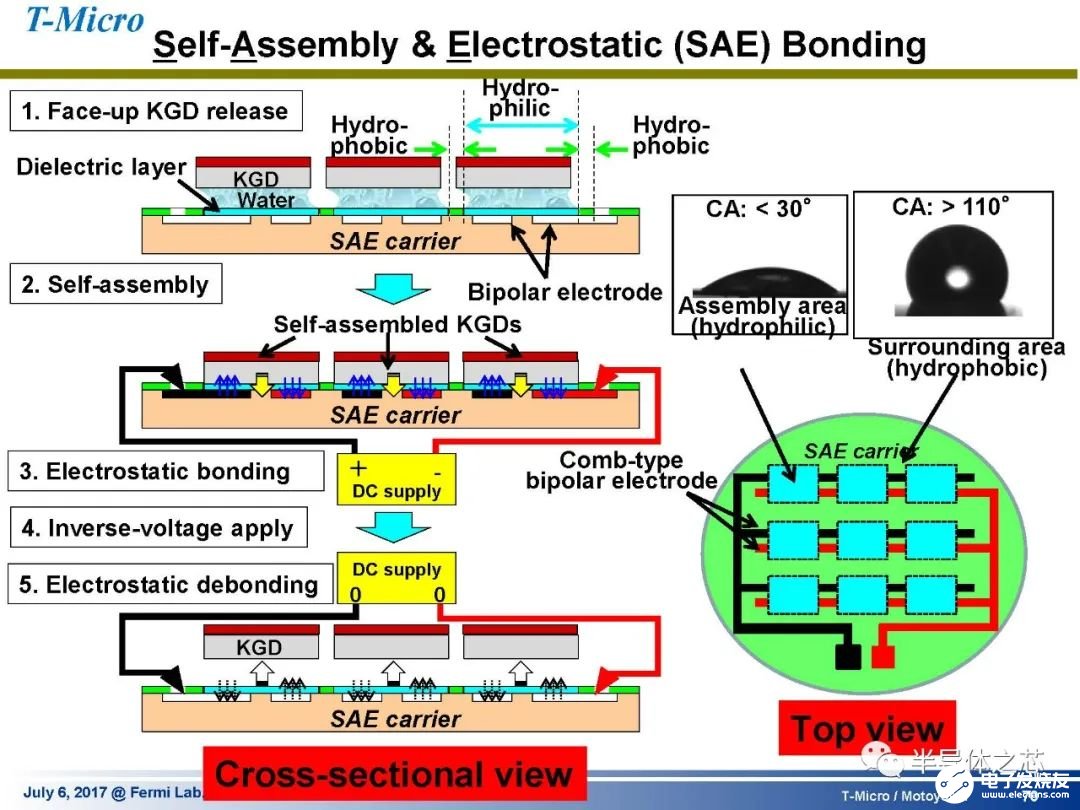


聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
探測器
+關注
關注
15文章
2769瀏覽量
76018 -
封裝
+關注
關注
128文章
9309瀏覽量
148973 -
3D堆疊封裝
+關注
關注
0文章
18瀏覽量
7603
發布評論請先 登錄
相關推薦
熱點推薦
[VirtualLab] 光波導系統的均勻性探測器
個均勻性檢測器,為此類研究提供工具。在本文檔中,我們演示了均勻性檢測器的配置選項。
這個使用用例展示了 …
均勻性檢測器
均勻性檢測器的編輯對話框
發表于 03-30 09:27
從3D堆疊到二維材料:2026年芯片技術全面突破物理極限
2026年半導體行業跨越物理極限:3D堆疊芯片性能提升300%,二維材料量產為1納米工藝鋪路。探討芯片技術在算力、能耗與全球化合作中的關鍵進
2D材料3D集成實現光電儲備池計算
先進材料與三維集成技術的結合為邊緣計算應用帶來了新的可能性。本文探討研究人員如何通過單片3D集成方式將硒化銦光電探測器與二硫化鉬憶阻晶體管結合,實現傳感器與計算單元之間物理距離小于50

電氣火災監控探測器的防護方
1. 電氣火災監控探測器 電氣火災監控探測器是指探測被保護線路中的剩余電流、溫度等電氣火災危險參數變化的探測器,適用在電氣火災發生機率最大的工廠、大型庫房、辦公室、商業建筑、賓館、住宅

相機分辨率:融合探測器與光學性能
圖1、該系統的調制傳遞函數為 MTFSYS = MTFOPTICS*MTFDETECTOR。由于探測器的調制傳遞函數起著主導作用,所以這是一個受探測器限制的系統(Fλ/d = 0.1) 相機的分辨率
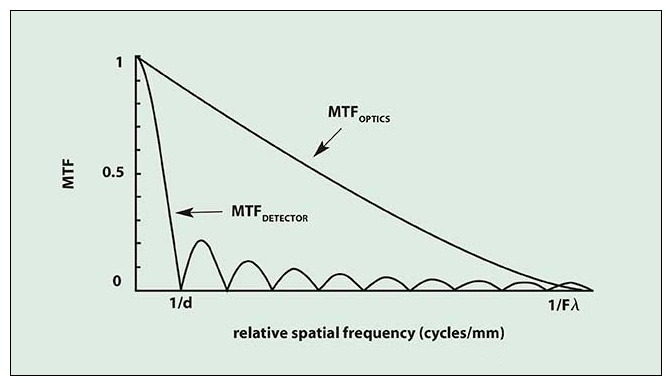
Socionext推出3D芯片堆疊與5.5D封裝技術
、3D及5.5D的先進封裝技術組合與強大的SoC設計能力,Socionext將提供高性能、高品質的解決方案,助力客戶實現創新并推動其業務增長。

【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導體芯片產業的前沿技術
無線通信(CCWC),可以解決傳統芯片內采用金屬互連線、硅通孔燈通信的瓶頸,提高芯片的性能和能效,同時大大縮小面積。
CCWC面臨的挑戰:
2、3D堆疊
1)
發表于 09-15 14:50
iTOF技術,多樣化的3D視覺應用
視覺傳感器對于機器信息獲取至關重要,正在從二維(2D)發展到三維(3D),在某些方面模仿并超越人類的視覺能力,從而推動創新應用。3D 視覺解決方案大致分為立體視覺、結構光和飛行時間 (
發表于 09-05 07:24
EtherCAT科普系列(17):EtherCAT技術在多自由度 3D 打印領域應用
3D打印技術即三維快速成型打印技術,是一種新型增材制造方式。區別于傳統的“減材制造技術”,3D打印通過數字化模型離散目標實體模型,再通過材料

VirtualLab:通用探測器
追跡結果)。請注意,這將只適用于單一模式,否則相干求和被禁用。
探測器附加組件 - 電磁場量
附加組件是一種多功能工具,允許基于入射場數據(單個物理值或2D數組)對任何值進行額外計算。它們以樹
發表于 06-12 08:59
VirtualLab Fusion應用:光波導系統的均勻性探測器
個均勻性檢測器,為此類研究提供工具。在本文檔中,我們演示了均勻性檢測器的配置選項。
這個使用用例展示了 …
均勻性檢測器
均勻性檢測器的編輯對話框
發表于 04-30 08:49



 3D堆疊像素探測器芯片技術詳解(72頁PPT)
3D堆疊像素探測器芯片技術詳解(72頁PPT)








評論