大家好久不見!今天我們來聊聊堆疊封裝。隨著信息數據大爆發時代的來臨,市場對于存儲器的需求也水漲船高,同時對于使用多芯片的堆疊技術來實現同尺寸器件中的高存儲密度的需求也日益增長。那么,什么是堆疊封裝呢?在芯片成品制造的環節中,堆疊封裝(Stacked Packaging)是一種將多個芯片垂直堆疊在一起,通過微型互連方式(如TSV硅通孔、RDL重布線層、微凸點等)實現高密度集成的封裝技術。與傳統的二維封裝相比,堆疊封裝具有更小的占板面積、更短的信號路徑和更高的帶寬密度,因此在高性能計算、移動設備、存儲和AI領域越來越受到青睞。
 圖1.半導體封裝方法的分類
圖1.半導體封裝方法的分類接下來我簡單介紹一下三種封裝方法:
1.封裝堆疊
封裝堆疊通過將多個已完成單個封裝的集成電路在垂直方向上堆疊來實現,經封裝級互連形成電氣連接后,成為一個功能完整、高密度的系統級模塊。封裝堆疊可以通過錫球柵陣列堆疊、引腳堆疊、硅中介層或硅橋堆疊等方式實現。
優勢:封裝堆疊有極高的空間利用率,通過在Z軸上充分利用空間,能顯著減小主板占用的面積;其次還能將不同工藝、不同功能、不用供應商的專用組件集成在一起;每一個封裝體在堆疊前都會進行全面的測試和老化篩選,確保只有合格的組件才能被堆疊,從而降低了復雜度和成本,提高了測試效率和良品率,如果某個封裝體測試不合格,也能輕松地完成替換;因為減少了主板上的走線密度和層數,主板的設計也得以簡化。
難點:堆疊結構在受到彎曲、沖擊或溫度循環時,應力會集中在焊接點,容易導致開裂失效。需要使用底部填充膠來增強機械強度;功耗集中在狹小的立體空間內,熱量難以散發,底部的封裝會被上方的封裝遮擋,散熱路徑受阻,可能導致器件過熱,需要精心的熱設計或使用導熱界面材料;對于有嚴格厚度和重量限制的設備,堆疊的層數和每個封裝的厚度都需要精確控制;需要協同設計多個封裝和主板,考慮信號完整性、電源完整性和熱分布的相互影響。
2.芯片堆疊
不同于在封裝外部堆疊成品組件的封裝堆疊,芯片堆疊是在封裝內部進行,堆疊的是裸晶圓,可以說芯片堆疊是更底層、更緊密、性能潛力更高的集成方式。通過在Z軸方向上將兩個或以上的經過減薄的芯片進行對準、貼裝、互連,極大地提升了在單位面積上的晶體管數量和功能多樣性。芯片堆疊的實現方式主要取決于芯片如何放置及連接的,可分為面對面、背對背、面對面和背對背混合。
優勢:更短的互連能大幅減少信號延遲和功耗,數千個I/O通道可以實現極高的寬帶,帶來性能的飛躍;外觀尺寸極小化,滿足可穿戴設備、移動設備對于緊湊的需求;在最小的體積內集成最多的功能,實現功能密度最大化。
難點:功率密度急劇上升,而散熱路徑受限,堆疊在頂部的芯片熱量必須穿過下方的芯片才能散出,導致“熱耦合”效應,設計不當會引發過熱失效;設計時需要協同進行系統架構、芯片設計、封裝設計、熱設計和信號/電源完整性分析,是一個極其復雜的多物理場問題;工藝步驟繁多,每一步都可能引入缺陷,總體良率是各步驟良率的乘積,“一顆壞,全盤廢”,成本風險高;堆疊后內部的芯片難以直接測試,因此必須依賴內建自測試和已知合格芯片策略,這增加了芯片設計和測試的成本;不同材料的熱膨脹系數不匹配,在溫度變化時會產生應力,可能導致芯片翹曲、開裂或互連失效。
3.硅通孔
硅通孔是一種通過在硅片上鉆孔來容納電極的芯片堆疊技術。相比采用傳統引線方法實現芯片與芯片(Chip-to-Chip)互連或芯片與基板(Chip-to-Substrate)互連,硅通孔通過在芯片上鉆孔并填充金屬等導電材料來實現芯片垂直互連,讓電信號可以垂直穿過硅芯片本身,而不是像傳統那樣只能通過芯片四周的引線來水平連接。盡管使用硅通孔進行堆疊時使用了芯片級工藝,但卻采用晶圓級工藝在芯片正面和背面形成硅通孔和焊接凸點(Solder Bump)。由此,硅通孔被歸類為晶圓級封裝技術。
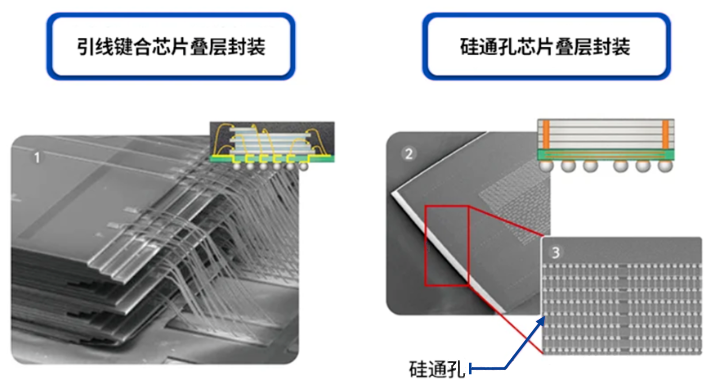 圖2.硅通孔示意圖
圖2.硅通孔示意圖硅通孔的簡化制造工藝流程包括:深刻刻蝕——絕緣層沉積——阻擋層和種子層沉積——銅電鍍填充——化學機械拋光——晶圓減薄——背面再布線層和凸點制作。
優勢:縮短互聯長度,降低延遲和功耗,提升帶寬,帶來性能的提升;實現真正的3D集成,大幅減小封裝尺寸;使不同工藝、不同材料的芯片能夠通過硅通孔和中介層實現高性能集成;更短的路徑意味著更少的串擾和電感效應,改善信號完整性。
難點:工藝復雜,設備昂貴,是3D集成中成本最高的環節之一;深孔刻蝕、無空洞電鍍、超薄晶圓處理等都極具挑戰;銅和硅的熱膨脹系數差異很大,在溫度變化時會產生應力,可能導致硅片翹曲或晶體管性能漂移;電遷移、熱機械疲勞等可靠性問題;對部分完成的硅通孔晶圓進行測試非常復雜。
關于堆疊封裝的介紹就暫告一段落,本文只對堆疊封裝進行了一點簡單的介紹,如果大家感興趣,后續我們還可以圍繞這個話題深入討論一些其他的內容,比如芯片堆疊實現方式的三種分類的優缺點、詳細的硅通孔制造工藝流程、硅通孔的三種主要集成方案、堆疊封裝的核心應用領域等。除此之外,我司的設備同樣能滿足堆疊焊接的工藝要求,配合我司持有的“正負壓焊接工藝”,相信可以令您滿意。如果您感興趣,可以聯系我們一同討論。
 圖3.我司設備示意圖
圖3.我司設備示意圖成都共益緣真空設備有限公司
-
芯片
+關注
關注
463文章
54256瀏覽量
468221 -
焊接
+關注
關注
38文章
3576瀏覽量
63384 -
3D堆疊封裝
+關注
關注
0文章
18瀏覽量
7601
發布評論請先 登錄
真空回流焊爐/真空焊接爐——正壓純氫還原+燃燒裝置




 真空共晶爐/真空焊接爐——堆疊封裝
真空共晶爐/真空焊接爐——堆疊封裝


















評論