完善資料讓更多小伙伴認(rèn)識你,還能領(lǐng)取20積分哦,立即完善>
標(biāo)簽 > TSV
TSV(Through Silicon Vias)硅片通道通過硅通孔(TSV)銅互連的立體(3D)垂直整合,目前被認(rèn)為是半導(dǎo)體行業(yè)最先進(jìn)的技術(shù)之一。硅片通孔(TSV)是三維疊層硅器件技術(shù)的最新進(jìn)展。
文章:130個(gè) 視頻:2個(gè) 瀏覽:82709次 帖子:0個(gè)

硅通孔(Through Silicon Via,TSV)技術(shù)是一種通過在硅介質(zhì)層中制作垂直導(dǎo)通孔并填充導(dǎo)電材料來實(shí)現(xiàn)芯片間垂直互連的先進(jìn)封裝技術(shù)。

硅通孔(TSV)技術(shù)借助硅晶圓內(nèi)部的垂直金屬通孔,達(dá)成芯片間的直接電互連。相較于傳統(tǒng)引線鍵合等互連方案,TSV 技術(shù)的核心優(yōu)勢在于顯著縮短互連路徑(較引...

TSV和TGV產(chǎn)品在切割上的不同難點(diǎn)
技術(shù)區(qū)別TSV硅通孔(ThroughSiliconVia),指連接硅晶圓兩面并與硅襯底和其他通孔絕緣的電互連結(jié)構(gòu)。硅中介層有TSV的集成是最常見的一種2...

在三維集成電路設(shè)計(jì)中,TSV(硅通孔)技術(shù)通過垂直互連顯著提升了系統(tǒng)集成密度與性能,但其物理尺寸效應(yīng)與寄生參數(shù)對互連特性的影響已成為設(shè)計(jì)優(yōu)化的核心挑戰(zhàn)。

構(gòu)建適用于三維集成系統(tǒng)的互連線長分布模型
在三維集成電路設(shè)計(jì)中,TSV技術(shù)通過垂直互連顯著優(yōu)化了互連線長分布特性。基于倫特定律的經(jīng)典分析框架,可構(gòu)建適用于三維集成系統(tǒng)的互連線長分布模型。
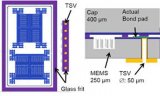
在 MEMS(微機(jī)電系統(tǒng))中,銅(Cu)因優(yōu)異的電學(xué)、熱學(xué)和機(jī)械性能,成為一種重要的金屬材料,廣泛應(yīng)用于電極、互連、結(jié)構(gòu)層等關(guān)鍵部件。
2025-08-12 標(biāo)簽:mems微機(jī)電系統(tǒng)TSV 1.2k 0

聊聊倒裝芯片凸點(diǎn)(Bump)制作的發(fā)展史
凸點(diǎn)(Bump)是倒裝芯片的“神經(jīng)末梢”,其從金凸點(diǎn)到Cu-Cu鍵合的演變,推動(dòng)了芯片從平面互連向3D集成的跨越。未來,隨著間距縮小至亞微米級、材料與工...
根據(jù)TONTI圖將離散幾何法應(yīng)用TSV力場耦合問題立即下載
類別:電力論文網(wǎng) 2017-10-28 標(biāo)簽:TSV 1.5k 0
類別:半導(dǎo)體技術(shù)論文 2011-12-07 標(biāo)簽:TSV硅通孔3D封裝 2.9k 0
類別:半導(dǎo)體技術(shù)論文 2011-12-07 標(biāo)簽:3DTSV硅通孔 1.8k 0
日月光最新推出FOCoS-Bridge TSV技術(shù)
日月光半導(dǎo)體最新推出FOCoS-Bridge TSV技術(shù),利用硅通孔提供更短供電路徑,實(shí)現(xiàn)更高 I/O 密度與更好散熱性能,滿足AI/HPC對高帶寬與高...
電子發(fā)燒友網(wǎng)報(bào)道(文/黃山明)TSV(Through Silicon Via)即硅通孔技術(shù),是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實(shí)現(xiàn)芯片...
正式投產(chǎn)!天成先進(jìn)12英寸晶圓級TSV立體集成生產(chǎn)線
來源:天成先進(jìn) 2024年12月30日,天成先進(jìn)12英寸晶圓級TSV立體集成生產(chǎn)線正式投產(chǎn)! 本次投產(chǎn)聚焦三大類型,共計(jì)六款產(chǎn)品,產(chǎn)品基于天成先進(jìn)“九重...
TSV 三維封裝技術(shù)特點(diǎn)鮮明、性能好、前景廣闊, 是未來發(fā)展方向,但是 TSV 堆疊芯片這種結(jié)構(gòu)和工 藝復(fù)雜性的提高,為三維封裝的可靠性控制帶來了 挑戰(zhàn)...

先進(jìn)封裝中互連工藝凸塊、RDL、TSV、混合鍵合的新進(jìn)展
談一談先進(jìn)封裝中的互連工藝,包括凸塊、RDL、TSV、混合鍵合,有哪些新進(jìn)展?可以說,互連工藝是先進(jìn)封裝的關(guān)鍵技術(shù)之一。在市場需求的推動(dòng)下,傳統(tǒng)封裝不斷...
2024-11-21 標(biāo)簽:SiP半導(dǎo)體封裝TSV 5.2k 0

天成先進(jìn)發(fā)布“九重”先進(jìn)封裝技術(shù)平臺(tái),12英寸晶圓級TSV立體集成生產(chǎn)線通線
“方寸無垠 恒然天成 ”。在科技的廣袤星空中,先進(jìn)封裝如一顆璀璨的新星,散發(fā)著獨(dú)特而迷人的光芒。2.5D/3D TSV 技術(shù)就像是一位神奇的建筑師,在微...

開啟高性能芯片新紀(jì)元:TSV與TGV技術(shù)解析
隨著半導(dǎo)體技術(shù)的飛速發(fā)展,傳統(tǒng)的二維平面集成方式已經(jīng)逐漸接近其物理極限。為了滿足日益增長的性能需求,同時(shí)克服二維集成的瓶頸,三維集成技術(shù)應(yīng)運(yùn)而生。其中,...

TSV 制程關(guān)鍵工藝設(shè)備技術(shù)及發(fā)展
共讀好書 魏紅軍 段晉勝 (中國電子科技集團(tuán)公司第二研究所) 摘要: 論述了 TSV 技術(shù)發(fā)展面臨的設(shè)備問題,并重點(diǎn)介紹了深硅刻蝕、 CVD/PVD 沉...
 換一批
換一批
編輯推薦廠商產(chǎn)品技術(shù)軟件/工具OS/語言教程專題
| 電機(jī)控制 | DSP | 氮化鎵 | 功率放大器 | ChatGPT | 自動(dòng)駕駛 | TI | 瑞薩電子 |
| BLDC | PLC | 碳化硅 | 二極管 | OpenAI | 元宇宙 | 安森美 | ADI |
| 無刷電機(jī) | FOC | IGBT | 逆變器 | 文心一言 | 5G | 英飛凌 | 羅姆 |
| 直流電機(jī) | PID | MOSFET | 傳感器 | 人工智能 | 物聯(lián)網(wǎng) | NXP | 賽靈思 |
| 步進(jìn)電機(jī) | SPWM | 充電樁 | IPM | 機(jī)器視覺 | 無人機(jī) | 三菱電機(jī) | ST |
| 伺服電機(jī) | SVPWM | 光伏發(fā)電 | UPS | AR | 智能電網(wǎng) | 國民技術(shù) | Microchip |
| Arduino | BeagleBone | 樹莓派 | STM32 | MSP430 | EFM32 | ARM mbed | EDA |
| 示波器 | LPC | imx8 | PSoC | Altium Designer | Allegro | Mentor | Pads |
| OrCAD | Cadence | AutoCAD | 華秋DFM | Keil | MATLAB | MPLAB | Quartus |
| C++ | Java | Python | JavaScript | node.js | RISC-V | verilog | Tensorflow |
| Android | iOS | linux | RTOS | FreeRTOS | LiteOS | RT-THread | uCOS |
| DuerOS | Brillo | Windows11 | HarmonyOS |