日月光半導體最新推出FOCoS-Bridge TSV技術,利用硅通孔提供更短供電路徑,實現更高 I/O 密度與更好散熱性能,滿足AI/HPC對高帶寬與高效能的需求。
FOCoS-Bridge TSV結合高度整合的扇出結構優勢與5μm 線寬/線距的三層RDL布線,可使電阻和電感分別降低 72% 和 50%;
當前已實現由兩個相同扇出模塊組成85mm x 85mm 測試載具(Test Vehicle)——每一模塊以4個TSV橋接芯片以及10個整合式被動芯片,橫向互連1個ASIC和4個HBM3內存。
該技術突破傳統電性互連的局限,實現處理器、加速器和內存模塊之間的高速率、低延遲、高能效的數據通訊。
從智能制造、自動駕駛,到下世代零售基建與精準診療,AI日漸融入各應用領域,推動計算及能效需求呈指數級增長。我們推出FOCoS-Bridge TSV,彰顯日月光整合解決方案支持AI生態系統的承諾。這項創新增強了我們 VIPack產品組合,并針對可持續高性能計算架構提供了一個優化可擴展的高密度封裝平臺。——日月光執行副總Yin Chang
HPC 和 AI 日益增長的應用加速高性能計算需求,日月光 FOCoS-Bridge 可實現 SoC 、Chiplets與HBM無縫整合。FOCoS-Bridge TSV提高運算和能效,并將我們的先進封裝技術組合提升到一個新的高度。——日月光研發處長李德章
日月光長期處于封裝產業前沿,是高功率 AI/HPC應用先進封裝領導廠商。我們的優勢在于我們有能力提供創新技術以滿足快速發展中客戶不斷變化的需求。——日月光工程和技術推廣處長 Charles Lee
VIPack平臺的持續擴展反映了日月光的策略愿景—為可持續的高效能運算提供全面、可擴展的生態系統,滿足新興 AI 和 HPC負載的急遽需求。
-
TSV
+關注
關注
4文章
137瀏覽量
82736 -
日月光
+關注
關注
0文章
159瀏覽量
20200 -
先進封裝
+關注
關注
2文章
554瀏覽量
1053
原文標題:日月光最新推出FOCoS-Bridge TSV技術進一步降低AI/HPC應用功耗
文章出處:【微信號:ASE_GROUP,微信公眾號:ASE日月光】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
TSV99x/TSV99xA系列運算放大器:特性、參數與應用全解析
基于TSV77x系列運算放大器的精密信號調理技術分析與應用設計
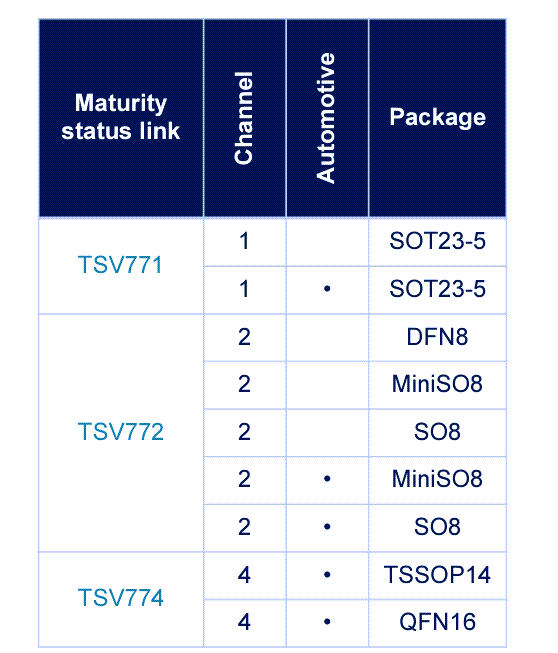
強強合作 西門子與日月光合作開發 VIPack 先進封裝平臺工作流程

TSV和TGV產品在切割上的不同難點

臺積電日月光主導,3DIC先進封裝聯盟正式成立
TSV工藝中的硅晶圓減薄與銅平坦化技術

TSV技術的關鍵工藝和應用領域

基于TSV的減薄技術解析

日月光新專利展現柔性基板“織紋術”
日月光精彩亮相SEMICON SEA 2025
TSV以及博世工藝介紹




 日月光最新推出FOCoS-Bridge TSV技術
日月光最新推出FOCoS-Bridge TSV技術







評論