電子發(fā)燒友網(wǎng)報(bào)道(文/黃山明)TSV(Through Silicon Via)即硅通孔技術(shù),是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實(shí)現(xiàn)芯片之間互連的技術(shù),是2.5D/3D封裝的關(guān)鍵工藝技術(shù)之一。
這些材料核心功能主要有三個(gè),導(dǎo)電連接,主要提供低電阻信號/電源傳輸路徑;結(jié)構(gòu)支撐,用來承受多層堆疊帶來的機(jī)械應(yīng)力;介質(zhì)隔離,避免相鄰?fù)组g的電短路。
主流材料種類繁多,包括導(dǎo)電材料、絕緣材料、輔助材料等。技術(shù)上,TSV材料需要再材料匹配性上讓熱膨脹系數(shù)(CTE)需與硅(2.6ppm/℃)接近,避免熱應(yīng)力導(dǎo)致分層,其中銅填充需控制晶粒尺寸(<1μm)以降低電阻率。
填充工藝上,要滿足高深寬比(>10:1)通孔的無空洞填充,電鍍銅需優(yōu)化添加劑(如整平劑、抑制劑)實(shí)現(xiàn)超填充( superfilling)。
同時(shí)可靠性上,電遷移壽命(10年@150℃)需滿足 JEDEC 標(biāo)準(zhǔn),銅擴(kuò)散阻擋層厚度需≥10nm(防止與硅反應(yīng)生成Cu?Si)。
當(dāng)前全球TSV技術(shù)發(fā)展情況
目前在全球,主要由臺(tái)積電、三星和英特爾主導(dǎo)TSV技術(shù)發(fā)展,尤其在HBM、3D IC等高端封裝領(lǐng)域占據(jù)全球超80%市場份額。其中銅作為主流填充材料,其電鍍工藝(如硫酸銅、甲基磺酸銅體系)已實(shí)現(xiàn)高深寬比TSV的無缺陷填充,電鍍設(shè)備與添加劑市場由安美特、陶氏等國際企業(yè)壟斷。
規(guī)模上,2024年全球TSV市場規(guī)模達(dá)342.3億美元,預(yù)計(jì)2031年增至796.1億美元(CAGR 13%),其中填充材料成本占比達(dá)44%,驅(qū)動(dòng)電鍍市場年復(fù)合增長率16%。預(yù)計(jì)2025年中國TSV市場規(guī)模占全球25%,2027年國內(nèi)封裝材料市場規(guī)模突破600億元,TSV相關(guān)材料(如絕緣層、種子層)成為增長核心。
近年來,國內(nèi)市場在TVS材料上也有了不小的技術(shù)突破,例如深南電路、興森科技的FC-BGA基板通過華為認(rèn)證;華海誠科的顆粒狀環(huán)氧塑封料(GMC)通過HBM封裝驗(yàn)證;德邦科技實(shí)現(xiàn)集成電路封裝材料批量供應(yīng)。
值得一提的是,TSV關(guān)鍵材料(如絕緣層、種子層)國產(chǎn)化率逐步提升,2025年目標(biāo)ABF載板15%、鍵合絲30%、封裝樹脂25%,2030年目標(biāo)達(dá)50%、70%、60%。當(dāng)然,一些高端材料(如高純度球鋁、先進(jìn)基板)仍依賴進(jìn)口,需加強(qiáng)產(chǎn)學(xué)研協(xié)同發(fā)展。
小結(jié)
TSV 填充材料的選擇需綜合考慮導(dǎo)電性、機(jī)械性能、工藝兼容性及成本。隨著 3D 集成技術(shù)向更高密度、更低功耗發(fā)展,材料創(chuàng)新與工藝優(yōu)化將持續(xù)推動(dòng) TSV 技術(shù)突破,成為半導(dǎo)體產(chǎn)業(yè)重要支撐。
這些材料核心功能主要有三個(gè),導(dǎo)電連接,主要提供低電阻信號/電源傳輸路徑;結(jié)構(gòu)支撐,用來承受多層堆疊帶來的機(jī)械應(yīng)力;介質(zhì)隔離,避免相鄰?fù)组g的電短路。
| 材料類型 | 典型材料 | 特性優(yōu)勢 | 應(yīng)用場景 |
| 導(dǎo)電材料 | 銅(Cu) | 導(dǎo)電性最優(yōu)(1.68μΩ?cm),成本低 | 主流 TSV 填充 |
| 鎢(W) | 抗電遷移能力強(qiáng),高溫穩(wěn)定性好 | 高溫環(huán)境 / 可靠性要求高 | |
| 銀(Ag) | 高導(dǎo)電性,但成本高易氧化 | 特殊高頻器件 | |
| 絕緣材料 | 二氧化硅(SiO?) | 介電常數(shù)低(3.9),工藝成熟 | 通孔側(cè)壁絕緣 |
| 聚酰亞胺(PI) | 柔韌性好,應(yīng)力緩沖能力強(qiáng) | 柔性電子器件 | |
| 氮化硅(Si?N?) | 高擊穿電壓(>10MV/cm) | 高壓器件 | |
| 輔助材料 | 阻擋層(Ta/TaN) | 防止銅擴(kuò)散至硅基底 | 銅填充 TSV 必備 |
| 種子層(Cu) | 促進(jìn)電鍍銅均勻沉積 | 銅填充工藝 |
主流材料種類繁多,包括導(dǎo)電材料、絕緣材料、輔助材料等。技術(shù)上,TSV材料需要再材料匹配性上讓熱膨脹系數(shù)(CTE)需與硅(2.6ppm/℃)接近,避免熱應(yīng)力導(dǎo)致分層,其中銅填充需控制晶粒尺寸(<1μm)以降低電阻率。
填充工藝上,要滿足高深寬比(>10:1)通孔的無空洞填充,電鍍銅需優(yōu)化添加劑(如整平劑、抑制劑)實(shí)現(xiàn)超填充( superfilling)。
同時(shí)可靠性上,電遷移壽命(10年@150℃)需滿足 JEDEC 標(biāo)準(zhǔn),銅擴(kuò)散阻擋層厚度需≥10nm(防止與硅反應(yīng)生成Cu?Si)。
當(dāng)前全球TSV技術(shù)發(fā)展情況
目前在全球,主要由臺(tái)積電、三星和英特爾主導(dǎo)TSV技術(shù)發(fā)展,尤其在HBM、3D IC等高端封裝領(lǐng)域占據(jù)全球超80%市場份額。其中銅作為主流填充材料,其電鍍工藝(如硫酸銅、甲基磺酸銅體系)已實(shí)現(xiàn)高深寬比TSV的無缺陷填充,電鍍設(shè)備與添加劑市場由安美特、陶氏等國際企業(yè)壟斷。
規(guī)模上,2024年全球TSV市場規(guī)模達(dá)342.3億美元,預(yù)計(jì)2031年增至796.1億美元(CAGR 13%),其中填充材料成本占比達(dá)44%,驅(qū)動(dòng)電鍍市場年復(fù)合增長率16%。預(yù)計(jì)2025年中國TSV市場規(guī)模占全球25%,2027年國內(nèi)封裝材料市場規(guī)模突破600億元,TSV相關(guān)材料(如絕緣層、種子層)成為增長核心。
近年來,國內(nèi)市場在TVS材料上也有了不小的技術(shù)突破,例如深南電路、興森科技的FC-BGA基板通過華為認(rèn)證;華海誠科的顆粒狀環(huán)氧塑封料(GMC)通過HBM封裝驗(yàn)證;德邦科技實(shí)現(xiàn)集成電路封裝材料批量供應(yīng)。
值得一提的是,TSV關(guān)鍵材料(如絕緣層、種子層)國產(chǎn)化率逐步提升,2025年目標(biāo)ABF載板15%、鍵合絲30%、封裝樹脂25%,2030年目標(biāo)達(dá)50%、70%、60%。當(dāng)然,一些高端材料(如高純度球鋁、先進(jìn)基板)仍依賴進(jìn)口,需加強(qiáng)產(chǎn)學(xué)研協(xié)同發(fā)展。
小結(jié)
TSV 填充材料的選擇需綜合考慮導(dǎo)電性、機(jī)械性能、工藝兼容性及成本。隨著 3D 集成技術(shù)向更高密度、更低功耗發(fā)展,材料創(chuàng)新與工藝優(yōu)化將持續(xù)推動(dòng) TSV 技術(shù)突破,成為半導(dǎo)體產(chǎn)業(yè)重要支撐。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報(bào)投訴
-
TSV
+關(guān)注
關(guān)注
4文章
139瀏覽量
82743 -
硅通孔
+關(guān)注
關(guān)注
2文章
31瀏覽量
12141
發(fā)布評論請先 登錄
相關(guān)推薦
熱點(diǎn)推薦
無源TSV轉(zhuǎn)接板的制作方法
無源TSV轉(zhuǎn)接板作為先進(jìn)封裝的“交通樞紐”,是實(shí)現(xiàn)高密度異構(gòu)集成的核心。本文深度解析TSV高深寬比刻蝕與填充工藝,詳盡對比聚合物電鍍與大馬士革法RDL的制備差異,并拆解背面減薄、露銅及CoW組裝全流程,帶你攻克先進(jìn)互連技術(shù)的制造

硅通孔電鍍材料在先進(jìn)封裝中的應(yīng)用
硅通孔(TSV)技術(shù)借助硅晶圓內(nèi)部的垂直金屬通孔,達(dá)成芯片間的直接電互連。相較于傳統(tǒng)引線鍵合等互連方案,

?三維集成電路的TSV布局設(shè)計(jì)
在三維集成電路設(shè)計(jì)中,TSV(硅通孔)技術(shù)通過垂直互連顯著提升了系統(tǒng)集成密度與性能,但其物理尺寸效應(yīng)與寄生參數(shù)對互連特性的影響已成為設(shè)計(jì)優(yōu)化的核心挑戰(zhàn)。

TSV工藝中的硅晶圓減薄與銅平坦化技術(shù)
本文主要講述TSV工藝中的硅晶圓減薄與銅平坦化。 硅晶圓減薄與銅平坦化作為 TSV 三維集成技術(shù)的核心環(huán)節(jié),主要應(yīng)用于含銅 TSV 互連的減

PCB板中塞孔和埋孔的區(qū)別
PCB板中塞孔和埋孔在很多方面都存在明顯區(qū)別,下面咱們一起來看看: 一、定義? 塞孔是指在孔壁鍍銅之后,用環(huán)氧樹脂等材料填平過孔,再在表面鍍
TSV制造技術(shù)里的通孔刻蝕與絕緣層
相較于傳統(tǒng)CMOS工藝,TSV需應(yīng)對高深寬比結(jié)構(gòu)帶來的技術(shù)挑戰(zhàn),從激光或深層離子反應(yīng)刻蝕形成盲孔開始,經(jīng)等離子體化學(xué)氣相沉積絕緣層、金屬黏附/阻擋/種子層的多層沉積,到銅電鍍填充及改進(jìn)型化學(xué)機(jī)械拋光(CMP)處理厚銅層,每一步均
基于TSV的減薄技術(shù)解析
在半導(dǎo)體三維集成(3D IC)技術(shù)中,硅通孔(TSV)是實(shí)現(xiàn)芯片垂直堆疊的核心,但受深寬比限制,傳統(tǒng)厚硅片(700-800μm)難以制造直徑更小(5-20μm)的TSV,導(dǎo)致芯片面積占

日月光最新推出FOCoS-Bridge TSV技術(shù)
日月光半導(dǎo)體最新推出FOCoS-Bridge TSV技術(shù),利用硅通孔提供更短供電路徑,實(shí)現(xiàn)更高 I/O 密度與更好散熱性能,滿足AI/HPC對高帶寬與高效能的需求。
溝槽填充技術(shù)介紹
(void),溝槽的填充工藝技術(shù)也不斷發(fā)展。從圖中可見,集成電路芯片的制造過程中包含很多種填充技術(shù)上的挑戰(zhàn),包括淺溝槽隔離、接觸孔和溝槽。根據(jù)填充材
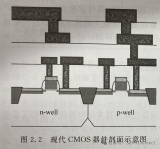
TSV以及博世工藝介紹
在現(xiàn)代半導(dǎo)體封裝技術(shù)不斷邁向高性能、小型化與多功能異構(gòu)集成的背景下,硅通孔(TSV,Through-SiliconVia)工藝作為實(shí)現(xiàn)芯片垂直互連與三維集成(3DIC)的核心技術(shù),正日益成為先進(jìn)封裝




 TSV硅通孔填充材料
TSV硅通孔填充材料









評論