共讀好書
魏紅軍 段晉勝
(中國電子科技集團公司第二研究所)
摘要:
論述了 TSV 技術發展面臨的設備問題,并重點介紹了深硅刻蝕、 CVD/PVD 沉積、電鍍銅填充、晶圓減薄、晶圓鍵合等幾種制約我國 TSV 技術發展的關鍵設備。
隨著半導體技術的發展,特征尺寸已接近物理極限,以往通過減小芯片特征尺寸的方法已無法滿足消費類電子產品向更為智能、緊湊及集成化方向發展的需求,基于 TSV 的 3D 封裝為業界提供了一種全新的途徑,能夠使芯片在三維方向堆疊的密度最大,芯片之間的互連線最短,外形尺寸最小,大大改善芯片速度和低功耗的性能。
TSV(through siliconvia) 技術是穿透硅通孔技術的英文縮寫,一般簡稱硅通孔或硅穿孔技術,是 3D 集成電路中堆疊芯片實現互連的一種新的技術解決方案。它是在芯片和芯片之間、晶圓和晶圓之間制作垂直導通,從而實現芯片之間的互連,相對于傳統的引線鍵合(WB)、載帶自動焊(TAB)以及倒裝芯片(FC),TSV 技術具有的優勢:
(1)高密度集成:可以大幅度地提高電子元器件的集成度,減少封裝的幾何尺寸,滿足消費類電子產品對于多功能和小型化的要求;
(2)提高電性能:可以大幅度地縮短電互連的長度,連線長度縮短到芯片厚度,傳輸距離減少到千分之一,進而降低寄生電容和耗電量;
(3) 實現異質集成:可以把不同的功能芯片(如射頻、內存、邏輯、數字和 MEMS 等)集成在一起,實現電子元器件的多功能化;
(4)降低成本:基于 TSV 的 3D 集成技術雖然目前在工藝上的成本較高,但是將來在技術和設備成熟條件下比 2D 封裝更具成本效益。基于此,TSV 也被業界稱為繼引線鍵合、載帶自動焊和倒裝芯片之后的第四代互連技術,也被稱為終極互連技術。
1 TSV 工藝技術發展面臨的設備問題
TSV 技術首先應用于圖像傳感器,未來還將在邏輯芯片、存儲器芯片、CPU 甚至異質集成方面都會得到廣泛應用,技術應用領域不斷拓展,其發展前景十分光明。可以預知的是,隨著 TSV 技術的發展,將會帶來新的生產設備群的發展,如深刻蝕設備、銅填充設備、鍵合機、微檢測儀等,同時也意味著大量的傳統設備即將淘汰。
通 過 近 幾 年 的 發 展 , 國 內 在 深 刻 蝕 、PVD/CVD、晶圓減薄、晶圓鍵合等設備領域積累了一定經驗,并有了一定突破,但與國外最高水平相比還有很大差距。用于 TSV 制程的關鍵設備依賴少數國外企業,存在成本高、交貨周期長、應對市場變化反應較慢的情況。國內設備廠商設備的各項經濟技術指標如能達到國外設備同等或更高的水平,將可能被優先采用,市場前景廣闊。
2 TSV 制程關鍵工藝設備
TSV 制作工藝包括以下幾步:通孔制作;絕緣層、阻擋層和種子層的沉積;銅填充;通過化學機械拋光去除多余的金屬;晶圓減薄;晶圓鍵合等。每一步工藝都有相當的技術難度,在通孔制作步驟,保持孔的形狀和控制角度非常重要,通過Bosch 工藝來實現深孔刻蝕;在沉積絕緣層、阻擋層和種子層時,需要考慮各層的均勻性和粘附性;銅填充時必須避免空洞等缺陷,這樣填充的銅可以在疊層器件較高的溫度下保持正常的電性能;一旦完成了銅填充,則需要對晶圓進行減薄;最后是進行晶圓鍵合。
TSV 制作流程會涉及到深刻蝕、PVD、CVD、銅填充、微凸點及 RDL 電鍍、清洗、減薄、鍵合等二十余種設備,其中通孔制作、絕緣層 / 阻擋層 /種子層的沉積、銅填充、晶圓減薄、晶圓鍵合等工序涉及的設備最為關鍵,在某種程度上直接決定了 TSV 的性能指標。
2.1 深硅刻蝕設備
通常情況下,制造硅通孔(經常穿透多層金屬和絕緣材料) 采用深反應離子刻蝕技術(DRIE),常用的深硅刻蝕技術又稱為“Bosch(博氏)”工藝,有最初發明該項技術的公司命名。
如圖 1 所示,一個標準 Bosch 工藝循環包括選擇性刻蝕和鈍化兩個步驟,其中選擇性刻蝕過程采用的是 SF 6 和 O 2 兩種氣體,鈍化過程采用的是 C 4 F 8 氣體。在 Bosch 工藝過程中,首先利用 SF 6等離子體刻蝕硅襯底,接著利用 C 4 F 8 等離子體作為鈍化物沉積在硅襯底上,在這些氣體中加入 O 2等離子體,能夠有效控制刻蝕速率與選擇性。因此,在 Bosch 刻蝕過程中很自然地形成了貝殼狀的刻蝕側壁。
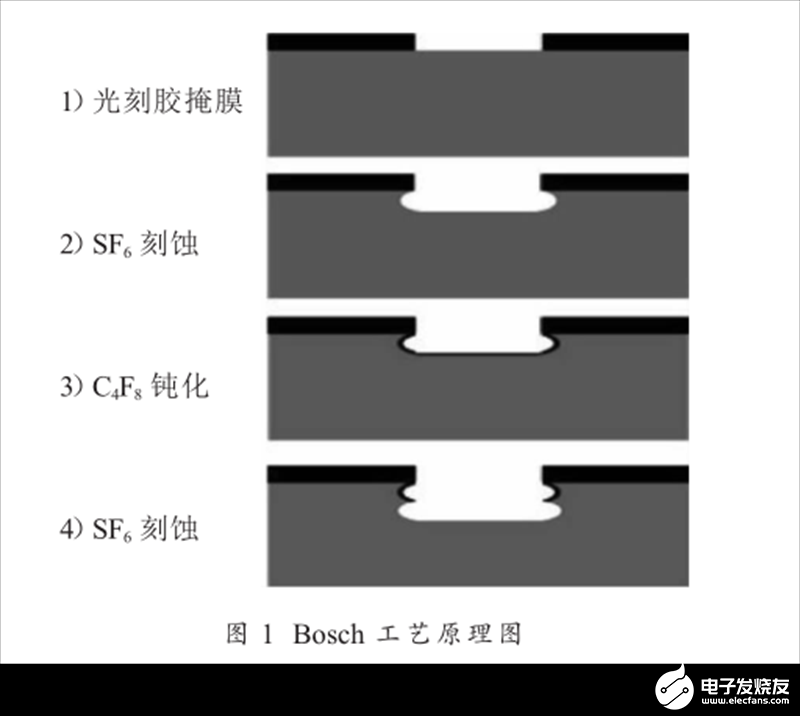
目前深硅刻蝕設備主要由美國應用材料、泛林半導體等設備廠商控制。從國內看,近年來在國家科技重大專項支持下,中微半導體、北方微電子等廠家研制的深硅等離子刻蝕機可以投入硅通孔刻蝕的研發及量產中。尤其 DSE200 系列刻蝕機是北方微電子公司于 2012 年推出的首款深硅等離子刻蝕機,該刻蝕機能實現高達 50:1 的硅高深寬比刻蝕,并同時實現優良的側壁形貌控制、穩定的均勻性、極高的刻蝕選擇比。
2.2 PVD/CVD 沉積設備
硅通孔形成后,通過等離子體增強化學氣相沉積法(PECVD)在硅孔內表面沉積一層絕緣材料 SiO 2 ,工藝溫度低,在 100~400℃進行沉積,是TSV 孔絕緣的主流技術之一。今年來ICP-PECVD新型等離子氣相增強化學沉積設備被引入進行TSV 孔絕緣層的填充,與常規 PECVD 不同之處在于,其射頻功率通過電感耦合至工藝腔室,配合耦合至反應室襯底的射頻源可以提高反應離子的方向性,典型的 ICP-PECVD 工藝腔設計如圖 2 所示。ICP-PECVD 沉積 SiO 2 的工藝溫度低至 20~100 ℃,反應離子濃度高,有助于提高對 TSV 孔的填充效率。

絕緣層做好后,通過物理氣相沉積法(PVD)沉積金屬擴散阻擋層和種子層,為后續的銅填充做好準備。如果填充材料為多晶硅或者鎢,則不需要種子層。
后續的電鍍銅填充要求 TSV 側壁和底部具有連續的阻擋層和種子層。種子層的連續性和均勻性被認為是 TSV 銅填充最重要的影響因素。根據硅通孔的形狀、深寬比及沉積方法不同,種子層的特點也各有不同,種子層沉積的厚度、均勻性和粘合強度是很重要的指標。
2.3 電鍍銅填充設備
很多成本模型顯示,TSV 填充工藝是整個工藝流程中最昂貴的步驟之一。TSV 的主要成品率損耗之一是未填滿的空洞。電鍍銅工藝作為最合適的硅通孔填充技術受到業內的普遍關注,其關鍵技術在于 TSV 高深寬比(通常大于 10:1)通孔的全填充電鍍技術。
國外有諸多公司已經成功研發該項目技術并已形成成熟產品,包括 NEXX、TECHNIC、Semitool等公司。尤其是美國 NEXX 公司是先進封裝領域的專用設備供應商,其中 Stratus S200 (4~8 英寸)、S300(8~12 英寸)全自動電鍍設備已應用于全球各大封裝廠家的 12 英寸及以下規格的晶圓量產生產中,可用于 TSV、凸點、UBM、RDL、銅互連等制程。見圖 3。

NEXX 公司系列電鍍設備銷往全球,其中亞洲封測廠家占 75%。據了解國內封裝龍頭企業長電、富士通等的產線上都在使用 Stratus 系列設備。該系列設備采用剪切電鍍方式,具有鍍層均勻、結構緊湊、易于擴展等優點,為封測廠家提供了質量穩定、生產效率高、占地小的一款自動設備。
垂直剪切鍍單元作為該設備的核心部分(見圖 4),主要包括陽極、屏蔽件、晶圓夾具、剪切屏及驅動電機等。整體單元框架上分別布置以上各件的安裝導槽、提高鍍層均勻性的剪切屏、直流導電夾緊機構。各個部件主體均采用氟塑料材質板,單元整體為用螺栓、密封件將各個部件連接組合。
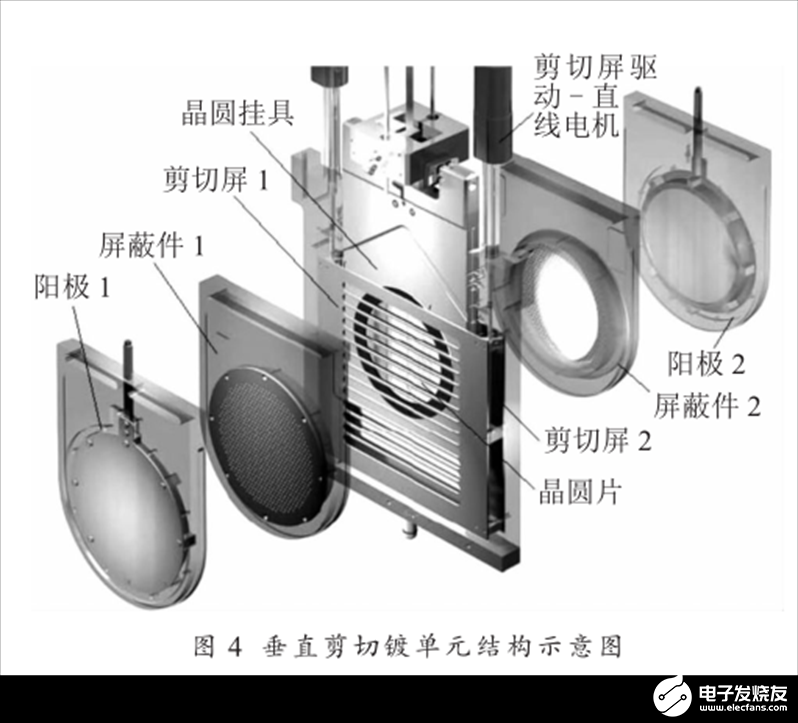
目前國內研究機構在 TSV 單項技術上取得一些研究結果,但是對于電鍍相關工藝設備幾乎并無廠家涉及,只有中國電子科技集團公司第二研究所在進行 TSV 銅填充工藝技術的研究,并有相關實驗設備交付客戶使用。
2.4 晶圓減薄設備
TSV 要求晶圓減薄至 50 μm 甚至更薄,要使硅孔底部的銅暴露出來,為下一步的互連做準備。目前晶圓減薄可以通過機械研磨、化學機械拋光、濕法及干法化學處理等不同的加工工序來實現,通過它們之間有機的結合,并優化這幾道工序的比例關系,保證晶圓既能減薄到要求的厚度,又要有足夠的強度。目前四種主要晶圓減薄方法對比見表 1。
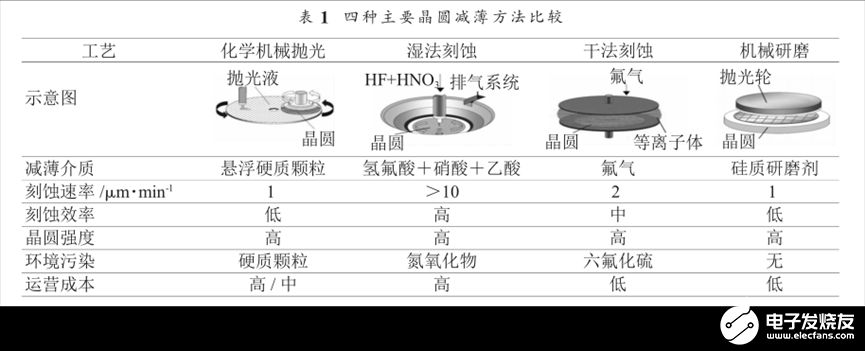
在要求<50 μm 這個厚度上,晶圓很難容忍減薄過程中的磨削對晶圓的損傷及內在應力,其剛性也難以使晶圓保持原有的平整狀態,同時后續工藝的晶圓傳遞、搬送也遇到了很大的問題。目前業界的主流解決方案是采用一體機的思路,將晶圓的磨削、拋光、保護膜去除、劃片膜粘貼等工序集合在一臺設備內,晶圓從磨片一直到粘貼劃片膜為止始終被吸在真空吸盤上,始終保持平整狀態,從而解決了搬送的難題。
圖 5 是東京精密公司的一體機PG200/300 的基本配置示意圖。圖中 PG 部分是磨片和拋光的集成體。通過一個帶有 4 個真空吸盤的大圓盤回轉臺 360°順時針旋轉,使晶圓在不用離開真空吸盤的情況下就可以依次送到粗磨、精磨、拋光等不同的加工工位,完成整個減薄過程。

減薄好的晶圓從 PG 處轉移到 RM 處,它是通過一個多孔陶瓷吸盤來完成。RM 部分主要是完成保護膜的去除和劃片膜的粘貼。由于保護膜的剝離需要在晶圓的正面動作,所以必須將晶圓進行反轉。由于晶圓厚度很薄,翻轉難度很大。東京精密公司把傳統剝膜工藝的后續工藝—— — 貼膜工藝前移,利用劃片膜粘貼到框架上所具有的平整性和張力來給晶圓提供支撐,從而解決這一問題。
2.5 晶圓鍵合設備
晶圓鍵合最初是為 MEMS 制造工藝而開發,主要作為晶圓級覆蓋技術。現在晶圓鍵合不僅用于覆蓋 MEMS 晶圓,而且也用于堆疊具有不同功能的晶圓,通過 TSV 實現晶圓的 3D 堆疊。
目前晶圓鍵合主要有直接氧化物鍵合、陽極鍵合、粘接鍵合、基于焊料的鍵合、金屬 - 金屬直接鍵合、超聲鍵合、玻璃介質鍵合等等。但是,因為CMOS 器件熱預算的緣故,與 TSV 互連的 CMOS晶圓兼容的鍵合工藝僅僅局限于直接氧化物鍵合、金屬鍵合(Cu-Cu 或 Cu-Sn-Cu)、粘接鍵合和這幾種方法的組合。其中 Cu-Cu 直接鍵合與其它鍵合方法對比有種種優點:電阻率較低、抗 EM 較好、互連 RC 延遲減少,可以同時實現機械和電學的接觸界面。
不過,可靠地 Cu-Cu 鍵合對于大多數應用僅從高溫、高壓和長工藝時間產生,主要是因為它有形成自然氧化物的傾向,對器件可靠性有不利影響。現在,工藝溫度高是 Cu-Cu 直接鍵合的主要瓶頸之一,因為它給器件可靠性及制造良率產生負面影響。另外,高溫下對晶圓之間的對準精度也產生了不利影響。
基于此,領先地晶圓鍵合設備供應商奧地利EVG 公司開發了光學對準、低溫 Cu-Cu 熱壓鍵合工藝,對準精度達到了亞微米。
3 結束語
據 Yole 預測,從 2014 年到 2020 年,TSV 的年增長率會達到48%,可以預見 TSV 市場孕育巨大商機,相關的設備及材料市場面臨爆發式增長機會。在此情況下,我們必須科學分析、冷靜面對TSV 技術發展帶來的歷史機遇,制定科學的發展規劃,加大 TSV 關鍵工藝設備的投入力度,抓住半導體先進封裝技術發展的新機遇。
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54007瀏覽量
465940 -
封裝
+關注
關注
128文章
9248瀏覽量
148612 -
TSV
+關注
關注
4文章
137瀏覽量
82626
發布評論請先 登錄
晶圓工藝制程清洗方法

芯矽科技:半導體濕法工藝設備引領者
燕東微北電集成12英寸生產線工藝設備順利搬入
在電子制造的高精度領域中,芯片引腳的處理工藝
TSV技術的關鍵工藝和應用領域

TSV制造技術里的通孔刻蝕與絕緣層
基于TSV的減薄技術解析

TSV以及博世工藝介紹




 TSV 制程關鍵工藝設備技術及發展
TSV 制程關鍵工藝設備技術及發展









評論