在后摩爾時代,扇出型晶圓級封裝(FOWLP) 已成為實現異構集成、提升I/O密度和縮小封裝尺寸的關鍵....

半導體產業正面臨傳統芯片縮放方法遭遇基本限制的關鍵時刻。隨著人工智能和高性能計算應用對計算能力的需求....

先進材料與三維集成技術的結合為邊緣計算應用帶來了新的可能性。本文探討研究人員如何通過單片3D集成方式....

在封裝基板發展的早期階段,廣泛采用一種稱為減成法的印制電路板制造技術,亦稱蝕刻銅箔技術。該技術的基本....
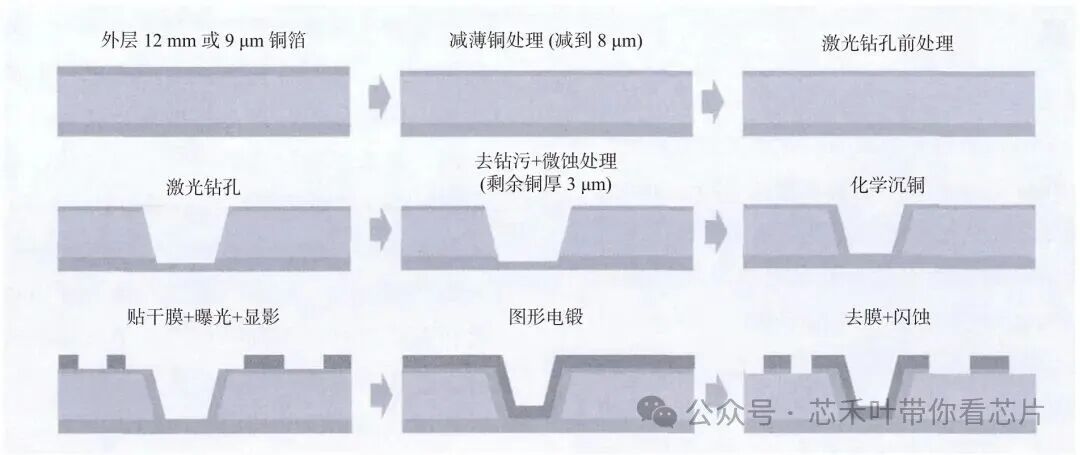
集成電路濕法工藝是指在集成電路制造過程中,通過化學藥液對硅片表面進行處理的一類關鍵技術,主要包括濕法....

硅基光電子技術的發展催生了可編程光電子集成芯片的誕生,這類芯片可以通過軟件重新配置來實現多種應用功能....
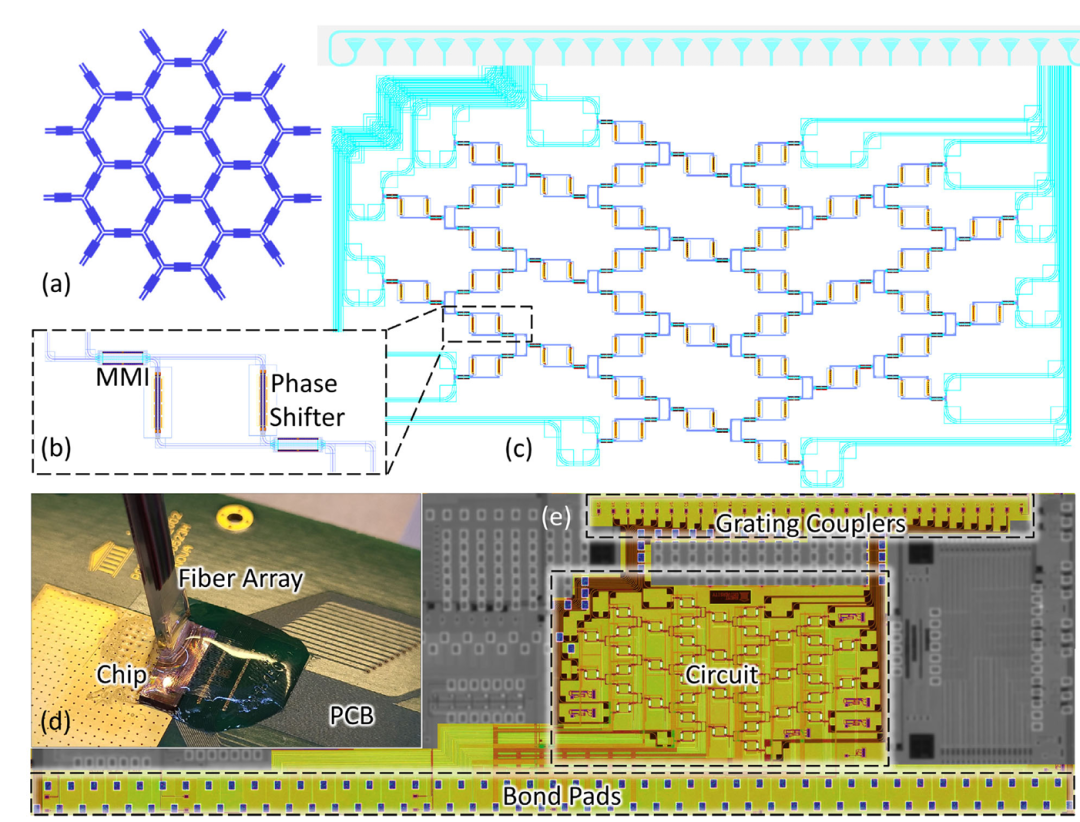
氮化鎵(GaN)作為一種第三代寬禁帶半導體材料,憑借其高電子遷移率和高擊穿電場等優異特性,已在5G通....

掃描電鏡(SEM)的分辨率是指其能夠分辨樣品表面兩點之間的最小距離,是衡量其成像能力的關鍵指標。

在半導體材料與器件的表征中,薄層電阻是一個至關重要的參數,直接關系到導電薄膜、摻雜層以及外延層的電學....
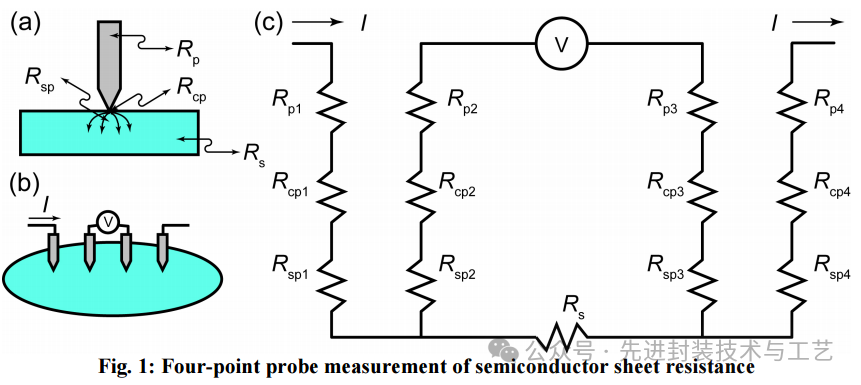
人工智能、云計算和高性能計算的快速發展對現代數據中心的數據傳輸帶寬和能源效率提出了更高的要求。傳統的....
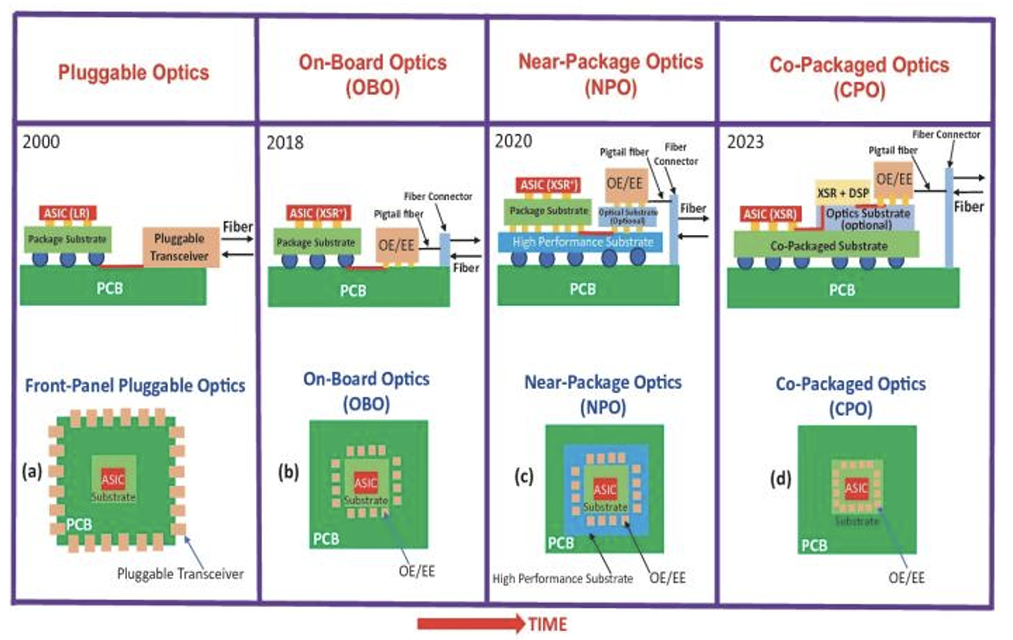
扇出型晶圓級封裝(FOWLP)的概念最早由德國英飛凌提出,自2016 年以來,業界一直致力于FOWL....

為了實現更緊湊和集成的封裝,封裝工藝中正在積極開發先進的芯片設計、材料和制造技術。隨著具有不同材料特....

到目前為止,我們已經了解了如何將芯片翻轉焊接到具有 FR4 核心和有機介電薄膜的封裝基板上,也看過基....
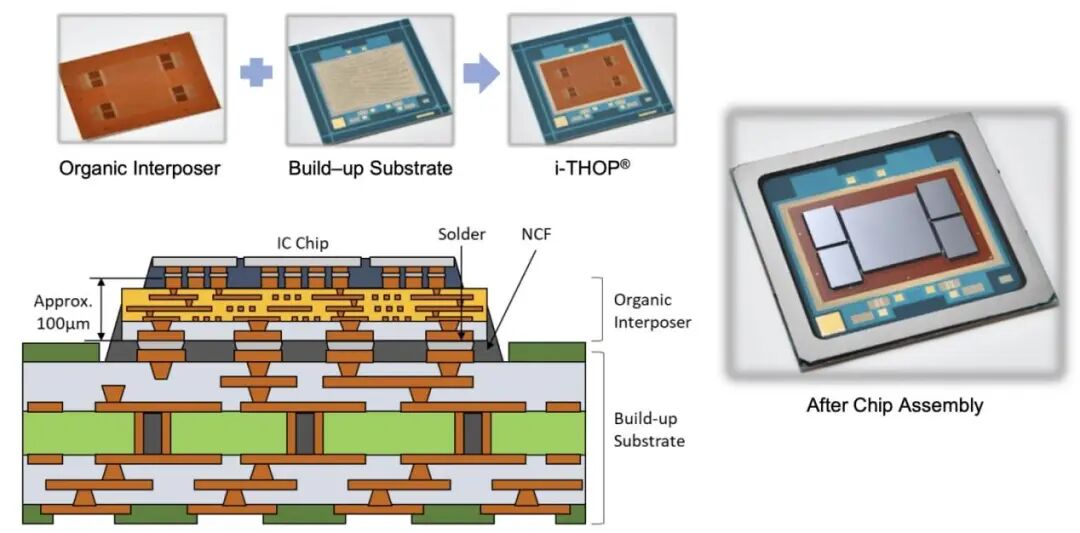
這是一份涉及芯片封裝幾乎所有關鍵概念的終極指南,它可以幫助您全面了解芯片的封裝方式以及未來互連技術的....

熱阻(Thermal Resistance)表示熱量在傳遞過程中所受到的阻力,為傳熱路徑上的溫差與熱....
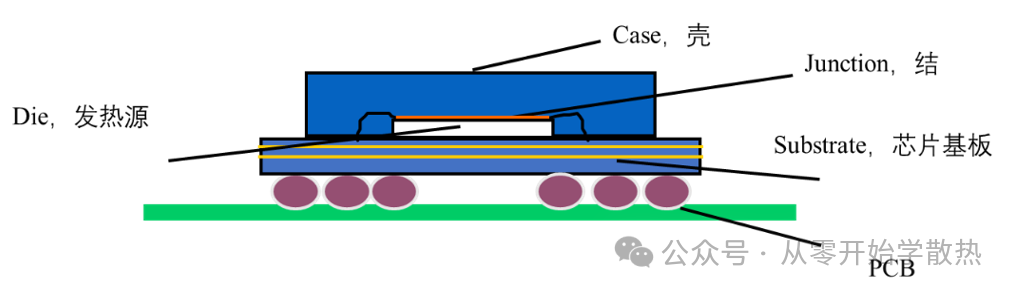
人工智能和機器學習應用的爆炸式增長已經將高性能計算系統推向極限。在訓練日益復雜的AI模型時,計算需求....
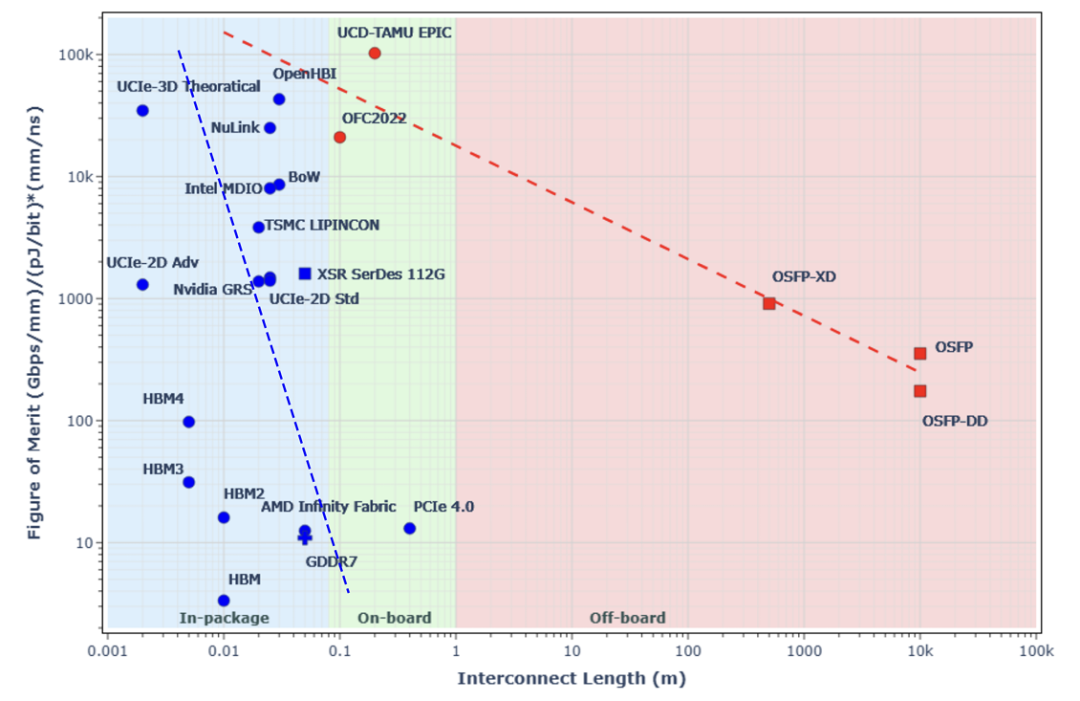
隨著高性能計算(HPC)、人工智能(AI)和大數據分析的快速發展,諸如CoWoS(芯片-晶圓-基板)....

臺積電在先進封裝技術,特別是CoWoS(Chip on Wafer on Substrate)平臺上....

半導體產業正處在傳統封裝邊界逐步消解的轉型節點,新的集成范式正在涌現。理解從分立元件到復雜異構集成的....

玻璃基板正在改變半導體封裝產業,通過提供優異的電氣和機械性能來滿足人工智能和高性能計算應用不斷增長的....

半導體行業持續推進性能和集成度的邊界,Chiplet技術作為克服傳統單片設計局限性的解決方案正在興起....
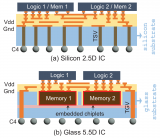
半導體行業正面臨傳統封裝方法的性能極限,特別是在滿足AI計算需求的爆炸性增長方面。CoWoP(芯片晶....
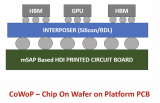
在先進封裝中, Hybrid bonding( 混合鍵合)不僅可以增加I/O密度,提高信號完整性,還....

半導體行業正在經歷向更緊湊、更高效封裝解決方案的轉型。隨著移動設備和物聯網(IoT)應用對更小、更薄....

毫米波(mmWave)嚴格意義上是指波長在1到10毫米之間、頻率范圍是30GHz-300GHz的電磁....
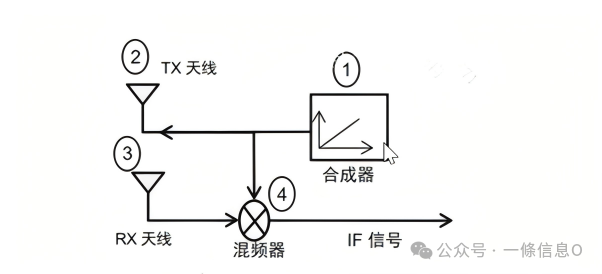
數據中心網絡架構正在經歷向光電共封裝(CPO)交換機的根本性轉變,這種轉變主要由其顯著的功耗效率優勢....
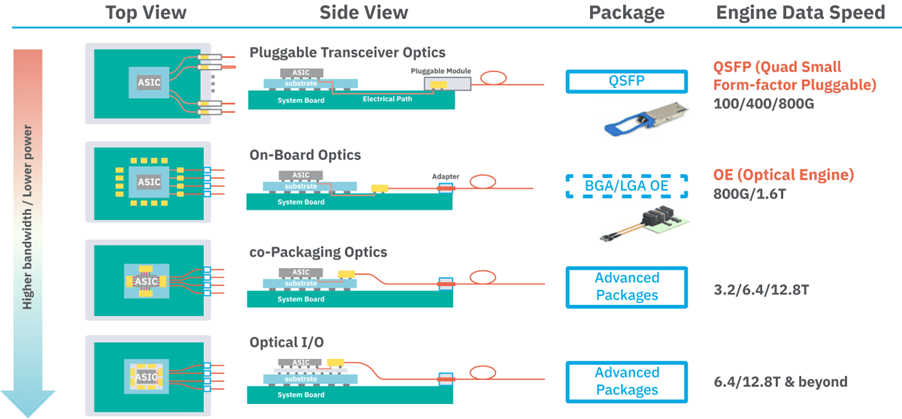
傳統封裝方法已無法滿足人工智能、高性能計算和下一代通信技術的需求。晶體管尺寸已縮小至個位數納米量級,....
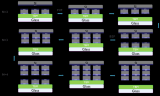
光電共封裝(Co-Packaged Optics,CPO)代表了光互連技術的新發展方向,這種技術將光....

FOPLP 技術目前仍面臨諸多挑戰,包括:芯片偏移、面板翹曲、RDL工藝能力、配套設備和材料、市場應....

在異構集成組件中,互連結構通常是薄弱處,在經過溫度循環、振動等載荷后,互連結構因熱、機械疲勞而斷裂是....
