以下文章來源于芯禾葉帶你看芯片,作者花茶
一、封裝基板制造方法
1.減成法制造技術
在封裝基板發展的早期階段,廣泛采用一種稱為減成法的印制電路板制造技術,亦稱蝕刻銅箔技術。該技術的基本原理是在覆銅板上印刷出所需的電路圖案,通過抗蝕膜保護圖案區域,隨后利用化學蝕刻去除未被保護的銅層,最終形成印刷線路板。
減成法制造技術具有多方面的優勢:①高精度,能夠實現精細加工,適用于對尺寸精度要求較高的零部件與產品;②多材料適用性,可加工金屬、塑料、陶瓷等多種材料,適應不同材料的制造需求;③工藝靈活性,制造過程可根據設計及產品要求進行定制化調整;④良好表面質量,加工后可獲得較高的表面光潔度,有助于提升產品的外觀與性能;⑤工藝成熟可靠。
然而,減成法在制作過程中常出現側蝕現象,即在垂直蝕刻方向發生橫向侵蝕,導致線路截面呈梯形結構,頂部寬度小于底部。這種形貌易引發線路開路或短路,同時也會使線路電阻值偏離設計范圍,影響電路性能與可靠性。
2.半加成法與改良型半加成法
在近年來,對于線路制作工藝,往往不再用原來的減成法技術,而是用日益興起的半加成法技術。減成法技術流程會受到諸多因素的影響,也就是其不可控因素較半加成法技術更多。目前,半加成法技術的主要工藝是電沉積銅工藝,該工藝也是實現互聯結構的主流工藝,其最大的優點就是利用銅具備適合該工藝的性能特點,在工藝實施過程中能夠避免蝕刻銅流程對互連結構側面會造成侵蝕,以及此方法成本相對較低。電沉積銅技術在封裝基板制作過程中起到了至關重要的作用,能夠提供更好的互連結構精細度和完整性,同時也是一種更準確、環保的選擇。
改良型半加成法(modified semi-additive process,MSAP)進一步改進了半加成法的技術。它使用了薄銅箔作為基材(≤8 μm),在其上使用正片進行圖形轉移,并通過圖形電鍍來加厚形成線路。去除干膜和底銅,完成高精度的布線,再進行脫膜,將底銅進行蝕刻(即閃蝕)。基材銅箔非常薄,在制作精細線路過程中可以發現,在進行差分蝕刻時,沒有進行電鍍加厚工藝的區域,銅會比較容易消失,只留下需要的部分形成線路。如果控制好電鍍的時間和其他參數,就可以得到需要的線路厚度。隨著工藝的不斷改進,使用更多的是MSAP。相較于半加成法工藝,其工藝稍微復雜一些,但是比較容易實現。而以前的半加成法雖然工藝簡單,但工藝操作技術較復雜,特別是在化學沉銅工藝上難以實現。借助MSAP技術的發展,封裝基板制造能夠更加精確和可靠。隨著技術的不斷進步和深入研究,可以期待封裝基板制造技術在未來的持續發展,以滿足不斷變化的市場需求。
二、制備基板關鍵工藝技術
目前市面上的主流工藝是MSAP,其流程如圖所示。
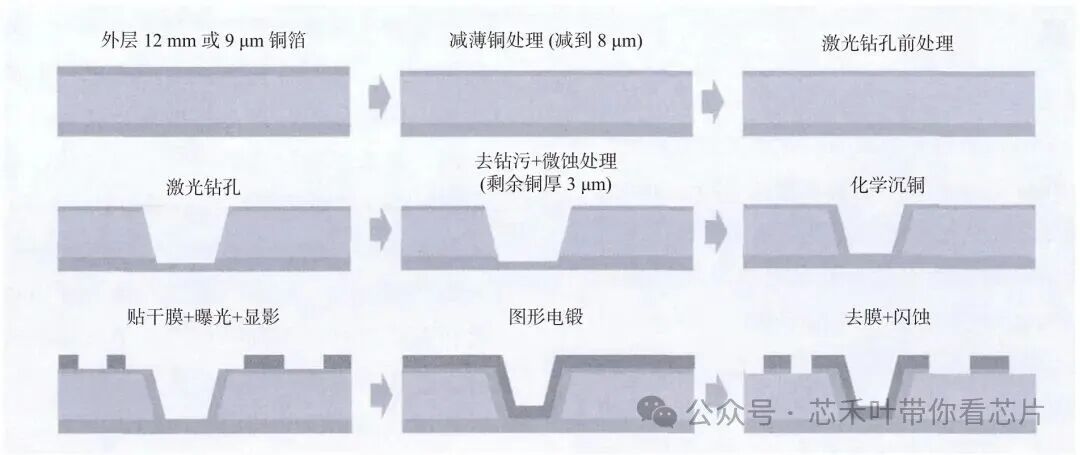 改良型半加成工藝流程
改良型半加成工藝流程
1) 基銅。在改良型半加成法工藝中對基銅的厚度有著嚴格要求,為了薄化銅厚度,常使用覆銅箔層壓板的方式來減厚。覆銅箔層壓板的銅箔厚度有規定范圍,一般來說規定其厚度不超過12 μm,因此選擇合適的銅箔厚度至關重要。銅箔的厚度需要嚴格把控,超過一定的厚度要求就容易導致表面銅層的不均勻。如果太薄,則會增加工藝難度,太薄的銅箔在層壓時會容易出現表面不平坦,并且薄銅箔由于成本太高,不適合大量使用。將減銅量控制在9 μm以下時,可以在±2 μm的范圍內控制表面銅層的厚度均勻性。標準銅箔不能作為基銅,因為其粗糙度很大,在進行閃蝕時不容易去除不需要的銅,因此不會選擇標準銅箔進行制作精細線路。現在大多采用低輪廓銅箔或者超低輪廓銅箔,這有助于保證線路制作的精細度和質量。
2) 貼膜前處理。涂膜前的預處理質量和干膜性能的選擇將影響干膜與銅的附著力。常見的前處理方法包括3種:化學處理法、噴砂研磨法和機械研磨法。后2種方法屬于物理處理方法,經過物理方法處理后會發現處理之后銅表面的粗糙程度不符合要求,因此如果要獲得微粗糙度,通常采用最后1種方法,或者將噴砂研磨與最后1種方法相結合。這樣更容易得到滿足要求的表面粗糙度。
3) 圖形電鍍。圖形電鍍是指將干膜覆蓋在經過孔處理的銅箔板上,使用陽紋底片進行曝光和顯影,形成陰紋線路圖案,并通過電鍍方式給線路覆蓋一層耐蝕金屬的工藝。其中,感光干膜的作用是作為電鍍保護層。其工藝中最關鍵的是控制銅層厚度和均勻性,如果銅層過厚或不均勻,在閃蝕后可能會殘留銅層引發短路問題;如果銅層過薄或不均勻,在閃蝕過程中部分線路可能會被完全蝕刻掉,或者殘留的銅層厚度不足,導致線路截面形狀變形。一些研究學者采用實驗設計、數值模擬和電化學實驗等方法,研究會對細線路電鍍銅的均勻性產生影響的因素、以及適用于半加成工藝或改進半加成工藝制程的新型電鍍銅添加劑。
4) 閃蝕。閃蝕技術是一項有效的工藝,其目的是去掉不需要的銅,并且能夠防止所需要的圖形區域的銅被去掉(尤其是圖形側壁)。蝕刻因子是判斷蝕刻強弱的重要參考量之一,反映了蝕刻的效果和能力。側向侵蝕量是在半加成法工藝中衡量線形質量的另一個重要指標。使用蝕刻藥水去除銅的時候,由于藥水具有流動性,其流動方向不好把控,很容易會發生側向侵蝕的情況。如果側向侵蝕過于嚴重,就會造成線路與基材方式脫離,最終導致制作精細線路失敗。通過不斷的實踐操作,發現主要因素包括閃蝕的程度和藥水特性。若閃蝕程度沒有把控好,就很容易導致發生側向侵蝕現象。所以,在實際操作工藝中,要經過日積月累的工藝操作經驗,來精準地把握好閃蝕的程度以及藥水的特性,來保證這一步驟的工藝具有更高的質量。為了確保產品質量的穩定性,傳統閃蝕設備可能難以滿足未來對品質的要求。引入真空和二流體相結合的閃蝕設備將成為未來的趨勢,合理調配二流體段的液壓和氣壓比例可以獲得更好的線路效果。而與單獨使用真空段或二流體段相比,將真空段與二流體段結合使用能夠在制作線路時取得更優異的效果。
5) 化學沉銅。有研究學者提出了全新的化學沉銅速率控制配方,在探究化學銅沉積速率偏快的狀況下基底對于拉力值的表現時,得出化學沉銅速率對于粗糙度0.45 μm的基材沒有產生拉力方面的變化。其他研究使用表面改性在同一基底上產生增強的化學鍵來提高抗拉強度,但最終結果表明,產品的抗拉強度比較相似。雖然目前的半加成法技術滿足了精細線路的需求,但不能忽視產品可靠性和功能等因素。國內半加成法工藝仍有很長的路要走,需要不斷改進工藝和探索新的材料與制造方法,以提高產品的可靠性和功能,并確保其在長期使用中能夠表現出色。
三、結語
隨著先進封裝技術的演進,與之適配的高端封裝基板市場份額不斷擴大,其制備工藝也日益受到產業與學界的重點關注。其中,基板精細化線路蝕刻工藝的精度控制水平持續提升。理解干膜在分辨率、附著力、顯影性與耐顯影性,以及耐蝕刻性與耐電鍍性等方面的性能表現,有助于更清晰地認識其在制作精細線路工藝過程中的功能與作用。然而,必須指出的是,對線路精細化的追求不能以犧牲電子產品的實際可靠性為代價。因此,研究者需持續探索新材料與制造工藝,以提升線路的可靠性及功能性。這可能涉及電路布局設計的優化、材料耐久性與導電性能的改進,以及制造過程中各環節的精確控制,確保每一工藝步驟均能可靠、精準地完成。同時,也應充分考慮產品的實際應用環境,積極開展環境適應性測試,以保障產品在不同條件下的性能穩定性。這仍有待研究人員的進一步深入探索。
-
封裝
+關注
關注
128文章
9248瀏覽量
148610 -
基板
+關注
關注
2文章
321瀏覽量
24053 -
工藝流程
+關注
關注
7文章
118瀏覽量
16855
原文標題:封裝基板的制備工藝
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
玻璃基板時代,TGV技術引領基板封裝
【轉帖】一文讀懂BGA封裝技術的特點和工藝
四種功率型封裝基板對比分析
《炬豐科技-半導體工藝》用于半導體封裝基板的化學鍍 Ni-P/Pd/Au
淺談電子封裝用陶瓷基板材料及其制備工藝
一文詳解封裝互連技術
一文了解DPC陶瓷基板工藝流程
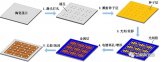



 一文詳解封裝基板的制備工藝
一文詳解封裝基板的制備工藝





評論