以下文章來源于芯禾葉帶你看芯片,作者花茶
一、概述
扇出型晶圓級封裝(FOWLP)的概念最早由德國英飛凌提出,自2016 年以來,業界一直致力于FOWLP 技術的發展。這種封裝架構具有較大的靈活性,適用于多樣的應用場景,能夠在晶圓級別上集成多種功能芯片,包括邏輯、存儲器、功率IC、射頻和無源元件等,從而實現多功能、高性能和低功耗的目標。扇出型封裝是指芯片焊盤通過扇出方式從芯片的邊緣通過RDL 和焊球與PCB 連接,圖 為扇出型晶圓級封裝結構以及扇出區域演示圖。RDL 工藝有效地增加了芯片可用的布線區域,并降低了成本。目前,扇出型封裝基本分為3 類:先上晶芯片面朝上(Chip First-Face Up),先上晶芯片面朝下(Chip First-Face Down),后上晶(Chip Last)或稱先RDL(RDL First)。與Chip First 工藝相比,Chip Last(RDL First)工藝具有更高的復雜度和制作成本。

扇出型晶圓級封裝結構以及扇出區域演示圖
扇出型晶圓級封裝不僅已在移動設備領域廣泛應用(如用于封裝處理器、存儲器及射頻芯片),其應用范圍也正逐步拓展至汽車電子(如處理器、傳感器與控制單元封裝)、人工智能(如學習芯片、神經網絡處理器封裝)以及物聯網等多元化領域。其靈活的封裝架構與多功能特性,使得該技術能夠滿足不同應用場景下的多樣化需求。目前,市場上已有多款代表性產品采用了扇出型晶圓級封裝技術,例如蘋果A10芯片、賽靈思ACAP自適應計算平臺以及英特爾Lakefield芯片等。
二、封裝技術
1.臺積電InFO 技術
InFO 技術是臺積電在2016年推出的一項扇出型封裝技術。該技術的核心是將芯片直接放置于基板上,通過再分布層(RDL)實現芯片與基板之間的電氣互連,無需采用傳統的引線鍵合方式。RDL形成于晶圓表面,可對鍵合焊盤進行重新布局,提供更大的焊盤間距,從而支持更多的I/O連接,實現更緊湊和高效的系統設計。該技術最早應用于2016年發布的蘋果A10芯片,并已發展出多個衍生技術方向,包括InFO-oS、InFO-LSI、InFO-PoP以及InFO-AiP等。圖展示了InFO技術及其主要衍生應用的封裝結構示意圖。
InFO-oS技術能夠集成多個先進邏輯芯片,在封裝內部實現更高的集成密度,尤其適用于5G網絡設備等場景。InFO-LSI技術在功能上與英特爾的嵌入式多芯片互連橋接技術類似,致力于在互連帶寬與成本之間實現最優平衡。該技術采用硅基互連方式,實現不同芯片層之間的高密度連接,支持同一封裝內部的高速信號傳輸,從而提升系統整體性能與能效。InFO-LSI技術主要面向高性能計算、人工智能、通信與網絡設備等對高速信號傳輸與處理有嚴格要求的領域,具有重要的應用價值。
InFO-PoP技術是InFO與堆疊封裝(PoP)技術的結合,適用于需集成多顆芯片的應用場景(如移動設備),有助于實現更高的集成度與功能復雜度。InFO-AiP技術則是在InFO封裝中直接集成天線,可實現更緊湊的器件布局與更優的信號傳輸性能。該技術常見于移動終端、物聯網設備及通信設備等領域,能夠顯著提升無線連接性能。
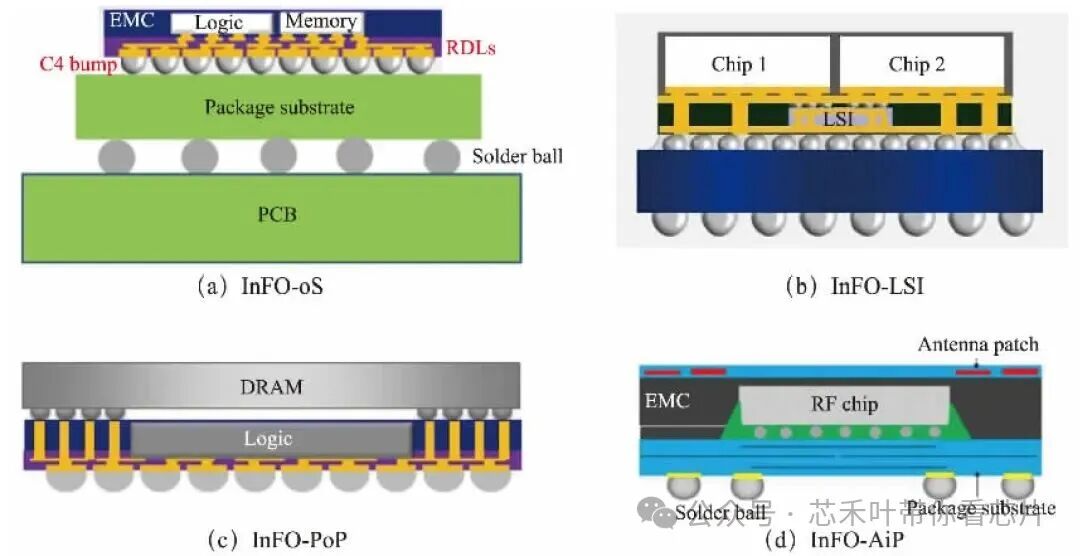
InFO 技術及其衍生應用的封裝結構示意圖
2. FOWLP 在MEMS 傳感器封裝中的應用
FOWLP 技術可用于實現多傳感器堆疊。壓力傳感器和專用集成電路(ASIC)堆疊封裝結構如圖 所示,該封裝結構被組裝在一個加速度傳感器和ASIC封裝的背面,并通過模具通孔實現3D 布線。壓力傳感器的封裝采用了Chip First 方法和基于薄膜的RDL的FOWLP 技術;加速度傳感器和ASIC 的封裝采用了基于雙面樹脂涂層銅重新分配的FOWLP 技術。該技術的優點是可以直接實施激光鉆孔,以實現從封裝底部到頂部的3D 布線。
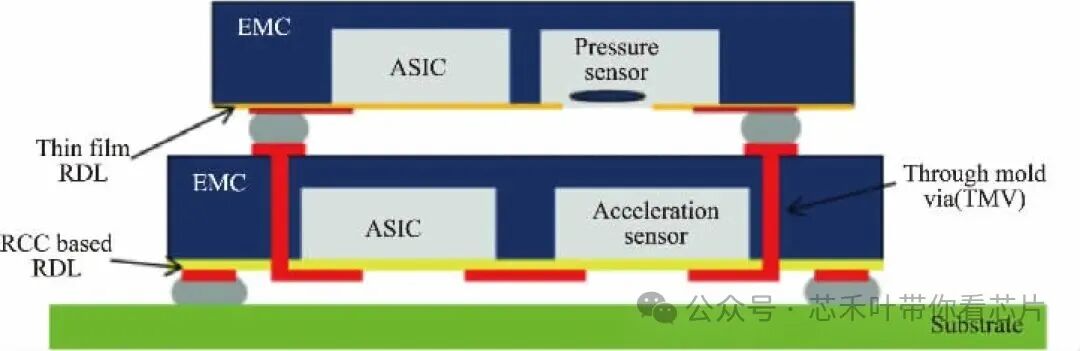
壓力傳感器和ASIC 堆疊封裝結構
在人工智能和5G 通信等產品的推動下,FOWLP技術在移動通信、高性能計算、自動駕駛汽車和物聯網等領域展現出廣泛的應用前景。Chip First 封裝形式適用于便攜式、移動和可穿戴產品,以及射頻/模擬、PMIC、AP、低端ASIC、CPU 和GPU 等IC 的封裝。預計未來5 年內,Chip First 將成為最常用且廣泛應用的封裝方式。而針對高端CPU、GPU、ASIC 以及超級計算機、服務器、網絡和電信產品的FPGA 等IC 器件,Chip Last(RDL First)的封裝形式可能更為適用。
-
芯片
+關注
關注
463文章
54083瀏覽量
467117 -
晶圓級封裝
+關注
關注
5文章
46瀏覽量
11809 -
FOWLP
+關注
關注
1文章
18瀏覽量
10195
原文標題:扇出型晶圓級封裝
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 扇出型晶圓級封裝技術的概念和應用
扇出型晶圓級封裝技術的概念和應用











評論