以下文章來源于逍遙設計自動化,作者逍遙科技
引言
半導體行業正在經歷向更緊湊、更高效封裝解決方案的轉型。隨著移動設備和物聯網(IoT)應用對更小、更薄且具有增強電氣可靠性的封裝提出需求,研究人員將注意力轉向3D封裝技術。雖然硅基板傳統上主導著半導體制造,但玻璃基板正在成為先進電子組件的引人注目的替代方案,特別是在移動設備和物聯網應用中。

圖1:采用玻璃Interposer的2.5D半導體封裝 該圖展示了在2.5D半導體封裝中實施玻璃Interposer與玻璃通孔技術的集成,顯示了與HBM存儲器、TSV連接和IC芯片的整合。
玻璃通孔基板的市場潛力反映了這種日益增長的興趣,預測顯示從2022年的6000萬美元增長到2029年的4.805億美元,復合年增長率高達34.2%。這種戲劇性的擴張突顯了該技術在滿足現代半導體封裝不斷發展需求方面的重要性。
玻璃基板的優勢
玻璃材料提供了幾個獨特的優勢,使其特別適合于射頻通信和Interposer應用。玻璃的低介電常數和最小電氣損耗特性,結合其可變的熱膨脹系數,將其定位為精密TGV形成的理想材料。這些特性在保持信號完整性的同時實現芯片之間的可靠電氣連接。
TGV技術最重要的優勢之一在于與傳統引線鍵合方法相比,能夠提供更密集的互連。這種能力允許工程師在有限的空間約束內容納更多的電氣信號,這是現代高密度封裝應用的重要要求。此外,在玻璃基板中實施的TGV有效地抑制了與硅基通硅孔(TSV)相關的常見問題,包括串擾和插入損耗。
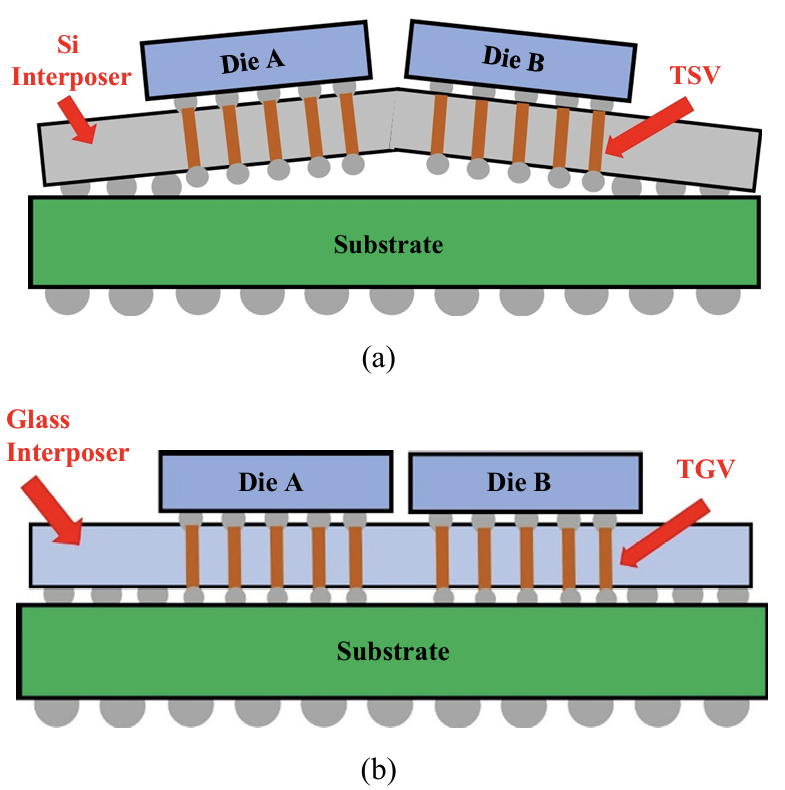
圖2:使用不同Interposer材料的2.5D封裝,(a) Si Interposer,(b) Glass Interposer 這種比較展示了玻璃Interposer如何與硅Interposer相比在2.5D封裝應用中最小化翹曲問題,突顯了玻璃材料的熱膨脹優勢。
玻璃優異的射頻透明性使高頻信號能夠以最小的電氣損耗通過TGV傳輸,在無線通信和雷達應用中產生優越的性能。此外,玻璃基板固有的剛性和絕緣特性,結合其成本效益和大約100微米厚的超薄柔性玻璃基板的可用性,在電子封裝應用中提供了顯著的優勢。
TGV形成技術
激光誘導選擇性蝕刻(LISE)
TGV的形成需要復雜的制造技術,激光誘導選擇性蝕刻代表了最有發展潛力的方法之一。LISE技術利用激光局部蝕刻被照射區域,通過在飛秒到皮秒的極短持續時間內傳遞集中的高能激光脈沖來創建精確的圖案。
在LISE過程中,激光在最短時間內向玻璃表面局部傳遞強烈能量,引起熱機械效應,改變玻璃的表面膨脹和密度。這些變化創建了對化學蝕刻敏感的區域。隨后用氫氧化鉀等溶液進行化學蝕刻,形成稱為納米隕石坑的納米衍射光柵結構,改變玻璃表面特征。
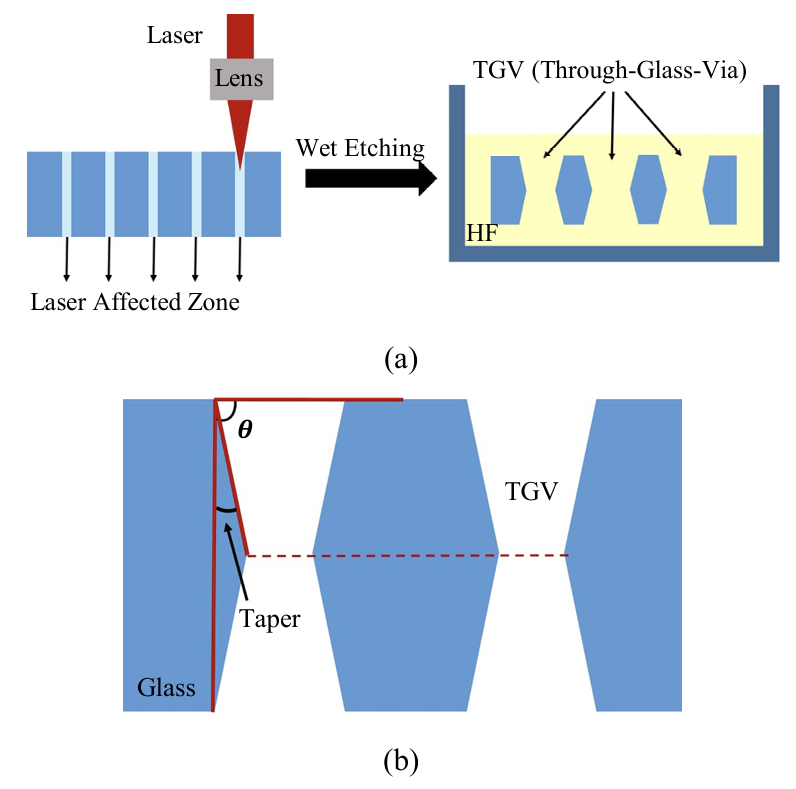
圖3:(a) LISE工藝示意圖,(b) 硼硅酸鹽玻璃上TGV結構橫截面視圖 該圖說明了LISE工藝流程,顯示激光應用、濕蝕刻步驟以及產生的錐形TGV結構的詳細橫截面幾何形狀。
LISE技術的精度允許制造商通過調整激光脈沖能量和化學蝕刻條件來控制納米隕石坑尺寸,最終實現所需的通孔形狀。研究表明,納米衍射光柵結構的創建和連接作為飛秒激光選擇性蝕刻過程中圖案形成的主要機制。
電火花加工(EDM)
電火花加工代表了TGV形成的另一種可行方法,利用高電壓和電流在玻璃基板上創造精確結構。該技術通過兩步過程將玻璃保持在兩個對準的電極之間。首先,電火花集中并產生熱量,局部降低玻璃粘度。隨后,玻璃通過焦耳加熱進行提取,創建所需的孔。
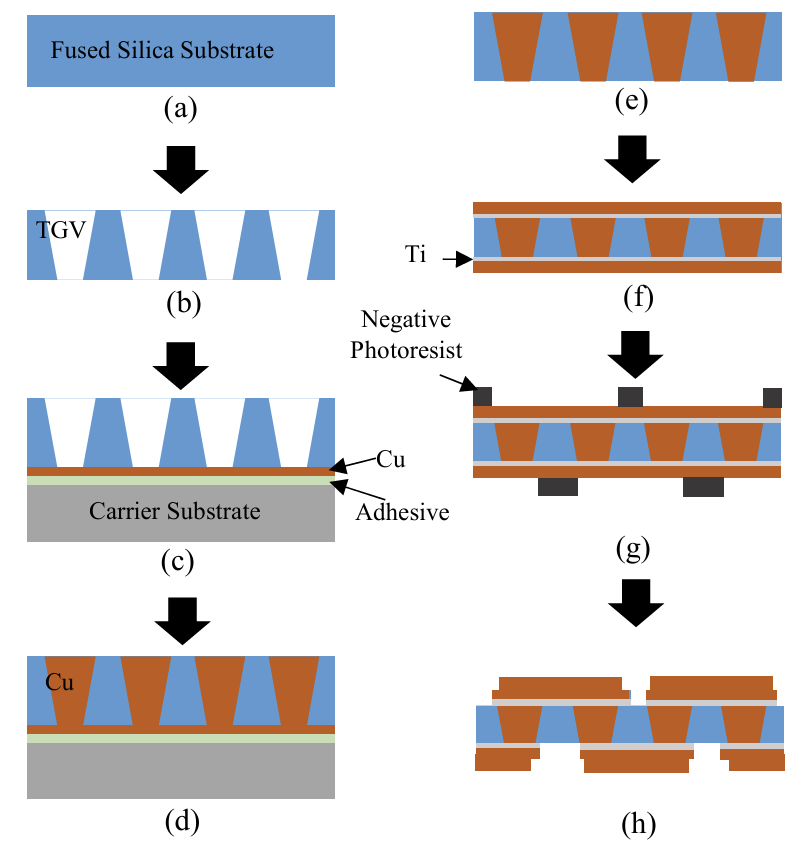
圖4:熔融石英基板上3D電感器制造的示意圖 這個綜合工藝流程顯示了使用TGV技術制造3D電感器的完整制造序列,從初始基板準備到最終銅電鍍和圖案化步驟。
EDM工藝能夠在相對較短的時間內形成高長寬比孔,與傳統TGV形成方法相比。雖然EDM僅利用電火花,但諸如電化學放電加工(ECDM)之類的變體通過結合電解質將電火花與化學反應相結合,提供增強的工藝控制和精度。
功能薄膜形成和銅填充
TGV的成功實施需要仔細關注功能薄膜形成和銅填充工藝。功能薄膜在TGV制造中發揮多種重要作用,包括用于銅和金等填充金屬平滑電鍍的種子層、用于電氣隔離和防止電流泄漏的絕緣層,以及用于加強不同材料層之間結合的粘附層。
傳統的干法方法如濺射已被普遍用于玻璃基板上的薄膜形成,但在高長寬比TGV中實現均勻膜厚度面臨重大挑戰。濕法方法涉及將玻璃基板浸入溶液中進行薄膜形成,在TGV和玻璃表面上提供優越的均勻性和一致性。
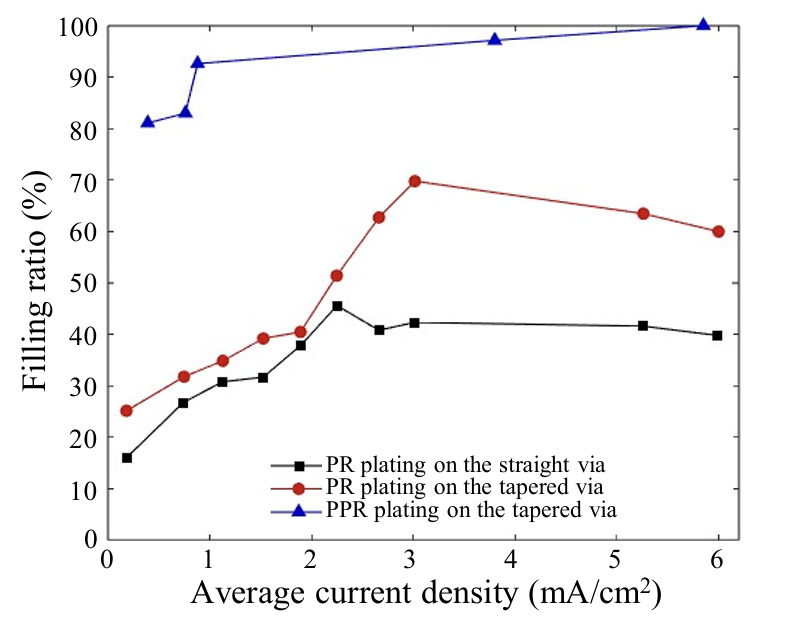
圖5:根據PR和PPR電流密度的直孔和錐形孔的Cu填充比 該圖表展示了不同孔幾何形狀和電流波形的電流密度與銅填充效率之間的關系,顯示了PPR(周期脈沖反向)方法相對于PR(脈沖反向)技術的優越性能。
TGV和TSV的銅填充主要采用電鍍方法,其中金屬離子通過施加的電流移動到陰極。銅電鍍工藝涉及電流通過含有銅離子的電鍍溶液,離子遷移到陰極,接受電子并還原為銅,然后沉積在TSV和TGV表面。

圖6:使用PPR電流的Cu填充工藝示意圖,(a) 高電流密度,(b) 低電流密度 該圖說明了PPR電鍍中不同電流密度如何影響銅填充模式,展示了在適當電流水平下形成無空洞超保形填充。
電鍍參數的優化,包括電流密度和波形選擇,在實現無缺陷銅填充方面發揮重要作用。周期脈沖反向波形在防止空洞形成和實現高長寬比結構的超保形填充方面表現出特別的有效性。
應用前景和發展方向
高密度、高性能半導體封裝領域通過采用TGV技術來集成2.5D和3D硅芯片和Interposer繼續發展。雖然TSV技術提供了包括增加互連密度和縮短信號路徑在內的優勢,但正在進行的努力解決諸如電氣損耗、基板翹曲和制造成本等挑戰。
基于玻璃的TGV通過優越的絕緣性能、成本效益和高頻域適用性,提供了解決許多TSV技術限制的有吸引力的替代方案。玻璃材料中的可變熱膨脹系數值有效緩解了堆疊器件中的翹曲,使其對先進的2.5D和3D封裝應用特別有價值。
隨著半導體封裝要求繼續向更高性能、改進的可靠性和增強的成本效益發展,TGV技術代表了一個重要的進步。玻璃基板、TGV鉆孔技術、功能層涂層工藝和銅填充技術的持續改進將該技術定位為下一代半導體封裝解決方案的基石。
技術成熟度和市場需求的結合表明,TGV技術將在滿足現代電子系統(從移動設備到高性能計算應用)的挑戰性要求方面發揮越來越重要的作用。該技術的發展將繼續推動半導體封裝行業向更高集成度和更優性能的方向發展。
-
半導體
+關注
關注
339文章
30725瀏覽量
264012 -
封裝
+關注
關注
128文章
9248瀏覽量
148610 -
玻璃基板
+關注
關注
1文章
104瀏覽量
11069 -
通孔
+關注
關注
2文章
60瀏覽量
11918
原文標題:用于高性能半導體封裝的玻璃通孔技術
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
玻璃中介層:顛覆傳統封裝,解鎖高性能芯片 “新密碼”
深愛半導體 代理 SIC213XBER / SIC214XBER 高性能單相IPM模塊
意法半導體推出封裝小、性能強的低壓差穩壓器創新產品
安森美半導體應用于物聯網的成像技術和方案
高性能功率半導體封裝在汽車通孔的應用
JNTC 向3家半導體封裝公司提供首批玻璃基板樣品
高性能半導體封裝TGV技術的最新進展
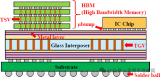
日本電氣玻璃與VIA Mechanics簽署面向下一代半導體封裝的無機芯板開發協議
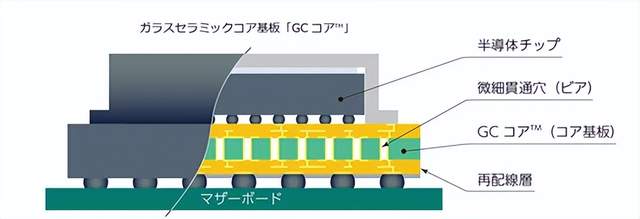



 用于高性能半導體封裝的玻璃通孔技術
用于高性能半導體封裝的玻璃通孔技術

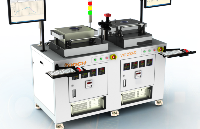


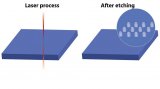




評論