nm 時,摩爾定律的進一步發展遭遇瓶頸。傳統 2D 封裝因互連長度較長,在速度、能耗和體積上難以滿足市場需求。在此情況下,基于轉接板技術的 2.5D 封裝,以及基于引線互連和 TSV 互連的 3D 封裝等應運而生,并迅速發展起來。
2025-08-12 10:58:09 2201
2201 
半導體設備、封測廠今年將擴大高階覆晶封裝(Flip Chip)研發支出。隨著半導體開始邁入3D IC架構,晶片封裝技術也面臨重大挑戰,因此一線半導體設備廠、封測業者皆積極布局高階覆晶封裝
2013-03-13 09:13:10 1589
1589 目前在全球半導體產業領域,有業界人士認為2.5D先進封裝技術的芯片產品成本,未來可望隨著相關產品量產而愈來愈低,但這樣的假設可能忽略技術本身及制造商營運管理面的諸多問題與困境,可能并非如此容易預測新興封裝技術產品的未來價格走勢。
2016-03-24 08:23:56 4152
4152 半導體協會理事長盧超群指出,未來半導體將要做3D垂直堆疊,全球半導體產業未來會朝向類摩爾定律成長。
2016-06-10 00:14:00 2696
2696 為了應對半導體芯片高密度、高性能與小體積、小尺寸之間日益嚴峻的挑戰,3D 芯片封裝技術應運而生。從工藝和裝備兩個角度詮釋了 3D 封裝技術;介紹了國內外 3D 封裝技術的研究現狀和國內市場對 3D
2022-11-11 09:43:08 3232
3232 主要的技術路徑。2.5D/3D封裝正在加速3D互連密度的技術突破,TSV及TGV的技術作為2.5D/3D封裝的核心技術,越來越受到重視。
2023-05-23 12:29:11 5750
5750 
隨著半導體技術的不斷發展,芯片封裝技術也在持續進步。目前,2D封裝和3D封裝是兩種主流的封裝技術。這兩種封裝技術在散熱路徑和熱設計方面有著各自的特點和挑戰。本文將深入探討2D封裝和3D封裝的散熱路徑及熱設計考慮。
2024-07-25 09:46:28 2651
2651 
2.5D封裝工藝是一種先進的半導體封裝技術,它通過中介層(Interposer)將多個功能芯片在垂直方向上連接起來,從而減小封裝尺寸面積,減少芯片縱向間互連的距離,并提高芯片的電氣性能指標。這種工藝
2025-02-08 11:40:35 6652
6652 
隨著摩爾定律接近物理極限,半導體產業正在向2.5D和3D集成電路等新型技術方向發展。在2.5D集成技術中,多個Chiplet通過微凸點、硅通孔和重布線層放置在中介層上。這種架構在異構集成方面具有優勢,但同時在Chiplet布局優化和溫度管理方面帶來了挑戰[1]。
2025-02-12 16:00:06 2206
2206 
電子發燒友網報道(文/吳子鵬)先進封裝包括倒裝焊、2.5D封裝、3D封裝、晶圓級封裝、Chiplet等,過去幾年我國先進封裝產業發展迅猛。根據中國半導體協會的統計數據,2023年我國先進封裝市場規模
2024-07-16 01:20:00 4618
4618 
求大神賜個全面的3D PCB封裝庫(PCB封裝附帶3D模型)!!!~
2015-08-06 19:08:43
求PLCC封裝3D模型,最好是完整的
2013-12-27 16:53:29
good,3d封裝,感謝樓主無償奉獻!!
2015-06-22 10:35:56
,3D封裝將產生巨大的影響。日前,AMD在其2020年財務分析師日發布了其新型的封裝技術——X3D封裝,據悉,該技術是將3D封裝和2.5D封裝相結合。AMD稱其X3D芯片封裝技術將把其MCM帶入三維
2020-03-19 14:04:57
`AD16的3D封裝庫問題以前采用封裝庫向導生成的3D元件庫,都有芯片管腳的,如下圖:可是現在什么設置都沒有改變,怎么生成的3D庫就沒有管腳了呢?請問是什么原因?需要怎么處理,才能和原來一樣?謝謝!沒管腳的就是下面的樣子:`
2019-09-26 21:28:33
給PCB添加了3D模型之后,讓封裝旋轉45度,自己填加的3D模型旋轉45度后,代表3D模型的機械層不會和PCB重合;而用封裝向導畫的模型會和PCB重合。請問這個改怎么解決?雖然旋轉45度之后,在3D 模式下,3D圖也是旋轉了45度,但是在2D模式下的機械層看著很不舒服。
2017-07-20 22:46:11
各位親,我在Altium Designer中遇到下面的問題!希望得到幫助!下載了STEP格式的3D封裝,建好3D庫看封裝是可以顯示出來的如下圖:然后在PCB庫里放置3D body后,2D視圖下有顯示紅色框,如下圖:但是切換為3D視圖下卻并沒有3D封裝出現!請問解決辦法!!非常感謝!
2016-11-20 20:35:21
想請教一下大神們,allegro如何制作3D封裝庫的
2018-05-09 08:33:17
封裝封裝封裝封裝封裝封裝封裝封裝多數是3D的
2015-11-07 19:45:25
親, 我第1次用ALLEGRO是版本是14.2,隨著軟件的升級,他也有3D的封裝庫。誰有,可以提供嗎?
2015-09-10 10:38:26
`求解如圖,我在AD16導入step文件后,在封裝庫能看到3D元件,但是更新到PCB后卻看不到3D模型`
2019-05-10 15:42:46
哪位大神有ad的3d封裝庫啊?求發:164409980@qq.com
2014-12-29 17:20:25
有什么好的網站可以下載3D封裝?
2019-09-18 00:18:00
如何在封裝庫中去創建3D器件模型?有哪些常見的元器件?
2021-07-22 09:28:58
AD 在3D顯示下,怎么去除3D封裝的顯示,我只看焊盤,有時候封裝會遮掩底部的焊盤
2019-09-23 00:42:42
帶有3D的封裝
2015-11-27 10:44:56
PHONEJACK電源切換的3D封裝
2019-07-23 05:35:38
我用ALTIUM10 畫PCB封裝 從網上下載的3D模型怎么導入的時候顯示不了,前幾天還可以顯示 現在一個都顯示不了, 是不是弄錯了, 手動畫3D 又能顯示方塊模型 導入的時候就一點效果都沒有像沒有導入3D模型一樣, 求大師指點。
2016-07-12 22:48:20
AD做3D封裝的時候遇見這種情況怎么解決,2D平面封裝無法和3D封裝契合!!
2019-09-24 04:37:20
請問怎么將AD中的3D封裝庫轉換為2D的封裝庫
2019-06-05 00:35:07
隨著移動電話等電子器件的不斷飛速增長,這些器件中安裝在有限襯底面積上的半導體封裝也逐漸變小變薄。3D封裝對減少裝
2010-07-24 15:36:03 2498
2498 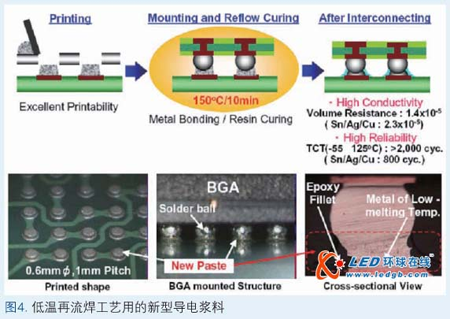
2011將于7日開展,3D IC依舊是此次展覽的焦點。推動2.5D和3D IC技術相當積極的日月光集團總經理暨研發長唐和明6日表示,半導體供應鏈近1年來有動起來的跡象
2011-09-07 10:10:33 661
661 3D元件封裝庫3D元件封裝庫3D元件封裝庫3D元件封裝庫
2016-03-21 17:16:57 0
0 Altium Designer 3D封裝
2017-02-28 23:09:41 147
147 簡單來說,普通屏幕就是屏幕是一塊純平面,沒有任何弧形設計;2.5D 屏幕則為中間是平面的,但邊緣是弧形設計;而 3D 屏幕,無論是中間還是邊緣都采用弧形設計。 3D 曲面玻璃的特色符合 3
2017-09-30 09:32:34 22
22 對于數據密集型應用,大量能量和延時消耗在計算和存儲單元之間的數據傳輸上,造成馮諾依曼瓶頸。在采用2.5D封裝集成的系統中,這一問題依然存在。為此,提出一種新型的硬件加速方案。引入存儲型計算到2.5D
2018-02-26 11:47:46 1
1 對于目前的高端市場,市場上最流行的2.5D和3D集成技術為3D堆疊存儲TSV,以及異構堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術已經廣泛用于高性能計算
2019-02-15 10:42:19 8043
8043 
依現行3D封裝技術,由于必須垂直疊合HPC芯片內的處理器及存儲器,因此就開發成本而言,比其他兩者封裝技術(FOWLP、2.5D封裝)高出許多,制程難度上也更復雜、成品良率較低。
2019-08-15 14:52:14 3391
3391 SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內系統集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強調封裝內包含了某種系統的功能封裝,3D封裝僅強調在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 7076
7076 半導體業界,幾家公司正在競相開發基于各種下一代互連技術的新型2.5D和3D封裝。
2020-06-16 14:25:05 8484
8484 至此,全球主要的三家半導體芯片制造廠商均擁有3D或2.5D的封裝技術。3D封裝技術的提出,說明了這些廠商的殊途同歸,正在漸漸走進未來芯片發展的同時一個方向-不再拘泥于傳統框架,追求更加靈活地設計性能更強、功能更豐富、功耗更低、用途更靈活的不同產品。
2020-09-23 16:37:46 3259
3259 代工廠、設備供應商、研發機構等都在研發一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項技術正在推動下一代2.5D和3D封裝技術。
2020-10-10 15:24:32 7955
7955 
盛美半導體設備(NASDAQ:ACMR),作為半導體制造與先進晶圓級封裝領域中領先的設備供應商,近日發布了應用于填充3D硅通孔(TSV)的硅通孔電鍍設備Ultra ECP 3d。借助盛美半導體電鍍設備的平臺,該設備可為高深寬比(H.A.R)銅應用提供高性能、無孔洞的鍍銅功能。
2020-11-26 11:30:45 4171
4171 如今的高端半導體芯片越來越復雜,傳統的封裝技術已經無法滿足,Intel、臺積電、三星等紛紛研發了各種2.5D、3D封裝技術,將不同IP模塊以不同方式,整合封裝在一顆芯片內,從而減低制造難度和成本。
2020-11-27 09:09:09 1805
1805 如今的高端半導體芯片越來越復雜,傳統的封裝技術已經無法滿足,Intel、臺積電、三星等紛紛研發了各種2.5D、3D封裝技術,將不同IP模塊以不同方式,整合封裝在一顆芯片內,從而減低制造難度和成本。
2020-11-27 10:38:38 1667
1667 異構集成基礎:基于工業的2.5D/3D尋徑和協同設計方法
2021-07-05 10:13:36 12
12 的發展做出更多的貢獻。
近年來,隨著“摩爾定律”的推進放緩,再加上追逐先進制程工藝所帶來的成本壓力越來越高,使得越來越多的芯片廠商開始選擇通過Chiplet、2.5D/3D先進封裝技術來進行異質集成
2022-02-08 12:47:41 18640
18640 電子行業正在經歷半導體封裝技術的再興。越來越多的創新性的3D封裝方法已經發展,是電子工廠能夠去最大化他們的產品功能。通過整合多個芯片到一個封裝模組中,產品板可以明顯的比它們的前輩更小,并且更短的內部
2022-04-29 17:17:43 8
8 開始呈現疲軟的狀態,先進
制成工藝也無法帶來成本上的縮減。如何超越摩爾定律(More than Moore’s
law),讓行業繼續高速發展,成為業界苦苦尋思的問題。而目前來看,2.5D/3D
先進封裝技術將會是行業一個重要的突破口,是超越摩爾定律的必經之路
2022-04-29 17:20:01 8
8 (Signal Integrity, SI)、電源完整性 (Power
Integrity, PI) 及可靠性優化。總結了目前 2.5D/3D 芯片仿真進展與挑戰,介紹了基于芯片模型的
Ansys 芯片-封裝-系統 (CPS) 多物理場協同仿真方法,闡述了如何模擬芯片在真實工況下達到優化
芯片信
2022-05-06 15:20:42 19
19 3D晶圓級封裝,包括CIS發射器、MEMS封裝、標準器件封裝。是指在不改變封裝體尺寸的前提下,在同一個封裝體內于垂直方向疊放兩個以上芯片的封裝技術,它起源于快閃存儲器(NOR/NAND)及SDRAM的疊層封裝。
2022-07-25 15:35:41 2769
2769 芯和半導體技術總監蘇周祥在2022年EDA/IP與IC設計論壇中提出,在SoC的設計階段需要克服可靠性問題,而在2.5D和3D方面需要解決的問題則是系統級封裝和模塊仿真。
2022-08-18 10:48:58 2196
2196 異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418 在 IC 設計的大部分歷史中,我們在一個封裝中使用了一個芯片,以及多芯片模塊 (MCM)。對于具有多個裸片的 2.5D 和 3D IC,您如何進行單個裸片測試,然后使它們適用于最終封裝?
2022-10-12 09:59:07 1972
1972 隨著集成電路制程工藝逼近物理尺寸極限,2.5D/3D封裝,芯粒(Chiplet)、晶上系統(SoW)等先進封裝成為了提高芯片集成度的新方向,并推動EDA方法學創新。這也使得芯片設計不再是單芯片的問題,而逐漸演變成多芯片系統工程。
2023-01-29 09:31:01 1478
1478 SiP是一個非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術,但就最先進SiP封裝技術而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構Chiplet封裝技術。
2023-03-20 09:51:54 2006
2006 
創建真正的 3D 設計被證明比 2.5D 復雜和困難得多,需要在技術和工具方面進行重大創新。
2023-04-03 10:32:41 5313
5313 就收入而言,倒裝芯片BGA、倒裝芯片CSP和2.5D/3D是主要的封裝平臺,其中2.5D/3D技術的增長率最高。2.5D/3D 市場預計將從 2022 年的 92 億美元增長到 2028 年的 258 億美元,實現 19% 的復合年增長率。
2023-04-24 10:09:52 1622
1622 
據2022年2月7日消息,上海微電子裝備(集團)股份有限公司(SMEE)舉行首臺2.5D/3D先進封裝光刻機發運儀式,向客戶正式交付先進封裝光刻機。需要指出的是,上海微電子此次交付的是用于IC后道
2022-02-11 09:37:04 15455
15455 
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 1652
1652 2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 5284
5284 
本文通過測試、仿真分析了影響2.5D CoWoS翹曲、應力、可靠性的因素:real/dummyHBM、interposer 厚度、C4 bump高度。對2.5D package的設計非常有指導意義。
2023-09-07 12:22:40 4745
4745 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2023-10-31 09:16:29 3859
3859 
來源:《半導體芯科技》雜志 ASIC設計服務暨IP研發銷售廠商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先進封裝服務。通過獨家的芯片中介層
2023-11-20 18:35:42 1107
1107 TSV是2.5D和3D集成電路封裝技術中的關鍵實現技術。半導體行業一直在使用HBM技術將DRAM封裝在3DIC中。
2023-11-27 11:40:20 1762
1762 
當 2.5D 和 3D 封裝最初被構想出來時,普遍的共識是只有最大的半導體公司才能負擔得起,但開發成本很快就得到了控制。在某些情況下,這些先進的封裝實際上可能是成本最低的選擇。
2023-12-05 11:10:57 1364
1364 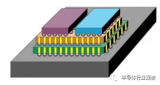
半導體芯片封裝的重要性、傳統和先進技術以及該領域的未來趨勢。
2024-01-02 11:09:17 2174
2174 
2.5D 和 3D 半導體封裝技術對于電子設備性能至關重要。這兩種解決方案都不同程度地增強了性能、減小了尺寸并提高了能效。2.5D 封裝有利于組合各種組件并減少占地面積。它適合高性能計算和人工智能加速器中的應用。3D 封裝提供無與倫比的集成度、高效散熱并縮短互連長度,使其成為高性能應用的理想選擇。
2024-01-07 09:42:10 4503
4503 
level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。 審核編輯 黃宇
2024-02-21 10:34:20 1565
1565 
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 5268
5268 
2.5/3D-IC封裝是一種用于半導體封裝的先進芯片堆疊技術,它能夠把邏輯、存儲、模擬、射頻和微機電系統 (MEMS)集成到一起
2024-03-06 11:46:05 3931
3931 
。2.5D封裝技術可以看作是一種過渡技術,它相對于傳統的2D封裝技術,在性能和功耗上有了顯著的改進,同時相比于更先進的3D封裝技術,技術難度和成本較低。
2024-04-18 13:35:13 1709
1709 。 典型封裝技術包括:1)倒片封裝(Flip-Chip):芯片倒置,舍棄金屬引線,利用凸塊連接;2)扇入型/扇出型封裝(Fan-In/Fan-Out):在晶圓上進行整體封裝,成本更低,關鍵工藝為重新布線(RDL);3)2.5D/3D封裝:2.5D封裝中芯片位于硅中介層上,3D封裝舍
2024-07-03 08:44:54 6868
6868 
7月17日,韓國財經媒體Money Today披露,半導體巨頭SK海力士正就硅中介層(Si Interposer)技術合作事宜,與業界領先的半導體封裝與測試外包服務(OSAT)企業Amkor進行深入探討。此次合作旨在共同推動高性能HBM(高帶寬內存)與2.5D封裝技術的融合應用。
2024-07-17 16:59:18 1689
1689 深視智能3D相機2.5D模式高度差測量SOP流程
2024-07-27 08:41:36 2002
2002 
。2.5D封裝技術可以看作是一種過渡技術,它相對于傳統的2D封裝技術,在性能和功耗上有了顯著的改進,同時相比于更先進的3D封裝技術,技術難度和成本較低。
2024-07-30 10:54:23 1792
1792 半導體行業不斷發展,不斷推動芯片設計和制造的邊界。隨著逐漸接近傳統平面縮放的極限,先進封裝技術正成為持續提升性能的關鍵推動力。在這些技術中,3.5D封裝作為當前2.5D解決方案和完全3D集成之間的折中方案,正在獲得廣泛關注。本文將探討3.5D封裝的概念、優勢、挑戰以及對半導體設計未來的潛在影響。
2024-10-28 09:47:45 1804
1804 
隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。
2024-11-11 11:21:51 5379
5379 
的一項重要創新,不僅提高了芯片的性能和集成度,還為未來的芯片設計提供了更多的可能性。本文將深入剖析2.5D封裝技術的內涵、優勢及其在現代半導體工業中的應用。 一、芯片封裝的重要性 封裝作為半導體制造流程中的關鍵環節,其核心作用在
2024-11-22 09:12:02 4311
4311 
三類:1)溫度變化導致的熱力;2)化學或電化學導致的金屬腐蝕或遷移;3)高溫下的老化。2.5D封裝中,最主要的失效是第一類,因封裝尺寸越來越大,各部件材料CTE的不匹配,會引起熱變形或翹曲。翹曲不僅會導致焊球的non-wet或橋接,還會導致焊接界面
2024-11-24 09:52:48 3092
3092 
本文要點在提升電子設備性能方面,2.5D和3D半導體封裝技術至關重要。這兩種解決方案都在不同程度提高了性能、減小了尺寸并提高了能效。2.5D封裝有利于組合各種器件并減小占用空間,適合高性能計算和AI
2024-12-07 01:05:05 2506
2506 
2.5D封裝技術是一種先進的異構芯片封裝技術,它巧妙地利用中介層(Interposer)作為多個芯片之間的橋梁,實現高密度線路連接,并最終集成為一個封裝體。
2024-12-25 18:34:16 6798
6798 技術前沿:半導體先進封裝從2D到3D的關鍵 半導體分類 集成電路封測技術水平及特點?? ? 1. 發展概述 ·自20世紀90年代以來,集成電路封裝技術快速發展,推動了電子產品向小型化和多功能方向邁進
2025-01-07 09:08:19 3353
3353 
整合更多功能和提高性能是推動先進封裝技術的驅動,如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統的flip-chip要求每個IC單獨封裝,并通過傳統PCB技術與其他IC集成
2025-01-14 10:41:33 2903
2903 
在半導體行業的快速發展歷程中,芯片封裝技術始終扮演著至關重要的角色。隨著集成電路設計復雜度的不斷提升和終端應用對性能、功耗、尺寸等多方面要求的日益嚴苛,傳統的2D封裝技術已經難以滿足市場的需求。在此背景下,芯片3D堆疊封裝技術應運而生,成為半導體技術發展的新里程碑。
2025-02-11 10:53:45 2819
2819 
3D封裝與系統級封裝概述 一、引言:先進封裝技術的演進背景 隨著摩爾定律逐漸逼近物理極限,半導體行業開始從單純依賴制程微縮轉向封裝技術創新。3D封裝和系統級封裝(SiP)作為突破傳統2D平面集成限制
2025-03-22 09:42:56 1794
1794 
?多年來,封裝技術并未受到大眾的廣泛關注。但是現在,尤其是在AI芯片的發展過程中,封裝技術發揮著至關重要的作用。2.5D封裝以其高帶寬、低功耗和高集成度的優勢,成為了AI芯片的理想封裝方案。 在
2025-03-27 18:12:46 711
711 
面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。2.5D/3D 集成技術正快速發展,集成方案與集成技術日新月異。
2025-06-16 15:58:31 1507
1507 
隨著“后摩爾時代”的到來,芯粒(Chiplet)與 2.5D/3D 先進封裝技術正成為突破晶體管微縮瓶頸的關鍵路徑。通過異構集成將不同的芯片模塊化組合,依托2.5D/3D封裝實現高帶寬互連與低功耗
2025-08-07 15:42:25 4111
4111 
?AD ?PCB 3D封裝
2025-08-27 16:24:59 3
3 Socionext Inc.(以下簡稱“Socionext”)宣布,其3DIC設計現已支持面向消費電子、人工智能(AI)和高性能計算(HPC)數據中心等多種應用。通過結合涵蓋Chiplet、2.5D
2025-09-24 11:09:54 2350
2350 
集成電路封裝技術從2D到3D的演進,是一場從平面鋪開到垂直堆疊、從延遲到高效、從低密度到超高集成的革命。以下是這三者的詳細分析:
2025-12-03 09:13:15 440
440 2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能和集成度,還能有效降低功耗,為AI和高性能計算等領域提供強有力的
2024-07-11 01:12:00 8591
8591


 電子發燒友App
電子發燒友App



























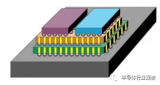























評論