一、核心結(jié)論
1.?先進(jìn)制程受限,先進(jìn)封裝/Chiplet提升算力,必有取舍。
在技術(shù)可獲得的前提下,提升芯片性能,先進(jìn)制程升級(jí)是首選,先進(jìn)封裝則錦上添花。
2.?大功耗、高算力的場(chǎng)景,先進(jìn)封裝/Chiplet有應(yīng)用價(jià)值。
3.?我國(guó)先進(jìn)制程產(chǎn)能儲(chǔ)備極少,先進(jìn)封裝/Chiplet有助于彌補(bǔ)制程的稀缺性。
先進(jìn)封裝/Chiplet可以釋放一部分先進(jìn)制程產(chǎn)能,使之用于更有急迫需求的場(chǎng)景。 ?
二、用面積和堆疊跨越摩爾定律限制
芯片升級(jí)的兩個(gè)永恒主題:性能、體積/面積。芯片技術(shù)的發(fā)展,推動(dòng)著芯片朝著高性能和輕薄化兩個(gè)方向提升。而先進(jìn)制程和先進(jìn)封裝的進(jìn)步,均能夠使得芯片向著高性能和輕薄化前進(jìn)。面對(duì)美國(guó)的技術(shù)封裝,華為難以在全球化的先進(jìn)制程中分一杯羹,手機(jī)、HPC等需要先進(jìn)制程的芯片供應(yīng)受到嚴(yán)重阻礙,亟需另辟蹊徑。而先進(jìn)封裝/Chiplet等技術(shù),能夠一定程度彌補(bǔ)先進(jìn)制程的缺失,用面積和堆疊換取算力和性能。
先進(jìn)制程受限,先進(jìn)封裝/Chiplet提升算力,必有取舍
三、何謂先進(jìn)封裝?
先進(jìn)封裝是對(duì)應(yīng)于先進(jìn)圓晶制程而衍生出來(lái)的概念,一般指將不同系統(tǒng)集成到同一封裝內(nèi)以實(shí)現(xiàn)更高效系統(tǒng)效率的封裝技術(shù)。換言之,只要該封裝技術(shù)能夠?qū)崿F(xiàn)芯片整體性能(包括傳輸速度、運(yùn)算速度等)的提升,就可以視為是先進(jìn)封裝。傳統(tǒng)的封裝是將各個(gè)芯片單獨(dú)封裝好,再將這些單獨(dú)的封裝芯片裝配到PCB主板上構(gòu)成完整的系統(tǒng),芯片間的信息交換屬于PCB級(jí)的互連(interconnect),又稱板級(jí)互連;或者將不同的芯片貼裝到同一個(gè)封裝基板Substrate上,再完成系統(tǒng)級(jí)的封裝,芯片間的通訊屬于Substrate級(jí)的互連。這兩種形式的封裝互連技術(shù),芯片間的信息傳輸需要通過(guò)PCB或Substrate布線完成。理論上,芯片間的信息傳輸距離越長(zhǎng),信息傳遞越慢,芯片組系統(tǒng)的性能就越低。因此,同一芯片水平下,PCB級(jí)互連的整體性能比Substrate級(jí)互連的性能弱。
在摩爾定律失效之前,芯片系統(tǒng)性能的提升可以完全依賴于芯片本身制程提升(制程提升使得芯片集成晶體管數(shù)量提升)。但隨著摩爾定律失效,芯片制程提升速度大大放緩,芯片系統(tǒng)性能的提升只能通過(guò)不斷優(yōu)化各個(gè)芯片間的信息傳輸效率,圓晶Wafer級(jí)封裝互連技術(shù)的價(jià)值凸顯。
Wafer級(jí)的封裝互連技術(shù),將不同的SoC集成在TSV(硅通孔技術(shù):Through silicon via)內(nèi)插板(interposer)上。Interposer本身材料為硅,與SoC的襯底硅片相同,通過(guò)TSV技術(shù)以及再布線(RDL)技術(shù),實(shí)現(xiàn)不同SoC之間的信息交換。換言之,SoC之間的信息傳輸是通過(guò)Interposer完成。Interposer再布線采用圓晶光刻工藝,比PCB和Substrate布線更密集,線路距離更短,信息交換更快,因此可以實(shí)現(xiàn)芯片組整體性能的提升。圖XX示例為CoWoS封裝(Chip on Wafer on Substrate),CPU/GPU?die與Memory die通過(guò)interposer實(shí)現(xiàn)互連,信息直接通過(guò)interposer上的RDL布線傳輸,不經(jīng)過(guò)Substrate或PCB,信息交換快,系統(tǒng)效率高。
從半導(dǎo)體制程進(jìn)入10nm以來(lái),摩爾定律已經(jīng)失效,即芯片迭代不再滿足“集成電路芯片上所集成的晶體管數(shù)目,每隔18個(gè)月就翻一番;微處理器的性能每隔18個(gè)月提高一倍,而價(jià)格下降一倍”。在后摩爾定律時(shí)代,對(duì)于“more than moore”的延續(xù),先進(jìn)封裝是業(yè)界公認(rèn)的有效途徑。
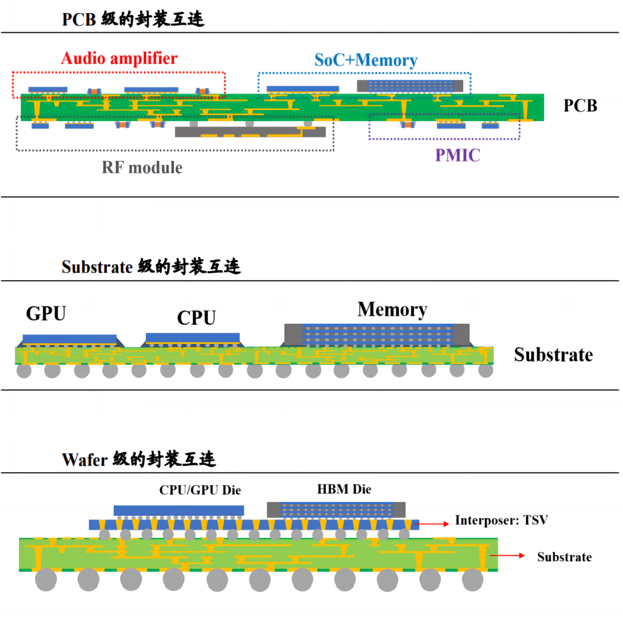
四、何謂Chiplet?
Chiplet即小芯片之意,指在晶圓端將原本一顆“大”芯片(Die)拆解成幾個(gè)“小”芯片(Die),因單個(gè)拆解后的“小”芯片在功能上是不完整的,需通過(guò)封裝,重新將各個(gè)“小”芯片組合起來(lái),功能上還原原來(lái)“大”芯片的功能。Chiplet可以將一顆大芯片拆解設(shè)計(jì)成幾顆與之有相同制程的小芯片,也可以將其拆解成設(shè)計(jì)成幾顆擁有不同制程的小芯片。
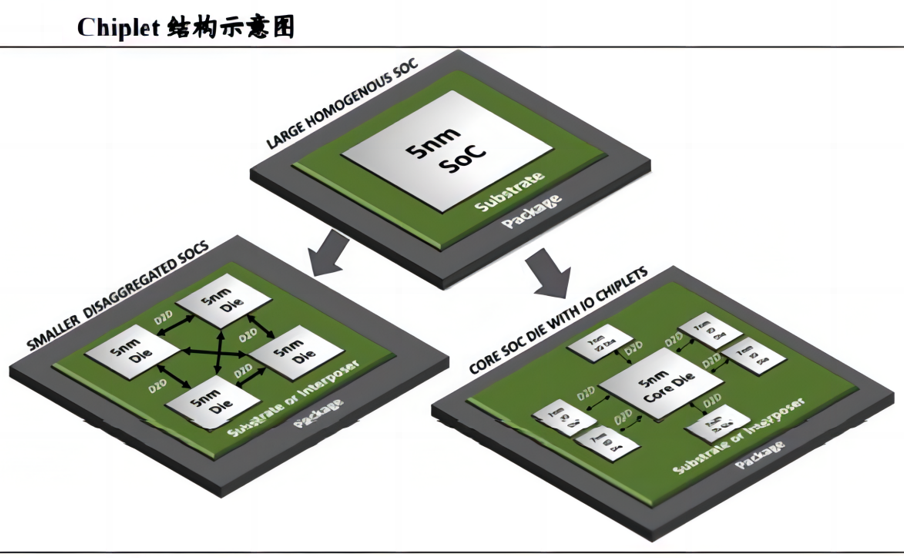
?
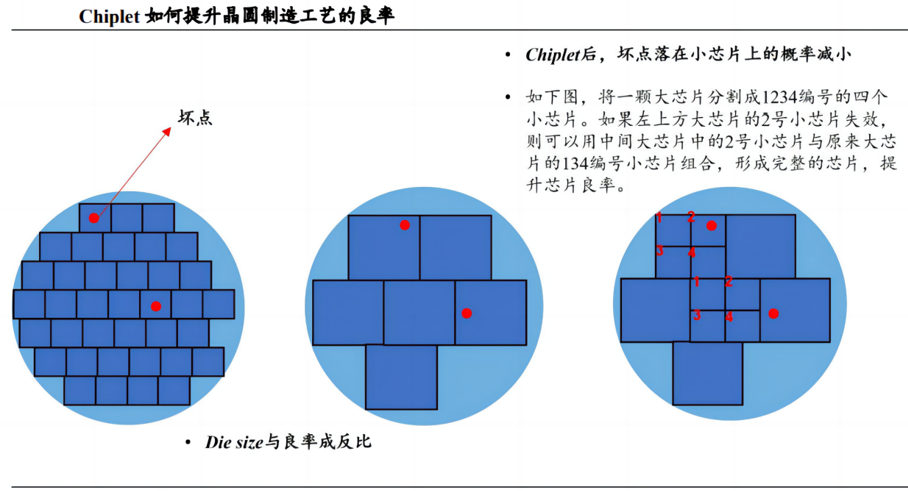
Chiplet可以提升芯片制造的良率。對(duì)于晶圓制造工藝而言,芯片面積(Die size)越大,工藝的良率越低。可以理解為,每片wafer上都有一定概率的失效點(diǎn),對(duì)于晶圓工藝來(lái)說(shuō),在同等技術(shù)條件下難以降低失效點(diǎn)的數(shù)量,如果被制造的芯片,其面積較大,那么失效點(diǎn)落在單個(gè)芯片上的概率就越大,因而良率就越低。如果Chiplet的手段,將大芯片拆解分割成幾顆小芯片,單個(gè)芯片面積變小,失效點(diǎn)落在單個(gè)小芯片上的概率將大大降低。芯片面積Die size與良率成反比。 五、先進(jìn)制程和先進(jìn)封裝,對(duì)芯片性能、輕薄化的提升,孰更顯著?
在提升芯片性能方面,先進(jìn)制程路線是通過(guò)縮小單個(gè)晶體管特征尺寸,在同等芯片面積(Die size)水平下,提升晶體管集成度(同等設(shè)計(jì)框架,芯片性能/算力與晶體管數(shù)目正相關(guān));而先進(jìn)封裝并不能改變單個(gè)晶體管尺寸,只能從系統(tǒng)效率提升的角度,一是讓CPU更靠近Memory,讓“算”更靠近“存”,提升每一次計(jì)算的算存效率。二是讓單個(gè)芯片封裝內(nèi)集成更多的元件:信號(hào)傳輸速度排序,Wafer > IC substrate > PCB,元件在芯片內(nèi)部的通訊效率比在板級(jí)上更高,從系統(tǒng)層面提升芯片性能。
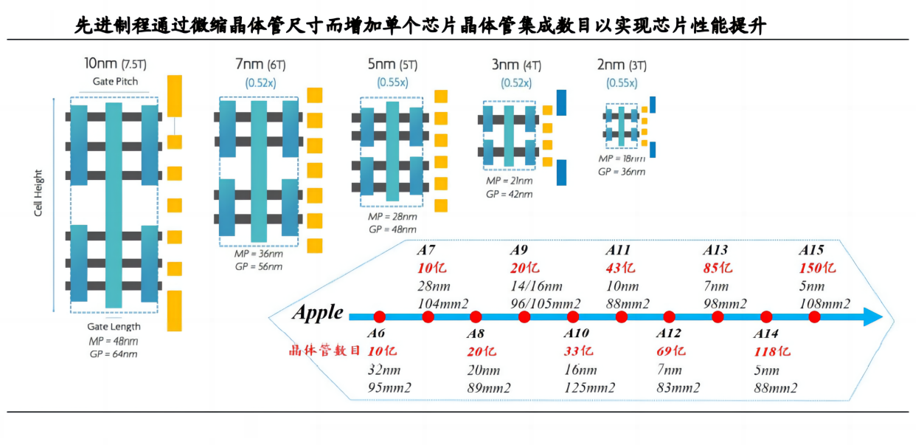
?

在芯片輕薄化方面,在不犧牲芯片整體性能的前提下,先進(jìn)制程能夠在算力和晶體管數(shù)目不變時(shí),通過(guò)縮小單個(gè)晶體管特征尺寸,實(shí)現(xiàn)芯片面積(Die size)縮小;而先進(jìn)封裝,因?yàn)榉庋b對(duì)晶體管尺寸無(wú)微縮的能力,只能通過(guò)更精細(xì)的材料、更致密的結(jié)構(gòu)來(lái)實(shí)現(xiàn)輕薄化。比如,手機(jī)AP處理器的封裝多采用FCCSP的封裝形式,其結(jié)構(gòu)包括一個(gè)CSP載板,而Fanout(TSMC與APPLE公司合作,APPLE公司的A系列芯片多采用InFO技術(shù)封裝,即Fannout)封裝,取消了CSP載板(CSP載板約0.3 mm厚度),封裝后的芯片更輕薄,對(duì)整機(jī)(手機(jī))結(jié)構(gòu)空間余量有重要提升。
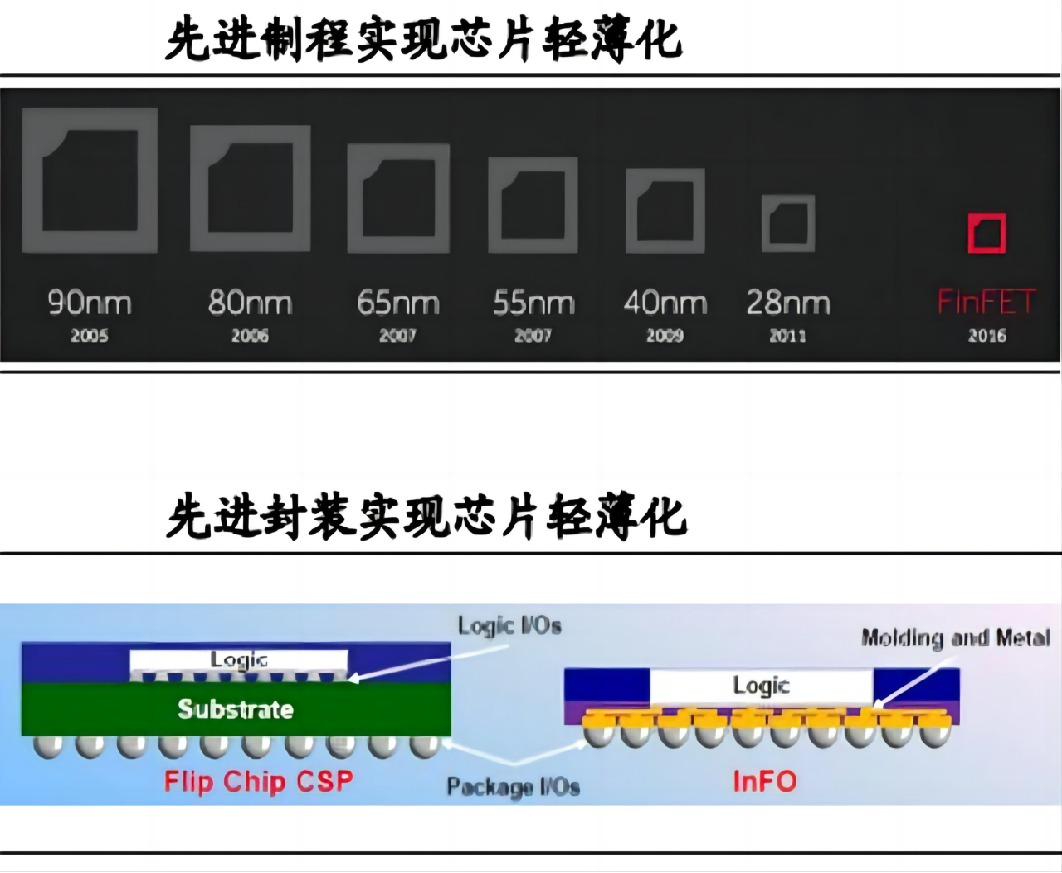
在高性能和輕薄化兩個(gè)方向上,先進(jìn)制程可以做到兼顧,而先進(jìn)封裝則有取舍。比如,APPLE的A系列芯片,從A10升級(jí)到A11時(shí),由16 nm工藝提升至10 nm工藝,芯片面積從125 mm2減小至88 mm2,而晶體管集成數(shù)則由33億顆增加至43億顆;A系列芯片從A13升級(jí)到A14時(shí),晶圓工藝從7nm升級(jí)到5nm,芯片面積從98 mm2減小至88 mm2,而晶體管集成數(shù)則由85億顆增加至118億顆,做到了性能提升和輕薄化的兼顧。而先進(jìn)封裝,要做到芯片性能提升,因?yàn)榉庋b對(duì)晶體管尺寸微縮沒(méi)有效果,提升性能一是增加芯片內(nèi)部各元件的協(xié)作效率,二是往一個(gè)系統(tǒng)中堆疊更多的元件(本質(zhì)上也是提升了系統(tǒng)內(nèi)的晶體管數(shù)據(jù)),代價(jià)就是系統(tǒng)體積、面積更為龐大,即先進(jìn)封裝提升性能的代價(jià)是犧牲輕薄,實(shí)現(xiàn)輕薄的代價(jià)是犧牲性能的提升。

在技術(shù)可獲得的前提下,提升芯片性能,先進(jìn)制程升級(jí)是首選,先進(jìn)封裝則錦上添花。通常我們可以見到的是,高性能、大算力的芯片,會(huì)考慮上先進(jìn)封裝(2.5D、CoWoS等),但這些大算力芯片往往也同時(shí)采用的先進(jìn)制程工藝,也就是說(shuō),先進(jìn)封裝/Chiplet應(yīng)用通常只出現(xiàn)在頂級(jí)的旗艦芯片的封裝方案選擇中,并不是一個(gè)普適性的大規(guī)模應(yīng)用方案。比如寒武紀(jì)的7 nm?AI訓(xùn)練芯片思元290,從芯片宣傳圖片可以看出,其可能采用“1+4”架構(gòu),即1顆CPU/GPU搭配4顆HBM存儲(chǔ)的Chiplet封裝形式,該芯片也是寒武紀(jì)的旗艦芯片產(chǎn)品之一;華為海思昇騰910芯片,采用7 nm的先進(jìn)制程工藝,從宣傳圖可以看出,也是采用了多顆芯片堆疊的CoWoS結(jié)構(gòu),也系Chiplet的一種形式。這些芯片都是在擁有先進(jìn)制程的基礎(chǔ)上,為了進(jìn)一步提升芯片性能,而采用了CoWoS這些2.5D先進(jìn)封裝技術(shù),說(shuō)明了先進(jìn)制程在工藝路線的選擇上是優(yōu)于先進(jìn)封裝的,先進(jìn)制程是升級(jí)芯片性能的首選,先進(jìn)封裝則是錦上添花。

五.?大功耗、高算力的場(chǎng)景,先進(jìn)封裝/Chiplet有應(yīng)用價(jià)值
在先進(jìn)制程不可獲得的情況下,通過(guò)芯片堆疊(先進(jìn)封轉(zhuǎn)/Chiplet)和計(jì)算架構(gòu)重構(gòu),以維持產(chǎn)品性能。以APPLE的A系列芯片參數(shù)為例,A12、A10、A7芯片分別采用7 nm、14/16 nm(Samsung 14 nm、TSMC 16 nm)、28 nm制程。A系列的手機(jī)AP芯片,通常芯片面積(Die Size)在約100 mm2大小。在這100 mm2大小的芯片上,?A12、A10、A7芯片分別集成了約69億、33億、10億顆晶體管。下面,我們簡(jiǎn)單進(jìn)行算術(shù)換算,討論降制程如何維持芯片的算力。如果芯片工藝從7 nm降至14 nm,A12芯片上7nm工藝集成69億顆晶體管,如果用14 nm工藝以試圖達(dá)到接近的算力,首先要保證晶體管數(shù)目與A12芯片一致,即~70億顆,且在未考慮制程提升對(duì)單個(gè)晶體管性能有顯著提升的背景下,14 nm工藝的芯片需要兩倍于7 nm工藝的面積,即~200 mm2;如果芯片工藝從7 nm降至28 nm,參考28 nm的A7芯片只集成了10億顆晶體管,如果要達(dá)到70億晶體管數(shù)目,則需要將芯片面積擴(kuò)大至~700 mm2。芯片面積越大,工藝良率越低,在實(shí)際制造中得到的單顆芯片的制造成本就越高,因此,在先進(jìn)制程不可獲得的背景下,降制程而通過(guò)芯片堆疊的方式,的確可以一定程度減少算力劣勢(shì),但是因?yàn)槎询B更多芯片,需要更大的IC載板、更多的Chiplet小芯片、更多的封裝材料,也導(dǎo)致因?yàn)橹瞥搪浜髱?lái)的功耗增大、體積/面積增加、成本的增加。因此,比如,通過(guò)14 nm的兩顆芯片堆疊,去達(dá)到同樣晶體管數(shù)目的7 nm芯片性能;通過(guò)多顆28 nm的芯片堆疊,去達(dá)到14 nm芯片性能。此種堆疊方案在HPC(服務(wù)器、AI推理)、基站類大芯片領(lǐng)域可能有適用價(jià)值,但對(duì)于消費(fèi)電子領(lǐng)域如手機(jī)AP芯片和可穿戴芯片,在其應(yīng)用場(chǎng)景對(duì)空間體積有嚴(yán)苛約束的條件下,芯片堆疊則較難施展。
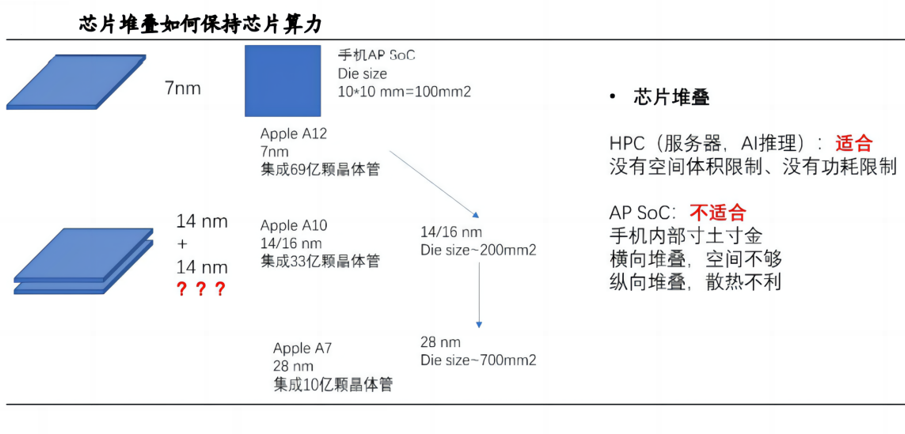
六.?我國(guó)先進(jìn)制程產(chǎn)能儲(chǔ)備極少,先進(jìn)封裝/Chiplet有助于彌補(bǔ)制程的稀缺性 尖端科技全球化已死,大陸先進(jìn)制程的產(chǎn)能極為稀缺、緊缺。按不同晶圓尺寸統(tǒng)計(jì),大陸6英寸晶圓產(chǎn)能已占全球近一半,而12英寸產(chǎn)能僅為全球約10%。按不同制程統(tǒng)計(jì),大陸90 nm以上制程占全球約20%,20-90 nm制程占全球約10%,20 nm以下制程僅占全球約1%。大陸高端制程占比低,產(chǎn)業(yè)結(jié)構(gòu)存在明顯短板,未來(lái)擴(kuò)產(chǎn)空間大。高端制程擴(kuò)產(chǎn)投入大,3 nm制程芯片每萬(wàn)片產(chǎn)能的投資約100億美元,遠(yuǎn)高于28 nm制程芯片每萬(wàn)片約7億美元的投資。彌補(bǔ)大陸晶圓產(chǎn)業(yè)結(jié)構(gòu)短板,需重點(diǎn)投資高端制程晶圓制造產(chǎn)能,既需要完成技術(shù)攻關(guān),又需要大額投資支持,任重而道遠(yuǎn)。
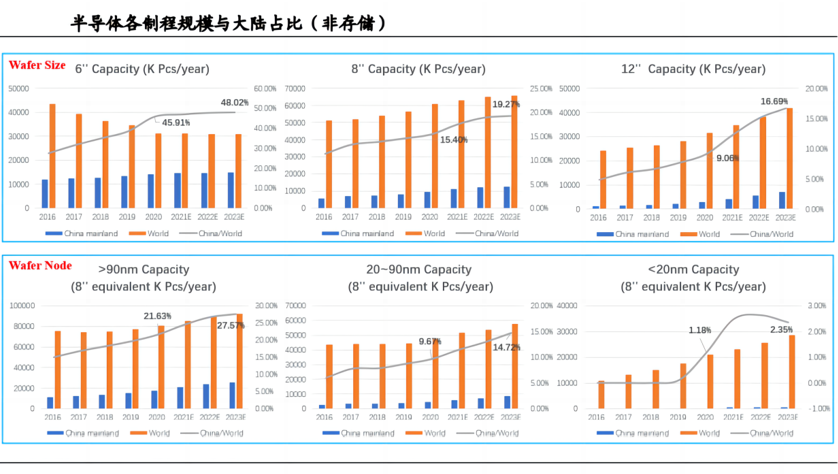
七、結(jié)語(yǔ)
先進(jìn)封裝/Chiplet可以釋放一部分先進(jìn)制程產(chǎn)能,使之用于更有急迫需求的場(chǎng)景。從上文分析可見,通過(guò)降制程和芯片堆疊,在一些沒(méi)有功耗限制和體積空間限制、芯片成本不敏感的場(chǎng)景,能夠減少對(duì)先進(jìn)制程的依賴。可以將當(dāng)下有限的先進(jìn)制程產(chǎn)能,以更高的戰(zhàn)略視角,統(tǒng)一做好規(guī)劃,應(yīng)用在更需要先進(jìn)工藝的應(yīng)用需求中。
編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App













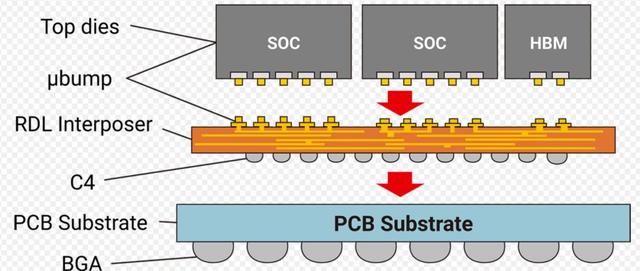








































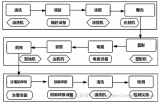

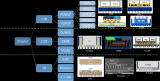























評(píng)論