來源:半導體小馬;作者:小馬
前面分享了先進封裝的四要素一分鐘讓你明白什么是先進封裝,今天分享一下先進封裝四要素中的再布線(RDL)。
RDL(Redistribution Layer)即重分布層,是先進封裝中實現芯片水平方向電氣延伸和互連的關鍵技術,在 3D/2.5D 封裝集成以及 FOWLP(扇出型晶圓級封裝)中應用廣泛。
一、工作原理
通過在芯片表面沉積金屬層和相應的介電層,形成金屬導線,將 IO 端口重新設計到更寬敞的區域,構建出表面陣列布局。簡單來說,就是把芯片原本位于邊緣或四周的 I/O 觸點,通過半導體工藝延伸到芯片表面其他位置,擴展布局到占位更寬松的區域,實現 I/O 觸點的重新布線。
二、優勢
降低設備成本:打破了傳統封裝中昂貴且耗時的引線鍵合和倒裝芯片鍵合工藝的束縛,通過減少設備所需的元件數量,有效降低設備成本。
減少占地面積:可將多個芯片集成到單個封裝中,極大地減少器件的整體占地面積,滿足智能手機、可穿戴設備等對空間要求極高的產品需求。
改善電氣性能:RDL 中介層信號通孔尺寸極小,可大幅改善 SerDes 信號完整性,其金屬厚度優勢也能提升內存 SI,同時低損耗介電材料可降低介電損耗,優化整個封裝的電氣性能。
提高設計靈活性:RDL介質層利用精細的線路寬度和間距,減少路由干擾,支持更多引腳數量,使 I/O 觸點間距更靈活,凸點面積更大,為芯片設計提供更大自由度。
三、工藝流程
在重新分配層工藝中,首先通過濺射工藝創建一層金屬薄膜,之后在金屬薄膜上涂覆厚層光刻膠。隨后利用光刻工藝繪制電路圖案,在電路圖案的曝光區域電鍍金層,以形成金屬引線。由于重新分配工藝本身就是重建焊盤的工藝,因此確保引線鍵合強度是十分重要的。這也正是被廣泛用于引線鍵合的材料—金,被用于電鍍的原因。

四、應用領域
RDL 技術已廣泛應用于MEMS器件、傳感器、功率器件、存儲器、微處理器和圖形處理器等眾多領域的封裝,為實現更小、更快、更高效的芯片設計提供技術支撐。
在WLP中:在FIWLP/FOWLP中,RDL是最為關鍵的技術,通過RDL將IOPad進行扇入Fan-In或扇出Fan-Out,形成不同類型的晶圓級封裝。
在2.5D中:除了硅基板上的TSV,RDL同樣不可或缺,通過RDL將網絡互聯并分布到不同的位置,從而將硅基板上方芯片的Bump和基板下方的Bump連接。
在3D中:對于上下堆疊是同一種芯片,通常TSV就可以直接完成電氣互聯功能了,而堆疊上下如果是不同類型芯片,則需要通過RDL重新布線層將上下層芯片的IO進行對準,從而完成電氣互聯。
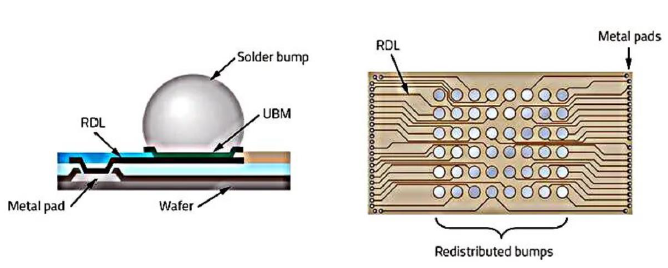
五、技術發展
目前 4 層 RDL 技術已經成熟,良率可達 99%,能滿足約 85% 的封裝需求。未來,RDL 工藝將朝著提高粘附力,減少熱循環過程中的機械應力和熱應力的方向發展,同時對布線檢測等設備也提出了更高要求。
-
芯片
+關注
關注
463文章
54226瀏覽量
468193 -
晶圓
+關注
關注
53文章
5434瀏覽量
132556 -
先進封裝
+關注
關注
2文章
553瀏覽量
1053
原文標題:先進封裝四要素中再布線(RDL)是什么?
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
芯片設計中再分布層(RDL)技術的優勢
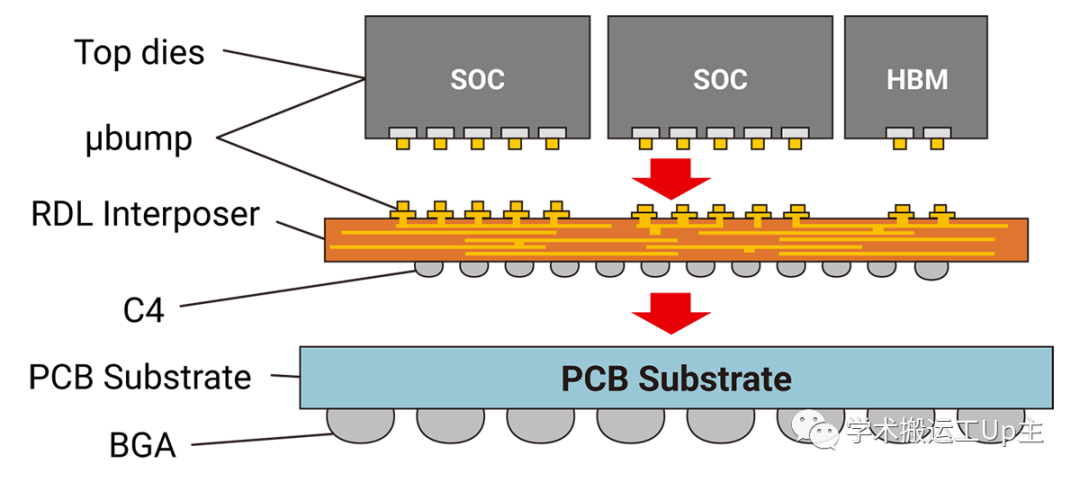
什么是先進封裝?先進封裝技術包括哪些技術

Manz亞智科技 RDL先進制程加速全球板級封裝部署和生產

芯片先進封裝里的RDL




 先進封裝中的RDL技術是什么
先進封裝中的RDL技術是什么











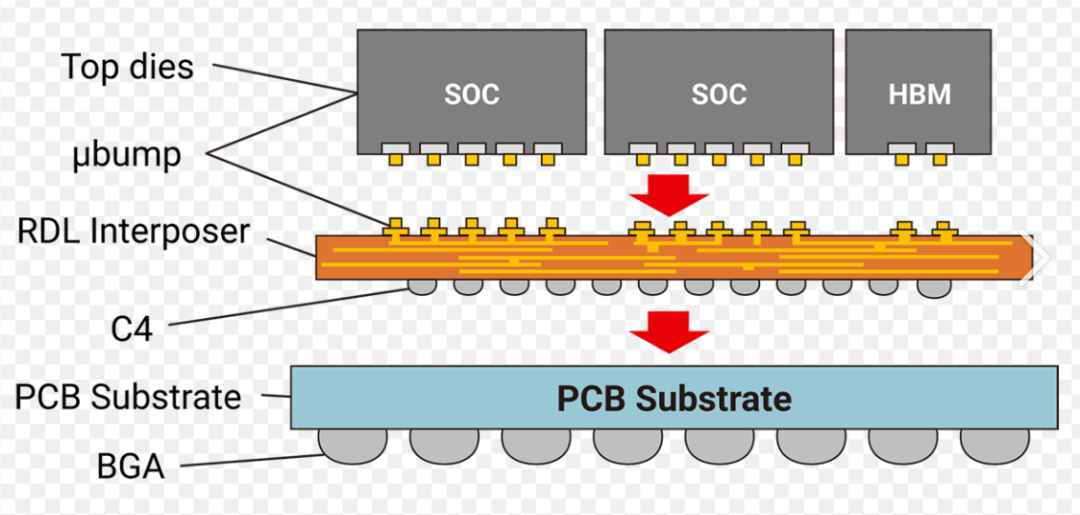



評論