以系統應用為出發點,各種技術進行異質整合的先進封裝技術持續演進。先進封裝也稱為高密度先進封裝HDAP(High Density Advanced Package)。 采用了先進的設計思路和先進的集成工藝、縮短引線互連長度,對芯片進行系統級封裝的重構,并且能有效提高系統功能密度的封裝。現階段的先進封裝是指:倒裝焊(FlipChip)、晶圓級封裝(WLP)、2.5D封裝(Interposer、RDL)、3D封裝(TSV) 與傳統封裝相比,先進封裝的應用范圍不斷擴大,根據Yole數據,預計到 2026 年將占到整個封裝市場的 50% 以上。半導體先進封裝市場簡析(2022)”報告從半導體先進封裝發展背景、半導體先進封裝定義、半導體先進封裝市場結構及規模、半導體先進封裝產業鏈圖譜、半導體先進封裝產業競爭格局進行分析。







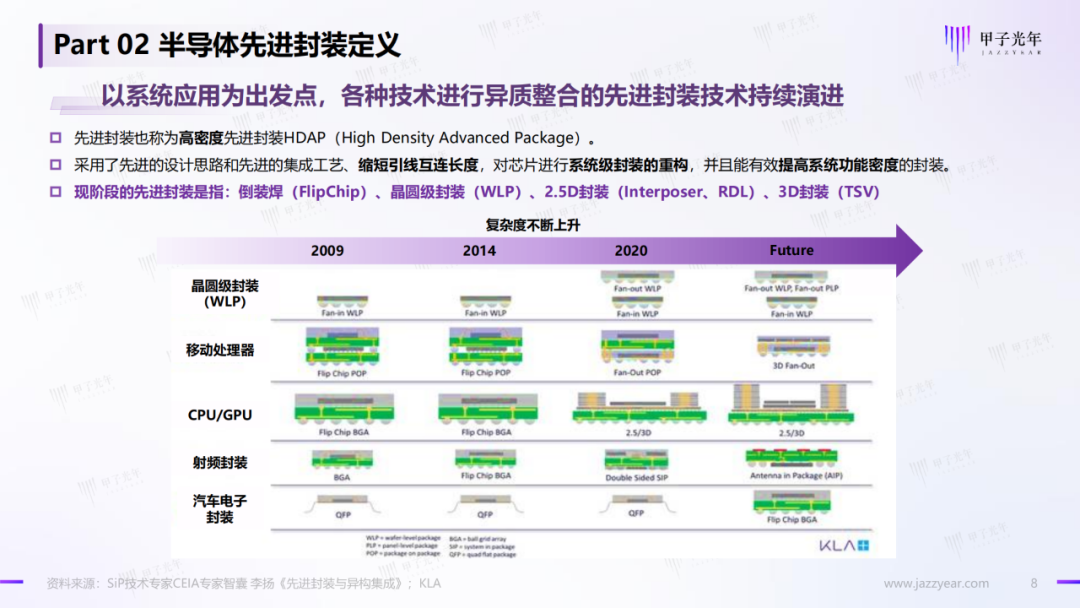





審核編輯 :李倩
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
339文章
30725瀏覽量
264012 -
封裝
+關注
關注
128文章
9248瀏覽量
148610 -
先進封裝
+關注
關注
2文章
533瀏覽量
1026
原文標題:半導體先進封裝市場簡析(2022)
文章出處:【微信號:AI_Architect,微信公眾號:智能計算芯世界】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
AI時代算力瓶頸如何破?先進封裝成半導體行業競爭新高地
電子發燒友網報道(文/李彎彎)在半導體行業,先進封裝(Advanced Packaging)已然占據至關重要的地位。它不再局限于芯片制造的“后道工序”范疇,而是成為提升芯片性能、在后摩爾定律時代突破
攜手伏達半導體:RedPKG解決方案助力封裝自主,加速產品創新
伴隨摩爾定律逐步放緩,后摩爾時代正式來臨,半導體產業的技術創新重心向封裝領域持續傾斜。因此,在追求高效與自主的半導體產業浪潮中,封裝已成為連接芯片設計與終端

3D-Micromac CEO展望2026半導體:AI 為核,激光微加工賦能先進封裝
2025 年半導體市場在 AI 需求爆發與全產業鏈復蘇的雙重推動下,呈現出強勁的增長態勢。以 EDA/IP 先進方法學、先進工藝、算力芯片、端側 AI、精準控制、高端模擬、高速互聯、新
發表于 12-24 10:00
?4947次閱讀


奧芯明:AI驅動半導體產業迎來“異構集成”新紀元,先進封裝成破局關鍵
在10月29日至30日于深圳舉辦的第四屆SEMI大灣區產業峰會上ASMPT集團半導體事業部副總裁,奧芯明半導體設備技術有限公司首席商務官、先進封裝研發中心負責人薛晗宸先生在開幕式上發表

BW-4022A半導體分立器件綜合測試平臺---精準洞察,卓越測量
可靠性保駕護航!
一、嚴謹細微,鑄就精準測試之魂
BW-4022A半導體分立器件綜合測試平臺采用先進的高精度傳感器和精密的測量算法,如同擁有一雙“火眼金睛”,能夠對 Si/SiC/GaN 等各類材料
發表于 10-10 10:35
自主創新賦能半導體封裝產業——江蘇拓能半導體科技有限公司與 “半導體封裝結構設計軟件” 的突破之路
當前,全球半導體產業正處于深度調整與技術革新的關鍵時期,我國半導體產業在政策支持與市場需求的雙重驅動下,加速向自主可控方向邁進。作為半導體產業鏈后道核心環節的


半導體先進封測年度大會:長電科技解讀AI時代封裝趨勢,江蘇拓能半導體科技有限公司技術成果受關注
2025年7月,半導體先進封測年度大會如期舉行,匯聚了行業內眾多企業與專家,共同聚焦先進封裝技術在AI時代的發展方向。其中,長電科技總監蕭永寬的主題演講,分別從
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
——薄膜制作(Layer)、圖形光刻(Pattern)、刻蝕和摻雜,再到測試封裝,一目了然。 全書共分20章,根據應用于半導體制造的主要技術分類來安排章節,包括與半導體制造相關的基礎技術信息;總體流程圖
發表于 04-15 13:52
先進碳化硅功率半導體封裝:技術突破與行業變革
本文聚焦于先進碳化硅(SiC)功率半導體封裝技術,闡述其基本概念、關鍵技術、面臨挑戰及未來發展趨勢。碳化硅功率半導體憑借低內阻、高耐壓、高頻率和高結溫等優異特性,在移動應用功率密度提升

芯和半導體將參加重慶半導體制造與先進封測產業發展論壇
芯和半導體科技(上海)股份有限公司(以下簡稱“芯和半導體”)將于3月13日參加在重慶舉辦的重慶半導體制造與先進封測產業發展論壇。作為國內Chiplet



 半導體先進封裝市場簡析(2022)
半導體先進封裝市場簡析(2022)







評論