2.5D/3D封裝技術(shù)作為當前前沿的先進封裝工藝,實現(xiàn)方案豐富多樣,會根據(jù)不同應用需求和技術(shù)發(fā)展動態(tài)調(diào)整,涵蓋芯片減薄、芯片鍵合、引線鍵合、倒裝鍵合、TSV、塑封、基板、引線框架、載帶、晶圓級薄膜
2025-08-05 15:03:08 2816
2816 
本文主要講述TSV工藝中的硅晶圓減薄與銅平坦化。 硅晶圓減薄與銅平坦化作為 TSV 三維集成技術(shù)的核心環(huán)節(jié),主要應用于含銅 TSV 互連的減薄芯片制造流程,為該技術(shù)實現(xiàn)短互連長度、小尺寸、高集成度等特性提供了重要支撐。
2025-08-12 10:35:00 1546
1546 
TSV技術(shù)應用即將遍地開花。隨著各大半導體廠商陸續(xù)將TSV立體堆疊納入技術(shù)藍圖,TSV應用市場正加速起飛,包括影像感應器、功率放大器和處理器等元件,皆已開始采用;2013年以后,3D TSV技術(shù)更將由8寸晶圓逐漸邁向12寸晶圓應用。
2013-01-27 10:25:00 3943
3943 本文介紹了一種新型的高縱橫比TSV電鍍添加劑系統(tǒng),利用深層反應離子蝕刻(DRIE)技術(shù)對晶片形成圖案,并利用物理氣相沉積(PVD)技術(shù)沉積種子層。通過陽極位置優(yōu)化、多步驟TSV填充過程、添加劑濃度
2021-12-27 16:00:41 3170
3170 
本文報道了TSV過程的細節(jié)。還顯示了可以在8-in上均勻地形成許多小的tsv(直徑:6 m,深度:22 m)。通過這種TSV工藝的晶片。我們?nèi)A林科納研究了TSV的電學特性,結(jié)果表明TSV具有低電阻和低電容;小的TSV-硅漏電流和大約83%的高TSV產(chǎn)率。
2022-06-16 14:02:43 4102
4102 
硅通孔(TSV) 是當前技術(shù)先進性最高的封裝互連技術(shù)之一。基于 TSV 封裝的核心工藝包括 TSV 制造、RDL/微凸點加工、襯底減薄、圓片鍵合與薄圓片拿持等。
2023-05-08 10:35:24 5731
5731 
來源:半導體風向標 從HBM存儲器到3D NAND芯片,再到CoWoS,硬件市場上有許多芯片是用英文稱為TSV構(gòu)建的,TSV是首字母縮寫,意為“通過硅通孔”并翻譯為via硅的事實,它們垂直地穿過
2023-07-26 10:06:15 2219
2219 在上篇文章中介紹了扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝,這篇文章著重介紹硅通孔(TSV)封裝工藝。
2023-11-08 10:05:53 7069
7069 
硅通孔技術(shù)(TSV,Through Silicon Via)是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導通,實現(xiàn)芯片之間互連的技術(shù),是2.5D/3D 封裝的關(guān)鍵工藝之一。通過垂直互連減小互連長度、信號延遲,降低電容、電感,實現(xiàn)芯片間低功耗、高速通訊,增加帶寬和實現(xiàn)小型化。
2024-01-09 09:44:13 23017
23017 
以硅通孔(TSV)為核心的 2.5D/3D 封裝技術(shù)可以實現(xiàn)芯片之間的高速、低功耗和高帶寬的信號傳輸。
2024-02-25 16:51:10 2811
2811 
3D-IC通過采用TSV(Through-Silicon Via,硅通孔)技術(shù),實現(xiàn)了不同層芯片之間的垂直互連。這種設(shè)計顯著提升了系統(tǒng)集成度,同時有效地縮短了互連線的長度。這樣的改進不僅降低了信號傳輸?shù)难訒r,還減少了功耗,從而全面提升了系統(tǒng)的整體性能。
2025-02-21 15:57:02 2460
2460 
在三維集成電路設(shè)計中,TSV(硅通孔)技術(shù)通過垂直互連顯著提升了系統(tǒng)集成密度與性能,但其物理尺寸效應與寄生參數(shù)對互連特性的影響已成為設(shè)計優(yōu)化的核心挑戰(zhàn)。
2025-08-25 11:20:01 2272
2272 
硅通孔(Through Silicon Via,TSV)技術(shù)是一種通過在硅介質(zhì)層中制作垂直導通孔并填充導電材料來實現(xiàn)芯片間垂直互連的先進封裝技術(shù)。
2025-10-13 10:41:46 3148
3148 
具有代表性的技術(shù)包括晶圓級封裝(WLP)及采用TSV(硅通孔)的硅轉(zhuǎn)接板等,潛藏著新的商機。
2011-08-28 12:17:46 4724
4724 
電子發(fā)燒友網(wǎng)報道(文/黃山明)TSV(Through Silicon Via)即硅通孔技術(shù),是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導通,實現(xiàn)芯片之間互連的技術(shù),是2.5D/3D封裝的關(guān)鍵
2025-04-14 01:15:00 2557
2557 TSV0505D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV0505S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV0515D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV0515S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1205D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1205S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1212D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1212S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1215D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV1215S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV2405D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV2412D - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV2412S - DC/DC Converters - TRACO Electronic AG
2022-11-04 17:22:44
TSV622-3-4-5 - Micropower, wide bandwidth CMOS operational amplifiers - STMicroelectronics
2022-11-04 17:22:44
TSV632-3-4-5 - Micropower, wide bandwidth CMOS operational amplifiers - STMicroelectronics
2022-11-04 17:22:44
TSV911AIDCKR
2023-03-28 13:13:59
TSV914 - High performance CMOS quad operational amplifier - STMicroelectronics
2022-11-04 17:22:44
TSV994IPT是一個四路運放芯片,當我VCC=+3.3V,VDD=-5V供電時,芯片明顯發(fā)燙,且不能正常工作,這時什么導致的???
2019-08-29 11:23:12
硅通孔(TSV)電鍍的高可靠性是高密度集成電路封裝應用中的一個有吸引力的熱點。本文介紹了通過優(yōu)化濺射和電鍍條件對完全填充TSV的改進。特別注意具有不同種子層結(jié)構(gòu)的樣品。這些樣品是通過不同的濺射和處理
2021-01-09 10:19:52
MICROFJ-30035-TSV-TR
2023-04-06 23:31:03
MICROFJ-60035-TSV-TR
2023-04-06 23:31:03
MICROFJ-60035-TSV-TR1
2023-04-06 23:35:33
使用STM32_Programmer_CLI構(gòu)建鏡像,可以根據(jù)Flashlayout_emmc.tsv安裝到板子上, 同樣,從sd卡啟動時,是否可以使用命令根據(jù)Flashlayout_emmc.tsv將構(gòu)建的鏡像安裝
2022-12-16 08:39:14
你好, OpAmp TSV632的數(shù)據(jù)表允許最大輸入電流為10mA(第4頁)。沒有給出任何標志,所以我認為不允許負輸入電流。但是我不確定它會對我有所幫助,如果它們被允許的話......那么,有人
2019-08-09 06:18:51
你有TSV6390AIDT和/或TSV6290AIDT的SPICE型號嗎? 謝謝, 何魯麗 #運算放大器,香料宏模型
2019-08-06 14:07:54
STMicroelectronics 運算放大器 TSV912AIDT 雙 高速、精密, 8MHz增益帶寬積
2022-05-31 10:04:31
3D-IC設(shè)計者希望制作出高深寬比(HAR>10:1)硅通孔(TSV),從而設(shè)計出更小尺寸的通孔,以減小TSV通孔群在硅片上的占用空間,最終改進信號的完整性。事實上,當前傳統(tǒng)的TSV生產(chǎn)供應鏈已落后于ITRS對其的預測。
2011-01-14 16:10:40 2333
2333 
重點討論了垂直互連的硅通孔(TSV)互連工藝的關(guān)鍵技術(shù)及其加工設(shè)備面臨的挑戰(zhàn).提出了工藝和設(shè)備開發(fā)商的應對措施并探討了3DTSV封裝技術(shù)的應用前景。
2011-12-07 10:59:23 89
89 對3D封裝技術(shù)結(jié)構(gòu)特點、主流多層基板技術(shù)分類及其常見鍵合技術(shù)的發(fā)展作了論述,對過去幾年國際上硅通孔( TSV)技術(shù)發(fā)展動態(tài)給與了重點的關(guān)注。尤其就硅通孔關(guān)鍵工藝技術(shù)如硅片減薄
2011-12-07 11:00:52 153
153 2011年,半導體封裝業(yè)界的熱門話題是采用TSV(硅通孔)的三維封裝技術(shù)。雖然TSV技術(shù)此前已在CMOS圖像傳感器等產(chǎn)品上實用化,但始終未在存儲器及邏輯LSI等用途中普及。最近,存儲器及邏
2011-12-23 09:34:58 5386
5386 TSV3DIC技術(shù)雖早于2002年由IBM所提出,然而,在前后段IC制造技術(shù)水準皆尚未成熟情況下,TSV3DIC技術(shù)發(fā)展速度可說是相當緩慢,DIGITIMESResearch分析師柴煥欣分析,直至2007年東芝(Toshiba)將
2012-02-21 08:45:37 1856
1856 中微半導體設(shè)備有限公司(以下簡稱“中微”)推出了8英寸硅通孔(TSV)刻蝕設(shè)備Primo TSV200E?
2012-03-15 09:39:40 1776
1776 你最近有看到關(guān)于過孔硅(TSV)的新聞嗎?
2012-04-16 08:54:46 6312
6312 在日本,硅通孔(TSV:Through Silicon Via)技術(shù)從10多年前開始就備受業(yè)界關(guān)注。比如,日本超尖端電子技術(shù)開發(fā)機構(gòu)(ASET)從1999年度起就在通過名為“超高密度電子SI”的研究項目推
2012-04-18 09:43:11 1757
1757 GlobalFoundries 已開始在紐約的 Fab 8 廠房中安裝硅穿孔(TSV)設(shè)備。如果一切順利,該公司希望在2013下半年開始採用 20nm 及 28nm 製程技術(shù)製造3D堆疊晶片。
2012-05-01 10:13:12 1435
1435 硅通孔技術(shù)(Through Silicon Via, TSV)技術(shù)是一項高密度封裝技術(shù),正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認為是第四代封裝技術(shù)。TSV技術(shù)通過銅、鎢、多晶硅等導電物質(zhì)
2016-10-12 18:30:27 18197
18197 
TSV互連結(jié)構(gòu)傳輸性能分析及故障建模研究_尚玉玲
2017-01-07 19:00:39 3
3 The TSV99x and TSV99xA family of single, dual, and quad operational amplifiers offers low voltage
2017-09-04 14:51:18 12
12 The TSV358, TSV358A, TSV324, and TSV324A (dual and quad) devices are low voltage versions of the LM358 and LM324 commodity operational amplifiers.
2017-09-05 09:12:30 6
6 The TSV6390, TSV6391, and their “A” versions are single operational amplifiers (op amps) offering
2017-09-05 09:34:14 4
4 The TSV52x and TSV52xA series of operational amplifiers offer low voltage operation and rail-torail
2017-09-05 09:52:58 5
5 The TSV630 and TSV631 devices are single operational amplifiers offering low voltage, low power operation, and rail-to-rail input and output.
2017-09-05 10:04:32 16
16 The TSV622, TSV622A, TSV623, TSV623A, TSV624, TSV624A, TSV625, and TSV625A dual and quad operational amplifiers offer low voltage
2017-09-05 10:58:25 4
4 The TSV620, TSV620A, TSV621, and TSV621A are single operational amplifiers offering low voltage, low power operation
2017-09-05 11:01:53 6
6 The TSV85x, TSV85xA series of single, dual, and quad operational amplifiers offer low voltage operation with a rail-to-rail output swing.
2017-09-25 10:42:09 11
11 硅通孔TSV發(fā)生開路故障和泄漏故障會降低三維集成電路的可靠性和良率,因此對綁定前的TSV測試尤為重要。現(xiàn)有CAFWAS測試方法對泄漏故障的測試優(yōu)于其他方法(環(huán)形振蕩器等),缺點是該方法不能測試
2017-11-22 10:56:29 17
17 要實現(xiàn)三維集成,需要用到幾個關(guān)鍵技術(shù),如硅通孔(TSV),晶圓減薄處理,以及晶圓/芯片鍵合。TSV 互連具有縮短路徑和更薄的封裝尺寸等優(yōu)點,被認為是三維集成的核心技術(shù)。
2017-11-24 16:23:48 66425
66425 
的填充,實現(xiàn)硅通孔的垂直電氣互連。硅通孔技術(shù)可以通過垂直互連減小互聯(lián)長度,減小信號延遲,降低電容/電感,實現(xiàn)芯片間的低功耗,高速通訊,增加寬帶和實現(xiàn)器件集成的小型化。基于TSV技術(shù)的3D封裝主要有以下幾個方面優(yōu)勢:
2018-08-14 15:39:10 92829
92829 電子發(fā)燒友網(wǎng)為你提供TI(ti)TSV914相關(guān)產(chǎn)品參數(shù)、數(shù)據(jù)手冊,更有TSV914的引腳圖、接線圖、封裝手冊、中文資料、英文資料,TSV914真值表,TSV914管腳等資料,希望可以幫助到廣大的電子工程師們。
2018-11-02 18:33:05

電子發(fā)燒友網(wǎng)為你提供TI(ti)TSV912相關(guān)產(chǎn)品參數(shù)、數(shù)據(jù)手冊,更有TSV912的引腳圖、接線圖、封裝手冊、中文資料、英文資料,TSV912真值表,TSV912管腳等資料,希望可以幫助到廣大的電子工程師們。
2018-11-02 18:33:05

從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來。
2019-08-14 11:18:42 4607
4607 
TSL2584TSV Block Diagram
2021-01-22 09:39:41 1
1 RoHS Certificate TSL2584TSV
2021-01-25 07:17:06 7
7 直通硅通孔(TSV)器件是3D芯片封裝的關(guān)鍵推動者,可提高封裝密度和器件性能。要實現(xiàn)3DIC對下一代器件的優(yōu)勢,TSV縮放至關(guān)重要。
2022-04-12 15:32:46 1788
1788 
硅通孔(Through Silicon Via,TSV)技術(shù)是一項高密度封裝技術(shù),它正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認為是第四代封裝技術(shù)。在2.5D/3D IC中TSV被大規(guī)模應用于
2022-05-31 15:24:39 3876
3876 本文介紹了采用芯和半導體ViaExpert軟件進行TSV陣列的建模和仿真分析流程。TSV結(jié)構(gòu)復雜,存在建模繁瑣、分析不便等問題。
2022-06-03 09:03:00 2631
2631 
onsemi TSV 封裝的 SiPM 傳感器的處理和焊接
2022-11-14 21:08:39 2
2 TSV 是目前半導體制造業(yè)中最為先進的技術(shù)之一,已經(jīng)應用于很多產(chǎn)品生產(chǎn)。實現(xiàn)其制程的關(guān)鍵設(shè)備選擇與工藝選擇息息相關(guān), 在某種程度上直接決定了 TSV 的性能優(yōu)劣。本文筆者在綜述 TSV 的工藝流程
2023-02-17 10:23:53 2864
2864 TSV 是目前半導體制造業(yè)中最為先進的技術(shù)之一,已經(jīng)應用于很多產(chǎn)品生產(chǎn)。實現(xiàn)其制程的關(guān)鍵設(shè)備選擇與工藝選擇息息相關(guān), 在某種程度上直接決定了 TSV 的性能優(yōu)劣。
2023-02-17 17:21:40 10514
10514 硅通孔(Through Si Vias,TSV)硅轉(zhuǎn)接基板技術(shù)作為先進封裝的一種工藝方式,是實現(xiàn)千級IO芯片高密度組裝的有效途徑,近年來在系統(tǒng)集成領(lǐng)域得到快速應用。
2023-06-16 16:11:33 1614
1614 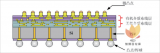
本文要點:3D集成電路需要一種方法來連接封裝中垂直堆疊的多個裸片由此,與制造工藝相匹配的硅通孔(Through-SiliconVias,TSV)設(shè)計應運而生硅通孔設(shè)計有助于實現(xiàn)更先進的封裝能力,可以
2022-11-17 17:58:04 2260
2260 
隨著三維集成技術(shù)的發(fā)展,如何將不同材料、結(jié)構(gòu)、工藝、功能的芯片器件實現(xiàn)一體化、多功能集成化是未來系統(tǒng)集成發(fā)展的重點。基于TSV、再布線(RDL)、微凸點(Micro Bump)、倒裝焊(FC)等關(guān)鍵工藝的硅轉(zhuǎn)接基板集成技術(shù)是將處理器、存儲器等多種芯片集成到同一個基板上,可提供高密度引腳的再分布。
2023-07-01 10:35:21 4499
4499 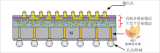
編者注:TSV是通過在芯片與芯片之間、晶圓和晶圓之間制作垂直導通;TSV技術(shù)通過銅、鎢、多晶硅等導電物質(zhì)的填充,實現(xiàn)硅通孔的垂直電氣互聯(lián),這項技術(shù)是目前唯一的垂直電互連技術(shù),是實現(xiàn)3D先進封裝的關(guān)鍵技術(shù)之一。
2023-07-03 09:45:34 5433
5433 
硅通孔(TSV)有望成為電子器件三維芯片堆疊技術(shù)的未來。TSV互連的結(jié)構(gòu)是通過首先在晶片表面蝕刻深過孔,然后用所需金屬填充這些過孔來形成的。目前,銅基TSV是最具成本效益的大規(guī)模生產(chǎn)TSV。一旦過孔
2023-08-30 17:19:11 1234
1234 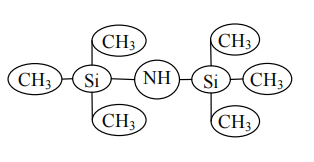
先進封裝中硅通孔(TSV)銅互連電鍍研究進展
2023-09-06 11:16:42 2280
2280 
文章轉(zhuǎn)自:屹立芯創(chuàng)公眾號 “TSV是能實現(xiàn)芯片內(nèi)部上下互聯(lián)的技術(shù),可以使多個芯片實現(xiàn)垂直且最短互聯(lián)”,AI算力帶動TSV由2.5D向3D深入推進,HBM異軍突起,前道大廠憑借積淀的制造優(yōu)勢繼續(xù)壟斷并
2023-11-09 13:41:21 7320
7320 
3D-IC 中 硅通孔TSV 的設(shè)計與制造
2023-11-30 15:27:28 2237
2237 
三星電子和sk海力士用于tsv蝕刻的設(shè)備都是Syndion。synthion是典型的深硅蝕刻設(shè)備,深度蝕刻到晶片內(nèi)部,用于tsv和溝槽等的高度和寬度比的形成。泛林集團 sabre 3d將用于用銅填充蝕刻的晶圓孔來制作線路的tsv線路。
2023-11-30 10:15:57 1742
1742 共讀好書 田苗,劉民,林子涵,付學成,程秀蘭,吳林晟 (上海交通大學 a.電子信息與電氣工程學院先進電子材料與器件平臺;b.射頻異質(zhì)異構(gòu)集成全國重點實驗室) 摘要: 以硅通孔(TSV)為核心
2024-02-25 17:19:00 1957
1957 
先進封裝是芯片設(shè)計的必由之路。TSV則是必由之路上的服務(wù)站。世界上各個主要的IC廠商包括設(shè)計、晶圓、封測廠商,開發(fā)了一大批專利技術(shù),使用TSV達成各種復雜的三維芯片的高性能堆疊結(jié)構(gòu)。
2024-02-25 09:58:58 2480
2480 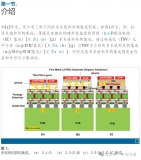
共讀好書 魏紅軍 段晉勝 (中國電子科技集團公司第二研究所) 摘要: 論述了 TSV 技術(shù)發(fā)展面臨的設(shè)備問題,并重點介紹了深硅刻蝕、 CVD/PVD 沉積、電鍍銅填充、晶圓減薄、晶圓鍵合等幾種制約
2024-03-12 08:43:59 2370
2370 
TSV(Through-Silicon Via)是一種先進的三維集成電路封裝技術(shù)。它通過在芯片上穿孔并填充導電材料,實現(xiàn)芯片內(nèi)、芯片間以及芯片與封裝之間的垂直連接。
2024-04-11 16:36:36 9819
9819 
上圖是TSV工藝的一般流程。TSV,全名Through-Silicon Via,又叫硅通孔工藝。
2024-04-17 09:37:56 4129
4129 
注入導電物質(zhì),將相同類別芯片或不同類別的芯片進行互連,達到芯片級集成的先進封裝技術(shù)。 TSV技術(shù)中的這個通道中主要是通過銅等導電物質(zhì)的填充完成硅通孔的垂直電氣互連,減小信號延遲,降低電容、電感,實現(xiàn)芯片的低功耗、高速通信,增加帶寬和實現(xiàn)器件集成的小型化需求
2024-12-17 14:17:51 3345
3345 
TSV 三維封裝技術(shù)特點鮮明、性能好、前景廣闊, 是未來發(fā)展方向,但是 TSV 堆疊芯片這種結(jié)構(gòu)和工 藝復雜性的提高,為三維封裝的可靠性控制帶來了 挑戰(zhàn)。主要體現(xiàn)在以下 4 個方面 :(1) TSV
2024-12-30 17:37:06 2629
2629 高性能計算機中日益廣泛采用“處理器+存儲器”體系架構(gòu),近兩年來Intel、AMD、 Nvidia都相繼推出了基于該構(gòu)架的計算處理單元產(chǎn)品,將多個存儲器與處理器集成在一個TSV硅轉(zhuǎn)接基板上,以提高計算
2025-01-27 10:13:00 3792
3792 
Hello,大家好,我們來分享下先進封裝中TSV需要的相關(guān)設(shè)備。
2025-02-19 16:39:24 1946
1946 
在現(xiàn)代半導體封裝技術(shù)不斷邁向高性能、小型化與多功能異構(gòu)集成的背景下,硅通孔(TSV,Through-SiliconVia)工藝作為實現(xiàn)芯片垂直互連與三維集成(3DIC)的核心技術(shù),正日益成為先進封裝
2025-04-17 08:21:29 2509
2509 
日月光半導體最新推出FOCoS-Bridge TSV技術(shù),利用硅通孔提供更短供電路徑,實現(xiàn)更高 I/O 密度與更好散熱性能,滿足AI/HPC對高帶寬與高效能的需求。
2025-05-30 15:30:42 1120
1120 TGV(Through Glass Via)和TSV(Through Silicon Via)是兩種用于實現(xiàn)不同層面之間電氣連接的技術(shù)。
2025-06-16 15:52:23 1609
1609 
在半導體三維集成(3D IC)技術(shù)中,硅通孔(TSV)是實現(xiàn)芯片垂直堆疊的核心,但受深寬比限制,傳統(tǒng)厚硅片(700-800μm)難以制造直徑更小(5-20μm)的TSV,導致芯片面積占比過高,且多層堆疊后總厚度可能達毫米級,與智能手機等應用對芯片厚度的嚴苛限制(通常<1mm)沖突。
2025-07-29 16:48:59 1369
1369 
在TSV制造技術(shù)中,既包含TSV制造技術(shù)中通孔刻蝕與絕緣層的相關(guān)內(nèi)容。
2025-08-01 09:24:23 1782
1782 
技術(shù)區(qū)別TSV硅通孔(ThroughSiliconVia),指連接硅晶圓兩面并與硅襯底和其他通孔絕緣的電互連結(jié)構(gòu)。硅中介層有TSV的集成是最常見的一種2.5D集成技術(shù),芯片通常通過MicroBump
2025-10-11 16:39:24 747
747 
STMicroelectronics TSV771、TSV772和TSV774是單通道、雙通道和四通道20MHz帶寬單位增益穩(wěn)定放大器。TSV771、TSV772和TSV774具有軌到軌輸入級
2025-10-25 17:36:33 1448
1448 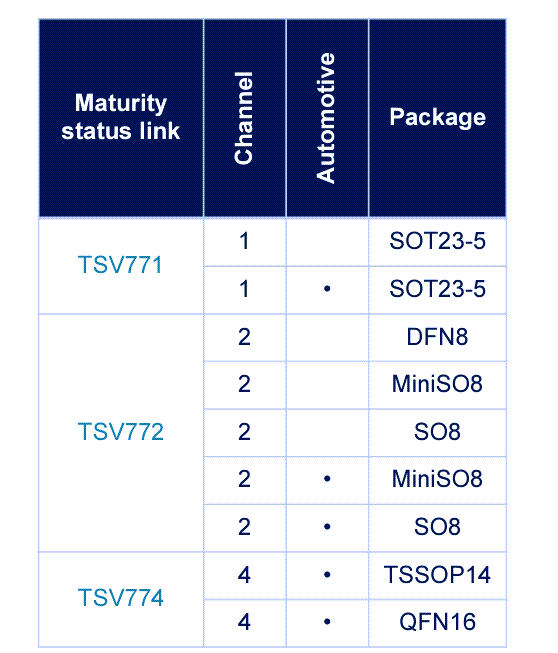
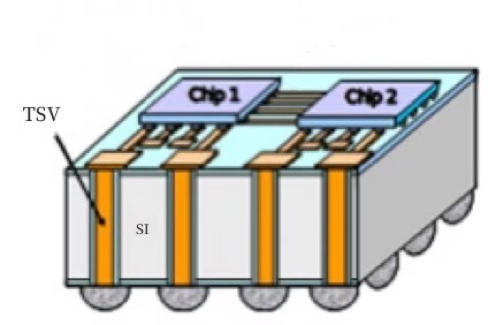

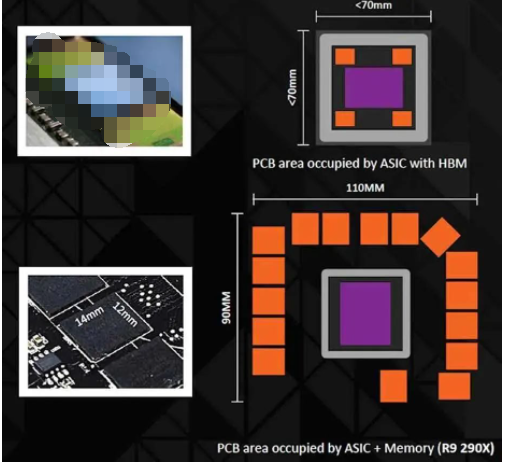
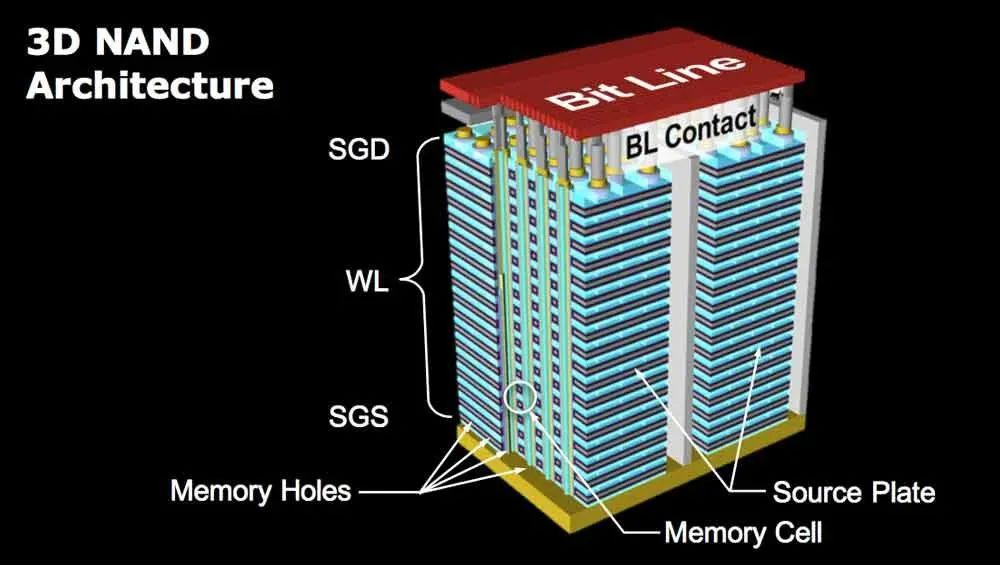
 電子發(fā)燒友App
電子發(fā)燒友App






























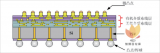

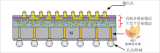

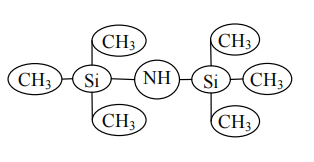




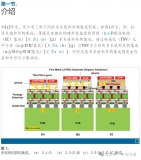











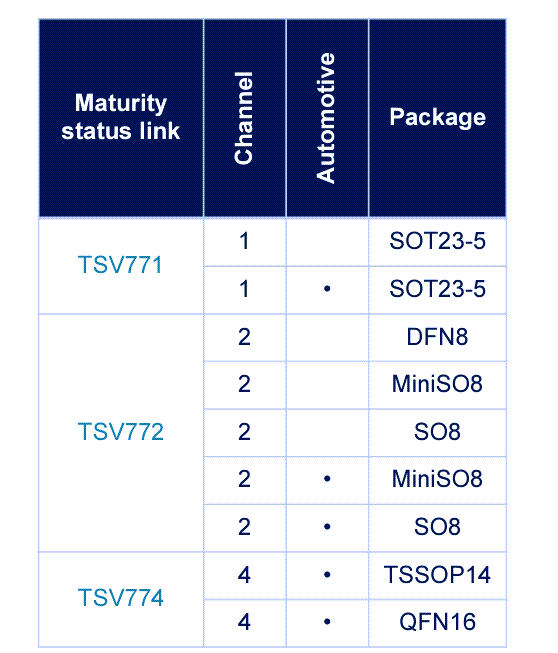



評論