2.5D/3D封裝技術(shù)作為當(dāng)前前沿的先進封裝工藝,實現(xiàn)方案豐富多樣,會根據(jù)不同應(yīng)用需求和技術(shù)發(fā)展動態(tài)調(diào)整,涵蓋芯片減薄、芯片鍵合、引線鍵合、倒裝鍵合、TSV、塑封、基板、引線框架、載帶、晶圓級薄膜
2025-08-05 15:03:08 2814
2814 
本文主要講述TSV工藝中的硅晶圓減薄與銅平坦化。 硅晶圓減薄與銅平坦化作為 TSV 三維集成技術(shù)的核心環(huán)節(jié),主要應(yīng)用于含銅 TSV 互連的減薄芯片制造流程,為該技術(shù)實現(xiàn)短互連長度、小尺寸、高集成度等特性提供了重要支撐。
2025-08-12 10:35:00 1545
1545 
TSV技術(shù)應(yīng)用即將遍地開花。隨著各大半導(dǎo)體廠商陸續(xù)將TSV立體堆疊納入技術(shù)藍圖,TSV應(yīng)用市場正加速起飛,包括影像感應(yīng)器、功率放大器和處理器等元件,皆已開始采用;2013年以后,3D TSV技術(shù)更將由8寸晶圓逐漸邁向12寸晶圓應(yīng)用。
2013-01-27 10:25:00 3943
3943 本文介紹了一種新型的高縱橫比TSV電鍍添加劑系統(tǒng),利用深層反應(yīng)離子蝕刻(DRIE)技術(shù)對晶片形成圖案,并利用物理氣相沉積(PVD)技術(shù)沉積種子層。通過陽極位置優(yōu)化、多步驟TSV填充過程、添加劑濃度
2021-12-27 16:00:41 3170
3170 
)技術(shù)的芯片間互連成為一種極具吸引力的潛在解決方案,可實現(xiàn)更高的性能和更低的制造成本。穿過硅芯片的垂直電互連可以縮短芯片間互連的長度,并實現(xiàn)更緊湊的CPI互連結(jié)構(gòu)。在TSV制造中,硅中具有受控側(cè)壁輪廓的高深寬比結(jié)構(gòu)對于納米和微米尺
2022-06-15 17:22:22 5508
5508 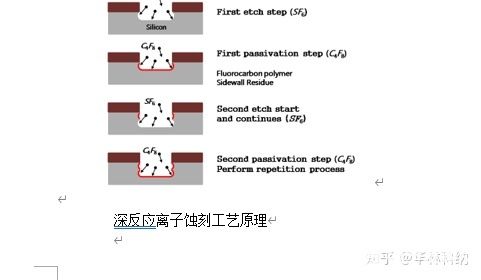
本文報道了TSV過程的細節(jié)。還顯示了可以在8-in上均勻地形成許多小的tsv(直徑:6 m,深度:22 m)。通過這種TSV工藝的晶片。我們?nèi)A林科納研究了TSV的電學(xué)特性,結(jié)果表明TSV具有低電阻和低電容;小的TSV-硅漏電流和大約83%的高TSV產(chǎn)率。
2022-06-16 14:02:43 4102
4102 
主要的技術(shù)路徑。2.5D/3D封裝正在加速3D互連密度的技術(shù)突破,TSV及TGV的技術(shù)作為2.5D/3D封裝的核心技術(shù),越來越受到重視。
2023-05-23 12:29:11 5750
5750 
來源:半導(dǎo)體風(fēng)向標 從HBM存儲器到3D NAND芯片,再到CoWoS,硬件市場上有許多芯片是用英文稱為TSV構(gòu)建的,TSV是首字母縮寫,意為“通過硅通孔”并翻譯為via硅的事實,它們垂直地穿過
2023-07-26 10:06:15 2219
2219 硅通孔技術(shù)(TSV,Through Silicon Via)是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實現(xiàn)芯片之間互連的技術(shù),是2.5D/3D 封裝的關(guān)鍵工藝之一。通過垂直互連減小互連長度、信號延遲,降低電容、電感,實現(xiàn)芯片間低功耗、高速通訊,增加帶寬和實現(xiàn)小型化。
2024-01-09 09:44:13 23017
23017 
以硅通孔(TSV)為核心的 2.5D/3D 封裝技術(shù)可以實現(xiàn)芯片之間的高速、低功耗和高帶寬的信號傳輸。
2024-02-25 16:51:10 2811
2811 
3D-IC通過采用TSV(Through-Silicon Via,硅通孔)技術(shù),實現(xiàn)了不同層芯片之間的垂直互連。這種設(shè)計顯著提升了系統(tǒng)集成度,同時有效地縮短了互連線的長度。這樣的改進不僅降低了信號傳輸?shù)难訒r,還減少了功耗,從而全面提升了系統(tǒng)的整體性能。
2025-02-21 15:57:02 2460
2460 
硅通孔(Through Silicon Via,TSV)技術(shù)是一種通過在硅介質(zhì)層中制作垂直導(dǎo)通孔并填充導(dǎo)電材料來實現(xiàn)芯片間垂直互連的先進封裝技術(shù)。
2025-10-13 10:41:46 3147
3147 
泛林集團 (Nasdaq:LRCX) 宣布推出一款全新的工藝方案——先進的Striker? FE平臺——用于制造高深寬比的芯片架構(gòu)。S
2020-09-23 11:50:10 1012
1012 電子發(fā)燒友網(wǎng)報道(文/黃山明)TSV(Through Silicon Via)即硅通孔技術(shù),是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實現(xiàn)芯片之間互連的技術(shù),是2.5D/3D封裝的關(guān)鍵
2025-04-14 01:15:00 2555
2555 TSV911AIDCKR
2023-03-28 13:13:59
,從而支持每次充電能續(xù)航更遠的里程。車載充電器(OBC)和牽引逆變器現(xiàn)在正使用寬禁帶(WBG)產(chǎn)品來實現(xiàn)這一目標。碳化硅(SiC)和氮化鎵(GaN)是寬禁帶材料,提供下一代功率器件的基礎(chǔ)。與硅相比
2018-10-30 08:57:22
Hi6000A在LED照明驅(qū)動設(shè)計中,外圍電路復(fù)雜度、恒流精度與調(diào)光性能是工程師核心關(guān)注要點。Hi6000A 作為一款寬調(diào)光比升壓調(diào)光恒流驅(qū)動器,以簡潔設(shè)計與卓越性能,為 3-40V 輸入電壓范圍
2025-10-29 18:13:34
MICROFJ-60035-TSV-TR
2023-04-06 23:31:03
規(guī)范內(nèi)容和一些高深的設(shè)計失誤。希望pcb電路設(shè)計者們通過不斷的學(xué)習(xí)和經(jīng)驗積累,能夠在一次次的電路設(shè)計中不斷提升,達到優(yōu)良的電路性能和散熱性能,有效的節(jié)約生產(chǎn)成本。PCB技術(shù)規(guī)范內(nèi)容:1、PCB布線與布局PCB布線與布局隔離準則:強弱電流隔離、大小電壓隔離,高低頻率隔離、輸入輸出隔離、數(shù)..
2021-06-30 06:44:33
`我想請問一下PWM技術(shù)中的調(diào)制比是什么啊?有點搞不懂謝謝辣。。`
2015-12-31 16:52:30
,從而支持每次充電能續(xù)航更遠的里程。車載充電器(OBC)和牽引逆變器現(xiàn)在正使用寬禁帶(WBG)產(chǎn)品來實現(xiàn)這一目標。那么具體什么是寬禁帶技術(shù)呢?
2019-07-31 07:42:54
LED 照明的許多應(yīng)用都需要寬調(diào)光比。這可簡單地通過一個如下所示的可調(diào)型電流源來實現(xiàn)。可采用多種不同的方法來改變該電流源,而且能實現(xiàn)一個大的 LED 電流范圍。
2019-10-12 07:12:07
110°C。 寬爬電距離光耦越來越受設(shè)計者所青睞,各方面參數(shù)標準都優(yōu)于其他性體管輸出光耦,體積比傳統(tǒng)的817,521要小,比TLP185,TLP181,PS2701,PC357這些要窄,厚度也非常薄
2017-06-09 17:29:19
普通學(xué)生一枚,專業(yè)課老師讓分組幾個人找一個已有的電路,然后對電路進行計算,然后仿真出結(jié)果,但是我不知道該怎么計算這個電路中各個管子的寬長比,還請各位大神指點一二,十分感謝
2016-05-07 14:03:24
在節(jié)能減排、小型化、輕量化的全球發(fā)展趨勢中,電動助力轉(zhuǎn)向系統(tǒng)(簡稱EPS)的應(yīng)用正逐漸成為汽車轉(zhuǎn)向系統(tǒng)技術(shù)的主流,特別是在新能源和電驅(qū)動乘用車領(lǐng)域。EPS 能夠根據(jù)汽車方向盤轉(zhuǎn)矩、方向盤轉(zhuǎn)角、車速和路面狀況等,為駕駛員提供轉(zhuǎn)向助力,使轉(zhuǎn)向更加輕松柔和...
2021-06-30 07:50:34
電動助力轉(zhuǎn)向系統(tǒng)EPS(electricpowersteering)是一種直接依靠電機提供輔助扭矩的動力轉(zhuǎn)向系統(tǒng),與傳統(tǒng)的液壓助力轉(zhuǎn)向系統(tǒng)HPS(hydraulicpowersteering)相比
2019-10-16 06:16:06
前言近年來,隨著電子技術(shù)的發(fā)展和節(jié)能、環(huán)保兩大主題的推廣,電動助力轉(zhuǎn)向系統(tǒng)(EPS)以其優(yōu)越性能表現(xiàn)得到業(yè)界的廣泛關(guān)注,逐漸成為世界汽車技術(shù)發(fā)展的重點和熱點之一。目前電動助力轉(zhuǎn)向系統(tǒng)在輕型載貨汽車
2020-07-29 06:06:38
硅通孔(TSV)電鍍的高可靠性是高密度集成電路封裝應(yīng)用中的一個有吸引力的熱點。本文介紹了通過優(yōu)化濺射和電鍍條件對完全填充TSV的改進。特別注意具有不同種子層結(jié)構(gòu)的樣品。這些樣品是通過不同的濺射和處理
2021-01-09 10:19:52
我司做汽車電子,尋求電子方面的高深技術(shù)人才兼顧我司部分開發(fā),有時間、有能力請與我聯(lián)絡(luò)。QQ705581757
2015-01-28 13:32:55
你有TSV6390AIDT和/或TSV6290AIDT的SPICE型號嗎? 謝謝, 何魯麗 #運算放大器,香料宏模型
2019-08-06 14:07:54
當(dāng)前,蜂窩移動通信系統(tǒng)發(fā)展到第三代,3G系統(tǒng)進入商業(yè)運行一方面需要解決不同標準系統(tǒng)間的兼容性;另一方面為了適應(yīng)技術(shù)的發(fā)展,3G系統(tǒng)要求具有高度的靈活性和擴展升級能力。軟件無線電技術(shù)無疑是最好
2019-05-28 06:16:05
STMicroelectronics 運算放大器 TSV912AIDT 雙 高速、精密, 8MHz增益帶寬積
2022-05-31 10:04:31
醫(yī)用滌綸表面殼聚糖化學(xué)接枝法制備及細菌粘附研究: 摘 要:通過化學(xué)方法構(gòu)建了殼聚糖長鏈分子接枝的滌綸表面,并研究了其細菌粘附性質(zhì)。XPS 全譜顯示接枝表
2009-04-28 23:35:31 15
15 電調(diào)脈寬的單穩(wěn)態(tài)電路圖
2009-06-26 13:14:04 940
940 
重點討論了垂直互連的硅通孔(TSV)互連工藝的關(guān)鍵技術(shù)及其加工設(shè)備面臨的挑戰(zhàn).提出了工藝和設(shè)備開發(fā)商的應(yīng)對措施并探討了3DTSV封裝技術(shù)的應(yīng)用前景。
2011-12-07 10:59:23 89
89 對3D封裝技術(shù)結(jié)構(gòu)特點、主流多層基板技術(shù)分類及其常見鍵合技術(shù)的發(fā)展作了論述,對過去幾年國際上硅通孔( TSV)技術(shù)發(fā)展動態(tài)給與了重點的關(guān)注。尤其就硅通孔關(guān)鍵工藝技術(shù)如硅片減薄
2011-12-07 11:00:52 153
153 2011年,半導(dǎo)體封裝業(yè)界的熱門話題是采用TSV(硅通孔)的三維封裝技術(shù)。雖然TSV技術(shù)此前已在CMOS圖像傳感器等產(chǎn)品上實用化,但始終未在存儲器及邏輯LSI等用途中普及。最近,存儲器及邏
2011-12-23 09:34:58 5386
5386 TSV3DIC技術(shù)雖早于2002年由IBM所提出,然而,在前后段IC制造技術(shù)水準皆尚未成熟情況下,TSV3DIC技術(shù)發(fā)展速度可說是相當(dāng)緩慢,DIGITIMESResearch分析師柴煥欣分析,直至2007年東芝(Toshiba)將
2012-02-21 08:45:37 1856
1856 在日本,硅通孔(TSV:Through Silicon Via)技術(shù)從10多年前開始就備受業(yè)界關(guān)注。比如,日本超尖端電子技術(shù)開發(fā)機構(gòu)(ASET)從1999年度起就在通過名為“超高密度電子SI”的研究項目推
2012-04-18 09:43:11 1757
1757 聯(lián)華電子與新加坡科技研究局旗下的微電子研究院宣布,將合作進行應(yīng)用在背面照度式CMOS影像感測器的TSV技術(shù)開發(fā),透過這項技術(shù),包括智慧手機、數(shù)位相機與個人平板電腦等行動
2012-06-07 09:26:21 1383
1383 聯(lián)電矽穿孔(TSV)制程將于2013年出爐。為爭食2.5D/三維晶片(3D IC)商機大餅,聯(lián)電加緊研發(fā)邏輯與記憶體晶片立體堆疊技術(shù),將采Via-Middle方式,在晶圓完成后旋即穿孔,再交由封測廠
2012-09-12 09:41:32 1034
1034 硅通孔技術(shù)(Through Silicon Via, TSV)技術(shù)是一項高密度封裝技術(shù),正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認為是第四代封裝技術(shù)。TSV技術(shù)通過銅、鎢、多晶硅等導(dǎo)電物質(zhì)
2016-10-12 18:30:27 18197
18197 
TSV互連結(jié)構(gòu)傳輸性能分析及故障建模研究_尚玉玲
2017-01-07 19:00:39 3
3 The TSV99x and TSV99xA family of single, dual, and quad operational amplifiers offers low voltage
2017-09-04 14:51:18 12
12 The TSV358, TSV358A, TSV324, and TSV324A (dual and quad) devices are low voltage versions of the LM358 and LM324 commodity operational amplifiers.
2017-09-05 09:12:30 6
6 The TSV6390, TSV6391, and their “A” versions are single operational amplifiers (op amps) offering
2017-09-05 09:34:14 4
4 The TSV52x and TSV52xA series of operational amplifiers offer low voltage operation and rail-torail
2017-09-05 09:52:58 5
5 The TSV630 and TSV631 devices are single operational amplifiers offering low voltage, low power operation, and rail-to-rail input and output.
2017-09-05 10:04:32 16
16 The TSV622, TSV622A, TSV623, TSV623A, TSV624, TSV624A, TSV625, and TSV625A dual and quad operational amplifiers offer low voltage
2017-09-05 10:58:25 4
4 The TSV620, TSV620A, TSV621, and TSV621A are single operational amplifiers offering low voltage, low power operation
2017-09-05 11:01:53 6
6 The TSV85x, TSV85xA series of single, dual, and quad operational amplifiers offer low voltage operation with a rail-to-rail output swing.
2017-09-25 10:42:09 11
11 要實現(xiàn)三維集成,需要用到幾個關(guān)鍵技術(shù),如硅通孔(TSV),晶圓減薄處理,以及晶圓/芯片鍵合。TSV 互連具有縮短路徑和更薄的封裝尺寸等優(yōu)點,被認為是三維集成的核心技術(shù)。
2017-11-24 16:23:48 66425
66425 
然而對于微尺度結(jié)構(gòu)的加工,尤其是高深寬比結(jié)構(gòu)的填充,注塑成型通常做的不如熱壓成型填充率高,對于微結(jié)構(gòu)的填充最有效的辦法是使用變模溫注塑技術(shù),即在一個循環(huán)周期內(nèi)將模具溫度實現(xiàn)高低溫切換,實現(xiàn)填充效果的優(yōu)化。
2018-05-07 11:49:02 8287
8287 硅通孔技術(shù)(Through Silicon Via, TSV)技術(shù)是一項高密度封裝技術(shù),正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認為是第四代封裝技術(shù)。TSV技術(shù)通過銅、鎢、多晶硅等導(dǎo)電物質(zhì)
2018-08-14 15:39:10 92829
92829 電子發(fā)燒友網(wǎng)為你提供TI(ti)TSV914相關(guān)產(chǎn)品參數(shù)、數(shù)據(jù)手冊,更有TSV914的引腳圖、接線圖、封裝手冊、中文資料、英文資料,TSV914真值表,TSV914管腳等資料,希望可以幫助到廣大的電子工程師們。
2018-11-02 18:33:05

從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來。
2019-08-14 11:18:42 4607
4607 
盛美半導(dǎo)體設(shè)備(NASDAQ:ACMR),作為半導(dǎo)體制造與先進晶圓級封裝領(lǐng)域中領(lǐng)先的設(shè)備供應(yīng)商,近日發(fā)布了應(yīng)用于填充3D硅通孔(TSV)的硅通孔電鍍設(shè)備Ultra ECP 3d。借助盛美半導(dǎo)體電鍍設(shè)備的平臺,該設(shè)備可為高深寬比(H.A.R)銅應(yīng)用提供高性能、無孔洞的鍍銅功能。
2020-11-26 11:30:45 4171
4171 TSL2584TSV Block Diagram
2021-01-22 09:39:41 1
1 直通硅通孔(TSV)器件是3D芯片封裝的關(guān)鍵推動者,可提高封裝密度和器件性能。要實現(xiàn)3DIC對下一代器件的優(yōu)勢,TSV縮放至關(guān)重要。
2022-04-12 15:32:46 1788
1788 
本文介紹了我們?nèi)A林科納半導(dǎo)體將空間交替相移(SAPS)兆頻超聲波技術(shù)應(yīng)用于TSV晶片的刻蝕后清洗工藝,SAPS技術(shù)通過在兆頻超聲波裝置和晶片之間的間隙中改變兆頻超聲波的相位,在整個晶片的每個點上提供
2022-05-26 15:07:03 1403
1403 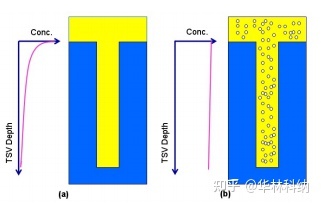
硅通孔(Through Silicon Via,TSV)技術(shù)是一項高密度封裝技術(shù),它正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認為是第四代封裝技術(shù)。在2.5D/3D IC中TSV被大規(guī)模應(yīng)用于
2022-05-31 15:24:39 3876
3876 本文介紹了采用芯和半導(dǎo)體ViaExpert軟件進行TSV陣列的建模和仿真分析流程。TSV結(jié)構(gòu)復(fù)雜,存在建模繁瑣、分析不便等問題。
2022-06-03 09:03:00 2631
2631 
onsemi TSV 封裝的 SiPM 傳感器的處理和焊接
2022-11-14 21:08:39 2
2 TSV 是目前半導(dǎo)體制造業(yè)中最為先進的技術(shù)之一,已經(jīng)應(yīng)用于很多產(chǎn)品生產(chǎn)。實現(xiàn)其制程的關(guān)鍵設(shè)備選擇與工藝選擇息息相關(guān), 在某種程度上直接決定了 TSV 的性能優(yōu)劣。本文筆者在綜述 TSV 的工藝流程
2023-02-17 10:23:53 2863
2863 TSV 是目前半導(dǎo)體制造業(yè)中最為先進的技術(shù)之一,已經(jīng)應(yīng)用于很多產(chǎn)品生產(chǎn)。實現(xiàn)其制程的關(guān)鍵設(shè)備選擇與工藝選擇息息相關(guān), 在某種程度上直接決定了 TSV 的性能優(yōu)劣。
2023-02-17 17:21:40 10514
10514 編者注:TSV是通過在芯片與芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通;TSV技術(shù)通過銅、鎢、多晶硅等導(dǎo)電物質(zhì)的填充,實現(xiàn)硅通孔的垂直電氣互聯(lián),這項技術(shù)是目前唯一的垂直電互連技術(shù),是實現(xiàn)3D先進封裝的關(guān)鍵技術(shù)之一。
2023-07-03 09:45:34 5432
5432 
的溝道長度、金屬互聯(lián)線的寬度等。隨著高密度集成電路特征尺寸的不斷減小,對于高深寬比的間隙進行均勻、無空洞,填充淀積工藝顯得至關(guān)重要。
2023-07-14 16:31:31 4012
4012 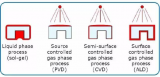
TSV不僅賦予了芯片縱向維度的集成能力,而且它具有最短的電傳輸路徑以及優(yōu)異的抗干擾性能。隨著摩爾定律慢慢走到盡頭,半導(dǎo)體器件的微型化也越來越依賴于集成TSV的先進封裝。
2023-07-25 10:09:36 1496
1496 
文章轉(zhuǎn)自:屹立芯創(chuàng)公眾號 “TSV是能實現(xiàn)芯片內(nèi)部上下互聯(lián)的技術(shù),可以使多個芯片實現(xiàn)垂直且最短互聯(lián)”,AI算力帶動TSV由2.5D向3D深入推進,HBM異軍突起,前道大廠憑借積淀的制造優(yōu)勢繼續(xù)壟斷并
2023-11-09 13:41:21 7320
7320 
3D-IC 中 硅通孔TSV 的設(shè)計與制造
2023-11-30 15:27:28 2237
2237 
三星電子和sk海力士用于tsv蝕刻的設(shè)備都是Syndion。synthion是典型的深硅蝕刻設(shè)備,深度蝕刻到晶片內(nèi)部,用于tsv和溝槽等的高度和寬度比的形成。泛林集團 sabre 3d將用于用銅填充蝕刻的晶圓孔來制作線路的tsv線路。
2023-11-30 10:15:57 1742
1742 先進封裝是芯片設(shè)計的必由之路。TSV則是必由之路上的服務(wù)站。世界上各個主要的IC廠商包括設(shè)計、晶圓、封測廠商,開發(fā)了一大批專利技術(shù),使用TSV達成各種復(fù)雜的三維芯片的高性能堆疊結(jié)構(gòu)。
2024-02-25 09:58:58 2480
2480 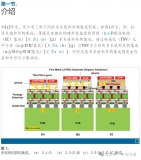
共讀好書 魏紅軍 段晉勝 (中國電子科技集團公司第二研究所) 摘要: 論述了 TSV 技術(shù)發(fā)展面臨的設(shè)備問題,并重點介紹了深硅刻蝕、 CVD/PVD 沉積、電鍍銅填充、晶圓減薄、晶圓鍵合等幾種制約
2024-03-12 08:43:59 2370
2370 
TSV(Through-Silicon Via)是一種先進的三維集成電路封裝技術(shù)。它通過在芯片上穿孔并填充導(dǎo)電材料,實現(xiàn)芯片內(nèi)、芯片間以及芯片與封裝之間的垂直連接。
2024-04-11 16:36:36 9819
9819 
上圖是TSV工藝的一般流程。TSV,全名Through-Silicon Via,又叫硅通孔工藝。
2024-04-17 09:37:56 4129
4129 
驗證。 超高深寬比溝槽填充CVD設(shè)備可以在晶圓表面沉積高品質(zhì)的介電薄膜材料,經(jīng)過固化及氧化等處理工藝后,可達到完全填充間隙而不會留下孔洞和縫隙的效果。拓荊科技稱,目前與超高深寬比溝槽填充CVD設(shè)備相關(guān)的反應(yīng)腔累計出貨超過
2024-09-25 11:19:41 1103
1103 的使用周期管理和回收問題逐漸凸顯,成為制約行業(yè)可持續(xù)發(fā)展的重要課題。株式會社電裝(以下簡稱電裝)針對這一挑戰(zhàn),開發(fā)了“SOH(State of Health電池診斷技術(shù),簡稱SOH)”,為電池的循環(huán)利用提供新的助力。
2024-12-05 14:22:33 762
762 得到的高深寬比硅通孔深度100μm,頂部底部尺寸分別為10μm和6μm,而不會造成任何旁瓣損傷。通過進一步優(yōu)化平面錐鏡的設(shè)計,可以解決定制貝塞爾光束制造速度的問題,實現(xiàn)更快、更高分辨率和更精確的TSV制造。 三維集成電路(3D IC)是傳統(tǒng)二維集成電路
2024-12-09 16:52:01 2000
2000 
Hello,大家好,今天我們來分享下什么是先進封裝中的TSV/硅通孔技術(shù)。 TSV:Through Silicon Via, 硅通孔技術(shù)。指的是在晶圓的硅部分形成一個垂直的通道,利用這個垂直的通道
2024-12-17 14:17:51 3345
3345 
TSV 三維封裝技術(shù)特點鮮明、性能好、前景廣闊, 是未來發(fā)展方向,但是 TSV 堆疊芯片這種結(jié)構(gòu)和工 藝復(fù)雜性的提高,為三維封裝的可靠性控制帶來了 挑戰(zhàn)。主要體現(xiàn)在以下 4 個方面 :(1) TSV
2024-12-30 17:37:06 2629
2629 ,HBM)依靠在臺積電的28nm工藝節(jié)點制造的GPU芯片兩側(cè),TSV硅轉(zhuǎn)接基板采用UMC的65nm工藝,尺寸28mm×35mm。
2025-01-27 10:13:00 3792
3792 
在現(xiàn)代半導(dǎo)體封裝技術(shù)不斷邁向高性能、小型化與多功能異構(gòu)集成的背景下,硅通孔(TSV,Through-SiliconVia)工藝作為實現(xiàn)芯片垂直互連與三維集成(3DIC)的核心技術(shù),正日益成為先進封裝
2025-04-17 08:21:29 2508
2508 
日月光半導(dǎo)體最新推出FOCoS-Bridge TSV技術(shù),利用硅通孔提供更短供電路徑,實現(xiàn)更高 I/O 密度與更好散熱性能,滿足AI/HPC對高帶寬與高效能的需求。
2025-05-30 15:30:42 1120
1120 TGV(Through Glass Via)和TSV(Through Silicon Via)是兩種用于實現(xiàn)不同層面之間電氣連接的技術(shù)。
2025-06-16 15:52:23 1606
1606 
在半導(dǎo)體三維集成(3D IC)技術(shù)中,硅通孔(TSV)是實現(xiàn)芯片垂直堆疊的核心,但受深寬比限制,傳統(tǒng)厚硅片(700-800μm)難以制造直徑更小(5-20μm)的TSV,導(dǎo)致芯片面積占比過高,且多層堆疊后總厚度可能達毫米級,與智能手機等應(yīng)用對芯片厚度的嚴苛限制(通常<1mm)沖突。
2025-07-29 16:48:59 1367
1367 
相較于傳統(tǒng)CMOS工藝,TSV需應(yīng)對高深寬比結(jié)構(gòu)帶來的技術(shù)挑戰(zhàn),從激光或深層離子反應(yīng)刻蝕形成盲孔開始,經(jīng)等離子體化學(xué)氣相沉積絕緣層、金屬黏附/阻擋/種子層的多層沉積,到銅電鍍填充及改進型化學(xué)機械拋光(CMP)處理厚銅層,每一步均需對既有設(shè)備與材料進行適應(yīng)性革新,最終構(gòu)成三維集成的主要工藝成本來源。
2025-08-01 09:13:51 1976
1976 在TSV制造技術(shù)中,既包含TSV制造技術(shù)中通孔刻蝕與絕緣層的相關(guān)內(nèi)容。
2025-08-01 09:24:23 1781
1781 
技術(shù)區(qū)別TSV硅通孔(ThroughSiliconVia),指連接硅晶圓兩面并與硅襯底和其他通孔絕緣的電互連結(jié)構(gòu)。硅中介層有TSV的集成是最常見的一種2.5D集成技術(shù),芯片通常通過MicroBump
2025-10-11 16:39:24 746
746 
STMicroelectronics TSV771、TSV772和TSV774是單通道、雙通道和四通道20MHz帶寬單位增益穩(wěn)定放大器。TSV771、TSV772和TSV774具有軌到軌輸入級
2025-10-25 17:36:33 1448
1448 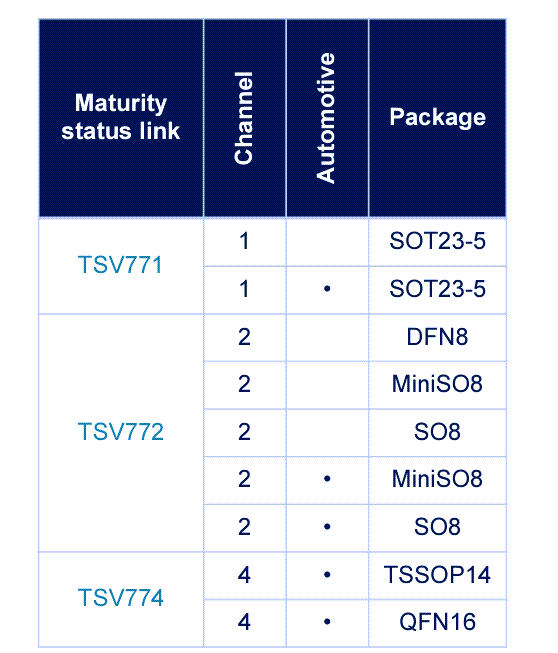
電流測量,采用單電源供電,工作電壓范圍為 2.0 V 至 5.5 V。該器件的額定負載為47pF,可輕松用作模數(shù)轉(zhuǎn)換器的輸入緩沖器。TSV78x系列具有軌到軌輸入和輸出、出色的速度/功耗比以及30MHz增益帶寬積,在5V時僅消耗3.3mA電流。
2025-10-29 10:01:03 278
278 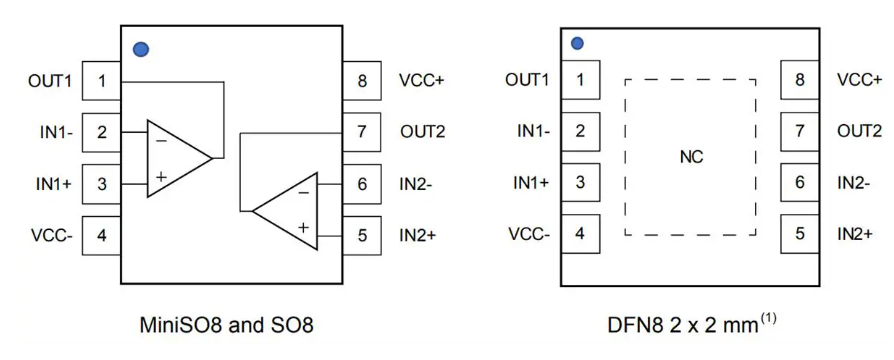





 電子發(fā)燒友App
電子發(fā)燒友App












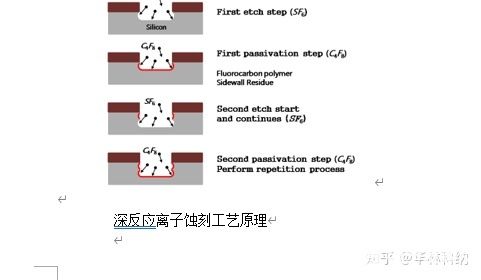




















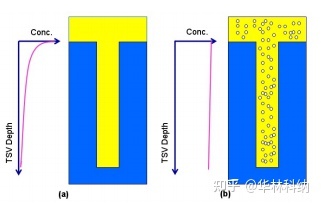


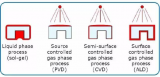



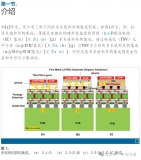











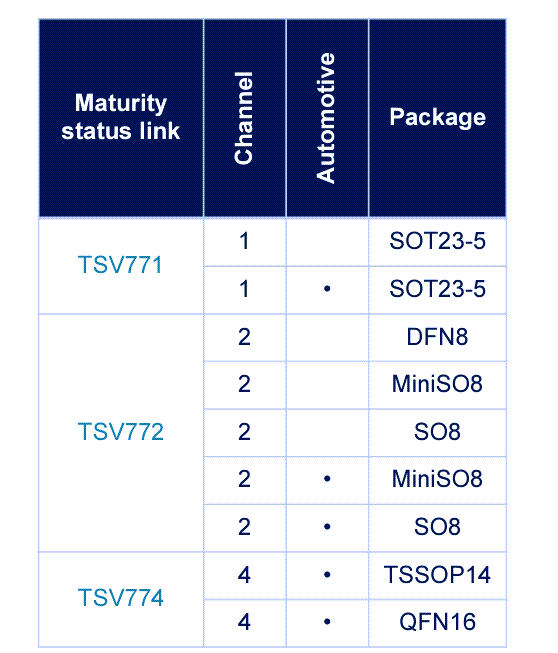
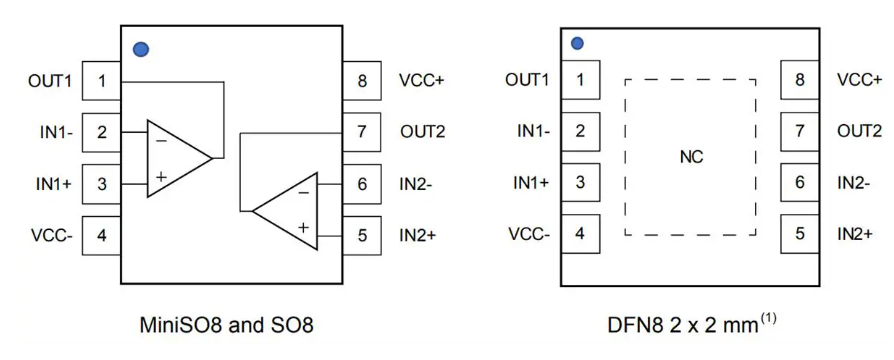



評論