)技術。 三星的創新被認為是大規模生產高性能芯片的最具挑戰性的封裝技術之一,因為它需要精確的精度才能通過具有60,000多個TSV孔的三維配置垂直互連12個DRAM芯片。 封裝的厚度(720um)與當前的8層高帶寬存儲器(HBM2)產品相同,這在組件設計上是一項重大進步。這將
2019-10-08 16:32:23 6863
6863 本文報道了硅通孔三維互連技術的核心工藝以及基于TSV形成的眾多先進封裝集成技術。形成TSV主要有Via-First、Via-Middle、Via-Last 3大技術路線。TSV 硅刻蝕、TSV 側壁
2024-11-01 11:08:07 5236
5236 
三維集成電路工藝技術因特征尺寸縮小與系統復雜度提升而發展,其核心目標在于通過垂直堆疊芯片突破二維物理極限,同時滿足高密度、高性能、高可靠性及低成本的綜合需求。
2025-07-08 09:53:04 1730
1730 
在“NEPCON日本2013”的技術研討會上,英特爾和高通分別就有望在新一代移動SoC(系統級芯片)領域實現實用的 TSV(硅通孔)三維封裝技術發表了演講。兩家公司均認為,“三維封裝是將來的技術方向”。
2013-01-22 09:06:01 1822
1822 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2022-07-13 16:50:15 2193
2193 三維封裝通過非 WB 互連技術實現芯片間的高密度封裝,為微電子系統封裝在三維空間開辟了一個新的發展方向,可以有效地滿足高功能芯片超輕、超薄、高性能、低功耗及低成本的需求"。該技術主要應用在高速計算、網絡和GPU 等系統芯片中。傳統二維封裝與三維封裝對比示意圖如圖所示。
2023-05-08 16:58:24 5108
5108 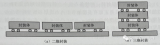
主要的技術路徑。2.5D/3D封裝正在加速3D互連密度的技術突破,TSV及TGV的技術作為2.5D/3D封裝的核心技術,越來越受到重視。
2023-05-23 12:29:11 5750
5750 
近年來,半導體封裝變得越發復雜,更加強調設計的重要性。半導體封裝設計工藝需要各類工程師和業內人士的共同參與,以共享材料信息、開展可行性測試、并優化封裝特性。在之前的文章:[半導體后端工藝:第四篇
2023-08-07 10:06:19 1553
1553 
的優點,多用于“數據倉庫”來使用。其技術的發展也是朝著不斷增大單位面積存儲容量的方向發展,由二維到三維,再到不斷地增加堆棧層數,當前業界已經推出 200 層以上堆棧的產品,未來還會向 1000 層發展。
2023-12-08 10:19:49 1497
1497 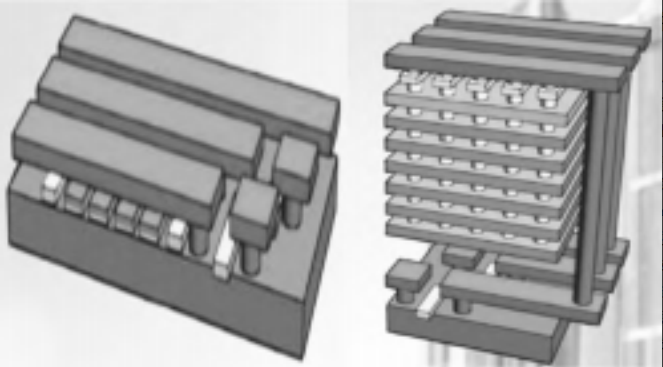
在本系列第二篇文章中,我們主要了解到半導體封裝的作用。這些封裝的形狀和尺寸各異,保護和連接脆弱集成電路的方法也各不相同。在這篇文章中,我們將帶您了解半導體封裝的不同分類,包括制造半導體封裝所用材料的類型、半導體封裝的獨特制造工藝,以及半導體封裝的應用案例。
2023-12-14 17:16:52 3692
3692 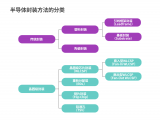
半導體器件的性能;芯片級封裝、系統封裝等是現在第三次革新的產物,其目的就是將封裝面積減到最小。半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現
2024-01-16 09:54:34 2668
2668 
在三維集成電路設計中,TSV(硅通孔)技術通過垂直互連顯著提升了系統集成密度與性能,但其物理尺寸效應與寄生參數對互連特性的影響已成為設計優化的核心挑戰。
2025-08-25 11:20:01 2271
2271 
在半導體封裝領域,堆疊技術作為推動高集成度與小型化的核心趨勢,正通過垂直堆疊芯片或封裝實現更緊湊的封裝尺寸及優化的電氣性能——其驅動力不僅源于信號傳輸與功率分布路徑的縮短,更體現在對系統級封裝(SiP)與三維集成(3D IC)的深度探索中。
2025-10-21 17:29:17 4787
4787 
智能芯片之三維內存介紹
2021-01-29 07:39:22
求哪位大神幫忙編一個三維加速度采集的LabVIEW8.5程序,采集卡NI9233,三個三維KISTLER加速度傳感器。QQ2984833847
2013-11-01 22:46:14
`三維快速建模技術與三維掃描建模的應用隨著數字化測量的發展,三維激光掃描儀能夠快速地以多角度、高效、高精度方式獲取物體的表面三維數據,可以用于物體的三維建模。首先采用中科院廣州電子
2018-08-07 11:14:41
用三維線條圖做了一個同心圓曲線,怎么才能把它導入到三維圖形控件中呢?如圖
2014-10-27 13:49:36
德國pi公司的三維移動平臺如何用labview控制呢?
2012-03-05 13:00:06
` 那什么是三維立體數字沙盤呢?三維立體數字沙盤又叫三維數字沙盤、立體數字沙盤,是利用三維技術、地理遙控技術、虛擬現實技術、觸控技術等實現的。在計算機中建立一個虛擬環境,把需要展現的內容利用
2020-08-28 14:40:10
空間中的坐標,并且根據用戶手的三維坐標(及其變化)做出相應回應。幸運的是,科學家和工程師們已經開始開發三維觸控來實現超越二維的人機交互。在具體地分析技術之前,我們不妨先來展望一下三維人機交互方法都能
2016-12-19 15:53:17
。三維CAD的使用,不僅能提高設計質量,還能縮短設計周期,創作良好的經濟效益和社會效益。所以,越來越多的企業將三維CAD作為企業進行產品設計和創新最通用的手段和工具。而隨著我國計算機技術的迅速發展
2019-07-03 07:06:31
`三維逆向工程的成果及應用案例何為逆向工程?為適應現代先進制造技術的發展,需將實物樣件或手工模型轉化為Sence數據,以便利用快速成形系統、計算機輔助系統等對其進行處理,并進行修改和優化。逆向工程
2016-03-02 15:12:00
本帖最后由 eehome 于 2013-1-5 09:52 編輯
請教關于JMP在半導體封裝數據分析中的使用案例,希望高手能多多指教。
2012-11-20 16:01:51
`蘇州賽爾科技有限公司,是一家致力于研究、生產、開發和銷售于一體的高科技公司,專門為半導體及光學玻璃行業提供專用的超精密金剛石和CBNH工具,公司專業生產半導體封裝行業專用切割刀片,已于國內知名
2017-10-21 10:38:57
請教下以前的[半導體技術天地]哪里去了
2020-08-04 17:03:41
本文檔的主要內容詳細介紹的是半導體芯片的制作和半導體芯片封裝的詳細資料概述
2023-09-26 08:09:42
怎樣通過ASV技術去生成準確的3D深度圖?采用艾邁斯半導體的ASV技術有什么特點?
2021-07-09 06:25:46
)進行清除,耗時耗力,還對燈箱表面具有一定的傷害。跟我司工程師溝通后,我們根據客戶的產品的特點,決定采用全新一代的HandyscanSAOMIAO3D,CN手持式藍色激光三維掃描設備,為客戶上門進行掃描
2020-07-15 10:52:54
`SMARTSCAN三維掃描儀電子產品配件三維掃描服務自從我司今年6月份發布了smartscan-這款新型桌面型工業用激光三維掃描儀后,受到了新老客戶的極大關注,該款設備設計精巧,采用藍色激光,掃描
2020-09-17 16:16:57
上海黃浦三維媒體動畫技術三維動畫作為多媒體藝術的一個獨立分支,是基于在動畫傳媒藝術和電腦軟硬件技術發展基礎上而形成的一種相對完善的新型的藝術表現形式。在制作過程中,常用到的三維軟件是30
2021-06-30 09:26:37
系統集成(VSI)。三維集成封裝的一般優勢包括:采用不同的技術(如CMOS、MEMS、SiGe、GaAs等)實現器件集成,即“混合集成”,通常采用較短的垂直互連取代很長的二維互連,從而降低了系統寄生
2011-12-02 11:55:33
摘 要:先進封裝技術不斷發展變化以適應各種半導體新工藝和材料的要求和挑戰。在半導體封裝外部形式變遷的基礎上,著重闡述了半導體后端工序的關鍵一封裝內部連接方式的發展趨勢。分析了半導體前端制造工藝的發展
2018-11-23 17:03:35
二極管和三種新型ESD二極管。 安森美半導體小信號產品部總經理Mamoon Rashid說:“安森美半導體已擴大SOx723封裝系列中的技術,以直接回應業內對超小型分立元件的需求。我們的便攜式產品
2008-06-12 10:01:54
了解,半導體封裝經歷了三次重大革新:第一次是在上世紀80年代從引腳插入式封裝到表面貼片封裝,它極大地提高了印刷電路板上的組裝密度;第二次是在上世紀90年代球型矩陣封裝的出現,滿足了市場對高引腳的需求
2019-12-09 16:16:51
傳熱材料、功率母線、功率器件、銅層、陶瓷、集成無源模塊、金屬層、表面貼裝芯片(驅動、檢測及保護元件)等。這種三維多層集成封裝技術,將功率模塊、集成電路等做成三明治(Sandwich)結構形式。 圖2 嵌入功率器件的多層集成封裝的剖面圖 :
2018-11-23 16:56:26
、動態跟蹤軟件模塊等,功能強大。中科院廣州電子總部設在華南地區,供應廣西三維掃描儀,專業穩定的技術團隊可提供廣西掃描服務、廣西三維檢測。傳統的手工測量已經不能適應當下快速發展的工業化進程,無法滿足復雜曲面
2018-08-29 14:42:40
小到精、精工封裝。采用IDM規模化大生產,這無論從提高企業核心競爭力還是從市場發展來看,具有較強生命力和發展潛力。隨著我國半導體封裝技術日新月異的發展,對人才、技術、資金、管理的要求越來越高,尤其在
2018-08-29 09:55:22
半導體封裝工程師發布日期2015-02-10工作地點北京-北京市學歷要求碩士工作經驗1~3年招聘人數1待遇水平面議年齡要求性別要求不限有效期2015-04-16職位描述1、半導體光電子學、微電子
2015-02-10 13:33:33
項目需要調研一下無人機三維建模的信息無人機三維建模核心技術是三維重建,或者說基于圖片的建模(Image-Based Modeling)。項目需要是建立園區的三維模型,其他應用上可以用于古街道、文物
2021-09-16 06:55:27
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
三維內存對人們生產生活方面的貢獻智能芯片的三維內存
2020-12-24 06:54:39
,目前的MCM已不只局限于將幾塊芯片平面安裝在一塊襯底上,而是采用埋置、有源基板或疊層技術,在三維空間內將多個不同工藝的芯片互連形成完整功能的模塊。 將MCM技術用于電力電子集成封裝的研究,核心內容
2018-08-28 11:58:28
的性能發展,縱觀近幾年的電子封裝產業,其發展趨勢如下:●電子封裝技術繼續朝著超高密度的方向發展,出現了三維封裝、多芯片封裝(MCP)和系統級封裝(SIP)等超高密度的封裝形式。 ●電子封裝技術繼續
2018-08-23 12:47:17
`隨著高性能計算、云計算、電子商務的普及,以及5G的低延遲和高數據速率,我們能看到更多的智能設備、電動汽車以及所有物聯網應用的可能性。這也帶來了更大的市場。近幾個月來,全球半導體和封裝產業供需矛盾
2021-03-31 14:16:49
型的解決方案,即創建兩個或四個堆棧,每個堆棧由64個ADC通道組成,從而使得通常只能容納64個通道的空間最多可以容納256個ADC通道。這種封裝技術被稱為第三維應用,雖然聽起來并不復雜,但是其實際的操作卻面臨著
2018-09-11 11:40:08
pitch Copper Pillar等;同時還將重點討論長期困擾大多數同行的常見技術難題及其對應的策略與建議:包括半導體封裝技術發展歷史和現狀、如何進行封裝選型、如何進行封裝的Cost Down
2016-03-21 10:39:20
Ω 30V Dpak來驅動一個H橋——這在當時被認為是一種“尖端”器件,但如今這樣一種器件卻十分平常。這種進步在很大程度上應歸功于半導體技術的巨大進步,但封裝技術發展如何呢?應當牢記的是,半導體封裝
2019-05-13 14:11:51
WD4000半導體晶圓表面三維形貌測量設備自動測量Wafer厚度、表面粗糙度、三維形貌、單層膜厚、多層膜厚。可廣泛應用于襯底制造、晶圓制造、及封裝工藝檢測、3C電子玻璃屏及其精密配件、光學加工、顯示
2023-10-23 11:05:50
半導體器件有許多封裝形式,按封裝的外形、尺寸、結構分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術指標一代比一代先進。總體
2010-11-14 21:35:09 55
55 半導體封裝,半導體封裝是什么意思
半導體封裝簡介:
2010-03-04 10:54:59 12890
12890 半導體封裝技術大全
2010-03-04 13:55:19 6019
6019 半導體封裝領域的分析師JeromeBaron這樣指出:在處于半導體前工序和后工序中間位置的“中端”領域,具有代表性的技術包括晶圓級封裝(WLP)及采用TSV(硅通孔)的硅轉接板等,潛藏著
2011-08-12 23:56:05 1542
1542 筆者首先分析了三維人臉建模技術背景意義和研究現狀;其次論證了各種三維人臉建模技術的優缺點;最后對三維人臉建模技術的應用領域進行了詳細介紹并進一步展望了今后三維人臉
2012-02-17 11:19:36 23
23 MEMS是一種把微型機械組件(如傳感器、制動器等)與電子電路集成在同一顆芯片上的半導體技術。三維微電子機械系統(3D-MEMS),是將硅加工成三維結構,其封裝和觸點便于安裝和裝配
2012-12-11 11:35:49 4617
4617 硅通孔技術(Through Silicon Via, TSV)技術是一項高密度封裝技術,正在逐漸取代目前工藝比較成熟的引線鍵合技術,被認為是第四代封裝技術。TSV技術通過銅、鎢、多晶硅等導電物質
2016-10-12 18:30:27 18197
18197 
三維芯片( 3DSIC)通過硅通孔TSV技術實現電路的垂直互連,有效提高了系統集成度和整體性能。由于三維芯片測試中,用于測試的引腳數和TSV數目以及測試時功耗的限制都對測試時間有很大的影響,擬提
2017-11-22 17:44:40 3
3 要實現三維集成,需要用到幾個關鍵技術,如硅通孔(TSV),晶圓減薄處理,以及晶圓/芯片鍵合。TSV 互連具有縮短路徑和更薄的封裝尺寸等優點,被認為是三維集成的核心技術。
2017-11-24 16:23:48 66425
66425 
半導體器件有許多封裝形式,按封裝的外形、尺寸、結構分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術指標一代比一代先進。總體說來,半導體
2018-07-23 15:20:00 5708
5708 硅通孔技術(Through Silicon Via, TSV)技術是一項高密度封裝技術,正在逐漸取代目前工藝比較成熟的引線鍵合技術,被認為是第四代封裝技術。TSV技術通過銅、鎢、多晶硅等導電物質
2018-08-14 15:39:10 92829
92829 早期的半導體封裝多以陶瓷封裝為主,伴隨著半導體器件的高度集成化和高速化的發展,電子設備的小型化和價格的降低,陶瓷封裝部分地被塑料封裝代替,但陶瓷封裝的許多用途仍具有不可替代的功能,特別是集成電路組件
2019-04-28 15:17:43 34147
34147 近年來,三維集成技術的發展,促進了系統微封裝集成技術的發展,其應用領域正由芯片向集成度、復雜度更高的系統級三維集成方向發展。
2019-11-30 07:16:00 7669
7669 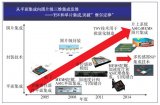
的互連密度等多種優勢使各大半導體廠商不斷對TSV立體堆疊技術投入研究和應用。 作為國家提前布局的國產先進封裝企業華進半導體,如今發展如何?今天邀請到了華進半導體市場與產業化部總監周鳴昊先生和我們分享華進半導體作為國家級先進封裝技術研發中
2020-09-26 09:45:35 6368
6368 技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2020-10-12 11:34:36 19530
19530 
一、技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝
2020-10-21 11:03:11 32866
32866 
封裝技術已從單芯片封裝開始,發展到多芯片封裝/模塊、三維封裝等階段,目前正在經歷系統級封裝與三維集成的發展階段。
2021-01-10 10:44:39 2979
2979 三維集成技術可分為三維晶圓級封裝、基于三維中介層(interposer)的集成、三維堆疊式集成電路(3D staked IC,3D-SIC)、單片三維集成電路、三維異構集成等。
2022-04-25 15:35:42 3068
3068 三維集成電路是在二維 MMCM 的基礎上,將傳統二維組裝和互連技術向三維發展而實現的三維立體結構的微波電路。在三維微波組件的研制中,許多新材料、新封裝和新互連工藝得到了廣泛應用。
2022-11-16 16:02:58 2602
2602 三維封裝技術是指在二維封裝技術的基礎上,進一步向垂直方向發展的微電子組裝技術。
2023-03-25 10:09:41 4758
4758 本文以半導體封裝技術為研究對象,在論述半導體封裝技術及其重要作用的基礎上,探究了現階段半導體封裝技術的芯片保護、電氣功能實現、通用性、封裝界面標準化、散熱冷卻功能等諸多發展趨勢,深入研究了半導體前端
2023-05-16 10:06:00 1547
1547 三維激光掃描技術是近年來發展的新型測量方法,通過三維掃描獲取大量全面點云數據,形成三維立體模型,實現快速掌握被測目標信息。
2023-05-16 13:56:57 1782
1782 
隨著電子產品的迅速發展,半導體封裝技術已經成為整個半導體產業的重要組成部分。從早期的簡單封裝到現代高密度、高集成度的封裝,半導體封裝技術在不斷地演進。目前,市場上常見的半導體封裝技術可以歸納為三大類:傳統封裝技術、表面貼裝技術和先進封裝技術。本文將詳細介紹這三大類半導體封裝技術的特點、優勢和發展趨勢。
2023-04-25 16:46:21 2516
2516 
半導體封裝過程中的缺陷檢測非常重要,對于半導體的性能會有很大的影像,今天蔡司代理三本精密儀器小編就給大家介紹一下蔡司三維X射線顯微鏡半導體封裝產品檢測方案:針對先進封裝中的高集成度和日益縮小的互聯
2023-06-27 15:52:39 1019
1019 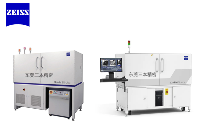
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2023-08-05 09:54:29 1021
1021 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝
2023-08-14 09:59:24 1258
1258 
三星電機是韓國最大的半導體封裝基板公司,將在展會上展示大面積、高多層、超薄型的下一代半導體封裝基板,展示其技術。
2023-09-08 11:03:20 1505
1505 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2023-10-31 09:16:29 3859
3859 
其實除了這些傳統的封裝,還有很多隨著半導體發展新出現的封裝技術,如一系列的先進封裝和晶圓級封裝等等。盡管半導體封裝技術不斷發展,但仍面臨著一些挑戰。首先,隨著半導體元件尺寸的不斷縮小,封裝過程中的良
2023-11-15 15:28:43 6118
6118 
共讀好書 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2024-02-21 10:34:20 1565
1565 
文物三維掃描,文物三維模型怎樣制作:我們都知道文物是不可再生的,要繼續保存傳承,需要文物三維數字化保護,所以三維數字化文物保護是非常重要的一個技術手段。
那么文物三維掃描,文物三維模型是怎樣
2024-03-12 11:10:23 1442
1442 
TSV(Through-Silicon Via)是一種先進的三維集成電路封裝技術。它通過在芯片上穿孔并填充導電材料,實現芯片內、芯片間以及芯片與封裝之間的垂直連接。
2024-04-11 16:36:36 9819
9819 
來源:陸熠磊 上海交大平湖智能光電研究院 在當今的半導體產業中,封裝技術的重要性不言而喻。它不僅保護了脆弱的芯片,還確保了電子信號的正確傳輸。但是,在封裝過程中可能會出現一些缺陷,如空洞、裂紋等
2024-08-05 15:14:02 956
956 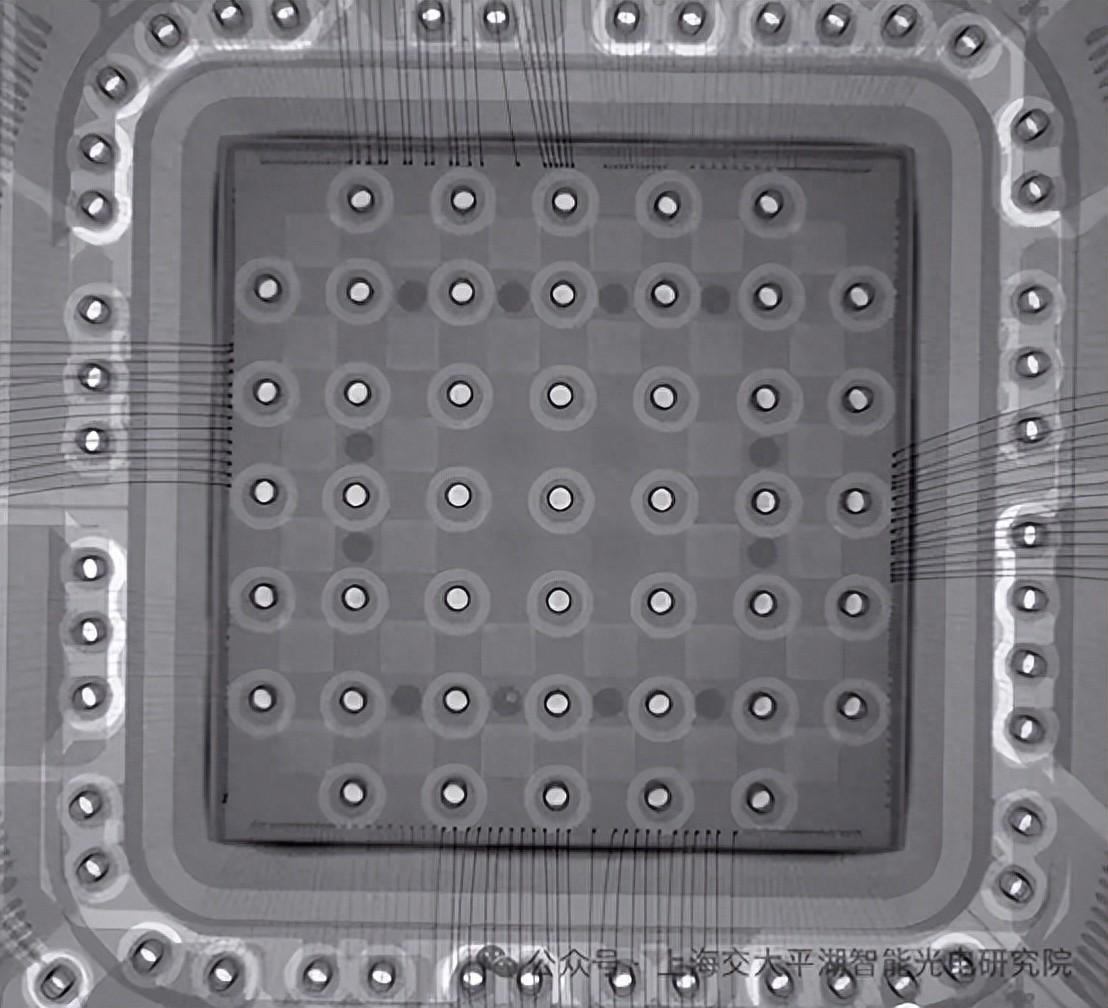
1. 引言 隨著電子技術的快速發展,半導體器件在各個領域的應用越來越廣泛。為了保護半導體芯片免受物理損傷、化學腐蝕和環境影響,封裝技術應運而生。LED封裝和半導體封裝是封裝技術中的兩個重要分支,它們
2024-10-17 09:09:05 3085
3085 半導體封裝技術是將半導體集成電路芯片用特定的外殼進行封裝,以保護芯片、增強導熱性能,并實現芯片內部與外部電路的連接和通信。隨著半導體技術的不斷發展,封裝技術也日新月異,涌現出了多種不同的封裝形式。以下是對半導體封裝技術的詳細介紹,包括主要類型、它們之間的區別以及各自的特點。
2024-10-18 18:06:48 4682
4682 隨著半導體技術的飛速發展,芯片的性能需求不斷提升,傳統的二維封裝技術已難以滿足日益增長的數據處理速度和功耗控制要求。在此背景下,混合鍵合(Hybrid Bonding)技術應運而生,并迅速成為三維
2024-11-13 13:01:32 3341
3341 
本文回顧了過去的封裝技術、介紹了三維集成這種新型封裝技術,以及TGV工藝。 一、半導體技術發展趨勢 以集成電路芯片為代表的微電子技術不僅在信息社會的發展歷程中起到了關鍵性作用,也在5G通信、人工智能
2024-11-24 09:56:02 4226
4226 
摘要:在最近的半導體封裝中,采用硅通孔 (TSV) 技術已成為集成 2.5 和 3D Si芯片以及中介層的關鍵。TSV 具有顯著的優勢,包括高互連密度、縮短信號路徑和提高電氣性能。然而,TSV 實施
2024-12-06 09:19:36 4743
4743 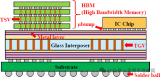
TSV 三維封裝技術特點鮮明、性能好、前景廣闊, 是未來發展方向,但是 TSV 堆疊芯片這種結構和工 藝復雜性的提高,為三維封裝的可靠性控制帶來了 挑戰。主要體現在以下 4 個方面 :(1) TSV
2024-12-30 17:37:06 2629
2629 在現代半導體封裝技術不斷邁向高性能、小型化與多功能異構集成的背景下,硅通孔(TSV,Through-SiliconVia)工藝作為實現芯片垂直互連與三維集成(3DIC)的核心技術,正日益成為先進封裝
2025-04-17 08:21:29 2508
2508 
在半導體三維集成(3D IC)技術中,硅通孔(TSV)是實現芯片垂直堆疊的核心,但受深寬比限制,傳統厚硅片(700-800μm)難以制造直徑更小(5-20μm)的TSV,導致芯片面積占比過高,且多層堆疊后總厚度可能達毫米級,與智能手機等應用對芯片厚度的嚴苛限制(通常<1mm)沖突。
2025-07-29 16:48:59 1367
1367 
 電子發燒友App
電子發燒友App











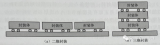


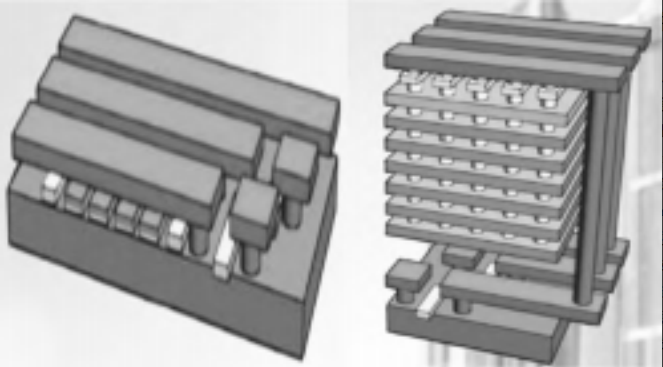
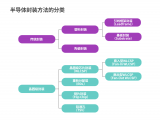






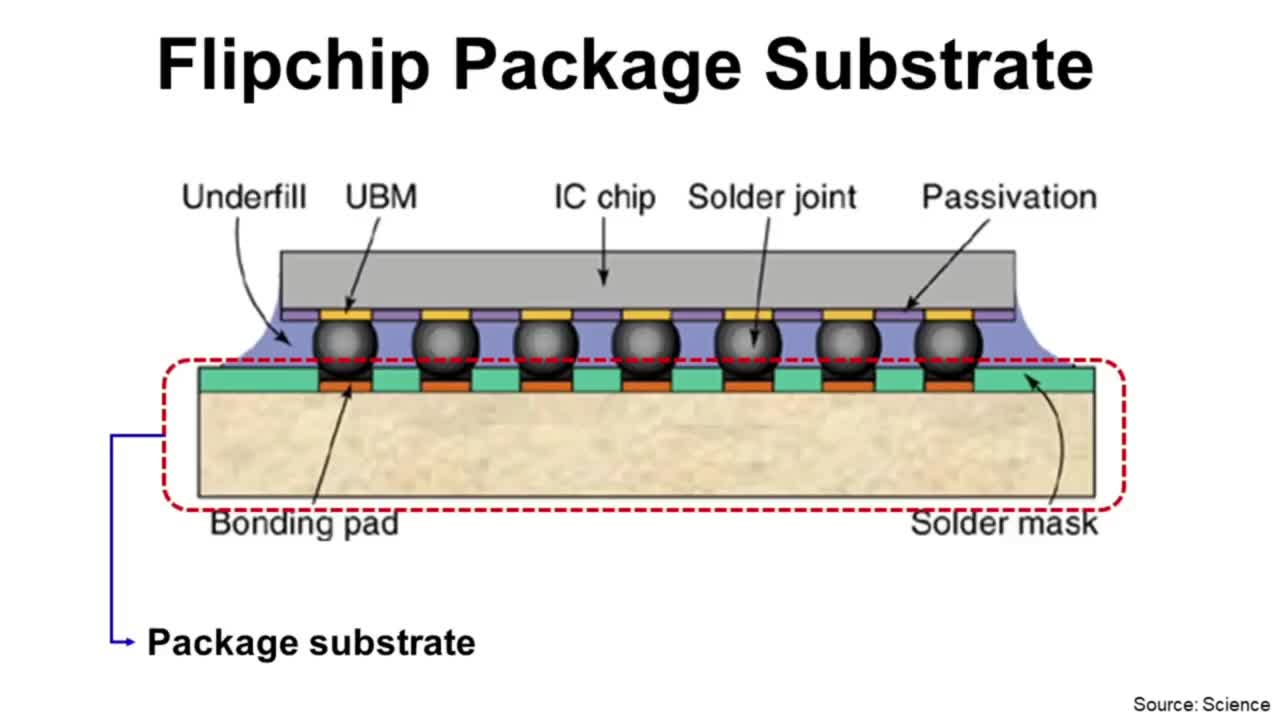








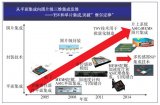




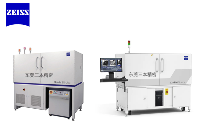







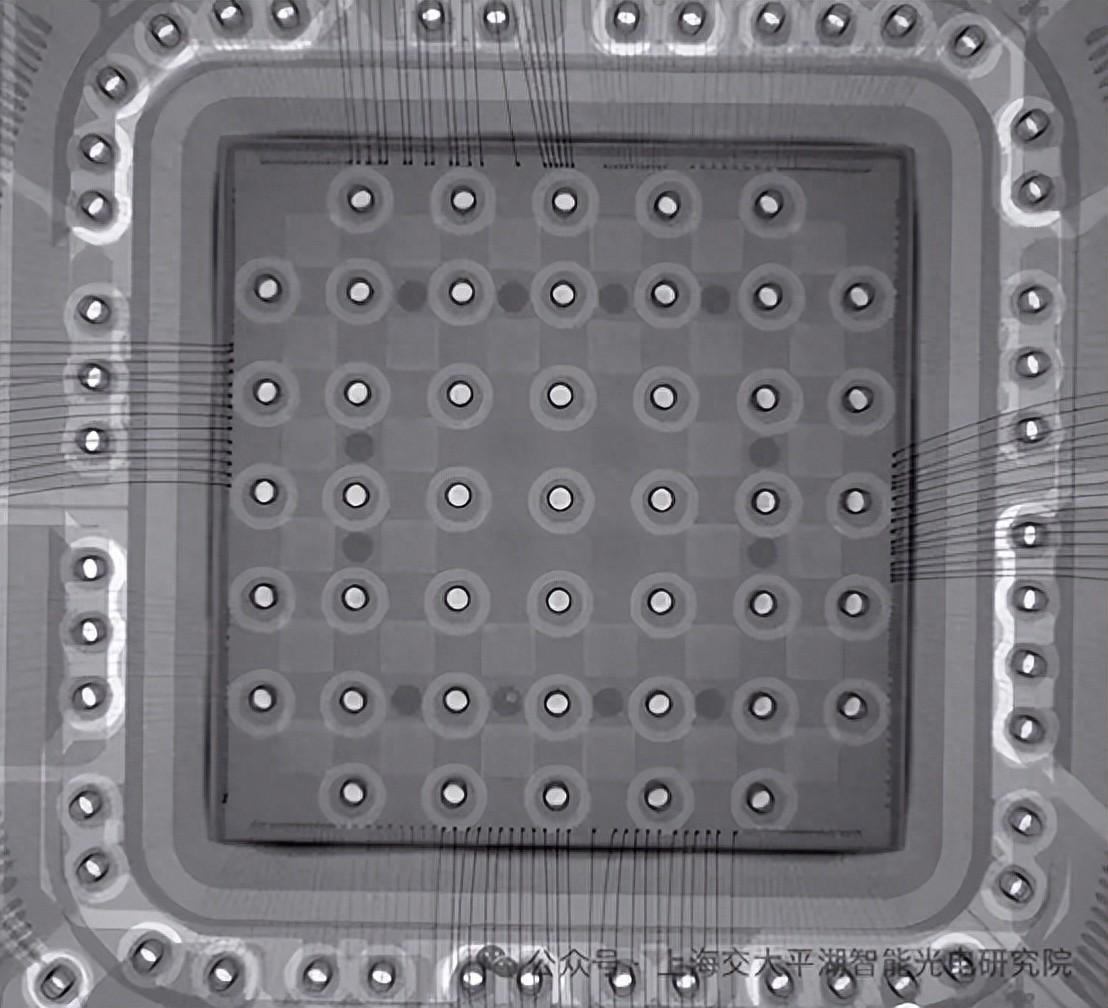


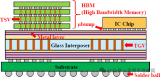





評論