當芯片被置放在基板時,首先接觸到靠近中心區域的密封劑。隨著其進一步向下移動,芯片將對液體形成向外的擠壓作用。隨著液體流動,密封劑必然繞過或淹沒焊膏凸點、印刷電路板跡線及其他特征區域,進而填充阻焊層開口。這一過程會產生并誘集氣泡,在凸點后面,多少有些順流的方向上表現尤為突出。
芯片被置放在玻璃基片上,從基片底部進行觀察。圖片所呈現的顆粒狀外觀源于密封劑內部的固態微粒,其在高溫下可溶解。圖片顯示,靠近中心凸點(以三角形排列)的氣泡尺寸與凸點本身尺寸相當;通過與周邊凸點的間距相比較,可以大體估算出氣泡的尺寸,這里周邊凸點間距為10密耳(0.254mm)。周邊凸點附近也有相似的氣泡,但它們已分離出來并沿邊角(圖中聚焦區以外的區域)上升;可以清楚地看到,一來自左下角凸點的氣泡一半在芯片下,一半在外面。大部分分離的氣泡均在其后面靠近各自凸點的地方留下了一個相對較小的氣泡。上述情形在所有貼片過程中非常普遍,難以避免。但是,元件制造商可以通過盡量減小芯片和基板表面的不規則性來應對氣泡的產生。
密封材料一旦到達芯片邊沿,勢必將其潤濕并沿芯片邊沿攀升以形成圓角。在這一過程中,必須對芯片加以固定,以防止其在密封液上產生滑動。否則接下來就有芯片貼裝在錯誤位置的危險。
密封劑的粘性是決定芯片固定到位時間的主要因素。對密封液潤濕芯片邊沿過程的錄像資料顯示,密封液停止顯然可見的運動的時間,從約0.1秒到超過1秒鐘不等,取決于粘度不同的密封劑。
貼片時不僅在貼裝頭后退之前必須將芯片固定一定的時間,還必須在這一時段里對芯片施加一定強度的壓力,將密封劑擠出,迫使其充滿芯片下的全部區域。特別對于獨立的焊盤開口,為給凸點騰出空間,密封劑必須流過各個凸點和開口側壁間的狹窄區域,尤其如此。即使這些獨立的開口被替換成溝槽交錯的跡線,密封劑可以更自由地流動,仍需對芯片施加相當強度的壓力。這種壓力的另一重要作用足可以將凸點下壓至基板,將其壓扁。這樣可以使盡可能多的凸點在再流焊之前貼近焊盤,在采用非流動性密封劑時,這有利于避免電氣開路的出現。在傳統工藝的再流焊過程中,最先熔化并潤濕其焊盤的部分凸點,因為沒有底充膠阻止芯片塌陷作用,會由于表面張力產生足夠強度的力將芯片下拉。這一過程將最終使得所有凸點與焊盤接觸,保證了部件的電氣連續性能。
與傳統過程相反,再流焊密封劑則阻止芯片向下運動。當密封劑形成聚合時,由于材料厚度明顯增加,這一阻止作用變得更加顯著。因此,必須有足夠強度的貼裝壓力,才能克服密封劑阻力,保證盡量多的凸點與其相應的焊盤相接觸。
密封劑同時還阻礙了芯片的側向運動,從而削弱再流焊過程中芯片的自對中作用。這進一步說明,在采用再流焊密封劑時,精確貼片非常重要。
為保證部件獲得優良電氣連續性能所需的壓力大小,隨密封劑粘度的不同而變化,密封劑粘度越高,所需的壓力越大。例如,采用目前粘度最高的密封劑,對于88個凸點的芯片,貼裝壓力為800克時,效果總是優良。而對兩塊這種芯片施加的壓力減為500克時,芯片均出現開路現象。另一方面,貼裝壓力過大不僅有可能損壞芯片,也可能使基板彎曲,一旦待壓力撤除時,基板可能出現反彈,造成表面上一定數量的凸點與焊盤脫離,甚至還可能引起芯片相對于基板的運動。
再流焊
再流焊是優化再流密封劑過程中最難控制的一步,這主要是因為很多過程同時發生并且可能在工藝需求上產生沖突。例如,再流焊過程中密封材料必須保持液態,以防阻礙焊點的生成和芯片的塌陷作用。同時,當電路板被送出再流焊爐時,密封劑必須實現相當程度(即便達不到完全)的固化。很多密封材料對再流溫度曲線的變化非常敏感,當溫度過快過高,甚至升溫速率過高時,都可能造成開路。
實驗中所測試的密封材料需要采用傳統的SMT溫度曲線(見圖3,標為“標準”的曲線)。這對于需同時處理其他表面貼裝元件的過程很有幫助。另外,由于這些密封材料開始聚合相當“緩慢”,可以認為它們對再流焊溫度曲線的敏感度最小。不過,它們在再流焊過后需要進行二次固化,一般為30至40分鐘。
另一個極端的情況是,一些密封材料與傳統再流焊中的“浸漬保溫”期不相兼容。相反,若將溫度直接穩定升高至再流條件,并在相對較低的溫度下保持幾分鐘,其反應的效果更佳。這一二次加熱期,使得再流曲線看起來更像是傳統SMT再流曲線的鏡像(見圖3“反向”曲線所示)。這些材料無需二次固化,事實上二次固化過程轉移到了再流焊爐內進行。
還有一類再流曲線,介于這兩種極端情況之間,我們可稱之為“中間”類型曲線。這種溫度曲線的特點是保溫期很短,甚至根本沒有保溫期(有時保溫期溫度低于常規保溫溫度)。其二次固化過程不在再流焊爐內部完成。其中有的需要不同時長的二次固化,有的則被設計為在再流過程中實現充分的固化。
適合于后兩種溫度曲線的密封劑材料固化開始時間早,因此對再流溫度曲線的敏感度更高。因此阻礙了圖中凸點對其焊盤的潤濕。從凸點的形貌可以看出,其他焊點此時已經塌陷,熔化的焊料被壓向焊盤,正處于形成焊點的過程中。一薄層密封材料卻將凸點與其焊盤隔離。采用此類密封劑時,焊點有時會呈現不規則的形貌(見圖5),這是由于密封材料在焊料還處于液態時就產生凝固而造成的。
采用無二次固化的密封材料,一大問題是再流焊過程中溫度曲線對固化程度的影響。由于無二次固化過程,密封劑必須在組件被送出焊爐前,從芯片塌陷到組件冷卻這段很短的時間間隔內完全固化,因此即使冷卻速率發生很小的變化,也會對材料的固化程度產生相當影響。密封劑固化程度降低并不會在組件從焊爐出來時被發現,但由于未固化完全的密封劑強度降低,以后可能會引發組件的可靠性問題。相對于無二次固化的密封材料,需要進行二次固化的密封材料采用相同的再流溫度曲線,對冷卻速率的敏感度要小得多。
再流焊過程可能使部分空隙消失,同時也可能產生新的空隙。當焊點塌陷時,密封材料被進一步擠出,這一過程將會帶走周邊凸點后部殘存的氣泡,這些氣泡一旦進入焊角,便會升至密封液表面或溶解于其中。通常情況下,再流焊過程中產生的焊角沒有空隙。而位于芯片下部或靠近中心凸點的氣泡在焊點塌陷過程中則無法到達焊角。這些氣泡消失的唯一途徑,足溶解在液態密封材料中,據實驗觀察,氣泡是溶解在置放在玻璃薄片間的密封液中的。最初的氣泡尺寸越小,溫度越高,氣泡在密封液中的溶解效果越好;而密封液增厚將減緩其溶解過程,當密封液膠化或來自于基板的水分滲入氣泡時,其溶解過程將終止。
這種情況顯示了需要采用傳統再流溫度曲線的密封劑的另一優勢。在傳統溫度曲線下,在相對較高的溫度下保溫相當的時間,為氣泡的溶解提供了理想的條件。最后需要提請注意的一點,必須確保基板的干燥,否則即使在再流焊過程前期組件的所有氣泡都已溶解,仍可能形成新的空隙。
 電子發燒友App
電子發燒友App











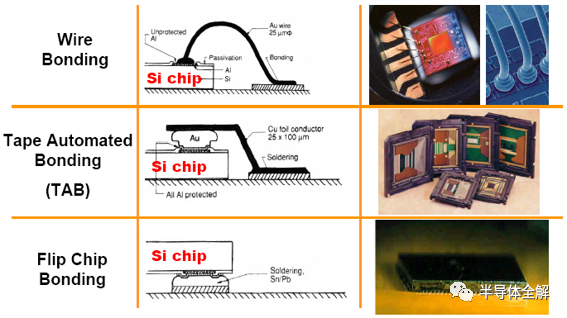



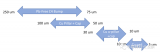

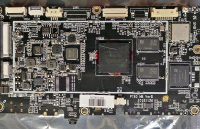
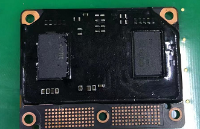






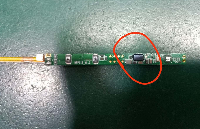

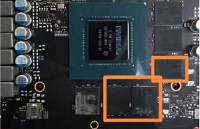
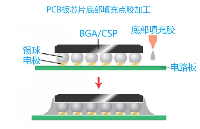



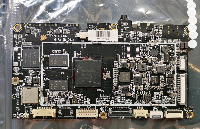
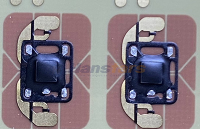

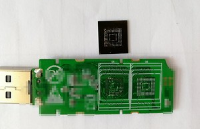
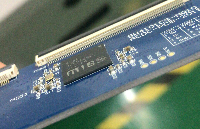
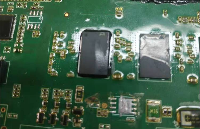







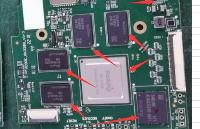
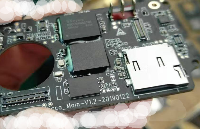

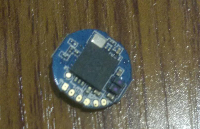



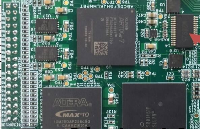





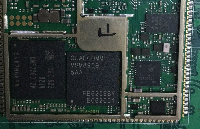




























評論