【先進封裝】Underfill的基本特性
底部填充膠在使用過程中,主要的問題是空洞,出現空洞的原因與其封裝設計、點膠工藝、固化參數等相關。而要分析空洞就需要對Underfill的特性有個基本的認識。今天就分別就空洞的特征和Underfill的基本特性做一個介紹。

圖1?Underfill的基本流程
01 空洞的特征 ?
了解空洞的特征有助于將空洞與它們的產生原因相聯系,其中包括:
①尺寸——空洞是什么形狀、大小?
②位置——空洞主要集中在什么位置?邊緣、中心、還是隨機?
③發生頻率——空洞是在特定的時期產生,還是一直產生,或者是隨機時間產生?
通過上面的基本信息收集,基本就可以大概有個判斷方向,可以知道是點膠問題、固化問題、還是膠水問題了。
02 填料(Filler)
底部填充膠通常配制有60-70%重量的無定形熔融二氧化硅。二氧化硅用于降低底部填充材料的CTE,因為沒有填料,固化聚合物的CTE會導致不可接受的焊點應變。通常,底部填充膠配方的CTE為25-30 ppm/℃,與焊料非常接近。填料的不同重量選擇,會增加配方的粘度,導致它不會流到芯片底部覆蓋整個焊點。?
03 固化(Cure)
底部填充膠被配制成熱固性塑料而不是熱塑性塑料,這主要是因為無溶劑的高性能熱塑性塑料的粘度對于封裝工藝來說太高了。作為熱固性材料,底部填充膠必須在封裝后通過加熱進行固化,而完全固化對于優化粘合力、玻璃化轉變溫度 (Tg) 和模量等性能至關重要。大多數底部填充膠在約 150℃-180℃的溫度下選擇真空壓力烘箱進行固化,以便于除泡,一般會先進行抽真空把大氣泡抽出變成小氣泡,再使用大壓力把小氣泡壓出。
04 玻璃化轉變溫度(Tg)
前面我們已經有文章大概介紹了玻璃化轉變溫度,可以看《一文了解玻璃化轉變溫度》進行學習,這里就不多贅述了。
05 彈性模量(Elastic Modulus)
底部填充膠的作用是將硅芯片機械連接到其載體上,形成一種結構,消除或顯著降低單個焊點上的應力。最佳模量將取決于應用,并受芯片和芯片載體的CTE差異、芯片載體的模量和底部填料的CTE的影響。
06 粘接力(Adhesion)
底部填充膠的粘接力是保證倒裝芯片組件可靠性的最重要特性。如果沒有持久的粘接力,底部填充膠提供的焊點加固將會是短暫的,一旦底部填充膠失去對一個或多個表面的粘接力,熱應力就會直接轉移到焊點出現功能性失效。底部填充膠必須對芯片鈍化層、硅芯片邊緣、芯片載體表面和焊點本身具有很好的粘接力。哪怕暴露在濕氣和熱應力下,也必須保持粘接力。聚合物的粘合性能通常受水分影響。作為一種小的極性分子,水很容易通過聚合物擴散并吸附在界面上,從而破壞粘接劑的粘接性能。
編輯:黃飛
?
 電子發燒友App
電子發燒友App




















































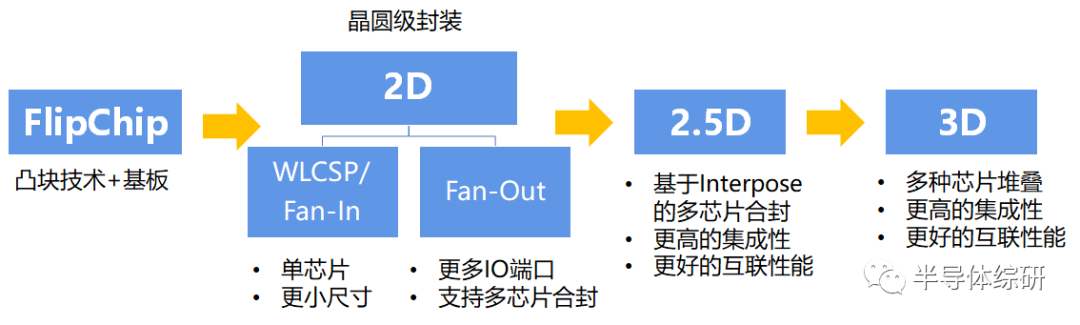



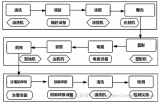
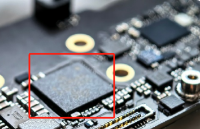
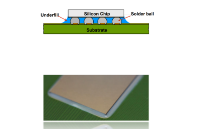


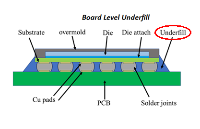


















評論