新的BONDSCALE??系統大大提升了晶圓鍵合的生產率;解決了IRDS路線圖中描述的晶體管邏輯電路擴展和3D集成的問題
奧地利,圣弗洛里安,2019年3月12日——面向MEMS、納米技術和半導體市場的晶圓鍵合與光刻設備的領先供應商EV集團?(EVG) 今日推出了全新的BONDSCALE?自動化生產熔融系統。BONDSCALE旨在滿足各種熔融/分子晶圓鍵合應用,包括工程基板制造和使用材料層轉移進行3D集成的方法,如單片3D (M3D)。通過BONDSCALE,EV集團將晶圓鍵合引入前端半導體處理,并協助解決國際半導體技術發展路線圖 (IRDS)中提出的擴展?“深度摩爾” 邏輯器件的長期問題。與現有的熔融平臺相比,BONDSCALE采用了增強的邊緣對準技術,大大提高了晶圓鍵合生產率并降低了成本 (CoO),目前該解決方案已向客戶供貨。
EVG將在SEMICON China上展示最新的晶圓鍵合解決方案,包括BONDSCALE。SEMICON China是中國首要的半導體行業展會,本屆展會將于3月20日-22日在上海新國際展覽中心舉辦。與會者如有興趣了解更多EVG的信息,可前往N2廳的2547號EVG展位。
BONDSCALE與EV集團的行業基準GEMINI?FB XT自動熔融系統一起銷售,每個系統平臺都針對不同的應用。BONDSCALE主要用于工程基板鍵合和層轉移處理,而GEMINI FB XT將支持需要更高對準精度的應用,例如存儲器堆疊、3D 片上系統?(SoC)、背照式?CMOS 圖像傳感器堆疊以及芯片分區。
直接晶圓鍵合是提升半導體縮放性能的關鍵
根據IRDS路線圖,在未來幾年里,寄生縮放將成為邏輯器件性能拓展的主要驅動因素,需要新的晶體管結構和材料。 IRDS路線圖還指出,新的3D集成方法 (如M3D) 將成為支持從2D到3D VLSI長期過渡的重要手段,包括后臺電源分配、N&P疊加、內存邏輯、集群功能棧和beyond-CMOS集成。層傳輸過程和工程基板通過提升器件性能和降低功耗,從而實現邏輯擴展技術。采用等離子激活的直接晶圓鍵合是一種可靠的解決方案,可實現不同材料、高質量工程基板以及薄硅層轉移應用的多樣化集成。
“作為晶圓鍵合領域的先驅和市場領導者,EV集團一直在幫助客戶將新半導體技術從早期研發轉向制造的最前沿,”EV集團技術執行總監Paul Lindner表示。“大約25年前,EV集團推出業界首款絕緣體硅片(SOI)晶圓鍵合機,以支持生產細分應用產品的高頻和抗輻射設備。 從那時起,我們不斷提高我們的直接鍵合平臺的性能和CoO,來幫助我們的客戶將工程基板的優勢帶到更廣泛的應用中。我們新的BONDSCALE解決方案將其提升到了一個新的水平,提高了生產力,滿足了對工程基板和層轉移處理不斷增長的需求,從而在‘深度摩爾’時代實現下一代邏輯和存儲器件持續的高性能、低功耗和面積擴展。”
EV集團推出BONDSCALE熔融晶圓鍵合平臺
BONDSCALE是用于前端應用所需的熔融/直接晶圓鍵合的大批量生產系統。BONDSCALE系統采用EV集團的LowTemp?等離子激活技術,將熔融鍵合的所有重要步驟 —— 包括清洗、等離子激活、對準、預鍵合和紅外檢測 —— 結合在一個適用于各種熔融/分子晶圓鍵合應用的單一平臺中。該系統能夠處理200毫米和300毫米晶圓,確保無空隙、高產量和高產量的生產過程。
BONDSCALE采用新一代熔融/直接鍵合模塊,一種新型晶圓處理系統和光學邊緣對準系統,可提高產量和生產率,以滿足客戶對工程基板晶圓生產和M3D集成增產的需求。
關于 EV 集團(EVG)
EV集團(EVG)是為半導體、微機電系統(MEMS)、化合物半導體、功率器件和納米技術器件制造提供設備與工藝解決方案的領先供應商。其主要產品包括:晶圓鍵合、薄晶圓處理、光刻/納米壓印光刻(NIL)與計量設備,以及涂膠機、清洗機和檢測系統。EV集團成立于1980年,可為遍及全球的眾多客戶和合作伙伴網絡提供各類服務與支持。
 電子發燒友App
電子發燒友App









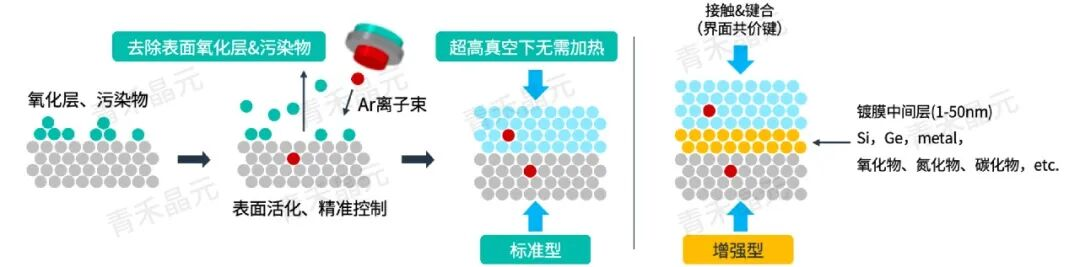







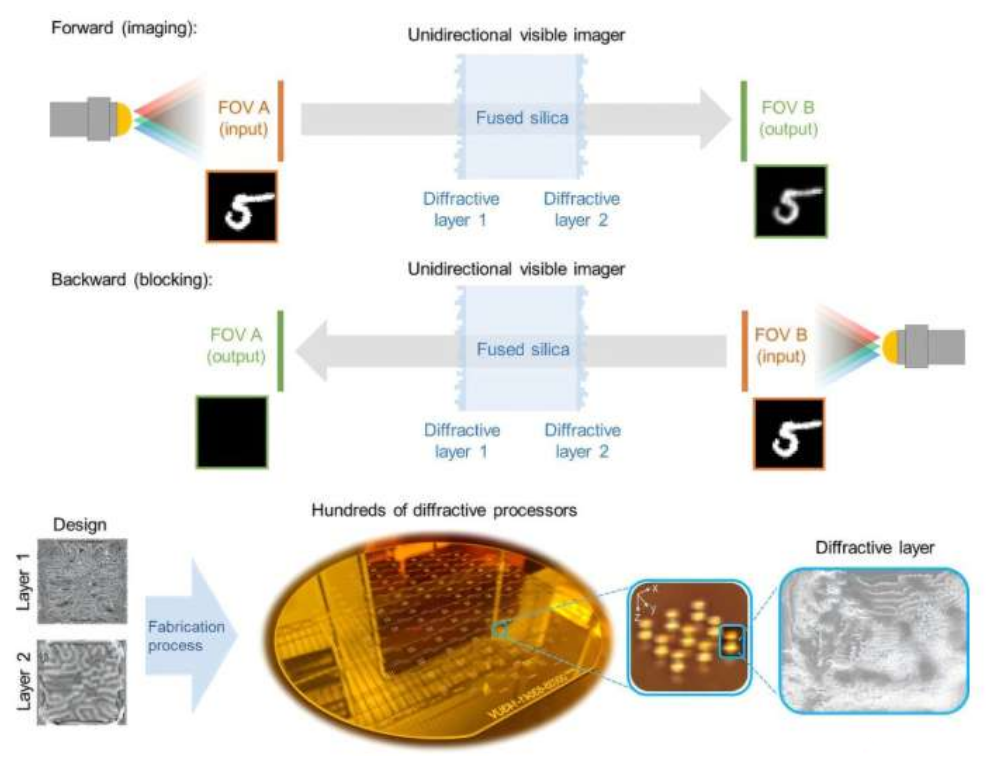


















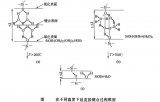




































評論