文章來源:Jeff的芯片世界
原文作者:Jeff的芯片世界
本文介紹了熱壓鍵合(TCB)工藝的技術原理和流程。
熱壓鍵合(Thermal Compression Bonding,TCB)是一種先進的半導體封裝工藝技術,通過同時施加熱量和壓力,將芯片與基板或其他材料緊密連接在一起。這種技術能夠在微觀層面上實現材料間的牢固連接,為半導體器件提供穩(wěn)定可靠的電氣和機械連接。
技術原理
熱壓鍵合的原理主要依賴于熱和壓力的共同作用。在鍵合過程中,芯片和基板的銅凸點首先進行對中,然后通過加熱和施加壓力,使凸點表面原子發(fā)生擴散,形成原子級的金屬鍵合。由于電鍍后的銅凸點表面粗糙且存在高度差,鍵合前需進行化學機械拋光等平坦化處理,以確保充分接觸。

與傳統(tǒng)的回流焊工藝相比,熱壓鍵合在控制芯片和基板翹曲方面具有顯著優(yōu)勢。回流焊工藝中,芯片和基板的曲翹得不到有效控制,導致芯片與基板之間的距離變化大,容易引發(fā)虛焊和橋接等缺陷。而熱壓鍵合通過真空將基板和芯片分別束縛在平整的基座和鍵合頭上,有效控制翹曲,使芯片間隙高度變化范圍大幅縮小,提高了工藝穩(wěn)定性和可靠性。
鍵合流程詳解
熱壓鍵合的流程包含多個精密步驟,以最常見的TCCUF(熱壓鍵合與毛細管底部填充)為例,整個過程僅需1到5秒。基板被真空吸附在加熱的基座上,溫度設定在150°C到200°C之間;鍵合頭同樣加熱并拾取芯片。通過相機系統(tǒng)進行精準對位,確保芯片與基板的凸點對齊。鍵合頭以亞微米精度靠近基板,實時監(jiān)測壓力變化,一旦接觸即切換至壓力和位置共同控制模式。
隨后,鍵合頭迅速加熱至300°C以上,使錫球熔融,并通過精確位置控制確保每個凸點鍵合,同時補償熱膨脹影響。最后快速冷卻至錫球熔點以下完成鍵合。整個過程中,設備實時監(jiān)控溫度、應力和位移,要求亞微米級對準精度和快速溫變控制,加熱溫度變化率可達100°C/s,冷卻溫度變化率約為-50°C/s。
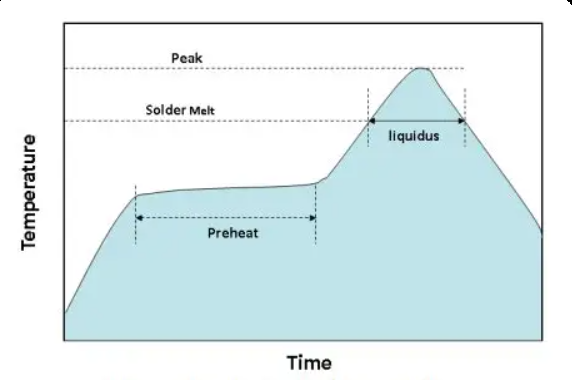
應用領域與技術優(yōu)勢
熱壓鍵合工藝具有高精度、高可靠性、靈活性和高效性等優(yōu)勢。它能夠實現芯片與基板的精確對齊和原子級金屬鍵合,形成牢固的電氣和機械連接,承受更大的機械和熱應力。該技術適用于多種材料和結構,如芯片到基板、芯片到晶圓等不同形式,并可與其他封裝技術結合,提升整體封裝效率。
在應用方面,該技術廣泛應用于3D集成電路集成、倒裝芯片鍵合和混合鍵合等領域。在3D IC中,它支持垂直芯片堆疊,提高集成度和性能;在倒裝芯片中,能實現更小的焊料凸塊,減少互連尺寸并改善電氣性能;與混合鍵合結合時,可消除底部填充需求,直接金屬接觸,提升性能并縮小尺寸,適用于高性能計算和人工智能等前沿領域。
發(fā)展挑戰(zhàn)與未來展望
熱壓鍵合技術面臨成本高、技術挑戰(zhàn)和市場競爭等問題。高精度設備和復雜工藝導致封裝成本較高,同時需不斷提升鍵合精度和可靠性以應對半導體技術發(fā)展。未來,通過技術創(chuàng)新、工藝優(yōu)化、與其他封裝技術融合以及拓展應用領域,如高性能計算和物聯網,熱壓鍵合有望進一步推動半導體封裝進步。
國產設備廠商已開始布局研發(fā),但與國際先進水平仍有差距。隨著HBM國產化進程推進,國內將迎來熱壓鍵合技術研究和設備開發(fā)的歷史機遇,預計會有更多科研機構和半導體設備公司涌入這一賽道,為產業(yè)發(fā)展注入新動力。
-
集成電路
+關注
關注
5458文章
12609瀏覽量
375019 -
鍵合
+關注
關注
0文章
101瀏覽量
8290 -
倒裝芯片
+關注
關注
1文章
121瀏覽量
16855
原文標題:TCB工藝介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
倒裝芯片的特點和工藝流程
先進封裝之熱壓鍵合工藝的基本原理

芯片鍵合-真空熱壓鍵合機使用方法
TCB熱壓鍵合:打造高性能半導體封裝的秘訣

氧濃度監(jiān)控在熱壓鍵合(TCB)工藝過程中的重要性




 熱壓鍵合工藝的技術原理和流程詳解
熱壓鍵合工藝的技術原理和流程詳解











評論