一、引言
在 IGBT 模塊的可靠性研究中,鍵合線失效是導致器件性能退化的重要因素。研究發現,芯片表面平整度與鍵合線連接可靠性存在緊密關聯。當芯片表面平整度不佳時,鍵合線與芯片連接部位易出現應力集中現象,進而引發鍵合失效。深入探究這一關聯性,對提升 IGBT 模塊的可靠性和使用壽命具有關鍵意義。
二、IGBT 鍵合結構與工作應力分析
IGBT 模塊的鍵合結構通常由鍵合線(多為金線或鋁線)連接芯片電極與基板引線框架構成。在器件工作過程中,鍵合線不僅要承受電應力和熱應力,還會因芯片表面形態差異產生額外的機械應力。芯片表面平整度差會打破鍵合線連接的均勻受力狀態,使局部區域承受異常集中的應力。當芯片溫度變化時,由于不同材料熱膨脹系數的差異,這種應力集中現象會進一步加劇。
三、平整度差引發應力集中的作用機制
芯片表面存在微觀起伏或局部凸起時,鍵合線在壓焊過程中會形成非均勻的弧度分布。在芯片與基板的界面處,不平整的表面會導致鍵合線在連接點附近產生較大的彎曲變形,這種變形會在鍵合界面形成應力集中。從材料力學角度分析,表面粗糙度引起的幾何不連續性,會使鍵合線連接部位的應力分布呈現非線性特征。當粗糙度超過一定閾值時,連接部位的最大應力值會顯著高于平均應力水平。例如,當芯片表面粗糙度從 Ra0.3μm 增加到 Ra0.8μm 時,鍵合線根部的應力集中系數可提升 20%-30%。
四、鍵合失效的典型模式與實驗驗證
(一)鍵合界面開裂
在應力集中作用下,鍵合線與芯片電極的連接界面易出現微裂紋。隨著器件反復熱循環,裂紋會逐步擴展,最終導致鍵合界面完全開裂。實驗中觀察到,表面平整度差的芯片,其鍵合界面開裂的起始循環次數比正常芯片減少約 40%-50%。
(二)鍵合線頸部斷裂
鍵合線頸部是應力集中的敏感區域,當芯片表面不平整時,頸部位置的彎曲應力會顯著增加。某 IGBT 模塊可靠性測試顯示,使用表面粗糙度 Ra1.0μm 芯片的樣品,鍵合線頸部斷裂的失效概率比使用 Ra0.5μm 芯片的樣品高 2.3 倍。
(三)實驗數據對比
通過設計對比實驗,對不同表面平整度的芯片進行鍵合可靠性測試。結果表明:當芯片表面粗糙度控制在 Ra0.5μm 以下時,鍵合線的平均失效時間超過 1000 小時;而當粗糙度達到 Ra1.0μm 時,平均失效時間縮短至 600 小時左右。掃描電鏡(SEM)觀察發現,失效樣品的鍵合界面普遍存在明顯的應力腐蝕痕跡。
激光頻率梳3D光學輪廓測量系統簡介:
20世紀80年代,飛秒鎖模激光器取得重要進展。2000年左右,美國J.Hall教授團隊憑借自參考f-2f技術,成功實現載波包絡相位穩定的鈦寶石鎖模激光器,標志著飛秒光學頻率梳正式誕生。2005年,Theodor.W.H?nsch(德國馬克斯普朗克量子光學研究所)與John.L.Hall(美國國家標準和技術研究所)因在該領域的卓越貢獻,共同榮獲諾貝爾物理學獎。?
系統基于激光頻率梳原理,采用500kHz高頻激光脈沖飛行測距技術,打破傳統光學遮擋限制,專為深孔、凹槽等復雜大型結構件測量而生。在1m超長工作距離下,仍能保持微米級精度,革新自動化檢測技術。?

核心技術優勢?
①同軸落射測距:獨特掃描方式攻克光學“遮擋”難題,適用于縱橫溝壑的閥體油路板等復雜結構;?

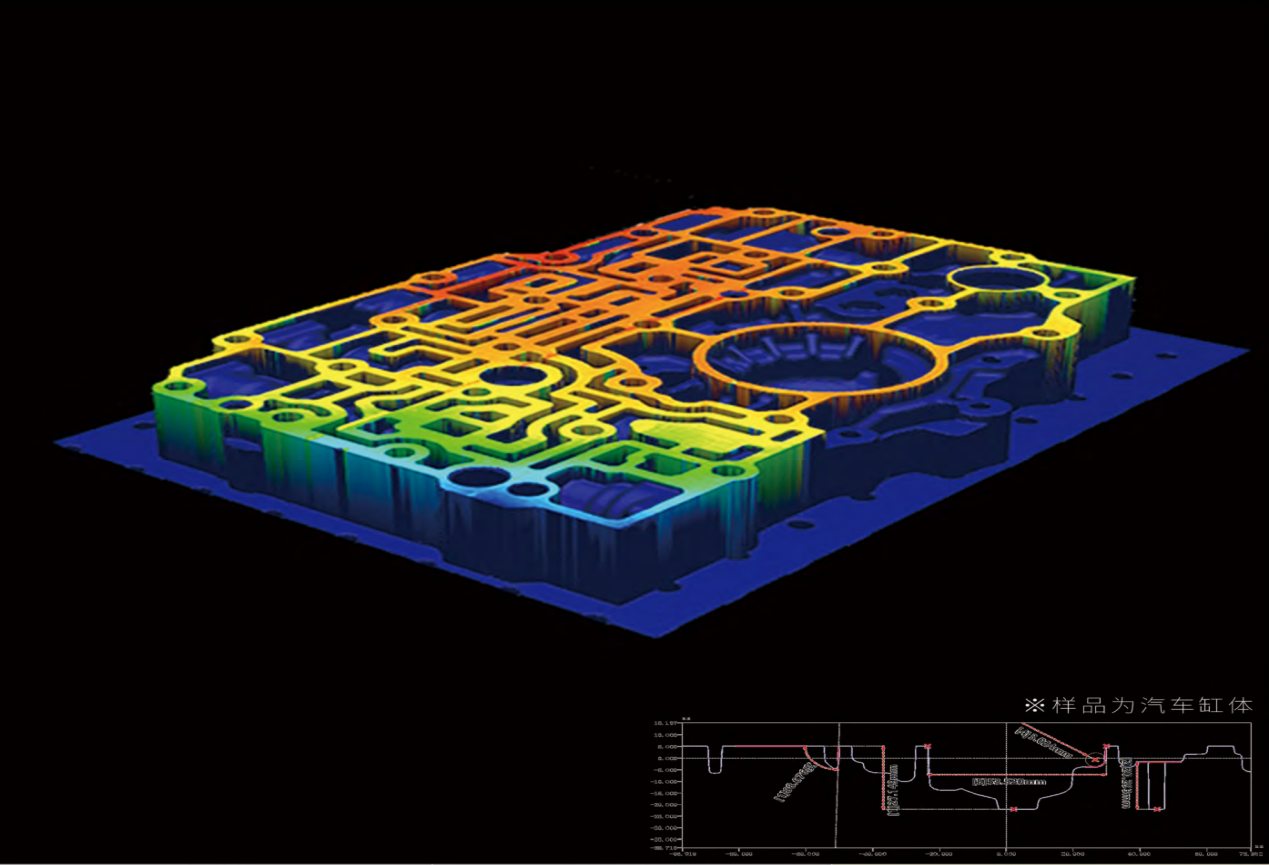
(以上為新啟航實測樣品數據結果)
②高精度大縱深:以±2μm精度實現最大130mm高度/深度掃描成像;?
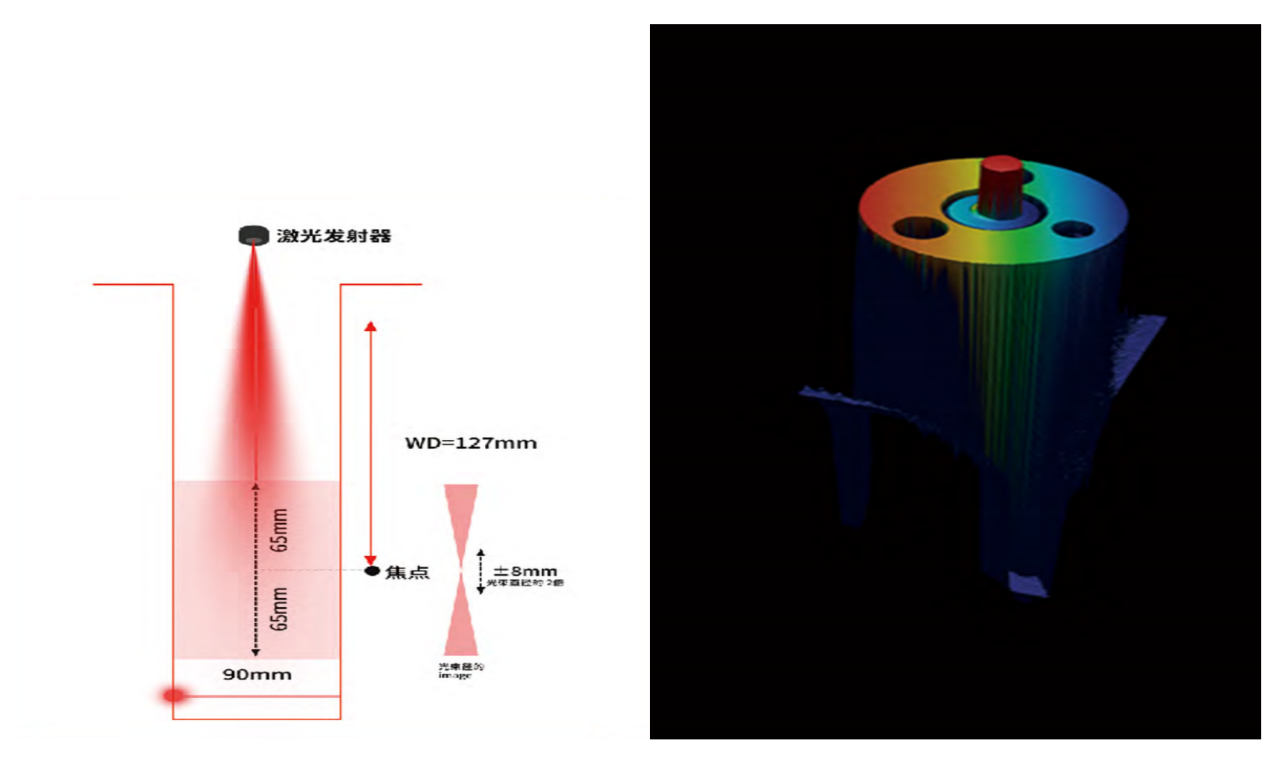
(以上為新啟航實測樣品數據結果)
③多鏡頭大視野:支持組合配置,輕松覆蓋數十米范圍的檢測需求。

(以上為新啟航實測樣品數據結果)
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54186瀏覽量
467872 -
IGBT
+關注
關注
1289文章
4356瀏覽量
263731
發布評論請先 登錄
半導體封裝引線鍵合技術:超聲鍵合步驟、優勢與推拉力測試標準

IGBT 封裝底部與散熱器貼合面平整度差,引發鍵合線與芯片連接部位應力集中,鍵合脆斷

IGBT 封裝底部與散熱器貼合面平整度差會使 IGBT 芯片受到不均勻的機械應力

IGBT 封裝底部與散熱器貼合面平整度差與 IGBT 的短路失效機理相關性




 IGBT 芯片平整度差,引發鍵合線與芯片連接部位應力集中,鍵合失效
IGBT 芯片平整度差,引發鍵合線與芯片連接部位應力集中,鍵合失效


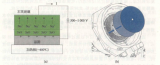
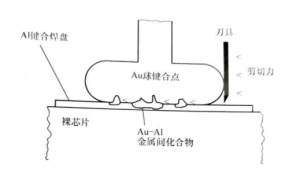








評論