電子元器件封裝中的引線鍵合工藝,是實現芯片與外部世界連接的關鍵技術。其中,金鋁鍵合因其應用廣泛、工藝簡單和成本低廉等優勢,成為集成電路產品中常見的鍵合形式。金鋁鍵合失效這種現象雖不為人所熟知,卻是電子設備可靠性的一大隱患。
為什么金鋁鍵合會失效
金鋁鍵合失效主要表現為鍵合點電阻增大和機械強度下降,最終導致電路性能退化或開路。其根本原因源于金和鋁兩種金屬的物理與化學特性差異。
1. 金屬間化合物形成(IMC)
當環境溫度升高,金原子和鋁原子開始相互擴散,在鍵合界面形成金屬間化合物,如Au?Al、Au?Al?和AuAl?。這些化合物具有較高的電阻率,且質地脆硬。它們的形成會顯著增加鍵合點的接觸電阻,并削弱其機械強度。
2. 柯肯德爾效應
由于金原子的擴散速率遠高于鋁原子,這種不對等的質量遷移導致界面處形成微觀空洞,即柯肯德爾空洞。空洞的匯聚和生長會減少鍵合點的有效接觸面積,直接導致鍵合強度降低,直至鍵合點分離。金屬間化合物的形成與柯肯德爾空洞的生長是相互關聯的物理化學過程,共同加速了鍵合界面的退化。
失效的主要影響因素
1. 溫度
環境溫度或器件工作溫度是加速失效的首要因素。溫度升高會顯著加快原子擴散速率和化學反應速度,從而急劇縮短鍵合界面的使用壽命。
2. 時間
金鋁鍵合的失效是一個隨時間累積的過程。即使在常規工作溫度下,經過足夠長的運行時間,鍵合界面性能的退化也會逐漸顯現。
解決方案與改進措施
面對金鋁鍵合的系統性問題,簡單的工藝參數調整已無法根本解決問題。實踐證明,最有效的解決方案是從材料體系入手,避免使用金鋁異質鍵合。金鑒實驗室提供專業的引線鍵合工藝評價服務,幫助企業評估和優化其引線鍵合技術,確保產品的性能和穩定性。
1. 金-金鍵合系統
當芯片鍵合區為金層時,采用金絲進行鍵合。該組合可實現同質金屬互聯,界面穩定,具有最高的可靠性。
2. 鋁-鋁鍵合系統
當芯片鍵合區為鋁層時,推薦使用硅鋁絲進行鍵合。純鋁絲機械強度不足且易氧化,添加約1%的硅元素形成的硅鋁絲,在保持單一金屬體系優勢的同時,改善了工藝性能和機械特性。
3. 其他替代方案
銅絲鍵合憑借其優良的導電性和機械強度,已成為中低端領域替代金絲的一種選擇。但需注意,銅與鋁同樣屬于異質金屬組合,存在類似的界面反應風險,且銅絲硬度較高,對工藝控制要求更為嚴格。
啟示與展望
金鋁鍵合失效問題給電子元器件可靠性工程帶來了重要啟示:在追求工藝簡便和成本控制的同時,不能忽視材料兼容性這一基礎科學問題。隨著電子設備向高性能、高可靠性方向發展,對鍵合工藝的要求也日益提高。通過材料體系的優化設計,從源頭上消除金屬間化合物形成的可能性,才能確保電子元器件在長期使用過程中的穩定性和可靠性。
-
芯片
+關注
關注
463文章
54007瀏覽量
465889 -
電子元器件
+關注
關注
134文章
3894瀏覽量
113914
發布評論請先 登錄



 電子元器件失效分析之金鋁鍵合
電子元器件失效分析之金鋁鍵合

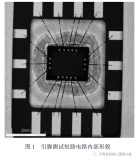




評論