文章來源:Jeff的芯片世界
原文作者:Jeff的芯片世界
本文介紹了芯片鍵合技術。
在半導體封裝工藝中,芯片鍵合(Die Bonding)是指將晶圓芯片固定到封裝基板上的關鍵步驟。鍵合工藝可分為傳統方法和先進方法:傳統方法包括芯片鍵合(Die Bonding)和引線鍵合(Wire Bonding),而先進方法主要指IBM在1960年代開發的倒裝芯片鍵合(Flip Chip)。倒裝芯片鍵合結合了模具鍵合和導線鍵合,通過在芯片襯墊上形成凸起來連接芯片和襯底。
芯片鍵合的重要性體現在多個方面:它提供機械支撐,使芯片牢固附著于封裝載體,抵御外部震動和溫度變化;它形成散熱路徑,將芯片工作時產生的熱量傳導到封裝或散熱層面;它確保精準定位,為后續電氣互聯(如焊線或倒裝焊)奠定基礎;從而提升器件的整體可靠性。如果貼裝不當,可能導致后續工藝偏移或連接失敗,影響器件性能。
主要鍵合方法
芯片鍵合的方法多樣,主要包括膠黏劑貼片、焊料貼片、共晶貼片和倒裝芯片貼片等。
膠黏劑貼片使用環氧樹脂或銀膠等半導體膠水進行粘接,優點包括工藝成熟、適用范圍廣,可在較低溫度下固化;但如果膠水厚度不均,可能因熱膨脹系數差異導致翹曲。
焊料貼片使用金屬焊料(如Sn-Pb、Sn-Ag-Cu或Au-Sn合金)在高溫下熔融,實現冶金連接,優點在于導電和導熱性能優異,結構牢固,適合高功率器件;但工藝溫度較高,需控制合金成分以避免空洞缺陷。
共晶貼片采用共晶焊料(如Au-Si、Au-Ge、Au-Sn等)在特定溫度下熔化形成共晶組織,實現牢固結合,可靠性極佳,但需要精確溫度控制且成本較高。
倒裝芯片貼片是一種先進方法,芯片通過凸塊翻轉貼到基板上,通過回流焊實現電氣和機械連接。嚴格來說,這更傾向于芯片互連工藝,但也可視為特殊貼裝方式。
此外,模貼膜(DAF)作為一種先進粘合方法,被廣泛使用。DAF是一種附著在芯片底部的薄膜,厚度可調整到更薄和恒定,不僅用于芯片與襯底的鍵合,還用于芯片與芯片的鍵合以創建多芯片封裝(MCP)。使用DAF可以跳過點膠程序,避免膠水厚度不均問題,但需要高精度設備處理,且可能因空氣穿透導致薄膜變形。
鍵合工藝流程
芯片鍵合的典型流程包括取放工藝、彈壓和粘合步驟。首先,在取放工藝(Pick & Place)中,設備從附著在膠帶上的芯片中單獨取出芯片(稱為“Pick”),然后將其放置在封裝基板表面(稱為“Place”)。這個過程可以通過輸入晶圓測試結果(Go/No Go)對好的芯片進行分選。
由于芯片由弱粘性附著在膠帶上,直接取放可能造成物理損傷,因此常使用彈射(Ejection)方法。彈射器對目標芯片施加物理力,使其與其他芯片產生輕微步長差異,然后從底部彈出芯片,同時用真空吸嘴從上面拉起,并用真空拉膠帶底部使薄片平整。
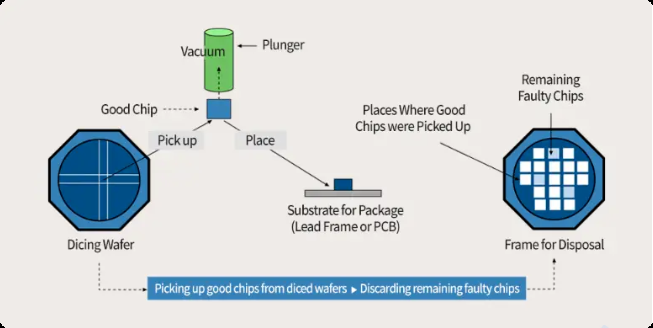
在粘合工藝中,如果使用環氧樹脂,需通過點膠將少量環氧樹脂精確涂在基板上,放置芯片后,在150°C至250°C下通過回流或固化硬化,將芯片和基材粘合。但環氧樹脂厚度不恒定可能導致翹曲。因此,DAF方法成為首選:它將芯片和DAF從切丁帶上取下后直接放置在基板上,無需點膠,簡化工藝并提高厚度均勻性。
對于傳統鍵合,首先在封裝基板上涂布粘合劑,然后放上芯片(引腳朝上);對于倒裝芯片鍵合,芯片引腳向下,焊料球凸起附著在襯墊上。組裝后單元通過溫度回流隧道,調節溫度以熔化粘合劑或焊料球,然后冷卻固定。
設備關鍵組成
Die Bonding設備由多個關鍵模塊組成,確保高精度和自動化。晶圓工作臺作為基礎平臺,承載并精確移動晶圓,保證芯片準確定位。芯片鍵合頭是實現物理連接的關鍵部件,通過熱壓、超聲波或激光等方式完成放置和焊接。框架傳輸系統負責芯片載體的自動傳輸與定位,提高生產效率。機器視覺系統利用高精度相機和圖像處理算法進行定位識別和質量檢測,是自動化生產不可或缺的部分。點膠系統在某些工藝中用于施加黏合劑或導電膠,控制膠量以保證鍵合效果。
此外,設備還包括供料和取片模塊(如頂針或真空吸頭從膠膜上取芯片)、對準系統(識別芯片和基板標記)、貼合頭(施加壓力、溫度或時間)、基板承載與定位單元(固定和移動基板)、以及控制與軟件系統(編排流程和監控參數)。
技術挑戰與發展趨勢
Die Bonding面臨多項技術挑戰。對準精度與速度需平衡,高精度要求微米級貼裝,同時需要高吞吐量;材料兼容與熱膨脹問題可能導致應力和形變;超薄芯片易彎曲或破裂,搬運方式需優化;空洞(Void)問題在焊料或膠水固化中可能降低接觸面積和可靠性。
應對措施包括采用先進視覺系統和智能算法、優化貼片溫度和曲線、使用柔性頂針和真空吸嘴、以及真空貼片或壓力固化排除空氣。
未來發展趨勢包括多芯片異構封裝,如系統級封裝(SiP)、Chiplet和3D封裝,要求設備具備多模塊、多材料貼裝能力;更高精度與自動化,結合AI視覺識別和精密運動控制;超薄與柔性器件貼裝,向非接觸傳輸和低應力方向發展;環保與低溫貼裝,發展低溫熔點合金或UV固化工藝。
?
-
芯片
+關注
關注
463文章
54007瀏覽量
465937 -
晶圓
+關注
關注
53文章
5408瀏覽量
132280 -
鍵合
+關注
關注
0文章
96瀏覽量
8272
原文標題:Die Bonding技術介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
介紹芯片鍵合(die bonding)工藝
MEMS工藝中的鍵合技術
熱壓鍵合工藝的技術原理和流程詳解




 芯片鍵合工藝技術介紹
芯片鍵合工藝技術介紹













評論