在半導體行業持續追求更高性能、更低功耗的今天,一種名為“SOI(Silicon-On-Insulat....
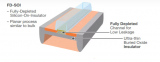
閂鎖效應(Latch-up)是CMOS集成電路中一種危險的寄生效應,可能導致芯片瞬間失效甚至永久燒毀....
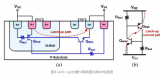
在半導體封裝領域,堆疊技術作為推動高集成度與小型化的核心趨勢,正通過垂直堆疊芯片或封裝實現更緊湊的封....

熱載流子注入效應(Hot Carrier Inject, HCI)是半導體器件(如晶體管)工作時,高....
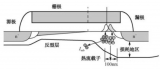
在功率半導體封裝領域,晶圓級芯片規模封裝技術正引領著分立功率器件向更高集成度、更低損耗及更優熱性能方....

薄膜刻蝕與薄膜淀積是集成電路制造中功能相反的核心工藝:若將薄膜淀積視為 “加法工藝”(通過材料堆積形....

3D封裝架構主要分為芯片對芯片集成、封裝對封裝集成和異構集成三大類,分別采用TSV、TCB和混合鍵合....

在過去的幾十年里,半導體器件緊湊型模型已經從 BJT Gummel-Poon 模型中的幾個參數發展到....
然而,隨著納米技術的出現,芯片制造過程越來越復雜,晶體管密度增加,導致導線短路或斷路的概率增大,芯片....

硅通孔(TSV)技術借助硅晶圓內部的垂直金屬通孔,達成芯片間的直接電互連。相較于傳統引線鍵合等互連方....

硅通孔(Through Silicon Via,TSV)技術是一種通過在硅介質層中制作垂直導通孔并填....

晶圓級封裝(WLP)與多芯片組件(MCM)作為先進封裝的“雙引擎”,前者在晶圓未切割時即完成再布線與....

半導體封裝正快速走向“堆疊+融合”:PoP把邏輯和存儲垂直整合,先測后疊保良率;光電路組裝用光纖替代....

系統級立體封裝技術作為后摩爾時代集成電路產業的核心突破方向,正以三維集成理念重構電子系統的構建邏輯。

目前車規級IGBT功率模塊主要采用硅基材料制作,與硅基半導體材料相比, 以SiC為代表的第三代半導體....

SOI(silicon-on-insulator,絕緣襯底上的硅)技術的核心設計,是在頂層硅與硅襯底....

隨著集成電路科學與工程的持續發展,當前集成電路已涵蓋二極管、晶體管、非易失性存儲器件、功率器件、光子....
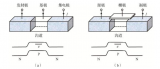
隨著封裝技術向小型化、薄型化、輕量化演進,封裝缺陷對可靠性的影響愈發凸顯,為提升封裝質量需深入探究失....

柵極電阻的存在對電路性能的影響很大,會引入熱噪聲,增大電路的噪聲系數,影響器件的開關速度和最大振蕩頻....
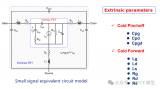
HBM通過使用3D堆疊技術,將多個DRAM(動態隨機存取存儲器)芯片堆疊在一起,并通過硅通孔(TSV....
隨著半導體工藝進入納米尺度,傳統體硅(Bulk CMOS)技術面臨寄生電容大、閂鎖效應等瓶頸。SOI....
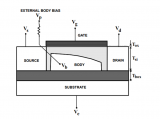
天然沙子里富含二氧化硅(SiO?),人們能夠從沙子中提取高純度單晶硅,以此制造集成電路。單晶硅對純度....

想象一下,如果我們能夠"聽見"分子的"聲音",那會是什么樣的?拉曼光譜技術正是這樣一種神奇的工具,它....

2025 光伏電池的研究起源可追溯至 1883 年,科學家 Charles Fritts 采用硒半導....
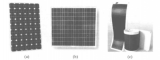
PMIC (Power Management Integrated Circuit):電源管理集成電....
為什么非彈性散射值得我們關注?因為這類散射過程產生了多種信號,每種信號都能提供比彈性電子更豐富的樣品....

離子注入單晶靶材時,因靶體存在特定晶向,其對入射離子的阻滯作用不再如非晶材料般呈現各向同性。沿硅晶體....

彈性散射電子是TEM圖像襯度的主要來源,同時也產生衍射圖樣(DPs)的大部分強度,因此理解控制這一過....

拉曼散射通常是一種非常微弱的效應,因為激發的光子與參與散射過程的分子之間存在非諧振的相互作用。因此,....
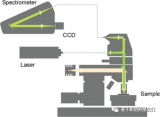
在空間輻射環境下,高能質子與重離子的作用會誘發單粒子效應。誘發這類單粒子效應的空間輻射,主要來源于兩....
