文章來源:學習那些事
原文作者:前路漫漫
本文介紹了離子注入技術中會遇到的常見問題。
溝道效應
離子注入單晶靶材時,因靶體存在特定晶向,其對入射離子的阻滯作用不再如非晶材料般呈現各向同性。沿硅晶體部分晶向觀察,能發現晶格間存在特定通道(圖 1)。當離子入射方向與靶材主晶軸平行時,部分離子會直接進入通道,極少與晶格原子發生核碰撞;這類雜質原子主要通過與電子相互作用降低自身能量,進而使注入深度顯著增加,該現象被稱為離子注入的 “溝道效應”。

圖 1
溝道效應的產生,源于入射離子與有序排列的靶晶體之間的相互作用。多年前,研究人員通過 Monte Carlo 模擬固體靶材中重金屬離子的注入分布,以及對千兆電子伏重離子在多晶金屬靶中分布剖面的測量,意外發現了這一效應。通常情況下,單晶硅襯底中最易發生溝道效應的晶向為 (110)(圖 1),原因是該晶向中間區域的原子密度最低。
溝道效應發生時,注入離子會到達更深位置,濃度分布也偏向較深區域,呈現出明顯的長拖尾;當輕原子注入重原子靶材時,注入離子的溝道效應(拖尾現象)尤為顯著(圖 2)。

圖 2
臨界角常用來描述離子注入的溝道效應,其計算公式為:

式中,E 為注入離子的能量,單位為 keV;d 為沿離子運動方向的原子間距,單位為 ?。若注入離子的運動方向與主晶軸方向的夾角遠大于臨界角,則溝道效應極少發生;反之,則易發生溝道效應。
不過存在一種特殊情況:初始時注入離子運動方向與主晶軸的夾角大于臨界角,溝道效應并未發生,但注入離子與靶原子發生多次碰撞后,運動方向發生改變,可能轉向某一晶軸方向,進而引發溝道效應。盡管無法完全排除這種情況,但此類事件的發生概率極低,因此不會對注入離子的濃度分布產生實質性影響。
實際工藝中,解決溝道效應的常用方法有(圖 3):① 采用非晶薄膜材料作為注入掩模,例如無定形二氧化硅(SiO?)薄膜等;② 將硅片傾斜一定角度,使注入離子運動方向與硅片主晶軸的夾角大于臨界角,通常傾斜 7°;③ 對硅片表面進行預非晶化處理(Pre-Amorphization Implantation, PAI),常用方式是注入與硅同族且原子量更大的鍺離子,這種方法僅需較低注入劑量就能實現硅片表面非晶化,且不會引入額外摻雜。
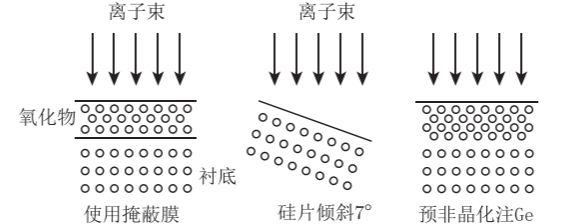
圖 3
陰影效應
當注入離子垂直硅片表面注入時,硅片表面所有區域均可受到離子注入(圖 4(a)),不存在陰影區域;但實際工藝中,為避免離子注入的溝道效應,需使注入離子運動方向與硅片主晶軸的夾角大于臨界角(通常為 7°)。此時若硅片表面存在具有一定高度的圖形(如光刻膠圖形或其他材料圖形,圖 4(b)),部分區域會處于離子注入的陰影區,無法被離子注入,且隨著圖形高度增加,陰影區域會逐漸擴大,該現象被稱為離子注入的 “陰影效應”(Shadow Effect)。
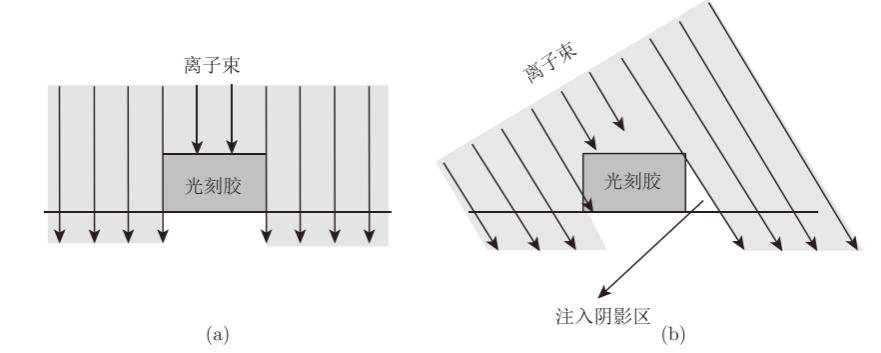
圖 4
降低或消除離子注入陰影效應的方法包括減小圖形高度、采用自旋轉多次注入等。
離子注入損傷
離子注入技術的核心優勢在于能精準控制注入摻雜雜質的數量與結深,但該過程屬于非平衡過程:大量碰撞動能會傳遞至靶原子,導致靶原子脫離晶格位置,進而使靶材襯底的晶體結構不可避免地產生損傷。
離子在減速過程中,一方面與電子發生非彈性相互作用,另一方面與其他靶原子產生彈性相互作用。若傳遞給靶材晶格原子的動能 E 超過其位移能(硅的位移能為 15eV),被碰撞的晶格原子便會脫離原有晶格位置并移動一定距離。這些經初次碰撞的原子會發生反沖,進而與其他原子產生二次碰撞,后續還會引發更多次碰撞。后續碰撞會產生大量低能量反沖現象,導致原子在近乎隨機的方向上發生小幅位移,這一過程被稱為碰撞級聯,持續時間約為 10?13s,該時長可通過離子范圍除以平均離子速度計算得出。以能量 200 keV 的 As 離子為例,其速度達 10?cm/s 時,在硅中的傳播范圍為 2×10??cm,對應的碰撞級聯過程可在 10?12s 內完成。碰撞級聯結束后,晶格與電子傳導會將能量重新分配至周圍材料,此過程額外持續 10?11~10?1?s;隨后的 10??s 內,不穩定的無序狀態會逐漸弛豫。離子注入前后,襯底晶體結構會發生變化,若注入能量或劑量過高,單晶襯底可能完全轉變為非晶狀態,這種結構變化與注入離子及襯底材料的特性均相關。
對于輕離子注入,初期能量損失以電子阻滯為主導。由于輕離子傳遞給靶原子的能量較低,散射角較大,僅能使少量靶原子發生位移,因此注入離子的運動方向變化明顯,產生的損傷密度低且不重疊,但損傷區域范圍較大,分布呈鋸齒狀(圖 5 (a))。
重離子則不同,其每次碰撞都會向靶原子傳遞較高能量,且散射角較小。獲得高能量的位移靶原子會持續移動,促使更多靶原子脫離原有晶格位置。此時,核阻滯成為注入離子能量損失的主要方式,重離子的射程較短,但會在小體積范圍內造成嚴重損傷,表現為損傷區域小、損傷密度高(圖 5 (b))。

圖 5
在靶材內部的碰撞過程中,核碰撞產生的能量損失通常遠高于靶原子的晶格結合能。因此,若離子注入時傳遞給晶格原子的能量超過其位移所需能量,晶格原子會脫離原有位置,導致晶格損傷。注入離子在襯底材料中逐步減速時,核碰撞的能量損失累積可能超過襯底材料的非晶化閾值,進而形成埋層非晶。隨著注入劑量增加,總累積能量上升,非晶層范圍會不斷擴大。通常會引入閾值劑量 θth 來量化這一過程,若注入劑量超過該閾值,晶格原子將受到完全損傷。此外,若靶晶格原子獲得的能量超過其位移能量的兩倍,被碰撞的晶格原子移位后仍保留較高能量,在后續運動中可能與其他晶格原子再次碰撞,促使更多晶格原子位移,這種連續碰撞現象被稱為 “級聯碰撞”。
大劑量離子注入時,晶圓在離子束作用下表面溫度會升高(即溫升效應),這一過程類似退火處理,可使注入離子在硅片中產生的部分缺陷發生遷移并實現修復,該現象稱為 “自退火效應”。此過程中,離子注入導致的缺陷產生與退火帶來的缺陷修復同時存在且相互競爭。隨著襯底溫度升高,離子注入的非晶化閾值劑量會相應提高(圖 6)。例如輕離子(如 B)注入時,能量損失主要由電子阻滯導致,因此其非晶化閾值劑量比重離子(P、As)高得多。
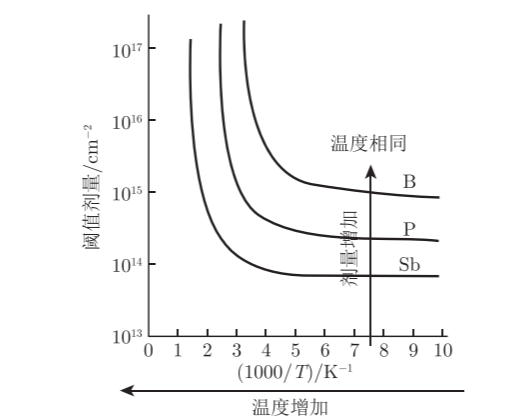
圖 6
熱退火
熱退火是離子注入的關鍵配套工藝,主要用于消除晶格損傷、恢復襯底晶體結構,同時讓間隙雜質進入替位位置獲得電活性,恢復載流子遷移率;為避免雜質再分布,需降低熱預算,這對源漏超淺結制備尤為重要,注入劑量超非晶化閾值時,退火會伴隨固相外延再生長,雜質或超該溫度下固溶度極限。
1. 射程末端(EOR)缺陷
高劑量離子注入會使單晶硅變非晶硅,退火后非晶 / 單晶界面易形成位錯環;非晶層外延再生長后,位錯環最大濃度出現在原界面下方,即射程末端缺陷,其源于界面處非晶化閾值損傷;這類缺陷若在 PN 結耗盡區附近,會增大反向電流,與金屬雜質結合還會加劇漏電流,需通過控制退火熱參數,讓缺陷處于高摻雜區且遠離耗盡區。

圖 7
2. 硼退火特性
硼是硅基常用 P 型雜質,用電學激活比例(自由空穴數與注入劑量比)衡量激活程度;低劑量注入時,硼的電學激活比例隨退火溫度單調遞增;高劑量時分為三區域:低溫區點缺陷移動增強,激活比例上升;500~600℃點缺陷形成擴展缺陷,硼被俘獲導致激活比例下降(逆退火特性);超 600℃硅中空位與間隙硼結合,激活比例再升,完全激活需 900℃以上高溫。
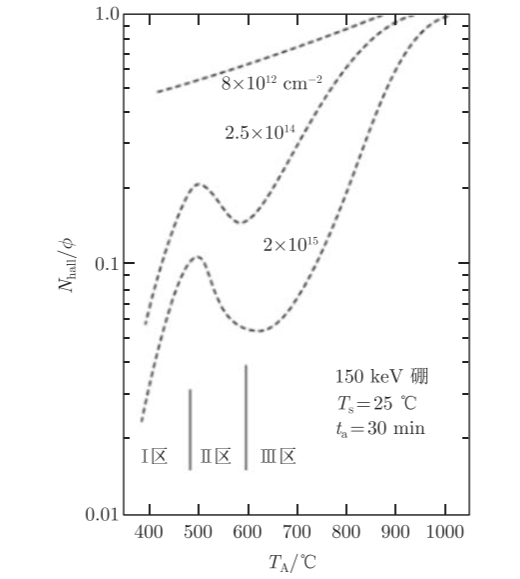
圖 8
3. 磷退火特性
磷是常用 N 型雜質,其退火特性與硼有差異;低劑量注入(3×1012~3×101?cm?2)時,磷的電學激活比例隨溫度升高遞增,與低劑量硼類似;高劑量注入(1×101?cm?2 及以上)時,因磷原子質量大易形成非晶層;借助低溫(約 600℃)固相外延再生長,磷原子可進入晶格替位位置,實現較高激活比例,無需像硼高劑量那樣依賴高溫。
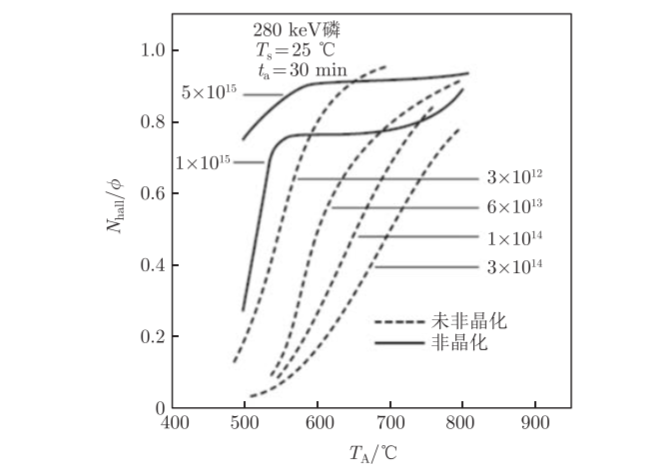
圖 9
淺結形成
對于先進 CMOS 器件而言,源漏超淺結仍是最關鍵的工藝環節之一,其在抑制晶體管短溝道效應中發揮重要作用。通常,制造極小尺寸 CMOS 器件時,源漏超淺結的深度不應超過溝道長度的 30%。
針對注入雜質硼,減少其瞬態增強擴散(Transient Enhanced Diffusion, TED)并實現完全激活是一大挑戰 —— 高摻雜意味著高注入劑量,會隨之產生大量缺陷,而這些缺陷會促進雜質擴散。一般情況下,注入離子在靶材內的分布可近似為高斯分布,但經過熱退火后,部分注入離子(尤其是硼)會偏離原有高斯分布,在分布曲線尾部出現明顯展寬,形成按指數衰減的長拖尾,這一現象即 “瞬態增強擴散效應”。目前普遍認為,該效應源于離子注入后殘留的缺陷(如高濃度空位、自間隙原子等):退火過程中,這些殘余缺陷中的間隙原子與硼結合,結合后的復合體擴散速率遠高于硼原子本身,最終導致雜質擴散增強。
表 1 列出了常用雜質在硅中穩態本征擴散與瞬時擴散的激活能。盡管硼與砷的瞬時擴散激活能相同,但目前學界普遍認為砷的瞬態增強擴散效應遠弱于硼,這種差異與注入襯底中缺陷湮滅的速率相關。對硼離子注入后的硅片進行快速熱退火時,瞬態增強擴散現象十分顯著,因此難以形成源漏超淺結。通過進一步降低注入離子能量、縮短退火時間,可減小離子注入與退火后形成的源漏超淺結深度。
表1常用雜質在硅中穩態本征擴散與瞬時擴散的激活能

然而,低能注入存在諸多問題:一是離子注入臨界角顯著增大,若采用常規 7° 傾斜注入,不僅會出現陰影效應,還會產生強烈自濺射現象,影響注入效率與效果;二是離子束穩定性面臨挑戰,在空間電荷效應作用下,低能離子束會逐漸發散,降低摻雜重復性與均勻性。針對這些問題,可采用離化大分子注入法 —— 通過大分子注入,能在常規能量下獲得與超低能注入等效的工藝效果。
硼離化大分子注入常選用 BF??離子束,因其是氣態硼源 BF?分子離化分解后的典型產物。BF??進入硅片等靶材后,離化大分子會立即分裂為單個硼原子與氟原子,且所有原子速率相同(即硼原子速度 v_B 等于氟原子速度 v_F)。其動能計算如下:
硼原子的動能:

氟原子的動能:

由于 v_B = v_F,結合硼(原子量 11)與氟(原子量 19)的原子量關系,可得:

根據上述計算,當加速電壓為 5kV 時,有效硼注入能量約為 1keV,無需減小加速電壓即可實現超低能注入效果(利于形成超淺結)。除 BF?外,十硼烷(B??H??)、十八硼烷(B??H??)等大分子固體材料,也可作為硼離化大分子注入的源材料。
另一類常用方法是預非晶化離子注入 —— 在硅片表面形成非晶層,可防止后續離子注入時出現溝道效應,進而控制注入結深。需注意的是,非晶層在退火過程中會發生固相外延再生長,雖結晶質量較好,但再結晶后可能殘留射程末端缺陷。為最大程度減少這類缺陷,可采用工藝參數為 1s/1000℃或 1s/1100℃的快速熱退火(RTA)或尖峰退火(Spike Annealing)。通常,以大分子材料作為 N 型或 P 型硅晶體(如 PMOS)的注入離子源時,預非晶化與離子注入摻雜過程可合二為一,簡化工藝流程;且熱退火后,非晶層通過固相外延再生長恢復為單晶狀態,此過程還能獲得更高的雜質摻雜濃度。
-
晶格
+關注
關注
0文章
96瀏覽量
9645 -
離子注入
+關注
關注
5文章
71瀏覽量
10665
原文標題:離子注入常見問題
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
鉺離子注入碳化硅后的射程分布和射程離散
離子注入技術有什么特點?
離子注入知識常見問答
離子注入技術的優點和應用

離子注入仿真用什么模型
離子注入工藝中的重要參數和監控手段

離子注入工藝中的常見問題及解決方案
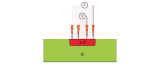



 離子注入技術的常見問題
離子注入技術的常見問題




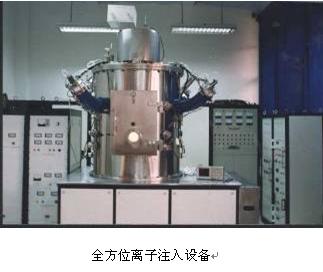
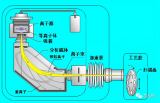




評論