在國際照明大廠競相投入下,智能照明市場正快速升溫,并掀起新一波LED驅(qū)動(dòng)器與封裝技術(shù)變革。為與傳統(tǒng)燈具相容,智能照明系統(tǒng)電路板設(shè)計(jì)空間極為有限,因此LED驅(qū)動(dòng)器與封裝業(yè)者已加速研發(fā)整合驅(qū)動(dòng)電路
2013-11-07 09:26:24 2515
2515 中芯長電半導(dǎo)體有限公司28日在江陰宣布正式開始為美國高通公司提供14納米硅片凸塊量產(chǎn)加工。這標(biāo)志著中芯長電成為中國大陸第一家進(jìn)入14納米先進(jìn)工藝技術(shù)節(jié)點(diǎn)產(chǎn)業(yè)鏈并實(shí)現(xiàn)量產(chǎn)的半導(dǎo)體公司。
2016-08-02 13:45:43 1276
1276 半導(dǎo)體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導(dǎo)體產(chǎn)品出現(xiàn)了系統(tǒng)級封裝(SiP)等新的封裝方式,從技術(shù)實(shí)現(xiàn)方法出現(xiàn)了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2022-07-13 16:50:15 2193
2193 倒裝芯片工藝是指通過在芯片的I/0 焊盤上直接沉積,或者通過 RDL 布線后沉積凸塊(包括錫鉛球、無鉛錫球、銅桂凸點(diǎn)及金凸點(diǎn)等),然后將芯片翻轉(zhuǎn),進(jìn)行加熱,使熔融的焊料與基板或框架相結(jié)合,將芯片的 I/0 扇出成所需求的封裝過程。倒裝芯片封裝產(chǎn)品示意圖如圖所示。
2023-04-28 09:51:34 5962
5962 
硅通孔(TSV) 是當(dāng)前技術(shù)先進(jìn)性最高的封裝互連技術(shù)之一。基于 TSV 封裝的核心工藝包括 TSV 制造、RDL/微凸點(diǎn)加工、襯底減薄、圓片鍵合與薄圓片拿持等。
2023-05-08 10:35:24 5731
5731 
)、凸塊制作(Bumping)及硅通孔(TSV)等工藝技術(shù),涉及與晶圓制造相似的光刻、顯影、刻蝕、剝離等工序步驟。
2023-08-07 10:59:46 3328
3328 
針對液晶驅(qū)動(dòng)芯片封裝晶圓電鍍金凸塊工藝制程,開發(fā)出一種新型亞硫酸鹽無氰電鍍金配方和工藝。[結(jié)果]自研無氰電鍍金藥水中添加了有機(jī)膦酸添加劑和晶體調(diào)整劑,前者能夠充分抑制鎳金置換,后者有助于形成低應(yīng)力
2024-06-28 11:56:15 3546
3546 
近期面板急單流竄,封測業(yè)界人士指出,近期臺(tái)灣LCD驅(qū)動(dòng)IC公司為分散風(fēng)險(xiǎn),將部分8吋金凸塊(Bumping)訂單下到日本、南韓代工廠,其中日系凸塊廠為求生存
2012-01-19 00:26:30 1230
1230 11 BGA封裝激光重熔釬料凸點(diǎn)制作技術(shù) 11.1 激光重熔釬料合金凸點(diǎn)的特點(diǎn) BGA/CSP封裝,F(xiàn)lip chip封裝時(shí)需要在基板或者芯片上制作釬料合金凸點(diǎn),釬料合金凸點(diǎn)的制作方法有:釬料濺射
2018-11-23 16:57:28
覆蓋膜,在關(guān)鍵位增加墊層介質(zhì),再疊層壓合,而后采用凸點(diǎn)模具沖壓電路板,形成電路板凸點(diǎn),電鍍鎳金,修整達(dá)到凸點(diǎn)平整、高度均勻,凸點(diǎn)金面光亮耐磨,不易下塌等效果。此工藝的常見產(chǎn)品應(yīng)用:打印機(jī)觸控排線柔性
2008-11-15 11:18:43
EtherCAT總線擴(kuò)展模塊包含哪些?怎樣去使用正運(yùn)動(dòng)技術(shù)運(yùn)動(dòng)控制器EtherCAT總線?
2021-09-27 08:34:04
的發(fā)展和創(chuàng)新,為人類社會(huì)的科技進(jìn)步和經(jīng)濟(jì)發(fā)展做出更大的貢獻(xiàn)。 隨著技術(shù)的進(jìn)步,目前市場上出現(xiàn)了板級的封裝,裸DIE通過凸點(diǎn),直接通過TCB熱壓鍵合實(shí)現(xiàn)可靠性封裝,是對BGA封裝的一種升級,省去
2023-04-11 15:52:37
器件的封裝,發(fā)展空間還相當(dāng)大。BGA封裝技術(shù)是在模塊底部或上表面焊有按陣列形式分布的許多球狀凸點(diǎn),通過焊料凸點(diǎn)實(shí)現(xiàn)封裝體與基板之間互連的一種封裝技術(shù)。在半導(dǎo)體IC的所有封裝類型中,1996~2001年
2015-10-21 17:40:21
(High Pin-Count)與高密度(High-Density) I/O Pad的扇出(Fanout)要求,而且凸塊(Bump)由于其優(yōu)越的導(dǎo)電性能與熱傳導(dǎo)性能,為芯片-封裝-系統(tǒng)的...
2021-07-23 06:59:24
LED封裝技術(shù)大都是在分立器件封裝技術(shù)基礎(chǔ)上發(fā)展與演變而來的,但卻有很大的特殊性。一般情況下,分立器件的管芯被密封在封裝體內(nèi),封裝的作用主要是保護(hù)管芯和完成電氣互連。而LED封裝則是完成輸出電信號(hào)
2016-11-02 15:26:09
` 本帖最后由 sushu 于 2013-3-20 09:34 編輯
是這樣的,我一開始沒有在前面板放置上凸盒,等到控件都弄好了以后才把上凸盒擺到前面板上。但這個(gè)時(shí)候想把控件再放到上凸盒里已經(jīng)不行了,控件會(huì)藏在上凸盒的下方,求問有什么辦法?`
2013-03-19 20:25:37
誰來闡述一下cof封裝技術(shù)是什么?
2019-12-25 15:24:48
楊建生(天水華天微電子有限公司)摘 要:本丈主要敘述了兩種BGA封裝(BGA—P 225個(gè)管腳和BGA—T 426個(gè)管腳)的安裝技術(shù)及可靠性方面的評定。關(guān)鍵詞:BGA—P封裝 BGA—T封裝 安裝
2018-08-23 17:26:53
。從2008年以后,隨著云計(jì)算、大數(shù)據(jù)、互聯(lián)網(wǎng)的出現(xiàn),互聯(lián)網(wǎng)現(xiàn)在進(jìn)入了工業(yè)互聯(lián)網(wǎng)的時(shí)代,也就是說它掀起了新一輪的產(chǎn)業(yè)變革。目前,中國制造正處于轉(zhuǎn)型升級的時(shí)期,“中國制造2025”行動(dòng)戰(zhàn)略指定了重點(diǎn)
2016-02-25 20:35:16
芯片的電極區(qū)制作好金屬凸點(diǎn),然后把金屬凸點(diǎn)與印刷基板上的電極區(qū)進(jìn)行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術(shù)中體積最小、最薄的一種。但如果基板的熱膨脹系數(shù)與LSI芯片不同,就會(huì)在接合處
2012-01-13 11:53:20
Nextreme公司日前宣布已經(jīng)通過其外部銅柱凸塊解決了當(dāng)今倒晶封裝芯片中的過熱問題。該技術(shù)在每個(gè)塊凸中嵌入了一個(gè)熱電制冷器,既可以冷卻芯片,也可以反過來從廢棄的熱量中制造能量
2018-08-29 10:10:22
的主流方式。倒裝芯片將作為高性能/高成本的內(nèi)部連接方式迅速發(fā)展并和引線鍵合長期共存,共同和硅片鍵合應(yīng)用在SiP、MCM、3D等新型封裝當(dāng)中。半導(dǎo)體前端工藝向封裝的延伸(倒裝芯片凸點(diǎn)生成)和封裝技術(shù)向前
2018-11-23 17:03:35
半導(dǎo)體技術(shù)是如何變革汽車設(shè)計(jì)產(chǎn)業(yè)的?
2021-02-22 09:07:43
盡管MEMS(微機(jī)電系統(tǒng))技術(shù)在氣囊和汽車壓力傳感器中的應(yīng)用已有大約20年,但促使大眾認(rèn)識(shí)到慣性傳感器作用的是任天堂的 Wii?和Apple? iPhone?手機(jī)。然而,在一定程度上,流行的看法
2019-07-16 06:49:53
推動(dòng)電源管理變革的5個(gè)趨勢
2021-03-11 07:50:56
封裝技術(shù)至關(guān)重要。衡量一個(gè)芯片封裝技術(shù)先進(jìn)與否的重要指標(biāo)是:芯片面積與封裝面積之比,這個(gè)比值越接近1越好。封裝時(shí)主要考慮的因素:芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1。引腳要盡量短以
2020-02-24 09:45:22
技術(shù)、多層印制板制作技術(shù)(包括多層陶瓷基板和BT樹脂基板)、芯片底部填充技術(shù)、焊球附接技術(shù)、散熱板附接技術(shù)等。它所涉及的封裝材料主要包括以下幾類。凸點(diǎn)材料:Au、PbSn和AuSn等;凸點(diǎn)下金屬化材料
2018-09-12 15:15:28
作者:Mats Andersson/Simon Glassman工業(yè)物聯(lián)網(wǎng)(Industrial Internet of Things, IIoT)風(fēng)潮持續(xù)發(fā)燒,全球制造業(yè)正掀起一波新變革。透過
2019-07-17 07:13:07
晶圓凸點(diǎn)模板技術(shù)和應(yīng)用效果評價(jià)詳細(xì)介紹了晶圓凸點(diǎn)目前的技術(shù)現(xiàn)狀,應(yīng)用效果,通過這篇文章可以快速全面了解晶圓凸點(diǎn)模板技術(shù)晶圓凸點(diǎn)模板技術(shù)和應(yīng)用效果評價(jià)[hide][/hide]
2011-12-02 12:44:29
` 晶圓級封裝是一項(xiàng)公認(rèn)成熟的工藝,元器件供應(yīng)商正尋求在更多應(yīng)用中使用WLP,而支持WLP的技術(shù)也正快速走向成熟。隨著元件供應(yīng)商正積極轉(zhuǎn)向WLP應(yīng)用,其使用范圍也在不斷擴(kuò)大。 目前有5種成熟
2011-12-01 14:33:02
晶圓級封裝技術(shù)源自于倒裝芯片。晶圓級封裝的開發(fā)主要是由集成器件制造廠家(IBM)率先啟動(dòng)。1964年,美國IBM公司在其M360計(jì)算器中最先采用了FCOB焊料凸點(diǎn)倒裝芯片器件。
2020-03-06 09:02:23
為聚亞酰胺材料僅適用于低溫接合技術(shù)(制程溫度低于攝氏200度),所以必須使用熱硬化黏膠,而非焊錫來提供機(jī)械性和電性的聯(lián)結(jié)。在這個(gè)研究中,我們使用低成本的柱形金凸塊技術(shù),而非其它類似應(yīng)用中所采用的錫鉛凸
2018-09-11 16:05:39
我們正處在汽車技術(shù)巨變的大門口。這次不是自動(dòng)化變革,雖然自動(dòng)化變革旋即到來。但這次變革是由現(xiàn)有的且快速發(fā)展的自動(dòng)化底層技術(shù)推動(dòng)。即高級駕駛員輔助系統(tǒng)(簡稱 ADAS)實(shí)現(xiàn)的防碰撞技術(shù)。
2020-05-01 06:45:20
隨著汽車電子技術(shù)的飛速發(fā)展,傳統(tǒng)的車用機(jī)械儀表盤已呈現(xiàn)出向數(shù)字儀表過度的趨勢,與之對應(yīng)的全部功能顯示也將被渲染后的高清畫面所取代。而引起這一巨大變革的根源,卻是一個(gè)只有一元硬幣大小的集成電子芯片--圖形儀表盤MCU(圖形儀表盤微控制單元),今天我們就以之為題為您講述汽車儀表變革背后的故事。
2019-07-09 06:03:04
主要軍事強(qiáng)國已經(jīng)嗅到了這股浪潮的氣息,紛紛制定標(biāo)準(zhǔn)、研發(fā)技術(shù)和推廣應(yīng)用,以期在新一輪軍事變革中占據(jù)有利位置。
2019-08-01 06:01:28
隨著集成電路設(shè)計(jì)師將更復(fù)雜的功能嵌入更狹小的空間,異構(gòu)集成包括器件的3D堆疊已成為混合與連接各種功能技術(shù)的一種更為實(shí)用且經(jīng)濟(jì)的方式。作為異構(gòu)集成平臺(tái)之一,高密度扇出型晶圓級封裝技術(shù)正獲得越來越多
2020-07-07 11:04:42
,不僅要開發(fā)光電器件技術(shù),也要開發(fā)光電器件封裝技術(shù)。此外,MCM封裝技術(shù)的發(fā)展也決定了光電子器件市場的發(fā)展。目前,光BGA以其性能和價(jià)格優(yōu)勢正成為封裝的主流技術(shù)。為滿足高速信號(hào)傳輸、微型化和低成本光傳輸網(wǎng)
2018-08-23 17:49:40
,目前的MCM已不只局限于將幾塊芯片平面安裝在一塊襯底上,而是采用埋置、有源基板或疊層技術(shù),在三維空間內(nèi)將多個(gè)不同工藝的芯片互連形成完整功能的模塊。 將MCM技術(shù)用于電力電子集成封裝的研究,核心內(nèi)容
2018-08-28 11:58:28
芯片封裝鍵合技術(shù)各種微互連方式簡介微互連技術(shù)簡介定義:將芯片凸點(diǎn)電極與載帶的引線連接,經(jīng)過切斷、沖壓等工藝封裝而成。載帶:即帶狀載體,是指帶狀絕緣薄膜上載有由覆 銅箔經(jīng)蝕刻而形成的引線框架,而且芯片
2012-01-13 14:58:34
請問NB-IoT技術(shù)風(fēng)頭正勁的原因是什么?
2021-06-15 09:24:31
我在IND4汽車人App可以幫助大家解答汽車電子相關(guān)技術(shù)問題,歡迎通過IND4汽車人App向我咨詢。在談到永磁同步電機(jī)的時(shí)候,經(jīng)常會(huì)講到兩個(gè)概念:凸極電機(jī)與隱極電機(jī)。有一些樸素的觀點(diǎn)是這么說:“轉(zhuǎn)子
2021-08-27 06:28:35
集成電路圓片級芯片封裝技術(shù)(WLCSP)及其產(chǎn)品屬于集成創(chuàng)新,是江陰長電先進(jìn)封裝有限公司結(jié)合了銅柱凸塊工藝技術(shù)及公司自身在封裝領(lǐng)域的技術(shù)沉淀,開發(fā)出的區(qū)別于國外技
2009-12-14 09:51:59 29
29 電將為美國高通公司提供14納米硅片凸塊量產(chǎn)加工。這是中芯長電繼規(guī)模量產(chǎn)28納米硅片凸塊加工之后,中國企業(yè)首次進(jìn)入14納米先進(jìn)工藝技術(shù)節(jié)點(diǎn)產(chǎn)業(yè)鏈并實(shí)現(xiàn)量產(chǎn)。
2016-08-04 11:42:23 1197
1197 凸優(yōu)化理論與應(yīng)用
2016-12-17 20:59:43 0
0 撐塊變化對凸極同步電動(dòng)機(jī)熱流場影響_路義萍
2017-01-08 11:37:44 0
0 天津戴卡汽車零部件有限公司是一家成立有12年歷史的企業(yè),將輪胎和輪轂裝配在一起,然后提供給整車企業(yè)進(jìn)行安裝,就是這家企業(yè)所從事的業(yè)務(wù)。 工業(yè)4.0掀起變革風(fēng)暴 戴卡汽車描繪智造藍(lán)圖 產(chǎn)業(yè)轉(zhuǎn)型升級的關(guān)鍵是技術(shù)進(jìn)步。
2017-01-09 09:08:11 1372
1372 ,保護(hù)管芯正常工作。現(xiàn)給大家介紹40種封裝技術(shù)。 1、BGA封裝(ballgridarray) 球形觸點(diǎn)陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點(diǎn)用以代替引腳,在印刷基板的正面裝配LSI芯片,然后用模壓樹脂或灌封方法進(jìn)行密
2017-10-20 11:48:19 30
30 BGA封裝在底部包含許多球形凸起管或在上表面。由于凸塊,封裝體和基座之間實(shí)現(xiàn)了互連。作為一種先進(jìn)的封裝技術(shù),BGA具有較大的引線空間和較短的引線,通過分布I/O端,在封裝體底部起到球或柱的作用。
2019-08-02 16:35:21 14592
14592 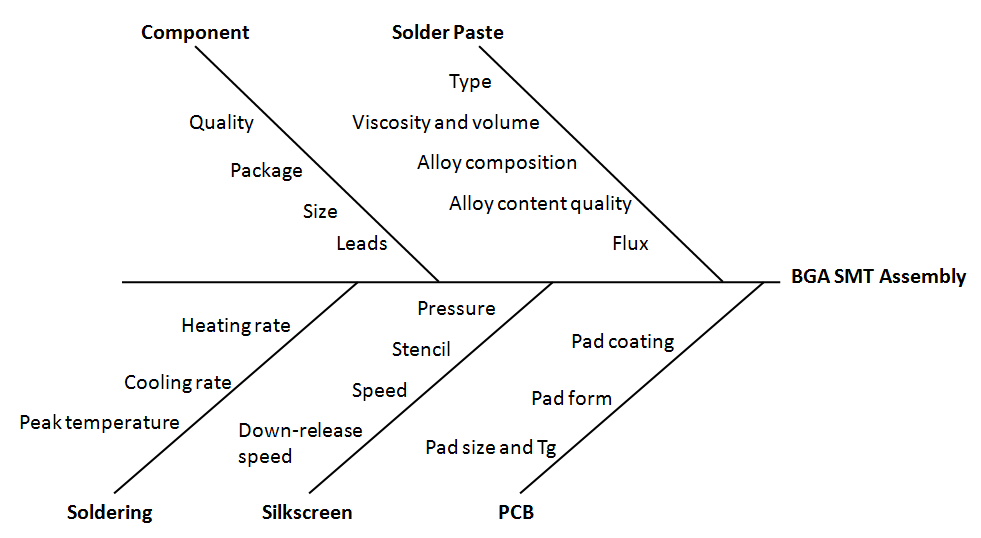
裸芯片封裝技術(shù)之一,在LSI 芯片的電極區(qū)制作好金屬凸點(diǎn),然后把金屬凸點(diǎn)與印刷基板上的電極區(qū)進(jìn)行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術(shù)中體積最小、最薄的一種。
2019-08-12 11:28:43 9444
9444 該銅柱適用于大多數(shù)電路板,能夠?qū)⑵涔潭ㄓ谄渌考稀;蛘邔⒉煌考?xiàng)目層疊,形成多層結(jié)構(gòu),是機(jī)器人、智能小車制作的必備緊固件。
2019-12-25 08:59:48 1780
1780 
已全部加載完成
 電子發(fā)燒友App
電子發(fā)燒友App














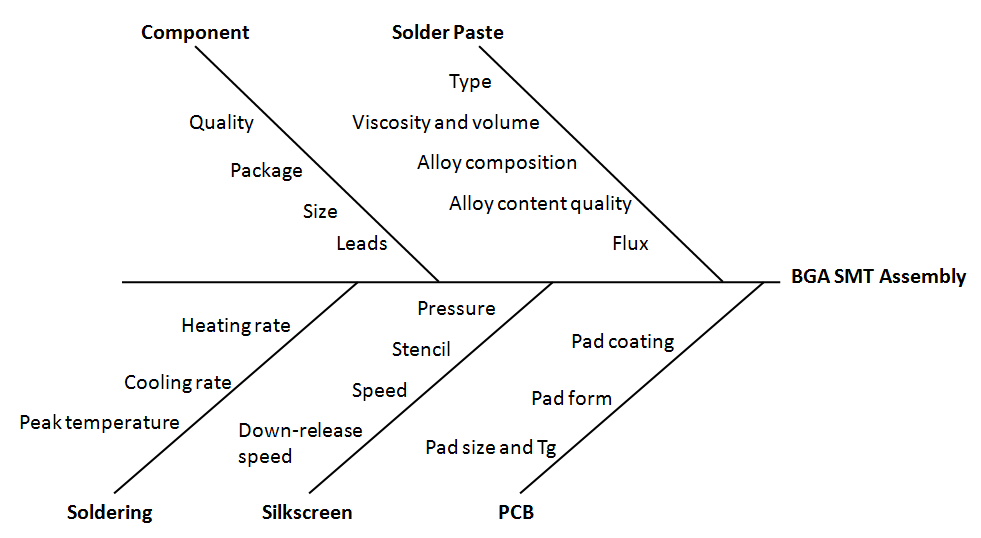







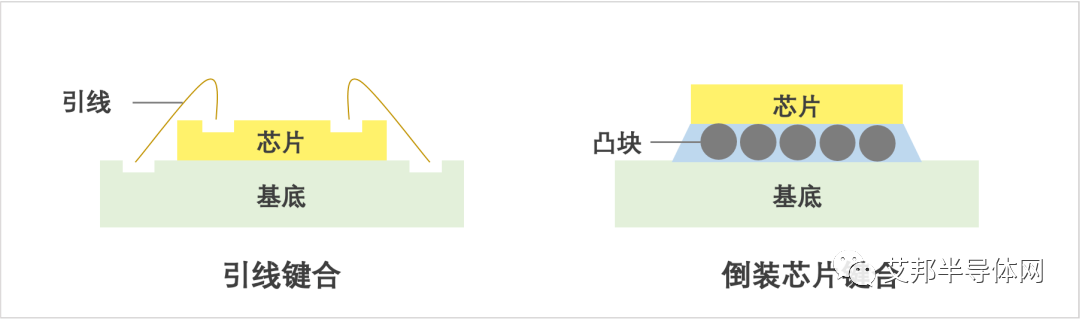








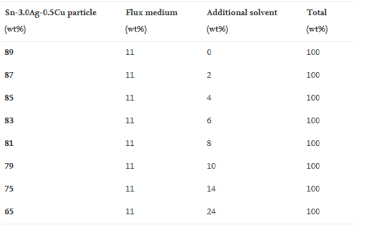

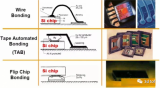




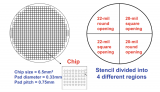

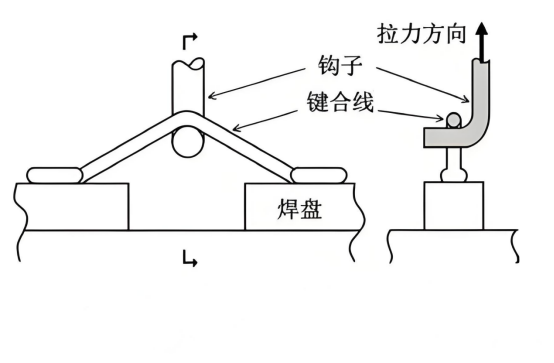







評論