全面解析3D芯片集成與封裝技術
- 調制解調器(40719)
- 封裝技術(69202)
- 3D芯片(19037)
相關推薦
熱點推薦
3D芯片封裝晶圓植球裝備關鍵技術研究
為了應對半導體芯片高密度、高性能與小體積、小尺寸之間日益嚴峻的挑戰,3D 芯片封裝技術應運而生。從工藝和裝備兩個角度詮釋了 3D 封裝技術;介紹了國內外 3D 封裝技術的研究現狀和國內市場對 3D
2022-11-11 09:43:08 3232
3232
 3232
32323D封裝熱設計:挑戰與機遇并存
隨著半導體技術的不斷發展,芯片封裝技術也在持續進步。目前,2D封裝和3D封裝是兩種主流的封裝技術。這兩種封裝技術在散熱路徑和熱設計方面有著各自的特點和挑戰。本文將深入探討2D封裝和3D封裝的散熱路徑及熱設計考慮。
2024-07-25 09:46:28 2651
2651
 2651
2651
臺積電SoIC封裝將量產!采用 3D 芯片間堆棧技術
臺積電傳出正在跟美國科技巨擘合作,共同開發系統整合芯片(SoIC)創新封裝科技,利用 3D 芯片間堆棧技術,讓半導體功能更強大。
2020-11-20 10:03:06 3583
3583
 3583
35833d全息聲音技術解析
不同于以往的立體聲、環繞聲概念,所謂3D全息聲音技術,就是通過音箱排列而成的陣列來對聲音進行還原,重現最自然、最真實的聲場環境。舉個最簡單的例子:在3D電影里,常常會出現物體從銀幕飛到觀眾眼前的鏡頭
2013-04-16 10:39:41
芯片的3D化歷程
正在從二維走向三維世界——芯片設計、芯片封裝等環節都在向3D結構靠攏。晶體管架構發生了改變當先進工藝從28nm向22nm發展的過程中,晶體管的結構發生了變化——傳統的平面型晶體管技術(包括體硅技術
2020-03-19 14:04:57
AD14簡易3D封裝制作問題
`新用AD軟件,需要用到一個散熱器的3D封裝,聽別人提起過AD14版本的可以制作簡單的.step文件,試了一下在PCB文件中放置3D原件對話框是可以生成3D模型的,但問題是這個模型我文件另存為后再導入到封裝庫中沒法使用啊(坐標無法調整),各位大神有沒有好的辦法麻煩指點一下。`
2017-12-10 00:10:33
AD16的3D封裝庫問題?
`AD16的3D封裝庫問題以前采用封裝庫向導生成的3D元件庫,都有芯片管腳的,如下圖:可是現在什么設置都沒有改變,怎么生成的3D庫就沒有管腳了呢?請問是什么原因?需要怎么處理,才能和原來一樣?謝謝!沒管腳的就是下面的樣子:`
2019-09-26 21:28:33
Altium Designer 09的3D封裝旋轉的問題
給PCB添加了3D模型之后,讓封裝旋轉45度,自己填加的3D模型旋轉45度后,代表3D模型的機械層不會和PCB重合;而用封裝向導畫的模型會和PCB重合。請問這個改怎么解決?雖然旋轉45度之后,在3D 模式下,3D圖也是旋轉了45度,但是在2D模式下的機械層看著很不舒服。
2017-07-20 22:46:11
Altium Designer13封裝導入3D無法顯示!求助!!!
各位親,我在Altium Designer中遇到下面的問題!希望得到幫助!下載了STEP格式的3D封裝,建好3D庫看封裝是可以顯示出來的如下圖:然后在PCB庫里放置3D body后,2D視圖下有顯示紅色框,如下圖:但是切換為3D視圖下卻并沒有3D封裝出現!請問解決辦法!!非常感謝!
2016-11-20 20:35:21
TI如何融入3D打印機技術
近年來,3D打印技術全面開花!好像隔兩天你就會聽到3D打印引領發展潮流的相關報道。最近,我讀到一篇有關第一臺太空3D打印機的報道。NASA希望3D打印將在某一天隨時隨地為打印備用零件提供資源,并且在
2018-09-11 14:04:15
什么叫3D微波技術
當3D電影已成為影院觀影的首選,當3D打印已普及到雙耳無線藍牙耳機,一種叫“3D微波”的技術也悄然而生。初次聽到“3D微波”,你可能會一臉茫然,這個3D微波是應用在哪個場景?是不是用這種技術的微波爐1秒鐘就能把飯煮熟?O M G!我覺得很有必要給大家科普一下!
2019-07-02 06:30:41
使用DLP技術的3D打印
使用DLP技術的3D打印光固化成形法 (SLA),一個常見的3D打印工藝,與傳統打印很相似。與硒鼓將碳粉沉積在紙張上很類似,3D打印機在連續的2D橫截面上沉淀數層材料,這些材料一層層的疊加
2022-11-18 07:32:23
浩辰3D的「3D打印」你會用嗎?3D打印教程
3D打印技術是綜合了三維數字技術、控制技術、信息技術眾多技術的創新研發技術,具有設計樣式多元化、試制成本低、制作材料豐富等特點。通過數字化設計工具+3D打印技術相結的模式,可以幫助企業高效實現創新
2021-05-27 19:05:15
畫PCB 3D封裝問題
我用ALTIUM10 畫PCB封裝 從網上下載的3D模型怎么導入的時候顯示不了,前幾天還可以顯示 現在一個都顯示不了, 是不是弄錯了, 手動畫3D 又能顯示方塊模型 導入的時候就一點效果都沒有像沒有導入3D模型一樣, 求大師指點。
2016-07-12 22:48:20
采用DLP技術的3D機器視覺參考設計包括BOM
描述3D 機器視覺參考設計采用德州儀器 (TI) 的 DLP 軟件開發套件 (SDK),使得開發人員可以通過將 TI 的數字微鏡器件 (DMD) 技術與攝像頭、傳感器、電機和其他外設集成來輕松構建
2018-10-12 15:33:03
單片型3D芯片集成技術與TSV的研究
單片型3D技術實現的關鍵在于如何將各層功能單元轉換到單片3D堆疊結構之中去,其采用的方法非常類似于Soitec在制作SOI晶圓時所采用的SMARTCUT技術
2011-05-04 11:27:21 2198
2198
 2198
2198
3D視頻技術全面解析
3D如果拍攝、制作精良,看起來會感覺非常好,現場感很強和畫面非常有沖擊力。有些3D電影是通過后期制作實現的,如果制作得不好還不如2D的電影,因為通過軟件把二維轉成三維,如
2011-07-26 09:19:32 3928
3928
 3928
3928
3D封裝技術及其發展
隨著國際電子信息行業新的變革, 3D封裝 蓬勃興起。為了在封裝之內硬塞進更多功能,芯片制造商被推到了極限。此外,我們不能忘記更加棘手的互連問題。采用Z方向封裝,或者說3
2011-09-16 17:38:08 3558
3558
 3558
35583D集成系統的測試挑戰
封裝技術的進步推動了三維(3D)集成系統的發展。3D集成系統可能對基于標準封裝集成技術系統的性能、電源、功能密度和外形尺寸帶來顯著改善。雖然這些高度集成系統的設計和測試
2012-06-01 09:25:32 2104
2104
 2104
2104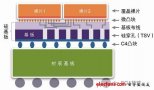
3D打印技術詳解,3D打印技術在地學信息領域的應用
3D打印技術近年來得到普遍關注。目前,3D打印技術在各領域的應用已取得明顯進展,但是3D打印技術還沒有得到全面應用。就地學信息領域而言,僅在個別部門得到初步應用。
2017-06-23 10:32:12 4346
4346
 4346
4346兩張圖看懂Intel3D邏輯芯片封裝技術
在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 16:03:40 9951
9951
 9951
9951英特爾為你解說“Foveros”邏輯芯片3D堆疊技術
在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 8854
8854
 8854
8854英特爾邏輯芯片3D堆疊技術“Foveros” 將實現世界一流性能
英特爾近日向業界推出了首款3D邏輯芯片封裝技術“Foveros”,據悉這是在原來的3D封裝技術第一次利用3D堆疊的優點在邏輯芯片上進行邏輯芯片堆疊。也是繼多芯片互連橋接2D封裝技術之后的又一個顛覆技術。
2018-12-14 16:16:45 3316
3316
 3316
3316Global Foundries 12nm工藝的3D封裝安謀芯片面世
對于3D封裝技術,英特爾去年宣布了其對3D芯片堆疊的研究,AMD也談到了在其芯片上疊加3D DRAM和SRAM的方案。
2019-08-13 10:27:53 3414
3414
 3414
3414硅3D集成技術解決方案在傳感器應用中的主要挑戰
從低密度的后通孔TSV 硅3D集成技術,到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發現許多開發新產品的機會。本文概述了當前新興的硅3D集成技術,討論了圖像傳感器
2020-01-16 09:53:00 1550
1550
 1550
1550硅3D集成技術全面解析
從最初為圖像傳感器設計的硅2.5D集成技術,到復雜的高密度的高性能3D系統,硅3D集成是在同一芯片上集成所有功能的系統芯片(SoC)之外的另一種支持各種類型的應用的解決方案,可用于創建性價比更高的系統。
2020-04-10 17:38:49 3497
3497
 3497
3497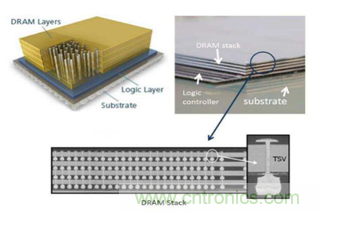
3D封裝技術定義和解析
SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內系統集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強調封裝內包含了某種系統的功能封裝,3D封裝僅強調在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 7076
7076
 7076
7076X-Cube?3D 系列推進 3D 封裝工藝發展
前有臺積電的 CoWoS,Intel 的 Foveros,現在三星也公布了自家的 3D 封裝技術 X-Cube。顯而易見的是,未來我們買到的電子產品中,使用 3D 封裝技術的芯片比例會越來越高。
2020-08-24 14:39:25 3046
3046
 3046
3046繼Intel、臺積電推出3D芯片封裝后,三星宣布新一代3D芯片技術
在Intel、臺積電各自推出自家的3D芯片封裝技術之后,三星也宣布新一代3D芯片技術——X-Cube,基于TSV硅穿孔技術,可以將不同芯片搭積木一樣堆疊起來,目前已經可以用于7nm及5nm工藝。
2020-10-10 15:22:58 2004
2004
 2004
2004臺積電3D封裝芯片計劃2020年量產
11月19日消息,據報道,臺積電與Google等美國客戶正在一同測試,合作開發先進3D堆棧晶圓級封裝產品,并計劃2022年進入量產。臺積電將此3D堆棧技術命名為“SoIC封裝”,可以垂直與水平的進行芯片鏈接及堆棧封裝。
2020-11-20 10:56:30 2854
2854
 2854
2854臺積電正在打造支持3D堆棧封裝技術建設的工廠
近日,據外國媒體報道谷歌和AMD,正在幫助臺積電測試和驗證3D堆棧封裝技術,將成為臺積電這一芯片封裝技術的首批客戶。報道中提到,臺積電正在打造支持3D堆棧封裝技術建設的工廠,預計明年建成。
2020-11-23 16:21:06 2515
2515
 2515
2515英特爾異構3D系統級封裝集成
異構 3D 系統級封裝集成 3D 集成與封裝技術的進步使在單個封裝(包含采用多項技術的芯片)內構建復雜系統成為了可能。 過去,出于功耗、性能和成本的考慮,高級集成使用單片實施。得益于封裝與堆疊技術
2021-03-22 09:27:53 2981
2981
 2981
29812.5D/3D芯片-封裝-系統協同仿真技術研究
(Signal Integrity, SI)、電源完整性 (Power
Integrity, PI) 及可靠性優化。總結了目前 2.5D/3D 芯片仿真進展與挑戰,介紹了基于芯片模型的
Ansys 芯片-封裝-系統 (CPS) 多物理場協同仿真方法,闡述了如何模擬芯片在真實工況下達到優化
芯片信
2022-05-06 15:20:42 19
19
 19
19分享一下小芯片集成的2.5D/3D IC封裝技術
異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418
 5418
5418為什么選擇3D,3D芯片設計要點分析
然已經有很多關于 3D 設計的討論,但對于 3D 的含義有多種解釋。然而,這不僅僅是語義,因為每個封裝選項都需要不同的設計方法和技術。
2023-03-27 13:01:38 1147
1147
 1147
1147一文解析3D芯片集成與封裝技術
Infineon芯片是一種多集成的無線基帶SoC芯片。功能(GPS、調頻收音機、BT.)同樣的eWLB產品也有自2010年以來,諾基亞一直在生產手機。
2023-03-30 12:57:26 2211
2211
 2211
2211日本計劃量產2nm芯片,著眼于2.5D、3D封裝異構技術
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 1652
1652
 1652
16523D封裝結構與2.5D封裝有何不同?3D IC封裝主流產品介紹
2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 5284
5284
 5284
5284
基于HFSS的3D多芯片互連封裝MMIC仿真設計
相對于傳統平面型的金絲鍵合焊接的MMIC應用,三維(3D)多芯片互連封裝MMIC以其高集成度、低損耗、高可靠性等性能優勢,正逐步在先進電路與系統中得到應用。而3D封裝引入的復雜電磁耦合效應,在傳統
2023-08-30 10:02:07 5731
5731
 5731
5731
三星2024年將推出先進3D芯片封裝技術SAINT
三星計劃在2024年先進3D芯片封裝技術SAINT(Samsung Advanced Interconnection Technology,三星高級互連技術),能以更小尺寸的封裝,將AI芯片等高性能芯片的內存和處理器集成。
2023-11-15 11:09:30 2499
2499
 2499
2499智原推出2.5D/3D先進封裝服務, 無縫整合小芯片
(Interposer)制造服務以連接小芯片(Chiplets),并與一流的晶圓代工廠和測試封裝供貨商緊密合作,確保產能、良率、質量、可靠性和生產進度,從而實現多源小芯片的無縫整合,進而保證項目的成功。 智原不僅專注于技術,更為每位客戶量身打造2.5D/3D先進封裝服務。作為一個中立的服務廠商,智原在包
2023-11-20 18:35:42 1107
1107
 1107
1107英特爾量產3D Foveros封裝技術
英特爾在封裝技術方面取得了重大突破,并已經開始大規模生產基于3D Foveros技術的產品。這項技術使得英特爾能夠在單個封裝中整合多個小芯片(Chiplets),從而提高了芯片的性能、尺寸和設計靈活性。
2024-01-26 16:04:50 1281
1281
 1281
1281探秘2.5D與3D封裝技術:未來電子系統的新篇章!
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 5268
5268
 5268
5268
混合鍵合技術:開啟3D芯片封裝新篇章
Bonding)技術應運而生,并迅速成為3D芯片封裝領域的核心驅動力。本文將深入探討混合鍵合技術在3D芯片封裝中的關鍵作用,分析其技術原理、應用優勢以及未來發展
2024-08-26 10:41:54 2476
2476
 2476
2476
一文理解2.5D和3D封裝技術
隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。
2024-11-11 11:21:51 5379
5379
 5379
5379
技術資訊 | 2.5D 與 3D 封裝
加速器中的應用。3D封裝提供了出色的集成度,高效的散熱和更短的互連長度,是高性能應用的理想之選。在快速發展的半導體技術領域,封裝在很大程度上決定了電子設備的性能、
2024-12-07 01:05:05 2506
2506
 2506
2506
技術前沿:半導體先進封裝從2D到3D的關鍵
技術前沿:半導體先進封裝從2D到3D的關鍵 半導體分類 集成電路封測技術水平及特點?? ? 1. 發展概述 ·自20世紀90年代以來,集成電路封裝技術快速發展,推動了電子產品向小型化和多功能方向邁進
2025-01-07 09:08:19 3353
3353
 3353
3353
2.5D和3D封裝技術介紹
整合更多功能和提高性能是推動先進封裝技術的驅動,如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統的flip-chip要求每個IC單獨封裝,并通過傳統PCB技術與其他IC集成
2025-01-14 10:41:33 2903
2903
 2903
2903
芯片3D堆疊封裝:開啟高性能封裝新時代!
在半導體行業的快速發展歷程中,芯片封裝技術始終扮演著至關重要的角色。隨著集成電路設計復雜度的不斷提升和終端應用對性能、功耗、尺寸等多方面要求的日益嚴苛,傳統的2D封裝技術已經難以滿足市場的需求。在此背景下,芯片3D堆疊封裝技術應運而生,成為半導體技術發展的新里程碑。
2025-02-11 10:53:45 2819
2819
 2819
2819
高密度3-D封裝技術全解析
隨著半導體技術的飛速發展,芯片集成度和性能要求日益提升。傳統的二維封裝技術已經難以滿足現代電子產品的需求,因此,高密度3-D封裝技術應運而生。3-D封裝技術通過垂直堆疊多個芯片或芯片層,實現前所未有的集成密度和性能提升,成為半導體封裝領域的重要發展方向。
2025-02-13 11:34:38 1614
1614
 1614
1614
3D封裝與系統級封裝的背景體系解析介紹
3D封裝與系統級封裝概述 一、引言:先進封裝技術的演進背景 隨著摩爾定律逐漸逼近物理極限,半導體行業開始從單純依賴制程微縮轉向封裝技術創新。3D封裝和系統級封裝(SiP)作為突破傳統2D平面集成限制
2025-03-22 09:42:56 1794
1794
 1794
1794
多芯粒2.5D/3D集成技術研究現狀
面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。2.5D/3D 集成技術正快速發展,集成方案與集成技術日新月異。
2025-06-16 15:58:31 1507
1507
 1507
1507
Chiplet與3D封裝技術:后摩爾時代的芯片革命與屹立芯創的良率保障
在摩爾定律逐漸放緩的背景下,Chiplet(小芯片)技術和3D封裝成為半導體行業突破性能與集成度瓶頸的關鍵路徑。然而,隨著芯片集成度的提高,氣泡缺陷成為影響封裝良率的核心挑戰之一。
2025-07-29 14:49:39 855
855
 855
855
【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估
一、引言
隨著半導體技術向小型化、高性能化發展,3D 集成封裝技術憑借其能有效提高芯片集成度、縮短信號傳輸距離等優勢,成為行業發展的重要方向 。玻璃晶圓因其良好的光學透明性、化學穩定性及機械強度
2025-10-14 15:24:56 317
317
 317
317
簡單認識3D SOI集成電路技術
在半導體技術邁向“后摩爾時代”的進程中,3D集成電路(3D IC)憑借垂直堆疊架構突破平面縮放限制,成為提升性能與功能密度的核心路徑。
2025-12-26 15:22:38 195
195
 195
195
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能和集成度,還能有效降低功耗,為AI和高性能計算等領域提供強有力的
2024-07-11 01:12:00 8591
8591
 8591
8591 電子發燒友App
電子發燒友App









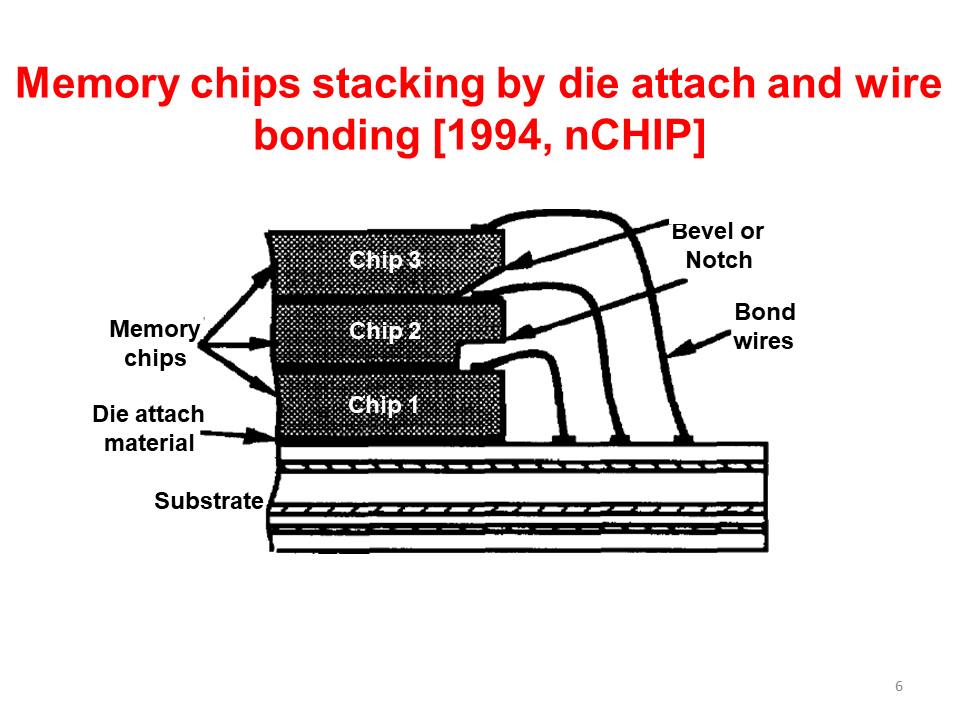
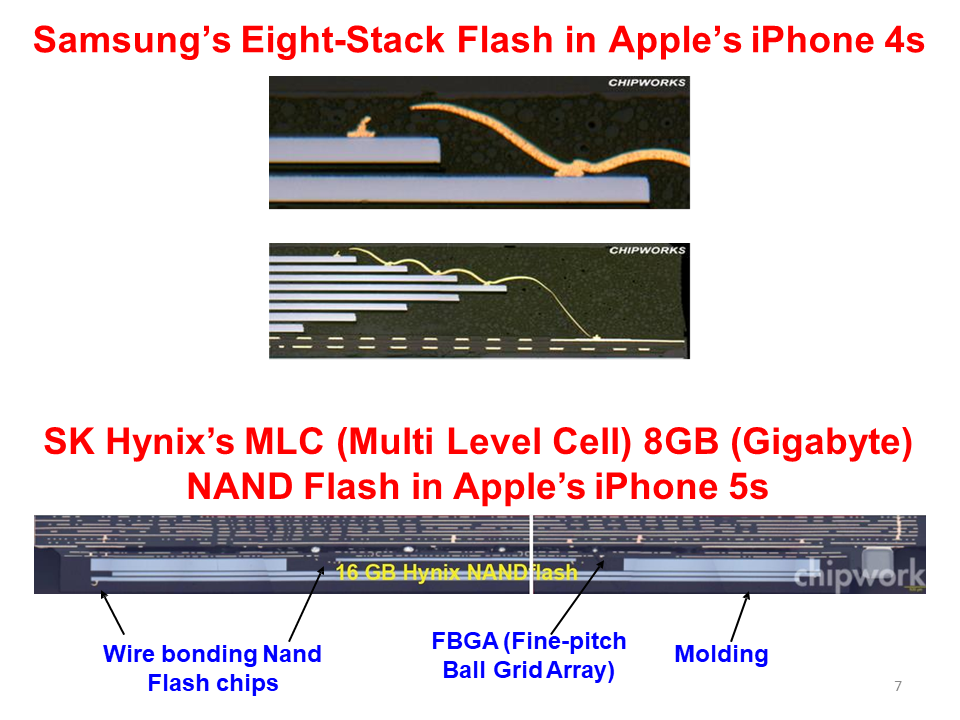
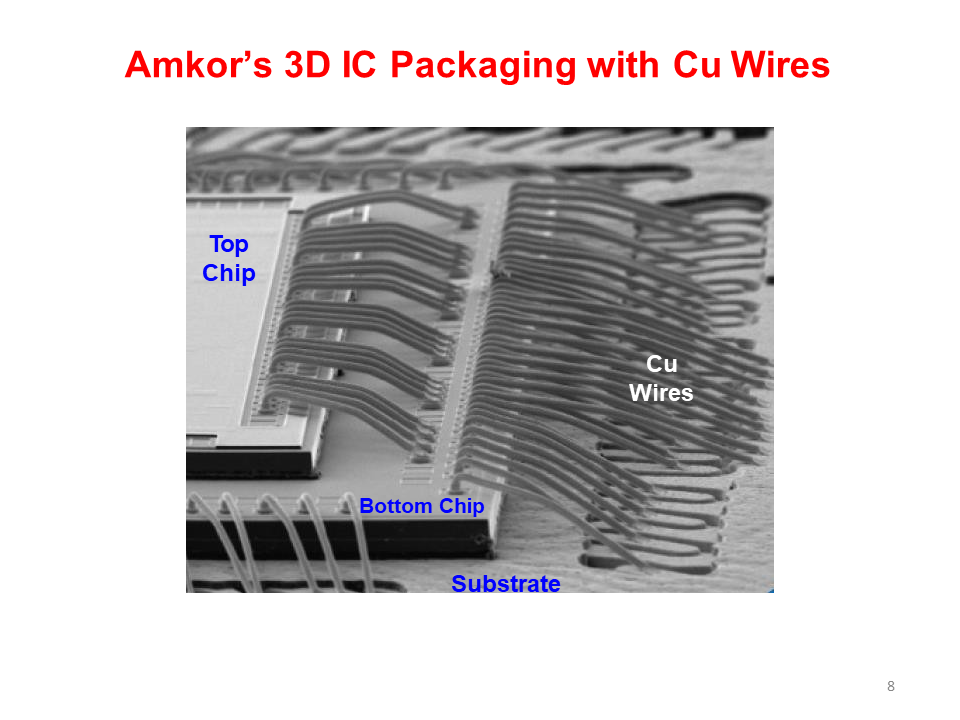

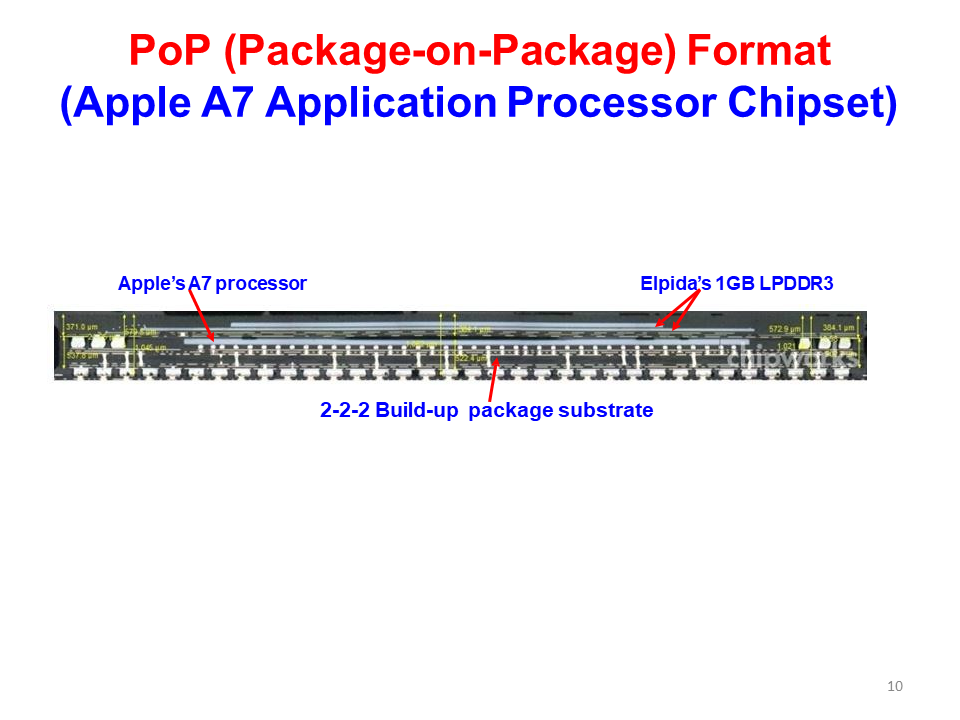
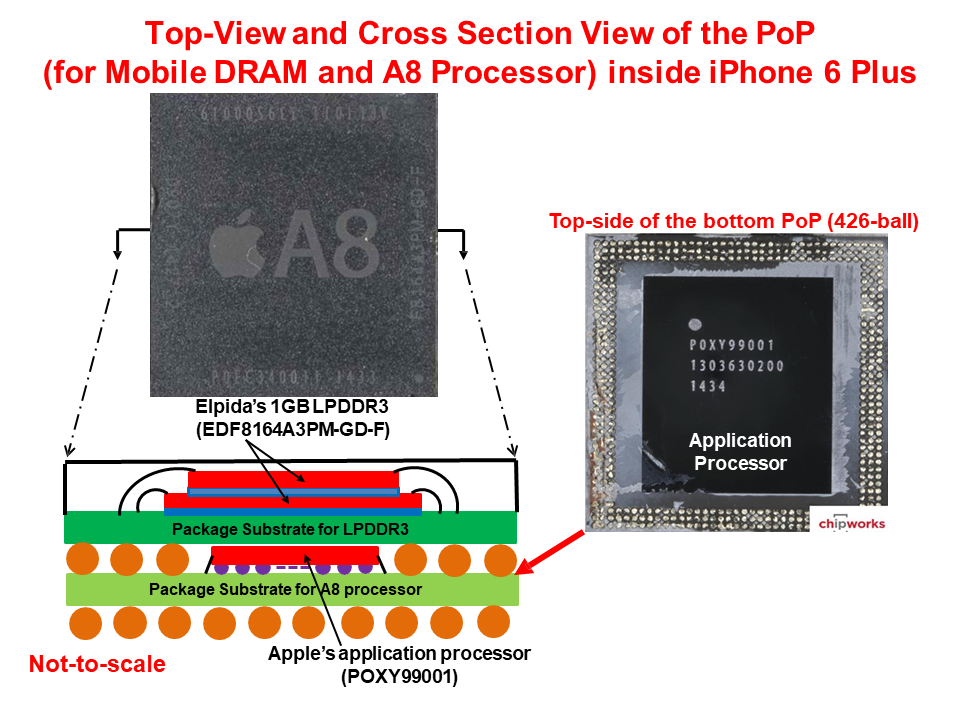
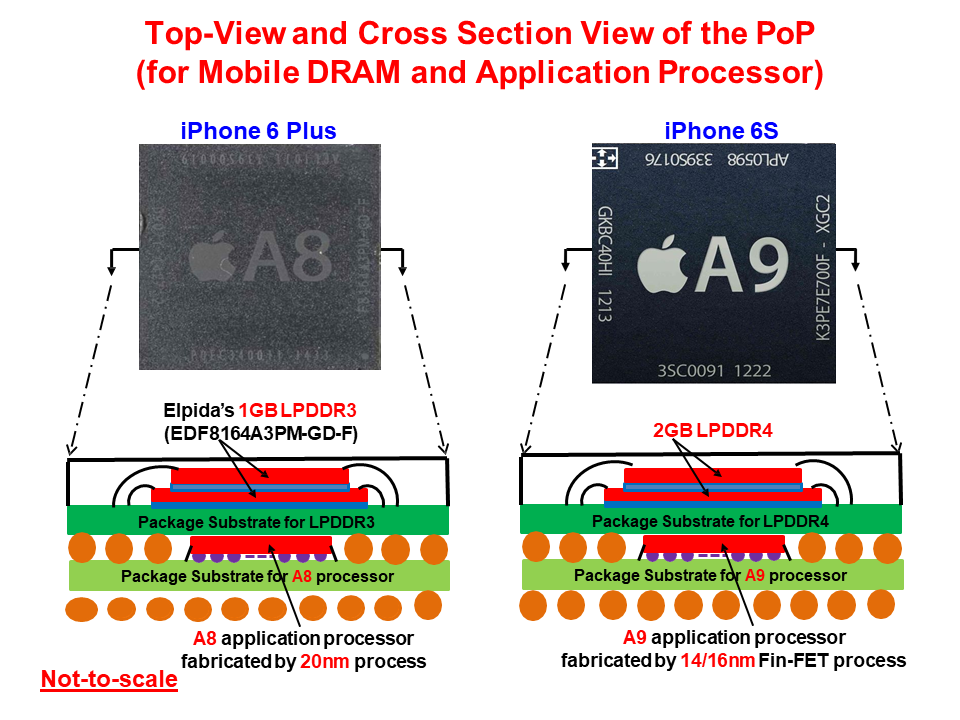
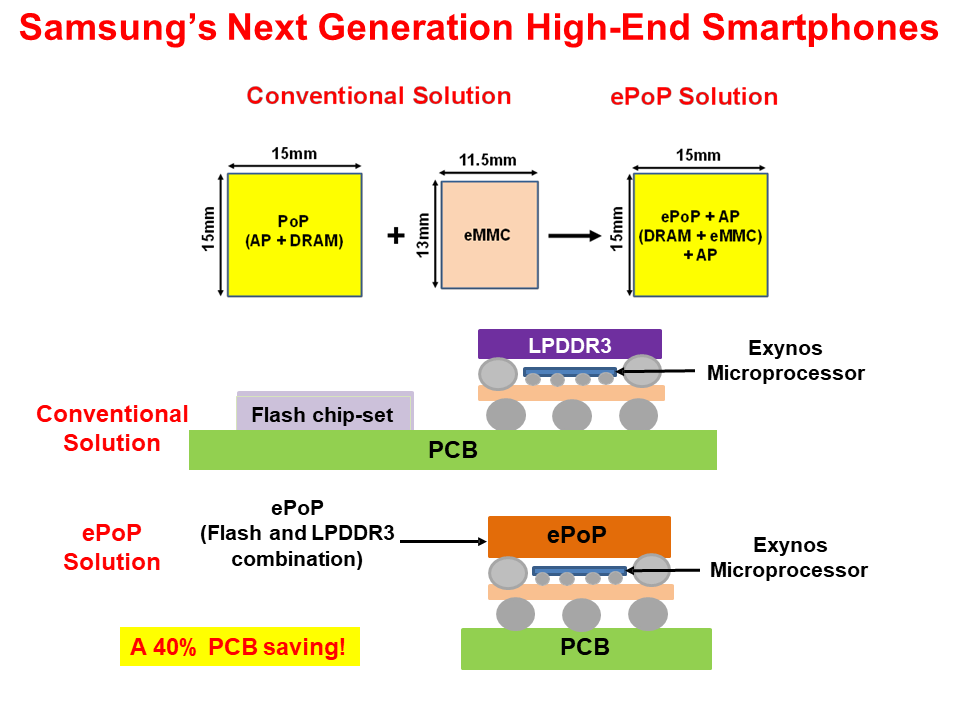

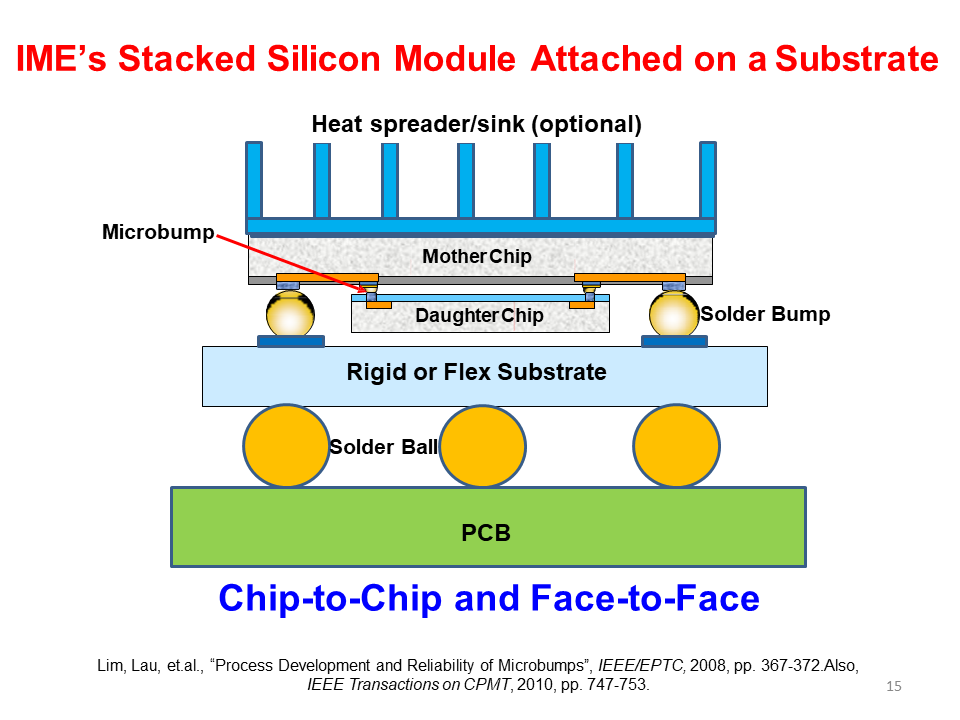
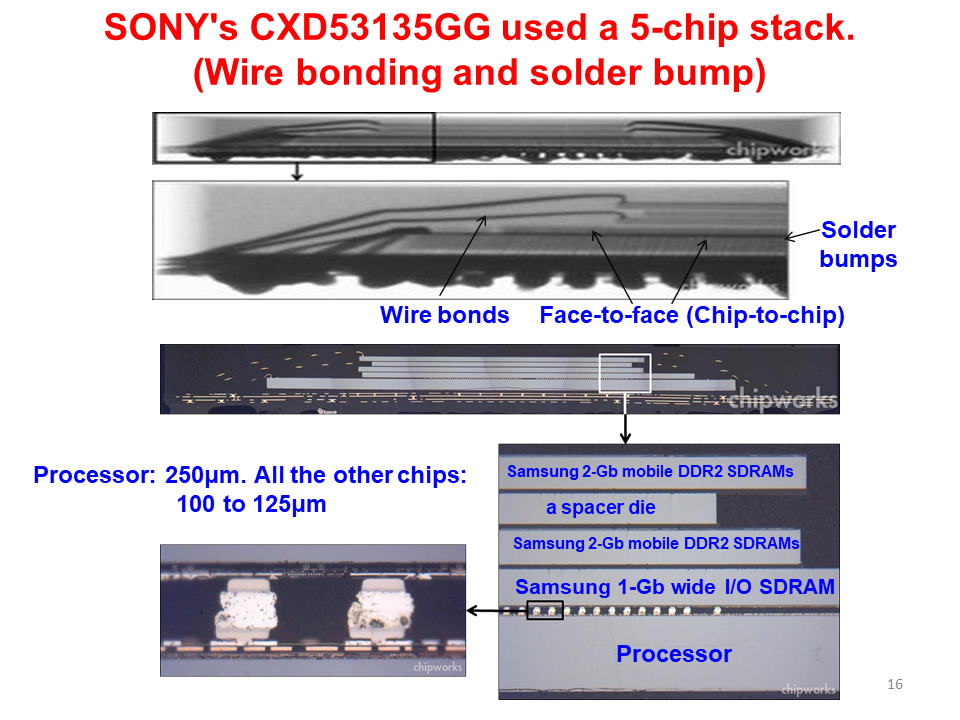

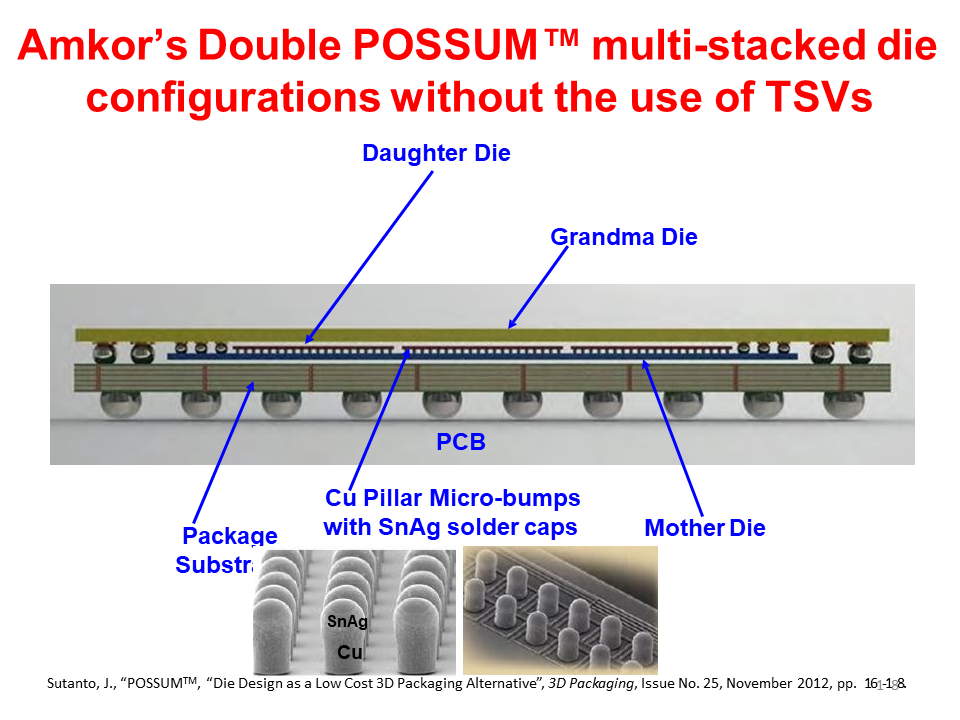
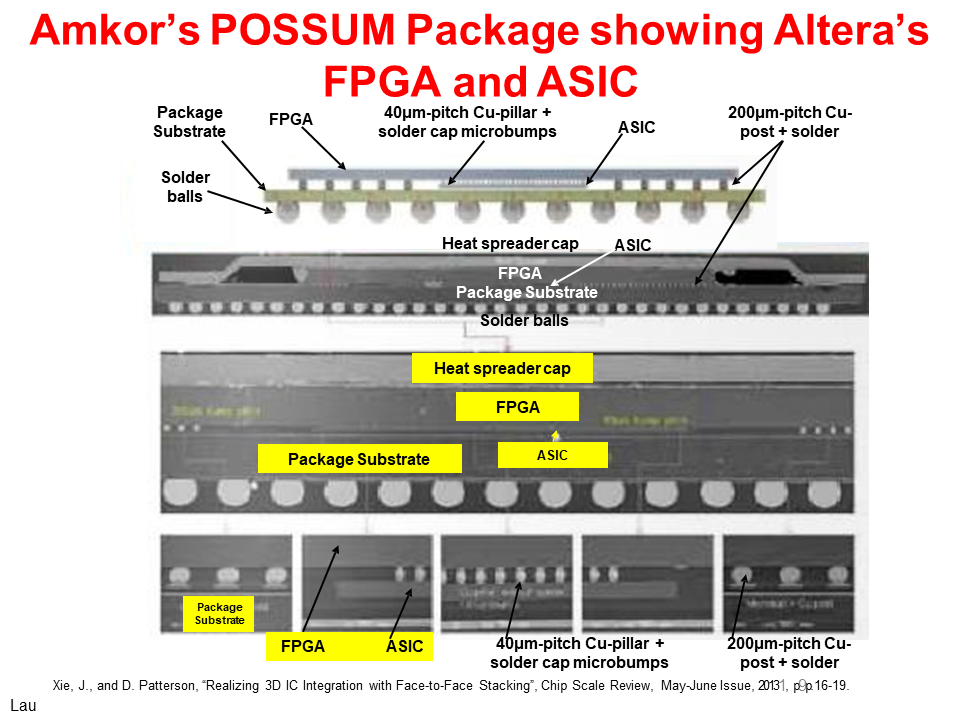

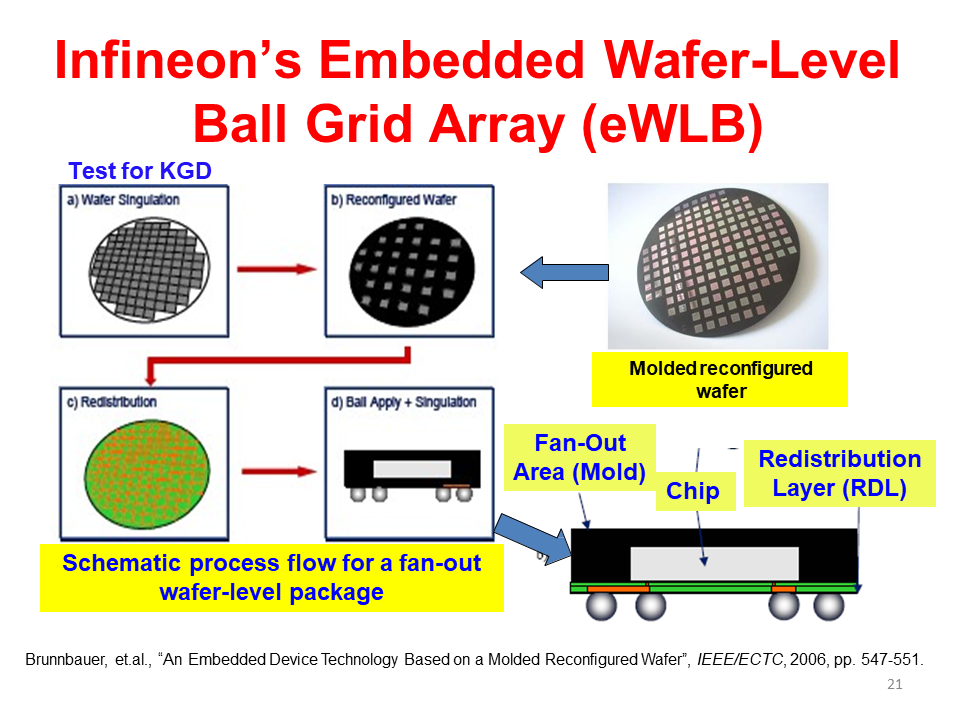
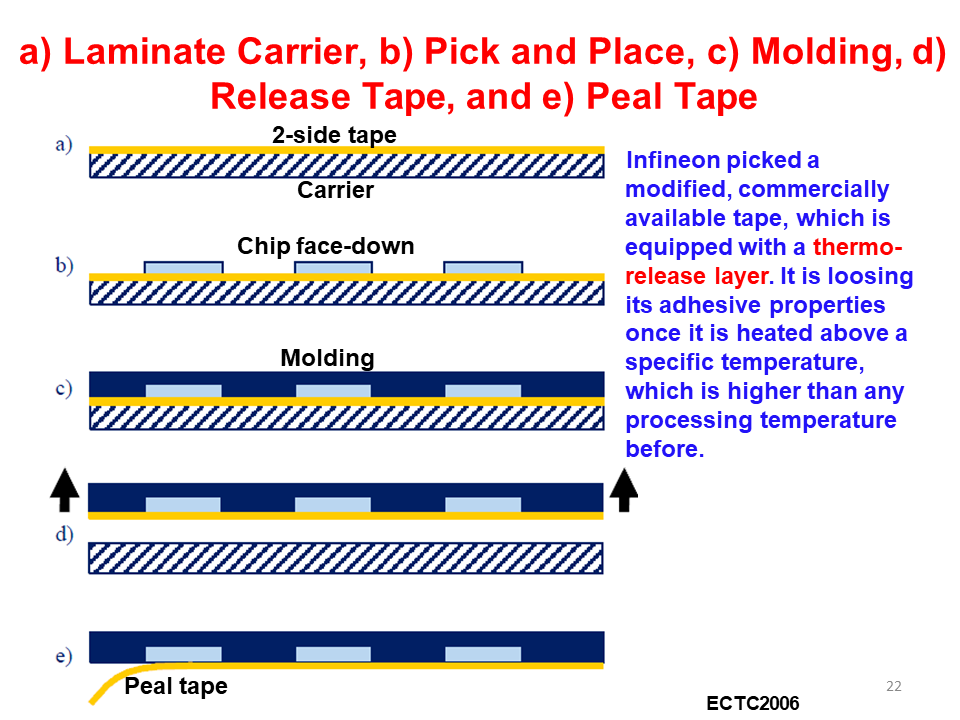
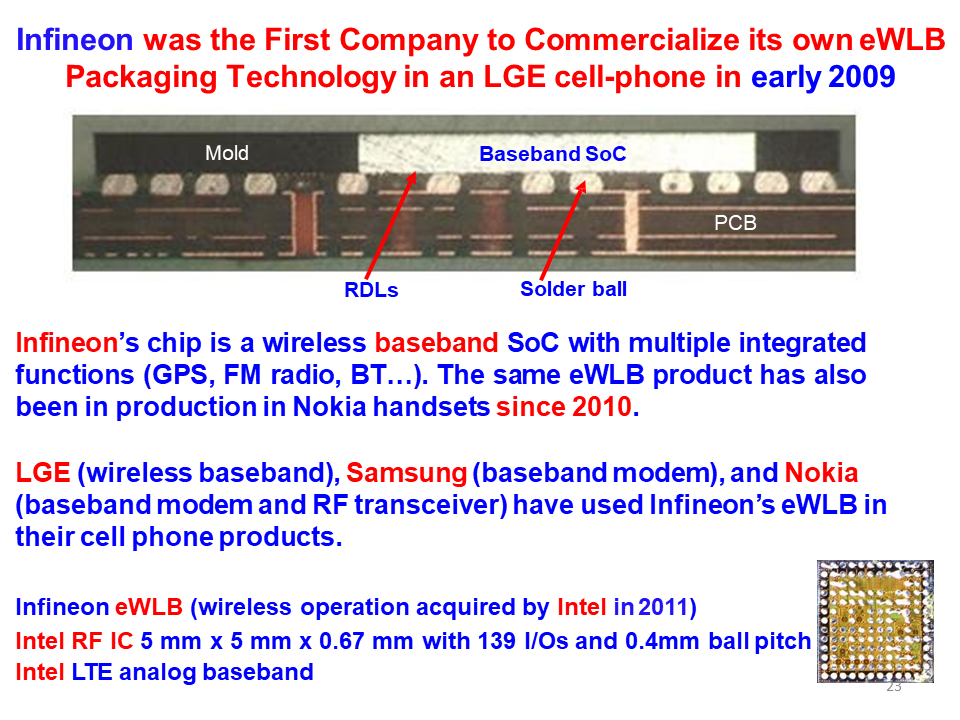
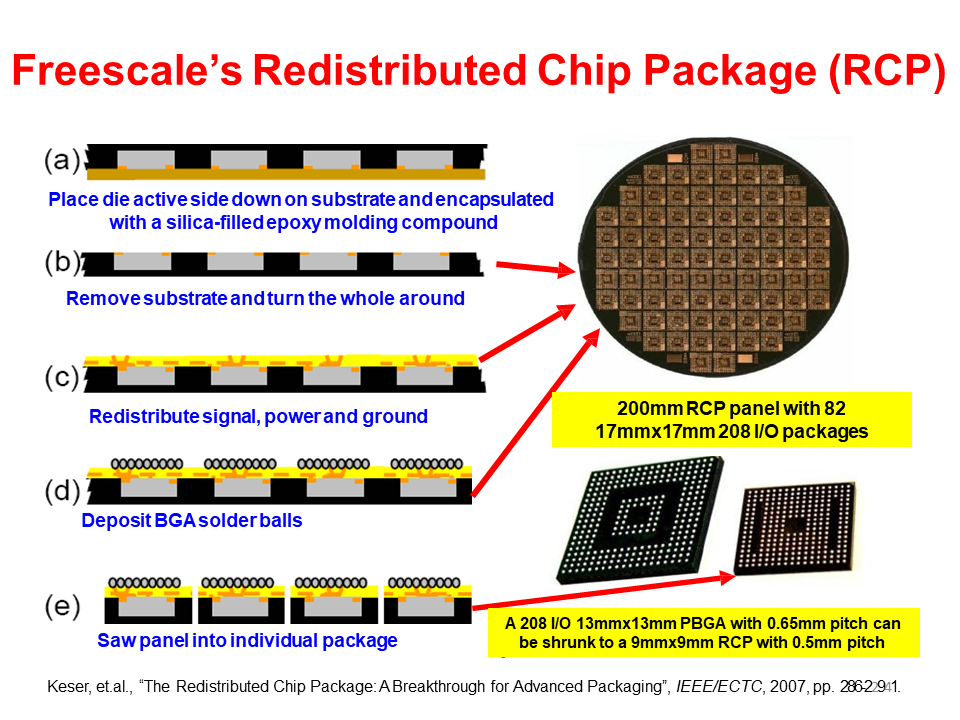
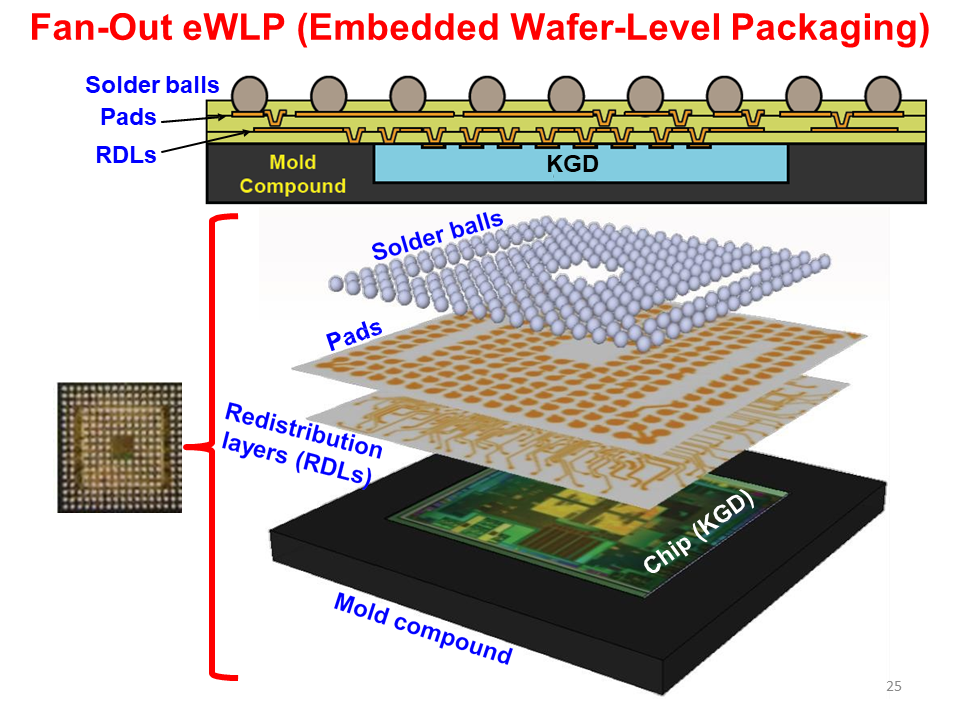
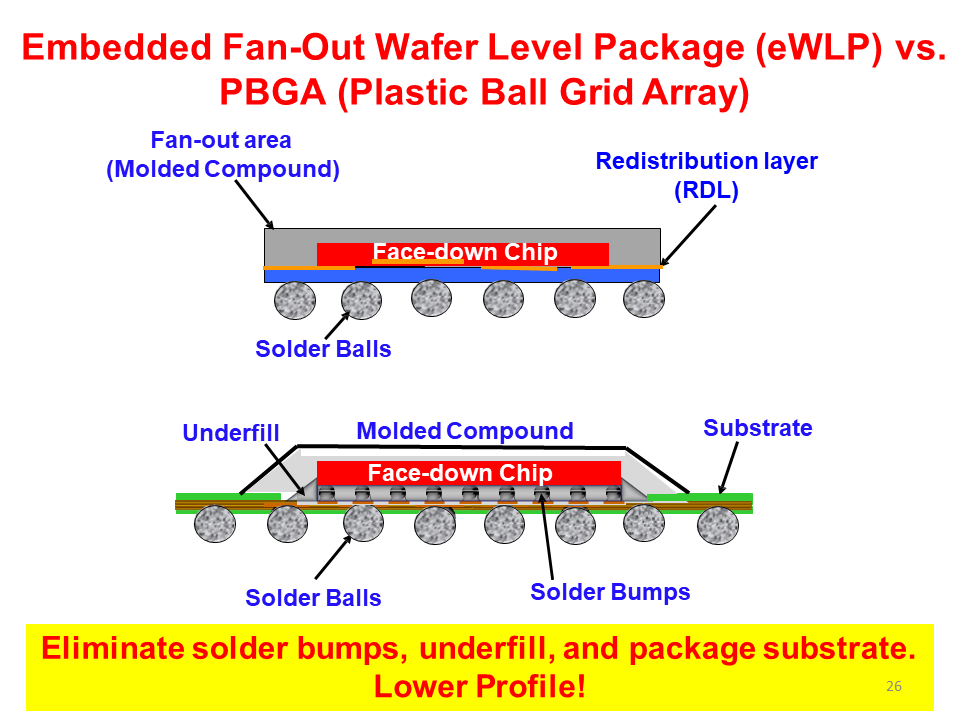


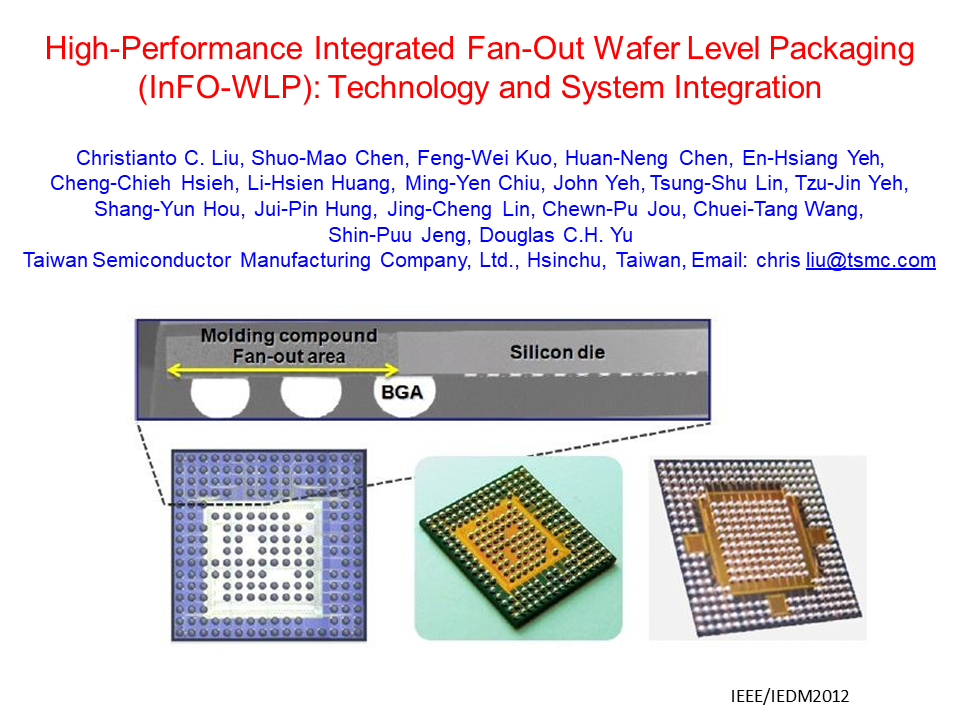
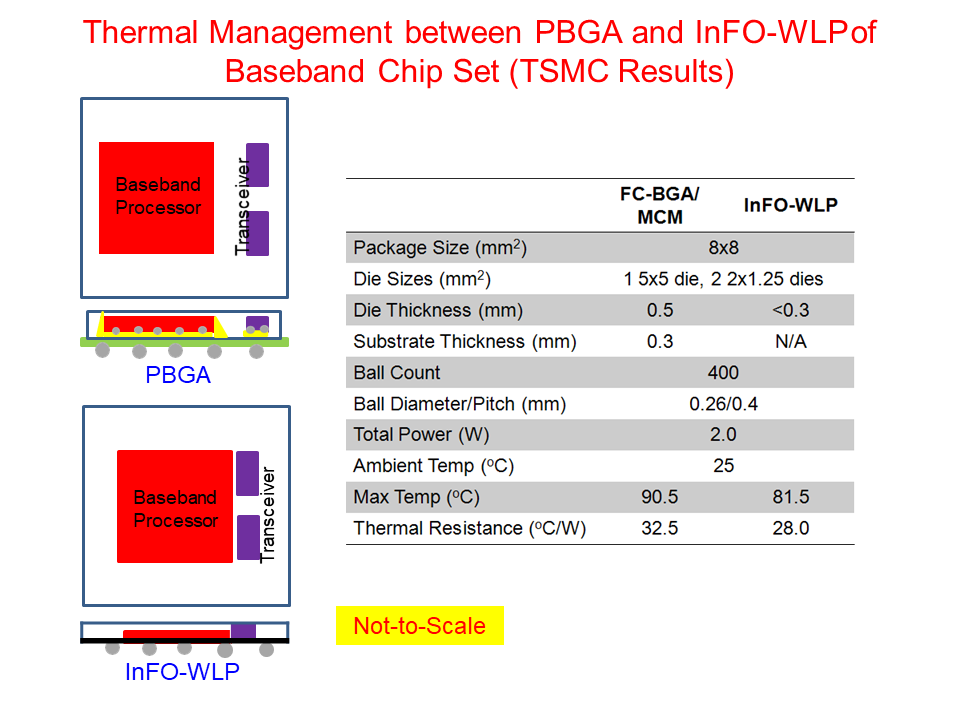
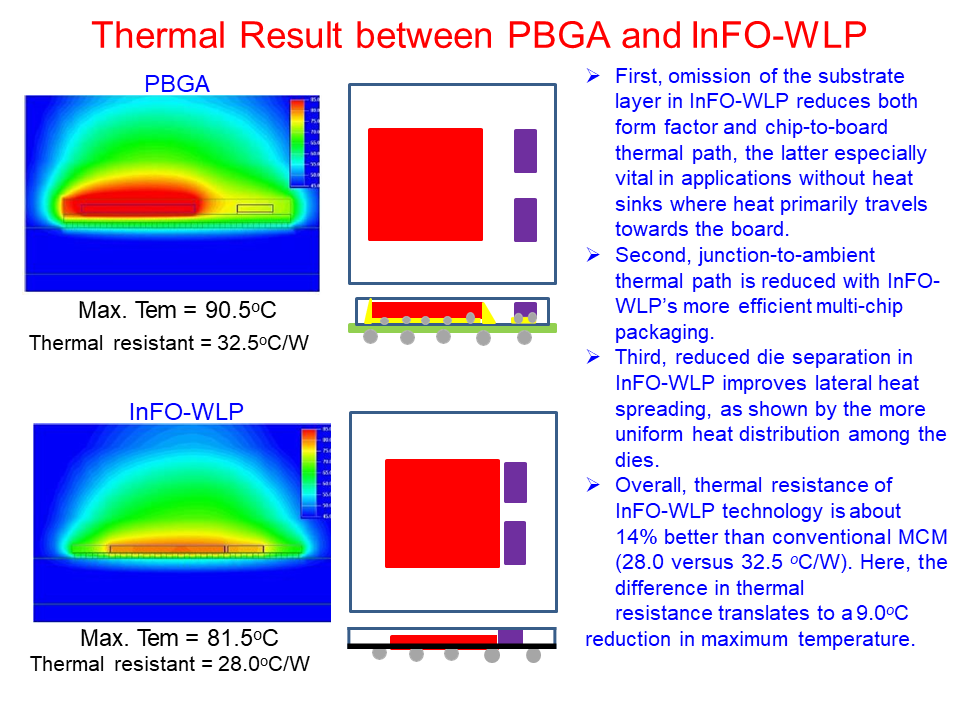
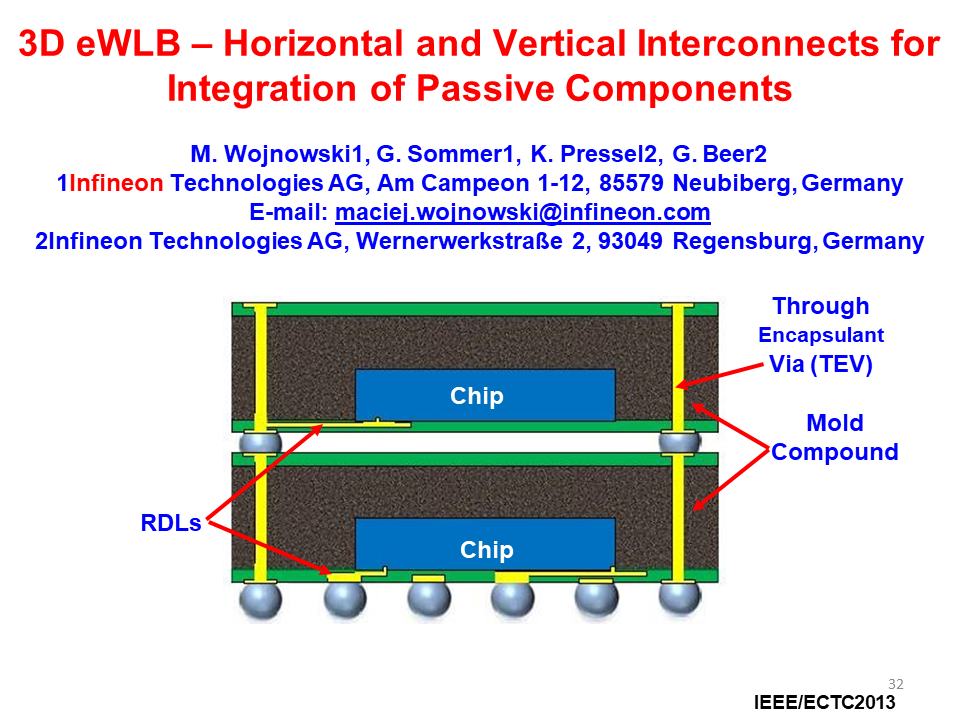
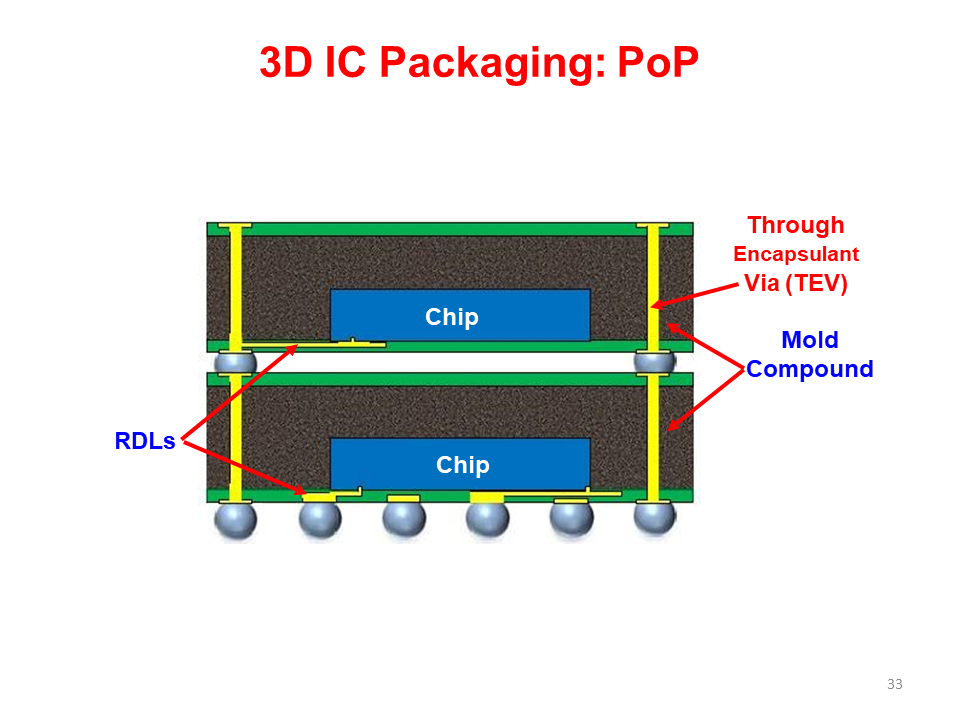
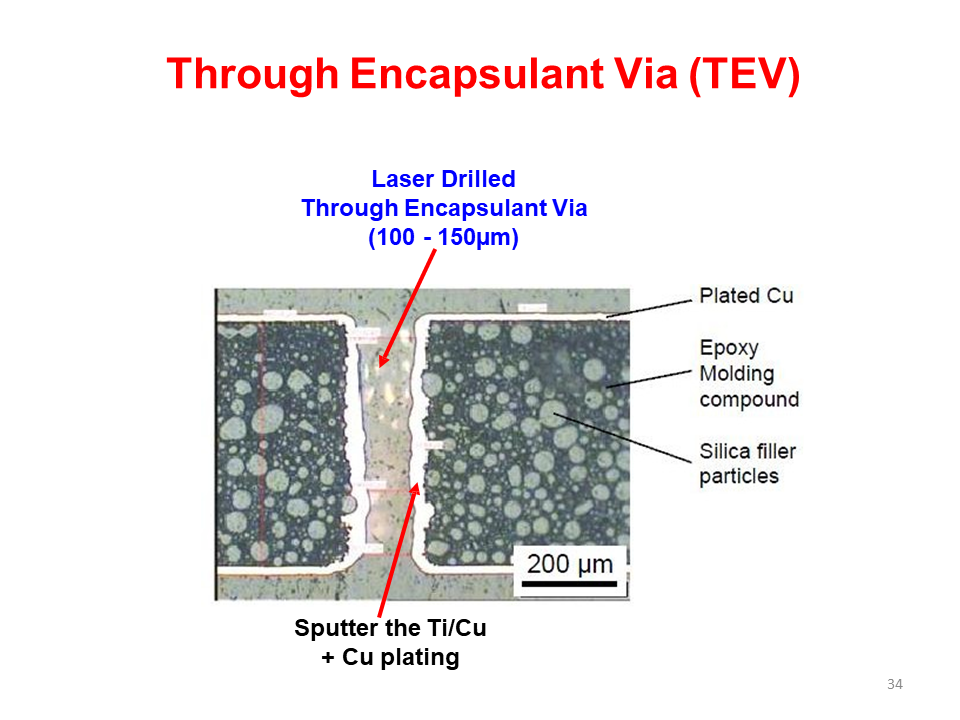
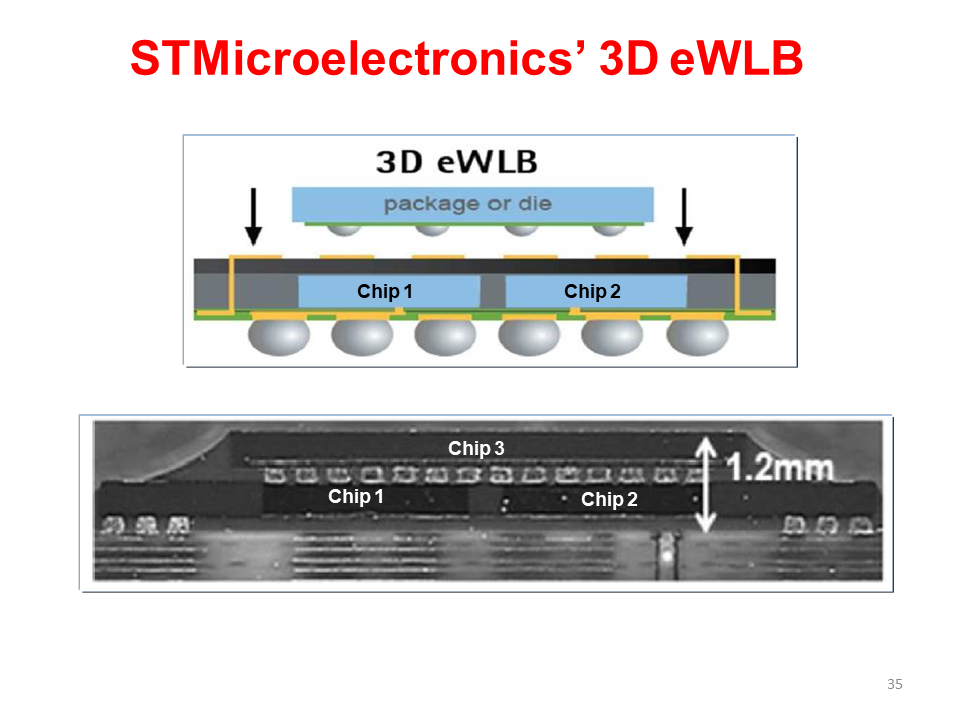
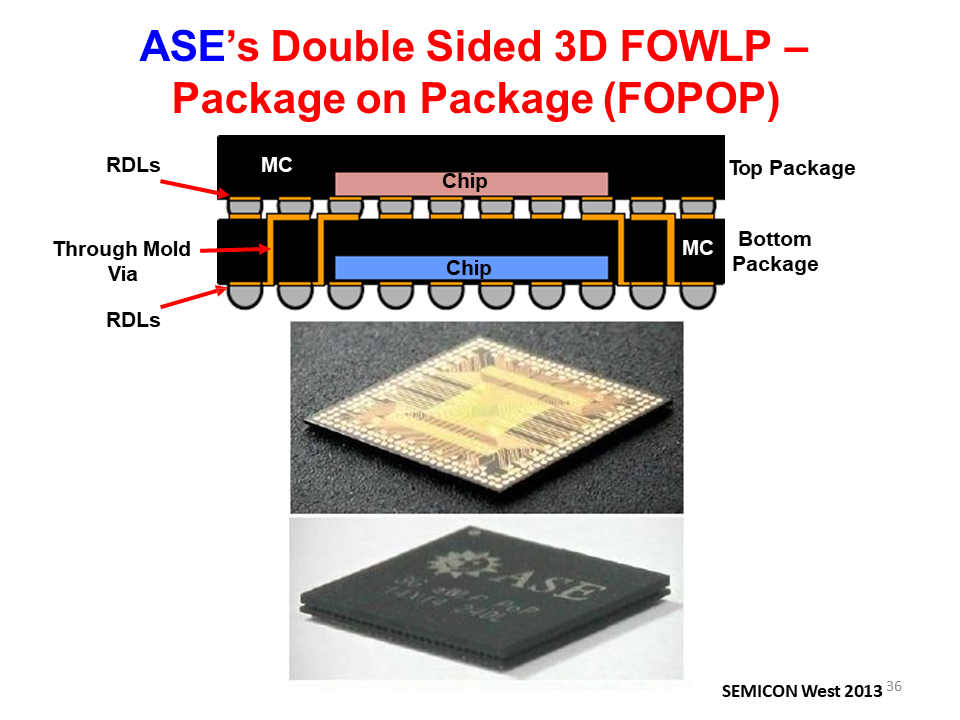
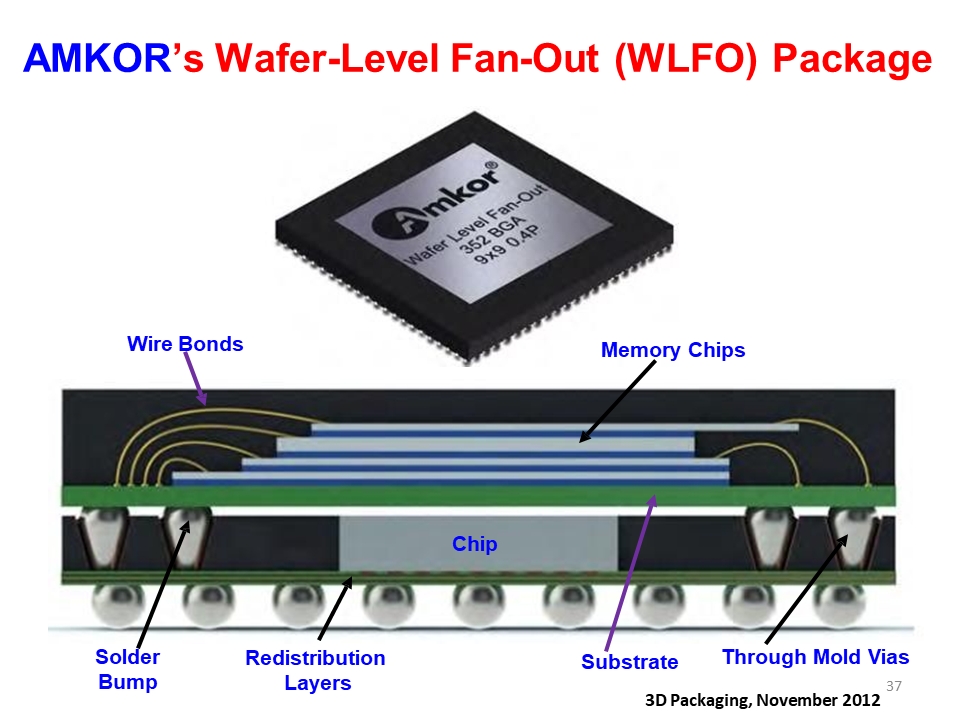
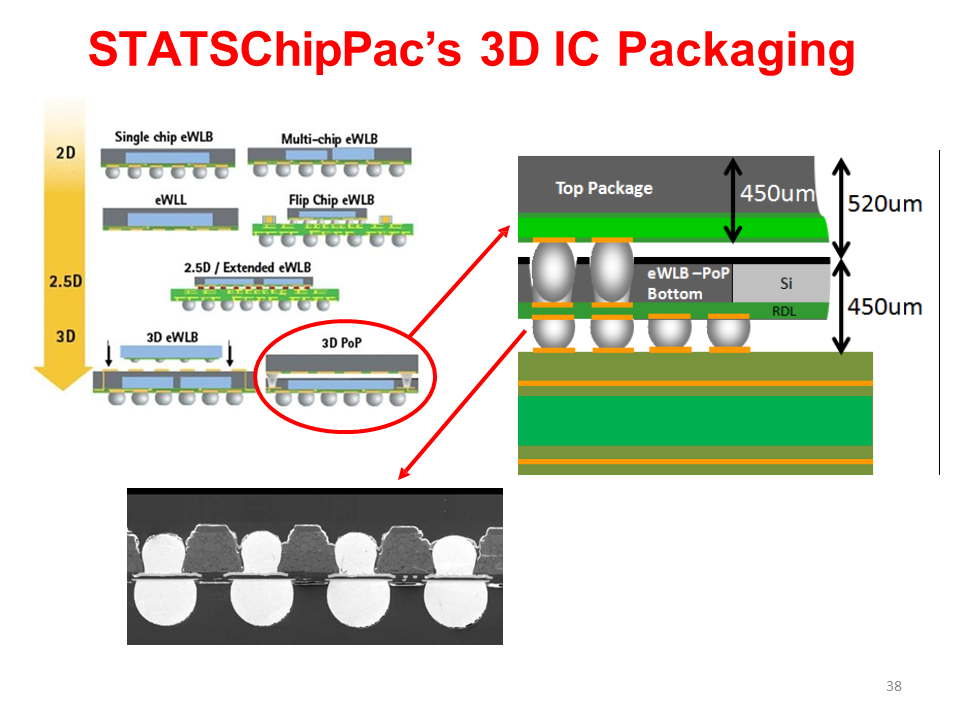







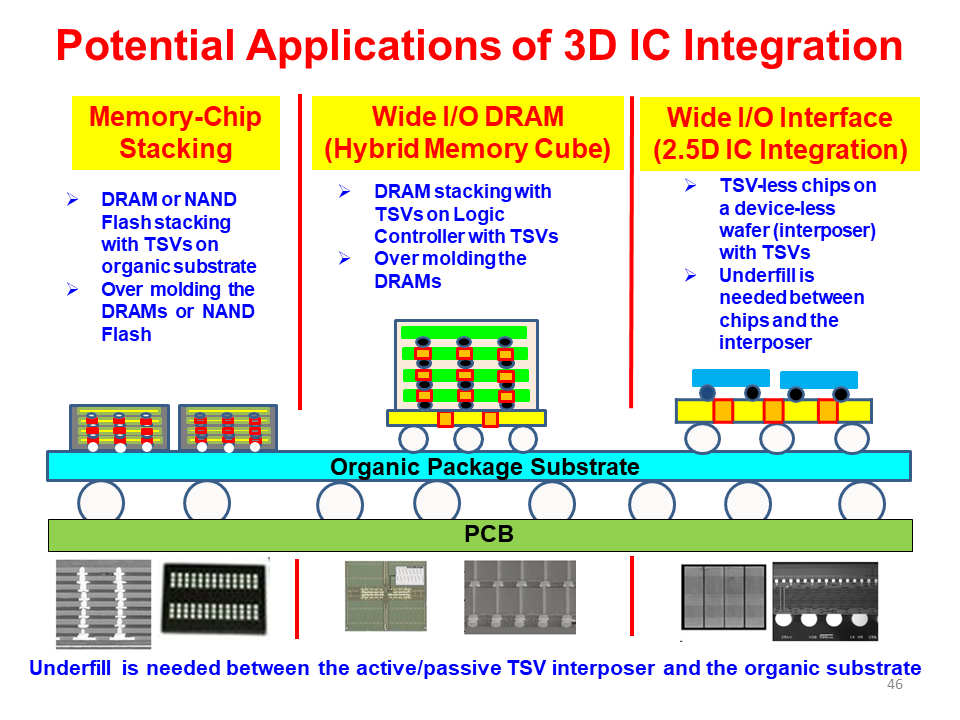

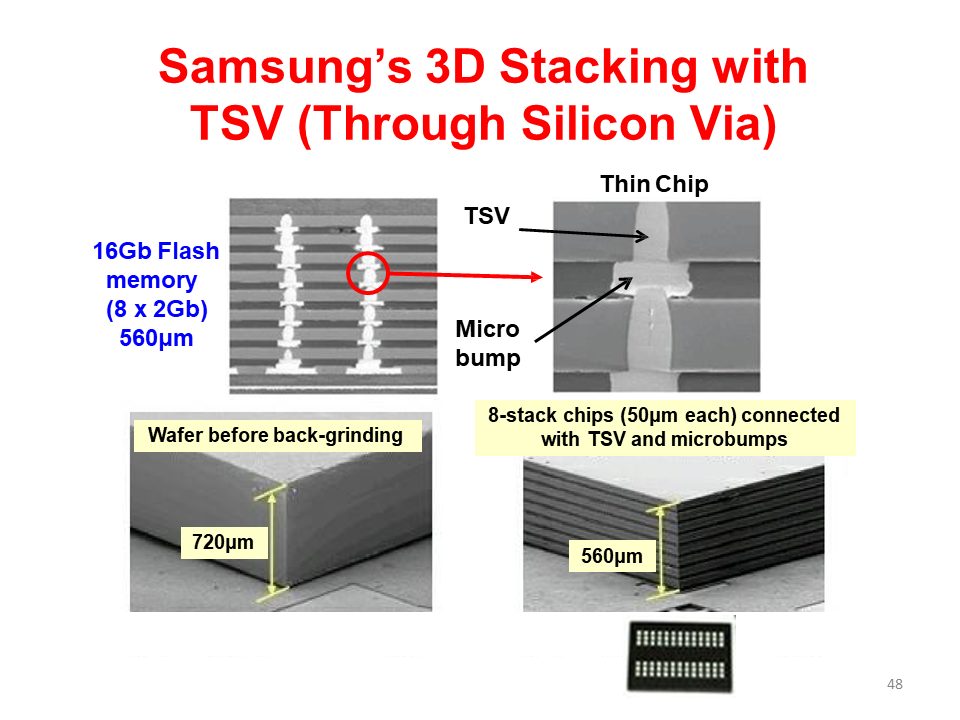
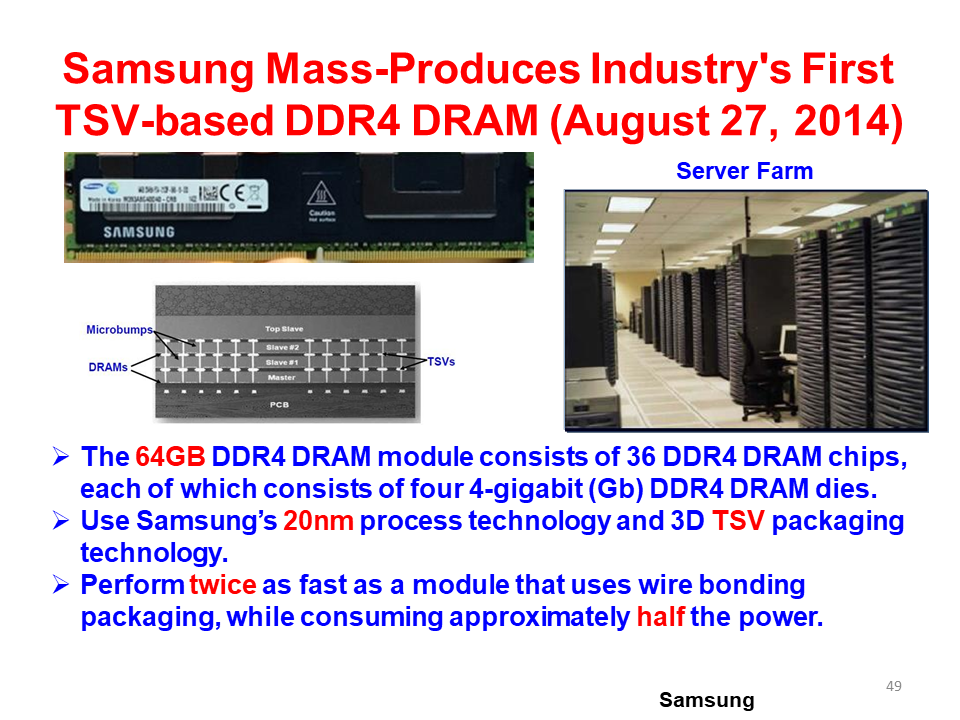
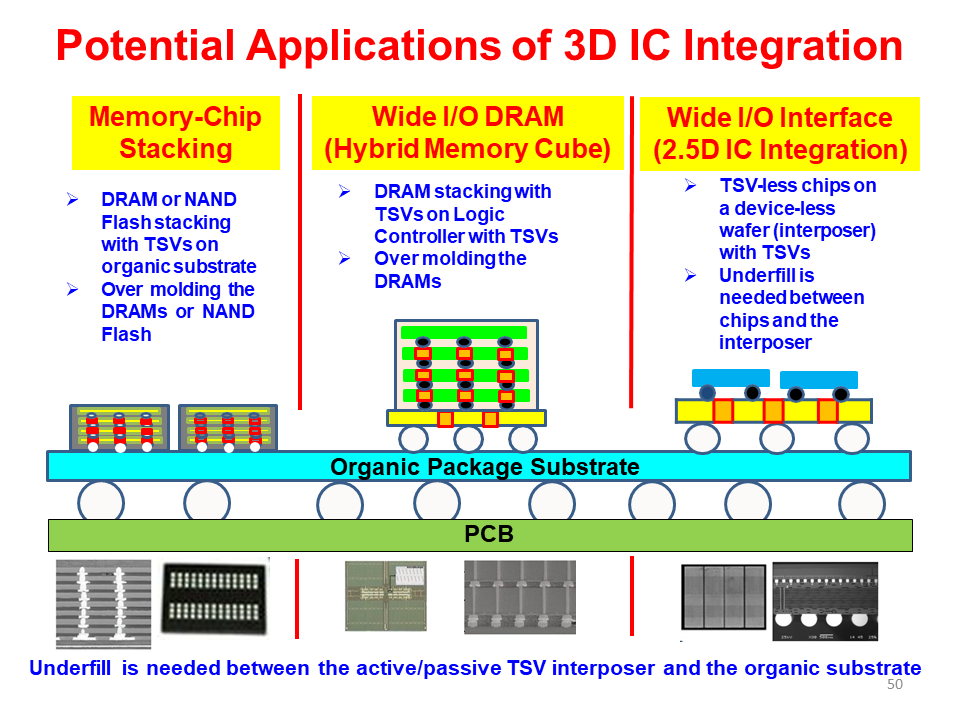

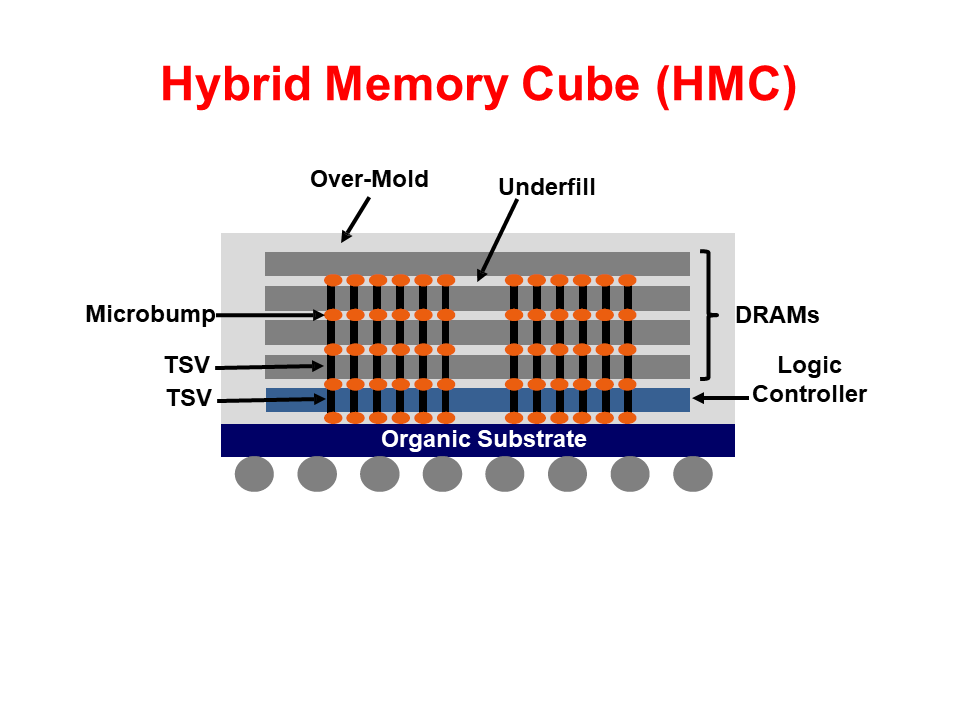

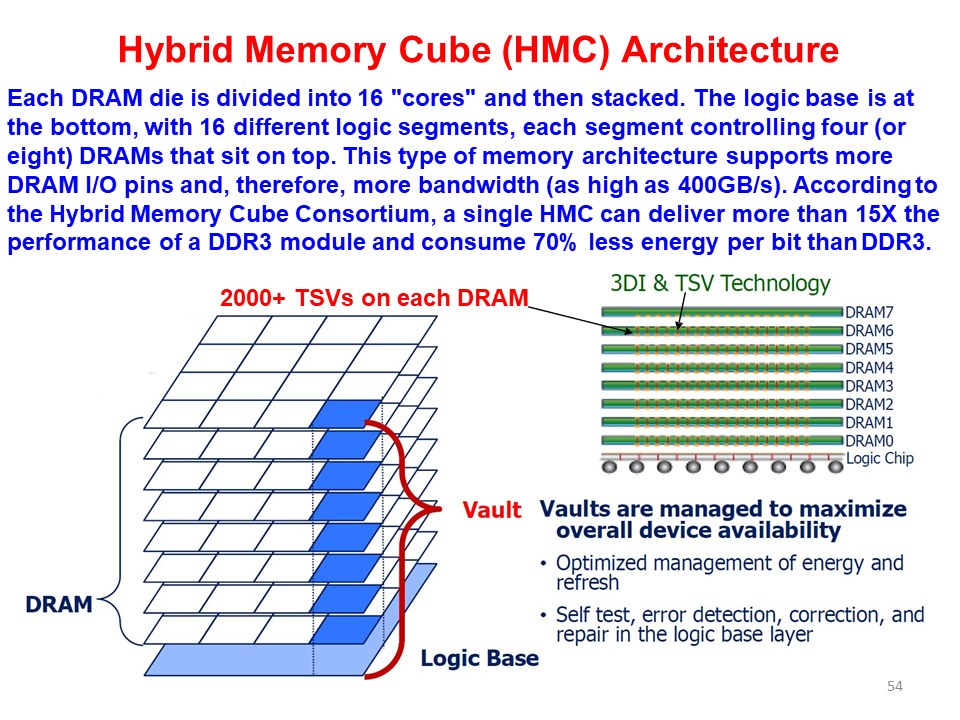

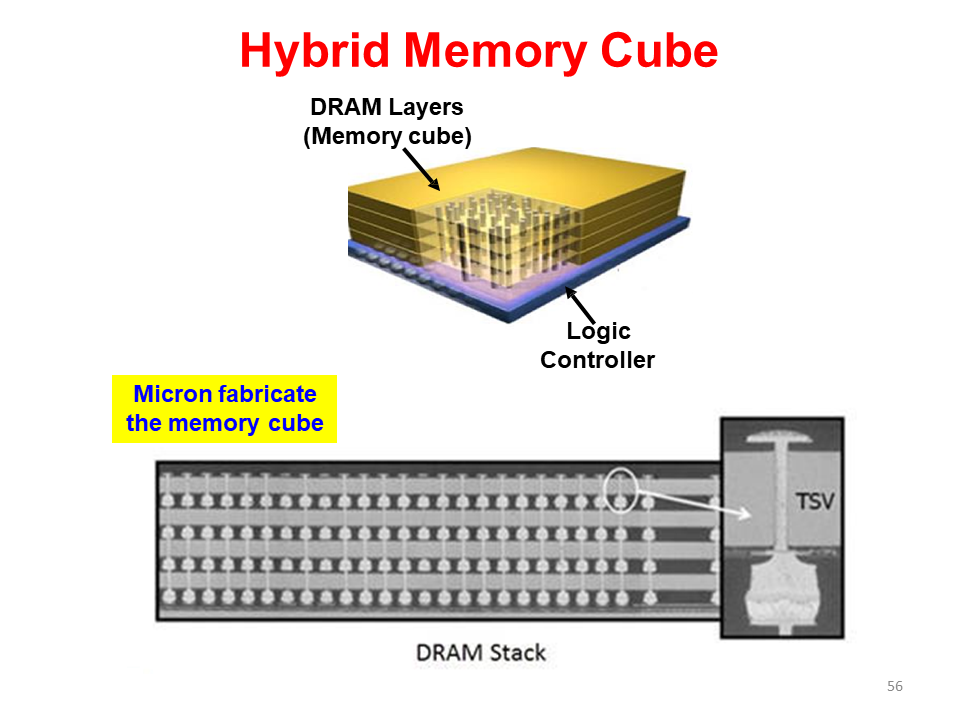
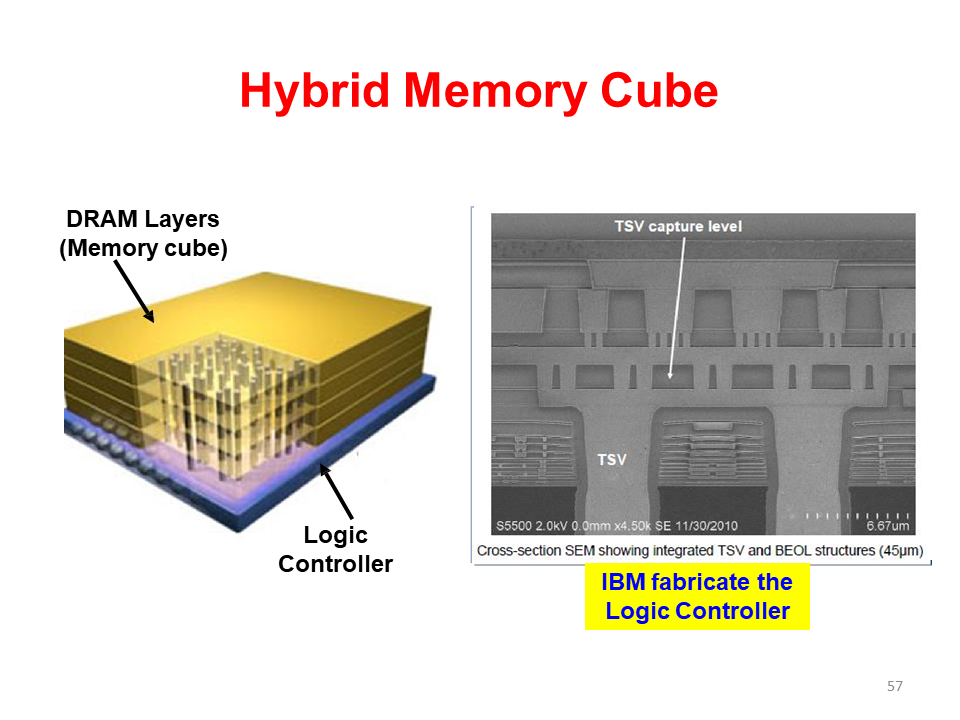

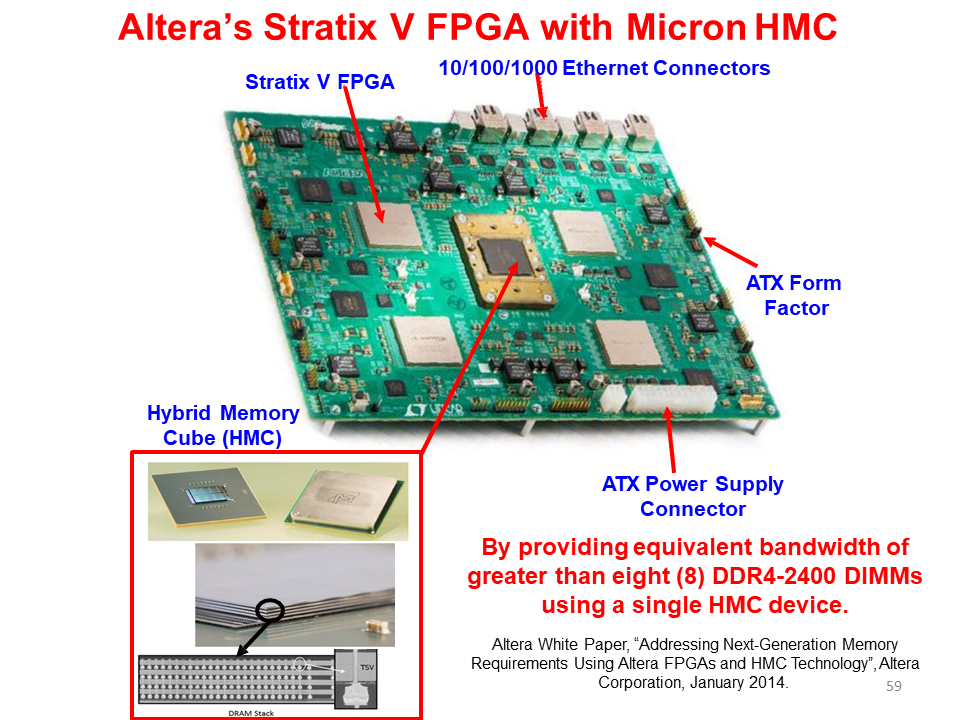
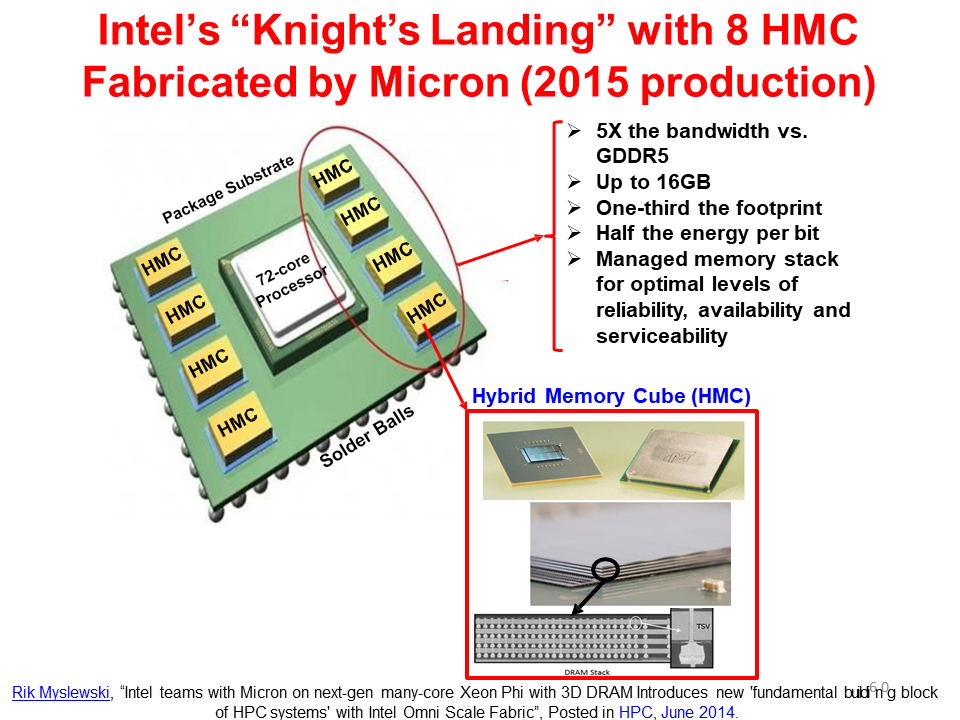
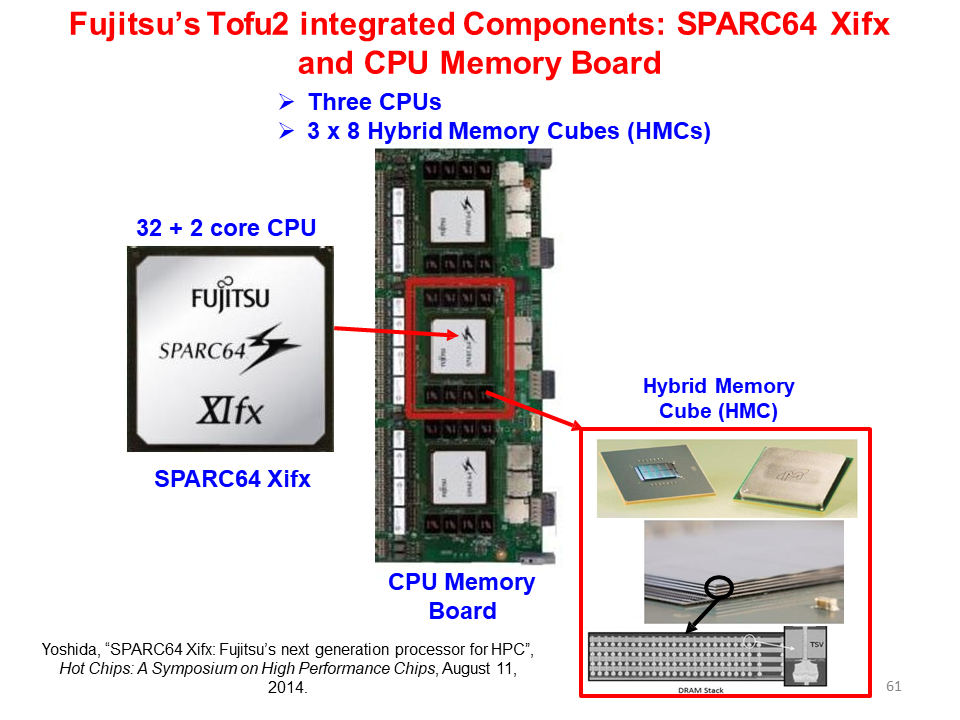

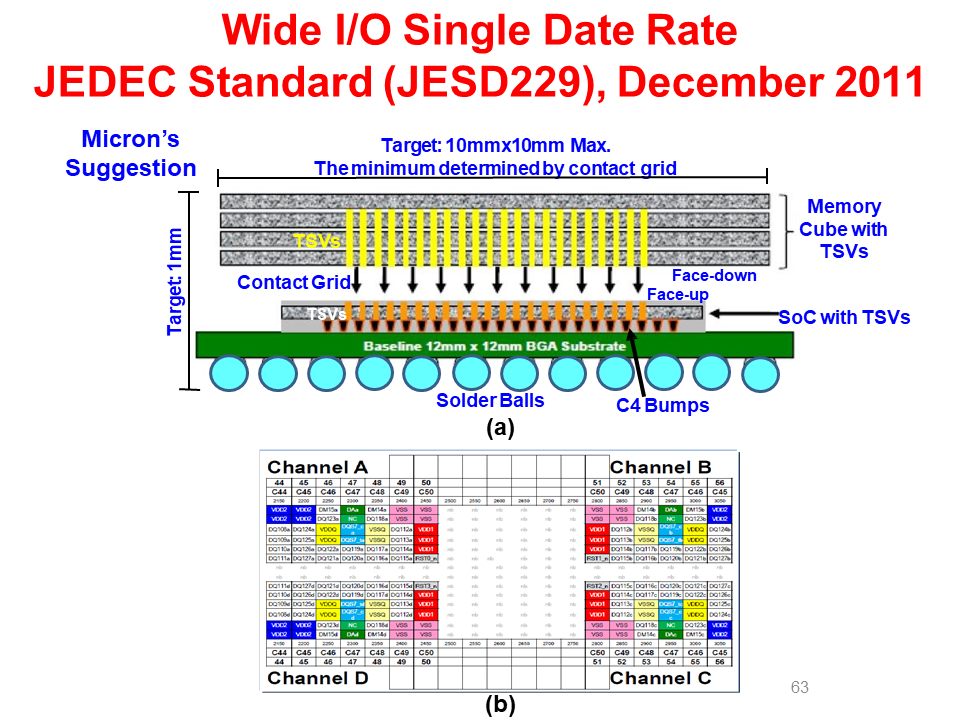



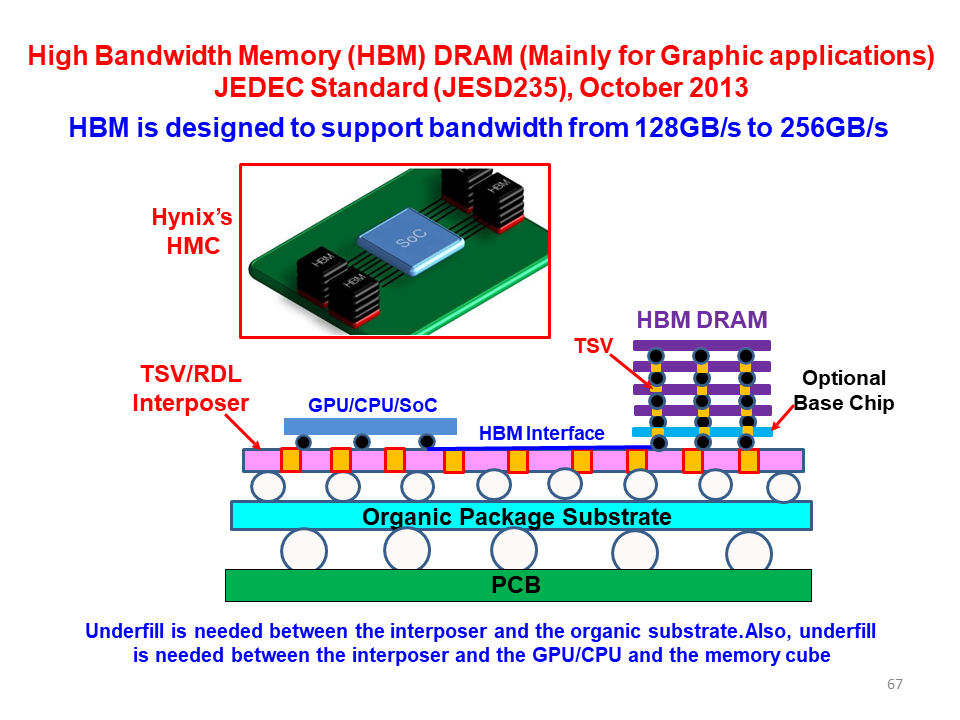


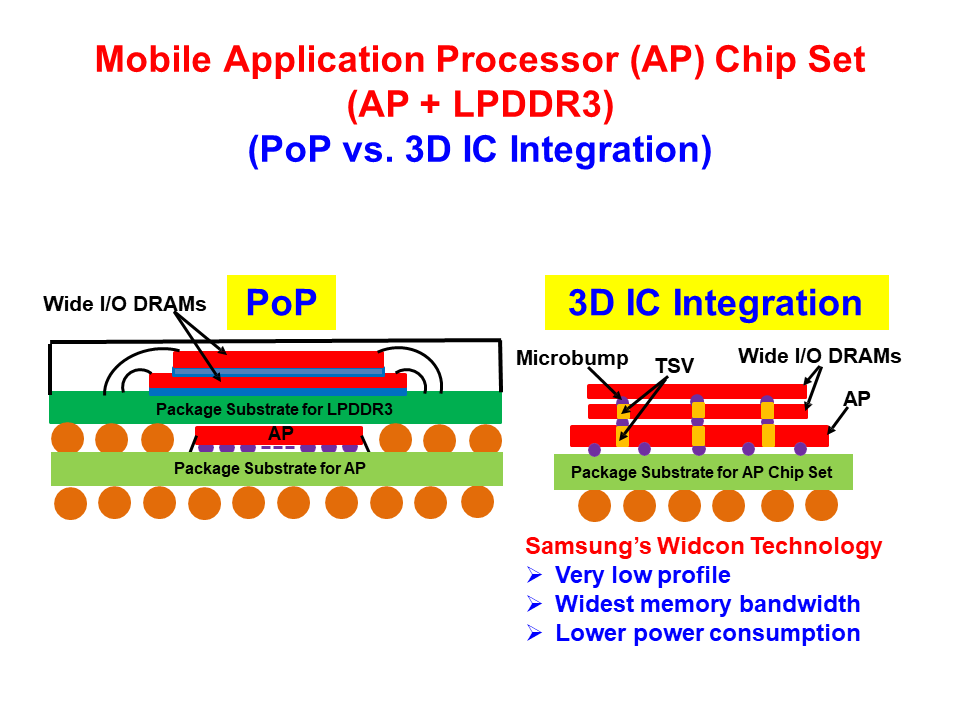



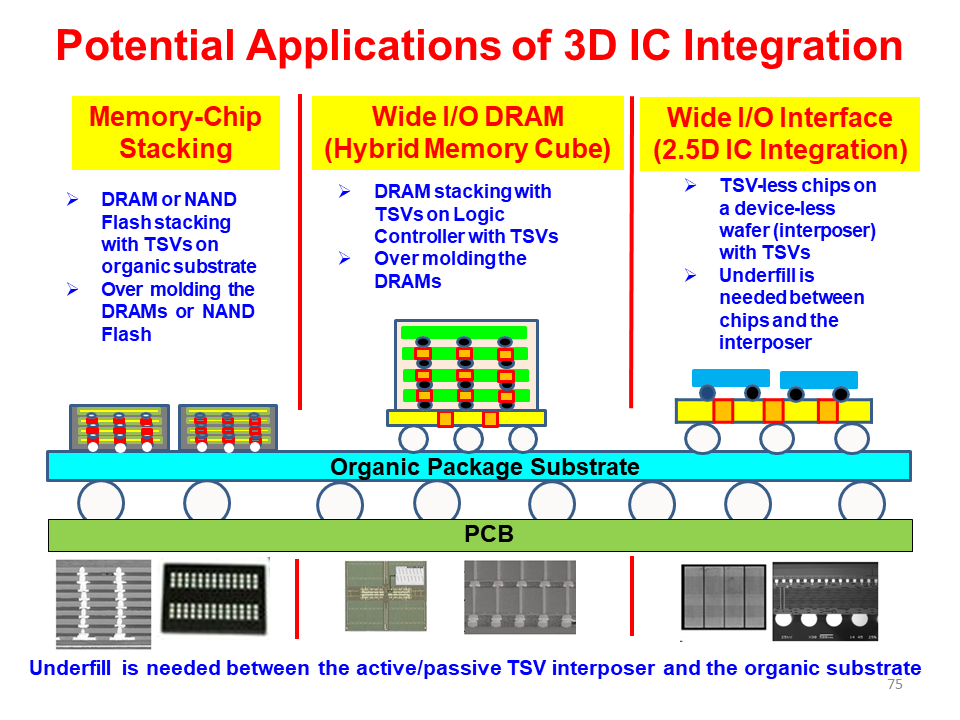
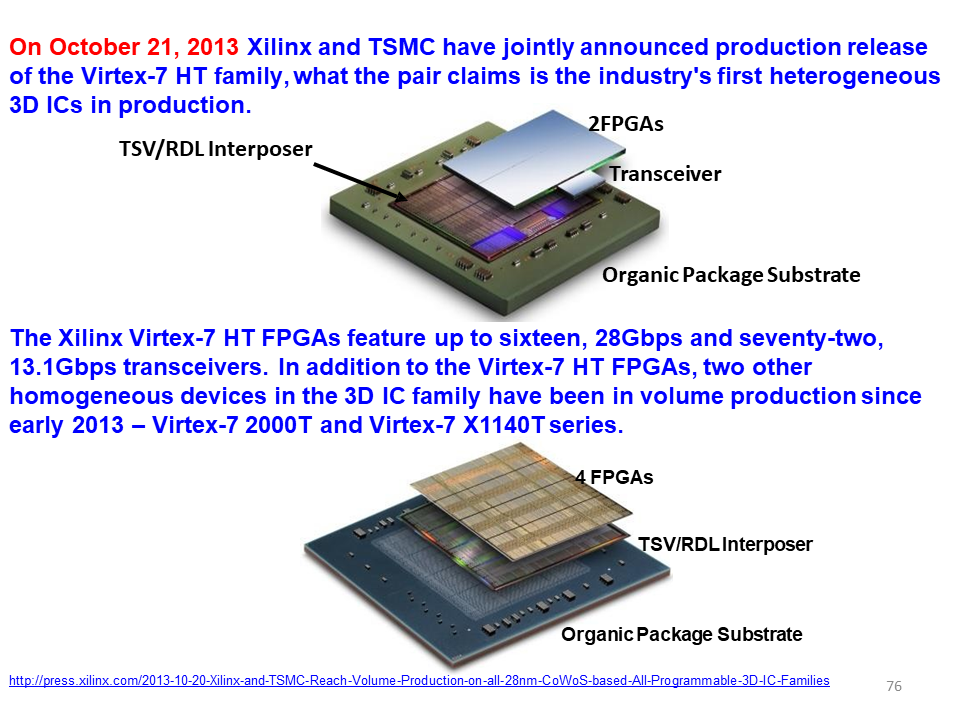
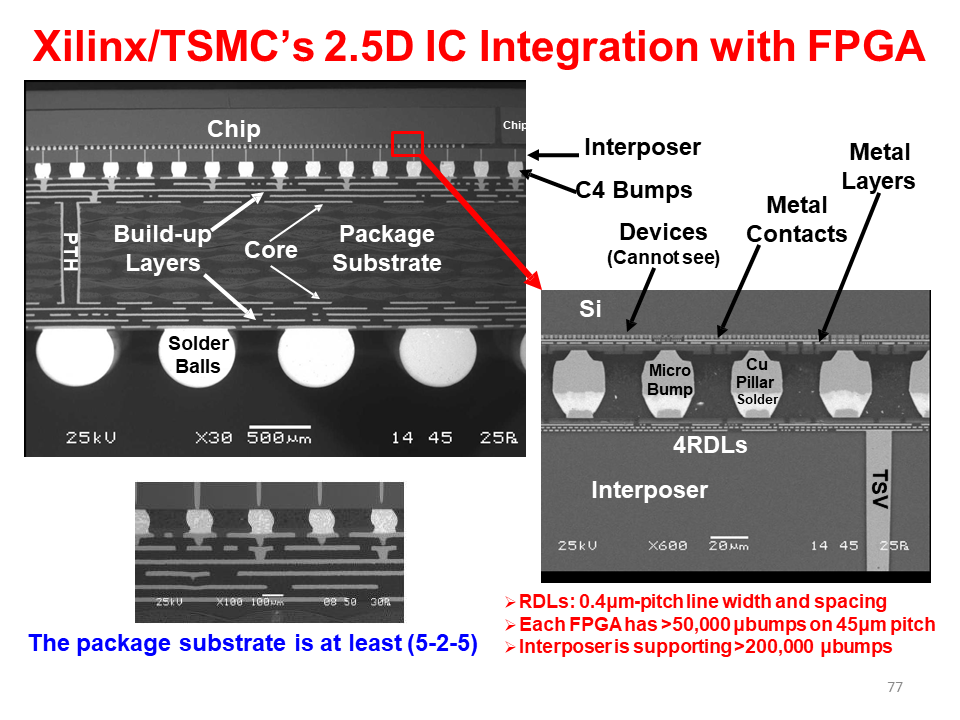
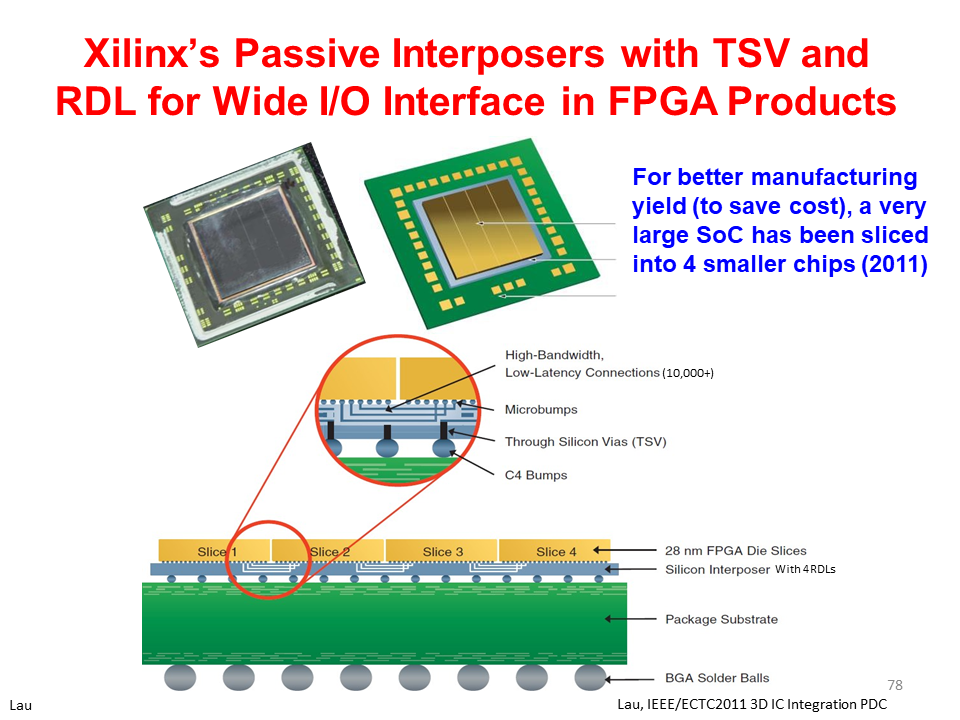
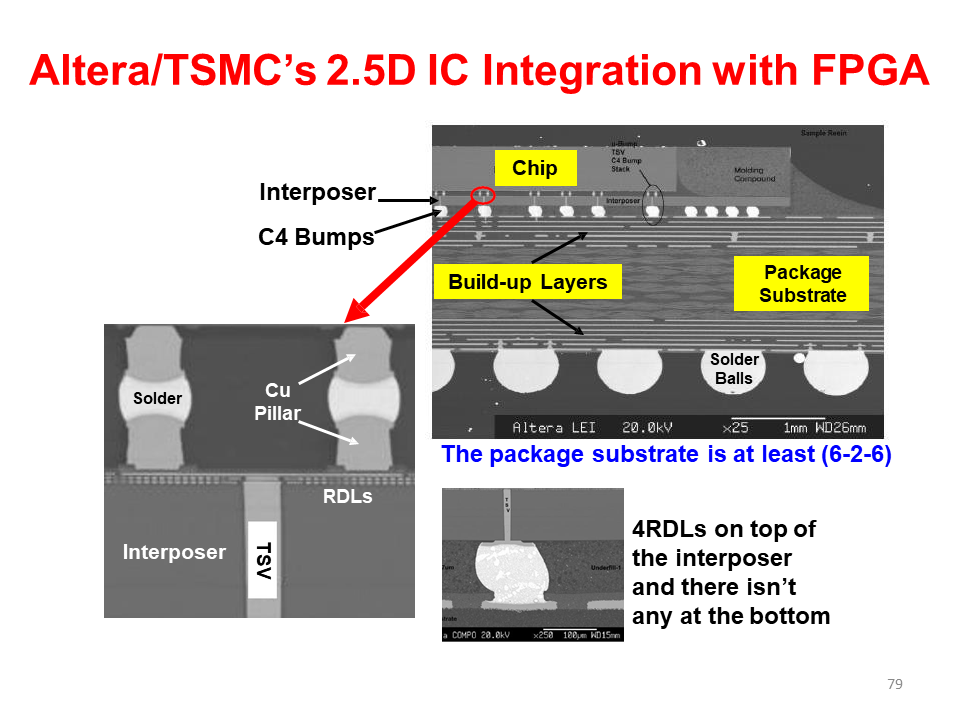
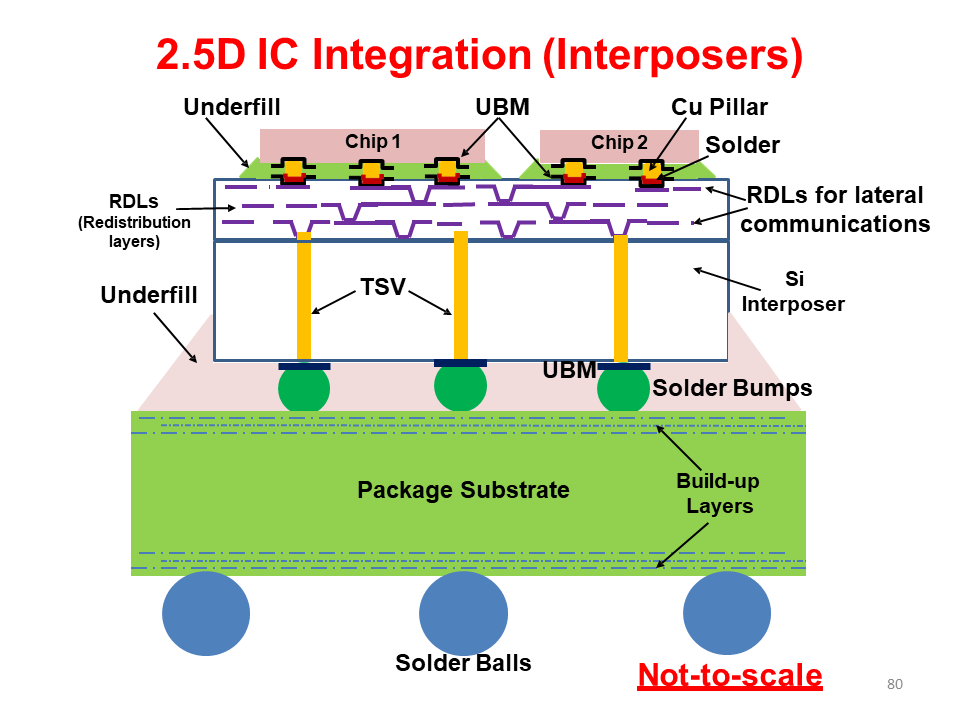











評論