一文解析3D芯片集成與封裝技術
- 封裝技術(69202)
- SoC芯片(37016)
- 3D芯片(19037)
相關推薦
熱點推薦
一文詳解多芯片封裝技術
多芯片封裝在現代半導體領域至關重要,主要分為平面多芯片封裝和多芯片堆疊封裝。多芯片堆疊封裝又細分為多芯片3D堆疊引線鍵合封裝、3D堆疊引線鍵合和倒裝異質封裝、3DTSV堆疊倒裝封裝等。
2025-05-14 10:39:54 1847
1847
 1847
1847
3D芯片封裝晶圓植球裝備關鍵技術研究
高端封裝制造設備植球機的需求。介紹了晶圓植球這一 3D 封裝技術的工藝路線和關鍵技術,以及研制的這一裝備的技術創新點。以晶圓植球機 X - Y - θ 植球平臺為例,分析了選型的技術參數。封裝技術的研究和植球機的研發,為我國高端芯片封裝制造業的同行提供了從技術理論到實踐應用的參考。
2022-11-11 09:43:08 3232
3232
 3232
32323D封裝熱設計:挑戰與機遇并存
隨著半導體技術的不斷發展,芯片封裝技術也在持續進步。目前,2D封裝和3D封裝是兩種主流的封裝技術。這兩種封裝技術在散熱路徑和熱設計方面有著各自的特點和挑戰。本文將深入探討2D封裝和3D封裝的散熱路徑及熱設計考慮。
2024-07-25 09:46:28 2651
2651
 2651
2651
臺積電SoIC封裝將量產!采用 3D 芯片間堆棧技術
臺積電傳出正在跟美國科技巨擘合作,共同開發系統整合芯片(SoIC)創新封裝科技,利用 3D 芯片間堆棧技術,讓半導體功能更強大。
2020-11-20 10:03:06 3583
3583
 3583
35833D混合制造技術介紹
的減輕產品重量呢?采用新型的塑料成型技術:3D混合制造 可以到達要求,3D混合制造步驟是3D打印成型/激光LDS選擇性沉積金屬。采用這種工藝的好處是節省了制造時間和實現了復雜的饋源/波導等器件的一體化免安裝調試,且帶來的另外好處是大幅度減輕了產品重量。下面舉例說明:
2019-07-08 06:25:50
3d全息聲音技術解析
,但與此同時,物體飛行時發出的聲音卻沒能跟著一起“飛”過來。而3D全息聲音技術要做到的,就是當物體飛到你眼前甚至砸在你臉上時,聲音也同時在最近處響起——就像生活中的真實場景一樣。這是目前世界上最為
2013-04-16 10:39:41
芯片的3D化歷程
,并將帶寬密度提高10倍。在CES 2019展會上,Intel也正式公布了Foveros 3D立體封裝技術,Foveros 3D可以把邏輯芯片模塊一層一層地堆疊起來,而且可以做到2D變3D后,性能
2020-03-19 14:04:57
AD14簡易3D封裝制作問題
`新用AD軟件,需要用到一個散熱器的3D封裝,聽別人提起過AD14版本的可以制作簡單的.step文件,試了一下在PCB文件中放置3D原件對話框是可以生成3D模型的,但問題是這個模型我文件另存為后再導入到封裝庫中沒法使用啊(坐標無法調整),各位大神有沒有好的辦法麻煩指點一下。`
2017-12-10 00:10:33
AD16的3D封裝庫問題?
`AD16的3D封裝庫問題以前采用封裝庫向導生成的3D元件庫,都有芯片管腳的,如下圖:可是現在什么設置都沒有改變,怎么生成的3D庫就沒有管腳了呢?請問是什么原因?需要怎么處理,才能和原來一樣?謝謝!沒管腳的就是下面的樣子:`
2019-09-26 21:28:33
Altium Designer 09的3D封裝旋轉的問題
給PCB添加了3D模型之后,讓封裝旋轉45度,自己填加的3D模型旋轉45度后,代表3D模型的機械層不會和PCB重合;而用封裝向導畫的模型會和PCB重合。請問這個改怎么解決?雖然旋轉45度之后,在3D 模式下,3D圖也是旋轉了45度,但是在2D模式下的機械層看著很不舒服。
2017-07-20 22:46:11
Altium Designer13封裝導入3D無法顯示!求助!!!
各位親,我在Altium Designer中遇到下面的問題!希望得到幫助!下載了STEP格式的3D封裝,建好3D庫看封裝是可以顯示出來的如下圖:然后在PCB庫里放置3D body后,2D視圖下有顯示紅色框,如下圖:但是切換為3D視圖下卻并沒有3D封裝出現!請問解決辦法!!非常感謝!
2016-11-20 20:35:21
為什么同一種封裝的器件的3D視圖不一樣?
又碰到一個很糾結的問題了,畫好了板子,想看看它的3D視圖。我的板子用了五個按鍵,它們的封裝都是一樣的,只不過是自己定義的,不是庫里的,它們的3D視圖竟然不一樣! 納悶了,為什么....還有,當我重新連線的時候,再看其3D視圖,又跟之前的3D視圖不一樣了!怎么回事啊!。。。。。求解釋,,,,,,
2011-12-04 00:10:21
什么叫3D微波技術
當3D電影已成為影院觀影的首選,當3D打印已普及到雙耳無線藍牙耳機,一種叫“3D微波”的技術也悄然而生。初次聽到“3D微波”,你可能會一臉茫然,這個3D微波是應用在哪個場景?是不是用這種技術的微波爐1秒鐘就能把飯煮熟?O M G!我覺得很有必要給大家科普一下!
2019-07-02 06:30:41
使用DLP技術的3D打印
使用DLP技術的3D打印光固化成形法 (SLA),一個常見的3D打印工藝,與傳統打印很相似。與硒鼓將碳粉沉積在紙張上很類似,3D打印機在連續的2D橫截面上沉淀數層材料,這些材料一層層的疊加在一
2022-11-18 07:32:23
浩辰3D的「3D打印」你會用嗎?3D打印教程
設計。由浩辰CAD公司研發的浩辰3D作為從產品設計到制造全流程的高端3D設計軟件,不僅能夠提供完備的2D+3D一體化解決方案,還能一站式集成3D打印的多元化數據處理,無需將模型數據再次導出到其他軟件
2021-05-27 19:05:15
畫PCB 3D封裝問題
我用ALTIUM10 畫PCB封裝 從網上下載的3D模型怎么導入的時候顯示不了,前幾天還可以顯示 現在一個都顯示不了, 是不是弄錯了, 手動畫3D 又能顯示方塊模型 導入的時候就一點效果都沒有像沒有導入3D模型一樣, 求大師指點。
2016-07-12 22:48:20
采用DLP技術的3D機器視覺參考設計包括BOM
描述3D 機器視覺參考設計采用德州儀器 (TI) 的 DLP 軟件開發套件 (SDK),使得開發人員可以通過將 TI 的數字微鏡器件 (DMD) 技術與攝像頭、傳感器、電機和其他外設集成來輕松構建
2018-10-12 15:33:03
3D封裝技術及其發展
隨著國際電子信息行業新的變革, 3D封裝 蓬勃興起。為了在封裝之內硬塞進更多功能,芯片制造商被推到了極限。此外,我們不能忘記更加棘手的互連問題。采用Z方向封裝,或者說3
2011-09-16 17:38:08 3558
3558
 3558
35583D集成系統的測試挑戰
封裝技術的進步推動了三維(3D)集成系統的發展。3D集成系統可能對基于標準封裝集成技術系統的性能、電源、功能密度和外形尺寸帶來顯著改善。雖然這些高度集成系統的設計和測試
2012-06-01 09:25:32 2104
2104
 2104
2104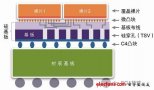
最新裸眼3D技術揭秘
通過裸眼3D技術,你就能看到本來要借助特殊眼鏡才能觀看到的3D立體影像。很好奇吧,就讓《最新裸眼3D技術揭秘》技術專題帶你一起揭秘裸眼3D,一起了解裸眼3D技術、裸眼3D產品(含裸眼3D手機、裸眼3D顯示器、裸眼3D電視...)、裸眼3D技術特點、裸眼3D技術應用等知識吧!
2012-08-17 12:21:52

一文解讀3D打印技術的應用及發展
隨著經濟增長速度不斷加快、技術創新不斷升級,諸如區塊鏈、自動駕駛、云計算、機器人等技術逐漸興起,3D打印技術就是其中之一。 3D打印技術從產生到發展經歷了漫長的時期:1976年,噴墨打印機被發明出來
2018-06-30 07:13:56 8029
8029
 8029
8029兩張圖看懂Intel3D邏輯芯片封裝技術
在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 16:03:40 9951
9951
 9951
9951英特爾為你解說“Foveros”邏輯芯片3D堆疊技術
在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 8854
8854
 8854
8854英特爾邏輯芯片3D堆疊技術“Foveros” 將實現世界一流性能
英特爾近日向業界推出了首款3D邏輯芯片封裝技術“Foveros”,據悉這是在原來的3D封裝技術第一次利用3D堆疊的優點在邏輯芯片上進行邏輯芯片堆疊。也是繼多芯片互連橋接2D封裝技術之后的又一個顛覆技術。
2018-12-14 16:16:45 3316
3316
 3316
3316Global Foundries 12nm工藝的3D封裝安謀芯片面世
對于3D封裝技術,英特爾去年宣布了其對3D芯片堆疊的研究,AMD也談到了在其芯片上疊加3D DRAM和SRAM的方案。
2019-08-13 10:27:53 3414
3414
 3414
3414硅3D集成技術解決方案在傳感器應用中的主要挑戰
從低密度的后通孔TSV 硅3D集成技術,到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發現許多開發新產品的機會。本文概述了當前新興的硅3D集成技術,討論了圖像傳感器
2020-01-16 09:53:00 1550
1550
 1550
1550硅3D集成技術全面解析
從最初為圖像傳感器設計的硅2.5D集成技術,到復雜的高密度的高性能3D系統,硅3D集成是在同一芯片上集成所有功能的系統芯片(SoC)之外的另一種支持各種類型的應用的解決方案,可用于創建性價比更高的系統。
2020-04-10 17:38:49 3497
3497
 3497
3497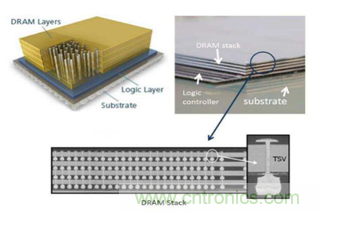
3D封裝技術定義和解析
SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內系統集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強調封裝內包含了某種系統的功能封裝,3D封裝僅強調在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 7076
7076
 7076
7076X-Cube?3D 系列推進 3D 封裝工藝發展
前有臺積電的 CoWoS,Intel 的 Foveros,現在三星也公布了自家的 3D 封裝技術 X-Cube。顯而易見的是,未來我們買到的電子產品中,使用 3D 封裝技術的芯片比例會越來越高。
2020-08-24 14:39:25 3046
3046
 3046
3046繼Intel、臺積電推出3D芯片封裝后,三星宣布新一代3D芯片技術
在Intel、臺積電各自推出自家的3D芯片封裝技術之后,三星也宣布新一代3D芯片技術——X-Cube,基于TSV硅穿孔技術,可以將不同芯片搭積木一樣堆疊起來,目前已經可以用于7nm及5nm工藝。
2020-10-10 15:22:58 2004
2004
 2004
2004臺積電3D封裝芯片計劃2020年量產
11月19日消息,據報道,臺積電與Google等美國客戶正在一同測試,合作開發先進3D堆棧晶圓級封裝產品,并計劃2022年進入量產。臺積電將此3D堆棧技術命名為“SoIC封裝”,可以垂直與水平的進行芯片鏈接及堆棧封裝。
2020-11-20 10:56:30 2854
2854
 2854
2854臺積電正在打造支持3D堆棧封裝技術建設的工廠
近日,據外國媒體報道谷歌和AMD,正在幫助臺積電測試和驗證3D堆棧封裝技術,將成為臺積電這一芯片封裝技術的首批客戶。報道中提到,臺積電正在打造支持3D堆棧封裝技術建設的工廠,預計明年建成。
2020-11-23 16:21:06 2515
2515
 2515
2515英特爾異構3D系統級封裝集成
異構 3D 系統級封裝集成 3D 集成與封裝技術的進步使在單個封裝(包含采用多項技術的芯片)內構建復雜系統成為了可能。 過去,出于功耗、性能和成本的考慮,高級集成使用單片實施。得益于封裝與堆疊技術
2021-03-22 09:27:53 2981
2981
 2981
2981一文帶你看懂3D視覺
從手機解鎖、支付消費到工廠的生產應用,3D 視覺已經深入到生活的方方面面。那到底什么是3D 視覺。它在仙工智能視覺 AI 解決方案中又扮演著什么角色? 今天零化身科普小達人一文帶你看懂 3D 視覺
2021-09-01 09:52:14 7364
7364
 7364
7364半導體2.5D/3D封裝技術:趨勢和創新
電子行業正在經歷半導體封裝技術的再興。越來越多的創新性的3D封裝方法已經發展,是電子工廠能夠去最大化他們的產品功能。通過整合多個芯片到一個封裝模組中,產品板可以明顯的比它們的前輩更小,并且更短的內部
2022-04-29 17:17:43 8
8
 8
82.5D/3D芯片-封裝-系統協同仿真技術研究
(Signal Integrity, SI)、電源完整性 (Power
Integrity, PI) 及可靠性優化。總結了目前 2.5D/3D 芯片仿真進展與挑戰,介紹了基于芯片模型的
Ansys 芯片-封裝-系統 (CPS) 多物理場協同仿真方法,闡述了如何模擬芯片在真實工況下達到優化
芯片信
2022-05-06 15:20:42 19
19
 19
19分享一下小芯片集成的2.5D/3D IC封裝技術
異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 5418
5418
 5418
5418為什么選擇3D,3D芯片設計要點分析
然已經有很多關于 3D 設計的討論,但對于 3D 的含義有多種解釋。然而,這不僅僅是語義,因為每個封裝選項都需要不同的設計方法和技術。
2023-03-27 13:01:38 1147
1147
 1147
1147日本計劃量產2nm芯片,著眼于2.5D、3D封裝異構技術
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 1652
1652
 1652
16523D封裝結構與2.5D封裝有何不同?3D IC封裝主流產品介紹
2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 5284
5284
 5284
5284
基于HFSS的3D多芯片互連封裝MMIC仿真設計
相對于傳統平面型的金絲鍵合焊接的MMIC應用,三維(3D)多芯片互連封裝MMIC以其高集成度、低損耗、高可靠性等性能優勢,正逐步在先進電路與系統中得到應用。而3D封裝引入的復雜電磁耦合效應,在傳統
2023-08-30 10:02:07 5731
5731
 5731
5731
三星2024年將推出先進3D芯片封裝技術SAINT
三星計劃在2024年先進3D芯片封裝技術SAINT(Samsung Advanced Interconnection Technology,三星高級互連技術),能以更小尺寸的封裝,將AI芯片等高性能芯片的內存和處理器集成。
2023-11-15 11:09:30 2499
2499
 2499
2499智原推出2.5D/3D先進封裝服務, 無縫整合小芯片
(Interposer)制造服務以連接小芯片(Chiplets),并與一流的晶圓代工廠和測試封裝供貨商緊密合作,確保產能、良率、質量、可靠性和生產進度,從而實現多源小芯片的無縫整合,進而保證項目的成功。 智原不僅專注于技術,更為每位客戶量身打造2.5D/3D先進封裝服務。作為一個中立的服務廠商,智原在包
2023-11-20 18:35:42 1107
1107
 1107
1107英特爾量產3D Foveros封裝技術
英特爾在封裝技術方面取得了重大突破,并已經開始大規模生產基于3D Foveros技術的產品。這項技術使得英特爾能夠在單個封裝中整合多個小芯片(Chiplets),從而提高了芯片的性能、尺寸和設計靈活性。
2024-01-26 16:04:50 1281
1281
 1281
1281探秘2.5D與3D封裝技術:未來電子系統的新篇章!
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 5268
5268
 5268
5268
混合鍵合技術:開啟3D芯片封裝新篇章
Bonding)技術應運而生,并迅速成為3D芯片封裝領域的核心驅動力。本文將深入探討混合鍵合技術在3D芯片封裝中的關鍵作用,分析其技術原理、應用優勢以及未來發展
2024-08-26 10:41:54 2476
2476
 2476
2476
一文理解2.5D和3D封裝技術
隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。
2024-11-11 11:21:51 5379
5379
 5379
5379
技術資訊 | 2.5D 與 3D 封裝
加速器中的應用。3D封裝提供了出色的集成度,高效的散熱和更短的互連長度,是高性能應用的理想之選。在快速發展的半導體技術領域,封裝在很大程度上決定了電子設備的性能、
2024-12-07 01:05:05 2506
2506
 2506
2506
一文解析多芯片封裝技術
多芯片封裝(Multi-Chip Packaging, MCP)技術通過在一個封裝中集成多個芯片或功能單元,實現了空間的優化和功能的協同,大幅提升了器件的性能、帶寬及能源效率,成為未來高性能計算
2024-12-30 10:36:47 1924
1924
 1924
1924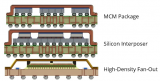
技術前沿:半導體先進封裝從2D到3D的關鍵
技術前沿:半導體先進封裝從2D到3D的關鍵 半導體分類 集成電路封測技術水平及特點?? ? 1. 發展概述 ·自20世紀90年代以來,集成電路封裝技術快速發展,推動了電子產品向小型化和多功能方向邁進
2025-01-07 09:08:19 3353
3353
 3353
3353
2.5D和3D封裝技術介紹
。 2.5D封裝將die拉近,并通過硅中介連接。3D封裝實際上采用2.5D封裝,進一步垂直堆疊die,使die之間的連接更短。通過這種方式直接集成IC,IC間通信接口通常可以減少或完全消除。這既可以提高性能,又可以減輕重量和功耗。 這種封裝的復雜性需要新穎的封裝和測試技術。 了解2.5D封裝與3
2025-01-14 10:41:33 2903
2903
 2903
2903
芯片3D堆疊封裝:開啟高性能封裝新時代!
在半導體行業的快速發展歷程中,芯片封裝技術始終扮演著至關重要的角色。隨著集成電路設計復雜度的不斷提升和終端應用對性能、功耗、尺寸等多方面要求的日益嚴苛,傳統的2D封裝技術已經難以滿足市場的需求。在此背景下,芯片3D堆疊封裝技術應運而生,成為半導體技術發展的新里程碑。
2025-02-11 10:53:45 2819
2819
 2819
2819
高密度3-D封裝技術全解析
隨著半導體技術的飛速發展,芯片集成度和性能要求日益提升。傳統的二維封裝技術已經難以滿足現代電子產品的需求,因此,高密度3-D封裝技術應運而生。3-D封裝技術通過垂直堆疊多個芯片或芯片層,實現前所未有的集成密度和性能提升,成為半導體封裝領域的重要發展方向。
2025-02-13 11:34:38 1614
1614
 1614
1614
3D封裝與系統級封裝的背景體系解析介紹
3D封裝與系統級封裝概述 一、引言:先進封裝技術的演進背景 隨著摩爾定律逐漸逼近物理極限,半導體行業開始從單純依賴制程微縮轉向封裝技術創新。3D封裝和系統級封裝(SiP)作為突破傳統2D平面集成限制
2025-03-22 09:42:56 1794
1794
 1794
1794
多芯粒2.5D/3D集成技術研究現狀
面向高性能計算機、人工智能、無人系統對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術為代表的先進封裝集成技術,不僅打破了當前集成芯片良率降低、成本驟升的困境,也是實現多種類型、多種材質、多種功能芯粒集成的重要手段。2.5D/3D 集成技術正快速發展,集成方案與集成技術日新月異。
2025-06-16 15:58:31 1507
1507
 1507
1507
Chiplet與3D封裝技術:后摩爾時代的芯片革命與屹立芯創的良率保障
在摩爾定律逐漸放緩的背景下,Chiplet(小芯片)技術和3D封裝成為半導體行業突破性能與集成度瓶頸的關鍵路徑。然而,隨著芯片集成度的提高,氣泡缺陷成為影響封裝良率的核心挑戰之一。
2025-07-29 14:49:39 855
855
 855
855
【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估
一、引言
隨著半導體技術向小型化、高性能化發展,3D 集成封裝技術憑借其能有效提高芯片集成度、縮短信號傳輸距離等優勢,成為行業發展的重要方向 。玻璃晶圓因其良好的光學透明性、化學穩定性及機械強度
2025-10-14 15:24:56 317
317
 317
317
淺談2D封裝,2.5D封裝,3D封裝各有什么區別?
集成電路封裝技術從2D到3D的演進,是一場從平面鋪開到垂直堆疊、從延遲到高效、從低密度到超高集成的革命。以下是這三者的詳細分析:
2025-12-03 09:13:15 440
440
 440
440簡單認識3D SOI集成電路技術
在半導體技術邁向“后摩爾時代”的進程中,3D集成電路(3D IC)憑借垂直堆疊架構突破平面縮放限制,成為提升性能與功能密度的核心路徑。
2025-12-26 15:22:38 195
195
 195
195
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D封裝將成為僅次于晶圓級封裝的第二大先進封裝形式。這一技術不僅能夠提高芯片的性能和集成度,還能有效降低功耗,為AI和高性能計算等領域提供強有力的
2024-07-11 01:12:00 8591
8591
 8591
8591 電子發燒友App
電子發燒友App









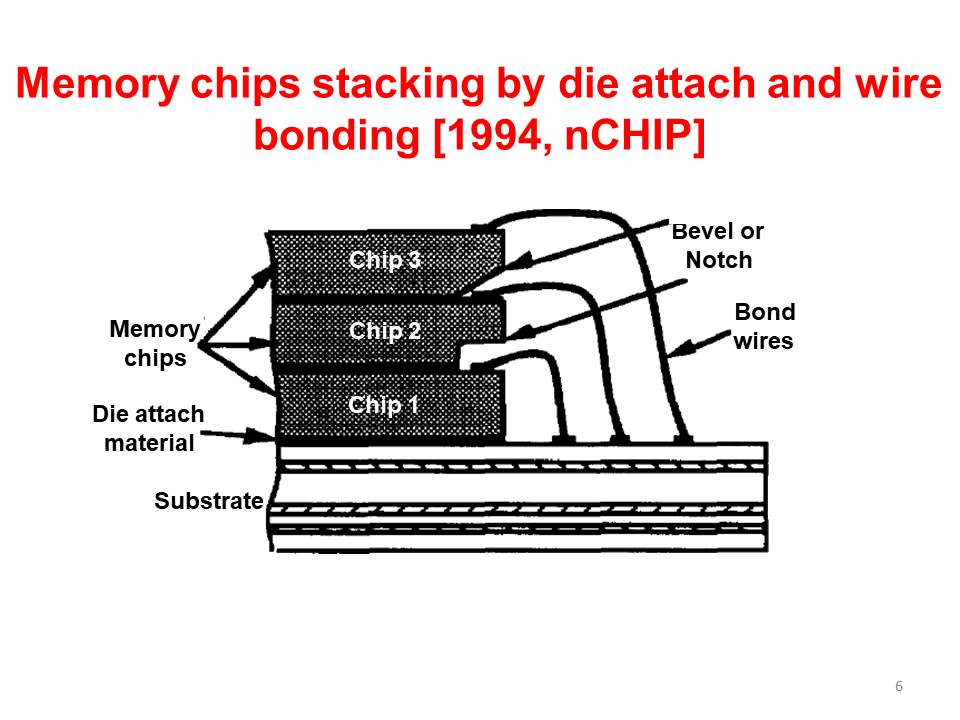
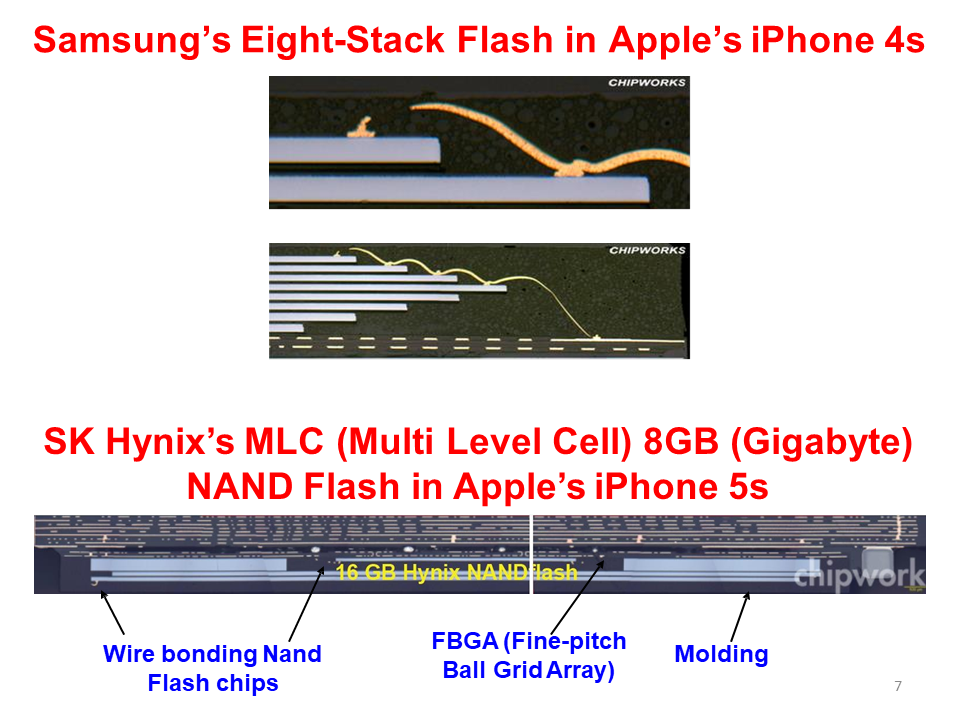
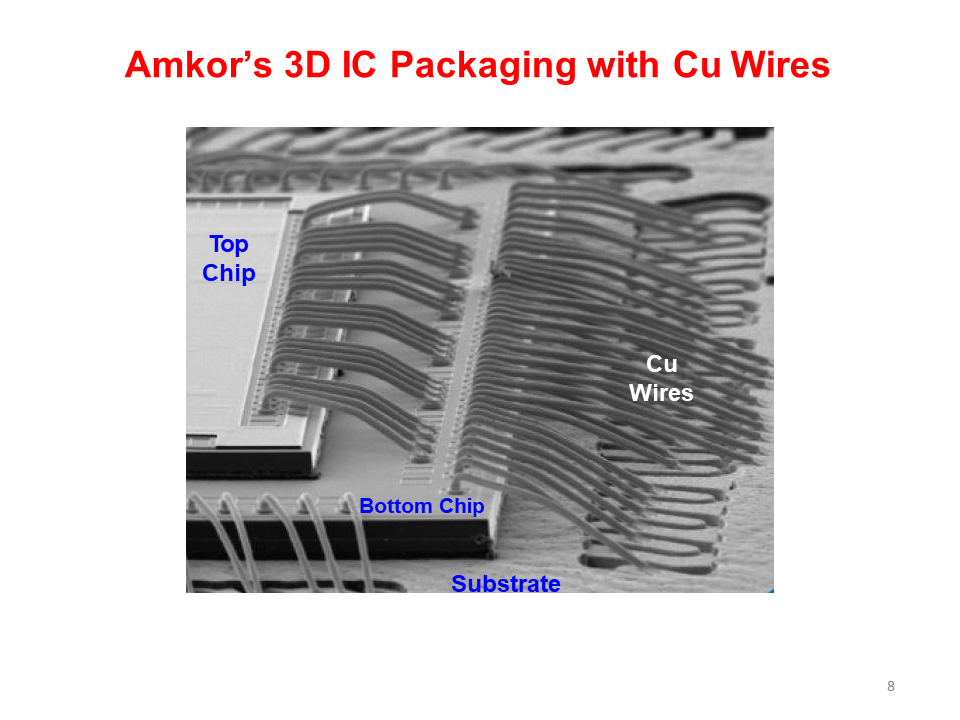

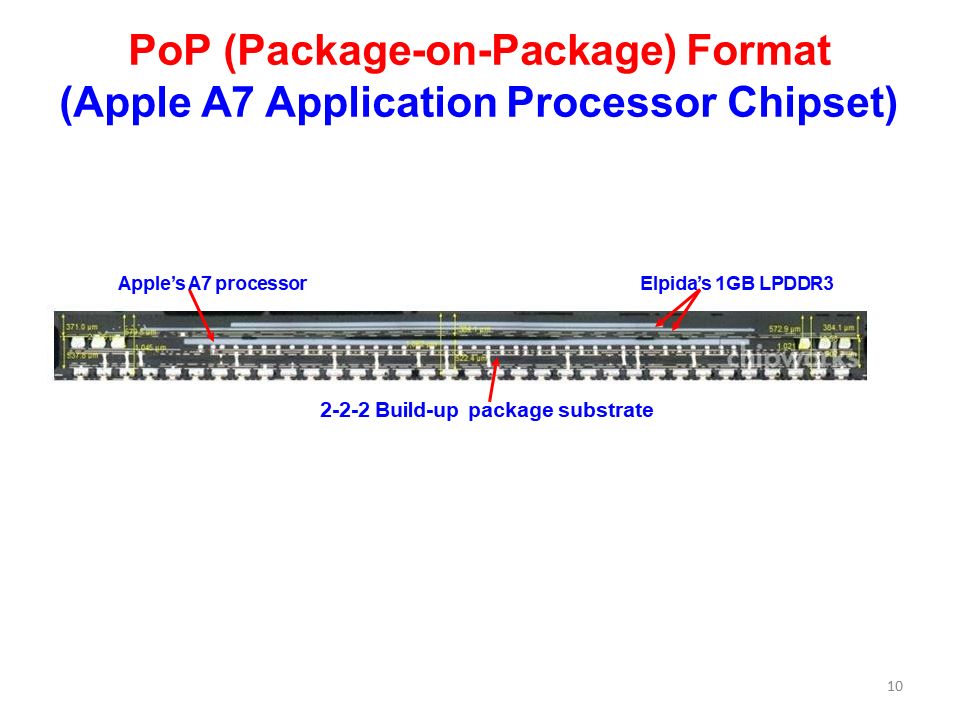
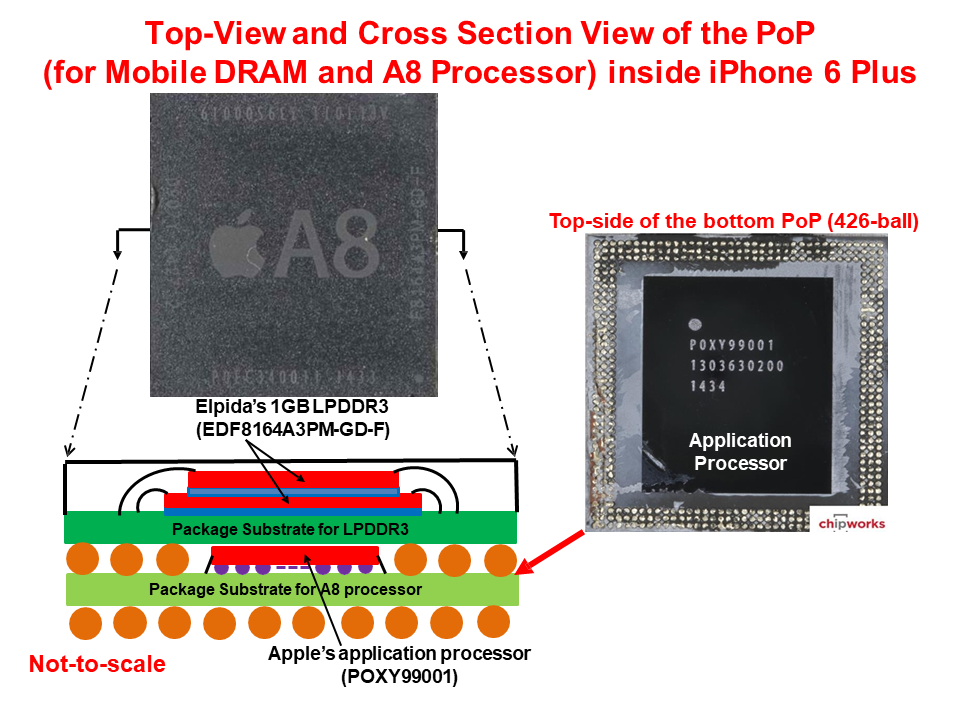
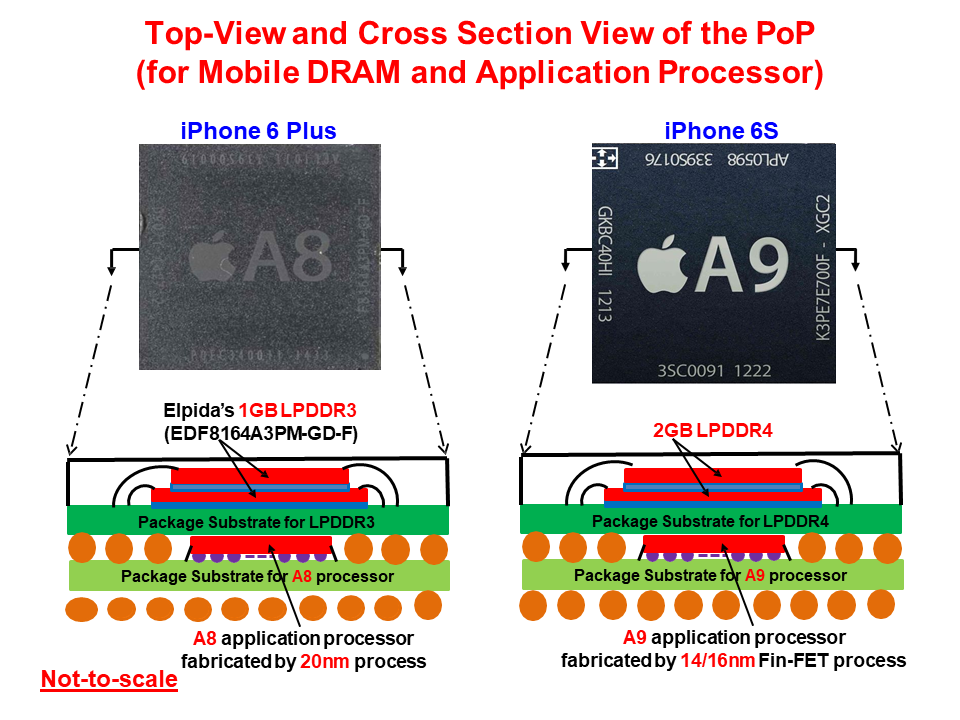
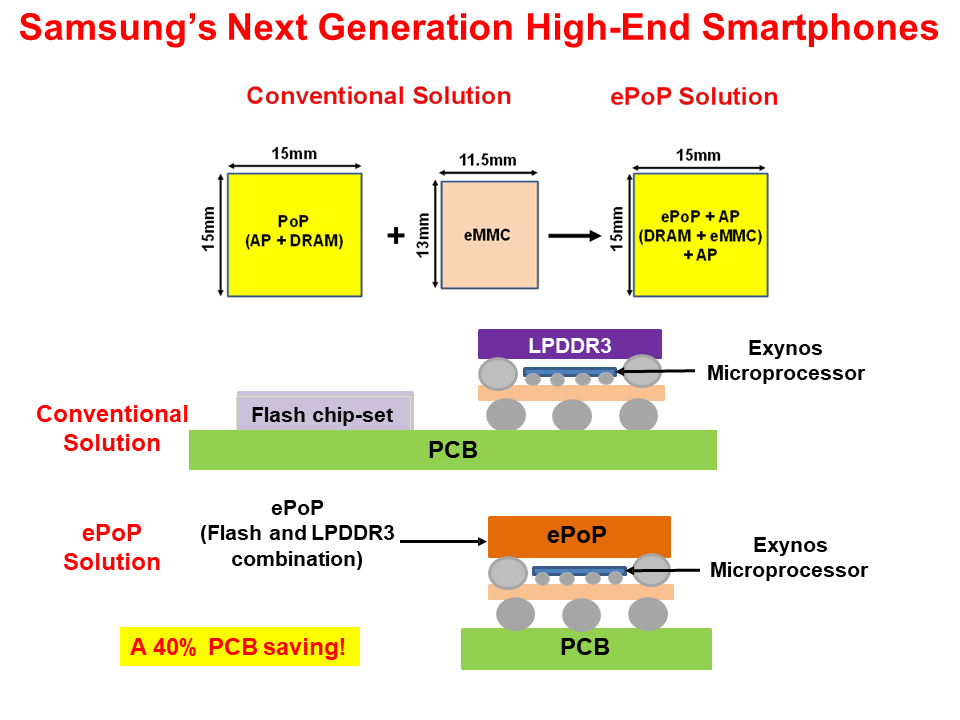

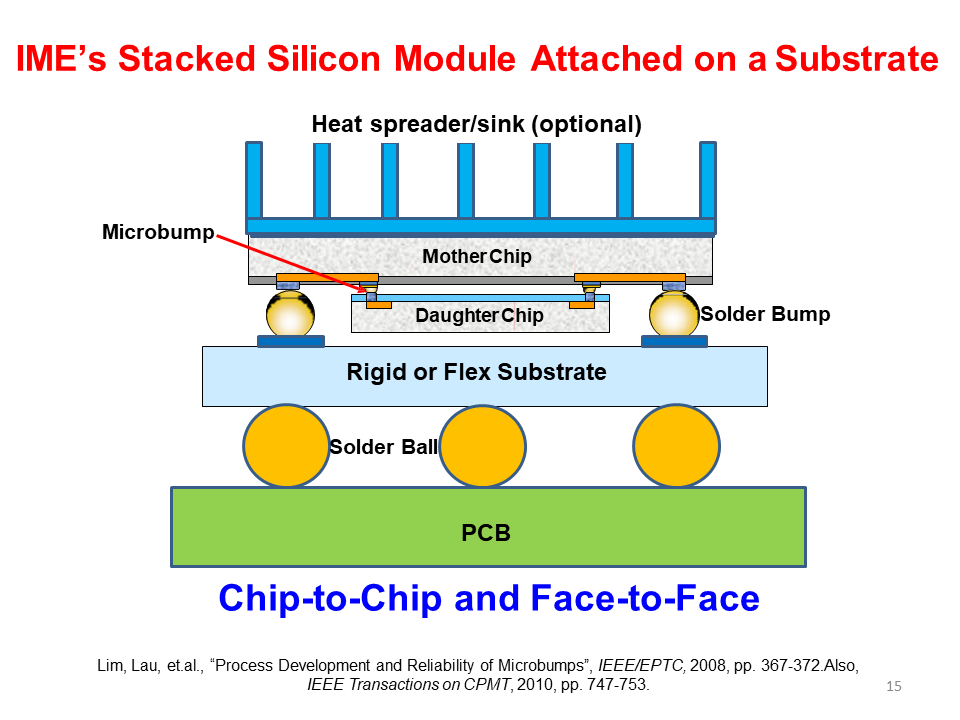
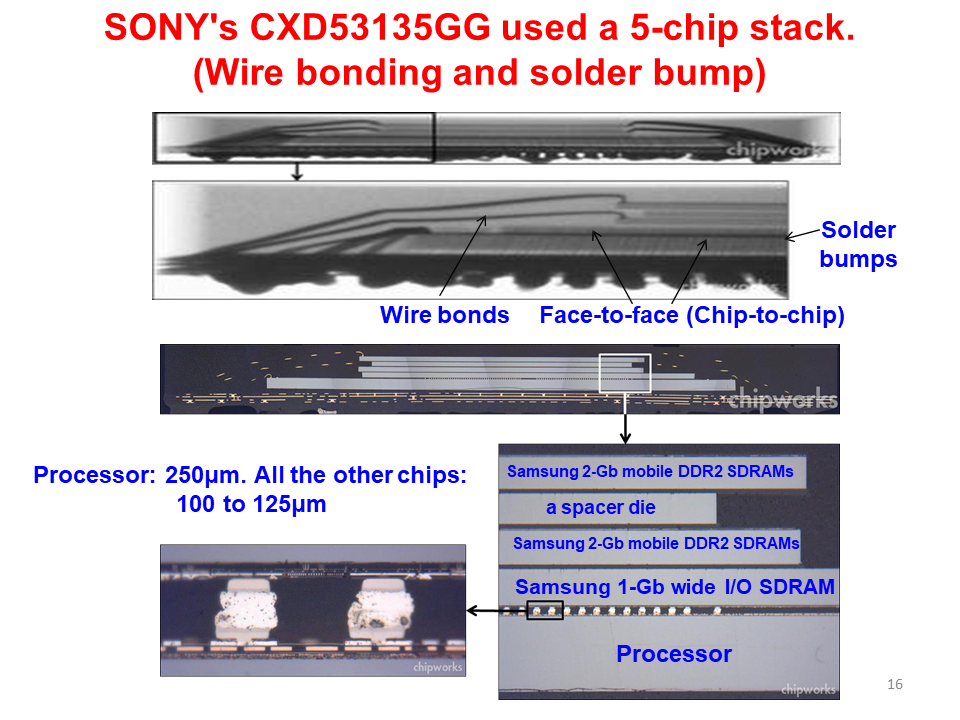

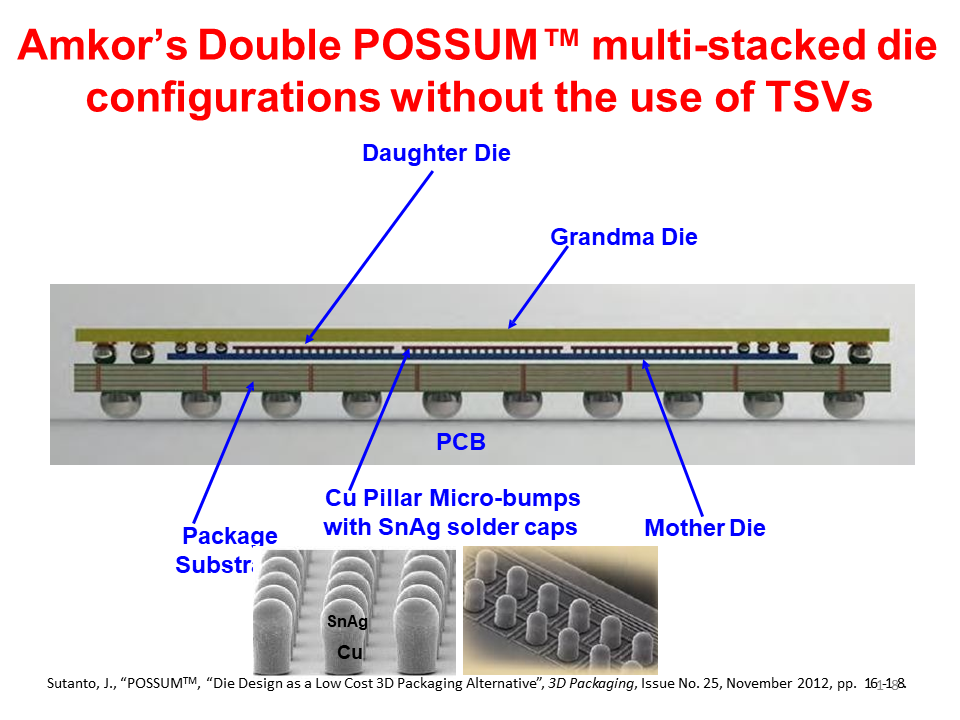
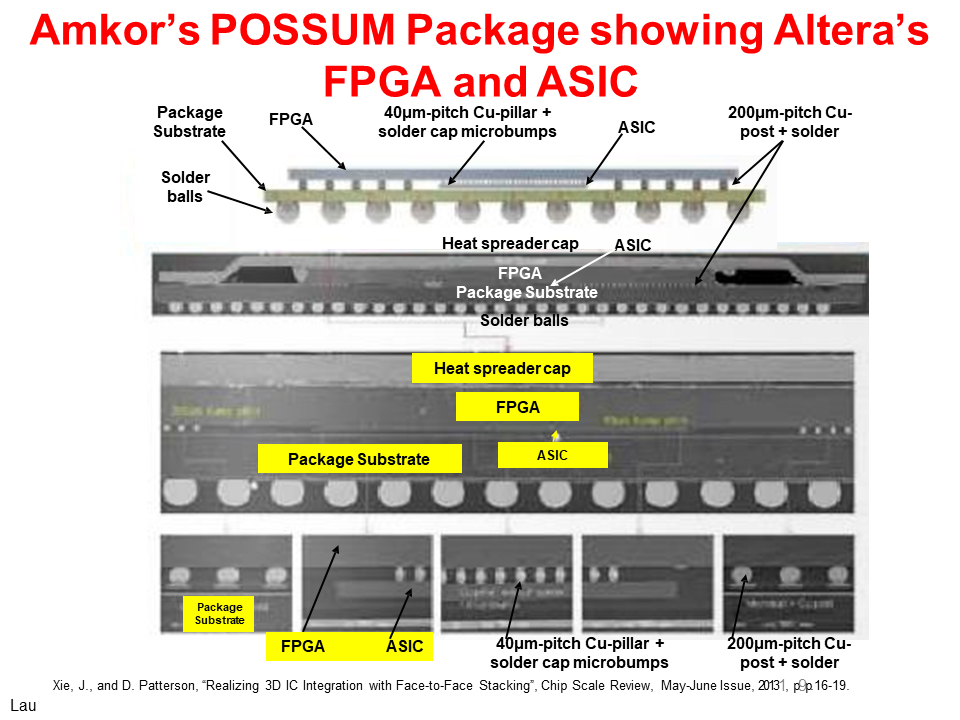

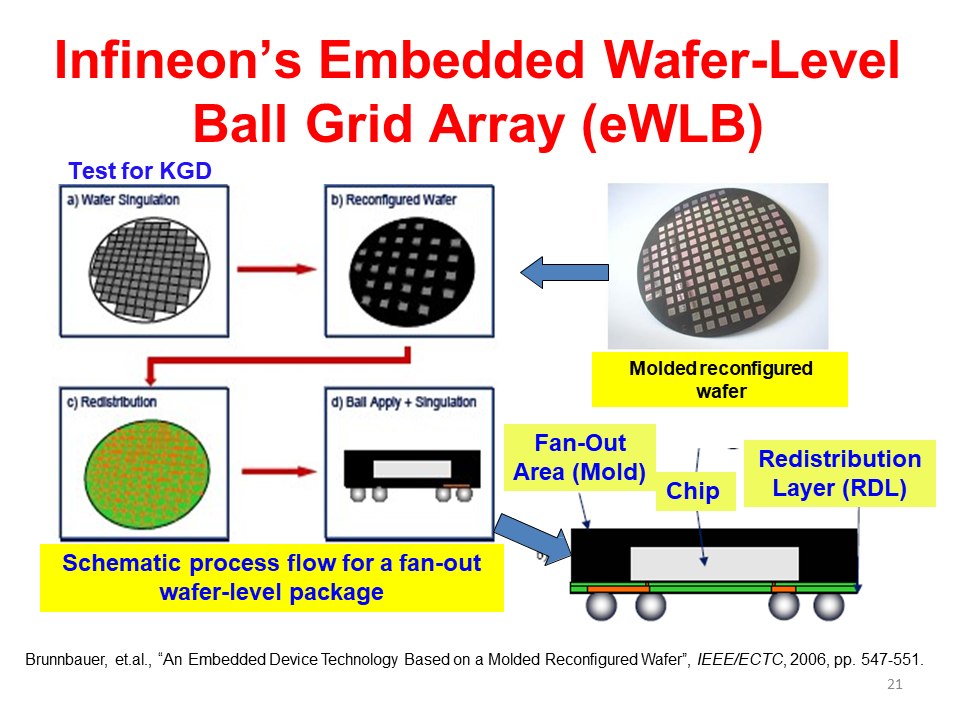
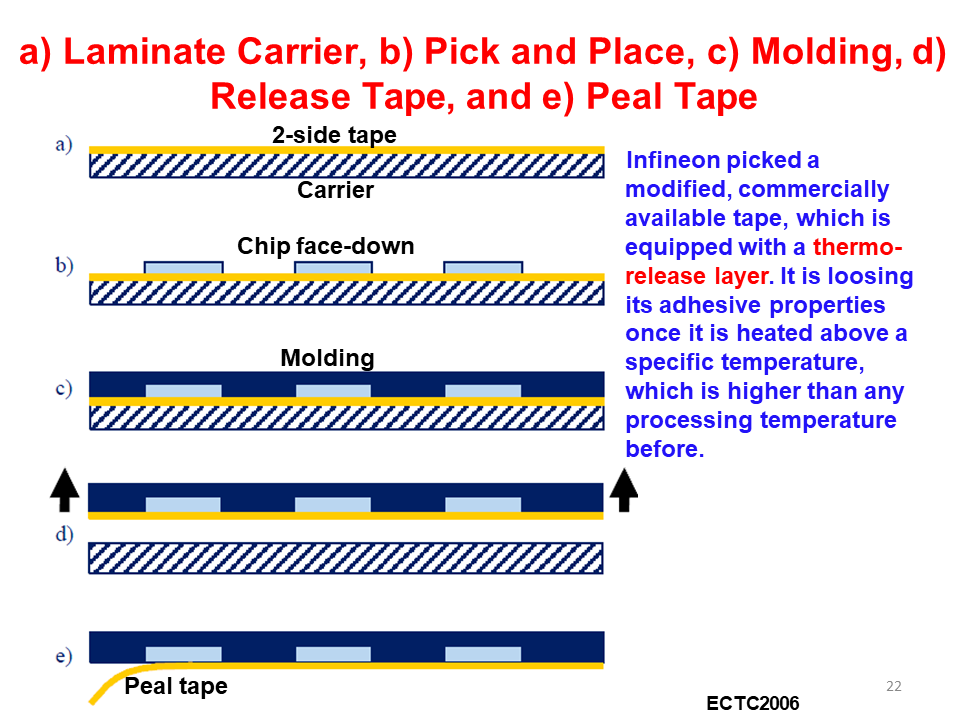
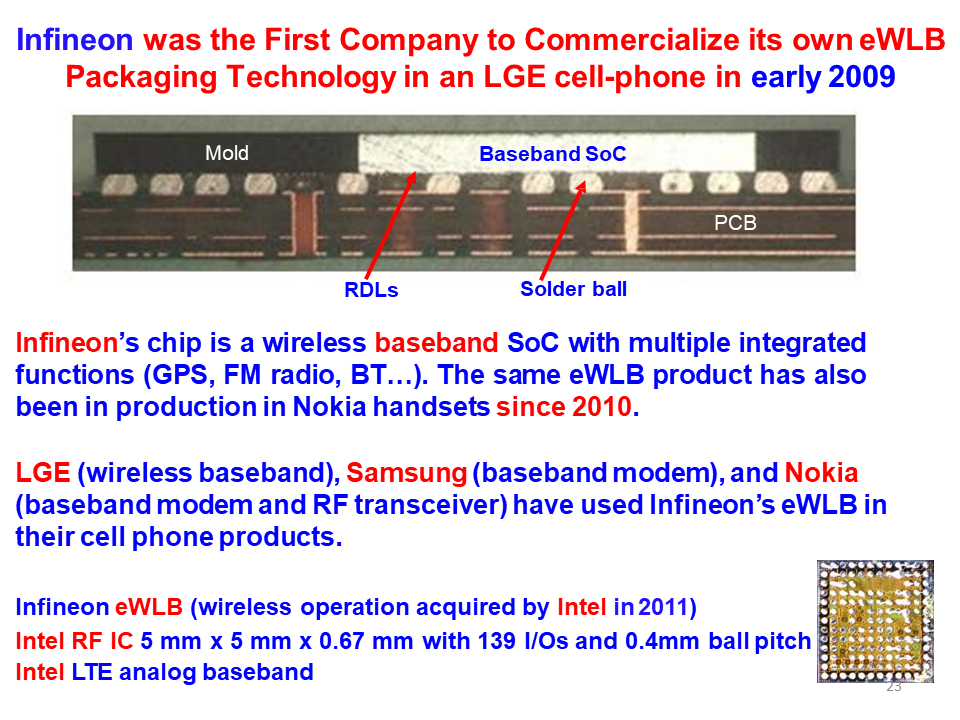
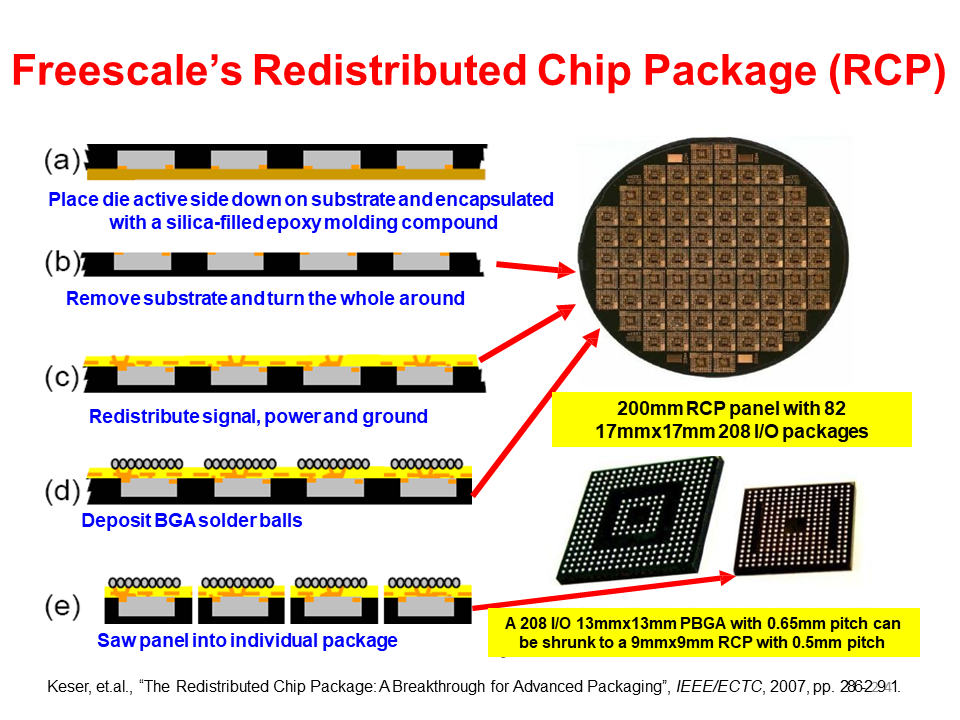
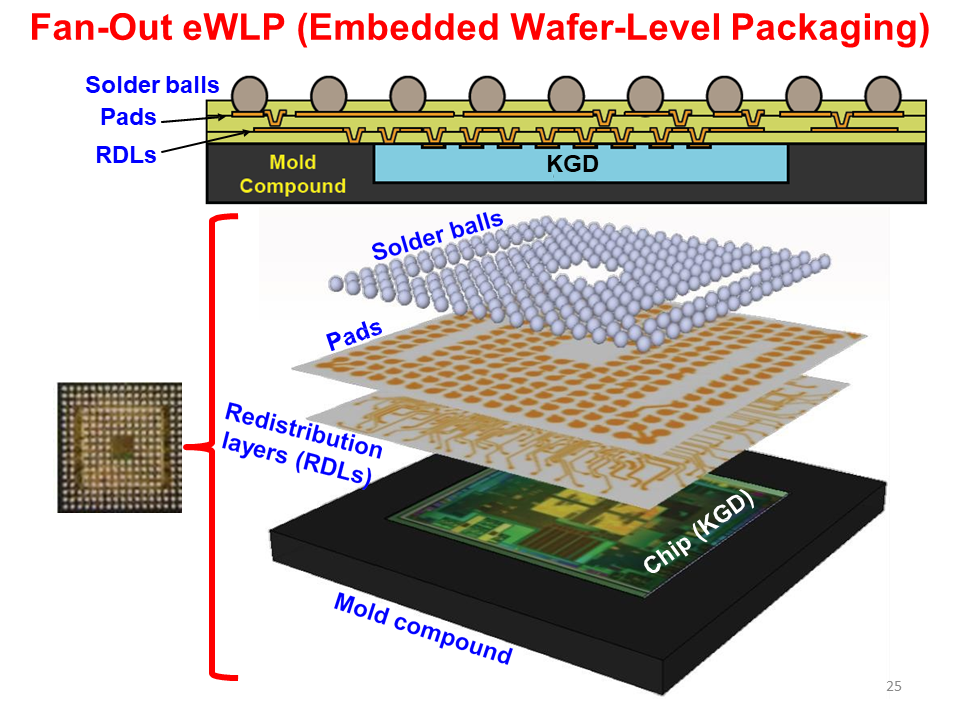
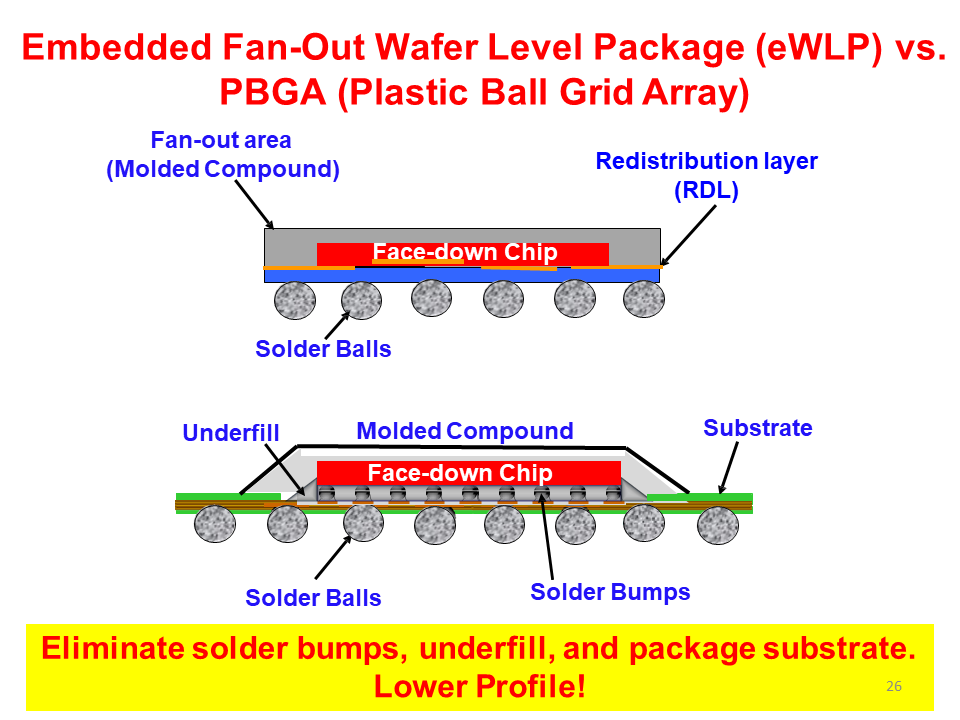


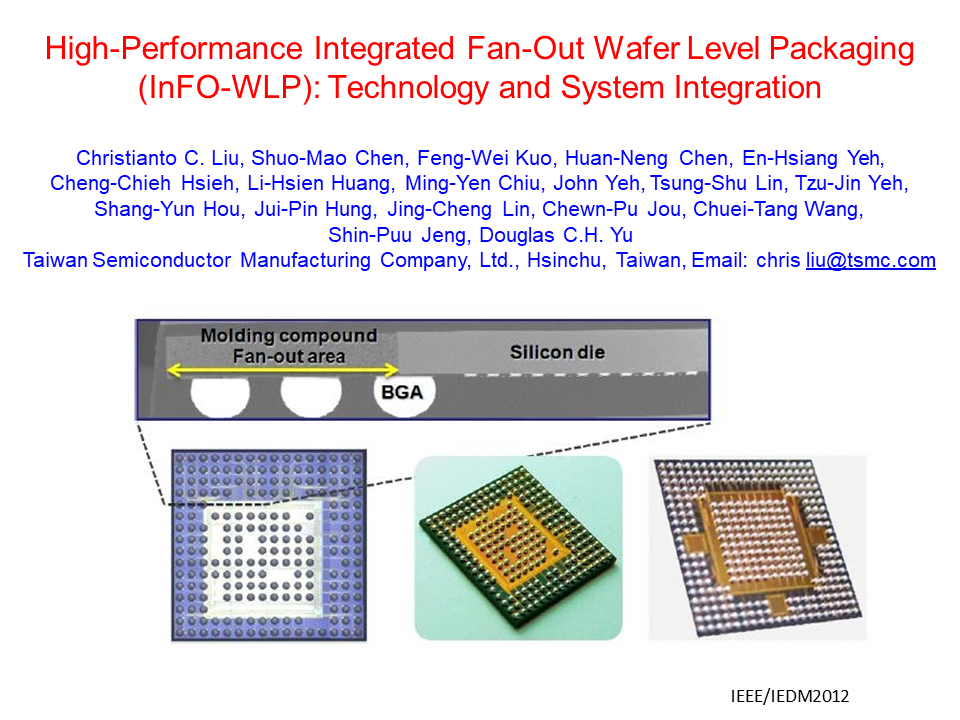
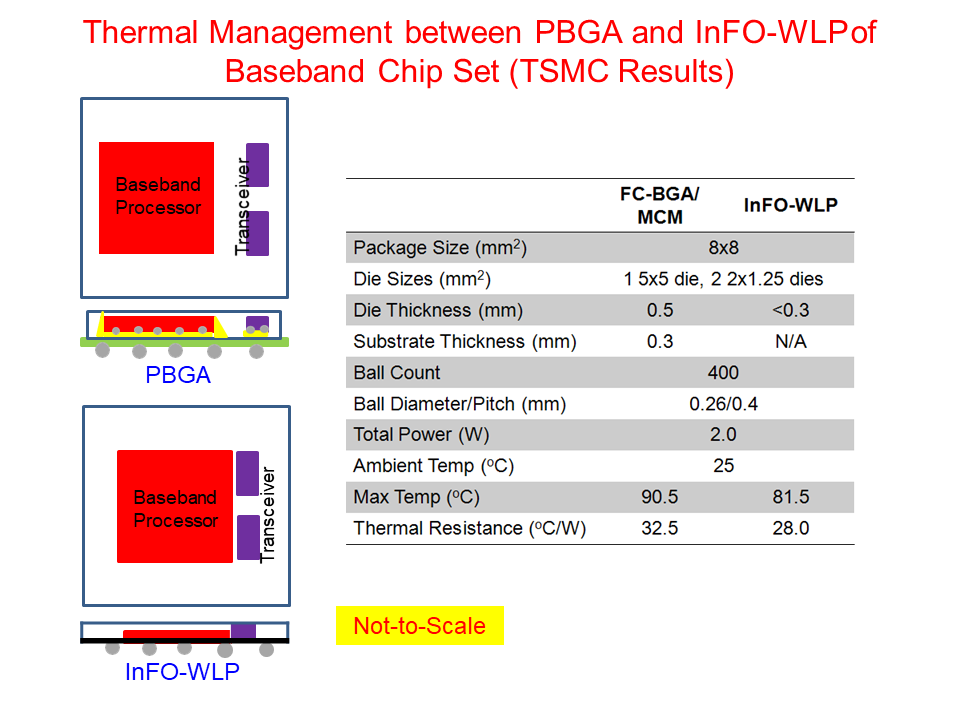
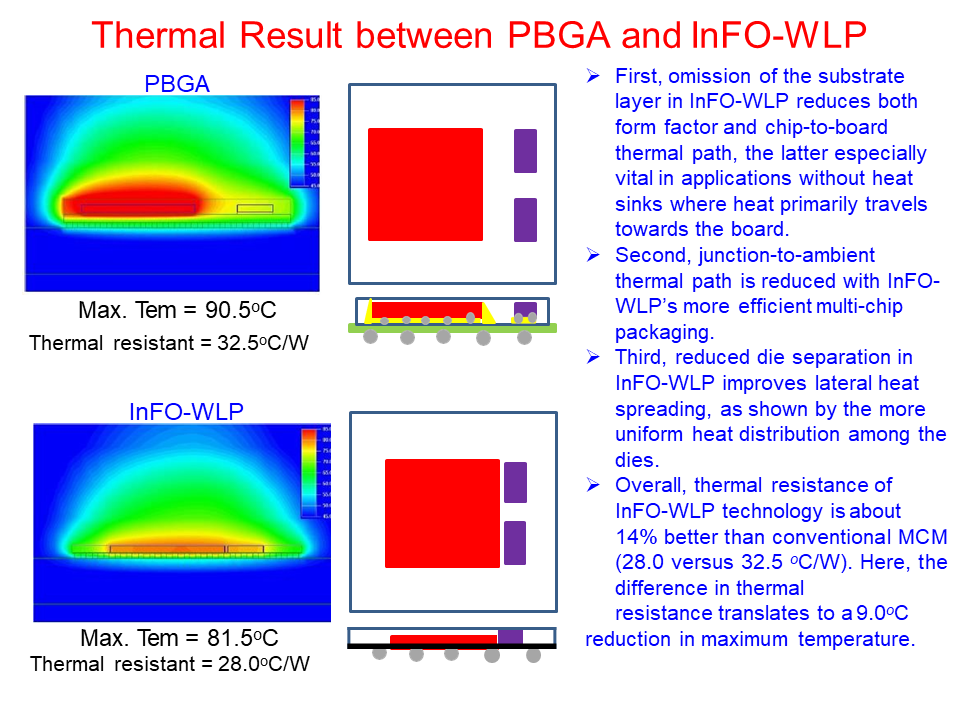
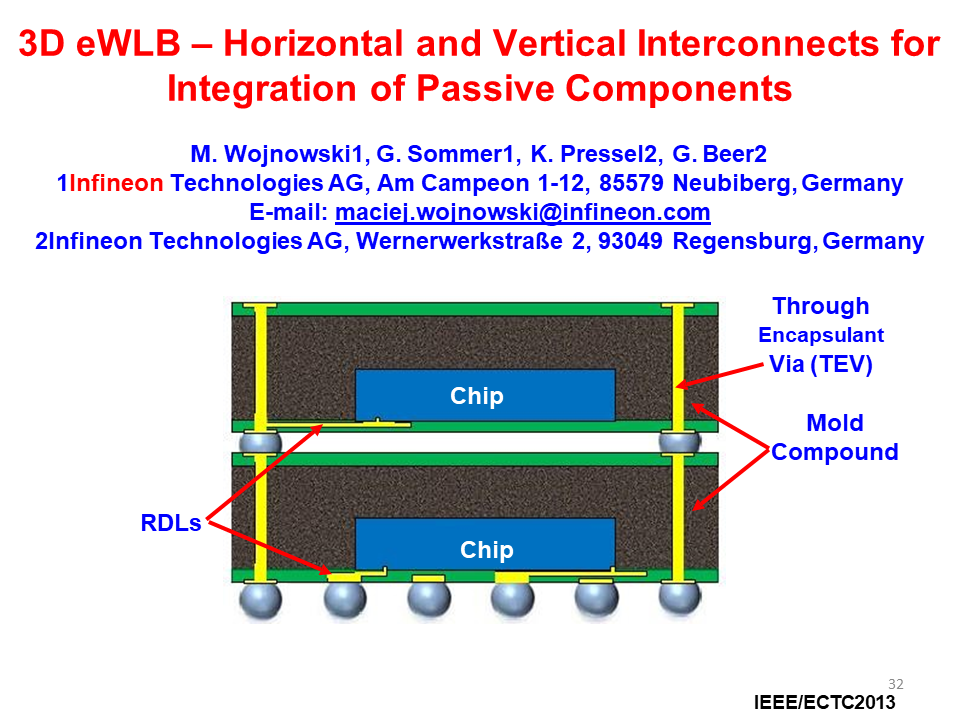
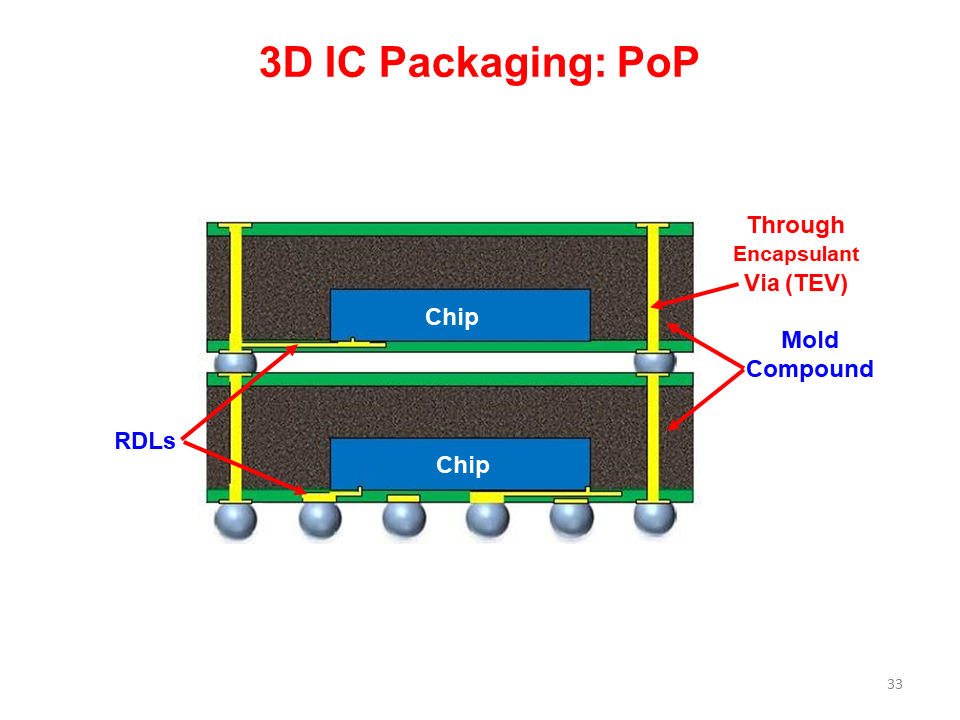
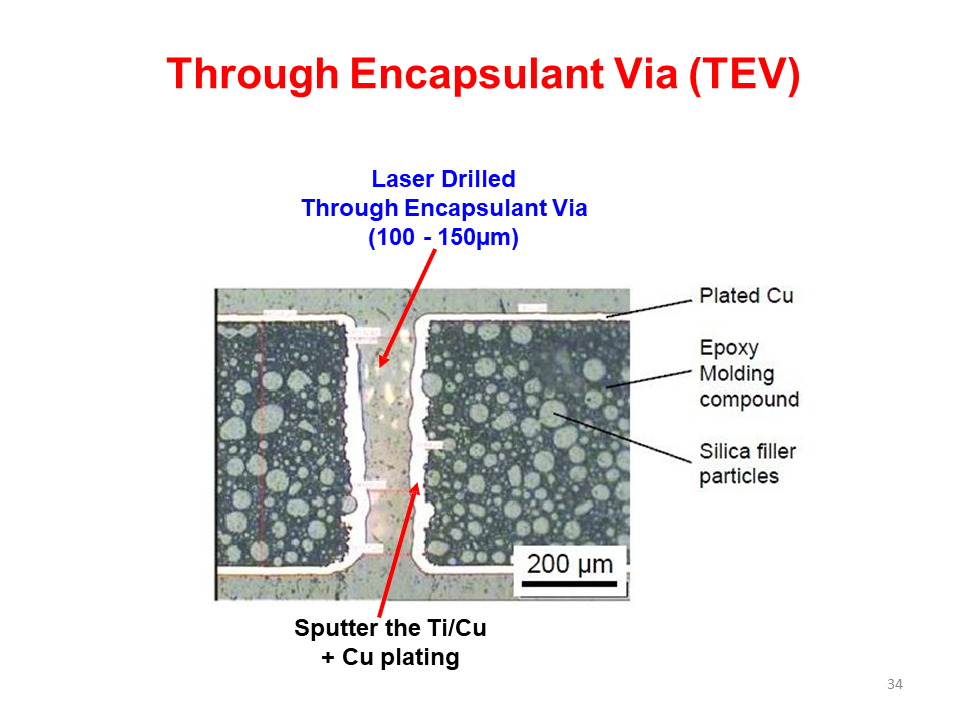
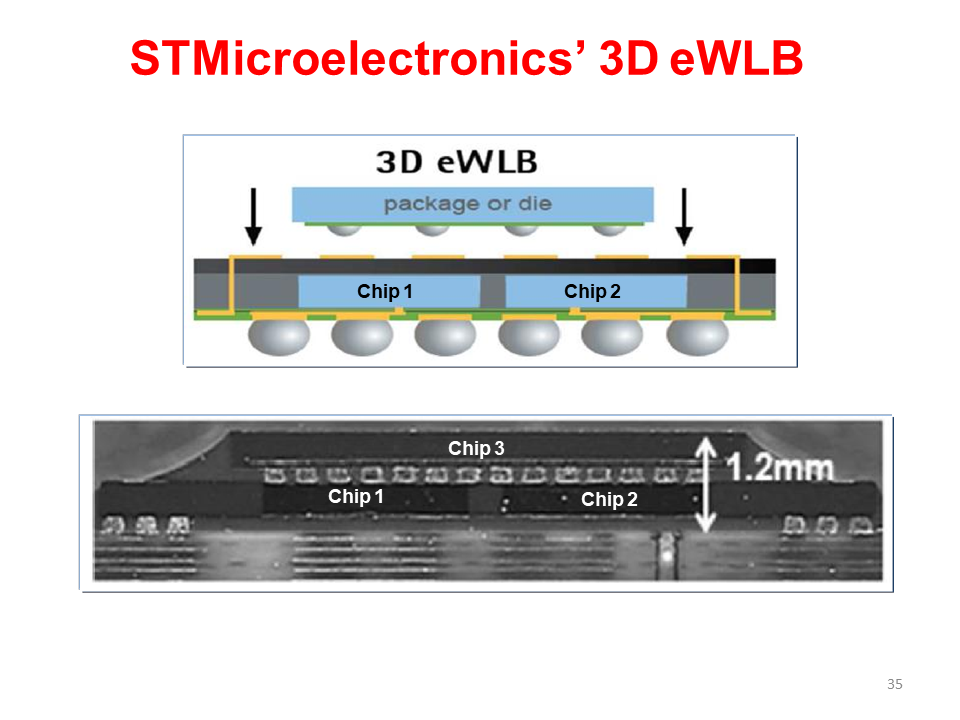
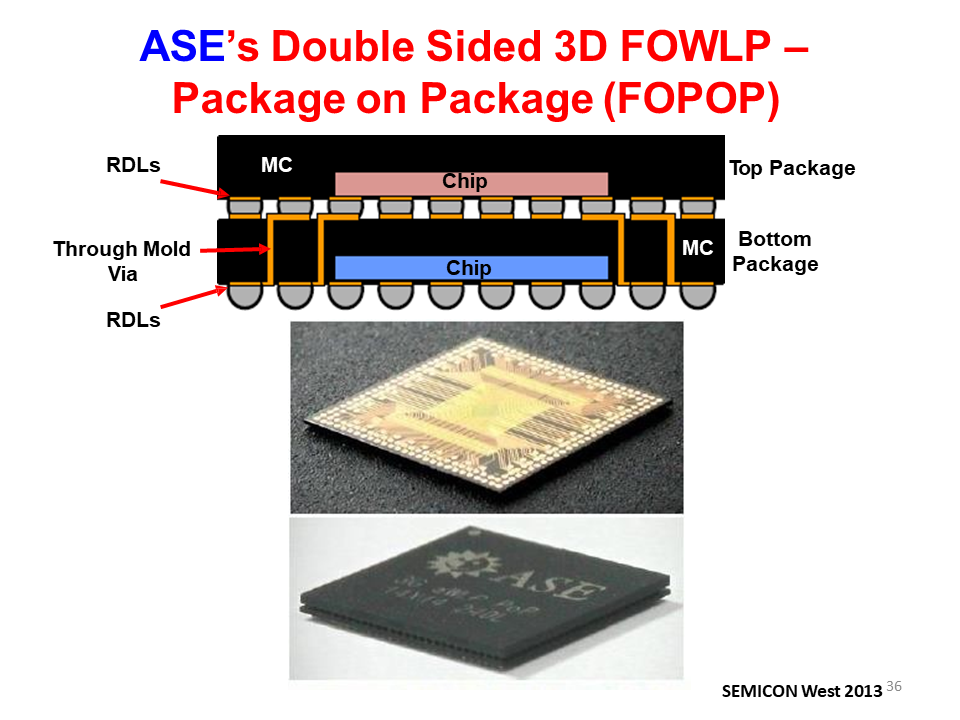
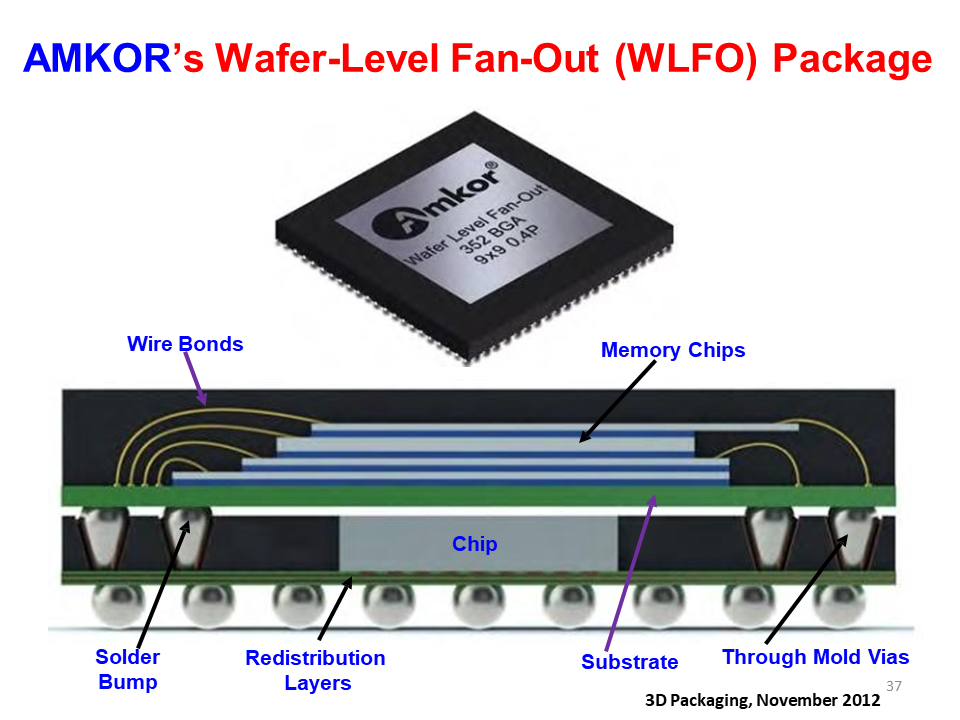
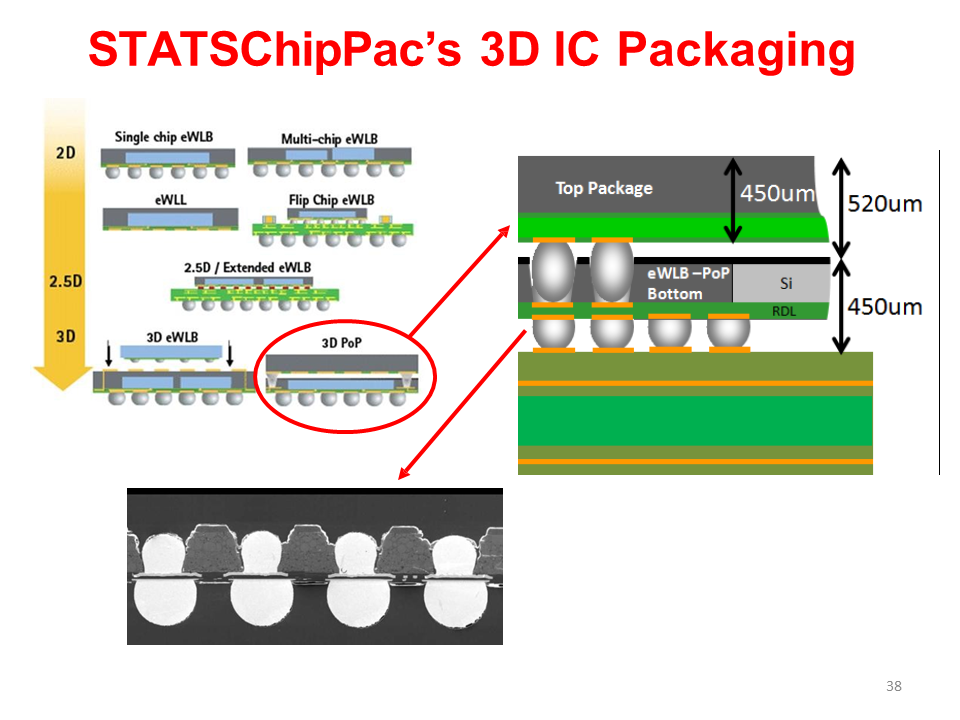







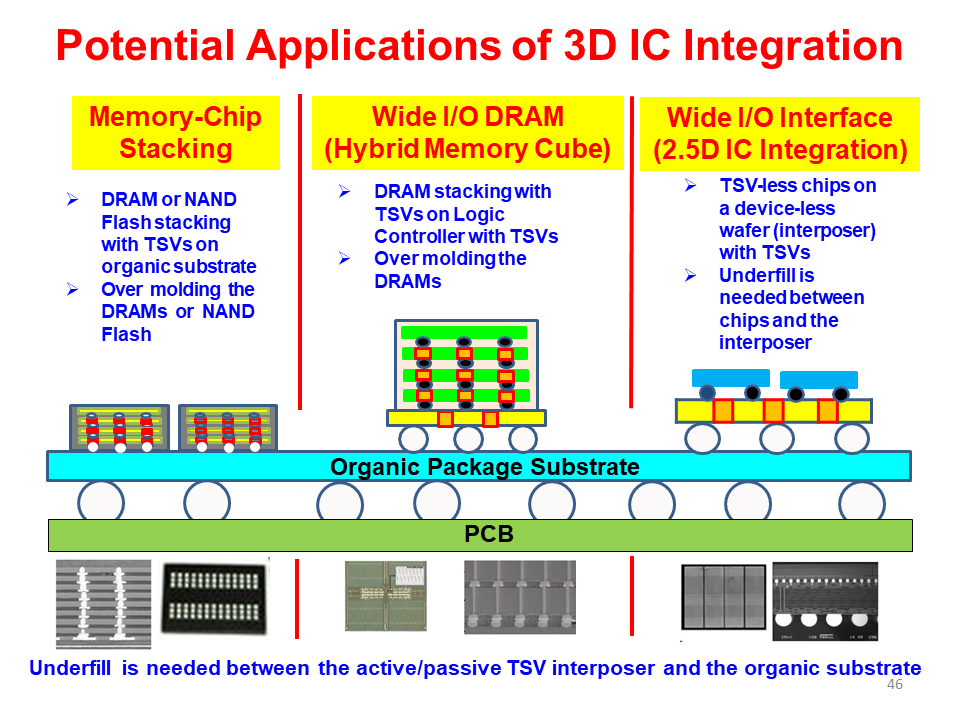

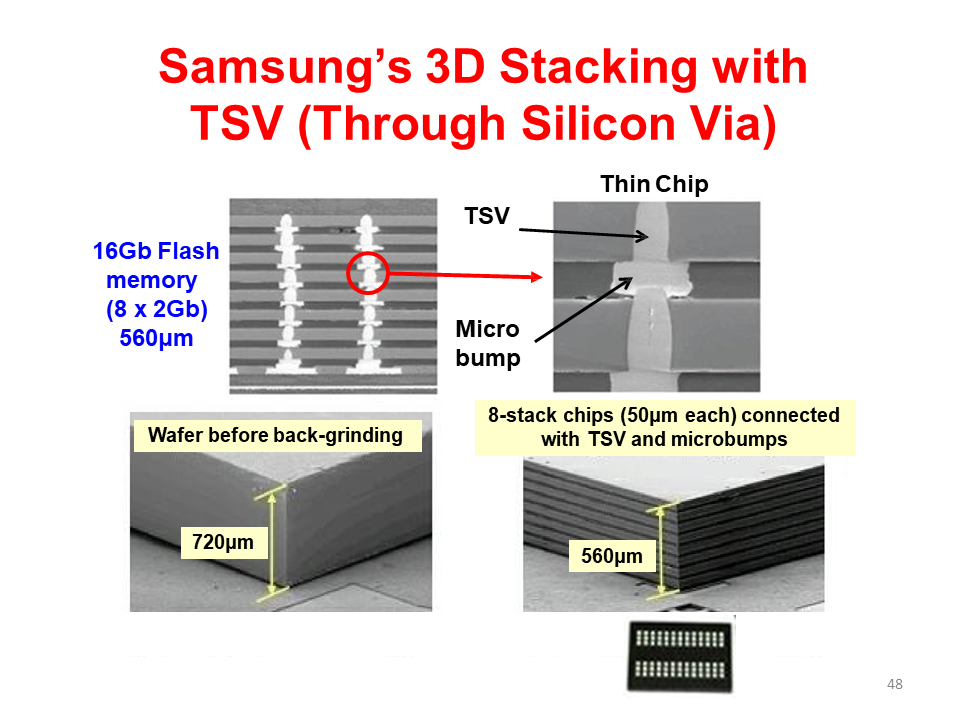
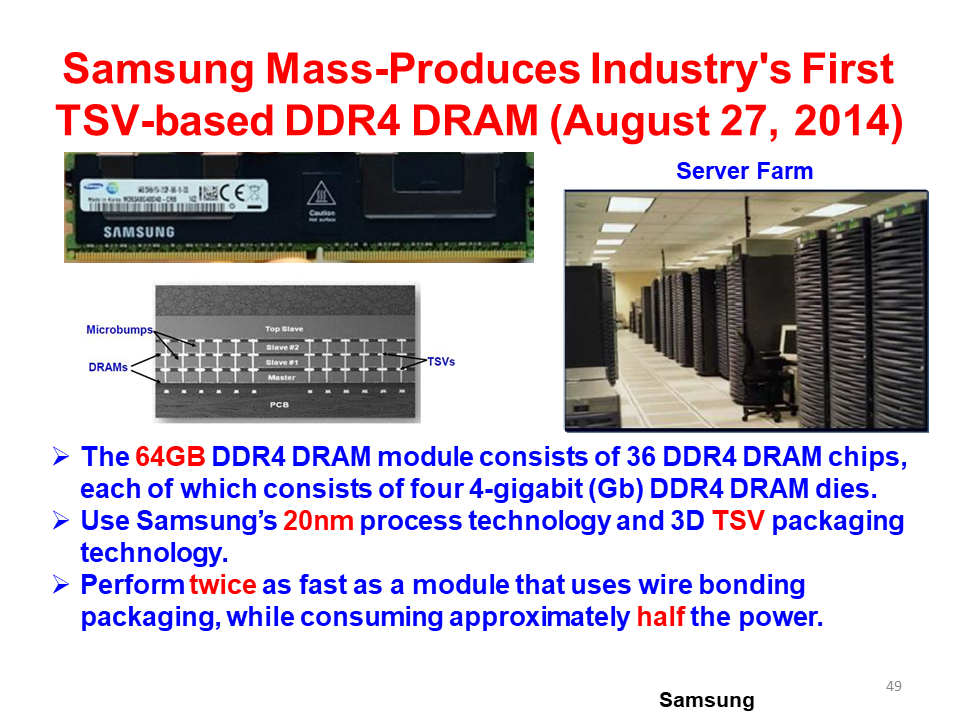
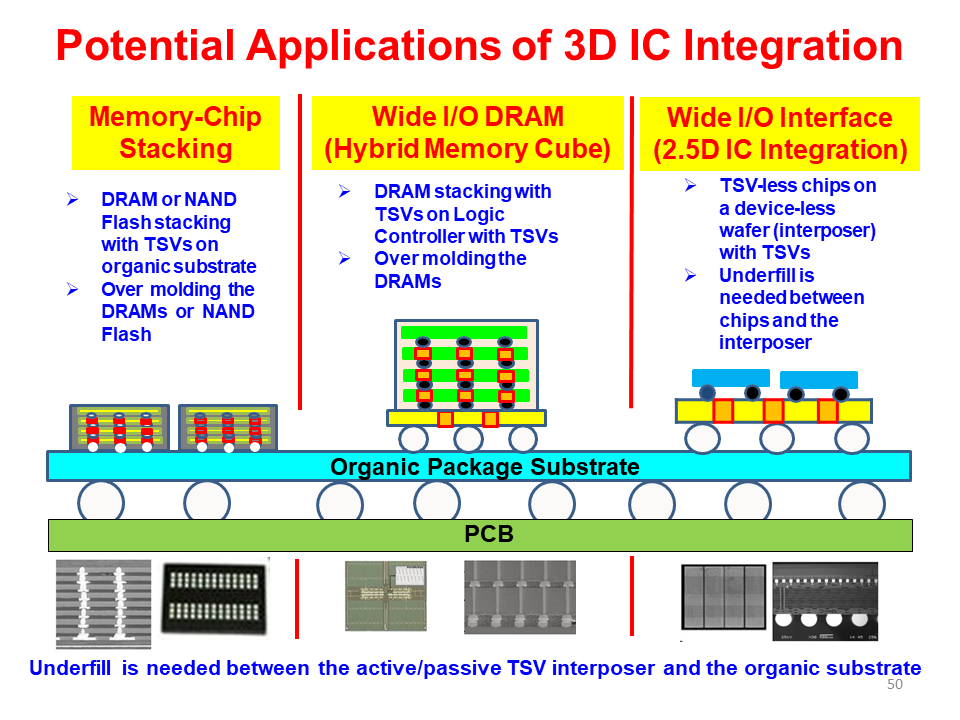

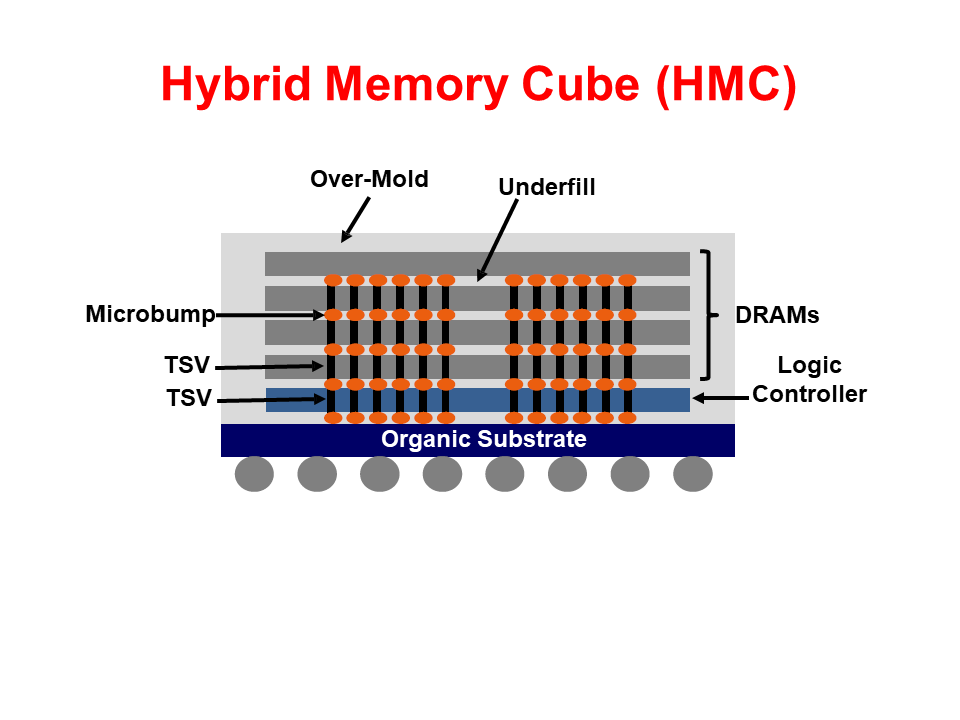

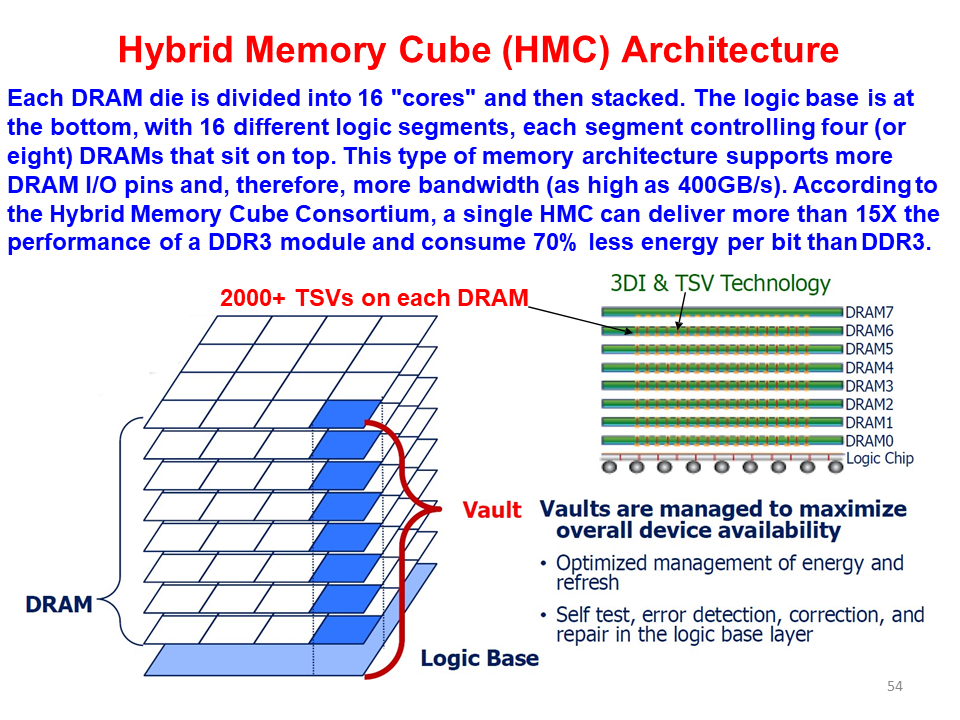

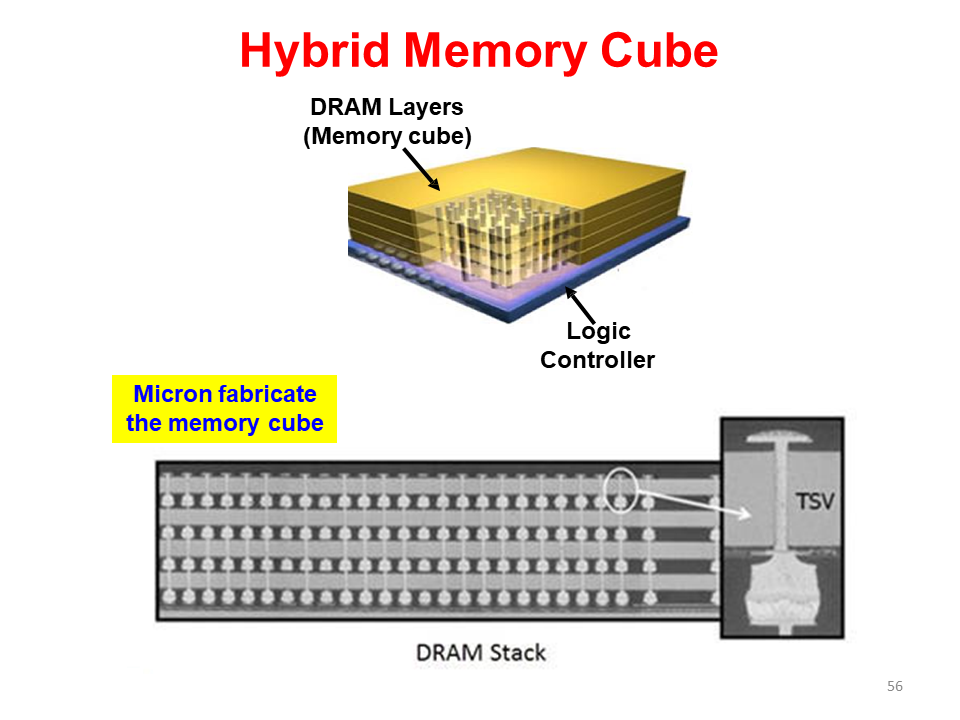
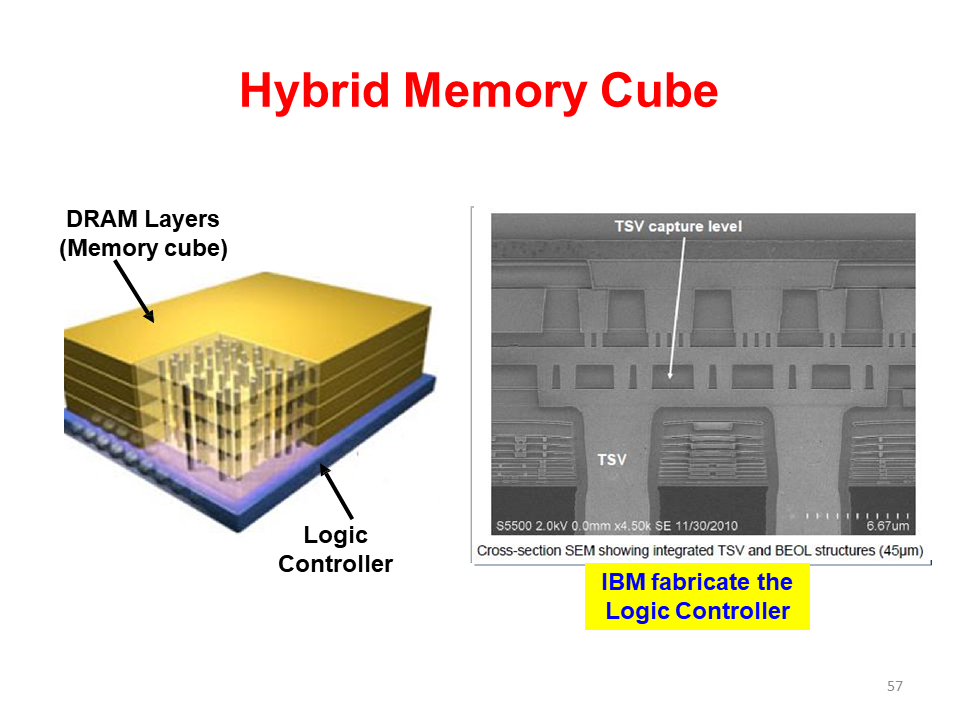

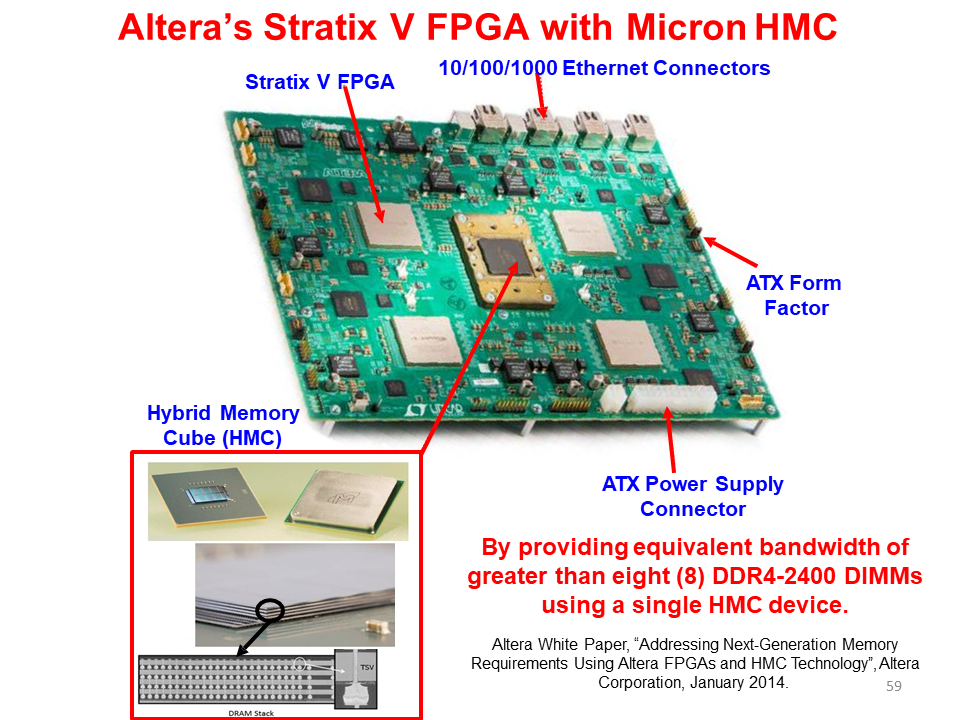
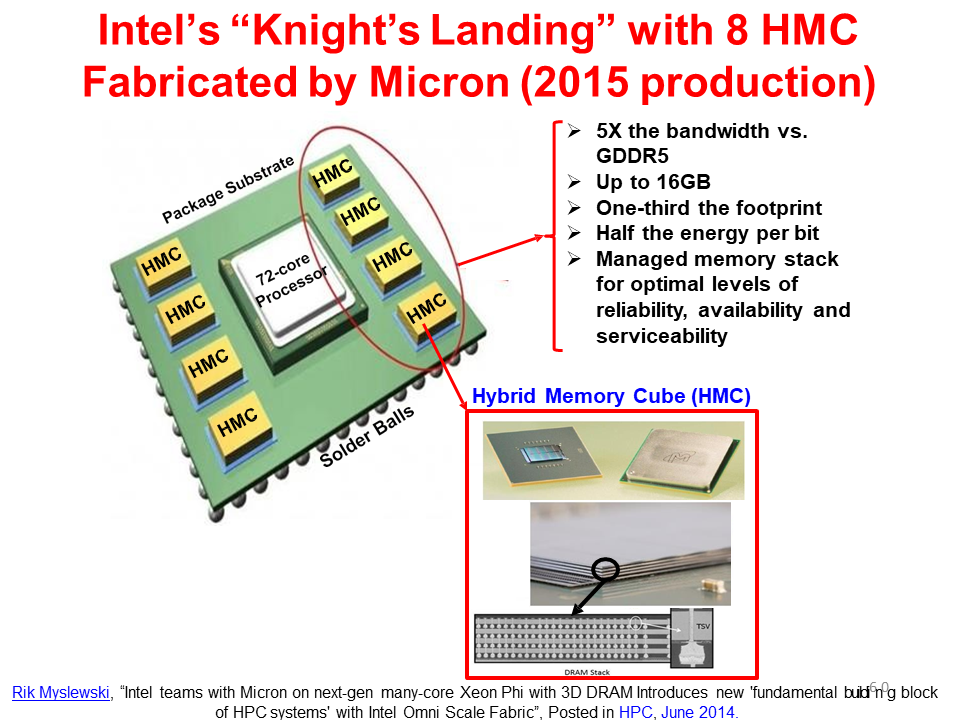
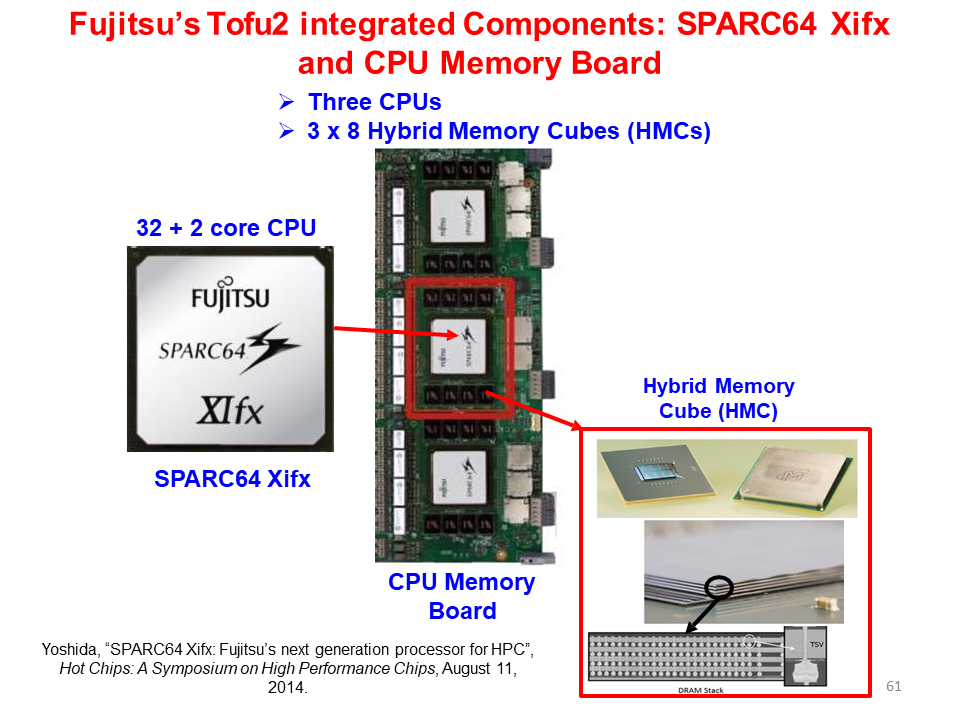

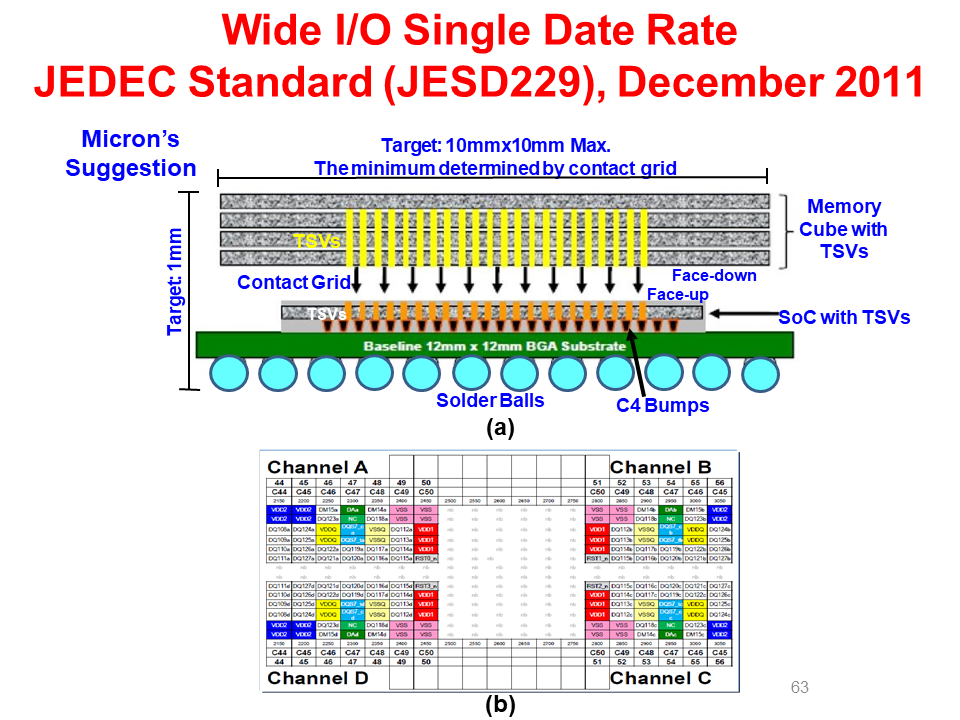



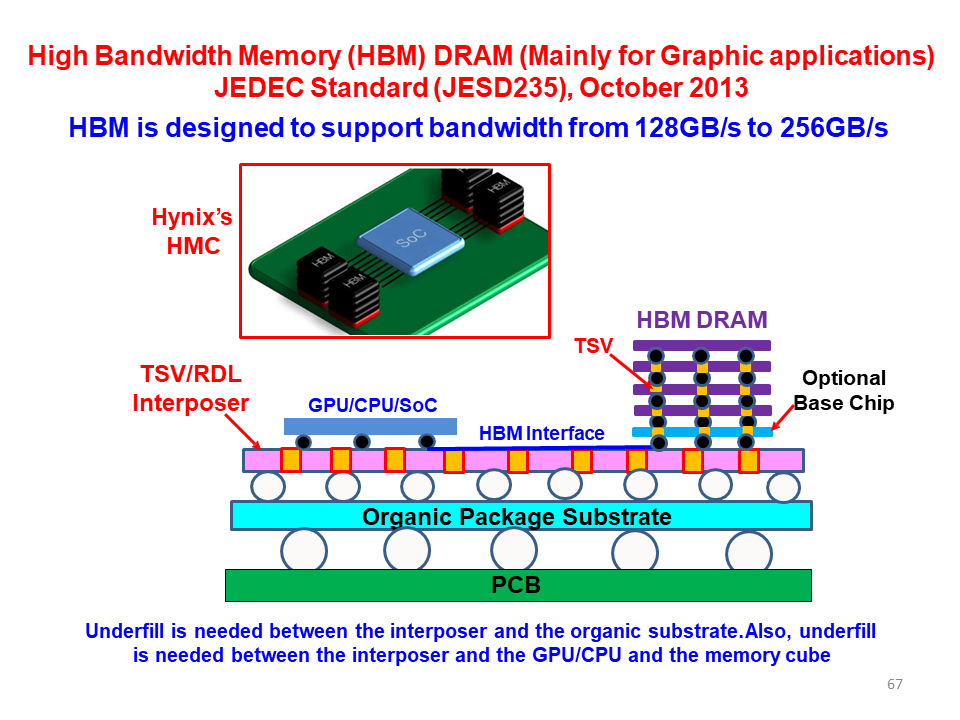


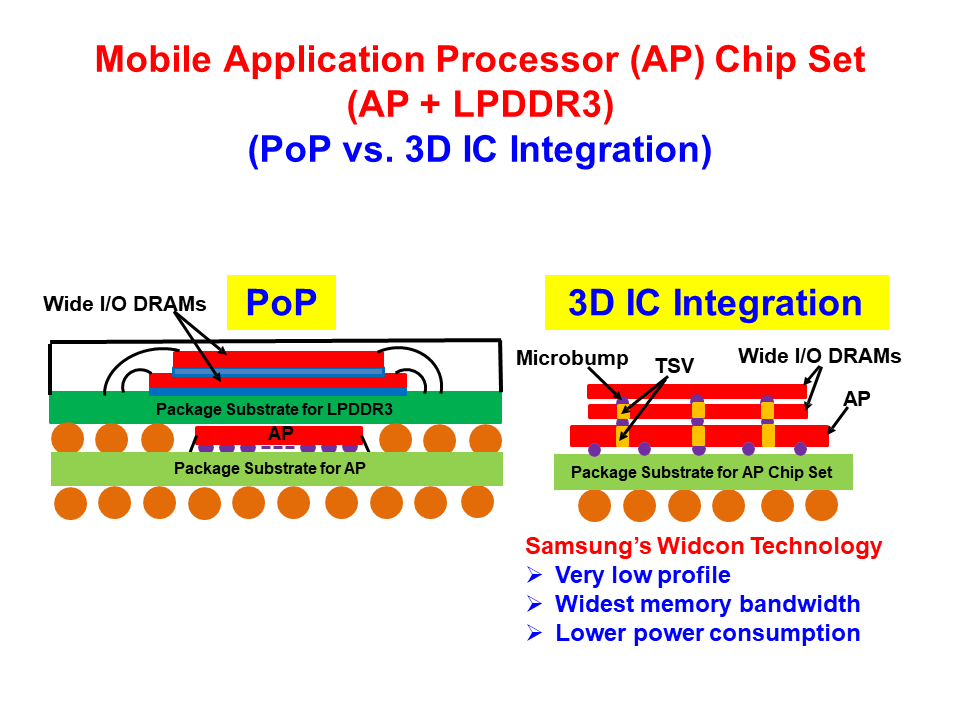



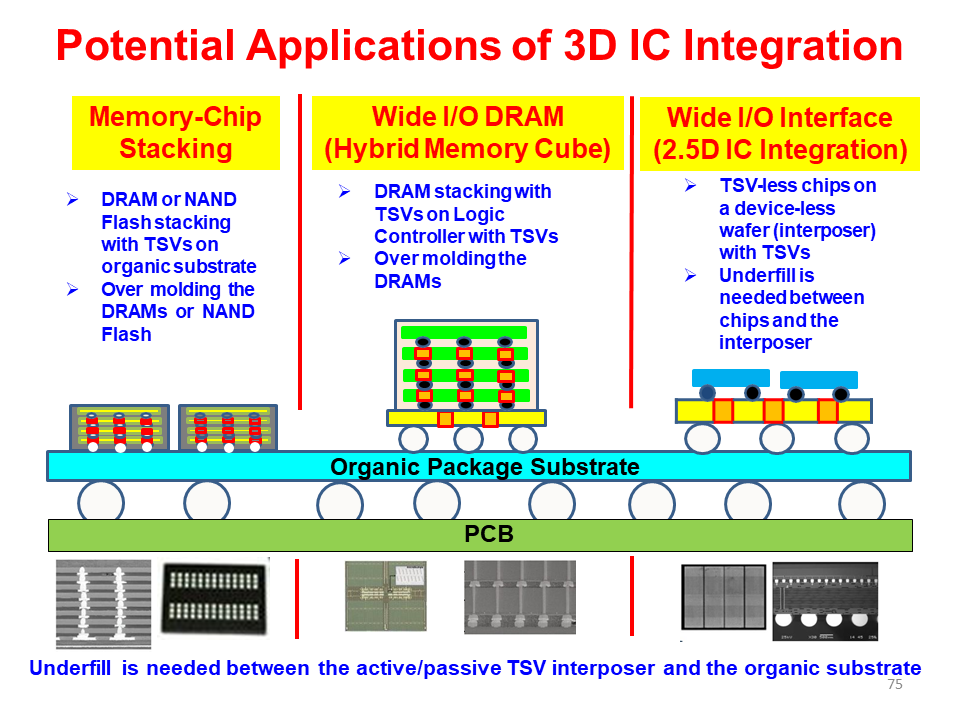
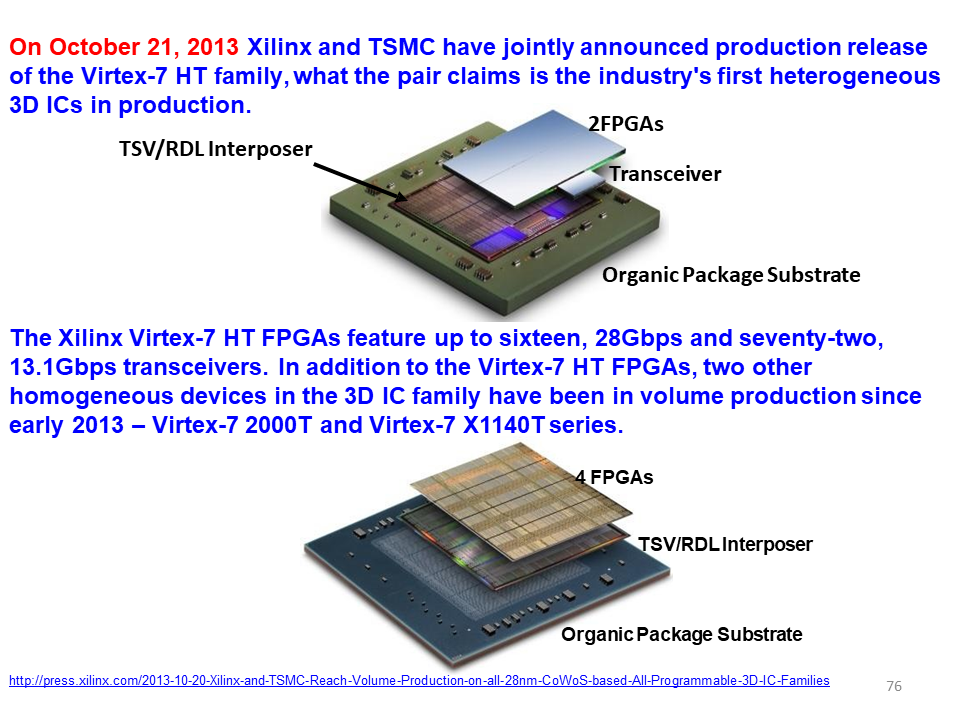
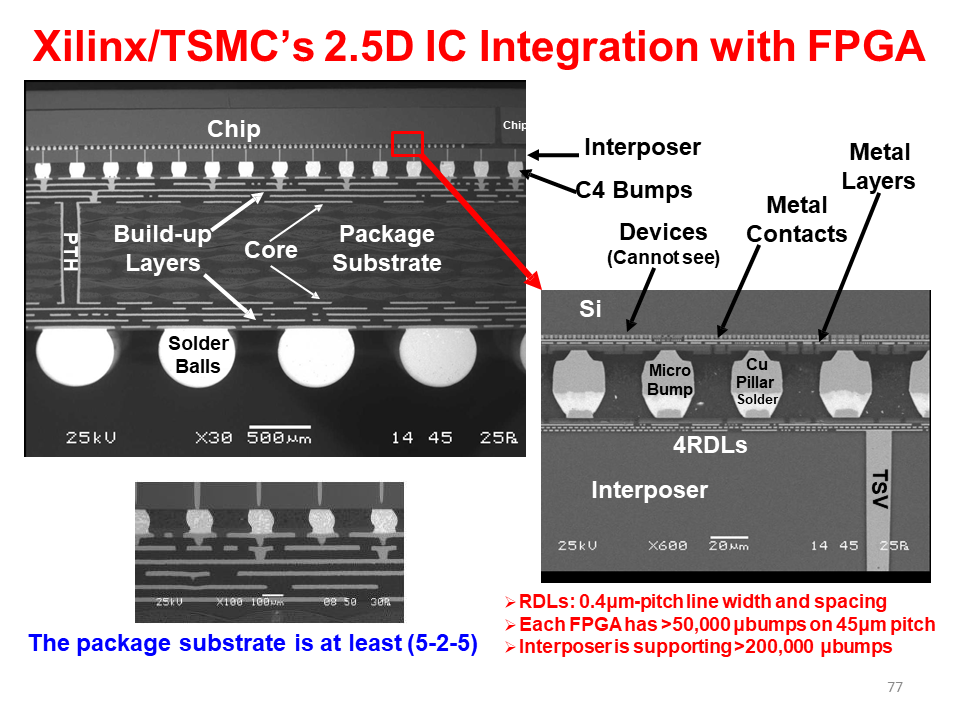
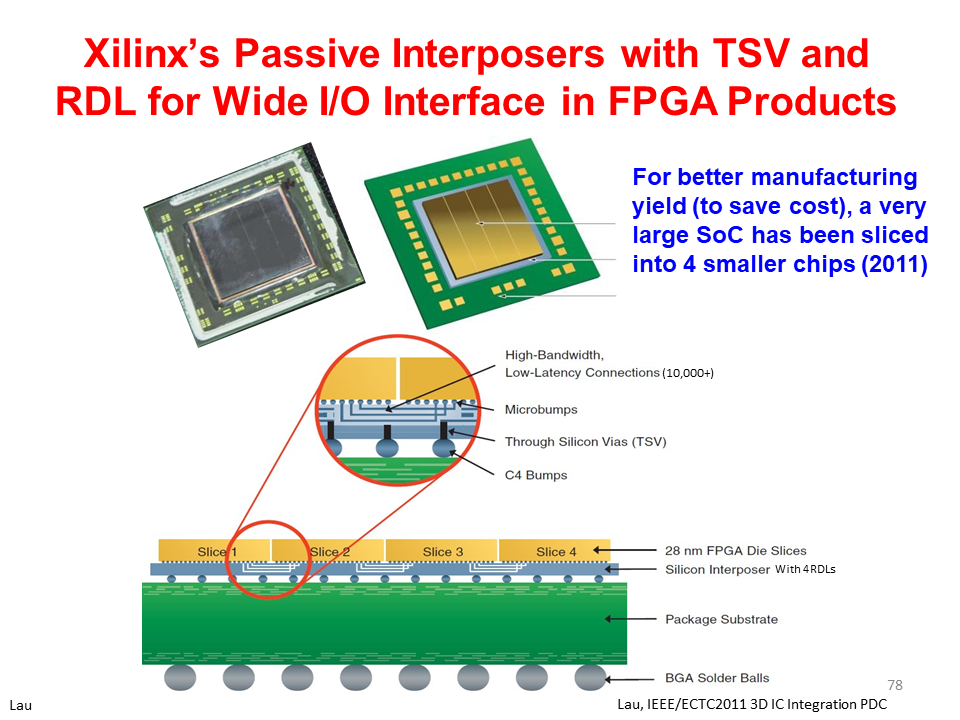
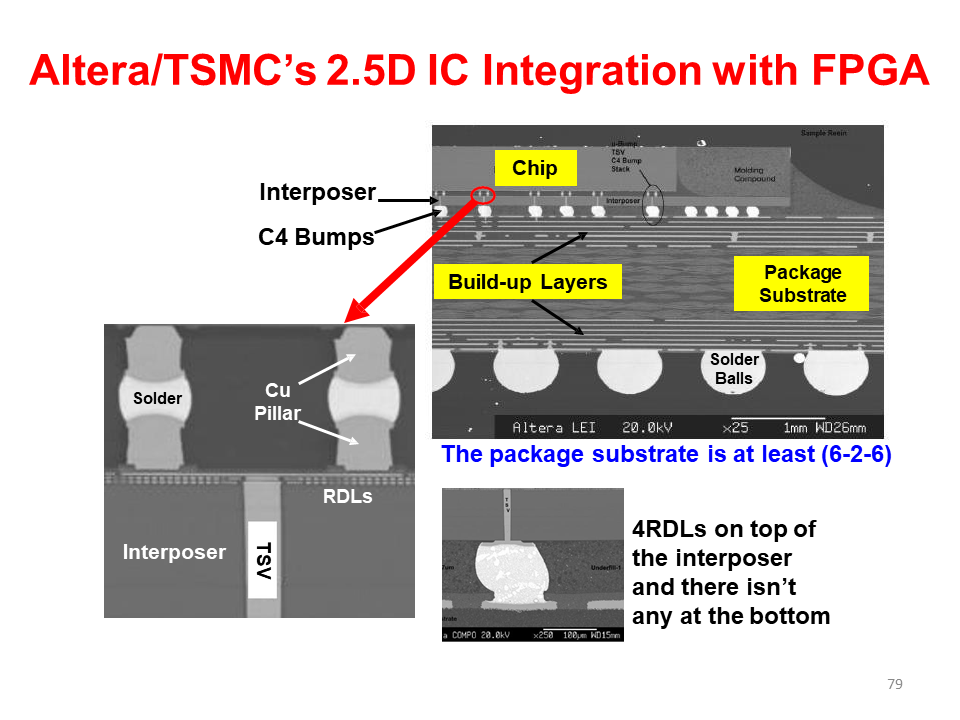
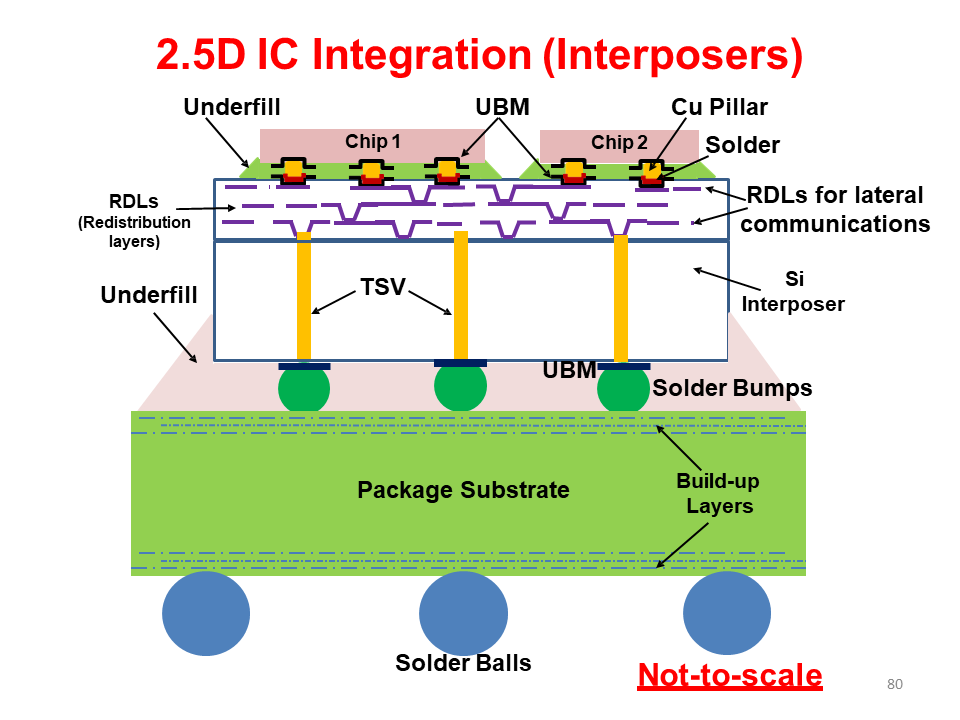










評論