電子發燒友網報道(文/黃山明)近日,華為密集公布了多項技術專利,其中引人注意的是華為再次公布了兩項與芯片堆疊有關的專利。為何說再次,因為就在一個月前,華為同樣公開了“一種芯片堆疊封裝及終端設備
2022-05-09 08:09:00 25559
25559 多芯片封裝在現代半導體領域至關重要,主要分為平面多芯片封裝和多芯片堆疊封裝。多芯片堆疊封裝又細分為多芯片3D堆疊引線鍵合封裝、3D堆疊引線鍵合和倒裝異質封裝、3DTSV堆疊倒裝封裝等。
2025-05-14 10:39:54 1847
1847 
使用直接晶圓到晶圓鍵合來垂直堆疊芯片,可以將信號延遲降到可忽略的水平,從而實現更小、更薄的封裝,同時有助于提高內存/處理器的速度并降低功耗。目前,晶圓堆疊和芯片到晶圓混合鍵合的實施競爭異常激烈,這被
2025-05-22 11:24:18 1405
1405 
元器件PIP(堆疊封裝)和PoP(堆疊組裝)的比較
1. PiP (Package In Package,堆疊封裝)
PiP一般稱堆疊封
2009-11-20 15:47:28 7563
7563 本文從關于固晶的挑戰、如何選用鍵合線材、瓷嘴與焊線參數等幾個方面向大家闡述在微小化的趨勢下關于LED小芯片封裝技術難點解析。
2016-03-17 14:29:33 5906
5906 獲得一顆IC芯片要經過從設計到制造漫長的流程,然而一顆芯片相當小且薄,如果不在外施加保護,會被輕易的刮傷損壞。此外,因為芯片的尺寸微小,如果不用一個較大尺寸的外殼,將不易以人工安置在電路板上。而這個時候封裝技術就派上用場了,本文接下來介紹了28種芯片封裝技術。
2016-07-28 17:10:03 51295
51295 也稱CPAC(globe top pad array carrier)。球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI 芯片,然后
2022-07-10 16:39:01 3838
3838 技術成為實現系統性能、帶寬和功耗等方面指標提升的重要備選方案之一。對目前已有的晶圓級多層堆疊技術及其封裝過程進行了詳細介紹; 并對封裝過程中的兩項關鍵工藝,硅通孔工藝和晶圓鍵合與解鍵合工藝進行了分析
2022-09-13 11:13:05 6190
6190 所謂芯片尺寸封裝就是CSP (Chip Size Package或Chip Scale Package)。JEDEC(美國EIA協會聯合電子器件工程委員會)的JSTK一012標準規定,LSI芯片封裝
2023-09-06 11:14:55 3022
3022 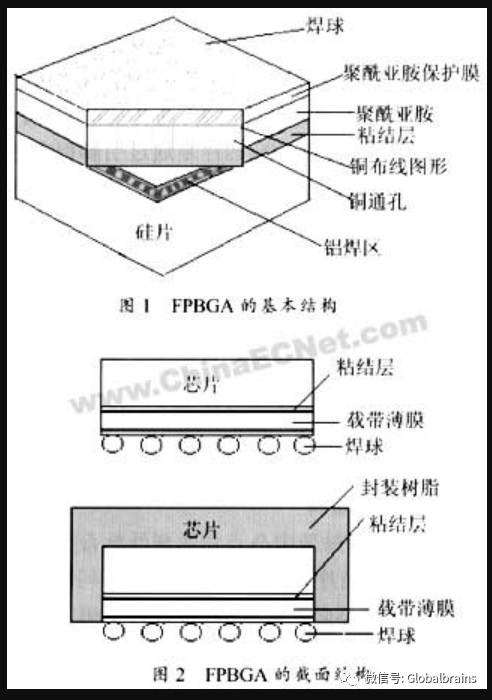
芯片封裝作為設計和制造電子產品開發過程中的關鍵技術之一日益受到半導體行業的關注和重視。
2024-02-22 17:24:51 6937
6937 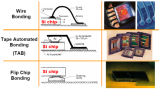
為適應異構集成技術的應用背景,封裝天線的實現技術也應有所變化,利用封裝工藝的優點以實現更佳的性能。
2024-02-29 11:11:30 2773
2773 
3D堆疊像素探測器芯片技術詳解
2024-11-01 11:08:07 4435
4435 
芯片堆疊封裝技術實用教程
2024-11-01 11:08:07 4273
4273 
。在同一個系統級封裝(SiP)結構里,可以同時存在多種內部互連方式。例如,引線鍵合與倒裝芯片相結合,能夠實現堆疊型封裝,其中包括基于中介層的內部互連和芯片間直接互連這兩種堆疊型封裝形式。
2025-08-05 15:09:04 2135
2135 
好的傳感器的設計是經驗加技術的結晶。一般理解傳感器是將一種物理量經過電路轉換成一種能以另外一種直觀的可表達的物理量的描述。而下文我們將對傳感器的概念、原理特性進行逐一介紹,進而解析傳感器的設計的要點。
2020-08-28 08:04:04
各個不同的IC 放在一起,再透過先前介紹的設計流程,制作成一張光罩。然而,SoC 并非只有優點,要設計一顆 SoC 需要相當多的技術配合。IC 芯片各自封裝時,各有封裝外部保護,且 IC 與 IC間
2017-09-04 14:01:51
標準封裝件,形成一個系統或者子系統。從架構上來講SiP是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內,從而實現一個基本完整的功能。與SOC(片上系統)相對應。不同的是系統級封裝是采用
2017-09-18 11:34:51
編者按:為了推進封裝天線技術在我國深入發展,微波射頻網去年特邀國家千人計劃專家張躍平教授撰寫了《封裝天線技術發展歷程回顧》一文。該文章在網站和微信公眾號發表后引起了廣泛傳播和關注,成為了點閱率最高
2019-07-16 07:12:40
芯片堆疊技術在SiP中應用的非常普遍,通過芯片堆疊可以有效降低SiP基板的面積,縮小封裝體積。 芯片堆疊的主要形式有四種: 金字塔型堆疊 懸臂型堆疊 并排型堆疊 硅通孔TSV型堆疊
2020-11-27 16:39:05
三級封裝的概念。并對發展我國新型微電子封裝技術提出了一些思索和建議。本文試圖綜述自二十世紀九十年代以來迅速發展的新型微電子封裝技術,包括焊球陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝
2023-12-11 01:02:56
統的一道橋梁,隨著微電子技術的飛速發展及其向各行業的迅速滲透,芯片封裝也在近二、三十年內獲得了巨大的發展,并已經取得了長足的進步。本文簡要介紹了近20年來計算機行業芯片封裝形成的演變及發展趨勢,從中可以
2018-11-23 16:59:52
DIP封裝(Dual In-line Package),也叫雙列直插式封裝技術,指采用雙列直插形式封裝的集成電路芯片,絕大多數中小規模集成電路均采用這種封裝形式,其引腳數一般不超過100。DIP封裝
2018-08-23 09:33:08
。 CPU封裝對于芯片來說是必須的,也是至關重要的。因為芯片必須與外界隔離,以防止空氣中的雜質對芯片電路的腐蝕而造成電氣性能下降。另一方面,封裝后的芯片也更便于安裝和運輸。由于封裝技術的好壞還直接影響到芯片
2018-08-29 10:20:46
為我們重點介紹了AI芯片在封裝、工藝、材料等領域的技術創新。
一、摩爾定律
摩爾定律是計算機科學和電子工程領域的一條經驗規律,指出集成電路上可容納的晶體管數量每18-24個月會增加一倍,同時芯片大小也
2025-09-15 14:50:58
隨著市場對芯片集成度要求的提高,I/O引腳數急劇增加,功耗也隨之增大,對集成電路封裝更加嚴格。為了滿足發展的需要,BGA封裝開始被應用于生產。BGA也叫球狀引腳柵格陣列封裝技術,它是一種高密度表面
2018-09-18 13:23:59
1、什么是堆疊設計也稱作系統設計,根據產品規劃,產品定義的要求,為實現一定的功能,設計出合理可靠的具備可量產性的PCB及其周邊元器件擺放的一種方案。2、堆疊工程師一般由結構工程師進行堆疊,有些公司
2021-11-12 08:17:17
1 引言 半導體技術的進步大大提高了芯片晶體管數量和功能,這一集成規模在幾年前是無法想象的。因此,如果沒有IC封裝技術快速的發展,不可能實現便攜式電子產品的設計。在消費類產品小型化和更輕、更薄
2018-08-27 15:45:31
元器件內芯片的堆疊大部分是采用金線鍵合的方式(Wire Bonding),堆疊層數可以從2~8層)。 STMICRO聲稱,誨今厚度到40μm的芯片可以從2個堆疊到8個(SRAM,Hash
2018-09-07 15:28:20
性能下降。另一方面,封裝后的芯片也更便于安裝和運輸。由于封裝技術的好壞還直接影響到芯片自身性能的發揮和與之連接的PCB(印制電路板)的設計和制造,因此它又是至關重要的。 目前業界普遍采用的封裝技術盡管
2018-08-28 16:02:11
嵌入式芯片封裝工藝,稱為SESUB(來源:TDK、Prismark)嵌入式芯片封裝并不是一項新技術,可由于工藝中存在各種各樣的挑戰,這項技術被歸為小眾應用,但前景光明。例如,TDK最近使用其專有的嵌入式
2019-02-27 10:15:25
封裝技術至關重要。衡量一個芯片封裝技術先進與否的重要指標是:芯片面積與封裝面積之比,這個比值越接近1越好。封裝時主要考慮的因素:芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1。引腳要盡量短以
2020-02-24 09:45:22
。如比較小的阻抗值、較強的抗干擾能力、較小的信號失真等等。芯片的封裝技術經歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM。技術指標和電器性能一代比一代先進。
2011-10-28 10:51:06
2種新型的芯片封裝技術介紹在計算機內存產品工藝中,內存的封裝技術是內存制造工藝中最關鍵一步,采用不同封裝技術的內存條,在性能上存在較大差距。只有高品質的封裝技術才能生產出完美的內存產品。本文就主要
2009-04-07 17:14:08
晶圓級芯片封裝技術是對整片晶圓進行封裝測試后再切割得到單個成品芯片的技術,封裝后的芯片尺寸與裸片一致。
2019-09-18 09:02:14
`華爾街日報發布文章稱,科技產品下一個重大突破將在芯片堆疊領域出現。Apple Watch采用了先進的的3D芯片堆疊封裝技術作為幾乎所有日常電子產品最基礎的一個組件,微芯片正出現一種很有意思的現象
2017-11-23 08:51:12
布局性能、三維晶粒堆疊結構生成與編輯性能。另外,完全的聯機設計規則檢查(DRC)可支持層壓、陶瓷、及鍍膜技術間各種組合的復雜和獨特要求。多層倒裝芯片與放射狀任意角襯底布線提供了快速的約束驅動互連創建
2018-06-06 19:43:43
和其他LSI集成電路都起著重要的作用。新一代CPU的出現常常伴隨著新的封裝形式的使用。芯片的封裝技術已經歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM,技術指標一代比一代先進
2018-09-03 09:28:18
大家好, 在Ultrascale FPGA中,使用單片和下一代堆疊硅互連(SSI)技術編寫。 “單片和下一代堆疊硅互連(SSI)技術”是什么意思?謝謝娜文G K.
2020-04-27 09:29:55
被稱之為“堆疊硅片互聯技術”的3D封裝方法采用無源芯片中介層、微凸塊和硅通孔 (TSV)技術,實現了多芯
2010-10-29 17:54:25 1168
1168 芯片堆疊封裝是提高存儲卡類產品存儲容量的主流技術之一,采用不同的芯片堆疊方案,可能會產生不同的堆疊效果。針對三種芯片堆疊的初始設計方案進行了分析,指出了堆疊方案失
2012-01-09 16:14:14 42
42 ,保護管芯正常工作。現給大家介紹40種封裝技術。 1、BGA封裝(ballgridarray) 球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI芯片,然后用模壓樹脂或灌封方法進行密
2017-10-20 11:48:19 30
30 一文解析PLC的應用,具體的跟隨小編一起來了解一下。
2018-07-19 11:21:56 6116
6116 
堆疊不是使用普通的線纜,而是有專用的堆疊線纜,將設備的主板直接連接,所以早期稱之為背板堆疊技術。既然是直接在主板上連接(專用的堆疊端口),這樣就像是將主板焊接在了一起似的,堆疊起來的設備在邏輯上算是一臺設備。由于堆疊不需要占用端口,有專用的堆疊端口,并且不浪費級聯個數,從而使得端口的數量成倍增加。
2018-09-23 11:08:00 27162
27162 在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 16:03:40 9951
9951 在近日舉行的英特爾“架構日”活動中,英特爾不僅展示了基于10納米的PC、數據中心和網絡系統,支持人工智能和加密加速功能的下一代“Sunny Cove”架構,還推出了業界首創的3D邏輯芯片封裝技術——Foveros。這一全新的3D封裝技術首次引入了3D堆疊的優勢,可實現在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 8854
8854 英特爾近日向業界推出了首款3D邏輯芯片封裝技術“Foveros”,據悉這是在原來的3D封裝技術第一次利用3D堆疊的優點在邏輯芯片上進行邏輯芯片堆疊。也是繼多芯片互連橋接2D封裝技術之后的又一個顛覆技術。
2018-12-14 16:16:45 3316
3316 近日,武漢新芯研發成功的三片晶圓堆疊技術備受關注。有人說,該技術在國際上都處于先進水平,還有人說能夠“延續”摩爾定律。既然3D芯片堆疊技術有如此大的作用,那今天芯師爺就跟大家一起揭開它的面紗。
2018-12-31 09:14:00 34067
34067 對全新芯片堆疊技術的全面支持確保實現最高性能的3D-IC解決方案
2019-05-18 11:28:01 4231
4231 PoP,譯為“堆疊封裝”,主要特征是在芯片上安裝芯片。目前見到的安裝結構主要為兩類,即“球——焊盤”和“球——球”結構。一般PoP為兩層,通常頂層封裝是小中心距的球柵陣列(FBGA)存儲器,而底層封裝是包含某種類型的邏輯器件或ASIC處理器。
2019-10-15 11:10:57 6478
6478 困于10nm的Intel也在這方面尋找新的機會,其在去年年底的“架構日”活動中,推出其業界首創的3D邏輯芯片封裝技術——Foveros,Foveros首次引入3D堆疊的優勢,可實現在邏輯芯片上堆疊
2020-01-28 16:10:00 4118
4118 SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內系統集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強調封裝內包含了某種系統的功能封裝,3D封裝僅強調在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 7076
7076 在Intel、臺積電各自推出自家的3D芯片封裝技術之后,三星也宣布新一代3D芯片技術——X-Cube,基于TSV硅穿孔技術,可以將不同芯片搭積木一樣堆疊起來,目前已經可以用于7nm及5nm工藝。
2020-10-10 15:22:58 2004
2004 在許多集成度高的電路板上用了很多芯片,每種芯片可能使用的封裝都是不一樣的。
2020-10-29 15:42:42 6998
6998 為應對摩爾定律的放緩,全球最大的芯片生產巨頭臺積電正在與谷歌等美國科技企業合作,以開發一種新的半導體封裝技術。新的架構通過將不同類型的芯片堆疊,能夠使得芯片組變得小而強大。 芯片封裝是半導體生產制造
2020-11-25 18:33:16 2242
2242 自今年4月5日華為公布芯片堆疊專利后,而過了一個月,5月6日,華為又公開了一項名為“芯片堆疊封裝結構及其封裝方法、電子設備”的專利,申請公布號為CN114450786A。 據國家知識產權局官網顯示
2022-05-07 15:59:43 101144
101144 電子發燒友網報道(文/黃山明)近日,華為密集公布了多項技術專利,其中引人注意的是華為再次公布了兩項與芯片堆疊有關的專利。為何說再次,因為就在一個月前,華為同樣公開了“一種芯片堆疊封裝及終端設備”的專利。多項與芯片堆疊相關專利的公開,或許也揭露了華為未來在芯片技術上的一個發展方向。
2022-05-09 09:50:20 6384
6384 堆疊技術也可以叫做3D堆疊技術,是利用堆疊技術或通過互連和其他微加工技術在芯片或結構的Z軸方向上形成三維集成,信號連接以及晶圓級,芯片級和硅蓋封裝具有不同的功能,針對包裝和可靠性技術的三維堆疊處理技術。
2022-05-10 15:58:13 4946
4946 
在芯片成品制造環節中,市場對于傳統打線封裝的依賴仍居高不下。市場對于使用多芯片堆疊技術、來實現同尺寸器件中的高存儲密度的需求也日益增長。這類需求給半導體封裝工藝帶來的不僅僅是工藝能力上的挑戰,也對工藝的管控能力提出了更高的要求。
2022-08-07 11:43:22 5100
5100 “芯片堆疊”技術近段時間經常聽到,在前段時間蘋果舉行線上發布會時,推出了號稱“史上最強”的Apple M1 ultra,這就是一種采用堆疊思路設計的芯片。
2022-08-11 15:39:02 10366
10366 
電學:硅光芯片和兩個淺藍色的模擬電芯片的電信號連接內容,需要3D堆疊封裝,與高頻信號損耗有關。
2022-09-01 10:44:54 7090
7090 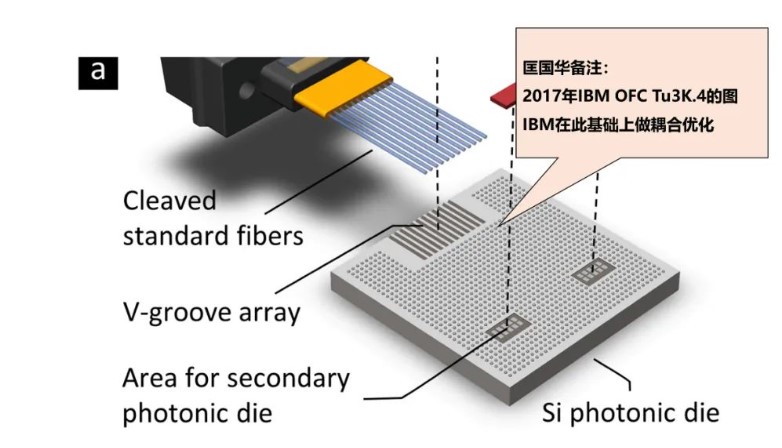
5D 封裝和 3D 封裝是兩種常用的晶圓級多層堆疊技術。2. 5D 封裝是將芯片封裝到 Si 中介層上,并利用 Si 中介層上的高密度走線進行互連。
2022-09-22 09:23:03 2050
2050 堆疊 PowerStack 封裝電流獲得更高功率 POL
2022-11-02 08:16:09 0
0 一文詳解精密封裝技術
2022-12-30 15:41:12 2358
2358 為什么芯片可以進行堆疊呢?這里面我們講的主要是未經過封裝的裸芯片。曾經有用戶問我,封裝好的芯片可不可以進行堆疊呢?一般來說是不可以的,因為封裝好的芯片引腳在下表面直接焊接到基板上,而裸芯片的引腳一般在芯片上表面,通過鍵合的方式連接到基板。
2023-02-11 09:44:18 2847
2847 熱點新聞 1、華為已經開發出“芯片堆疊技術”?華為回應:該消息為謠言 近日,網絡上流傳的一份通知稱,華為宣布,已經成功開發出芯片堆疊技術方案。另外,還有傳言稱華為的芯片堆疊方案,可以在 14nm
2023-03-16 13:35:02 4389
4389 Infineon芯片是一種多集成的無線基帶SoC芯片。功能(GPS、調頻收音機、BT.)同樣的eWLB產品也有自2010年以來,諾基亞一直在生產手機。
2023-03-30 12:57:26 2211
2211 芯片合封是指將多個半導體芯片集成在一起,形成一個更大的芯片,以滿足更高的功率、更高的效率和更高的可靠性等應用需求。芯片合封技術包括芯片堆疊、芯片封裝等多種方式。 芯片堆疊技術可以分為多種類型,包括
2023-04-12 10:14:25 2029
2029 全球化的先進制程中分一杯羹,手機、HPC等需要先進制程的芯片供應受到嚴重阻礙,亟需另辟蹊徑。而先進封裝/Chiplet等技術,能夠一定程度彌補先進制程的缺失,用面積和堆疊換取算力和性能。
2023-04-15 09:48:56 4395
4395 多芯片封裝技術是一種將多個芯片封裝在同一個封裝體內的集成封裝技術。在傳統的單芯片封裝中,一個封裝體內只封裝一個芯片,而多芯片封裝技術將多個芯片封裝在一個封裝體中,實現了不同功能芯片的集成和協同工作。
2023-05-24 16:22:31 4884
4884 Chiplet技術是一種利用先進封裝方法將不同工藝/功能的芯片進行異質集成的技術。這種技術設計的核心思想是先分后合,即先將單芯片中的功能塊拆分出來,再通過先進封裝模塊將其集成為大的單芯片。
2023-07-17 09:21:50 7024
7024 
芯片技術領域的應用概要,用于簡化芯片堆疊結構及其形成方法、芯片封裝結構、電子設備、芯片堆棧結構的制造技術。該芯片的堆疊結構至少包括兩個堆疊的芯片,每一個芯片包括電線層,電線層設有電具組。
2023-08-09 10:13:42 2753
2753 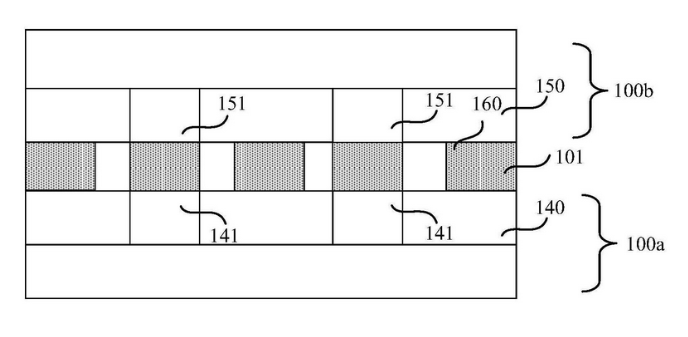
PoP一般稱堆疊組裝,又稱封裝上的封裝,還稱元件堆疊裝配。在底部元器件上面再放置元器件,邏輯+存 儲通常為2~4層,存儲型PoP可達8層
2023-09-27 15:26:43 5660
5660 
不同的連接技術把它們拼裝在一起,以實現更高效和更高性能的芯片設計。本文將會詳盡、詳實、細致地介紹Chiplet主流的封裝技術。 1. 面向異構集成的2.5D/3D技術 2.5D/3D技術是Chiplet主流封裝技術中最為流行和成熟的一種,通過把不同的芯片堆疊在一起,可以將它
2023-09-28 16:41:00 2931
2931 如何對系統和組件進行可靠的封裝是微系統工業面臨的主要挑戰,因為微系統的封裝技術遠沒有微電子封裝技術成熟。微系統封裝在廣義上講有三個主要的任務:裝配、封裝和測試,縮寫為AP&T. AP&T在整個生產成本中占有很大的比例。
2023-11-06 11:38:40 2848
2848 
交換機為什么要堆疊?有哪些設備可以堆疊?如何建立堆疊? 交換機的堆疊是一種將多個交換機連接在一起管理和操作的技術。通過堆疊,管理員可以將一組交換機視為一個虛擬交換機來進行集中管理和配置,提供靈活性
2023-11-09 09:24:35 3435
3435 HBM技術是一種基于3D堆疊工藝的高性能DRAM,它可以為高性能計算、人工智能、數據中心等領域提供高帶寬、高容量、低延遲和低功耗的存儲解決方案。本文將介紹HBM技術的原理、優勢、應用和發展趨勢。
2023-11-09 12:32:52 20015
20015 本文將幫助您更好地理解合封芯片、芯片合封和SiP系統級封裝這三種不同的技術。合封芯片是一種將多個芯片或不同功能的電子模塊封裝在一起的定制化芯片,以實現更復雜、更高效的任務。合封芯片可定制組成方式包括CoC封裝技術、SiP封裝技術等。
2023-11-23 16:03:42 2543
2543 CoWoS(Chip-on-Wafer-on-Substrate)是一種先進的半導體封裝技術,它結合了芯片堆疊與基板連接的優勢,實現了高度集成、高性能和低功耗的封裝解決方案。以下是對CoWoS封裝技術的詳細解析,包括其定義、工作原理、技術特點、應用領域以及未來發展趨勢等方面。
2024-08-08 11:40:58 9537
9537 倒裝芯片是微電子電路先進封裝的關鍵技術。它允許將裸芯片以面朝下的配置連接到封裝基板上,芯片和基板之間通過導電“凸起”進行電氣連接。
2024-10-18 15:17:19 2220
2220 
DDR作為一種內存技術正朝著更高性能、更低功耗的方向發展。應用前景廣闊,將對半導體、計算機、汽車、新能源及各行業發展產生影響巨大。
2024-11-05 10:56:52 2256
2256 
隨著半導體技術的飛速發展,芯片的性能需求不斷提升,傳統的二維封裝技術已難以滿足日益增長的數據處理速度和功耗控制要求。在此背景下,混合鍵合(Hybrid Bonding)技術應運而生,并迅速成為三維
2024-11-13 13:01:32 3341
3341 
多芯片封裝(Multi-Chip Packaging, MCP)技術通過在一個封裝中集成多個芯片或功能單元,實現了空間的優化和功能的協同,大幅提升了器件的性能、帶寬及能源效率,成為未來高性能計算
2024-12-30 10:36:47 1924
1924 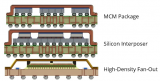
TSV 三維封裝技術特點鮮明、性能好、前景廣闊, 是未來發展方向,但是 TSV 堆疊芯片這種結構和工 藝復雜性的提高,為三維封裝的可靠性控制帶來了 挑戰。主要體現在以下 4 個方面 :(1) TSV
2024-12-30 17:37:06 2629
2629 在半導體行業的快速發展歷程中,芯片封裝技術始終扮演著至關重要的角色。隨著集成電路設計復雜度的不斷提升和終端應用對性能、功耗、尺寸等多方面要求的日益嚴苛,傳統的2D封裝技術已經難以滿足市場的需求。在此背景下,芯片3D堆疊封裝技術應運而生,成為半導體技術發展的新里程碑。
2025-02-11 10:53:45 2819
2819 
隨著半導體技術的飛速發展,芯片集成度和性能要求日益提升。傳統的二維封裝技術已經難以滿足現代電子產品的需求,因此,高密度3-D封裝技術應運而生。3-D封裝技術通過垂直堆疊多個芯片或芯片層,實現前所未有的集成密度和性能提升,成為半導體封裝領域的重要發展方向。
2025-02-13 11:34:38 1614
1614 
電子發燒友網站提供《一文解析工業互聯網.pptx》資料免費下載
2025-02-20 16:42:51 1
1 多芯片堆疊技術的出現,順應了器件朝著小型化、集成化方向發展的趨勢。該技術與先進封裝領域中的系統級封裝(SIP)存在一定差異。
2025-04-12 14:22:05 2567
2567 
引發行業高度關注,為其在芯片領域的持續創新注入強大動力。 堆疊封裝,創新架構 華為公布的 “一種芯片堆疊封裝及終端設備” 專利顯示,其芯片堆疊封裝技術通過將多個芯片或芯粒(Chiplet)以堆疊方式成在同一封裝體內,實
2025-06-19 11:28:07 1256
1256 裂,芯片本身無法直接與印刷電路板(PCB)形成電互連。封裝技術通過使用合適的材料和工藝,對芯片進行保護,同時調整芯片焊盤的密度,使其與PCB焊盤密度相匹配,從而實
2025-06-26 11:55:18 786
786 
以下完整內容發表在「SysPro電力電子技術」知識星球-《功率GaN芯片PCB嵌埋封裝技術全維解析》三部曲系列-文字原創,素材來源:TMC現場記錄、Horse、Hofer、Vitesco-本篇為節選
2025-08-07 06:53:44 1554
1554 
HBM通過使用3D堆疊技術,將多個DRAM(動態隨機存取存儲器)芯片堆疊在一起,并通過硅通孔(TSV,Through-Silicon Via)進行連接,從而實現高帶寬和低功耗的特點。HBM的應用中,CowoS(Chip on Wafer on Substrate)封裝技術是其中一個關鍵的實現手段。
2025-09-22 10:47:47 1618
1618 大家好久不見!今天我們來聊聊堆疊封裝。隨著信息數據大爆發時代的來臨,市場對于存儲器的需求也水漲船高,同時對于使用多芯片的堆疊技術來實現同尺寸器件中的高存儲密度的需求也日益增長。那么,什么是堆疊封裝呢
2025-10-27 16:40:34 428
428 
在當今電子設備追求輕薄短小的趨勢下,芯片封裝技術的重要性日益凸顯。作為兩種主流的封裝方式,LGA和BGA各有特點,而新興的激光錫球焊接技術正在為封裝工藝帶來革命性的變化。本文將深入解析LGA與BGA的區別,并探討激光錫球焊接技術如何提升芯片封裝的效率與質量。
2025-11-19 09:22:22 1308
1308 


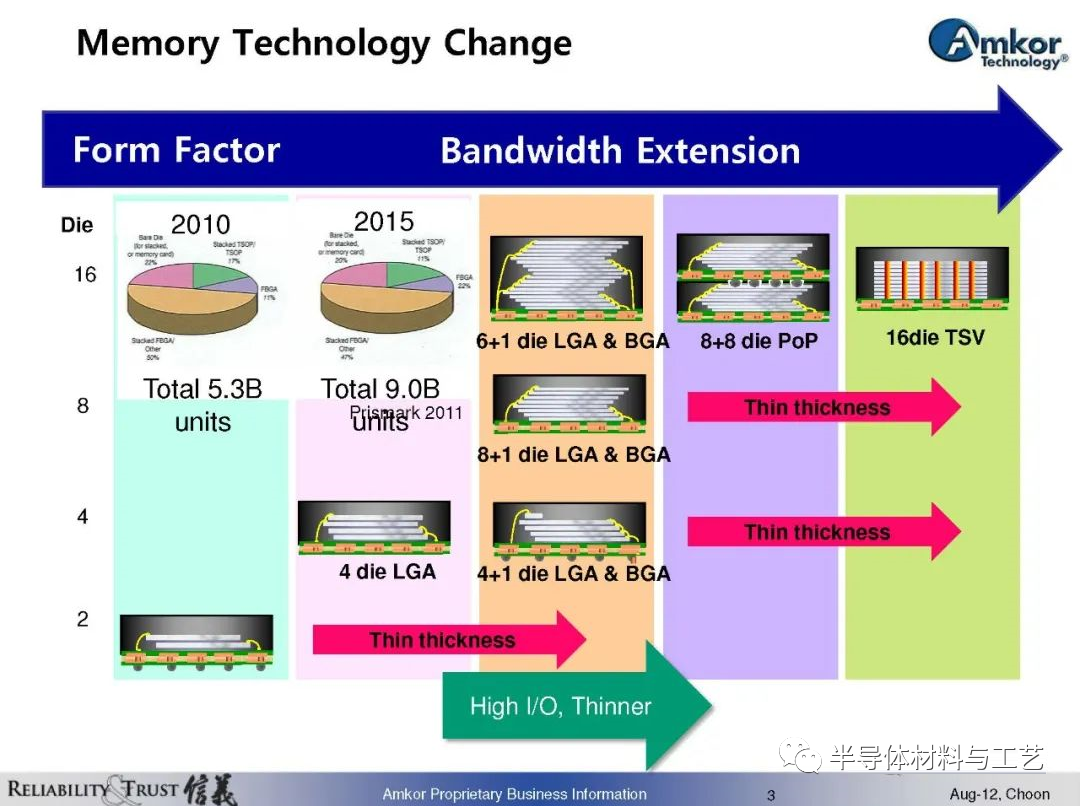
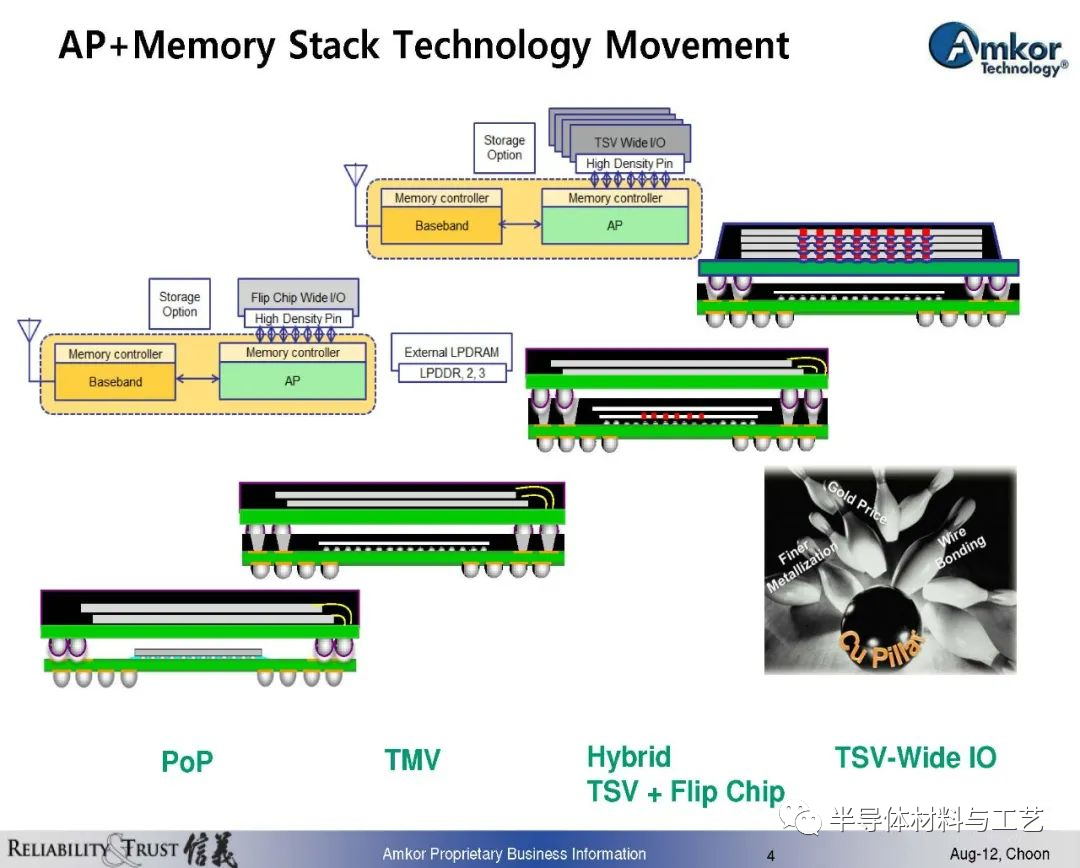
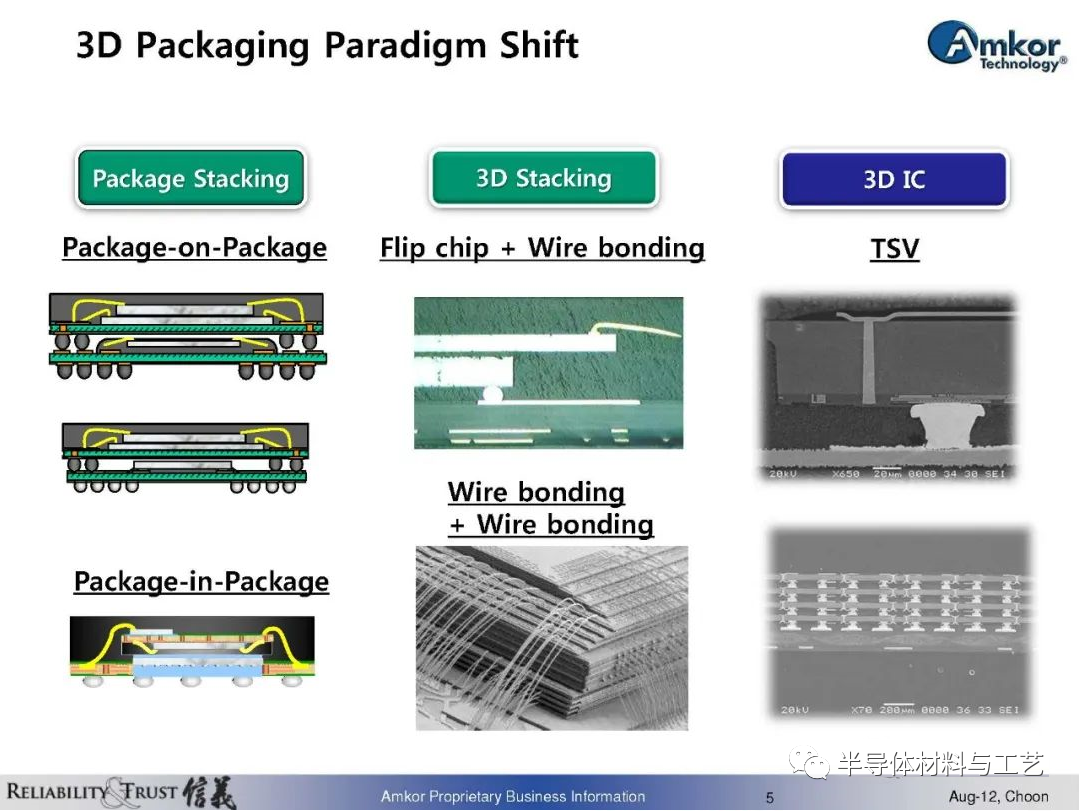
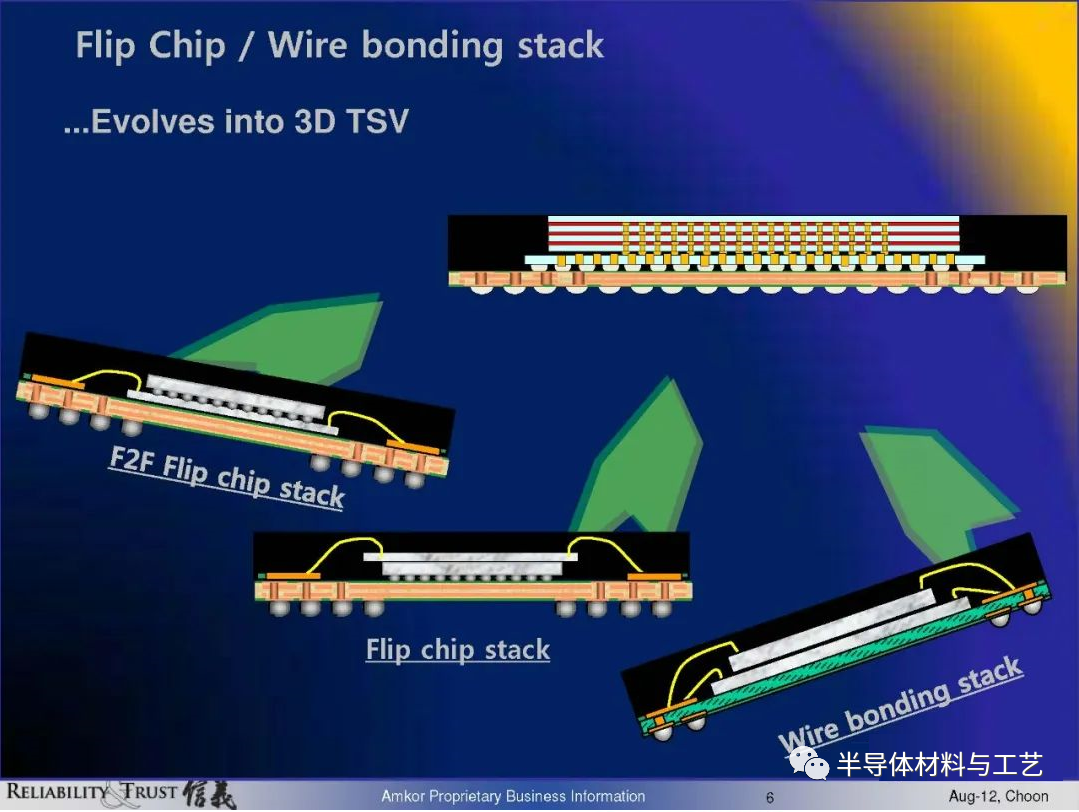
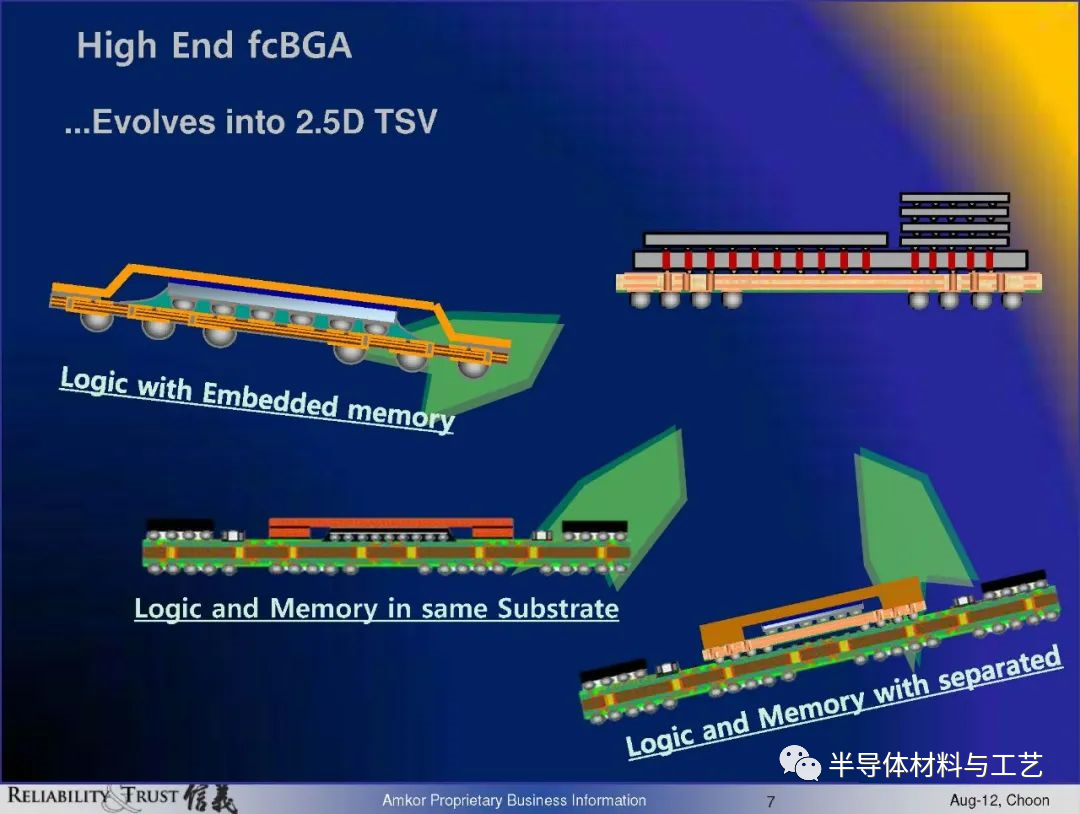
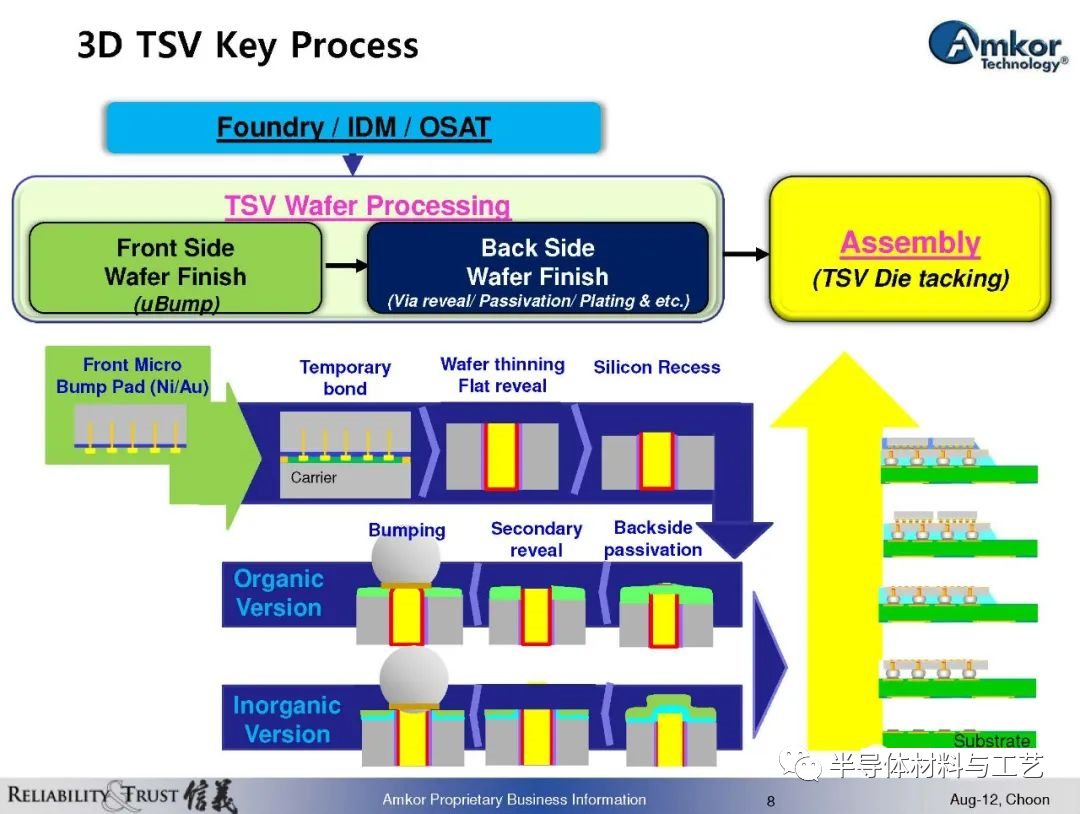
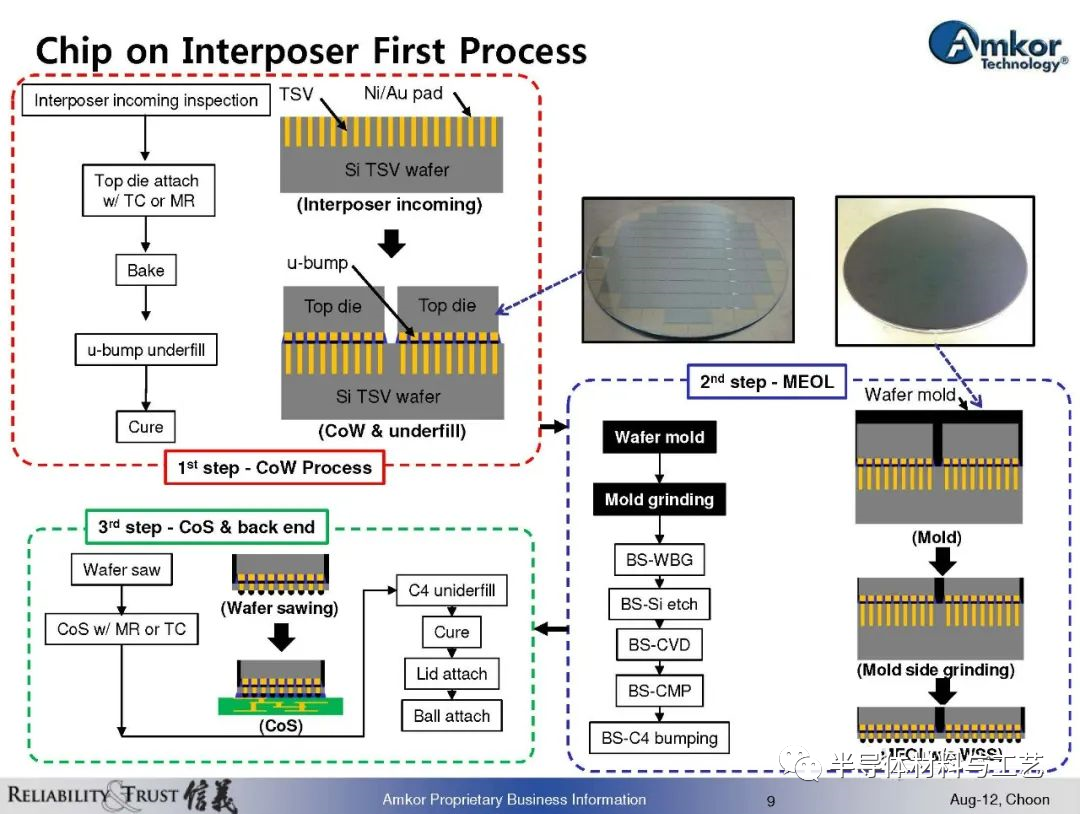
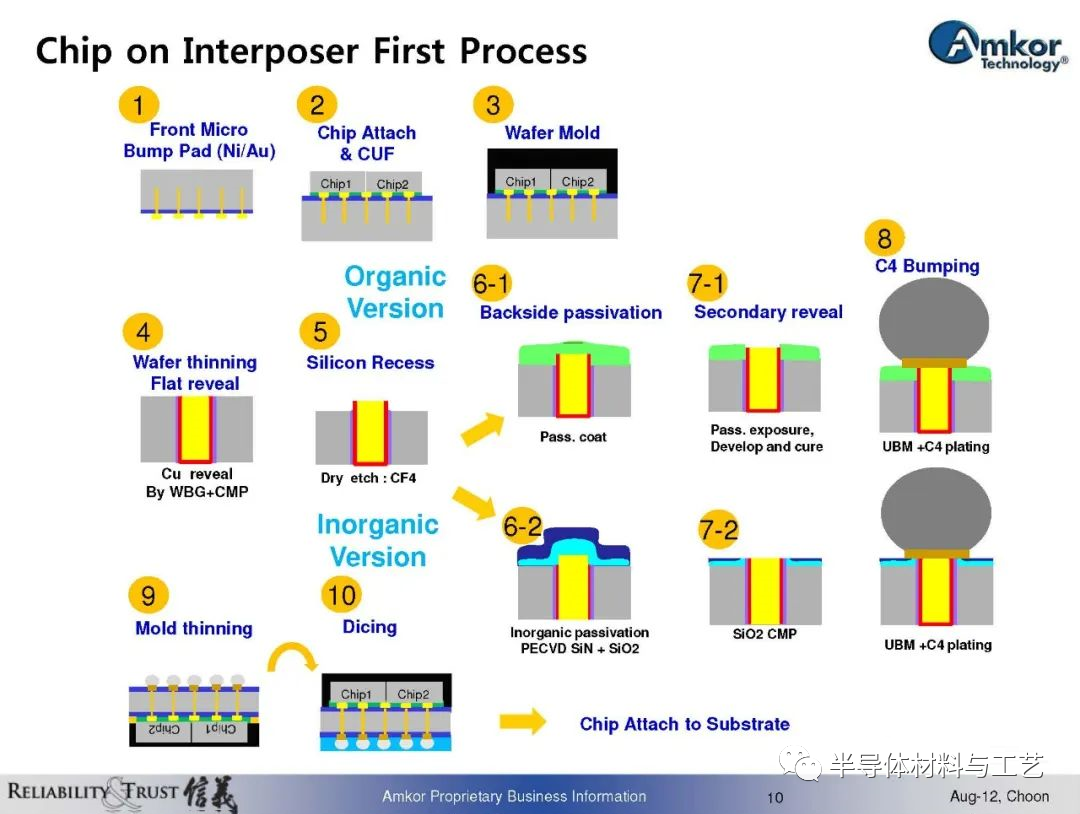

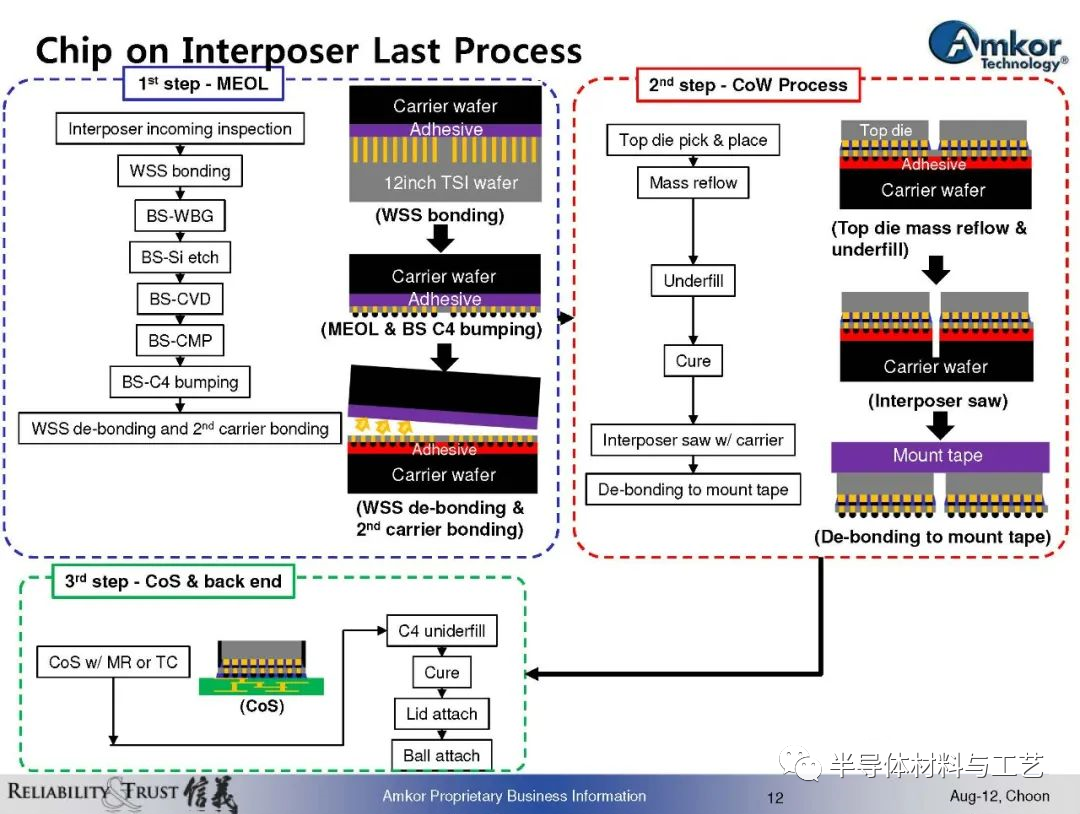



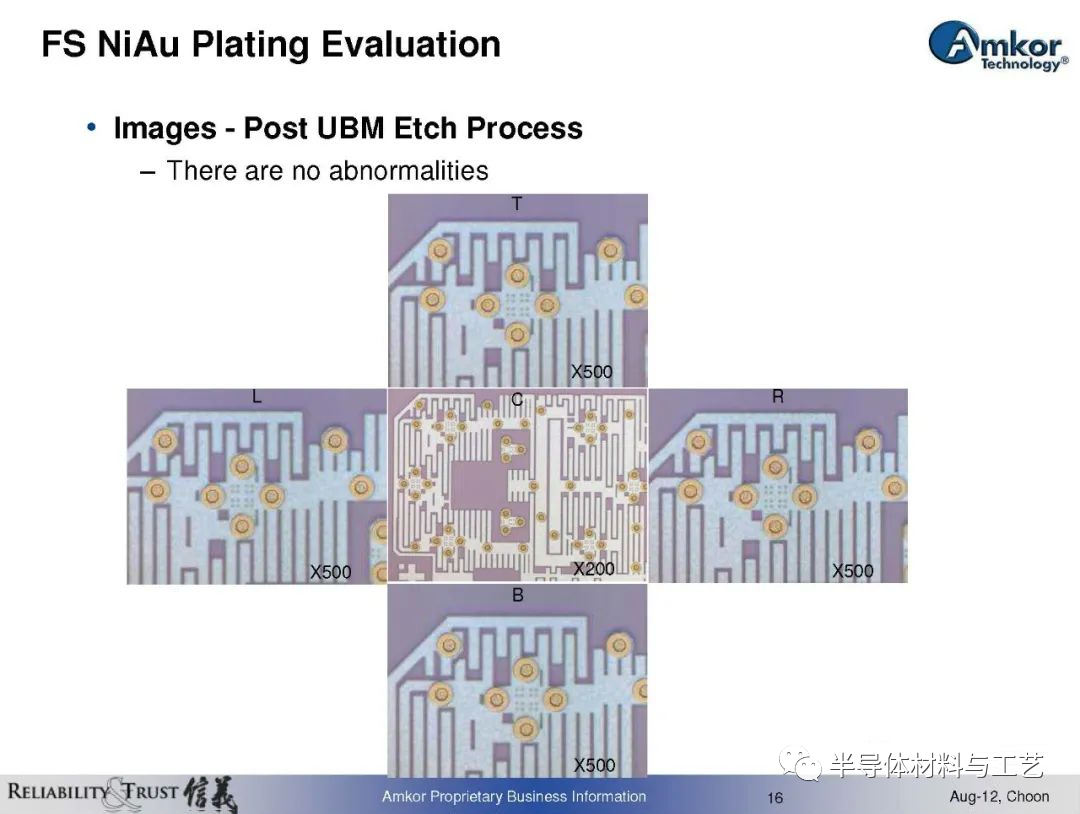



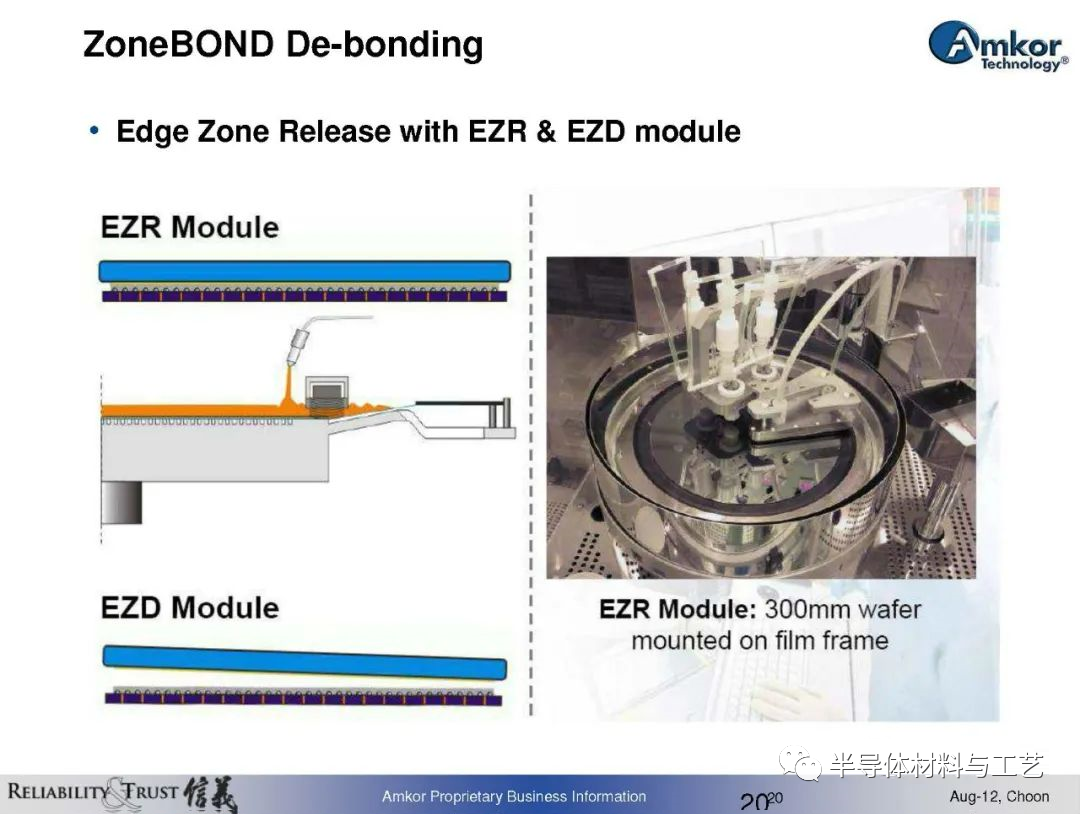


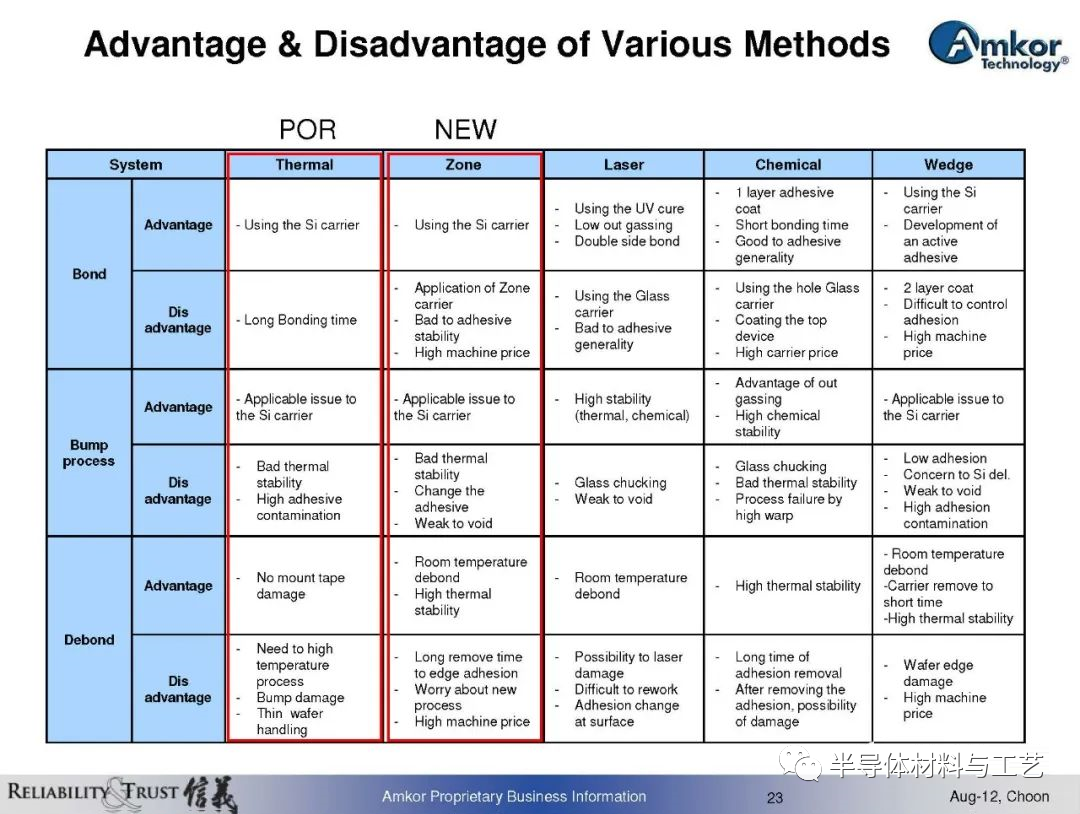


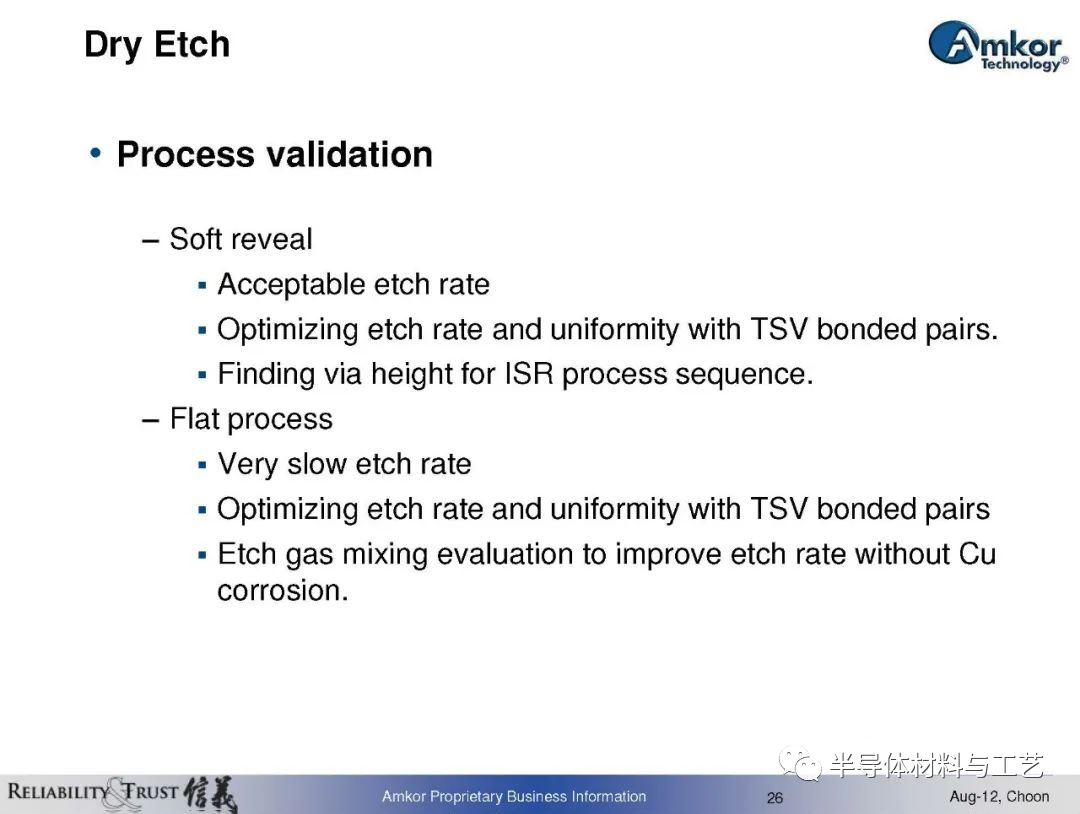
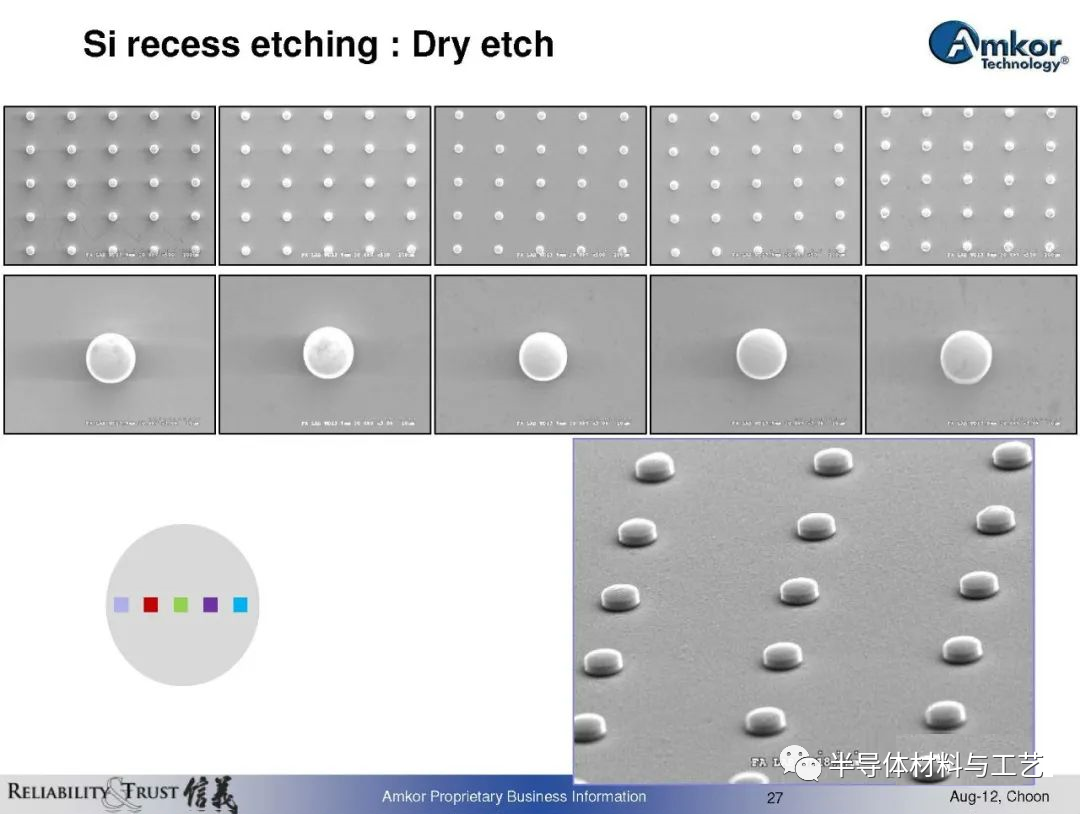
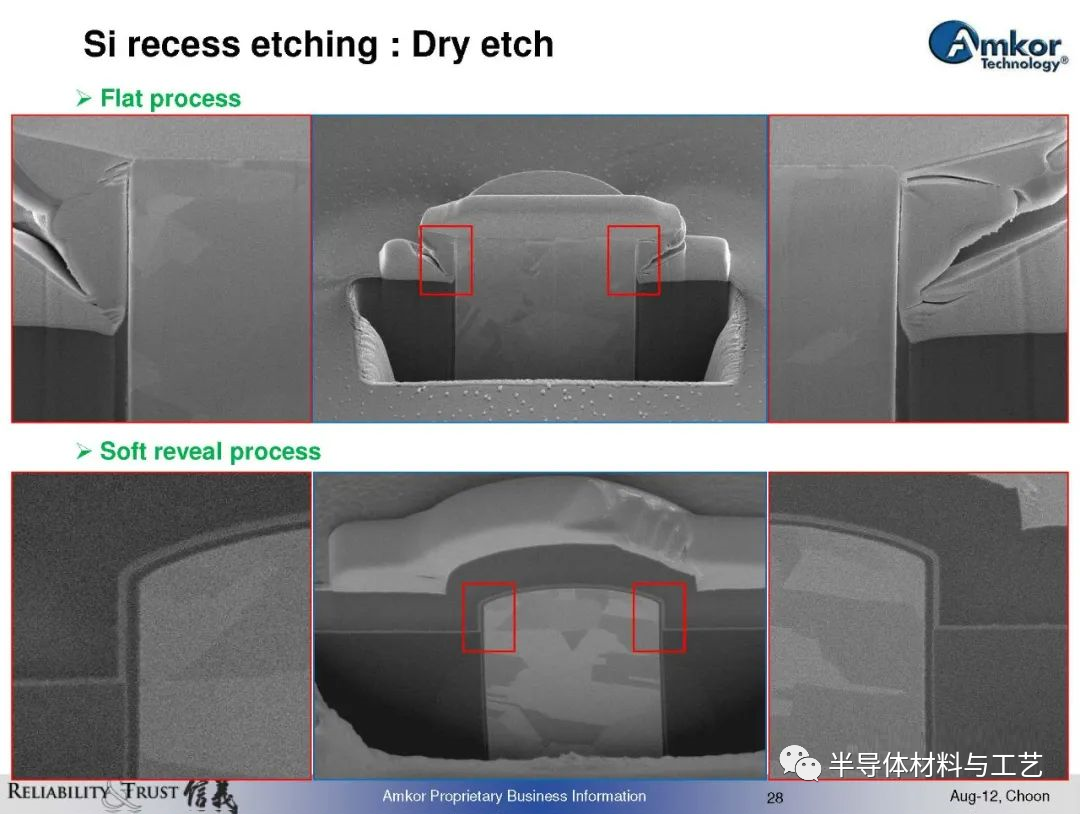


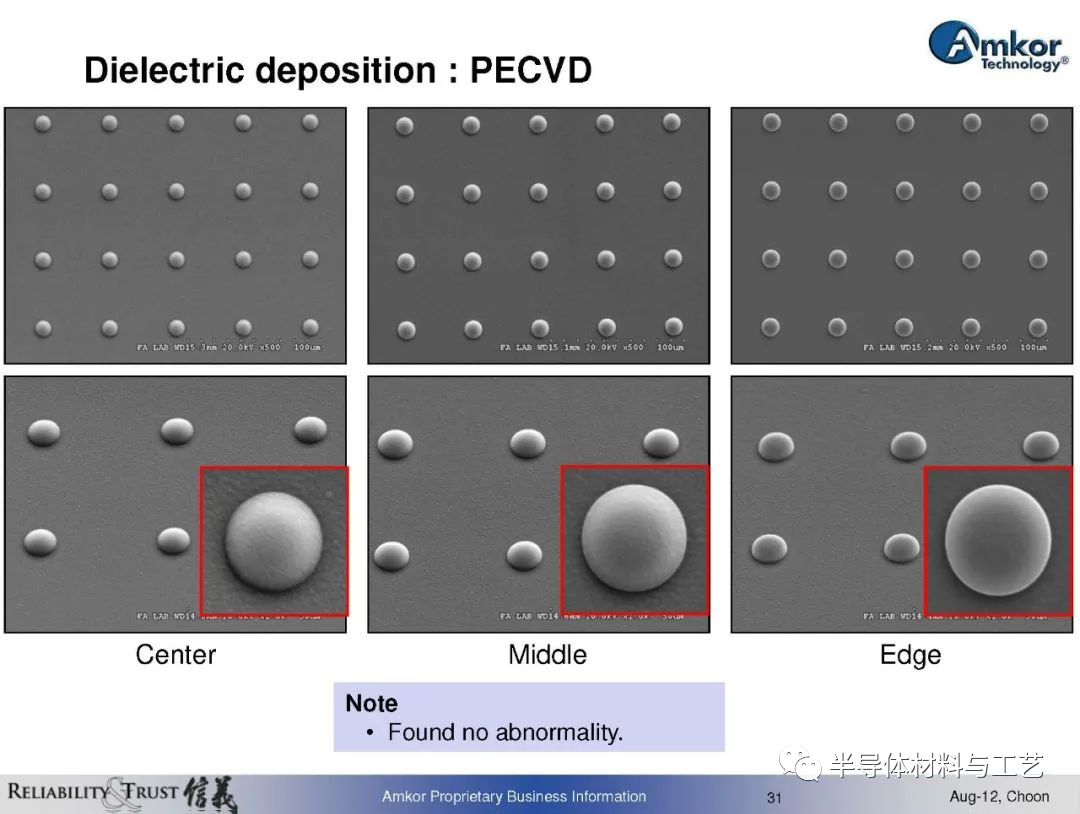

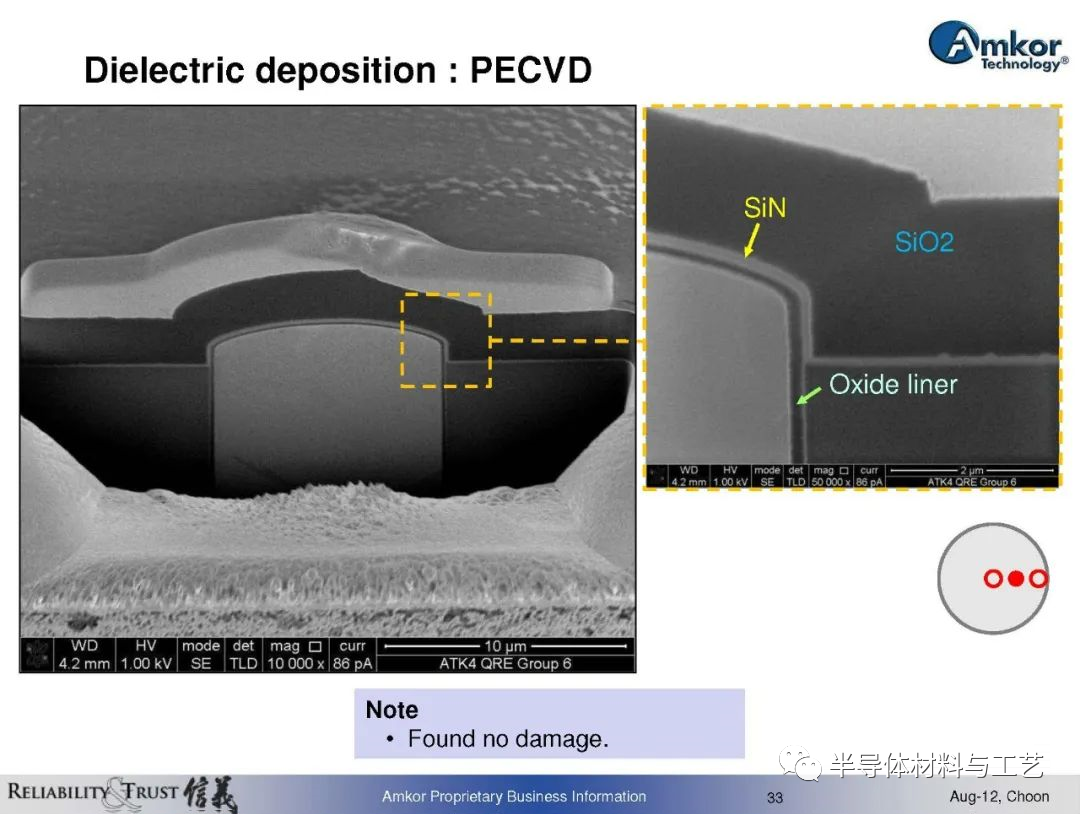
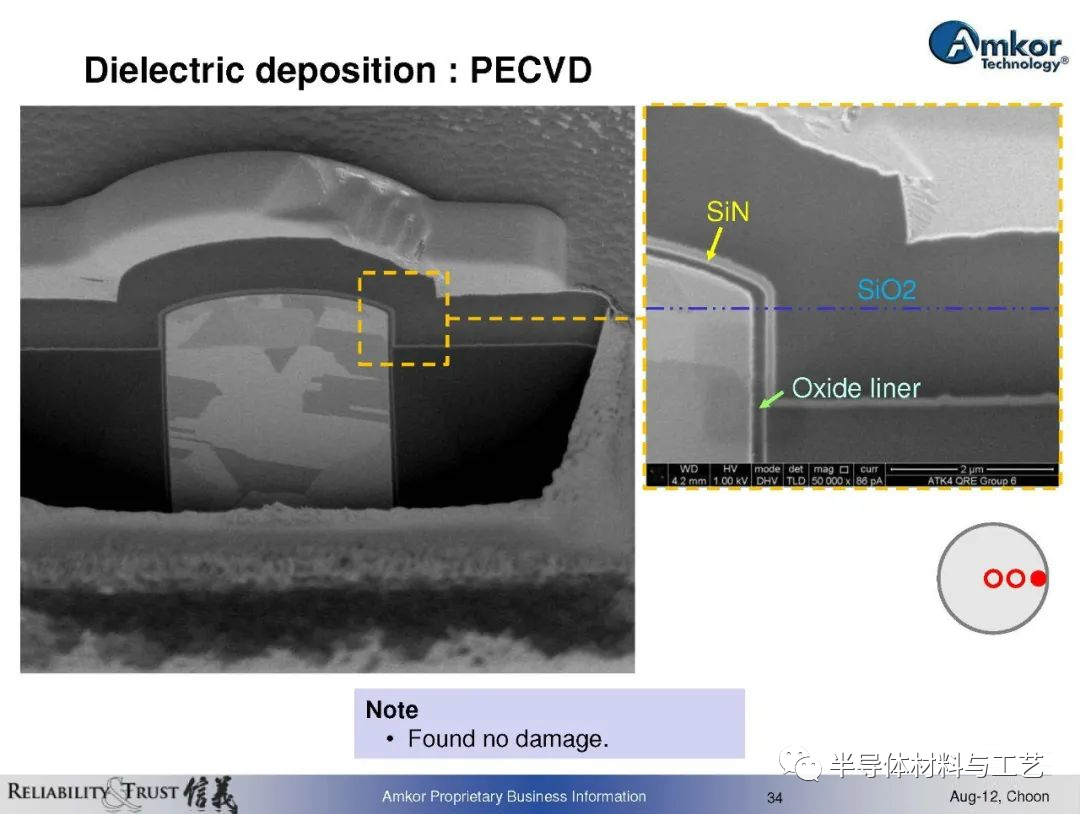

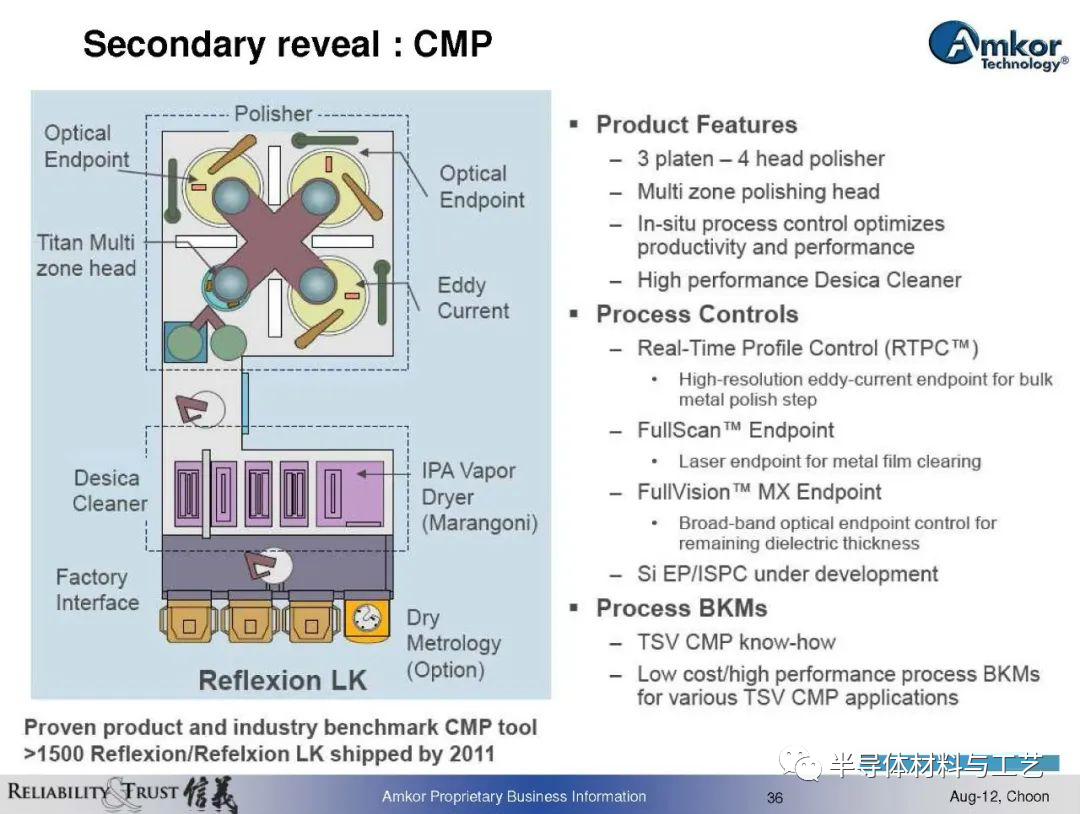

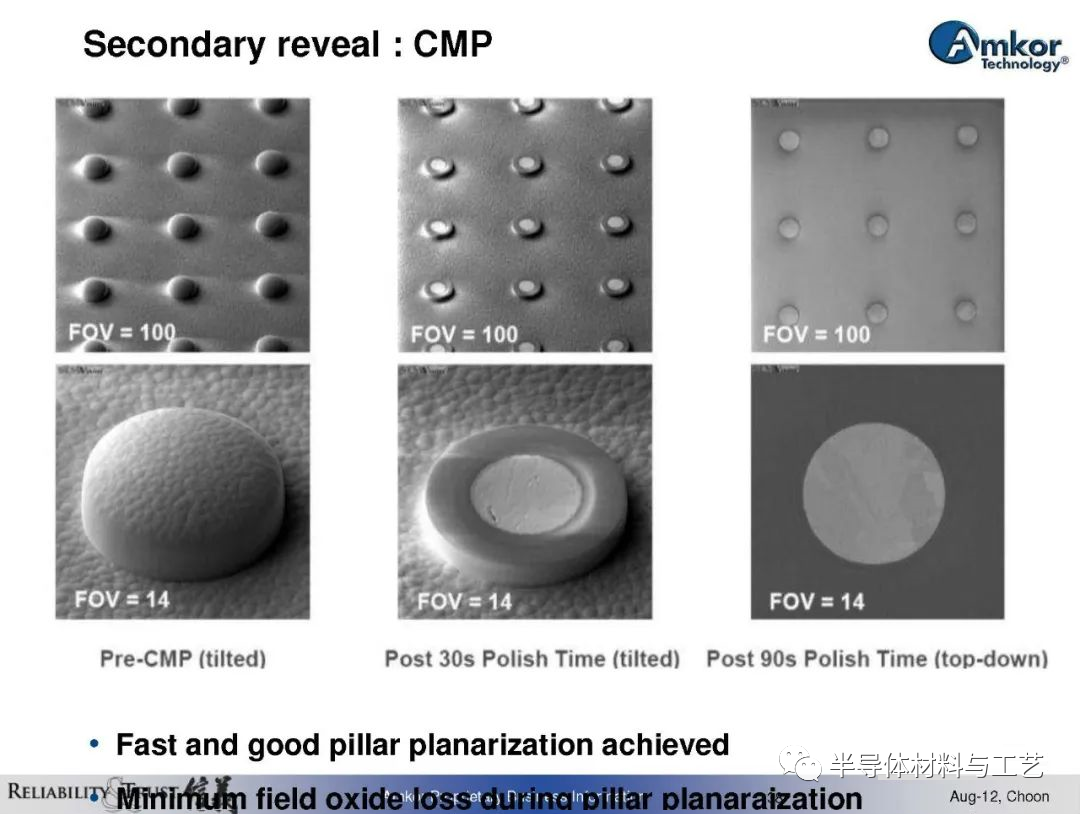






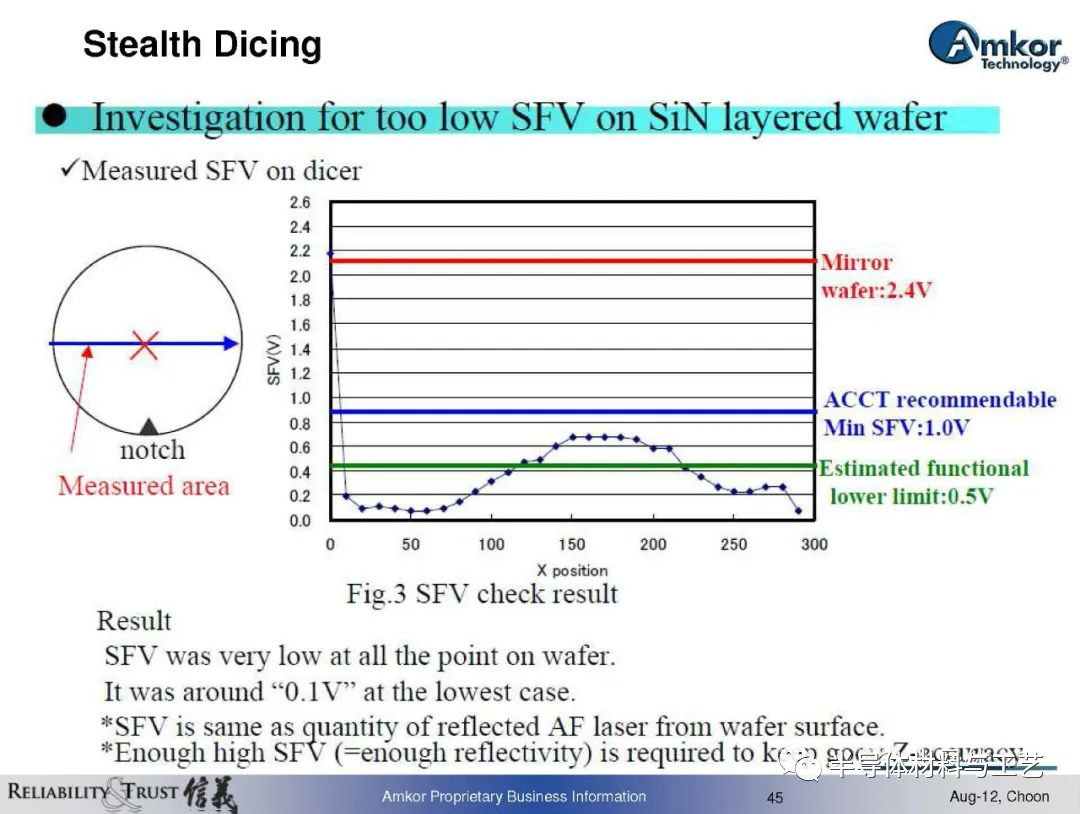
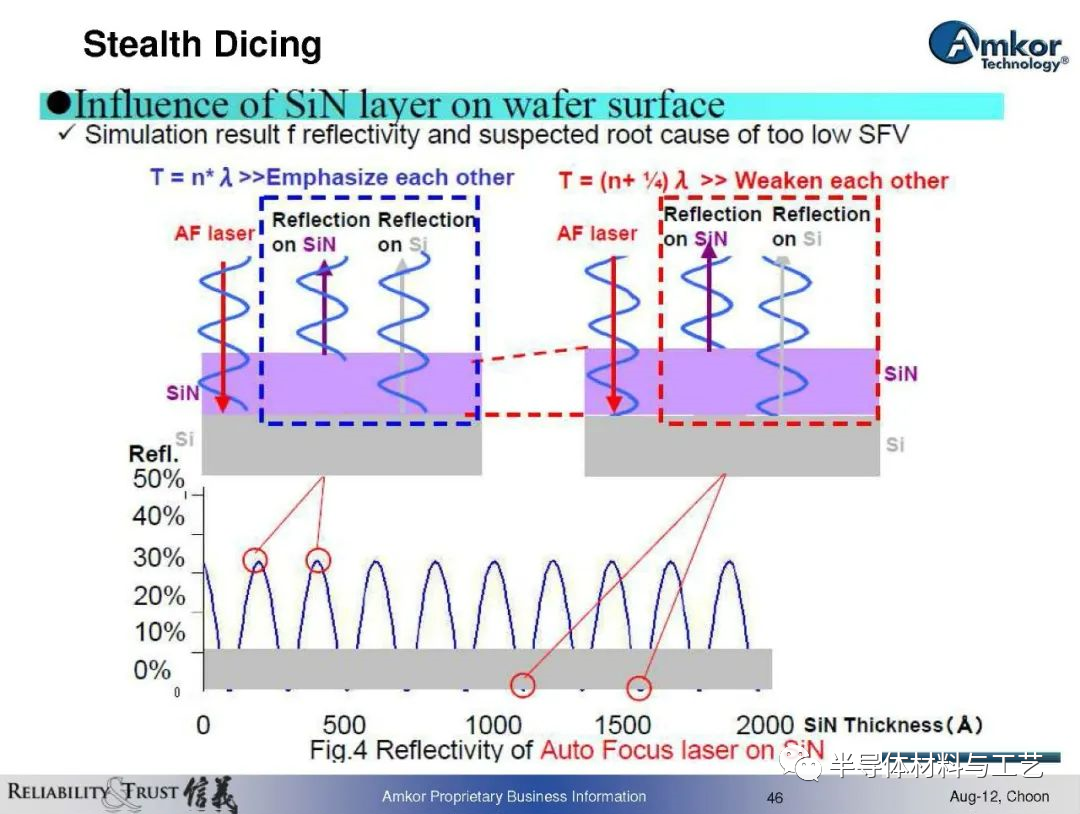
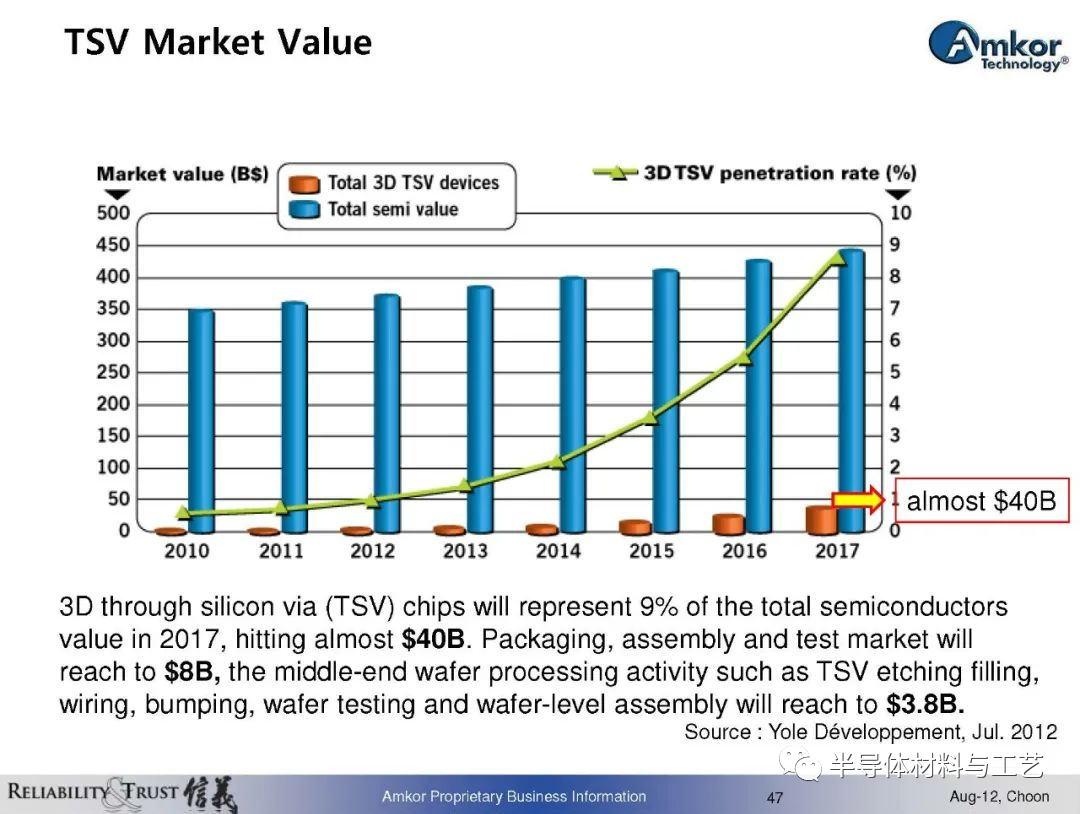

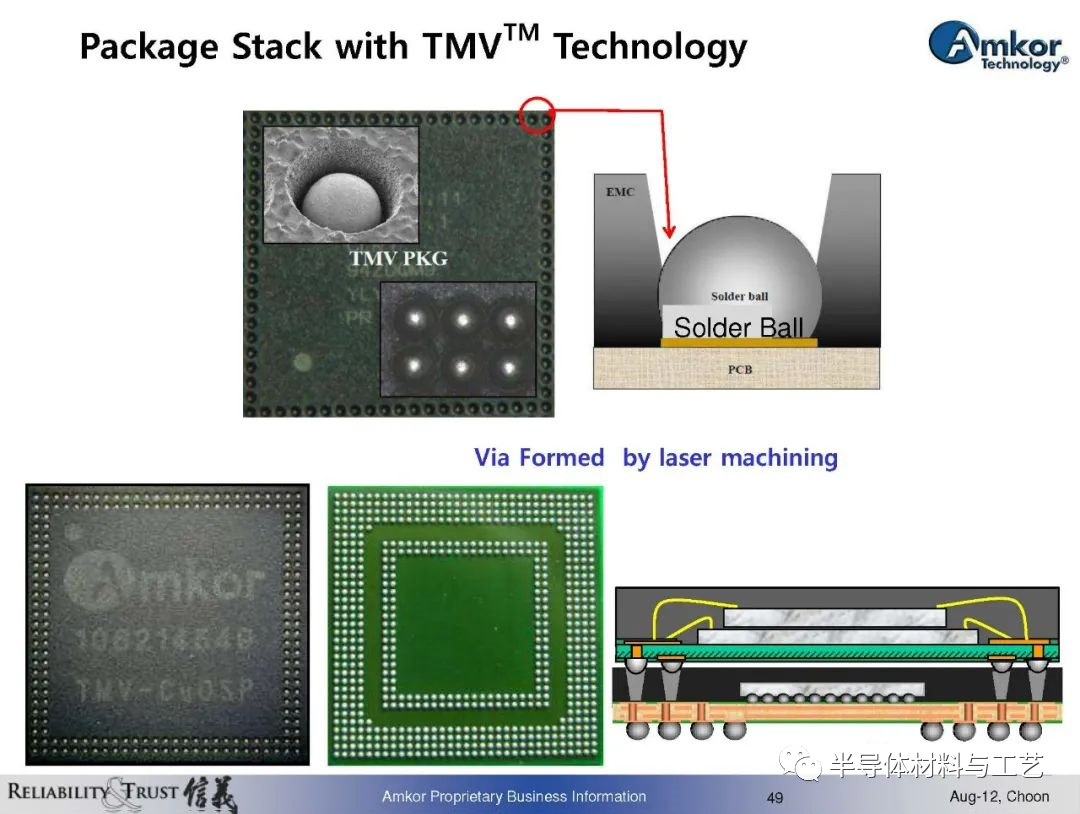
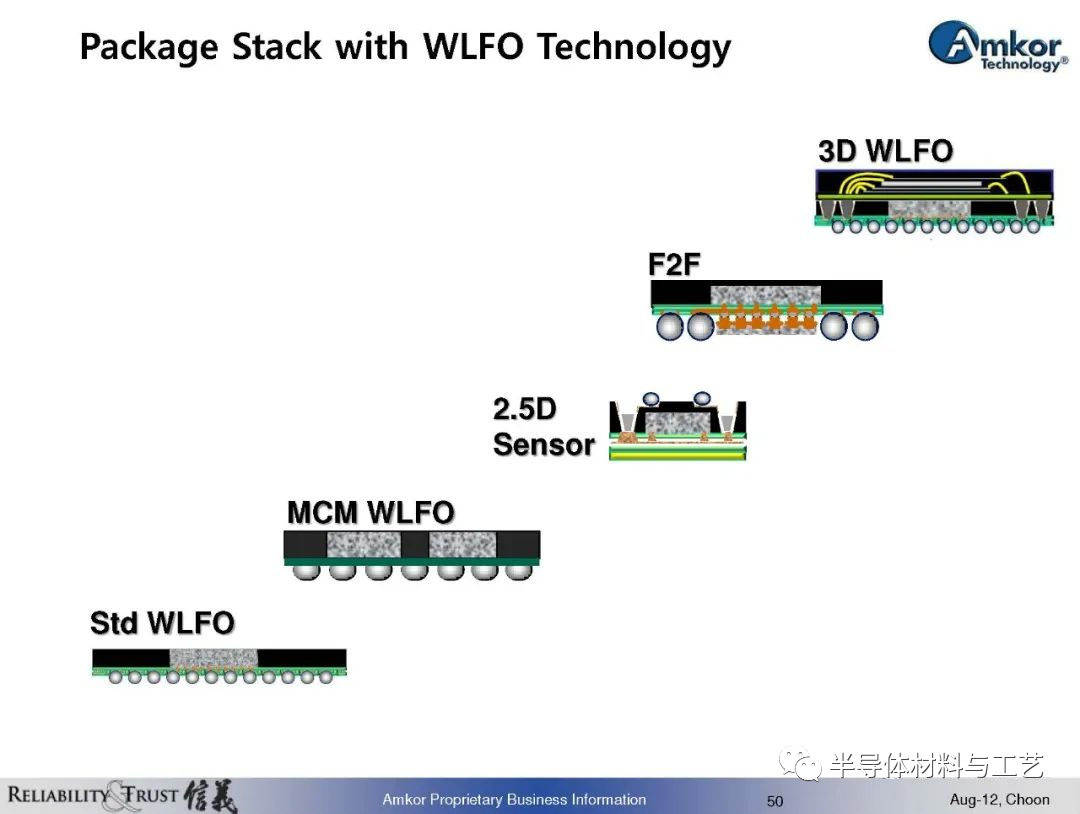
 電子發燒友App
電子發燒友App

 硬聲App
硬聲App


 25559
25559 1847
1847
 1405
1405
 7563
7563 51295
51295 3838
3838 6190
6190 3022
3022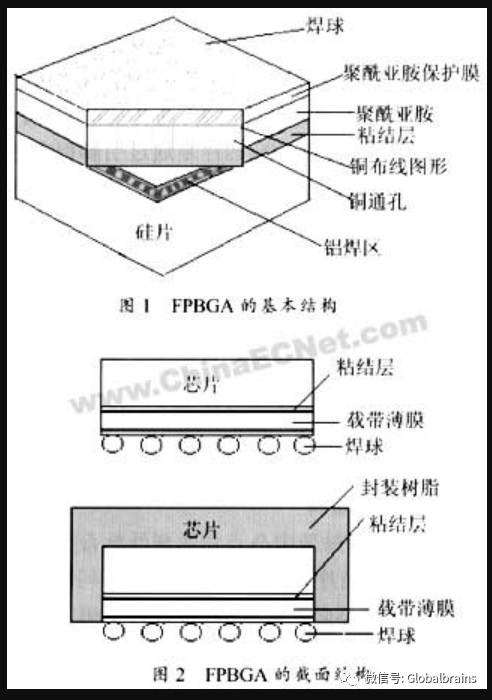
 2135
2135
 42
42 30
30 27162
27162 9951
9951 8854
8854 3316
3316 34067
34067 6478
6478 4118
4118 7076
7076 2004
2004 2242
2242 101144
101144 6384
6384 4946
4946
 5100
5100 10366
10366
 2050
2050 2847
2847 4389
4389 2211
2211 2029
2029 4395
4395 4884
4884 7024
7024
 2753
2753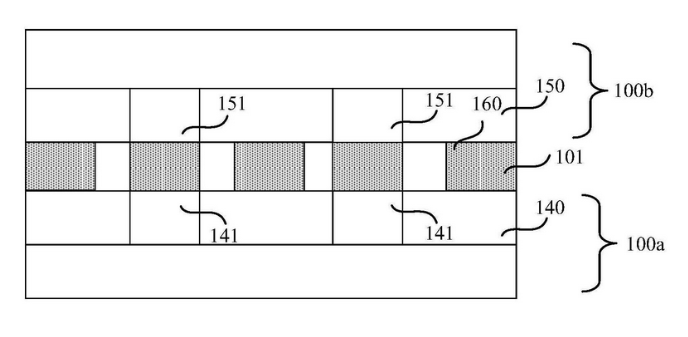
 5660
5660
 2931
2931 2848
2848
 3435
3435 20015
20015 2543
2543 9537
9537 3341
3341
 1924
1924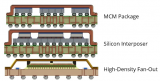
 2629
2629 2819
2819
 1614
1614
 1256
1256 786
786
 1554
1554
 1618
1618 428
428
 1308
1308
評論