引言
有應變和無應變的絕緣體上鍺(GOI)金屬氧化物半導體場效應晶體管因其高空穴遷移率和低寄生電容而引起了人們對其作為未來高性能金屬氧化物半導體場效應晶體管之一的強烈興趣。為了實現高質量的(應變的)GOI溝道層,在GOI或絕緣體上硅鍺(SGOI)襯底上外延生長鍺是一種很有前途的技術。GOI和SGOI襯底的表面清潔是獲得所需溝道層的最重要問題之一。另一方面,在清洗具有薄半導體層的襯底如SOI襯底時,已知必須降低退火溫度以防止表面粗糙化。因此,GOI襯底的清洗溫度上限可以認為是大約500℃或更低。然而,傳統的高頻蝕刻不適合在薄(S)GOI表面清潔中與這樣的低溫工藝結合,因為去除殘留雜質的能力不足。因此,對于(S)GOI基底強烈要求更有效的濕法清洗工藝。
在本報告中,提出了一種針對GOI和富鍺SGOI表面優化的有效濕法清洗工藝,該工藝可與低溫熱清洗相結合。此外,還演示了使用這種清洗方法在(S)GOI襯底上外延生長(應變)鍺層。
實驗
(S)?????? 采用鍺縮凝工藝制備了厚度為25-30nm、有效成分xeff分別為0.5、0.6和1.0的GOI底物。這里,有效成分意味著假定完全松弛SiGe晶體的SiGe層的平面內鍺成分。這些(S)GOI襯底和體鍺襯底被用于檢查清洗過程。用稀釋的HF溶液去除Ge冷凝過程中形成的二氧化硅層后,將(S)GOI底物在稀釋的銨根OH溶液中浸泡2分鐘,以去除剩余的金屬和有機材料,并在超純水中沖洗5分鐘。隨后將它們浸入各種酸溶液(氫氟酸、鹽酸、溴化氫和它們的混合溶液)中以清潔它們的表面。浸漬時間為2分鐘,除非另有說明。濕法清洗后,在化學氣相沉積室中,在700帕的氫氣氣氛中,在400℃至600℃的各種溫度下,對GOI襯底進行熱退火。隨后,在相同的化學氣相沉積室中,使用鍺四作為源氣體,在這些(硫)GOI襯底上生長鍺層。生長溫度從300℃到400℃,生長壓力從1帕到100帕。用x光電子能譜(XPS)和熱脫附譜(TDS)對化學清洗后的襯底表面進行了分析。分別用透射電子顯微鏡和原子力顯微鏡觀察了樣品的結構和表面形貌。用面外和面內X射線衍射測量了鍺的組成和弛豫比。
結果和討論
GOI基板的熱清洗-氫烘焙:
首先,評估熱清洗的溫度上限。用原子力顯微鏡測量的和鍺襯底的均方根值(@ 10米*10米)隨焙燒溫度的變化如圖1所示。即使清洗溫度升至600攝氏度,鍺塊表面也不會出現表面粗糙現象。然而,當溫度高于450攝氏度時,GOI層的表面會變得更加粗糙。已經證實,GOI襯底的熱清洗上限低于鍺體襯底。因此,在濕法清洗過程中,非常需要更有效地去除殘留的表面氧化物和雜質。
圖1 薄GOI襯底和鍺襯底均方根值隨氫烘烤溫度的變化
鍺表面的濕法清洗:
接下來,優化濕法清洗工藝。各種濕法清洗后鍺襯底的鍺-三維XPS光譜如圖2所示。這些樣品的光電子發射角設置為30°,以增強來自表面的信號。如前所述,GeO2和GeOx (x<2)可以被HBr溶液最有效地蝕刻。然而,在我們的實驗中,如圖3 (a)所示,在HBr蝕刻后,在大氣中保持約30分鐘的鍺表面上產生了顆粒狀產物,盡管在HBr蝕刻后的表面上沒有觀察到它們。證實了這些顆粒狀產物不歸因于HBr溶液,因為它們沒有出現在HBr處理的二氧化硅表面上。此外,原子力顯微鏡證實它們的尺寸和密度隨著時間的推移而增加。結果,由于不穩定的表面終止,顆粒狀產物可能是蝕刻過程后產生的任何產物。另一方面,HF+HCl溶液可以像HBr溶液一樣有效地蝕刻GeO2和GeOx (x<2),而沒有顆粒狀產物和表面粗糙化。因此,它被認為HF+HCl刻蝕是去除外延前處理剩余氧化物的最合適方法。
GOI襯底上鍺同質外延生長:
在HF+基質被HCl清洗并在450℃的H2中烘烤后,Ge層在400℃的GOI基質上外延生長。這里,由不同溶液清洗的襯底被一起裝載到沉積室中,并且鍺層同時在其上生長。在HF清洗的GOI襯底上的鍺層的表面上觀察到許多凹坑,這些凹坑被認為是由GOI襯底上剩余的表面氧化物形成的,而具有平坦表面的鍺層生長在HF+HCl清洗的GOI襯底上。由此發現,HF+HCl清洗是最適合的濕式清洗方法,可以與低溫熱清洗相結合。
SGOI襯底上的應變鍺外延生長:
最后,證明了利用上述方法在薄SGOI襯底上外延生長應變鍺層。實驗發現,為了避免表面粗糙化,與晶格匹配襯底上的情況相比,在晶格不匹配襯底上的外延中需要降低生長溫度。結果,發現在低于325℃的生長溫度下可以獲得具有平坦表面的應變鍺層。如圖7所示:
?圖7 生長在SGOI (Xeff = 0.6)襯底上的10納米厚應變鍺層的均方根值隨生長溫度的變化
通過XTEM圖像和面內XRD測量還發現,應變鍺層在300℃下成功地生長在SGOI襯底上而沒有晶格弛豫,而在325℃下生長的同樣具有平坦表面的鍺層由于更高的生長溫度而部分弛豫,如表1所示。因此,通過采用HF+HCl清洗、低溫H2烘烤和低溫鍺外延相結合的方法,成功地制造了應變GOI襯底。
總結
總之,我們提出了一種有效的表面清潔工藝,該工藝針對在GOI和富鍺復合SGOI襯底上的低溫外延生長進行了優化。研究發現,HF+HCl清洗是最適合在薄GOI層上生長外延膜的濕法清洗方法,需要低于450℃的熱清洗溫度。最后,通過將這些濕法和熱清洗工藝應用于薄的SGOI起始襯底,已經證明了應變GOI結構的成功形成。
? ? ? ?編輯:ymf
 電子發燒友App
電子發燒友App



























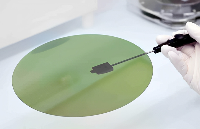





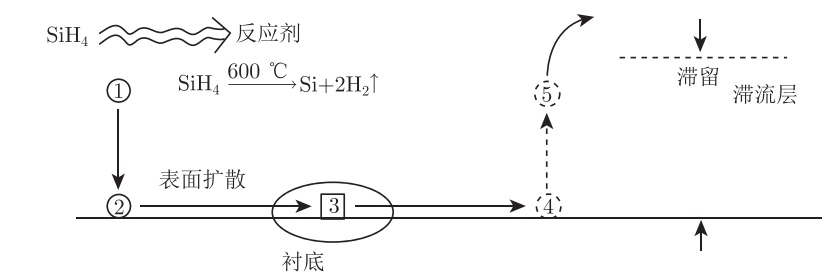
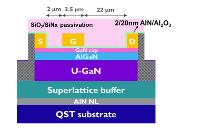






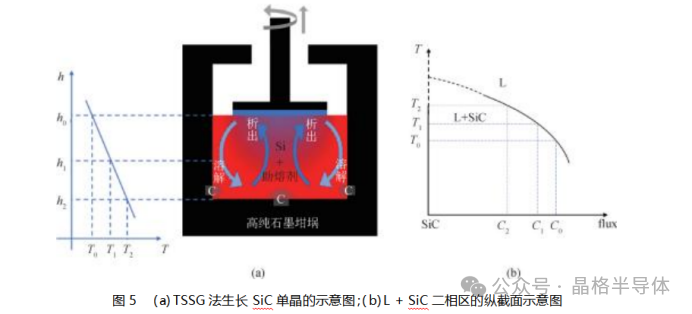
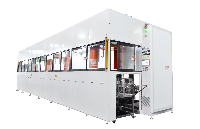

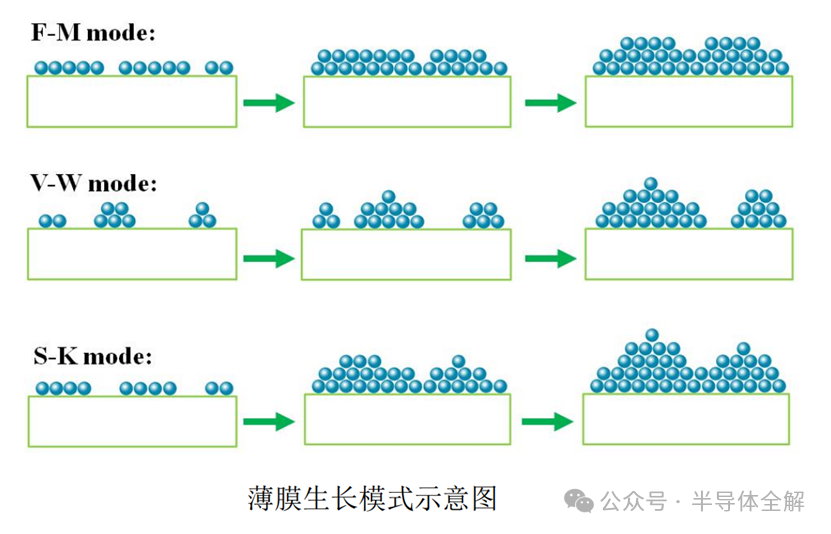




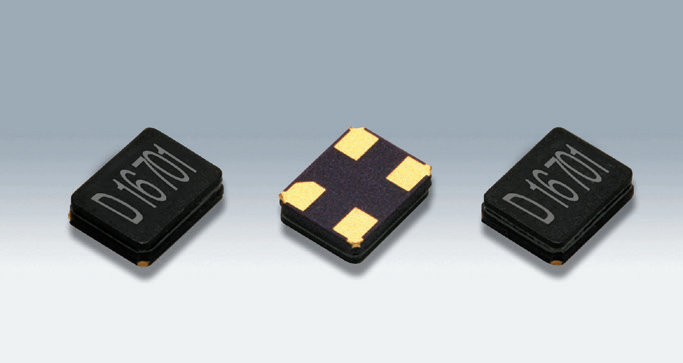
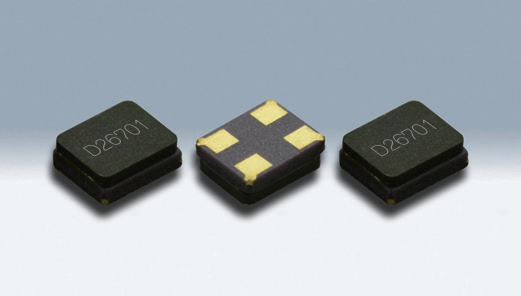

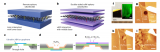

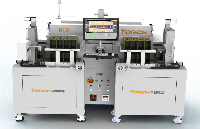




評論