一、引言
碳化硅外延片作為功率半導(dǎo)體器件的核心材料,其總厚度偏差(TTV)是衡量產(chǎn)品質(zhì)量的關(guān)鍵指標(biāo),直接影響器件的性能與可靠性 。外延片的 TTV 厚度受多種因素影響,其中生長工藝參數(shù)起著決定性作用。深入研究碳化硅外延片 TTV 厚度與生長工藝參數(shù)的關(guān)聯(lián)性,有助于優(yōu)化生長工藝,提升外延片質(zhì)量,推動碳化硅半導(dǎo)體產(chǎn)業(yè)發(fā)展。
二、碳化硅外延片生長工藝參數(shù)分析
2.1 溫度參數(shù)
生長溫度是碳化硅外延生長的關(guān)鍵參數(shù)之一。在化學(xué)氣相沉積(CVD)生長過程中,溫度影響反應(yīng)氣體的分解、吸附及表面遷移速率 。溫度過高,反應(yīng)氣體分解過快,可能導(dǎo)致原子在襯底表面無序堆積,造成外延層表面粗糙,進(jìn)而影響 TTV 厚度 ;溫度過低,原子活性不足,生長速率降低,且容易出現(xiàn)成核不均勻現(xiàn)象,同樣會使 TTV 厚度增大 。
2.2 氣體流量參數(shù)
生長過程中,反應(yīng)氣體(如硅源、碳源氣體)和載氣的流量對外延片生長有重要影響 。氣體流量配比不當(dāng),會導(dǎo)致硅、碳原子供應(yīng)不均衡,影響外延層的均勻生長 。例如,硅源氣體流量過高,可能在局部區(qū)域形成富硅層,造成外延片厚度不均勻,增大 TTV 。此外,氣體流量還會影響反應(yīng)腔內(nèi)的流場分布,若流場不均勻,會使外延片不同區(qū)域的生長速率存在差異,導(dǎo)致 TTV 厚度變化 。
2.3 壓力參數(shù)
反應(yīng)腔壓力也是影響碳化硅外延生長的重要參數(shù) 。在低壓 CVD(LPCVD)和常壓 CVD(APCVD)中,壓力的變化會改變反應(yīng)氣體的擴(kuò)散速率和表面反應(yīng)動力學(xué) 。較低的壓力有助于反應(yīng)氣體在襯底表面的均勻擴(kuò)散,可提高外延層的均勻性,降低 TTV ;而壓力過高時,氣體分子間碰撞加劇,會影響原子在襯底表面的吸附和遷移,導(dǎo)致外延片厚度不均勻,使 TTV 增大 。
三、TTV 厚度與生長工藝參數(shù)的關(guān)聯(lián)性
3.1 溫度與 TTV 的關(guān)聯(lián)
通過實驗研究發(fā)現(xiàn),在一定溫度范圍內(nèi),隨著生長溫度升高,碳化硅外延片 TTV 厚度呈現(xiàn)先減小后增大的趨勢 。存在一個最佳溫度區(qū)間,在此區(qū)間內(nèi),原子在襯底表面的遷移和吸附達(dá)到平衡,能夠形成均勻的外延層,TTV 厚度最小 。超出該溫度區(qū)間,無論是溫度過高還是過低,都會破壞這種平衡,導(dǎo)致 TTV 厚度增加 。
3.2 氣體流量與 TTV 的關(guān)聯(lián)
氣體流量與 TTV 厚度之間存在復(fù)雜的非線性關(guān)系 。合理調(diào)整硅源、碳源氣體及載氣的流量配比,可使外延層均勻生長,降低 TTV 。例如,當(dāng)硅源氣體流量與碳源氣體流量保持合適比例時,硅、碳原子能夠均勻沉積在襯底表面,外延片厚度均勻性提高 。若流量配比失衡,會導(dǎo)致局部區(qū)域生長過快或過慢,使 TTV 厚度增大 。
3.3 壓力與 TTV 的關(guān)聯(lián)
研究表明,反應(yīng)腔壓力與 TTV 厚度呈負(fù)相關(guān)關(guān)系 。在較低壓力下,氣體擴(kuò)散均勻,外延片生長均勻性好,TTV 厚度較小 ;隨著壓力升高,氣體擴(kuò)散受限,外延片不同區(qū)域生長速率差異增大,TTV 厚度隨之增加 。但壓力過低也可能引發(fā)其他問題,如生長速率過慢等,因此需要在合適的壓力范圍內(nèi)進(jìn)行生長,以控制 TTV 厚度 。
高通量晶圓測厚系統(tǒng)運(yùn)用第三代掃頻OCT技術(shù),精準(zhǔn)攻克晶圓/晶片厚度TTV重復(fù)精度不穩(wěn)定難題,重復(fù)精度達(dá)3nm以下。針對行業(yè)厚度測量結(jié)果不一致的痛點(diǎn),經(jīng)不同時段測量驗證,保障再現(xiàn)精度可靠。?

我們的數(shù)據(jù)和WAFERSIGHT2的數(shù)據(jù)測量對比,進(jìn)一步驗證了真值的再現(xiàn)性:

(以上為新啟航實測樣品數(shù)據(jù)結(jié)果)
該系統(tǒng)基于第三代可調(diào)諧掃頻激光技術(shù),相較傳統(tǒng)雙探頭對射掃描,可一次完成所有平面度及厚度參數(shù)測量。其創(chuàng)新掃描原理極大提升材料兼容性,從輕摻到重?fù)絇型硅,到碳化硅、藍(lán)寶石、玻璃等多種晶圓材料均適用:?
對重?fù)叫凸瑁删珳?zhǔn)探測強(qiáng)吸收晶圓前后表面;?
點(diǎn)掃描第三代掃頻激光技術(shù),有效抵御光譜串?dāng)_,勝任粗糙晶圓表面測量;?
通過偏振效應(yīng)補(bǔ)償,增強(qiáng)低反射碳化硅、鈮酸鋰晶圓測量信噪比;

(以上為新啟航實測樣品數(shù)據(jù)結(jié)果)
支持絕緣體上硅和MEMS多層結(jié)構(gòu)測量,覆蓋μm級到數(shù)百μm級厚度范圍,還可測量薄至4μm、精度達(dá)1nm的薄膜。

(以上為新啟航實測樣品數(shù)據(jù)結(jié)果)
此外,可調(diào)諧掃頻激光具備出色的“溫漂”處理能力,在極端環(huán)境中抗干擾性強(qiáng),顯著提升重復(fù)測量穩(wěn)定性。

(以上為新啟航實測樣品數(shù)據(jù)結(jié)果)
系統(tǒng)采用第三代高速掃頻可調(diào)諧激光器,擺脫傳統(tǒng)SLD光源對“主動式減震平臺”的依賴,憑借卓越抗干擾性實現(xiàn)小型化設(shè)計,還能與EFEM系統(tǒng)集成,滿足產(chǎn)線自動化測量需求。運(yùn)動控制靈活,適配2-12英寸方片和圓片測量。

-
碳化硅
+關(guān)注
關(guān)注
26文章
3518瀏覽量
52574 -
外延片
+關(guān)注
關(guān)注
0文章
40瀏覽量
10061 -
功率半導(dǎo)體器件
+關(guān)注
關(guān)注
3文章
62瀏覽量
6445
發(fā)布評論請先 登錄
【新啟航】如何解決碳化硅襯底 TTV 厚度測量中的各向異性干擾問題

【新啟航】碳化硅襯底 TTV 厚度測量設(shè)備的日常維護(hù)與故障排查

【新啟航】國產(chǎn) VS 進(jìn)口碳化硅襯底 TTV 厚度測量儀的性價比分析

【新啟航】碳化硅襯底 TTV 厚度測量中表面粗糙度對結(jié)果的影響研究

【新啟航】探針式碳化硅襯底 TTV 厚度測量儀的操作規(guī)范與技巧

探針式碳化硅襯底 TTV 厚度測量儀的操作規(guī)范與技巧

碳化硅襯底 TTV 厚度測量中邊緣效應(yīng)的抑制方法研究

碳化硅襯底 TTV 厚度不均勻性測量的特殊采樣策略

【新啟航】碳化硅襯底 TTV 厚度不均勻性測量的特殊采樣策略

【新啟航】碳化硅 TTV 厚度與表面粗糙度的協(xié)同控制方法

【新啟航】碳化硅 TTV 厚度測量中的各向異性效應(yīng)及其修正算法

[新啟航]碳化硅 TTV 厚度測量技術(shù)的未來發(fā)展趨勢與創(chuàng)新方向
![[新<b class='flag-5'>啟航</b>]<b class='flag-5'>碳化硅</b> <b class='flag-5'>TTV</b> <b class='flag-5'>厚度</b>測量技術(shù)的未來發(fā)展趨勢與創(chuàng)新方向](https://file1.elecfans.com/web3/M00/20/D6/wKgZPGhd-raAI0RYAACIgEePWXY565.png)



 【新啟航】碳化硅外延片 TTV 厚度與生長工藝參數(shù)的關(guān)聯(lián)性研究
【新啟航】碳化硅外延片 TTV 厚度與生長工藝參數(shù)的關(guān)聯(lián)性研究

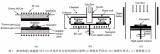



評論