隨著半導(dǎo)體器件向高溫、高頻、高功率方向發(fā)展,氮化鋁(AlN)等寬禁帶半導(dǎo)體材料的外延質(zhì)量至關(guān)重要。薄膜的厚度、界面粗糙度、光學(xué)常數(shù)及帶隙溫度依賴性直接影響器件性能。Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應(yīng)用于薄膜材料、半導(dǎo)體和表面科學(xué)等領(lǐng)域。
本文基于光譜橢偏技術(shù),結(jié)合X射線衍射、拉曼光譜等方法,系統(tǒng)研究了c面藍(lán)寶石襯底上生長的不同厚度AlN外延薄膜的結(jié)構(gòu)與光學(xué)性質(zhì),重點(diǎn)通過高溫變溫橢偏分析,揭示了薄膜厚度對晶體質(zhì)量、帶隙熱穩(wěn)定性及應(yīng)力狀態(tài)的調(diào)控機(jī)制。
1
實(shí)驗(yàn)與方法
flexfilm
橢偏儀測試系統(tǒng)
本研究采用Flexfilm全光譜橢偏儀進(jìn)行測試。測量時使用三個入射角:60°、65°和70°。變溫測試通過變溫臺實(shí)現(xiàn),溫度范圍300 K–850 K,每個溫度點(diǎn)穩(wěn)定15分鐘后采集數(shù)據(jù),以保證溫度均勻性。
樣品制備與測試流程
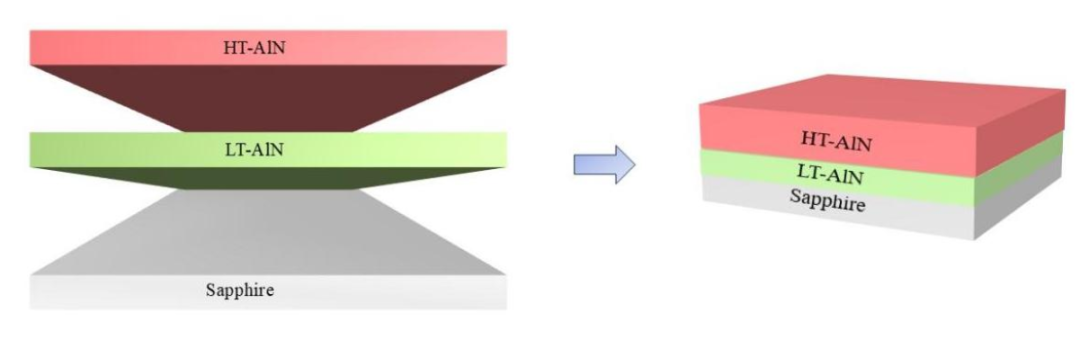
AlN 樣品結(jié)構(gòu)示意圖
樣品采用MOCVD階梯生長法在c面藍(lán)寶石襯底上制備,分別生長了名義厚度為2 μm(AlNt)和4 μm(AlNn)的AlN外延層。橢偏測試前未對樣品進(jìn)行特殊表面處理。測試在常壓環(huán)境下進(jìn)行,高溫測試時使用水循環(huán)控溫。
數(shù)據(jù)分析與誤差控制

室溫時樣品(a)AlNt(b)AlNn測試與模型擬合的Ψ(λ)和Δ(λ)光譜
采用CompleteEASE軟件建立四層物理模型(表面粗糙度/HT-AlN層/LT-AlN緩沖層/藍(lán)寶石襯底)對橢偏光譜進(jìn)行擬合。藍(lán)寶石襯底光學(xué)常數(shù)取自文獻(xiàn)并固定不變,AlN層采用高斯振子與Psemi振子組合描述。通過最小二乘法反復(fù)優(yōu)化,獲得膜厚、光學(xué)常數(shù)(n, k)、表面粗糙度及帶隙等參數(shù),擬合優(yōu)度通過實(shí)驗(yàn)曲線與擬合曲線的吻合程度判斷。
2
結(jié)果與討論
flexfilm
薄膜厚度與光學(xué)常數(shù)的橢偏表征

室溫下兩個樣品的擬合光學(xué)常數(shù)(折射率n和消光系數(shù)k)
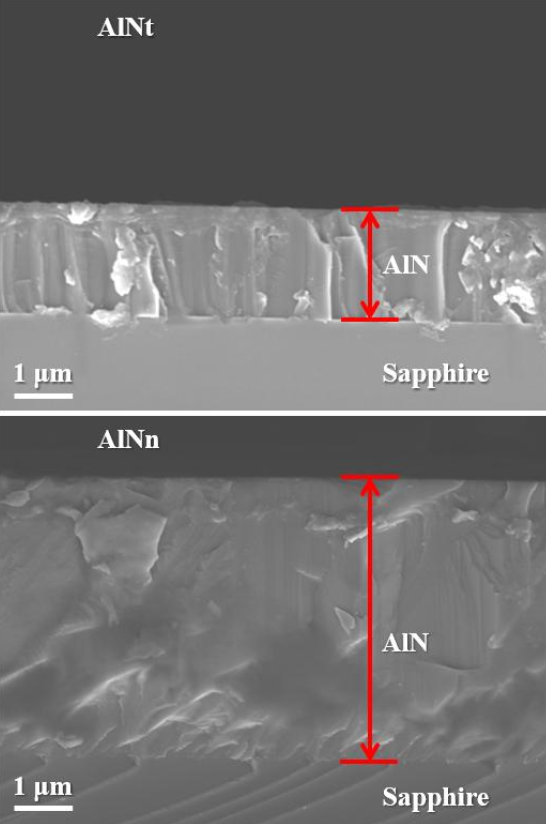
AlNt和AlNn薄膜樣品橫截面的SEM形貌圖
通過室溫橢偏擬合,獲得AlNt和AlNn的外延層厚度分別為(1.78±0.04)μm和(3.67±0.05)μm,與SEM結(jié)果一致。表面粗糙度分別為(3.07±0.03)nm和(3.58±0.05)nm。室溫下兩個樣品的折射率n與消光系數(shù)k隨光子能量的變化關(guān)系,在帶隙附近,k值迅速上升,表明吸收邊陡峭,晶體質(zhì)量較高。
帶隙與Urbach帶尾的橢偏分析
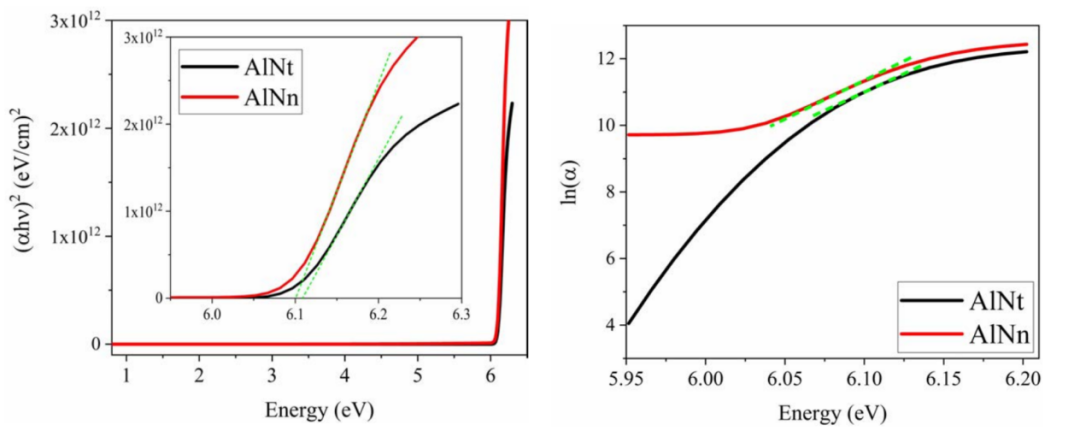
室溫下兩個AlN樣品外延層(αhν)2和ln(α)與光子能量(hν)的關(guān)系圖
通過(αhν)2-hν關(guān)系圖線性擬合得到AlNt和AlNn的帶隙分別為(6.11±0.01)eV和(6.10±0.02)eV。基于吸收系數(shù)α的指數(shù)衰減區(qū)域,通過lnα-hν關(guān)系擬合得到Urbach帶尾能量Eu分別為(50±0.02)meV和(45±0.02)meV。較厚的AlNn樣品Eu更小,表明其結(jié)構(gòu)無序度更低、晶體質(zhì)量更好,與XRD測得的(0002)面半高寬變化趨勢一致。
高溫變溫橢偏揭示帶隙熱穩(wěn)定性
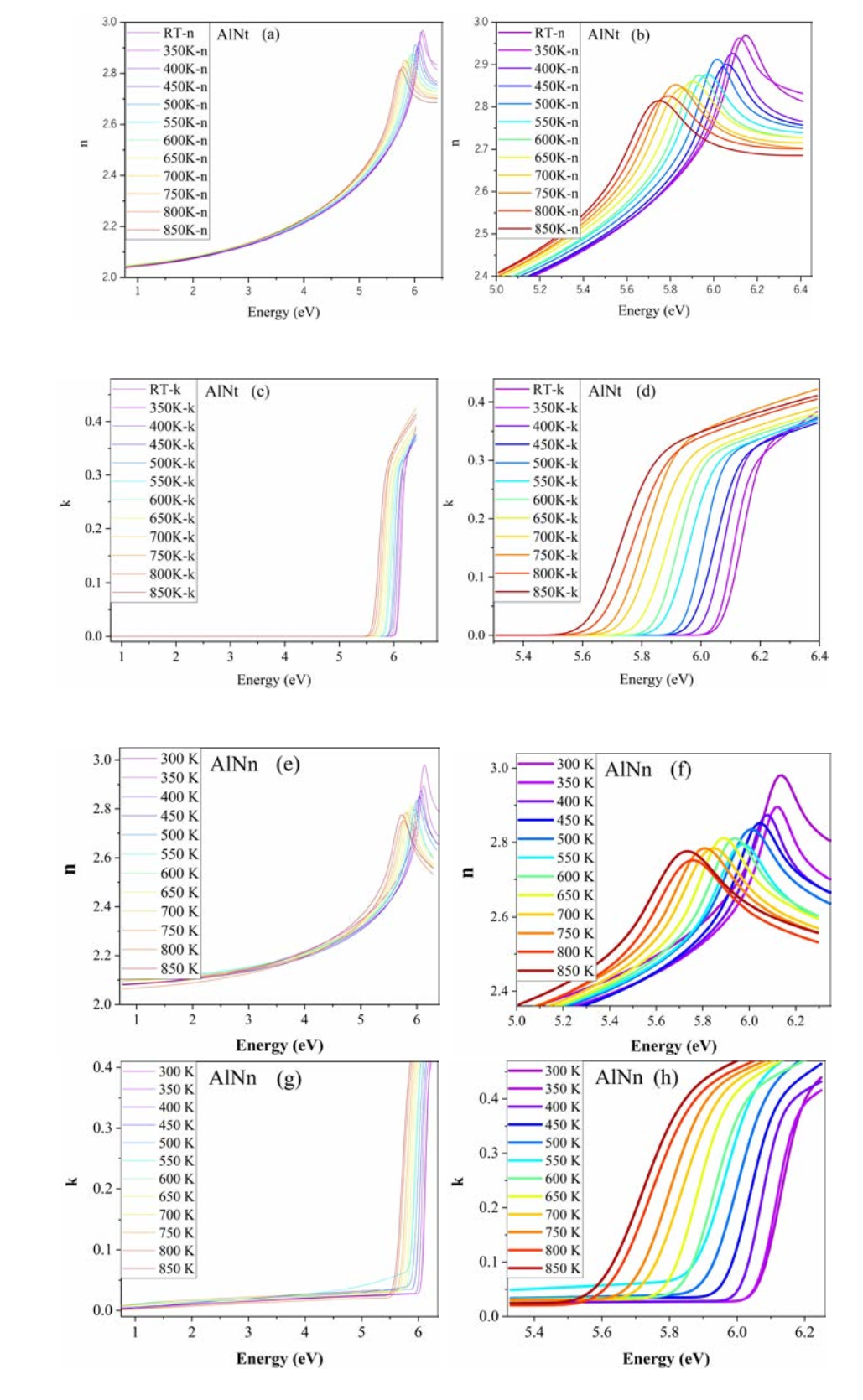
高溫變溫SE測試數(shù)據(jù)擬合后得到的n和k
在300 K–850 K溫度范圍內(nèi)進(jìn)行變溫橢偏測試,獲得了n、k及帶隙Eg隨溫度的變化關(guān)系。結(jié)果顯示,隨著溫度升高,吸收邊紅移,帶隙減小。
通過Bose-Einstein模型擬合Eg-T關(guān)系,得到AlNt和AlNn的平均電子-聲子耦合能分別為(389±100)meV和(390±102)meV,特征溫度分別為(800±154)K和(795±155)K。
與文獻(xiàn)中較薄樣品(如136 nm樣品耦合能為687 meV)相比,本研究中微米級厚度樣品的耦合顯著減弱,表明厚度增加可有效提升AlN帶隙的熱穩(wěn)定性。當(dāng)厚度達(dá)到微米級后,厚度對Eg溫度依賴性的影響趨于飽和。
本研究通過光譜橢偏技術(shù),準(zhǔn)確表征了不同厚度c面AlN外延薄膜的厚度、光學(xué)常數(shù)、帶隙及Urbach帶尾,并結(jié)合高溫變溫測試,系統(tǒng)分析了薄膜厚度對晶體質(zhì)量與熱穩(wěn)定性的影響。橢偏數(shù)據(jù)表明,厚度增加可降低薄膜的結(jié)構(gòu)無序度,減小Urbach帶尾,并顯著弱化電子-聲子耦合作用,從而增強(qiáng)帶隙在高溫下的穩(wěn)定性。這些結(jié)果為面向高溫工作的AlN基光電子器件設(shè)計與工藝優(yōu)化提供了關(guān)鍵的薄膜質(zhì)量評估依據(jù)。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領(lǐng)域中單層或多層納米薄膜的層構(gòu)參數(shù)(如厚度)和物理參數(shù)(如折射率n、消光系數(shù)k)
- 先進(jìn)的旋轉(zhuǎn)補(bǔ)償器測量技術(shù):無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進(jìn)的光能量增強(qiáng)技術(shù),高信噪比的探測技術(shù)。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達(dá)0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結(jié)合費(fèi)曼儀器全流程薄膜測量技術(shù),助力半導(dǎo)體薄膜材料領(lǐng)域的高質(zhì)量發(fā)展。
#橢偏儀#氮化鋁#外延薄膜#高溫光學(xué)特性#帶隙熱穩(wěn)定性
原文參考:《Ⅲ族氮化物半導(dǎo)體薄膜的結(jié)構(gòu)和光學(xué)性質(zhì)研究》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時間核實(shí)并處理。
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30725瀏覽量
264041 -
薄膜
+關(guān)注
關(guān)注
0文章
359瀏覽量
46153
發(fā)布評論請先 登錄
橢偏儀原理和應(yīng)用 | 精準(zhǔn)測量不同基底光學(xué)薄膜TiO?/SiO?的光學(xué)常數(shù)

橢偏儀測量薄膜厚度的原理與應(yīng)用

橢偏儀與DIC系統(tǒng)聯(lián)用測量半導(dǎo)體超薄圖案化SAM薄膜厚度與折射率

橢偏儀薄膜測量原理和方法:光學(xué)模型建立和仿真

橢偏儀的原理和應(yīng)用 | 薄膜材料或塊體材料光學(xué)參數(shù)和厚度的測量

薄膜測厚選臺階儀還是橢偏儀?針對不同厚度范圍提供技術(shù)選型指南

橢偏儀在半導(dǎo)體薄膜厚度測量中的應(yīng)用:基于光譜干涉橢偏法研究

橢偏儀在精密薄膜中的應(yīng)用:基于單驅(qū)動變角結(jié)構(gòu)的高重復(fù)性精度控制系統(tǒng)

橢偏術(shù)精準(zhǔn)測量超薄膜n,k值及厚度:利用光學(xué)各向異性襯底

橢偏儀在半導(dǎo)體的應(yīng)用|不同厚度m-AlN與GaN薄膜的結(jié)構(gòu)與光學(xué)性質(zhì)

光譜橢偏儀在二維材料光學(xué)表征中的應(yīng)用綜述




 橢偏儀在半導(dǎo)體的應(yīng)用|不同厚度c-AlN外延薄膜的結(jié)構(gòu)和光學(xué)性質(zhì)
橢偏儀在半導(dǎo)體的應(yīng)用|不同厚度c-AlN外延薄膜的結(jié)構(gòu)和光學(xué)性質(zhì)




評論