21世紀(jì)微電子技術(shù)的高速發(fā)展,隨之帶動的是一系列產(chǎn)業(yè)的發(fā)展。信息、能源、通訊各類新興產(chǎn)業(yè)的發(fā)展離不開微電子技術(shù)。而微電子封裝技術(shù)是微電子技術(shù)中最關(guān)鍵和核心的技術(shù)。微電子封裝體(Package)和芯片(Chip或die)通過封裝工藝(Packaging)組合成一個微電子器件(Device),通常封裝為芯片(或管芯)提供電通路、散熱通路、機械支撐、環(huán)境防護(hù)等,所以微電子封裝是微電器件的2個基本組成部分之一,器件的許多可靠性性能都是由封裝的性能決定的。致力于發(fā)展微電子封裝技術(shù)的人們把目光投在以下4個方面:①極低的成本。②薄、輕、便捷。③極高的性能。④各種不同的功能包括各類不同的半導(dǎo)體芯片。
1 微電子封裝技術(shù)的發(fā)展歷程
微電子封裝技術(shù)的發(fā)展經(jīng)歷了3個階段:
第一階段是20世紀(jì)70年代中期,由雙直列封裝技術(shù)(DIP)為代表的針腳插入型轉(zhuǎn)變?yōu)樗倪呉€扁平封裝型(QPF),與DIP相比,QFP的封裝尺寸大大減小,具有操作方便、可靠性高、適用于SMT表面安裝技術(shù)在PCB上安裝布線,由于封裝外形尺寸小,寄生參數(shù)減小,特別適合高頻應(yīng)用。
第二階段是20世紀(jì)90年代中期,以球柵陣列端子BGA型封裝為標(biāo)志,隨后又出現(xiàn)了各種封裝體積更小的芯片尺寸封裝(CSP)。與QPF相比,BGA引線短,散熱好、電噪小且其封裝面積更小、引腳數(shù)量更多、適合大規(guī)模生產(chǎn)。
第三階段是本世紀(jì)初,由于多芯片系統(tǒng)封裝SIP出現(xiàn),將封裝引入了一個全新的時代。
2 微電子封裝的主流技術(shù)
目前的主流技術(shù)集中在BGA、CSP以及小節(jié)距的QPF等封裝技術(shù)上,并向埋置型三維封裝、有源基板型三維封裝、疊層型三維封裝即三維封裝和系統(tǒng)封裝的方向發(fā)展。
2.1 BGACSP封裝
球柵陣列封裝BGA在GPU、主板芯片組等大規(guī)模集成電路封裝有廣泛應(yīng)用。它的I/O引線以圓形或柱狀焊點按陣列形式分布在封裝下面,引線間距大,引線長度短,這樣BGA消除了精細(xì)間距器件中由于引線而引起的共面度和翹曲的問題。BGA技術(shù)包括很多種類如陶瓷封裝BGA(CBGA)、塑料封裝BGA(PBGA)以及MicroBGA(μBGA)。BGA具有下述優(yōu)
點:
①I/O引線間距大(如1.0mm,1.27mm),可容納的I/O數(shù)目大,如1.27mm間距的BGA在25mm邊長的面積上可容納350個I/O,而0.5mm間距的QFP在40mm邊長的面積上只容納304個I/O。
②封裝可靠性高,不會損壞引腳,焊點缺陷率低,焊點牢固。
③管腳水平面同一性較QFP容易保證,因為焊錫球在溶化以后可以自動補償芯片與PCB之間的平面誤差,而且其引腳牢固運轉(zhuǎn)方便。
④回流焊時,焊點之間的張力產(chǎn)生良好的自對準(zhǔn)效果,允許有50%的貼片精度誤差,避免了傳統(tǒng)封裝引線變形的損失,大大提高了組裝成品率。
⑤有較好的電特性,由于引線短,減小了引腳延遲,并且導(dǎo)線的自感和導(dǎo)線間的互感很低,頻率特性好。
⑥能與原有的SMT貼裝工藝和設(shè)備兼容,原有的絲印機、貼片機和回流焊設(shè)備都可使用,兼容性好,便于統(tǒng)一標(biāo)準(zhǔn)。
⑦焊球引出形式同樣適用于多芯片組件和系統(tǒng)封裝。lw
 電子發(fā)燒友App
電子發(fā)燒友App










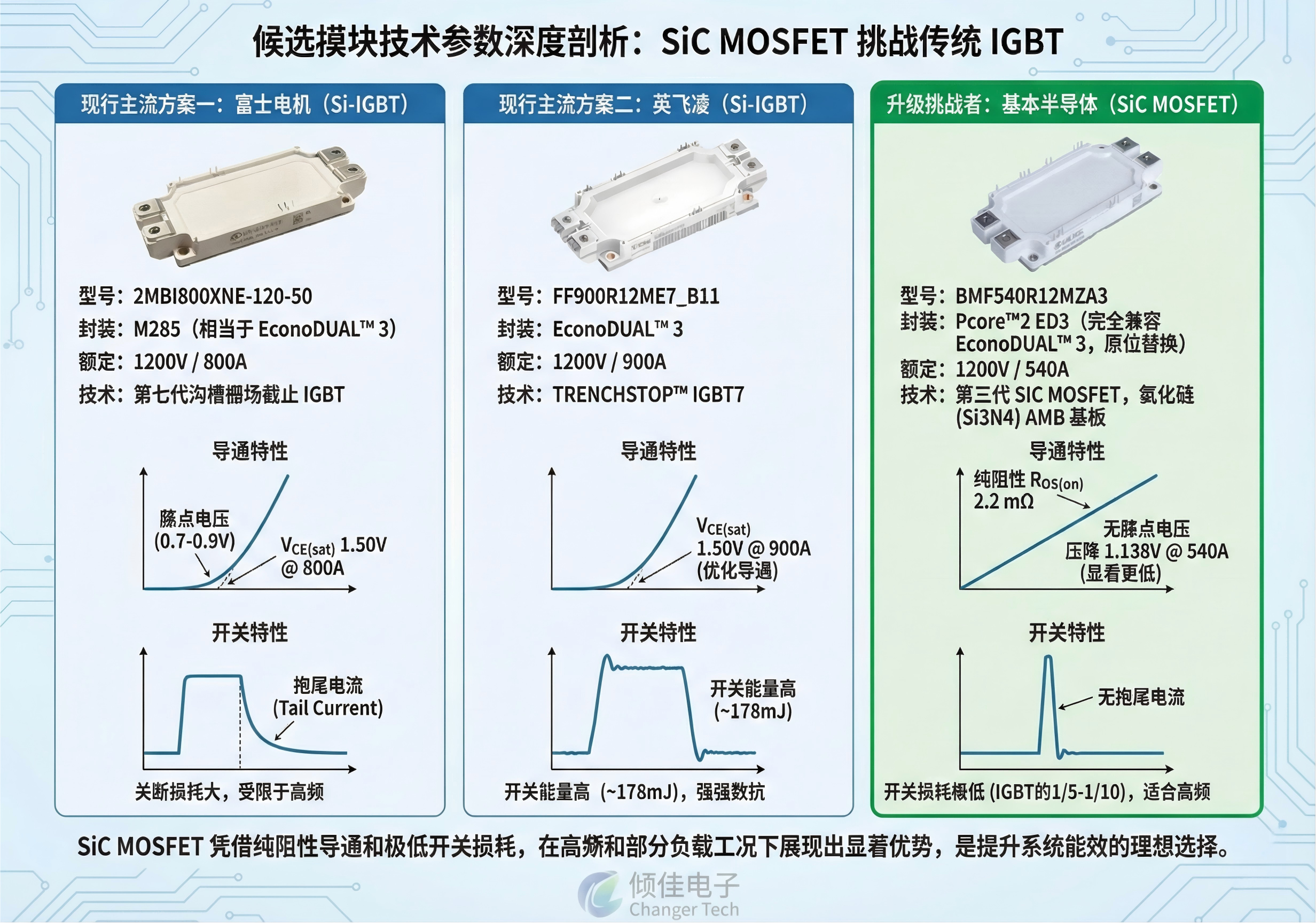





























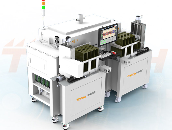

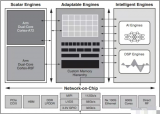








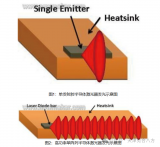

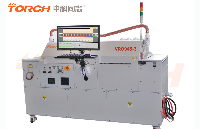









評論