這項新技術允許使用超過60,000個TSV孔堆疊12個DRAM芯片,同時保持與當前8層芯片相同的厚度。
全球先進半導體技術的領導者三星電子今天宣布,它已開發出業界首個12層3D-TSV(直通硅通孔)技術。
三星的創新被認為是大規模生產高性能芯片的最具挑戰性的封裝技術之一,因為它需要精確的精度才能通過具有60,000多個TSV孔的三維配置垂直互連12個DRAM芯片。
封裝的厚度(720um)與當前的8層高帶寬存儲器(HBM2)產品相同,這在組件設計上是一項重大進步。這將幫助客戶發布具有更高性能容量的下一代大容量產品,而無需更改其系統配置設計。
圖1:PKG截面結構
此外,3D封裝技術還具有比當前現有的引線鍵合技術短的芯片間數據傳輸時間,從而顯著提高了速度并降低了功耗。
三星電子TSP(測試與系統封裝)執行副總裁Hong-Joo Baek表示:“隨著各種新時代的應用(例如人工智能(AI)和高功率計算(HPC)),確保超高性能存儲器的所有復雜性的封裝技術變得越來越重要。”
隨著摩爾定律的擴展達到極限,預計3D-TSV技術的作用將變得更加關鍵。我們希望站在這一最新的芯片封裝技術的最前沿。”
依靠其12層3D-TSV技術,三星將為數據密集型和超高速應用提供最高的DRAM性能。
而且,通過將堆疊層數從8個增加到12個,三星很快將能夠批量生產24GB高帶寬內存,其容量是當今市場上8GB高帶寬內存的三倍。
圖2:引線鍵合與TSV技術
三星將憑借其尖端的12層3D TSV技術滿足快速增長的大容量HBM解決方案市場需求,并希望鞏固其在高端半導體市場的領先地位。
-
三星電子
+關注
關注
4文章
570瀏覽量
40715 -
內存
+關注
關注
9文章
3210瀏覽量
76365 -
芯片封裝
+關注
關注
13文章
614瀏覽量
32264
發布評論請先 登錄



 三星電子開發業界首創的12層3D TSV芯片封裝技術
三星電子開發業界首創的12層3D TSV芯片封裝技術







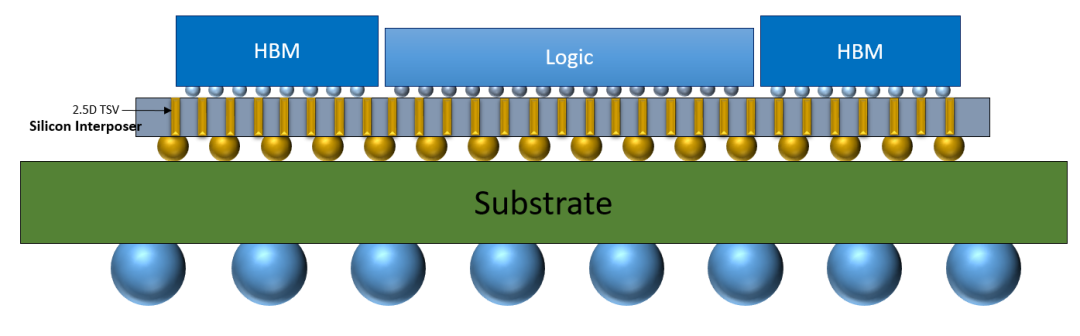




評論