在 FOWLP 中存在兩個重要概念, 即扇出型封裝和晶圓級封裝。如圖 1 所示, 扇出型封裝(Fan-out)是與扇入型封裝(Fan-in)對立的概念, 傳統扇入型封裝的 I/ O 接口均位于晶粒
2024-04-07 08:41:00 2958
2958 
常規IC封裝需經過將晶圓與IC封裝基板焊接,再將IC基板焊接至普通PCB的復雜過程。與之不同,WLP基于IC晶圓,借助PCB制造技術,在晶圓上構建類似IC封裝基板的結構,塑封后可直接安裝在普通PCB
2025-05-14 11:08:16 2423
2423 
傳蘋果(Apple)決定在下一款iPhone上采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)技術。由于半導體技術日趨先進,無須印刷電路板(PCB)的封裝技術出現,未來恐發生印刷電路板市場逐漸萎縮的現象。
2016-05-06 09:05:33 2138
2138 據海外媒體報道,扇出型晶圓級封裝(FOWLP)能以更小型的外觀造型規格(form factor)、更輕薄的封裝、更高的I/O密度以及多晶粒解決方案,創造許多性能與成本上的優勢,因此成為近年來半導體
2016-12-13 11:02:59 2472
2472 先進半導體封裝與測試服務提供商艾克爾科技 (Amkor) 和 NANIUM S.A. 于 6 日聯合宣布,雙方已簽署一項最終協議,由艾克爾科技收購扇型晶圓級 (WLFO) 半導體封裝解決方案供應商 NANIUM。不過,雙方并未針對交易金額等相關交易條款進行公布。
2017-02-08 09:23:45 2058
2058 高密度扇出型封裝技術滿足了移動手機封裝的外形尺寸與性能要求,因此獲得了技術界的廣泛關注。
2020-07-13 15:03:21 1588
1588 
近幾年中,芯片特征尺寸已接近物理極限,而先進封裝技術成為延續摩爾定律的重要途徑。一系列新型封裝技術出現在人們視野之中。而其中扇出型晶圓級封裝(FOWLP)被寄予厚望,它將為下一代緊湊型、高性能的電子設備提供堅實而有力的支持。
2022-07-10 15:06:32 15700
15700 技術成為實現系統性能、帶寬和功耗等方面指標提升的重要備選方案之一。對目前已有的晶圓級多層堆疊技術及其封裝過程進行了詳細介紹; 并對封裝過程中的兩項關鍵工藝,硅通孔工藝和晶圓鍵合與解鍵合工藝進行了分析
2022-09-13 11:13:05 6190
6190 扇出型圓片級封裝(FoWLP)是圓園片級封裝中的一種。相對于傳統封裝圓片級封裝具有不需要引線框、基板等介質的特點,因此可以實現更輕、薄短、小的封裝。扇出型圓片級封裝也可以支持多芯片、2.5D/3D
2023-05-08 10:33:17 3415
3415 
扇出型晶圓級封裝技術采取在芯片尺寸以外的區域做I/O接點的布線設計,提高I/O接點數量。采用RDL工藝讓芯片可以使用的布線區域增加,充分利用到芯片的有效面積,達到降低成本的目的。扇出型封裝技術完成芯片錫球連接后,不需要使用封裝載板便可直接焊接在印刷線路板上,這樣可以縮短信號傳輸距離,提高電學性能。
2023-09-25 09:38:05 3212
3212 
WLCSP(Wafer Level Chip Scale Packaging)即晶圓級芯片封裝方式,不同于傳統的芯片封裝方式(先切割再封測,而封裝后至少增加原芯片20%的體積),此種最新技術是先在整片晶圓上進行封裝和測試,然后才切割成一個個的IC顆粒,因此封裝后的體積即等同IC裸晶的原尺寸。
2023-11-06 11:02:07 5143
5143 
介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP
2023-11-08 09:20:19 11649
11649 
在上篇文章中介紹了扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝,這篇文章著重介紹硅通孔(TSV)封裝工藝。
2023-11-08 10:05:53 7069
7069 
晶圓承載系統是指針對晶圓背面減薄進行進一步加工的系統,該工藝一般在背面研磨前使用。晶圓承載系統工序涉及兩個步驟:首先是載片鍵合,需將被用于硅通孔封裝的晶圓貼附于載片上;其次是載片脫粘,即在如晶圓背面凸點制作等流程完工后,將載片分離。
2023-11-13 14:02:49 6499
6499 
隨著晶圓級封裝技術的不斷提升,眾多芯片設計及封測公司開始思考并嘗試采用晶圓級封裝技術替代傳統封裝。其中HRP(Heat?Re-distribution?Packaging)晶圓級先進封裝
2023-11-30 09:23:24 3833
3833 
扇出型封裝一般是指,晶圓級/面板級封裝情境下,封裝面積與die不一樣,且不需要基板的封裝,也就是我們常說的FOWLP/FOPLP。扇出型封裝的核心要素就是芯片上的RDL重布線層(可參考下面圖表說明
2023-11-27 16:02:01 17600
17600 
本篇文章將探討用于晶圓級封裝(WLP)的各項材料,從光刻膠中的樹脂,到晶圓承載系統(WSS)中的粘合劑,這些材料均在晶圓級封裝中發揮著重要作用。
2023-12-15 17:20:36 3691
3691 
在本文中,我們將重點介紹半導體封裝的另一種主要方法——晶圓級封裝(WLP)。本文將探討晶圓級封裝的五項基本工藝,包括:光刻(Photolithography)工藝、濺射(Sputtering)工藝
2024-01-24 09:39:09 3633
3633 
扇出型晶圓級中介層封裝( FOWLP)以及封裝堆疊(Package-on-Package, PoP)設計在移動應用中具有許多優勢,例如低功耗、短信號路徑、小外形尺寸以及多功能的異構集成。此外,它還
2025-01-22 14:57:52 4508
4508 
我們看下一個先進封裝的關鍵概念——晶圓級封裝(Wafer Level Package,WLP)。
2025-05-14 10:32:30 1534
1534 
晶圓級扇出封裝(FO-WLP)通過環氧樹脂模塑料(EMC)擴展芯片有效面積,突破了扇入型封裝的I/O密度限制,但其技術復雜度呈指數級增長。
2025-06-05 16:25:57 2152
2152 
在功率半導體封裝領域,晶圓級芯片規模封裝技術正引領著分立功率器件向更高集成度、更低損耗及更優熱性能方向演進。
2025-10-21 17:24:13 3875
3875 
由中國科學院微電子所、華進半導體共同出資成立的江蘇中科智芯集成科技有限公司的晶圓級扇出型(FO)封裝項目即將于2019年11月投產。 2018年3月,江蘇中科智芯集成科技有限公司成立,承接華進半導體
2019-08-02 11:38:29 4829
4829 圖為一種典型的晶圓級封裝結構示意圖。晶圓上的器件通過晶圓鍵合一次完成封裝,故而可以有效減小封裝過程中對器件造成的損壞。 圖1 晶圓級封裝工藝過程示意圖 1 晶圓封裝的優點 1)封裝加工
2021-02-23 16:35:18
晶圓級封裝技術Wafer Level Package Technology Board Mounting Application Note for 0.800mm pitch
2009-06-12 23:57:22
晶圓級封裝技術源自于倒裝芯片。晶圓級封裝的開發主要是由集成器件制造廠家(IBM)率先啟動。1964年,美國IBM公司在其M360計算器中最先采用了FCOB焊料凸點倒裝芯片器件。
2020-03-06 09:02:23
晶圓級封裝類型及涉及的產品
2015-07-11 18:21:31
晶圓級CSP的返修工藝包括哪幾個步驟?晶圓級CSP對返修設備的要求是什么?
2021-04-25 08:33:16
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
晶圓級芯片封裝技術是對整片晶圓進行封裝測試后再切割得到單個成品芯片的技術,封裝后的芯片尺寸與裸片一致。
2019-09-18 09:02:14
` 晶圓級封裝是一項公認成熟的工藝,元器件供應商正尋求在更多應用中使用WLP,而支持WLP的技術也正快速走向成熟。隨著元件供應商正積極轉向WLP應用,其使用范圍也在不斷擴大。 目前有5種成熟
2011-12-01 14:33:02
晶圓級芯片級封裝; 49 bumps; 3.29×3.29×0.54mm(包括背面涂層)
2022-12-06 06:06:48
SiC SBD 晶圓級測試 求助:需要測試的參數和測試方法謝謝
2020-08-24 13:03:34
,? PCB(引線鍵合和倒裝芯片)上的芯片堆疊,具有嵌入式器件的堆疊式柔性功能層,? 有或無嵌入式電子器件的高級印制電路板(PCB)(圖4)堆疊,? 晶圓級芯片集成,? 基于穿硅通孔(TSV)的垂直
2011-12-02 11:55:33
納米到底有多細微?什么晶圓?如何制造單晶的晶圓?
2021-06-08 07:06:42
`晶圓級封裝(WLP)就是在其上已經有某些電路微結構(好比古董)的晶片(好比座墊)與另一塊經腐蝕帶有空腔的晶片(好比玻璃罩)用化學鍵結合在一起。在這些電路微結構體的上面就形成了一個帶有密閉空腔的保護
2011-12-01 13:58:36
` 晶圓電阻又稱圓柱型精密電阻、無感晶圓電阻、貼片金屬膜精密電阻、高精密無感電阻、圓柱型電阻、無引線金屬膜電阻等叫法;英文名稱是:Metal Film Precision Resistor-CSR
2011-12-02 14:57:57
怎么選擇晶圓級CSP裝配工藝的錫膏?
2021-04-25 08:48:29
固態圖像傳感器要求在環境大氣中得到有效防護。第一代圖像傳感器安裝在帶玻璃蓋的標準半導體封裝中。這種技術能使裸片得到很好的密封和異常堅固的保護,但體積比較龐大,制造成本也比較高。引入晶圓級封裝后
2018-12-03 10:19:27
隨著集成電路設計師將更復雜的功能嵌入更狹小的空間,異構集成包括器件的3D堆疊已成為混合與連接各種功能技術的一種更為實用且經濟的方式。作為異構集成平臺之一,高密度扇出型晶圓級封裝技術正獲得越來越多
2020-07-07 11:04:42
`什么是硅晶圓呢,硅晶圓就是指硅半導體積體電路制作所用的硅晶片。晶圓是制造IC的基本原料。硅晶圓和晶圓有區別嗎?其實二者是一個概念。集成電路(IC)是指在一半導體基板上,利用氧化、蝕刻、擴散等方法
2011-12-02 14:30:44
SRAM中晶圓級芯片級封裝的需求
2020-12-31 07:50:40
的圖像傳感器晶圓上一般有750到1500個裸片,因此與單獨陶瓷封裝相比,每個裸片的封裝成本可以降低一個數量級。 雖然晶圓級封裝看起來似乎很簡單,但大批量生產所需的材料、工具和專業知識直到最近才真正成功
2018-10-30 17:14:24
市場分析:MEMS封裝朝向晶圓級發展
傳統的MEMS長期依賴陶瓷封裝,雖然行之有效,但MEMS產業已經醞釀向晶圓級封裝(WLP)技術轉變,而這一轉變的部分驅動力則來自于
2009-12-28 10:27:25 987
987 晶圓級封裝產業(WLP),晶圓級封裝產業(WLP)是什么意思
一、晶圓級封裝(Wafer Level Packaging)簡介 晶圓級封裝(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 46790
46790 松下電工成功開發出通過晶圓級接合,將封裝有LED的晶圓和配備有光傳感器的晶圓合計4枚晶圓進行集成封裝。
2011-08-28 11:37:22 1683
1683 WILSONVILLE, Ore., 2016年3月15日— Mentor Graphics公司(納斯達克代碼:MENT)今天發布了一款結合設計、版圖布局和驗證的解決方案,為TSMC集成扇出型 (InFO) 晶圓級封裝技術的設計應用提供支持。
2016-03-15 14:06:02 1296
1296 傳蘋果在2016年秋天即將推出的新款智能型手機iPhone 7(暫訂)上,將搭載采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)的芯片,讓新iPhone更輕薄,制造成本更低。那什么是FOWLP封裝技術呢?
2016-05-06 17:59:35 5105
5105 的局面:對于Amkor來講,歐洲公司Nanium在內嵌式晶圓級球柵陣列(eWLB)生產中積累了近10年的晶圓級封裝經
2017-09-25 09:36:00 19
19 蘋果供應訂單的爭奪戰上,臺積電領先三星以7nm制程拿下蘋果新世代處理器訂單,但三星也不會坐以待斃,據悉,三星將發展扇出型晶圓級封裝(Fo-WLP)制程,想藉此贏回蘋果供應訂單。
2017-12-29 11:36:27 1307
1307 由于晶圓級封裝不需要中介層、填充物與導線架,并且省略黏晶、打線等制程,能夠大幅減少材料以及人工成本;已經成為強調輕薄短小特性的可攜式電子產品 IC 封裝應用的之選。FuzionSC貼片機能應對這種先進工藝。
2018-05-11 16:52:52 53962
53962 
臨時鍵合需要鍵合(bonding)和剝離(debonding)兩種工藝。從扇出型晶圓級封裝(fan-out wafer-level packaging,FoWLP)到功率器件,每種應用在工藝溫度
2018-07-10 09:27:00 9864
9864 由于電子產品越來越細小,晶圓級CSP組裝已經廣泛地應用在不同產品了。
2018-10-30 09:51:06 47034
47034 面板級封裝(PLP)就是一種從晶圓和條帶級向更大尺寸面板級轉換的方案。由于其潛在的成本效益和更高的制造效率,吸引了市場的廣泛關注。由于面板的大尺寸和更高的載具使用率(95%),它還帶來了遠高于晶圓級尺寸扇出型晶圓級封裝(FOWLP)的規模經濟效益,并且能夠實現大型封裝的批量生產。
2018-12-30 10:24:00 12179
12179 MUNICH - Karl Suss KG GmbH&公司今天宣布與硅谷的Image Technology公司合作,開發和標準化9英寸掩模,用于大批量晶圓凸點和晶圓級芯片級封裝的生產。總體目標是降低晶圓級芯片級封裝的掩模成本。
2019-08-13 10:48:59 3097
3097 近日,亞智科技向廣東佛智芯微電子技術研究有限公司(以下簡稱:佛智芯)交付大板級扇出型封裝解決方案。
2020-03-17 15:15:38 4829
4829 來源:半導體行業觀察 在過去十年中,晶圓級封裝(Wafer level packaging:WLP)引起了人們的極大興趣和關注,因為半導體行業繼續推動以移動和消費領域為主導的一代又一代的更高
2020-09-15 15:08:23 2486
2486 摩爾定律在晶圓工藝制程方面已是強弩之末,此時先進的封裝技術拿起了接力棒。扇出型晶圓級封裝(FOWLP)等先進技術可以提高器件密度、提升性能,并突破芯片I/O數量的限制。然而,要成功利用這類技術,在芯片設計之初就要開始考慮其封裝。
2020-11-12 16:55:39 1147
1147 Durendal?工藝提供了一種經濟高效的方式進行單個晶片堆疊,并能產出高良率以及穩固可靠的連接。在未來,我們期待Durendal?工藝能促進扇出型晶圓級封裝在單個晶片堆疊中得到更廣泛的應用。
2020-12-24 17:39:43 1299
1299 作為華天集團晶圓級先進封裝基地,華天昆山2008年6月落戶昆山開發區,研發的晶圓級傳感器封裝技術、扇出型封裝技術、超薄超小型晶圓級封裝、晶圓級無源器件制造技術目前已達到世界領先水平。
2021-01-09 10:16:09 5508
5508 扇出型晶圓級封裝最大的優勢,就是令具有成千上萬I/O點的半導體器件,通過二到五微米間隔線實現無縫連接,使互連密度最大化,實現高帶寬數據傳輸,去除基板成本。
2022-03-23 14:02:25 2885
2885 在傳統晶圓封裝中,是將成品晶圓切割成單個芯片,然后再進行黏合封裝。不同于傳統封裝工藝,晶圓級封裝是在芯片還在晶圓上的時候就對芯片進行封裝,保護層可以黏接在晶圓的頂部或底部,然后連接電路,再將晶圓切成單個芯片。
2022-04-06 15:24:19 12071
12071 晶圓級封裝技術可定義為:直接在晶圓上進行大部分或全部的封裝、測試程序,然后再進行安裝焊球并切割,從而產出一顆顆的IC成品單元。
2022-07-10 11:23:51 2215
2215 晶圓拋光機作為半導體晶圓拋光配備,主要優點有新型實用、經濟成本低、容易實現。
2023-01-06 12:21:31 2955
2955 晶圓級封裝(Wafer Level Packaging,縮寫WLP)是一種先進的封裝技術,因其具有尺寸小、電性能優良、散熱好、成本低等優勢,近年來發展迅速。根據Verified Market
2023-02-24 09:35:05 3178
3178 隨著超高密度多芯片模組(Multiple Chip Module,MCM)乃至系統級封裝(SiP)產品在5G、AI、高性能運算、汽車自動駕駛等領域的普及,2.5D 和 3D 晶圓級封裝技術備受設計人員青睞。
2023-02-24 09:38:08 1723
1723 晶圓級芯片尺寸封裝-AN10439
2023-03-03 19:57:27 5
5 本應用筆記討論ADI公司的晶圓級封裝(WLP),并提供WLP的PCB設計和SMT組裝指南。
2023-03-08 19:23:00 4780
4780 
據業內人士透露,三星電子已加緊布局扇出型(FO)晶圓級封裝領域,并計劃在日本設立相關生產線。
2023-04-10 09:06:50 2851
2851 來源;《半導體芯科技》雜志 作者:黃泰源、羅長誠、鐘興進,廣東鴻浩半導體設備有限公司 摘要 扇出晶圓級封裝廣泛應用于手機、車載等電子產品上。制造過程中需要使用到暫時性基板,而移除暫時性基板最適
2023-04-28 17:44:43 2743
2743 
本文研究了一種用于5G通信的射頻微系統與天線一體化三維扇出型集成封裝技術. 通過在玻璃晶圓 上使用雙面布線工藝,實現毫米波天線陣列的制作. 將TSV轉接芯片與射頻芯片倒裝焊在玻璃晶圓上,再用樹脂材料
2023-05-15 10:39:22 2695
2695 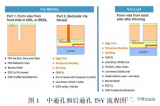
領先的晶圓代工廠組裝和封測代工廠 (OSAT) 已經在為其客戶提供高密度先進封裝(HDAP) 服務了。晶圓代工廠/OSAT 目前提供的常見方法包括 2.5D-IC(基于中介層)和扇出型晶圓級封裝(FOWLP) 方法(單裸片或多裸片),如圖 1 所示。
2023-07-11 15:18:54 1101
1101 
晶圓級封裝是在整個晶圓(wafer)的級別上進行封裝,而普通封裝是在單個芯片級別上進行封裝。晶圓級封裝通常在晶圓制造完成后,將多個芯片同時封裝在同一個晶圓上,形成多個封裝單元。相比之下,普通封裝將單個芯片分別封裝在獨立的封裝器件上。
2023-08-30 16:44:57 5859
5859 在扇出型晶圓級封裝(fowlp) 華海誠科的FOWLP封裝是21世紀前十年,他不對稱的封裝形式提出環氧塑封料的翹曲控制等的新要求環氧塑封料更加殘酷的可靠性要求,經過審查后也吐不出星星,芯片電性能維持良好。
2023-09-13 11:49:37 1711
1711 晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
2023-10-18 09:31:05 4921
4921 
扇出型晶圓級封裝技術的優勢在于能夠利用高密度布線制造工藝,形成功率損耗更低、功能性更強的芯片封裝結構,讓系統級封裝(System in a Package, SiP)和3D芯片封裝更愿意采用扇出型晶圓級封裝工藝。
2023-10-25 15:16:14 2051
2051 
近年來,隨著晶圓級封裝技術的不斷提升,眾多芯片設計及封測公司開始思考并嘗試采用晶圓級封裝技術替代傳統封裝。其中HRP(Heat Re-distribution Packaging)晶圓級先進封裝
2023-11-18 15:26:58 0
0 【科普】什么是晶圓級封裝
2023-12-07 11:34:01 2771
2771 
共讀好書 本篇文章將探討用于晶圓級封裝(WLP)的各項材料,從光刻膠中的樹脂,到晶圓承載系統(WSS)中的粘合劑,這些材料均在晶圓級封裝中發揮著重要作用。 光刻膠(Photoresists, PR
2024-02-18 18:16:31 2250
2250 
分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶
2024-03-05 08:42:13 3555
3555 
扇出技術是一種先進的封裝技術,能允許在晶圓級封裝之外的區域形成額外的I/O(輸入/輸出)點,從而提高芯片的性能和功能。與傳統的晶圓級封裝相比,扇出技術提供了更好的電氣和熱性能,同時還能實現更小的封裝尺寸。
2024-04-28 12:36:38 1677
1677 
本發明揭示了一種晶圓級芯片扇出封裝法,主要步驟包括:首先制作芯片單元(包括裸芯片及重布線層);其次,利用激光直寫光刻設備獲取裸芯片的實際位置信息并據此調整數字掩模版的原始布線圖;
2024-05-11 16:30:17 1074
1074 
晶圓級封裝是一種先進的半導體封裝技術,被廣泛應用在存儲器、傳感器、電源管理等對尺寸和成本要求較高的領域中。在這些領域中,這種技術能夠滿足現代對電子設備的小型化、多功能、低成本需求,為半導體制造商提供了創新的解決方案,更好地應對市場的需求和挑戰。
2024-07-19 17:56:41 3194
3194 在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝
2024-08-21 15:10:38 4450
4450 
使用昂貴的干法刻蝕設備和基板材料,具有很大的成本優勢,成為各大廠家優先布局發展的戰略方向。 硅基扇出封裝 硅基扇出型晶圓級封裝(embedded Silicon Fan-out,eSiFO) 是華天科技2015年開始研發,2018年開發成功并具有自主知識產權的一種先進Fan-Out封
2024-12-06 10:00:19 1367
1367 (Semiconductor Advanced Packaging) - 6 扇出型晶圓級封裝(FOWLP) 封裝技術從早期到現在的發展都是為了
2024-12-06 11:43:41 4730
4730 
晶圓微凸點封裝,更常見的表述是晶圓微凸點技術或晶圓級凸點技術(Wafer Bumping),是一種先進的半導體封裝技術。以下是對晶圓微凸點封裝的詳細解釋:
2024-12-11 13:21:23 1416
1416 和低成本等優點,成為滿足現代電子產品小型化、多功能化和高性能化需求的關鍵技術。本文將詳細解析晶圓級封裝的五項基本工藝,包括光刻(Photolithography)工
2025-01-07 11:21:59 3195
3195 
隨著半導體技術的飛速發展,晶圓級封裝(WLP)作為先進封裝技術的重要組成部分,正逐漸成為集成電路封裝的主流趨勢。在晶圓級封裝過程中,Bump工藝扮演著至關重要的角色。Bump,即凸塊,是晶圓級封裝中
2025-03-04 10:52:57 4980
4980 
經過半年的測試,普萊信智能和某頂級封裝廠就其巨量轉移式板級封裝設備(FOPLP)設備XBonder Pro達成戰略合作協議,這將是巨量轉移技術在IC封裝領域第一次規模化的應用,將掀起晶圓級封裝和板級
2025-03-04 11:28:05 1186
1186 
圓片級封裝(WLP),也稱為晶圓級封裝,是一種直接在晶圓上完成大部分或全部封裝測試程序,再進行切割制成單顆組件的先進封裝技術 。WLP自2000年左右問世以來,已逐漸成為半導體封裝領域的主流技術,深刻改變了傳統封裝的流程與模式。
2025-05-08 15:09:36 2068
2068 
在微電子行業飛速發展的背景下,封裝技術已成為連接芯片創新與系統應用的核心紐帶。其核心價值不僅體現于物理防護與電氣/光學互聯等基礎功能,更在于應對多元化市場需求的適應性突破,本文著力介紹晶圓級扇入封裝,分述如下。
2025-06-03 18:22:20 1055
1055 
晶圓級封裝含扇入型、扇出型、倒裝芯片、TSV 等工藝。錫膏在植球、凸點制作、芯片互連等環節關鍵:扇入 / 扇出型植球用錫膏固定錫球;倒裝芯片用其制作凸點;TSV 堆疊靠其實現垂直連接。應用依賴鋼網
2025-07-02 11:53:58 947
947 
扇出型晶圓級封裝(FOWLP)的概念最早由德國英飛凌提出,自2016 年以來,業界一直致力于FOWLP 技術的發展。
2026-01-04 14:40:30 199
199 
 電子發燒友App
電子發燒友App






























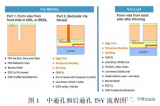




















評論