來源:華天科技
在半導(dǎo)體封裝領(lǐng)域,扇出(Fan-Out)技術(shù)正以其獨特的優(yōu)勢引領(lǐng)著新一輪的技術(shù)革新。它通過將芯片連接到更寬廣的基板上,實現(xiàn)了更高的I/O密度和更優(yōu)秀的熱性能。由于扇出型封裝不需要使用昂貴的干法刻蝕設(shè)備和基板材料,具有很大的成本優(yōu)勢,成為各大廠家優(yōu)先布局發(fā)展的戰(zhàn)略方向。
硅基扇出封裝
硅基扇出型晶圓級封裝(embedded Silicon Fan-out,eSiFO)是華天科技2015年開始研發(fā),2018年開發(fā)成功并具有自主知識產(chǎn)權(quán)的一種先進Fan-Out封裝技術(shù),目前已達到可以穩(wěn)定作業(yè)生產(chǎn)量產(chǎn)狀態(tài)。eSiFO使用硅基板為載體,通過在硅基板上干法刻蝕作出凹槽,將芯片放置且固定于凹槽內(nèi),用真空壓膜填補芯片間空隙后,芯片表面和硅片表面構(gòu)成了一個扇出面,在這個面上進行多層再布線,并制作引出端做球,最后切割達到封裝目的。華天科技在硅基晶圓封裝制造領(lǐng)域有著深厚的技術(shù)積累,產(chǎn)業(yè)下的TSV技術(shù)封裝工藝路線成熟,這也是其成功研發(fā)eSiFO的關(guān)鍵。
eSiFO技術(shù)廣泛應(yīng)用于電源管理芯片、射頻收發(fā)器芯片、基帶處理器和高端網(wǎng)絡(luò)系統(tǒng)等多種應(yīng)用領(lǐng)域。采用eSiFO芯片F(xiàn)an-out很大程度上縮小了芯片尺寸,提高晶圓產(chǎn)出,相比于傳統(tǒng)封裝芯片間互連更短,性能更優(yōu),在散熱上也具有較明顯的優(yōu)勢。
硅基扇出封裝更深層次應(yīng)用
華天科技不僅實現(xiàn)了單芯片硅基扇出型封裝,還開發(fā)完成了多芯片的系統(tǒng)級集成扇出型封裝并達到小批量生產(chǎn),eSiFO技術(shù)可以實現(xiàn)多芯片系統(tǒng)集成SIP,易于實現(xiàn)芯片異質(zhì)集成,相比于傳統(tǒng)封裝,整體封裝尺寸大幅度縮減,芯片間互連更短,性能更強。
為了實現(xiàn)更高階的微系統(tǒng)集成,華天科技在二維硅基扇出型封裝的基礎(chǔ)上繼續(xù)開發(fā)了基于大空腔干法刻蝕、TSV直孔和臨時鍵合技術(shù)的三維扇出型晶圓級封裝(embedded System in Chip,eSinC)。該技術(shù)的一個顯著優(yōu)勢是使用硅基取代塑封料,硅基的熱膨脹系數(shù)、楊氏模量及熱導(dǎo)率方面均優(yōu)于塑封料,且因材質(zhì)與芯片材質(zhì)相同,散熱能力更為穩(wěn)定。采用TSV通孔實現(xiàn)垂直方向互聯(lián),大大提高了互聯(lián)密度和集成度。eSinC技術(shù)的研發(fā)大大降低封裝的尺寸,所獲得的系統(tǒng)級封裝產(chǎn)品具有易于組裝、高性價比等突出優(yōu)勢。通過三維扇出型晶圓級封裝的研發(fā)成功,使華天初步具備了下一代垂直三維互連封裝技術(shù),在后摩爾時代將發(fā)揮重要作用。
聲明:本網(wǎng)站部分文章轉(zhuǎn)載自網(wǎng)絡(luò),轉(zhuǎn)發(fā)僅為更大范圍傳播。 轉(zhuǎn)載文章版權(quán)歸原作者所有,如有異議,請聯(lián)系我們修改或刪除。聯(lián)系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
封裝
+關(guān)注
關(guān)注
128文章
9249瀏覽量
148624 -
硅基
+關(guān)注
關(guān)注
0文章
62瀏覽量
16560
發(fā)布評論請先 登錄
GaN(氮化鎵)與硅基功放芯片的優(yōu)劣勢解析及常見型號
高扇出信號線優(yōu)化技巧(下)
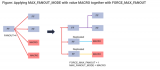
高扇出信號線優(yōu)化技巧(上)

推拉力測試機詳解:硅基WLP封裝焊球剪切與拉脫測試全流程
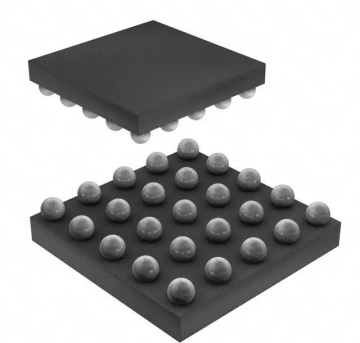
采用扇出晶圓級封裝的柔性混合電子

聚智姑蘇,共筑硅基光電子產(chǎn)業(yè)新篇 — “硅基光電子技術(shù)及應(yīng)用”暑期學校圓滿落幕!

扇出型封裝材料:技術(shù)突破與市場擴張的雙重奏
什么是晶圓級扇出封裝技術(shù)

一種低翹曲扇出重構(gòu)方案

高通公司中國區(qū)董事長孟樸來華天調(diào)研

半導(dǎo)體封裝材料革命:從硅基桎梏到多元破局
碳化硅VS硅基IGBT:誰才是功率半導(dǎo)體之王?

深入解析硅基光子芯片制造流程,揭秘科技奇跡!




 華天科技硅基扇出封裝
華天科技硅基扇出封裝





評論