經過半年的測試,普萊信智能和某頂級封裝廠就其巨量轉移式板級封裝設備(FOPLP)設備XBonder Pro達成戰略合作協議,這將是巨量轉移技術在IC封裝領域第一次規模化的應用,將掀起晶圓級封裝和板級封裝領域的一次技術革命。普萊信同時在和某全球最領先的封裝廠,某全球領先的功率器件公司就XBonder Pro在晶圓級封裝的應用開展合作。
芯片的轉移是晶圓級封裝和板級封裝的核心工序,由于高端的板級封裝和晶圓級封裝需要在貼片完成后,進行RDL等工藝,所以對貼片精度要求極高,一般精度要求不低于±7微米,甚至要達到±3微米,而傳統的高精度貼固晶機(貼片機),速度較低,各個設備廠家只能通過增加邦頭和吸嘴的數量來提升單機的UPH,這就導致機器復雜,成本高昂,吸嘴的不穩定導致稼動率和良率極低,而且隨著IC設計的發展,芯片集成度越來越高,小芯片的數量越來越多,導致傳統吸嘴式的貼片設備難以支持產業的發展。下圖展示了普萊信巨量轉移設備相對傳統設備的巨大優勢。

普萊信的巨量轉移技術采用了完全不同于傳統固晶設備的工藝,從而將整個固晶效率提升了十倍,將固晶,或者裝片的成本也降低了數倍。刺晶式固晶機是如何做到速度的數量級提升的呢。在傳統的IC封裝工藝中,固晶,或者叫裝片,貼片,是整個生產工藝的關鍵環節,傳統的固晶機,裝片機,無一列外采用的都是Pick & Place的工藝。
1.通過頂針,將芯片從下向上在藍膜上頂起;
2.吸嘴過來,通過視覺定位后,將芯片吸取;
3.吸住芯片后,移動到目標位置,通過多次視覺定位后,將芯片貼合到目標位置。
這種Pick&Place工藝非常成熟,市場上的各種固晶機,從貼裝精度三微米以下的高精度固晶機到貼裝精度幾十微米的LED固晶機,無一列外都是這種工藝模式,Pick & Place模式下,對精度要求越高,每小時產出(UPH)就會越低,比如貼裝精度3微米的高精度固晶機,UPH只有幾百個每小時。
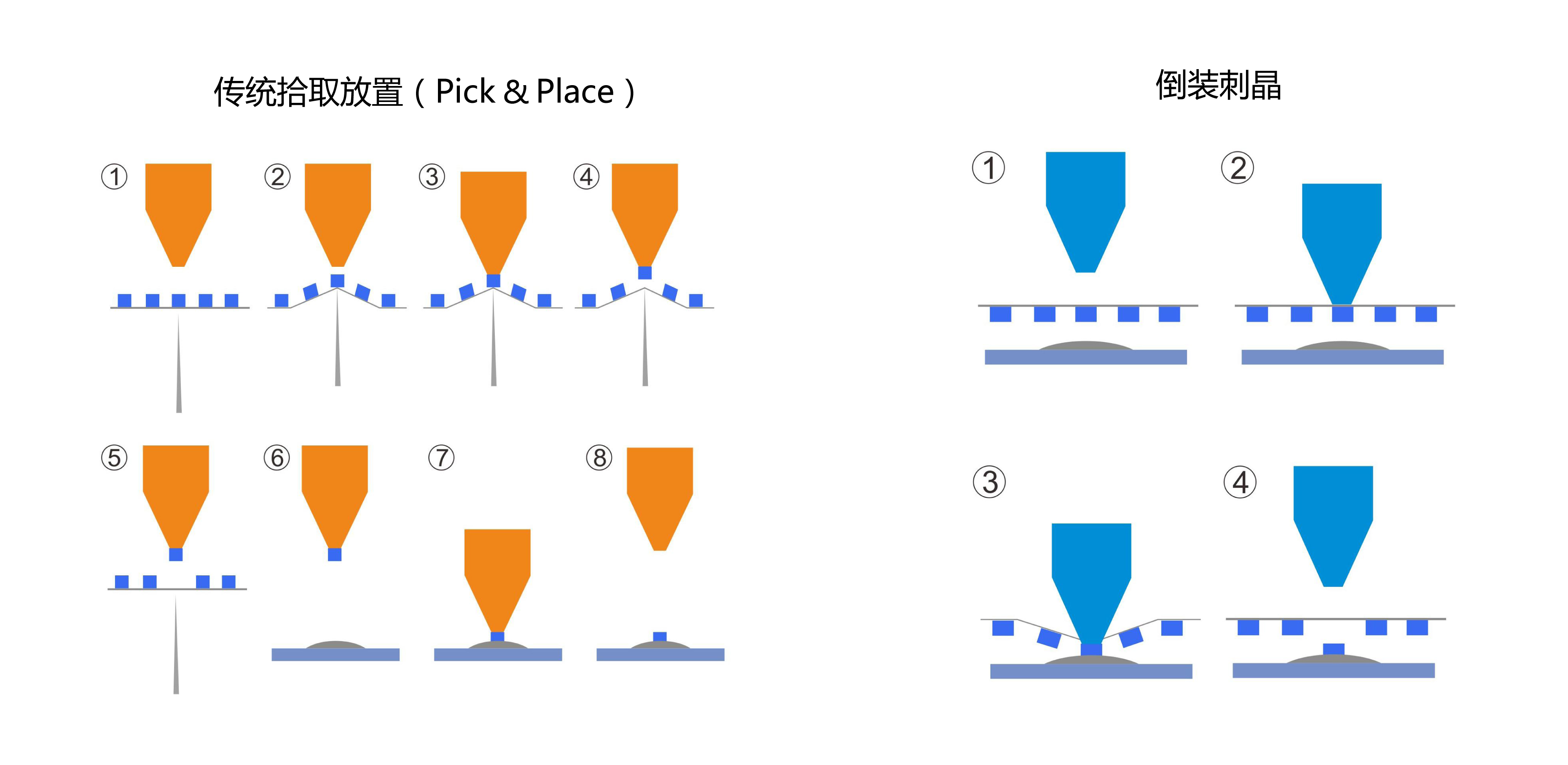
刺晶式巨量轉移設備,采用了更簡化的工藝,將芯片翻轉,基板置于其下,針,晶圓同時移動相對基板進行定位,用針刺的方式把芯片刺到基板,這樣大幅度減少了動作,提高了效率,普萊信的刺晶式固晶機,在MiniLED領域,其UPH可以超過300K。普萊信在其MiniLED巨量轉移設備的基礎上,結合板級封裝和晶圓級封裝的要求,設計了專為高精度IC封裝的XBonder Pro系列產品,高精度下UPH可以達到30K左右,因為沒有吸嘴的損耗或者多吸嘴的不一致問題,刺晶的稼動率遠高于傳統的高精度多頭設備。真正幫FOPLP和晶圓級封裝降低生產成本,讓其做到貼片成本可以低于傳統封裝。
同時,相對傳統的封裝設備,刺晶效率高,耗電耗氣大幅度降低,極大的降低了設備投入成本和運營成本,相信巨量轉移式設備在IC封裝領域的成熟,將會引起IC封裝行業的一次新技術變革。
3月26-28日,SEMICON China展會期間,普萊信(展位號:N1-1285)將攜巨量轉移式板級封裝設備XBonder Pro、TCB熱壓鍵合機Loong(國產唯一HBM/CoWoS鍵合設備)、高速夾焊系統Clip Bonder、多功能超高精度機DA403等亮相。
審核編輯 黃宇
-
封裝
+關注
關注
128文章
9297瀏覽量
148880 -
晶圓級
+關注
關注
0文章
39瀏覽量
10196
發布評論請先 登錄
基于板級封裝的異構集成詳解

什么是晶圓級扇入封裝技術




 簽約頂級封裝廠,普萊信巨量轉移技術掀起晶圓級封裝和板級封裝的技術革命
簽約頂級封裝廠,普萊信巨量轉移技術掀起晶圓級封裝和板級封裝的技術革命















評論